Croissance et gravure sélective de structures multicouches silicium/silicium-germanium dopés au phosphore pour application de transistors verticaux
Résumé
Les transistors à effet de champ à grille verticale (vGAAFET) sont considérés comme des candidats potentiels pour remplacer les FinFET pour la technologie avancée de fabrication de circuits intégrés au niveau/au-delà du nœud technologique de 3 nm. Une multicouche (ML) de Si/SiGe/Si est couramment développée et traitée pour former des transistors verticaux. Dans ce travail, l'incorporation de P dans Si/SiGe/Si et la gravure verticale de ces ML suivies d'une gravure sélective de SiGe dans la direction latérale pour former des structures pour vGAAFET ont été étudiées. Plusieurs stratégies ont été proposées pour l'épitaxie telles que la purge à l'hydrogène pour épuiser l'accès des atomes P à la surface du Si, et/ou l'insertion d'un Si ou Si0.93 Ge0,07 espaceurs des deux côtés des couches de Si dopé P, et substituant SiH4 par SiH2 Cl2 (DCS). Les résultats expérimentaux ont montré que la ségrégation et l'autodopage pouvaient également être soulagés en ajoutant 7 % de Ge au Si dopé au P. La structure avait une bonne qualité de réseau et n'avait presque pas de relaxation de contrainte. La gravure sélective entre Si dopé P (ou Si dopé P0.93 Ge0,07 ) et SiGe a également été discuté en utilisant une gravure humide et sèche. Les performances et la sélectivité de différentes méthodes de gravure ont également été comparées. Cet article fournit des connaissances sur la façon de traiter les défis ou les difficultés de l'épitaxie et de la gravure des couches de type n dans la structure verticale des GAAFET.
Introduction
Lorsque la mise à l'échelle du semi-conducteur à oxyde métallique complémentaire (CMOS) atteint sa limite physique, les effets de canal court affaiblissent considérablement les performances du transistor. Une solution à ces problèmes réside dans de nouvelles conceptions de transistors, par exemple, les GAAFET (transistors à effet de champ à grille globale), qui sont également considérés comme le candidat le plus prometteur pour les transistors à l'échelle nanométrique jusqu'au nœud technologique de 3 nm [1,2,3 ,4,5,6]. Les nanofils/nanofeuilles latéraux et verticaux sont les principales structures selon l'International Roadmap for Device and Systems (IRDS) 2020 pour remplacer les FinFET [7]. Les GAAFET verticaux (ou vGAAFET) ont une conception de flexibilité libre sur la longueur de la grille et ont un grand potentiel pour augmenter la densité intégrée [4, 8]. Il existe deux catégories principales pour mettre en œuvre des structures verticales de nanofils :ascendante et descendante. La méthode ascendante a introduit un catalyseur métallique, ce qui peut entraîner des problèmes de compatibilité des processus [9, 10]. La méthode descendante est la méthode dominante dans l'industrie en raison de son meilleur contrôle de la configuration des nanofils et de sa compatibilité avec FinFET [4, 11,12,13,14]. La méthode descendante pour fabriquer des GAAFET verticaux attire beaucoup d'attention. La porte d'auto-alignement avec un contrôle précis de la longueur de la porte était un problème crucial [15, 16]. Pour obtenir un meilleur contrôle efficace de la longueur de la grille ou réduire la variation, la longueur de la grille pourrait être principalement déterminée par l'épaisseur du matériau du canal épitaxié sur une surface plane inférieure, telle que Si/SiGe/Si, et SiGe était le matériau du canal [17, 18,19,20]. De plus, un autre défi d'intégration critique réside dans le dopage entre le canal et les régions S/D [16, 20, 21], en particulier avec un contrôle de jonction précis [20]. Comparé au processus d'implantation source/drain traditionnel, le processus d'épitaxie simplifie le processus de fabrication, réduit les dommages de surface et permet d'obtenir un profil de dopage uniforme. Cependant, la structure sandwich Si/SiGe/Si dopé P est difficile à croître par épitaxie en raison des phénomènes de ségrégation, d'autodopage et de surdiffusion des dopants de type n les plus courants, le phosphore [22, 23], l'arsenic [24, 25] et/ou l'antimoine [26, 27] à l'interface Si/SiGe dans les systèmes de dépôt chimique en phase vapeur (CVD). Par conséquent, les atomes donneurs séparés rassemblés à l'interface Si/SiGe et la couche SiGe seraient dopés, ce qui pourrait dégrader les performances du transistor avec des fuites élevées.
Une stratégie pour empêcher la ségrégation des dopants consiste à appliquer une température de croissance très basse. Il existe une série de rapports faisant de nombreux efforts pour développer le dopage de type n par épitaxie par faisceau moléculaire (MBE) [28]; entre-temps, cette méthode n'a pas été appliquée pour les MCV. L'équipement MBE est principalement de conception à puce unique, nécessitant un vide poussé et un débit lent. De plus, l'équipement MBE n'est pas compatible avec les tailles de plaquettes supérieures à 8 pouces dans l'industrie. Par conséquent, la technologie MBE n'est pas adaptée aux applications industrielles de production de masse. Cependant, le système RPCVD a une forte capacité de production et une structure d'équipement simple, ce qui convient à l'industrie des circuits intégrés [29]. La première idée pour la croissance RPCVD est de réguler le flux d'hydrogène dans la chambre puisque l'hydrogène est le gaz vecteur et peut affecter la cinétique des gaz précurseurs. Li et al. [23] ont rapporté que l'hydrogène modifiait la structure de liaison des atomes hôtes à la surface et réduisait l'énergie de ségrégation en appliquant une faible température de croissance dans un système CVD thermique rapide (RTCVD). Cependant, l'effet de l'hydrogène n'a pas été exploré à l'interface Si/SiGe dans un système CVD à pression réduite (RPCVD). Suvar et al. [30] ont inséré des couches d'espacement de Si non dopé de 30 nm entre le Si dopé P et le SiGe pour abaisser la concentration en P à l'interface d'un facteur 4 (de 8 × 10 19 cm −3 à 2 × 10 19 cm −3 ), mais le pic de dopage P ne peut être éliminé. Bennett et al. [31] ont étudié l'effet de la contrainte sur le dopage de type n dans Si. La solubilité solide du dopage a été augmentée en introduisant une contrainte de traction dans Si. Christensen et al. [32] n'ont trouvé aucune dépendance significative de la diffusivité du P sur la teneur en Ge dans Si1-x Gex (0 ≤ x ≤ 0,22). Et les coefficients de diffusion P avaient peu de différence entre le Si relaxé et le SiGe contraint en compression biaxiale. Zangenberg et al. [33] ont observé une amélioration du coefficient de diffusion d'un facteur 2 à 825 °C pour Si 0,88 relaxé Ge0.12 .
Dans cet article, plusieurs méthodes ont été proposées pour améliorer l'incorporation de P dans Si dans une multicouche de Si/SiGe/Si en utilisant RPCVD. Dans les expériences, différentes stratégies telles que la purge à l'hydrogène, l'insertion de couches d'espacement non dopées, le remplacement du précurseur Si de SiH4 à SiH2 Cl2 (DCS), et moduler le profil de déformation en introduisant Si0.93 Ge0,07 couche sacrificielle des deux côtés de la couche SiGe ont été présentés. De plus, la gravure sélective de SiGe a été discutée pour former une couche mince de SiGe (conçue comme couche de canal) [6, 34]. Les caractéristiques de gravure des outils de gravure humide et sèche ont également été comparées. La structure finale est destinée à être utilisée à l'avenir pour les vGAAFET pour les nœuds technologiques inférieurs à 10 nm.
Méthodes
Des multicouches Si/SiGe/Si (ML) ont été cultivées sur des plaquettes Si <100> de 200 mm avec un équipement RPCVD (ASM Epsilon 2000). Les substrats Si ont été nettoyés avec une solution de mélange de H2 SO4 et H2 O2 , suivi de HF dilué pour éliminer l'oxyde natif avant l'insertion dans les sas de charge de la chambre d'épitaxie. Les échantillons ont été nettoyés in situ par recuit à 1050 °C pour éliminer l'oxyde natif afin d'obtenir une surface de Si de haute qualité. Les précurseurs du Si, Ge et P étaient SiH4 (ou SiH2 Cl2 ), 10 % GeH4 en H2 , et 2% PH3 en H2 . La température de croissance était de 650 °C, tandis que la pression de la chambre était maintenue à 80 Torr pendant l'épitaxie. Dans certaines expériences, la pression de la chambre a été réduite à 10 Torr pour faire croître du Si dopé au P0,93 Ge0,07 couche dans les régions source/drain (S/D). La teneur en Ge dans le canal SiGe a été maintenue constante à 0,22. Pour étudier les caractéristiques de gravure sélective, du nitrure 50 nm/oxyde 30 nm a été déposé en tant que masque dur pour protéger les ML inférieurs. Une lithographie et une gravure verticale anisotrope sèche ont été réalisées pour former des motifs cuboïdes séparés. Des expériences de gravure sélective ont été réalisées avec un outil de gravure humide de HF (6%):H2 O2 (30%):CH3 COOH (99,8%) = 1:2:4 et outil de gravure sèche de CF4 :O2 :He = 4:1:5 [35].
Les ML Si/SiGe/Si ont été caractérisés par les techniques de microscopie électronique à transmission (HRTEM) à haute résolution (Thermo Scientific Talos F200), de spectroscopie des rayons X à dispersion d'énergie (EDX), de diffraction des rayons X à haute résolution (HRXRD) , et carte de réseau réciproque à haute résolution (HRRLM) de Bruker JV Delta-x, microscopie électronique à balayage (MEB) de Hitachi (Japon) et spectroscopie de masse d'ions secondaires (SIMS).
Résultats et discussion
Épitaxie des ML Si/SiGe/Si dopés P
Dans cette étude, l'incorporation de P dans Si et SiGe a été initialement explorée. Les structures ML sont illustrées à la Fig. 1a. Un ML de Si dopé P/Si non dopé avec PH 3 croissant l'écoulement a augmenté et les profils de couche ont été examinés par SIMS sur la figure 1b. La figure montre que la concentration de P augmente et atteint le niveau le plus élevé de 2,6 × 10 19 cm −3 . Deux autres échantillons avec un profil de « Si/Si dopé P0,72 Ge0.28 /Si dopé P' et 'Si/Si dopé P0.72 Ge0.28 /Si' ont été conçus, et le profil P est démontré dans les Fig. 1c, d, respectivement. Sur la figure 1c, un empilement de P est observé aux interfaces de Si/Si dopé P0.72 Ge0.28 multicouches. L'accumulation de P interfacial augmente avec l'augmentation de la concentration de P de bas en haut dans les multicouches, et la concentration la plus élevée est de 1,6 × 10 20 cm −3 , qui est 6 fois plus que la concentration de la Fig. 1b (2,6 × 10 19 cm −3 ). En Si0.72 dopé Ge0.28 couches (Fig. 1d), les concentrations de P sont remarquablement plus élevées et il n'y a pas de pics à l'interface. En raison du dopage, le pourcentage de Ge est légèrement augmenté. Ce comportement est lié à l'adsorption accrue de SiH4 et GeH4 en présence de PH3 . De plus, en raison du dopage, les épaisseurs de couche sont différentes entre les Fig. 1c, d, qui ont le même temps de croissance. Cela signifie que le dopage P améliore le taux de croissance de Si0,72 Ge0.28 couches et l'absorption de GeH4 , tandis que le taux de croissance de Si est retardé en raison de l'adsorption de P. Ces phénomènes sont cohérents avec les résultats rapportés dans les réfs. [36,37,38]. D'après ce qui précède, la ségrégation P et le phénomène d'autodopage sont sérieux à l'interface Si/SiGe. Le pic de dopage P à l'interface Si/SiGe provoque un dopage involontaire dans la couche SiGe. Étant donné que SiGe est conçu comme la couche de canal dans les transistors, le profil de dopage non homogène ou les niveaux de dopage de fond élevés limiteraient les applications des dispositifs [39]. Plusieurs méthodes pour éliminer le pic P seront discutées ci-dessous. Pour une meilleure comparaison, toutes les couches de SiGe sont tendues et le rapport d'écoulement de SiH4 (SiH2 Cl2 ) et GeH4 pour la couche SiGe n'a pas été modifiée dans toutes les expériences.
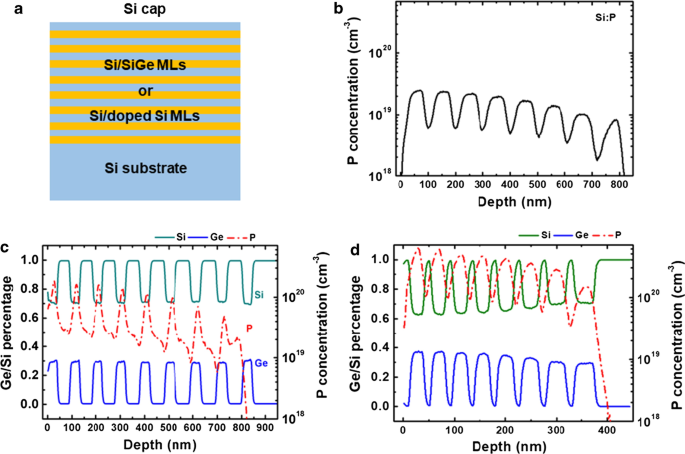
un Schéma de principe des ML Si/SiGe/Si dopés P. b Concentration de dopage P des ML Si non dopés/Si dopés P. Pourcentage Ge/Si et concentration en P de c Si non dopé0.72 Ge0.28 /Si dopé P, d Si non dopé/Si dopé P0.72 Ge0.28 ML. Aucune purge et couche d'espacement non dopée n'ont été prises en compte
Impact des couches d'espacement
Des couches d'espacement de Si non dopé ont été insérées entre la couche de Si dopé inférieur et la couche de SiGe non dopé pour absorber l'excès d'atomes de P. La figure 2a montre le diagramme schématique de la structure conçue, et la figure 2b–d montre les résultats de profil des entretoises Si intégrées avec une épaisseur de (b) 3 nm, (c) 5 nm et (d) 10 nm. Les pics d'accumulation de P sont réduits, tandis que le pourcentage de Si/Ge et la concentration de P dans les couches de Si sont maintenus constants comme sur la figure 2b–d. Le niveau d'accumulation P est réduit de 82%, passant de 4 × 10 19 cm −3 dans la Fig. 2b à 7 × 10 18 cm −3 dans la Fig. 2d, lorsque l'épaisseur de l'entretoise X b augmenté de 3 à 10 nm. L'augmentation de l'épaisseur des couches d'espacement de Si non dopé augmente l'absorption d'atomes de P en excès. Sur la figure 2d, la pente du profil P à Si0,86 Ge0.14 La surface /Si est de 15,9 nm/déc, tandis qu'à Si/Si0,86 Ge0.14 interface, la pente est de 31,3 nm/déc. Pendant ce temps, une couche d'espacement en Si trop épaisse n'est pas une solution appropriée car la résistance de la feuille augmente. Par conséquent, un compromis entre la résistance de couche et le profil P non contrôlé doit être fait pour les transistors. La figure 2 révèle également l'impact de la couche d'espacement entre le Si/Si0,86 Ge0.14 calques (X b ) était différent de la couche entre le Si0.86 Ge0.14 /Si (X t ). Dans la Fig. 2b, c, les épaisseurs d'espacement entre le Si0,86 Ge0.14 /Si étaient de 3 nm et 5 nm, tandis que sur la figure 2d, aucune couche d'espacement n'a été insérée. Cependant, la pente du profil P au Si0,86 Ge0.14 /Si est le même (environ 15,9 nm/déc), bien que sur la figure 2d, la couche d'espacement supérieure ait été supprimée, mais aucune influence sur le profil de dopage n'a été observée. D'après les résultats ci-dessus, le pic P n'était qu'au niveau Si/Si0,86 Ge0.14 l'interface, ce qui était peut-être dû à la limite de solubilité ; l'excès d'atomes de P peut former des dimères P-P à la surface et être incorporé dans la couche de couverture de SiGe. De plus, il y a un autodopage de P lors de la croissance du SiGe après Si dopé au P. Par conséquent, les méthodes pour éliminer l'excès d'atomes de P ou améliorer la solubilité du Si ont été recherchées.
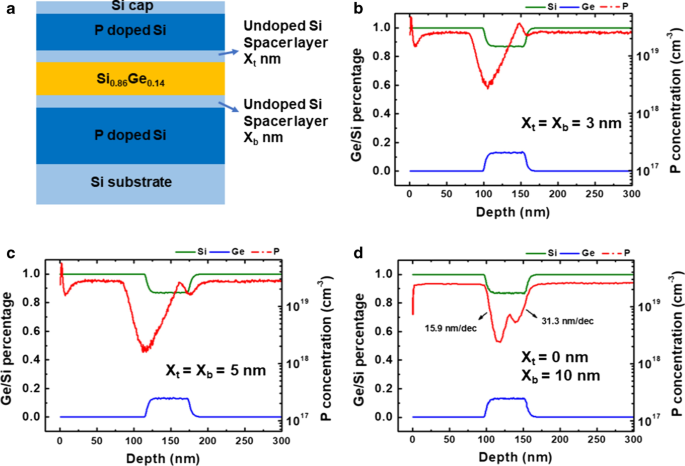
un Le schéma d'échantillons expérimentaux avec différentes couches d'espacement non dopées. Et profils Ge, Si et P de Si/Si dopé P0,86 Ge0.14 /ML Si dopé P avec des couches d'espacement de Si non dopé de b 3 nm, dans les deux interfaces, c 5 nm, dans les deux interfaces, d 10 nm, uniquement à une interface avec Si0.86 Ge0.14
Impact de la purge d'hydrogène à l'interface des ML Si/SiGe/Si
Dans cette section, la couche d'espacement de Si a été fixée à 5 nm et une purge d'hydrogène a été introduite pour éliminer l'excès d'atomes de P après la croissance de Si dopé au P. On peut voir sur la Fig. 3c, d que l'augmentation du débit d'hydrogène de 20 à 60 sccm et le temps de purge de 2 à 10 min n'a pas d'effet évident sur le pic P. La concentration de dopage en Si est de 3 × 10 19 cm −3 , qui est le même que celui décrit dans la section « Impact des couches d'espacement ». La concentration maximale de P à l'interface est la même que la concentration en Si de la figure 3d. Les épaisseurs de couche sont les mêmes dans des conditions de purge différentes. Les atomes P ne peuvent pas être nettoyés par l'hydrogène; ceci peut s'expliquer par la formation de complexes P stables en surface. En modifiant des paramètres tels que la température, la pression, le temps de purge serait utile [24, 40], mais un temps de purge trop long ne convient pas en raison du coût du temps, et une température élevée (> 950 °C) provoque une interdiffusion Si-Ge [41] .
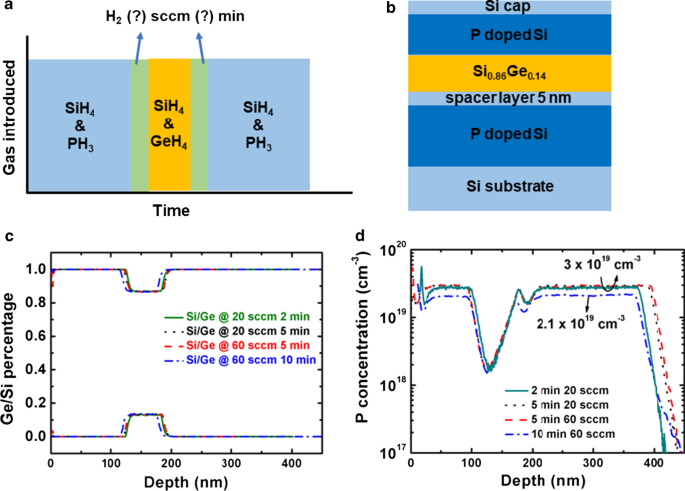
Diagrammes schématiques de a stratégie de dopage de H2 conditions de purge, et b structure expérimentale des ML Si/SiGe/Si. c Profil Ge/Si et d Concentration en P de Si/Si dopé P0,86 Ge0.14 /ML Si dopé P
Impact de la chimie de croissance sur l'incorporation de P
Dans ces expériences, le précurseur Si, SiH4 , a été remplacé par SiH2 Cl2 (DCS). Dans ces échantillons, les paramètres de croissance étaient les mêmes qu'auparavant, et les structures contiennent une couche d'espacement de Si de 5 nm et le temps de purge est de 5 min avec un débit de 60 sccm. L'idée derrière est d'étudier si la chimie à base de Cl pourrait éliminer les atomes de P en excès par la surface de Si et des réactions de P-Cl, Si-Cl ou Ge-Cl pourraient se produire [42]. D'après la figure 4, la concentration maximale de P est réduite d'un facteur 2 (de 2,6 × 10 19 cm −3 à 1,3 × 10 19 cm −3 ), et les concentrations de P dans les couches de Si sont de 2,6 × 10 19 cm −3 . La teneur estimée en Ge est de 30%, ce qui est supérieur à SiGe avec SiH4 . La teneur plus élevée en Ge démontre que Cl a éliminé de préférence les atomes de Si lors des réactions de surface. Ce résultat peut également être expliqué par la relation différente du rapport de débit de gaz et de la concentration de Ge avec SiH4 et SiH2 Cl2 précurseurs gazeux [32, 43]. Une autre explication était que les atomes de Ge augmentaient la désorption d'hydrogène, puis augmentaient les sites de nucléation libres [44]. La pente de concentration en P du Si0.7 Ge0.3 L'interface /Si était de 13,2 nm/déc, ce qui était un peu plus net que Si0,86 Ge0.14 Interface /Si (15,9 nm/déc). La pente du profil P au Si/Si0.7 Ge0.3 l'interface était de 20 nm/déc. Par conséquent, en introduisant plus de HCl ou en augmentant le rapport gazeux de SiH2 Cl2 et GeH4 , les atomes P séparés à la surface de Si dopé peuvent être gravés par HCl pour former des dimères P-Cl et la concentration maximale de P à Si/SiGe pourrait être plus faible [38, 45].
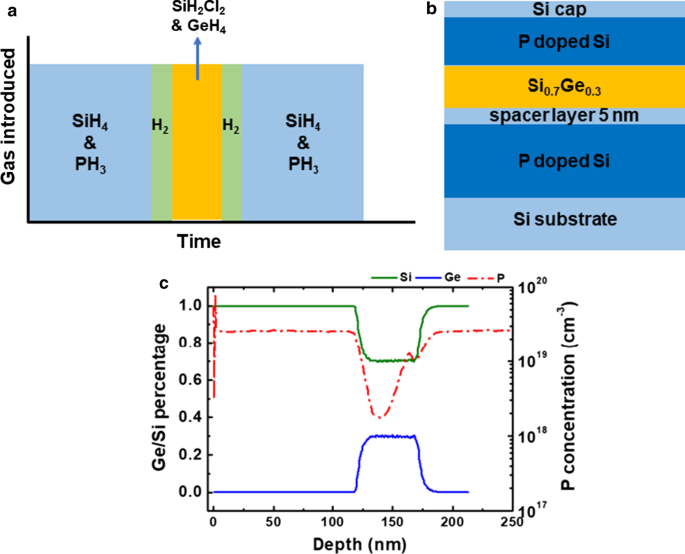
Diagrammes schématiques de a stratégie de dopage consistant à modifier la chimie de la croissance, b structure expérimentale des ML Si/SiGe/Si. La couche de SiGe a été développée avec du DCS. Le temps de purge était de 5 min avec un débit de 60 sccm après Si dopé. La couche d'espacement de Si non dopé était de 5 nm entre le Si dopé inférieur et le SiGe non dopé. c Profil Ge/Si et concentration en P de Si/Si dopé P0,7 Ge0.3 /ML Si dopé P
Impact du contenu Ge sur le profil P
Comme nous l'avons vu précédemment, l'incorporation de P dans SiGe était remarquablement plus élevée que dans Si. Par conséquent, cela peut soulever l'idée d'ajouter quelques pourcentages de Ge (7%) dans des espaceurs de Si (5 nm) pourrait améliorer l'incorporation de P dans Si. Il convient de mentionner ici que notre objectif n'est pas de modifier de manière significative le caractère du Si dopé au P mais d'empêcher la ségrégation du P dans le Si. Dans ces échantillons, la pression de la chambre a été réduite à 10 Torr pendant la croissance des couches d'espacement. Le taux de croissance dépendant du dopage et le pourcentage de Ge seraient importants à cette condition. D'après la figure 5b, les couches supérieure et inférieure étaient à 110 nm de Si0,93 Ge0,07 avec une concentration en P de 1 × 10 20 cm −3 , la couche intermédiaire était à 40 nm de Si0,78 Ge0.22 avec une concentration en P de 3,5 × 10 19 cm −3 . La pente de concentration en P du Si dopé au P0,93 Ge0,07 /Si0.78 Ge0.22 était d'environ 33 nm/déc. La pente n'était pas forte car la différence de pourcentage de Ge entre les deux couches n'était pas assez grande. Sur la figure 5d, trois couches de Si0,93 dopé P Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 Les ML ont été cultivés pour vérifier l'uniformité du dopage, et son diagramme de structure a été présenté sur la figure 5c. On peut voir, des couches inférieures aux couches supérieures, la concentration de P diminuant, ce qui peut s'expliquer par l'effet mémoire de P. Les atomes de P résiduels dans la chambre ou les atomes de P diffusés s'accumulent à la surface du film et bloquent les sites actifs libres sur la surface [38, 39]. Bien que le pic P ait été éliminé, la ségrégation entre Si0.78 Ge0.22 et Si0.93 Ge0,07 était toujours sérieux.
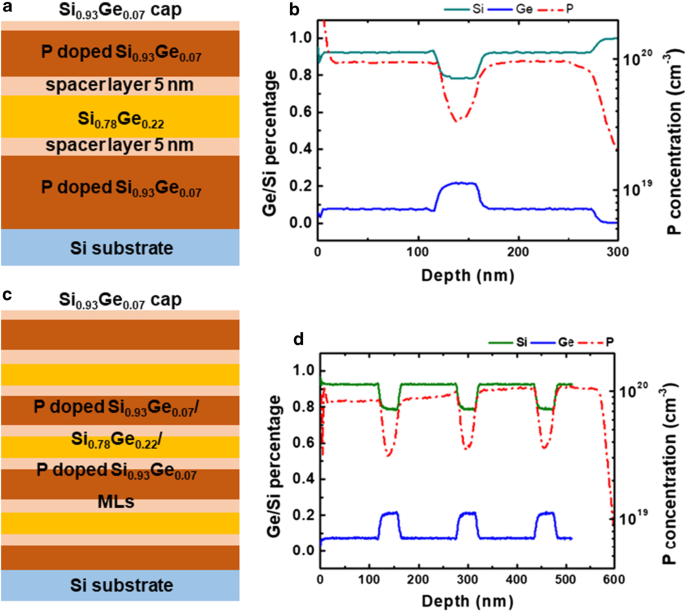
un Schéma de principe, b Profil Ge/Si et P dans une couche de Si dopé P0.93 Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 ML. c Schéma de principe, d Profil Ge/Si et P dans trois couches de Si dopé P0.93 Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 ML
Caractéristiques de gravure sélective des ML Si/SiGe/Si
Lorsque la structure ML est développée avec succès (en utilisant les stratégies de croissance ci-dessus), les NW se sont formés par gravure verticale à l'aide de SiO2 /SiN comme masque dur. Ensuite, la couche de SiGe doit être gravée sélectivement en Si dans la direction latérale pour former la couche de canal avec une largeur conçue. Dans ces expériences, deux types de structures ML ont été choisis :Si/SiGe/Si dopé P (échantillon-1, sur la Fig. 2c) et Si dopé P0.93 Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 (échantillon-2, dans la Fig. 5b). Ces choix sont effectués conformément aux discussions ci-dessus où la diffusion externe de P a été (partiellement) supprimée, ainsi que les perspectives d'application du dispositif sont prises en compte.
La gravure dans le sens vertical a été réalisée par gravure sèche, tandis que pour la gravure latérale une gravure sélective sèche ou humide a été appliquée. Les profils de gravure de l'échantillon-1 sont illustrés à la Fig. 6a, b. Et l'image TEM et la cartographie EDS de la figure 6a ont été montrées sur la figure 7. Dans ces expériences, le masque dur est un oxyde/nitrure. La figure 6a montre après 11,5 s la gravure à sec de CF4 /O2 /Il. La sélectivité de gravure de Si0.86 Ge0.14 et Si dopé P est de 5,8. La figure 6b montre qu'après 20 min de gravure humide de HF (6 %)/H2 O2 (30%)/CH3 COOH (99,8%). La gravure humide a enlevé le masque dur (SiO2 /SiN), et par conséquent, la couche de protection en Si a également été gravée ~ 10 nm. Comme discuté dans la section « Impact des couches d'espacement », il y a un empilement de P au niveau du Si/Si dopé P0,86 Ge0.14 interface. La gravure humide est sensible au niveau de dopage; par conséquent, la première interface a été gravée plus rapidement. En conséquence, l'interface de gravure avant n'est pas verticale et elle est facettée ou inclinée. La sélectivité moyenne était inférieure à 4,2. En comparant les deux méthodes de gravure, la gravure sèche est sensible au pourcentage de Ge avec une meilleure sélectivité de SiGe, tandis que la gravure humide est sensible à la concentration de dopant. Les gravures de l'échantillon-2 sont également étudiées dans la Fig. 6c, d. Des phénomènes similaires ont été observés dans cet échantillon, tandis que les profondeurs de gravure sélective de SiGe étaient plus profondes (Fig. 6a, c) en raison d'un pourcentage de Ge plus élevé. En gravure sèche, la sélectivité de Si0.78 Ge0.22 et Si0.93 dopé P Ge0,07 était de 6,3, tandis qu'en gravure humide, la sélectivité moyenne était inférieure à 2,5. Par conséquent, la gravure à sec était un meilleur choix en tenant compte de l'uniformité et de la sélectivité de la gravure.
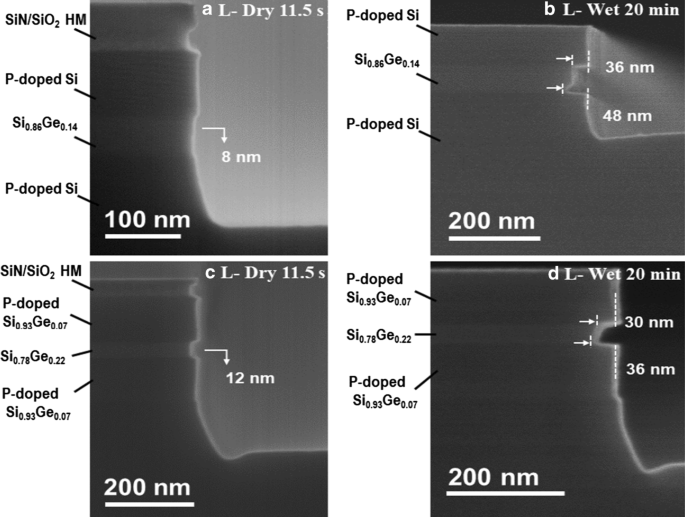
Images SEM de Si/Si dopé P0,86 Ge0.14 /Si dopé P sur la figure 2c avec a Gravure sèche de 11,5 s, b 20 min de gravure humide et Si0,93 dopé P Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 ML avec c Gravure sèche de 11,5 s, d Gravure humide de 20 min. La gravure à sec était CF4 :O2 :He = 4:1:5, et la gravure humide était HF (6%):H2 O2 (30%):CH3 COOH (99,8%) = 1:2:4
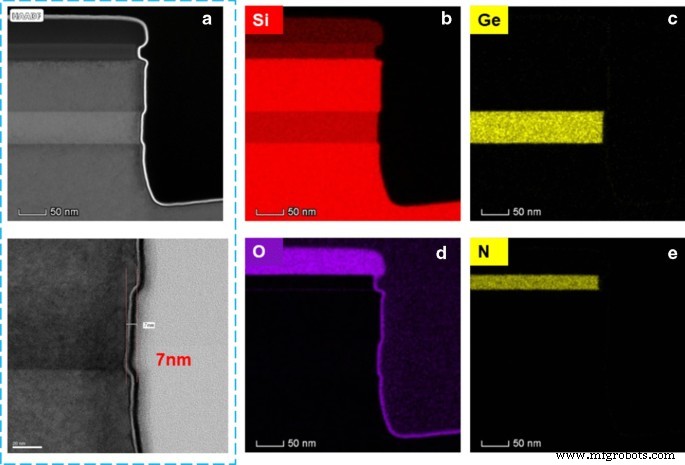
un images TEM, b –e Cartographie EDS de Si/Si dopé P0.86 Ge0.14 /Si dopé P sur la figure 6a avec une gravure sèche de 11,5 s. Les éléments dans b est Si, dans c est Ge, en d est O, et dans e est N
D'autres analyses ont été effectuées pour étudier la souche après les étapes de gravure dans l'échantillon-1 et l'échantillon-2. La figure 8a–h montre (004) les courbes d'oscillation (RC) de ces échantillons comme suit :tel que cultivé, après gravure verticale et gravure latérale de SiGe à l'aide d'une gravure humide et sèche. Dans l'analyse RC, l'élargissement (pleine largeur-demi-maximum ou FWHM) est un indicateur de la densité de défauts, et la position du pic SiGe par rapport à Si détermine la quantité de contrainte dans la couche. Nous soulignons ici que l'élargissement du pic peut également être dû à la faible épaisseur de la couche. Par conséquent, il sera difficile de distinguer de l'analyse RC la contribution de la densité de défauts, mais nous ne pouvons comparer FWHM que dans certaines extensions dans ces analyses. Dans ces RC, l'échantillon 1 (Fig. 8a–d) a une seule couche de SiGe ; pendant ce temps, l'échantillon 2 (Fig. 8e–h) montre deux pics représentant 7 % et 22 % Ge. Pour les échantillons d'As cultivé, une interférence du faisceau de rayons X est observée, ce qui provoque des franges de couche d'épaisseur. L'émergence de ces franges montre une interface SiGe/Si de haute qualité. Dans les RC, de l'échantillon-1 et de l'échantillon-2, le pic Ge s'est déplacé vers le pic du substrat Si indiquant une relaxation de contrainte. Aucun autre décalage du pic de Ge n'a été détecté après une gravure sèche latérale de SiGe. Il s'agit d'un résultat prometteur pour les performances du transistor puisque la mobilité des porteurs dans la région du canal dépend de la contrainte. Pendant ce temps, la déformation a été plus relâchée pour le SiGe gravé par voie humide, et plus de décalage vers le pic du substrat a été observé. Cela montre que la gravure humide n'est pas adaptée à la gravure latérale SiGe, formant la couche de canal.
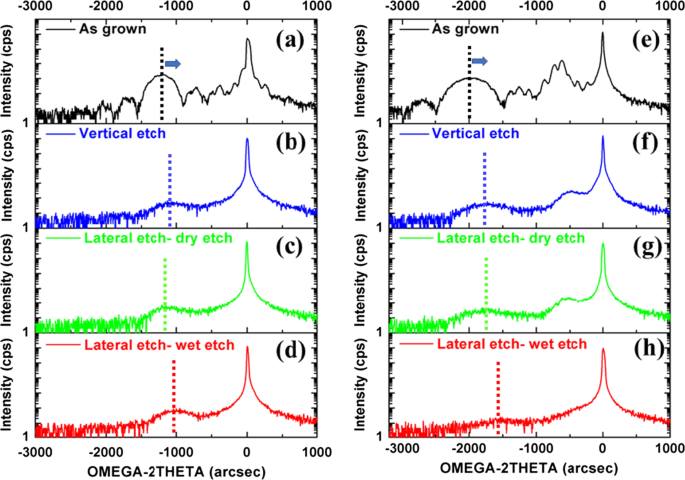
Courbe oscillante HRXRD autour de (004) réflexion de l'échantillon-1, Si/Si dopé P0.86 Ge0.14 /Si ML dopé P avec couche d'espacement de 5 nm dans a –d , et échantillon-2, Si0,93 dopé P Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 ML en e –h . Les deux échantillons ont quatre panneaux :tels que développés, après gravure verticale, gravure humide latérale SiGe de HF (6 %)/H2 O2 (30%)/CH3 COOH (99,8 %) 20 min et gravure à sec latérale de CF4 /O2 /He 11,5 s
D'autres analyses aux rayons X ont été effectuées pour obtenir plus d'informations sur la densité de défauts dans les échantillons de la figure 9a–h. Les HRRLM, qui sont basés sur des mesures bidimensionnelles, ont été effectués ici, comme le montre la figure 9a–h. L'indicateur de la densité de défauts dans les HRRLM est l'élargissement de la couche de SiGe le long de la direction ω (ω est l'angle du faisceau incident). La position des pics Si et SiGe fournit les composantes de la déformation parallèles et perpendiculaires à la direction de croissance. Dans les échantillons 1 et 2, les couches de SiGe telles que développées présentent un élargissement ω mineur et la couche est alignée sur le Si présentant des couches de SiGe entièrement contraintes (voir Fig. 9a, e). La figure 9b montre l'échantillon après la gravure verticale, le pic de SiGe s'est déplacé vers le substrat de Si d'une manière similaire dans les résultats RC de la figure 8b indiquant la relaxation de contrainte. Mais étonnamment, l'échantillon latéral gravé à sec (Fig. 9c) montre un élargissement clair du pic SiGe ainsi qu'un décalage dans l'espace réciproque, qui est dans la direction hors de l'alignement avec le pic Si. Cependant, l'échantillon gravé à l'état humide (sur la figure 9d) est entièrement aligné par déformation et a une intensité de couche inférieure à celle de l'échantillon gravé à sec (sur la figure 9c). Dans ce cas, on s'attend à ce que les défauts générés aient des origines différentes dans ces échantillons puisque la nature du processus de gravure est différente. L'échantillon-2 contient deux couches de SiGe ; le Si0.93 Ge0,07 le pic survit après la gravure dans les directions verticale et latérale, tandis que Si0,78 Ge0.22 est disparu après gravure verticale montrant une relaxation complète de la déformation (Fig. 8f–h). La mauvaise stabilité du processus de l'échantillon-2 pourrait provenir du dopage P, qui favorise la formation de dislocations inadaptées.

HRRLM de Si/Si dopé P0,86 Ge0.14 /Si ML dopé P avec couche d'espacement de 5 nm (échantillon-1) dans a –d , et Si0.93 dopé P Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 ML (échantillon-2) en e –h . Les deux cartographies ont toutes deux quatre panneaux :tel que développé, après gravure verticale, gravure humide latérale de HF (6%)/H2 O2 (30%)/CH3 COOH (99,8 %) 20 min et gravure à sec latérale de CF4 /O2 /He 11,5 s
Conclusions
Dans ce travail, l'épitaxie de Si/SiGe/Si dopé P MLs ainsi que la gravure de ces MLs en tant que structures initiales pour vGAAFET a été étudiée. Dans un premier temps, l'incorporation de P dans les ML Si/SiGe/Si a été étudiée. Différentes stratégies pour l'épitaxie et la structure ML ont été proposées pour éliminer le pic P-segregated à l'interface de l'hétérostructure Si/SiGe. D'après les expériences, l'insertion d'une couche d'espacement non dopée pourrait diminuer le pic P. La purge à l'hydrogène pour éliminer les atomes de P en excès n'était pas très utile et les dimères P-P stables n'ont pas pu être entièrement éliminés. Substitution de SiH4 avec SiH2 Cl2 en tant que précurseur de Si pour introduire la chimie du Cl pendant la croissance, le pic de P ségrégué a diminué de manière remarquable en raison des réactions de surface active du Cl. L'impact de Si0.93 Ge0,07 des couches d'espacement après Si dopé au P ont également été étudiées. Les résultats ont montré que le pic de P à l'interface SiGe a disparu, tandis que l'incorporation de P dans ces couches s'est améliorée d'un ordre de grandeur. Dans la deuxième partie de cette étude, la gravure verticale de Si/SiGe/Si ML a été réalisée pour former des NW, et plus tard, dans ces NW, le SiGe a été sélectivement gravé humide ou sec. La gravure humide était sensible à la concentration de dopant; pendant ce temps, la gravure sèche était sensible à la teneur en Ge. La gravure sèche était plus appropriée pour les structures de type n avec un profil de gravure uniforme et une sélectivité plus élevée. Pour Si/Si dopé P0.86 Ge0.14 / Si ML dopé P, la sélectivité était de 5,8 pour la gravure sèche et de 4,2 pour la gravure humide. La sélectivité du Si dopé P0.93 Ge0,07 /Si0.78 Ge0.22 /Si dopé P0.93 Ge0,07 Les ML étaient de 6,3 avec une gravure sèche et de 2,5 avec une gravure humide. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Disponibilité des données et des matériaux
The authors declare that the data supporting the findings of this study are available within the article.
Abréviations
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS :
-
Semi-conducteur à oxyde métallique complémentaire
- MBE :
-
Epitaxie par faisceau moléculaire
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S/D:
-
Source/drain
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- HRXRD :
-
Diffraction des rayons X haute résolution
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM :
-
Microscopie électronique à balayage
- SIMS :
-
Secondary ion mass spectroscopy
- RC:
-
Rocking curve
- FWHM :
-
Full-width-half-maximum
- HM:
-
Hardmask
Nanomatériaux
- Améliorer les performances des applications pour les utilisateurs et les clients de CyrusOne
- Espaceurs d'air pour puces 10 nm
- Croissance directe de structures de ZnO ressemblant à des plumes par une technique de solution facile pour une application de détection photo
- Évaluation des structures graphène/WO3 et graphène/CeO x en tant qu'électrodes pour les applications de supercondensateurs
- Choisir un type de procédé et d'équipement de soudage robotisé pour votre application
- Les entreprises se préparent aux grands changements et défis technologiques de 2019
- Tour vertical pour les applications de fonderie, de forgeage et de tournage
- Tour vertical pour les applications de fonderie, de forgeage et de tournage(2)
- VMC Machinery pour la production et l'efficacité



