Mesures locales de COV par microscopie à force de sonde Kelvin appliquées sur des nanofils SI à jonction radiale P-I-N
Résumé
Ce travail porte sur l'extraction de la tension en circuit ouvert (V OC ) sur des nanofils photovoltaïques par photovoltage de surface (SPV) basé sur des mesures de microscopie à force de sonde Kelvin (KPFM). Dans une première approche, des dispositifs à nanofils de silicium (SiNW) à jonction radiale (RJ) P-I-N ont été étudiés sous éclairage par KPFM et analyse courant-tension (I-V). À moins de 5 %, le SPV extrait est bien corrélé avec le V OC . Dans une deuxième approche, des mesures SPV locales ont été appliquées sur des SiNW à jonction radiale isolée, soulignant les effets d'ombrage de la pointe de l'AFM qui peuvent avoir un impact important sur l'évaluation du SPV. Plusieurs stratégies en termes de forme de pointe AFM et d'orientation d'éclairage ont été mises en place pour minimiser cet effet. Les mesures SPV locales sur des SiNW à jonction radiale isolée augmentent de manière logarithmique avec la puissance d'éclairage et démontrent un comportement linéaire avec le V OC . Les résultats montrent notamment que les mesures sans contact du V OC deviennent réalisables à l'échelle de dispositifs photovoltaïques simples SiNW.
Introduction
Les nanostructures semi-conductrices suscitent un grand intérêt pour la recherche en raison de leurs propriétés à l'échelle nanométrique qui offrent un grand potentiel pour améliorer les performances des dispositifs existants. Les réseaux de nanofils basés sur des jonctions radiales (RJ) sont des nanostructures prometteuses pour les applications photovoltaïques (PV) en raison de leurs propriétés de piégeage de la lumière et de collecte de porteurs [1, 2] qui sont délibérément combinées pour améliorer l'efficacité solaire par rapport aux structures planaires conventionnelles. L'efficacité des cellules solaires à nanofils peut être limitée par des jonctions de nanofils endommagées dans le réseau ; néanmoins, des rendements allant jusqu'à 9,6 % ont déjà été démontrés pour les RJ à nanofils de silicium (SiNW) basés sur la technologie des couches minces de Si [3]. La caractérisation de telles structures reste un enjeu critique, et notamment la possibilité de caractériser les performances photoélectriques de nanofils individuels est une valeur ajoutée pour l'amélioration du dispositif final.
Dans la présente étude, nous avons utilisé la microscopie à force de sonde Kelvin (KPFM) pour évaluer la tension locale en circuit ouvert (V OC ) sur les RJ SiNW. L'analyse de V OC a été évalué avec succès par KPFM sur plusieurs types de technologies photovoltaïques, principalement des structures planaires [3, 4]. Cependant, l'analyse KPFM sur les nanodispositifs photovoltaïques n'est pas simple, notamment en raison du fait qu'elle peut nécessiter d'effectuer des mesures dans des conditions d'obscurité et d'éclairage pour extraire la variation de potentiel de surface, appelée photovoltage de surface (SPV).
Notre première approche pour sonder le V local OC des RJ SiNWs était d'analyser les appareils terminés. Le terme achevé fait référence aux cellules solaires RJ SiNW qui sont finalisées avec ITO comme électrode avant. Les dispositifs terminés suivants ont été caractérisés séquentiellement par des mesures courant-tension (I-V) et KPFM. Les deux mesures ont été effectuées dans des conditions d'obscurité et d'éclairage dans le but final d'extraire et de comparer V OC et SPV. Notre deuxième approche consistait à analyser des SiNW RJ isolés uniques qui n'étaient pas recouverts d'ITO. Nous avons particulièrement cherché à optimiser le signal KPFM sous éclairage en évitant de nombreux artefacts pouvant entraîner une sous-estimation de la valeur SPV. Chaque RJ SiNW isolé sera référencé en tant qu'appareil isolé.
Enfin, pour compléter les résultats, la technique de la sonde Kelvin macroscopique a également été appliquée sur un appareil RJ terminé et sur un ensemble d'appareils isolés. Cela a été fait sous éclairage à différentes longueurs d'onde afin d'effectuer une spectroscopie de tension de surface (SPS).
Matériaux et méthodes
Fabrication de dispositifs de croissance SiNW et de jonction radiale P-I-N
Les RJ SiNW ont été préparés sur un substrat de verre Corning (Cg) revêtu de ZnO:Al. La croissance des SiNWs a été réalisée à une température de substrat de 500°C par dépôt chimique en phase vapeur assisté par plasma (PECVD) et a été médiée en utilisant des nanoparticules de Sn comme catalyseurs. Le P-I-N RJ a été obtenu en déposant de fines couches conformes de Si amorphe hydrogéné intrinsèque (80 nm) puis de type n (10 nm) (a-Si:H) également par PECVD à 175°C sur le cœur SiNW de type p. Les dispositifs terminés ont été finalisés par un dépôt conforme d'ITO formant des contacts supérieurs circulaires de diamètre 4 mm définis par un masque lors du dépôt par pulvérisation. Les détails complets de la fabrication sont expliqués ailleurs [1, 5, 6, 7].
Sonde Kelvin et photovoltage de surface
Les mesures KPFM peuvent être effectuées en utilisant deux modes différents, la modulation d'amplitude (AM) et la modulation de fréquence (FM). Les deux modes permettent d'obtenir la même valeur de propriété de différence de potentiel de contact (CPD) existant entre la pointe et la surface de l'échantillon. Le mode AM a été celui choisi dans cette étude, la raison étant sa plus grande stabilité de mesure en présence de variations de hauteur importantes telles que celles observées au bord des nanofils de l'échantillon.
Les mesures KPFM et SPV ont été effectuées à l'aide d'un système de microscopie à sonde à balayage de HORIBA/AIST-NT (plateforme TRIOS) qui offre plusieurs avantages. En effet, pour ce microscope à force atomique (AFM), le système de déviation à faisceau laser (LBBDS) utilise une longueur d'onde laser à 1310 nm qui minimise les interactions photoélectriques possibles avec l'échantillon [8,9,10] . Ceci sera souligné ici en comparant les données acquises à l'aide de cette plate-forme avec celles obtenues à l'aide d'un système AFM qui utilise une longueur d'onde de 690 nm pour le LBBDS.
La plateforme TRIOS est bien adaptée à l'étude des propriétés photoélectriques des matériaux puisqu'elle comprend trois objectifs de microscope permettant l'éclairage de l'échantillon depuis différentes directions (haut, côté et bas). Les mesures SPV à l'échelle micro/nano sont ici obtenues en soustrayant le CPD dans l'obscurité au CPD sous éclairage. Ce type de mesure a déjà été utilisé pour effectuer VOC mesures de dispositifs photovoltaïques [5, 11]. L'éclairage de l'échantillon a été réalisé à l'aide d'une diode laser stabilisée OXXIUS de longueur d'onde 488 nm avec un module de puissance variable.
Deux types de pointes AFM conductrices ont été utilisées pour les mesures de sonde de balayage appliquées, l'ARROW-EFM et l'ATEC-EFM. Les deux ont un cantilever en silicium dopé et un revêtement PtIr. Leur différence réside dans leur forme avec une forme de pointe classique pour l'ARROW et une forme inclinée pour l'ATEC.
Enfin, les mesures SPV à l'échelle nanométrique ont été complétées par des mesures macroscopiques à la sonde Kelvin avec la possibilité de faire varier la longueur d'onde d'éclairage afin d'effectuer des mesures SPS, c'est-à-dire des mesures SPV résolues spectralement. À cette fin, une configuration de sonde Kelvin ASKP200250 de KPTechnology équipée d'une pointe en acier de 2 mm de diamètre a été utilisée. Cette configuration comprend un éclairage latéral couplant une source de lampe halogène à un monochromateur qui couvre la plage de longueurs d'onde de 400 nm à 1 000 nm. A noter que cette configuration ne permet pas d'effectuer des mesures SPV à flux constant et pour cette raison particulière seules des observations qualitatives peuvent être faites.
Mesures macroscopiques I-V combinées à KPFM
Comme indiqué précédemment, notre première approche consistait à effectuer des mesures I-V macroscopiques sur un dispositif SiNW RJ terminé. À cette fin, nous avons utilisé un SourceMeter KEITHLEY 2450 et un micro positionneur avec une aiguille en tungstène qui permet de contacter l'appareil tout en étant sous la configuration AFM comme schématisé sur la Fig. 1.
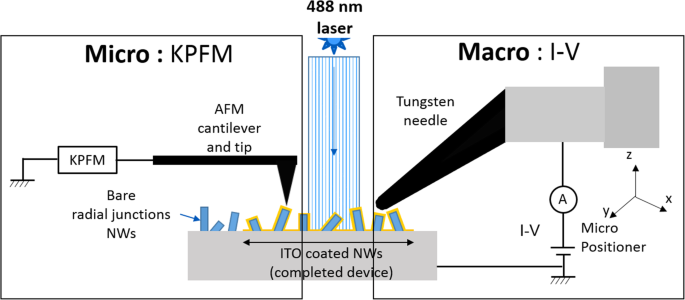
Schémas de la configuration de mesure pour les mesures KPFM et I-V macroscopiques
Les mesures I-V et KPFM ont été effectuées dans des conditions d'obscurité puis en utilisant le même éclairage décrit dans la sous-section précédente, à savoir une source laser à 488 nm avec une puissance réglable. L'éclairage a été réalisé par le dessus à travers un objectif MITUTOYO 10X et la puissance d'éclairage incidente a été calibrée dans la plage 70 -1000 μW.
Des mesures KPFM ont en outre été effectuées sur les dispositifs isolés avec deux types de pointes AFM, ARROW et ATEC. L'éclairage de l'échantillon pendant la mesure a été effectué dans deux directions, supérieure et latérale, et en utilisant la même puissance nominale que celles utilisées précédemment sur l'appareil terminé.
Résultats et discussion
Avant de commencer les mesures I-V et KPFM, l'impact du LBBDS de l'AFM a été étudié. En effet, il a déjà été montré que la longueur d'onde du LBBDS peut avoir une interaction significative avec les échantillons photovoltaïques [8,9,10] et peut ainsi influencer les mesures de propriétés électriques avec l'AFM. La figure 2 illustre les mesures I‑V macroscopiques d'un terminé Dispositif SiNW RJ exécuté dans des conditions sombres (LBBDS éteint) et lorsque le LBBDS est maintenu allumé. Comme mentionné précédemment, les mesures ont également été effectuées dans une configuration AFM différente en utilisant une longueur d'onde de 690 nm au lieu de 1310 nm pour le LBBDS. Les courbes I-V obtenues dans l'obscurité et avec le LBBDS à 1310 nm sont quasiment identiques. Ce n'est qu'en zoomant autour de l'origine que l'on peut observer un très petit décalage pour les mesures effectuées avec le LBBDS maintenu allumé, qui peut être exprimé par de très petites valeurs en termes de VOC (0,5 mV) et courant de court-circuit, ISC, (1 nA). En comparaison, la courbe I-V mesurée avec le système utilisant une longueur d'onde de 690 nm pour le LBBDS présente un effet photovoltaïque important, avec des valeurs de VOC et moiSC de 545 mV et 28 μA, respectivement. Cela met clairement en évidence l'effet perturbateur d'un LBBDS avec une longueur d'onde laser dans le domaine visible. Ces résultats montrent les difficultés à réaliser des mesures KPFM dans des conditions d'obscurité réelles lorsque notamment la longueur d'onde LBBDS peut interagir avec l'échantillon. Les résultats illustrés suivants ont tous été réalisés avec le LBBDS de l'AFM fonctionnant à 1310 nm décrit dans la sous-section Kelvin-Probe.
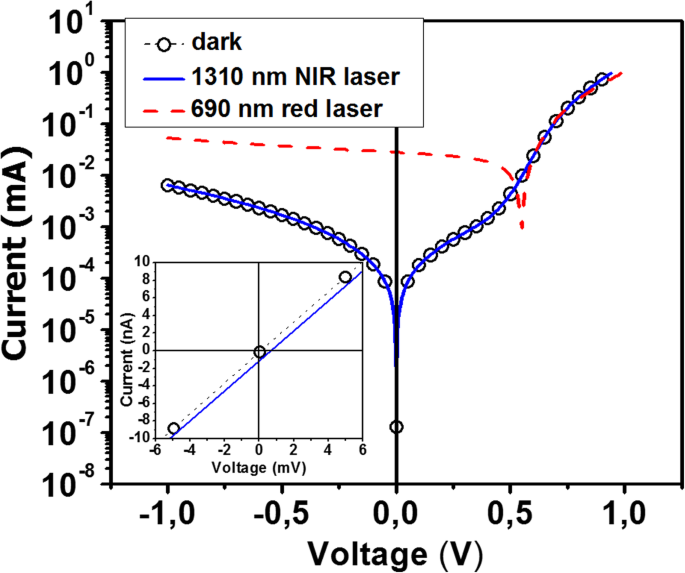
Courbes I-V obtenues sur un appareil SiNW RJ dans des conditions sombres (cercles noirs), avec le faisceau laser de 1310 nm de l'AFM TRIOS (ligne continue bleue) et avec le faisceau laser de 690 nm de l'Enviroscope AFM (ligne pointillée rouge). Le graphique principal illustre les courbes log |I|-V dans la plage − 1 V et + 1 V, et le graphique d'insertion représente un agrandissement des courbes I-V linéaires entre − 5 mV et + 5 mV
Un exemple de mesure photovoltaïque dans un dispositif SiNW RJ terminé est illustré à la Fig. 3. En particulier, les mesures I-V macroscopiques sous différentes puissances d'éclairage (70, 150, 270 et 560 μW) sont présentées à la Fig. 3.a. Les courbes I-V montrent un comportement de fonctionnement typique d'une cellule PV où ISC et VOC augmente avec la puissance lumineuse incidente. La figure 3.b montre un exemple de cartographie KPFM qui représente, de gauche à droite, la topographie, le CPD dans l'obscurité et le CPD sous un éclairage de 488 nm. Le scan topographique révèle des NW avec des hauteurs de plusieurs centaines de nanomètres et montrant une densité par unité de surface d'environ 10 9 cm -2 . Les balayages CPD affichent des variations de potentiel locales d'environ ±10 mV se produisant principalement sur les bords NW. Ces variations peuvent être considérées comme des artefacts dus au changement rapide de topographie que subit la pointe de l'AFM lors du mouvement de balayage et en particulier lorsqu'elle passe entre deux NW. Les endroits qui sont exempts d'un tel artefact sont le sommet des NW où le changement de hauteur de la topographie reste négligeable. Toutes les valeurs de CPD présentées ci-dessous ont été extraites en haut des NW.
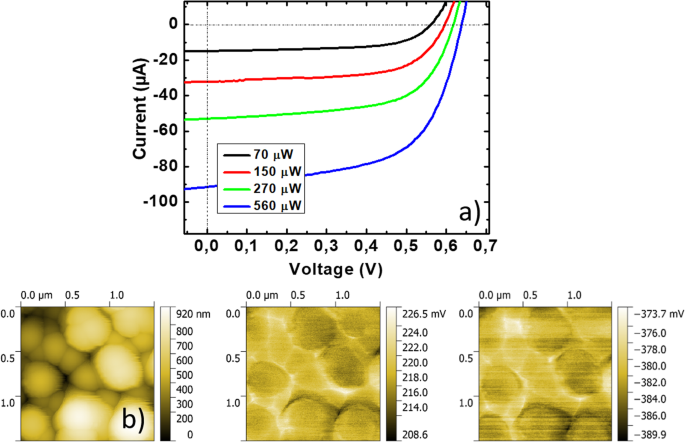
un Courbes I-V macroscopiques mesurées sous différents éclairages de puissance (66, 5, 149, 268 et 555 μW à 488 nm) ; b de gauche à droite :topographie, CPD dans l'obscurité et CPD sous éclairage (270 μW à 488 nm), respectivement
La figure 4 compare le VOC et les valeurs SPV extraites des mesures macroscopiques I-V et KPFM en fonction de la puissance d'éclairage incident. Cette comparaison a été effectuée pour deux appareils terminés différents et illustrée dans une échelle semi-logarithmique. La différence maximale entre les courbes Voc et SPV est inférieure à 5 % pour la puissance d'éclairage la plus faible (~70 μW) et devient inférieure à 2 % pour une puissance d'éclairage plus élevée. Il est important de noter que la barre d'erreur associée à l'évaluation expérimentale de la puissance lumineuse incidente augmente lorsque la puissance d'éclairage diminue ce qui peut expliquer la différence de 5% entre VOC et SPV mentionnés précédemment. Pour les deux graphiques, le SPV et le VOC les valeurs suivent un comportement logarithmique avec des valeurs comprises entre 500 et 600 mV. Les pentes de Voc et SPV donnent un facteur d'idéalité (n) de 1,5 ± 0,1 pour l'appareil 1 et de 1,75 ± 0,25 pour l'appareil 2, respectivement. Ces valeurs sont en bon accord avec les valeurs rapportées dans la littérature pour la jonction a-Si:H P-I-N qui sont comprises entre 1,5 et 2 [12,13,14]. Sur la figure 5, nous illustrons les mesures du SPV en fonction de la puissance lumineuse effectuées sur des dispositifs SINW RJ isolés. Le terme isolé fait ici référence au fait que les nanofils RJ ne sont pas recouverts d'ITO, ils ne sont donc pas connectés électriquement à travers la couche conductrice supérieure. À titre de référence, la courbe SPV obtenue précédemment pour le dispositif RJ terminé sur la figure 4.a a également été présentée sur la figure 5. Les valeurs SPV rapportées correspondent à une valeur moyenne résultant de plusieurs NW pour des tailles de balayage de 3x3 m². Les mesures SPV sur des appareils isolés ont d'abord été effectuées avec une pointe AFM en forme de flèche (ARROW-EFM) et un éclairage venant du haut tout comme la mesure SPV effectuée sur l'appareil terminé. Les valeurs très faibles du SPV pour cette courbe (Fig. 5.a, carrés) ainsi que sa pente inférieure à 1 (~0,4) suggèrent un effet d'ombrage dû à la pointe de l'AFM. En effet garder le même éclairage supérieur et changer la pointe de l'AFM par une sonde inclinée (ATEC-EFM) nous a permis d'observer une augmentation de 40 % des valeurs SPV pour la même plage de puissance d'éclairage (Figure 5.b, triangle). Des résultats similaires ont été obtenus en changeant l'éclairage du haut vers le côté et en remplaçant la pointe AFM ATEC par la pointe AFM initiale ARROW (Fig. 5.c, points bleus). Bien que les valeurs SPV aient considérablement augmenté par rapport aux mesures avec éclairage supérieur et pointe ARROW-EFM, elles restent inférieures à la référence tout en conservant des pentes similaires (~ 1,3-1,4). A noter que cet effet d'ombrage n'était pas observable dans le cas d'appareils terminés car pour cette configuration, le SPV image la phototension de l'ensemble de l'appareil :des milliers de nanofils reliés entre eux par le contact frontal ITO.
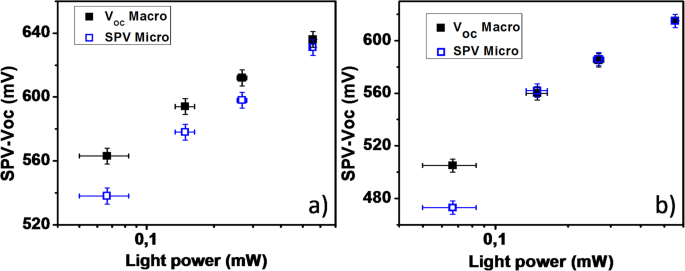
V OC et SPV par rapport à la puissance lumineuse pour deux appareils différents :dev 1 (a ) et dev 2 (b )

SPV en fonction de la puissance lumineuse obtenue sur des RJ NW isolés. Les mesures ont été effectuées avec différentes formes de pointes AFM (ARROW-EFM et ATEC-EFM) et différentes directions d'éclairage (haut et côté). Le dispositif RJ de référence désigne le dispositif 1 illustré sur la figure 4a. L'image AFM en bas à droite montre un exemple de la topographie mesurée sur des NW isolés
Pour compléter ces résultats, une analyse SPS qualitative a été effectuée au-dessus d'un groupe d'appareils isolés, puis au-dessus d'un appareil terminé. La figure 6.a affiche les spectres SPV obtenus avec des différences nettes sur l'ensemble du spectre. Il est intéressant de souligner que le dispositif terminé montre un SPV négligeable (~10 mV) dans le proche infrarouge (NIR) avec un seuil de SPV se situant autour de 800 nm et en dessous duquel le SPV augmente rapidement pour atteindre un maximum de 560 mV à 630 nm. A l'inverse, le faisceau d'appareils isolés révèle un SPV important de 80-260 mV dans le NIR (800-1000 nm) qui augmente progressivement avec la longueur d'onde décroissante, jusqu'à 435 mV pour 665 nm. En dessous de 665 nm et 630 nm, les deux courbes SPV diminuent avec la diminution de la longueur d'onde, ce qui peut être lié à la diminution attendue de l'éclairement énergétique de la lampe halogène utilisée dans cette configuration (comme mentionné ci-dessus, l'approche SPS ici est basée sur des mesures qualitatives puisque le flux ne peut pas être maintenu constant). Dans une deuxième approche, les mesures SPS ont été effectuées sur un appareil terminé et après avoir retiré localement le contact supérieur de l'ITO avec une solution de HF à 1 % appliquée sous forme de goutte sur l'appareil. La figure 6.b illustre ces mesures, et les spectres SPV ont été spécifiquement collectés juste après le retrait de l'ITO et 72 heures plus tard. La suppression de la couche ITO a un effet majeur sur le spectre SPV par rapport à l'appareil terminé. Une forte diminution du signal SPV est observée dans la gamme 400-750 nm juste après le retrait de l'ITO. Après 72 heures le signal SPV se stabilise à un niveau supérieur qui peut différer, selon la longueur d'onde, de plus d'un facteur 2. Il s'avère également que le signal SPV augmente légèrement aux longueurs d'onde plus longues (>750 nm). En comparant les spectres SPV de la figure 6, il apparaît qu'après le retrait de l'ITO illustré sur la figure 6.b et surtout après une stabilisation de 72 h, les dispositifs NW présentent un état similaire à ceux désignés comme groupe de NW isolés sur la figure 6.a, ce dernier n'ayant jamais eu de revêtement ITO. Une autre observation importante concerne le signal SPV mesuré à 488 nm dont la valeur est un facteur ~1,7 inférieur pour un groupe de NW isolés que pour un appareil terminé. Cette observation corrobore les résultats SPV de la figure 5 effectués par KPFM sur des RJ isolées NW avec un éclairage à 488 nm. En effet, malgré l'optimisation de la forme de la pointe de l'AFM et des conditions d'éclairage, les valeurs SPV mesurées étaient également inférieures à celle de l'appareil terminé d'un facteur variant entre 1,5 et 2, selon la puissance d'éclairage.
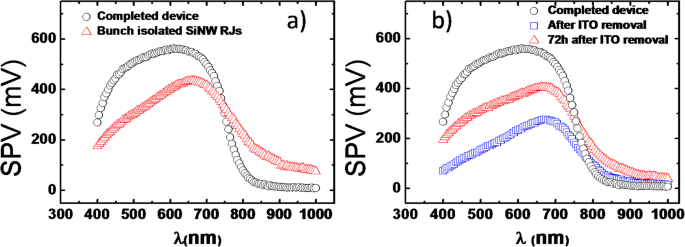
Mesures SPS effectuées sur a un appareil terminé et un tas de SiNW isolés ; b un appareil terminé, juste après avoir retiré ITO, et 72 h plus tard
Les résultats de la figure 6 montrent clairement que le contact supérieur ITO est nécessaire pour développer des valeurs plus élevées de SPV (c'est-à-dire VOC ) et plus précisément le point clé reste l'interface (n) a-Si:H/ITO. Cette interface est caractérisée par une couche de a-Si:H de type n très fine (~ 10 nm) afin de favoriser la transmission optique. Le niveau de dopage de cette couche et le travail de sortie d'ITO peuvent notamment provoquer l'épuisement complet de la couche a-Si:H. Ainsi, une chute soudaine de potentiel peut avoir lieu à travers l'interface avant d'atteindre un potentiel de bande plate dans l'ITO. Une telle chute de potentiel à l'interface avec le contact supérieur de l'ITO a déjà été illustrée dans les structures P‑I‑N a-Si:H qui ont été analysées par profilage SPV [12, 15]. Les mêmes interfaces avec des couches ultrafines de a-Si:H ont également été étudiées dans la technologie des cellules solaires de l'hétérojonction a-Si:H/Si cristallin en soulignant à nouveau l'impact du niveau de dopage et de l'épaisseur de la couche a-Si:H sur le V OC avec et sans ITO [16, 17].
Les considérations précédentes indiquent que l'analyse SPV locale par KPFM sur des RJ NW isolés ne peut pas refléter quantitativement la valeur optimale de VOC en raison de l'absence d'ITO. Le VOC local extrait est ici limitée par la courbure de la bande de surface en raison de l'épuisement complet de la couche de a-Si:H de type n et de son état de surface d'oxydation. Le SPV mesuré n'inclut pas seulement le VOC mais aussi le changement de flexion de bande photo-induit près de la surface de la couche a-Si:H de type n [18].
Conclusion
Les dispositifs terminés basés sur des RJ SiNW ont été analysés conjointement sous éclairage par des mesures I-V et KPFM. Cette première comparaison réalisée pour différentes puissances d'éclairage montre que les valeurs SPV locales extraites de KPFM sont très proches des VOC valeurs obtenues à partir de l'analyse I-V. Les mesures SPV locales sur des RJ SiNW isolés montrent au contraire une différence significative par rapport au précédent VOC valeurs. Un effet d'ombrage de la pointe de l'AFM a été mis en évidence et minimisé en modifiant la forme de la pointe et/ou l'orientation de l'éclairage. Les valeurs SPV optimisées recueillies à partir de RJ SiNW isolés montrent un comportement logarithmique avec la puissance d'éclairage mais restent bien en deçà du VOC valeurs de référence. L'analyse SPS réalisée sur des paquets de dispositifs SiNW isolés met en évidence l'absence de l'interface (n) a-Si:H /ITO comme cause de la perte de potentiel, et notamment parce que les dispositifs SiNW isolés étudiés n'ont pas d'ITO comme contact haut. Malgré cela, le SPV local extrait sur des dispositifs SiNW isolés dans différentes conditions d'éclairage montre une correspondance linéaire avec le VOC mesuré sur les appareils terminés, confirmant notamment que le SPV local peut refléter le VOC .
Disponibilité des données et des matériaux
Les ensembles de données utilisés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- AFM :
-
Microscopie à force atomique
- AM :
-
Modulation d'amplitude
- a-Si:H :
-
Silicium amorphe hydrogéné
- Cg :
-
Verre Corning
- DPC :
-
Différence de potentiel de contact
- FM :
-
Modulation de fréquence
- ITO :
-
Indium-étain-oxyde
- I-V :
-
Courant-tension
- KPFM :
-
Microscopie à force de sonde Kelvin
- LBBDS :
-
Système de déviation par faisceau laser
- n :
-
Facteur d'idéalité
- NW :
-
Nanofil
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- PV :
-
Photovoltaïque
- RJ :
-
Jonction radiale
- SiNW :
-
Nanofil de silicium
- SPS :
-
Spectroscopie photovoltaïque de surface
- SPV :
-
Photovoltage de surface
- V OC :
-
Tension en circuit ouvert
Nanomatériaux
- Imagerie d'atomes sur des cristaux atomiques 2D dans des liquides
- Les scientifiques des matériaux enseignent aux nanofils comment « danser »
- Absorption de la lumière améliorée par le plasmon dans les cellules solaires à nanofils GaAs à jonction (p-i-n) :étude d'une méthode de simulation FDTD
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Étude théorique de nanofils de germanium soumis à une traction biaxiale
- Étude de la force d'adhérence et de la transition vitreuse de films minces de polystyrène par microscopie à force atomique
- Capteur de gaz hydrogène à nanofils d'oxyde de cuivre assisté par lumière ultraviolette
- Réduction à basse température de l'oxyde de graphène :conductance électrique et microscopie à force de sonde Kelvin à balayage
- Qu'est-ce que la force radiale ?



