Caractéristique de commutation résistive de faible puissance dans la mémoire à accès aléatoire résistive bicouche HfO2/TiOx
Résumé
Dispositifs de mémoire vive résistive avec dépôt de couche atomique HfO2 et pulvérisation radiofréquence TiOx car les couches de commutation résistives ont été fabriquées avec succès. Une caractéristique de faible puissance avec une puissance réglée de 1,52 μW (1 μA@1,52 V) et une puissance de réinitialisation de 1,12 μW (1 μA@1,12 V) a été obtenue dans le HfO2 /TiOx dispositifs de mémoire résistive à accès aléatoire (RRAM) en contrôlant la teneur en oxygène du TiOx couche. De plus, l'influence de la teneur en oxygène pendant le TiOx processus de pulvérisation cathodique sur les propriétés de commutation résistive serait discuté en détail. Les enquêtes ont indiqué qu'une « claquage en douceur » s'est produite facilement pendant le processus de formage/de prise électrique dans le HfO2 /TiOx Appareils RRAM à haute teneur en oxygène du TiOx couche, résultant en une puissance de commutation résistive élevée. La caractéristique de faible puissance a été obtenue dans HfO2 /TiOx Dispositifs RRAM avec une densité de lacunes d'oxygène suffisamment élevée de TiOx couche, suggérant que la densité de lacunes d'oxygène appropriée dans le TiOx La couche pourrait éviter un « claquage en douceur » à travers l'ensemble des couches diélectriques pendant le processus de formage/fixation, limitant ainsi le courant circulant dans le dispositif RRAM et diminuant la consommation d'énergie de fonctionnement.
Introduction
La mémoire résistive à accès aléatoire (RRAM) offre une solution prometteuse pour passer au-delà de la mémoire traditionnelle basée sur la charge en raison d'une structure cellulaire simple, d'un stockage non volatile, d'un fonctionnement à grande vitesse et d'un rapport marche/arrêt élevé [1,2,3, 4,5,6,7,8,9,10]. Récemment, une résistance à un transistor (1T1R) est une structure largement acceptée pour empêcher les mesures de résistance inexactes causées par un courant de chemin furtif dans le réseau 1R [11, 12]. En outre, la mémoire émergente, en particulier la RRAM à base d'oxyde, a été proposée pour les dispositifs synaptiques en plastique en raison de la modulation progressive de la conductance avec le nombre d'impulsions, qui peut imiter le comportement synaptique biologique pour recevoir des signaux des neurones pré- et postsynaptiques [13,14,15 ,16,17]. Cependant, un courant de commutation résistif élevé est la principale limitation pour les applications à faible puissance et à haute densité [18,19,20]. La baie 1T1R est également confrontée à des défis de mise à l'échelle si le courant de fonctionnement de la RRAM ne peut pas évoluer en conséquence. Par exemple, lorsque la technologie CMOS est réduite à 27 nm, le courant de commande diminue à 40 μA [21]. Par conséquent, la réduction du courant de fonctionnement du dispositif RRAM jusqu'à 10 μA en optimisant la structure et le matériau est nécessaire pour continuer la mise à l'échelle 1T1R [22]. De plus, les synapses biologiques consomment environ 1 ~ 10 fJ par événement dans le cerveau humain complexe, ainsi, réduire la consommation d'énergie des dispositifs synaptiques électriques aussi peu que les synapses biologiques est important pour le développement de réseaux de neurones artificiels neuromorphiques (ANN) [23, 24,25]. Par conséquent, la limitation du courant de l'appareil et la réduction de la consommation d'énergie profiteront au processus pratique de stockage de données et d'application de calcul neuromorphique.
Dans ce travail, Pt/HfO2 /TiOx Appareils /Pt avec une teneur en oxygène différente de TiOx des films ont été fabriqués et une caractéristique de faible puissance à faible teneur en oxygène a été démontrée. Le dispositif de mémoire a atteint une puissance de réglage de 1,52 μW et une puissance de réinitialisation de 1,12 μW en diminuant la teneur en oxygène du TiOx film pendant le processus de pulvérisation. Le mécanisme conducteur de la caractéristique de faible puissance a été analysé plus en détail pour fournir des informations sur la conception de la RRAM à oxyde.
Méthodes
Le Pt/HfO2 /TiOx La structure et le processus de fabrication du dispositif /Pt sont illustrés aux figures 1a et b. Dans un premier temps, sur Si/SiO2 /Ti substrat, une électrode inférieure en Pt (BE) de 100 nm a été préparée par pulvérisation cathodique à courant continu (CC) à température ambiante. Ensuite, 3 nm HfO2 a été déposé par la technique de dépôt par couche atomique (ALD) (Picosun R200) à 300°C en utilisant TEMAH et H2 O comme précurseurs. Par la suite, 30 nm TiOx a été déposé avec différentes teneurs en oxygène par pulvérisation cathodique radiofréquence. Pendant TiOx procédé de pulvérisation cathodique, fixant le débit total de gaz d'argon (Ar) et d'oxygène (O2 ) comme 20 sccm et en changeant la pression partielle d'oxygène avec 9%, 11% et 13%, trois dispositifs d'échantillonnage (S1, S2 et S3) ont été obtenus pour étudier l'influence de la teneur en oxygène de TiOx film sur les performances de commutation résistive. Ensuite, une électrode supérieure en Pt de 70 nm (TE) a été déposée par pulvérisation cathodique CC et modelée par lithographie. Enfin, des dispositifs de forme carrée de 100 μm x 100 μm ont été formés par gravure ionique réactive (RIE). Une tension de polarisation a été appliquée sur le TE et le BE a été connecté à la terre. Les images au microscope électronique à transmission à haute résolution (HRTEM) de la section efficace du Pt/HfO2 /TiOx /Pt sont illustrés à la Fig. 2. Les caractéristiques électriques des dispositifs ont été mesurées avec l'analyseur de paramètres à semi-conducteur Agilent B1500A. Les états chimiques des atomes dans le TiOx les films ont été étudiés par spectroscopie photoélectronique aux rayons X (XPS, Axis Ultra).
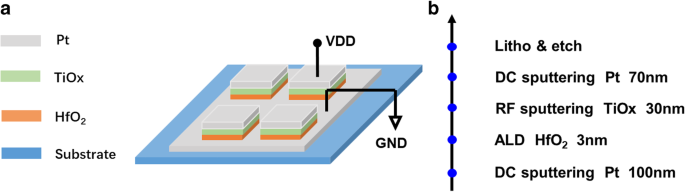
un La structure de Pt/HfO2/TiOx /Pt appareil. b Le flux du processus de fabrication
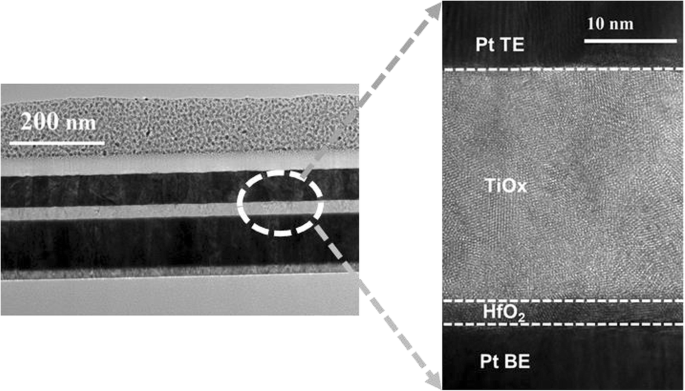
Coupes MET du Pt/HfO2 /TiOx /Pt appareil
Résultats et discussion
Les figures 3a, b et c montrent les spectres au niveau du noyau XPS O 1s de TiOx cinéma. Pour clarifier la liaison chimique de l'oxygène dans les films, les pics asymétriques O 1s sont divisés en deux pics, qui sont généralement attribués à l'O 2− lié par des ions métalliques et O 2− dans la région pauvre en oxygène [26]. Pression partielle d'oxygène pendant TiOx le processus de pulvérisation cathodique du film a été fixé à 9 %, 11 % et 13 %, respectivement, et la teneur en oxygène correspondant dans trois échantillons est d'environ 28,23 %, 24,06 % et 23,63 %, indiquant que la teneur en ions oxygène non réticulaires et les lacunes en oxygène diminuent avec l'augmentation de la pression partielle d'oxygène.

O 1s spectres de balayage XPS de TiOx films en S1, S2 et S3. La pression partielle d'oxygène a été définie sur a 9%, b 11%, et c 13% pendant TiOx procédé de pulvérisation cathodique
Pour les appareils neufs, l'état d'origine est en état de haute résistance (HRS). Comme le montre la figure 4, la formation de courant (CF) est appliquée pour initier la formation du filament conducteur et changer l'état du dispositif en état de faible résistance (LRS) [27]. Lors de l'application de 1 A de conformité de courant, un chemin conducteur est formé dans S1 et le processus stable de réglage/réinitialisation peut être réalisé dans l'opération suivante. Pour S2 et S3, l'opération de réinitialisation n'est pas réussie à partir de l'état intermédiaire de l'appareil pendant le processus CF jusqu'à ce que la conformité actuelle atteigne 20 mA.
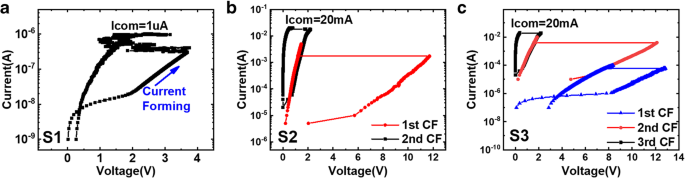
Processus de formage actuel du Pt/HfO2/TiOx /Pt Périphérique RRAM dans a S1, b S2 et c S3
Afin de tester les performances électriques du dispositif RRAM, des mesures en courant continu sous balayage de tension sont effectuées. Une tension de polarisation positive dans le processus de formation et de réglage est appliquée sur TE pour terminer le filament conducteur, et la tension de polarisation négative dans le processus de réinitialisation est de casser le filament. Lorsque la polarisation est balayée d'avant en arrière, 100 cycles de courbes courant-tension (IV) de commutation bipolaire de trois échantillons sont illustrés à la Fig. 5. Les dispositifs S1 atteignent des performances de commutation résistives stables sous une conformité de courant de 10 μA, mais le courant de fonctionnement jusqu'à 10 mA pour les deux autres échantillons. La caractéristique de faible puissance de S1 pourrait être attribuée à une teneur élevée en lacunes d'oxygène préexistant dans TiOx film, qui limite efficacement le courant pendant le processus de formage/fixation.
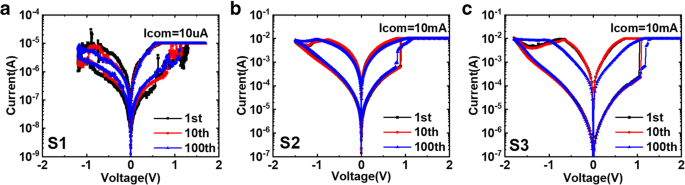
Courbes I-V bidirectionnelles stables à 100 cycles en a S1, b S2 et c S3
Les figures 6 et 7 illustrent la variation d'un cycle à l'autre et d'un appareil à l'autre (écart type relatif, (σ /μ )) de trois échantillons, et les statistiques sont résumées dans les tableaux 1 et 2. Pour S1, un faible courant de saut entraîne une distribution de résistance modeste, et les filaments conducteurs forts formés dans S2 et S3 garantissent une distribution de résistance relativement stable. Bien qu'il y ait une petite dégradation pour S3 après des dizaines de cycles, le rapport marche/arrêt est toujours supérieur à 100.

Variation cycle à cycle de RLRS et RHRS pour 100 cycles en a S1, b S2 et c S3

Variation d'appareil à appareil de RLRS et RHRS pour 20 appareils en a S1, b S2 et c S3
Comme le montre la Fig. 8, la puissance réglée (Pset) 1,52 μW et la puissance de réinitialisation (Preset) 1,12 μW sont atteintes sous un faible courant de conformité de 1 μA. La consommation électrique des deux autres échantillons est de plusieurs dizaines de milliwatts en raison de 10 mA de courant de fonctionnement. En outre, les états de résistance de S1 peuvent conserver des caractéristiques de rétention supérieures à 10 4 s sous 85 °C avec un rapport marche/arrêt d'environ 100, ce qui est stable pour les applications de stockage de données.
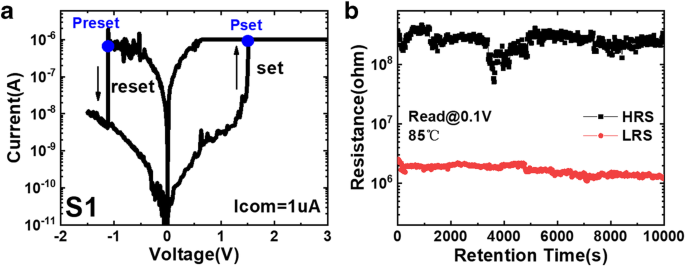
un Performances de commutation résistive sous une limitation de courant de 1 A. b La caractéristique de rétention dans S1 est supérieure à 10 4 s sous 85 °C
Pour élucider le mécanisme conducteur de la caractéristique de faible puissance, nous avons effectué des mesures de température pour S1 et S3 avec différents courants de fonctionnement et étudié le mécanisme correspondant, comme le montrent les Fig. 9 et 10. De 25 °C à 125 °C, la résistance de S1 diminue avec la température, mais la résistance de S3 ne change quasiment pas. La conductance et la température expérimentales sont adaptées au modèle de saut de gamme variable de Mott [28], comme le montre la figure 11, qui indique que le principal mécanisme conducteur de S1 est le saut d'électrons via des défauts localisés de lacunes d'oxygène dans l'oxyde diélectrique [29]. Lors de la diminution de la pression partielle d'oxygène pendant le TiOx processus de pulvérisation cathodique, comme indiqué dans S1, la teneur en oxygène manquant dans le TiOx initial couche augmente et la résistance du film diminue [30]. La tension sur le TE est appliquée principalement sur le HfO2 couche et une masse de lacunes d'oxygène sont motivées pour former le filament conducteur. Après cela, de nouvelles vacances d'oxygène sont également motivées dans le TiOx couche, mais la connexion entre les lacunes d'oxygène est faible. Par conséquent, les électrons sautent en conduction dans TiOx est dominant, ce qui garantit un faible courant de commutation résistif de 1 μA.

un La résistance change avec la température dans S1. b Le schéma de principe correspondant du mécanisme conducteur

un La résistance change avec la température dans S3. b Le schéma de principe correspondant du mécanisme conducteur

Dépendance de la température de la conductance de S1 dans a LRS et b RH
Cependant, comme le montre la figure 10, après avoir augmenté la teneur en oxygène pendant TiOx processus de pulvérisation cathodique, HRS et LRS restent presque inchangés avec la température, ce qui est très probablement associé au mécanisme de transport de type métallique, induit par le transport d'électrons à travers un filament conducteur constitué de lacunes d'oxygène concentrées. Par rapport au dispositif RRAM de S1, moins de lacunes en oxygène dans le TiOx initial couche de S3 ne suffit pas pour la conduction des sauts d'électrons. De plus, en raison de la résistance accrue du TiOx film, la polarisation de tension est appliquée à la fois sur HfO2 couche et TiOx couche en même temps. L'initialisation électrique conduit à de nombreuses lacunes en oxygène motivées en HfO2 et TiOx couches. Ces lacunes d'oxygène forment un filament conducteur puissant dans les deux couches diélectriques, et les électrons étendus abondants traversent les deux lacunes d'oxygène adjacentes, ce qui provoque un courant de fonctionnement élevé pendant le processus de commutation résistive.
En principe, il est possible de contrôler soigneusement la teneur en oxygène pour obtenir des performances de faible puissance dans d'autres mémoires résistives à l'oxyde (OxRRAM) liées au manque d'oxygène. L'exigence pour la couche d'oxyde est qu'il devrait y avoir suffisamment de lacunes d'oxygène dans l'état initial pour une conduction électrique par saut en cas de panne de l'appareil. Cependant, les lacunes excessives en oxygène entraîneront une caractéristique d'endurance instable et détérioreront les performances de l'appareil. Par conséquent, les lacunes d'oxygène appropriées sont nécessaires pour limiter le courant de fonctionnement et réduire la consommation d'énergie.
Le tableau 3 compare certains des paramètres clés du Pt/HfO2 /TiOx /Pt appareil avec d'autres rapports récents. L'appareil a les mérites importants d'une faible puissance de commutation résistive de 1,12 μW et d'un rapport supérieur à 100 HRS/LRS parmi divers appareils RRAM.
Conclusions
Dans ce travail, un courant de commutation résistif de 1 μA a été démontré en Pt/HfO2 /TiOx /Pt structure périphérique. Pour le mécanisme conducteur, la conduction par saut d'électrons est dominante dans la faible teneur en oxygène du TiOx couche, qui limite le courant de fonctionnement et diminue la consommation d'énergie. Le transport de type métallique est dominant dans la teneur élevée en oxygène du TiOx couche, et la "rupture douce" de deux couches diélectriques provoque un courant de fonctionnement élevé et une consommation d'énergie élevée. La teneur en oxygène appropriée du TiOx Le film peut limiter le courant RRAM et contribuer à la caractéristique de faible puissance, ce qui fournit une solution aux problèmes de courant de fonctionnement et de puissance élevée et montre la promesse pour les futures mémoires non volatiles intégrées et les applications Internet des objets (IoT).
Abréviations
- 1T1R :
-
Un transistor une résistance
- ALD :
-
Dépôt de couche atomique
- ANN :
-
Réseaux de neurones artificiels
- BE :
-
Électrode inférieure
- CF :
-
Formation en cours
- HRS :
-
État de haute résistance
- HRTEM :
-
Microscope électronique à transmission haute résolution
- IoT :
-
Internet des objets
- I-V :
-
Courant-tension
- LRS :
-
État de faible résistance
- Rapport marche/arrêt :
-
HRS/LRS
- OxRRAM :
-
Mémoire résistive à l'oxyde
- Préréglage :
-
Réinitialiser l'alimentation
- Pset :
-
Régler la puissance
- RIE :
-
Gravure ionique réactive
- RRAM :
-
Mémoire vive résistive
- TE :
-
Électrode supérieure
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- σ /μ :
-
Écart type relatif
Nanomatériaux
- Oxygène
- Nano graphème, mémoire transparente flexible à base de silicium
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Mémoire résistive ZrO2/ZrO2 − x /ZrO2 sans conformité avec comportement de commutation multi-états interfacial contrôlable
- Une RRAM SRAM 4T intégrée avec charge de commutation résistive à auto-inhibition par un processus logique CMOS pur
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire
- Effet de commutation résistive asymétrique induit par effet de champ ferroélectrique dans les hétérojonctions épitaxiales BaTiO3/Nb:SrTiO3
- Réaction de réduction de l'oxygène sur le nanocatalyseur PtCo :empoisonnement aux anions (bi)sulfate
- Une nouvelle méthode fabrique de la mémoire informatique à partir d'oxyde de titane



