Influence dominante de la diffusion de la rugosité de l'interface sur les performances des lasers GaN Terahertz Quantum Cascade
Résumé
L'effet de la rugosité de l'interface des puits quantiques, du dopage non intentionnel et du désordre des alliages sur les performances des lasers à cascade quantique térahertz (QCL) à base de GaN a été étudié par le formalisme des fonctions de Green hors d'équilibre. Il a été constaté que l'influence du désordre de l'alliage sur le gain optique est négligeable et que le dopage non intentionnel doit rester inférieur à une concentration raisonnable de 10 17 cm −3 afin d'éviter la dégradation de la diffusion des impuretés électroniques et l'absorption des porteurs libres. Plus important encore, la diffusion de la rugosité de l'interface s'avère le facteur dominant dans la dégradation du gain optique. Par conséquent, son contrôle précis pendant la fabrication est critique. Enfin, un gain de 60 cm −1 peut être obtenu à 300 K, montrant la possibilité de fabriquer du GaN Terahertz QCL à température ambiante.
Introduction
La région spectrale térahertz (THz) fait l'objet de recherches intensives en raison de ses applications potentielles dans le contrôle de la qualité et de la sécurité, le diagnostic médical et les télécommunications. Cependant, son développement a été entravé par le manque d'appareils compacts disponibles. Le laser à cascade quantique (QCL) est un candidat prometteur pour le développement de puissantes sources à l'état solide THz [1, 2]. Jusqu'à présent, le meilleur THz QCL est basé sur GaAs, dont la température maximale de fonctionnement est d'environ 200 K en raison de la faible énergie LO-phonon (36 meV) de GaAs [3, 4]. A l'aide d'un champ magnétique, cette température peut être élevée jusqu'à 225 K. Cependant, cette méthode n'est pas adaptée aux applications à grande échelle [5, 6]. Lorsque la température augmente, les électrons à l'état de niveau supérieur peuvent acquérir suffisamment d'énergie thermique pour activer des relaxations non radiatives via l'émission de phonons LO vers l'état de niveau inférieur, détruisant ainsi l'inversion de population. Par rapport au GaAs, le GaN a une énergie LO-phonon beaucoup plus élevée (92 meV) et offre ainsi la possibilité de produire des THz QCL fonctionnant à température ambiante [7,8,9]. De plus, les QCL à base de GaAs ne peuvent pas fonctionner dans la gamme de fréquences 4,6-12 THz en raison de leur bande Reststrahlen, la région spectrale où le matériau est complètement opaque en raison de l'absorption par les phonons optiques. La plus grande énergie des phonons optiques dans GaN ouvre des perspectives pour les dispositifs à cascade quantique THz, qui peuvent fonctionner dans une gamme spectrale beaucoup plus large entre 1 et 15 THz.
La première étape de l'étude dans les QCL GaN THz était le réglage de la transition intersous-bande (ISB) vers le domaine infrarouge lointain. L'absorption ISB aux fréquences THz a été observée dans des puits quantiques polaires [10, 11] et non polaires à base de nitrure (QW) [12,13,14,15,16,17]. Des détecteurs ISB GaN fonctionnant en THz ont été démontrés à 13 THz [18] et 10 THz [19], respectivement. Aucune démonstration d'électroluminescence dans cette gamme n'a été réalisée jusqu'à présent, à l'exception d'un rapport controversé du groupe Hirayama sur l'électroluminescence spontanée à partir d'une structure QCL [20, 21]. Plusieurs études théoriques ont été publiées [7, 9, 22,23,24,25,26], parmi lesquelles certaines étudient les facteurs limitants des performances du GaN THz QCL tels que l'élargissement du spectre de gain dû aux très fortes interactions entre les électrons et les phonons LO dans GaN [23].
Dans cet article, nous proposons de compléter ces études en analysant d'autres facteurs pouvant endommager le gain optique THz GaN QCL tels que la rugosité de l'interface des puits quantiques, le dopage non intentionnel et le désordre des alliages. Il a été constaté que l'influence du désordre de l'alliage sur le gain optique est négligeable et que le dopage non intentionnel doit rester inférieur à une concentration raisonnable de 10 17 cm −3 afin d'éviter la dégradation de la diffusion des impuretés électroniques et l'absorption des porteurs libres [27]. Enfin, nous avons constaté que la diffusion de la rugosité de l'interface est le facteur dominant dans la dégradation du gain optique. Et un gain de 60 cm −1 peut être obtenu à 300 K, ce qui est bien au-dessus de la perte théorique d'un double guide d'onde métallique, montrant la possibilité de fabriquer à température ambiante GaN THz QCL.
Méthodes
Il est connu que la fabrication de dispositifs GaN THz QCL nécessite de développer des régions actives épaisses avec de faibles densités de dislocation. Cette tâche est difficile en raison du décalage de réseau entre GaN et AlGaN [28]. D'autres facteurs indésirables provenant de l'épitaxie peuvent également apparaître :rugosité d'interface (IFR) en fonction des conditions de croissance, dopage non intentionnel de type n (nid) provenant de l'incorporation d'impuretés (principalement de l'oxygène) lors de la croissance et désordre d'alliage (AD) provenant de la surface de Ga ségrégation et Al adatom faible mobilité. Pour étudier comment ces phénomènes influencent les performances THz GaN QCL, nous utilisons le formalisme des fonctions de Green hors d'équilibre (NEGF). Les calculs sont effectués à l'aide du logiciel Nextnano QCL [29,30,31]. Ce modèle inclut la relaxation induite par la rugosité de l'interface, les impuretés ionisées, le désordre de l'alliage, le phonon LO, le phonon acoustique ou l'interaction électron-électron. Nous avons utilisé un QCL à trois puits quantiques avec un schéma de dépopulation de phonons résonnants puisque cette conception QCL THz fournit la température de fonctionnement la plus élevée jusqu'à présent [3, 32]. La figure 1a montre la structure de région active conçue. La séquence de couches pour une structure quantique AlGaN/structure quantique AlGaN est 1,6 /6.2/1.6 /3.4/1.0 /3,4 nm, où les italiques indiquent l'épaisseur des barrières. La figure 1b montre le diagramme de bande de conduction de la structure QCL conçue à un biais de - 84,5 kV/cm. A partir de la période précédente à droite, les électrons sont injectés par effet tunnel résonnant dans l'état laser supérieur, marqué par 1. Ensuite, ils subissent une transition radiative vers l'état laser inférieur 2. Cet état laser inférieur est dépeuplé par effet tunnel jusqu'à l'état 3. Enfin, les électrons se détendent jusqu'à l'état 4 par émission de phonons LO. Le processus est répété pour chaque période.
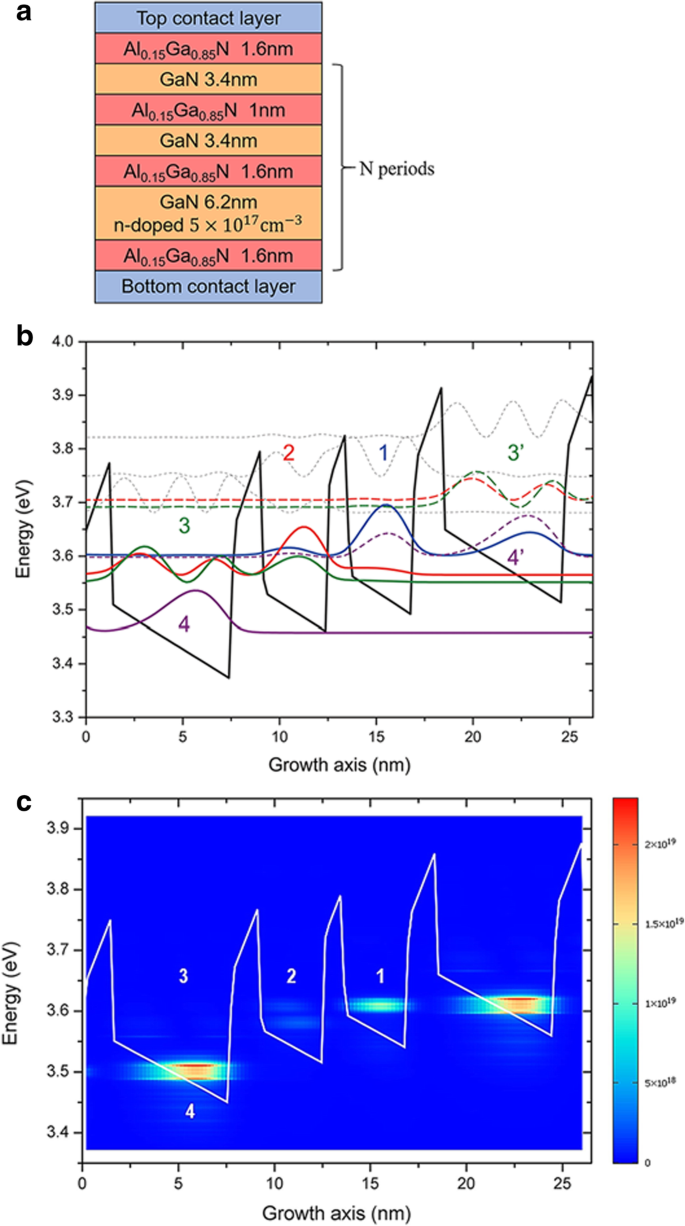
Structure de région active conçue, profil de bande de conduction, fonctions d'enveloppe au carré et densités de porteurs. un La séquence de couches pour une période est 1.6 /6.2/1.6 /3.4/1.0 /3,4 nm. Les barrières sont indiquées en italique. Le puits de 6,2 nm d'épaisseur est dopé n avec n = 5 × 10 17 cm −3 . b Profil de bande de conduction et fonctions enveloppe carrée du GaN/Al0,15 Ga0,85 N QCL considéré dans cette étude. Un champ électrique de − 84,5 kV/cm est appliqué. c Densités de porteurs et bande de conduction du QCL calculées dans le modèle NEGF. Le champ électrique appliqué est de − 84,5 kV/cm. La température est réglée à 10 K.
Dans le calcul, nous utilisons les paramètres habituellement trouvés dans la structure de croissance GaN/AlGaN avec épitaxie par faisceau moléculaire assistée par plasma (PAMBE) :une rugosité d'interface de 0,25 nm [33] avec une longueur de corrélation de 1 nm et un n- dopage avec une concentration de porteurs de 10 17 cm −3 . La diffusion des troubles de l'alliage est également incluse dans la simulation.
Résultats et discussion
La figure 1c montre les densités de porteurs calculées de cette structure au biais de fonctionnement de - 84,5 kV/cm. Nous avons observé l'anti-croisement entre la période précédente et l'état laser supérieur 1. Nous voyons également que l'état laser inférieur 2 est dépeuplé par le phonon résonant dans l'état 3 et 4. Afin d'analyser et de comparer l'influence de l'IFR, nid, et AD, nous avons calculé nos caractéristiques de gain optique et de courant GaN THz QCL pour plusieurs configurations :la configuration de référence prenant en compte IFR, nid et AD, une configuration sans IFR, une autre sans nid, et une dernière sans AD. La figure 2 montre le gain optique maximal par rapport à la fréquence (a) et les densités de courant par rapport au champ électrique appliqué (b) pour chaque configuration calculée à une température de 10 K. La structure de référence montre un gain de crête de 142 cm −1 à 8,7 THz, fréquence inaccessible pour les arséniures. Voyons comment n.i.d influence nos performances QCL. Sans n.i.d, le gain de crête est de 127 cm −1 à 8.46 THz. La baisse de gain est due au fait que la concentration de porteurs diminue dans l'état laser supérieur après avoir retiré les électrons provenant du n.i.d. En effet, dans la configuration de référence, la concentration électronique de l'état laser supérieur et inférieur est ∆N = N 1 – N 2 = 5.43 ×10 12 cm −2 , tandis que sans n.i.d il devient ∆N = N 1 – N 2 = 5,06 ×10 12 cm −2 . Le champ électrique appliqué passe de − 84,5 à − 81,6 kV/cm. Le seuil de courant chute et passe de 25,11 kA/cm 2 à − 84,49 kV/cm à 17,11 kA/cm 2 à − 93,24 kV/cm. La chute de densité de courant peut être attribuée à la réduction de la diffusion des électrons-impuretés qui augmente le transport des électrons dans le calcul sans n.i.d. Un autre indice de cette hypothèse est le pic à − 64 kV/cm que nous voyons dans le cas sans caractéristiques de densité de courant n.i.d. Il s'agit d'un tunnel résonant interpériode entre 4' et 3 (non représenté ici). Ce phénomène est masqué par la diffusion des électrons-impuretés dans les caractéristiques du courant tenant compte du n.i.d. Le seuil de courant et le décalage du champ électrique appliqué sont attribués au désalignement de la bande de conduction entre la configuration avec ou sans n.i.d. Fait intéressant, même si le pic de gain est plus important dans le cas n.i.d, nous observons un élargissement du spectre de gain, la signature des impuretés chargées influence [31] Le dopage non intentionnel devrait rester à une concentration raisonnable de 10 17 cm −3 pour empêcher la dégradation de la diffusion des impuretés électroniques et l'absorption des porteurs libres. Dans la configuration sans diffusion AD, le gain de crête est de 147 cm −1 à 8,7 THz. Nous observons que le gain de crête est à la même fréquence avec ou sans diffusion AD. Le gain optique n'obtient qu'une augmentation marginale de 3% lorsque la diffusion AD n'est pas incluse dans le calcul. Les caractéristiques actuelles sont également presque identiques. Étant donné que notre conception utilise une faible teneur en aluminium de 15 % et des barrières assez minces (1 à 1,5 nm), l'influence de la diffusion AD dans ce QCL est négligeable.

Gain optique maximal simulé par rapport à la fréquence et aux simulations de champ électrique courant pour différents processus de diffusion. un Gain optique simulé en fonction de la fréquence en tenant compte des différents processus de diffusion. b Simulations courant-champ électrique du GaN THz QCL prenant en compte différents paramètres de diffusion. La température est réglée à 10 K
Au contraire, l'influence de la diffusion IFR sur les performances de l'appareil est importante. Sans diffusion IFR, nous observons un gain de crête de 191 cm −1 à 8,7 THz. Le seuil de densité de courant est de 24,08 kA/cm 2 . Cette augmentation de gain de 34 % et la chute du seuil de densité de courant reflètent le fait que beaucoup d'électrons sont transportés par diffusion IFR. Plus la diffusion IFR est importante, moins il y a de diffusion radiative pour le laser. Lors de la comparaison de la population d'électrons de la configuration de référence de l'état laser supérieur et inférieur ∆N = N 1 – N 2 = 6,6 ×10 12 – 1,27 ×10 12 = 5.43 ×10 12 cm −2 à celui sans IFR ∆N = N 1 – N 2 = 7.4 ×10 12 – 1,17 ×10 12 = 6.23 ×10 12 cm −2 , on peut voir que la population d'électrons de l'état supérieur est plus élevée. Cela est dû à la durée de vie de l'état laser supérieur qui augmente en raison de l'absence de diffusion IFR. Par rapport au cas sans nid, dans les caractéristiques de densités de courant du dispositif sans diffusion IFR, on observe un pic à - 67 kV/cm, signature du tunnel résonant interpériode entre 4' et 3. Ce phénomène est plus visible dans le cas sans prendre en compte le processus de diffusion IFR. C'est une preuve de sa prédominance sur l'effet tunnel résonnant. Avec ces observations, nous mettons en évidence la prédominance de l'influence de la diffusion IFR dans les performances du THz GaN QCL.
Après avoir remarqué l'importance de la diffusion IFR dans les performances THz. Nous avons approfondi nos recherches en faisant varier la taille de l'IFR. Nous avons ajouté à notre étude le cas de l'IFR = 0,5 nm et 0,75 nm. La longueur de corrélation est maintenue à 1 nm. Sur la figure 3, nous avons montré le gain maximal en fonction de la fréquence (a) et les densités de courant en fonction des caractéristiques du champ électrique appliqué (b). Premièrement, nous avons observé que pour IFR = 0,5 nm, le gain optique maximal diminue à 47,9 cm −1 et chute même considérablement à − 8.8 cm −1 perte de gain optique pour IFR = 0.75 nm. L'élargissement du gain en fonction de la longueur IFR est également évident. Comme nous pouvons le voir dans les caractéristiques I-V, à mesure que la taille de l'IFR augmente, son rôle dans la diffusion des électrons augmente, augmentant les densités de courant et diminuant le tunnel résonant et le processus de diffusion radiative dans les dispositifs. Cet effet devient évident lorsque l'on compare la configuration de référence de IFR = 0.25 nm au cas extrême de IFR = 0.75 nm, la population d'électrons de l'état laser supérieur et inférieur chute de ∆N = 5.43 ×10 12 cm −2 à ∆N = N 1 – N 2 = 3,71 ×10 12 cm −2 .
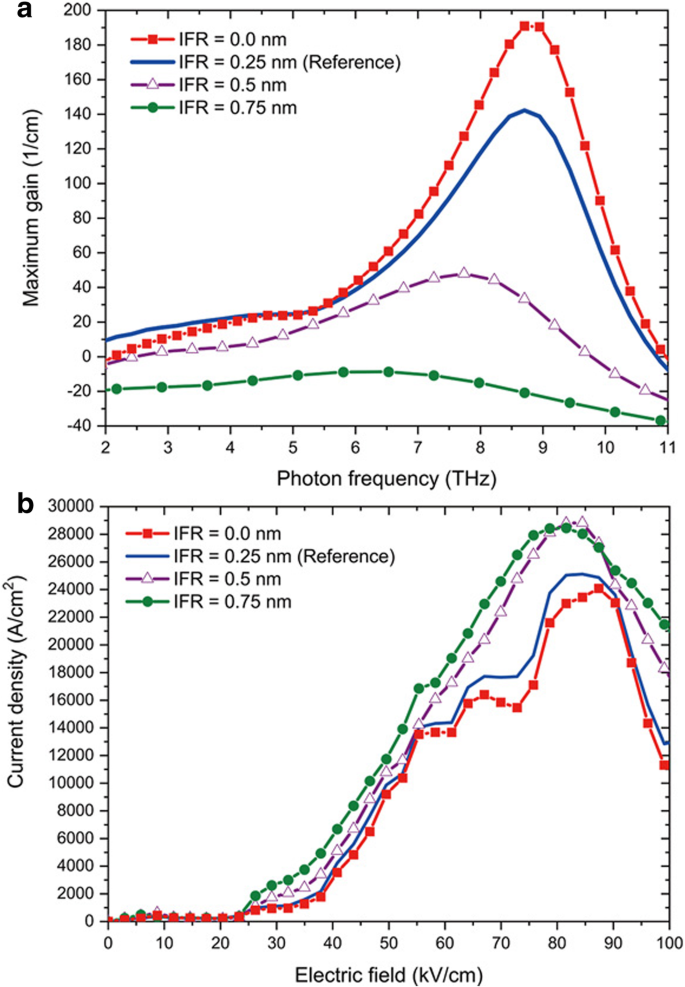
Gain optique maximal simulé par rapport à la fréquence et aux simulations de champ électrique courant pour différents IFR. un Gain optique maximal simulé en fonction de la fréquence pour différents IFR. b Simulations courant-champ électrique du GaN THz QCL prenant en compte différents IFR. La température est réglée à 10 K
Ce dernier diminue au point que l'on ne voit plus le laser dans les appareils. Comme déjà souligné dans des études précédentes utilisant le THz QCL à base de GaAs [25, 34, 35, 36], nous soulignons l'importance de considérer la taille de l'IFR lors de l'épitaxie et de la maintenir inférieure à 0,5 nm pour la fabrication de GaN THz QCL afin de pouvoir pour fournir un gain optique positif.
Un avantage pour GaN THz QCL est son potentiel de fonctionner à une température plus élevée que le THz QCL à base de GaAs. Dans cette partie, nous avons analysé les performances de notre appareil en fonction de la température de fonctionnement. Nous avons continué à utiliser nos appareils de référence avec IFR = 0.25 nm, n.i.d et AD inclus dans le calcul. La figure 4 montre le gain optique maximal pour différentes températures de réseau. La valeur de gain est stable de 10 à 150 K à environ 142 cm −1 , il commence à décroître entre 150 et 250 K, pour chuter à 61 cm −1 à 300 K. En effet, lorsque la température augmente, l'inversion de population diminue en raison du remplissage thermique et l'augmentation de la diffusion des phonons LO induit un élargissement du gain. Cette valeur de gain optique de 61 cm −1 est encore supérieure à la perte d'un double guide d'onde métallique GaN THz QCL (30 cm −1 ), montrant que cette conception GaN THz QCL devrait pouvoir fonctionner à température ambiante. Nous mentionnons également qu'en plus de pouvoir fonctionner à température ambiante, le THz QCL à base de GaN présente un autre avantage :en raison de leur concentration de dopage plus élevée, de leur indice de réfraction plus faible et de leur longueur de période plus mince, ils ont le potentiel de fournir un gain optique beaucoup plus élevé que dans leur homologue GaAs. Notre conception fournit une valeur de gain optique assez élevée de 142 cm −1 à 10 K, ce qui est un bon exemple.
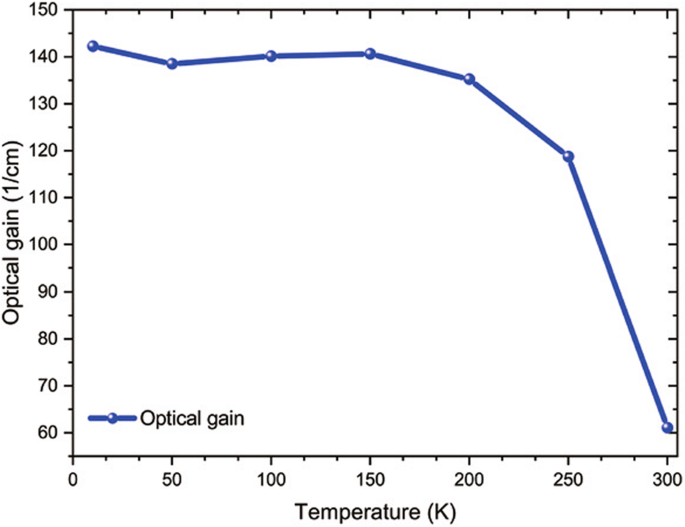
Caractéristiques du gain maximum calculé en fonction de la température du réseau
Conclusions
En conclusion, nous rapportons une conception de QCL GaN THz fonctionnant à 8,7 THz. La simulation montre un gain optique de 142 cm −1 à 10 K et 60 cm −1 à température ambiante. Parmi les phénomènes indésirables provenant de l'épitaxie, nous avons calculé l'influence de la rugosité de l'interface, du dopage non intentionnel et du désordre de l'alliage dans la performance du gain GaN THz QCL. L'influence du désordre de l'alliage est négligeable :le gain optique ne chute que de 147 à 142 cm −1 lors de l'ajout de la diffusion des désordres de l'alliage dans la simulation. Le dopage non intentionnel doit être pris en compte dans la conception pour éviter un désalignement de la bande de conduction. Nous avons observé un décalage du champ électrique appliqué de - 84,5 à - 81,6 kV/cm induit par n.i.d dans notre étude. Enfin, nous avons observé une grande disparité de gain optique pour différentes valeurs de rugosité d'interface :191, 142, 47,9 et − 8,8 cm −1 pour une rugosité d'interface égale à 0, 0,25, 0,5 et 0,75 nm, respectivement. C'est pourquoi nous identifions l'influence dominante de la diffusion de la rugosité de l'interface dans la dégradation du gain optique. Ce travail fournit des pistes pour l'optimisation des performances de la future fabrication GaN THz QCL.
Disponibilité des données et des matériaux
Les ensembles de données générés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- AD :
-
Trouble de l'alliage
- IFR :
-
Rugosité de l'interface
- ISB :
-
Intersous-bande
- n.i.d :
-
Dopage non intentionnel
- NEGF :
-
Fonctions de Nonequilibrium Green
- QCL :
-
Laser à cascade quantique
Nanomatériaux
- Influence du molybdène sur les performances de l'acier inoxydable
- Introduction à la bande térahertz
- Les performances de la fibre de verre
- Influence de l'eau sur la structure et les propriétés diélectriques de la microcristalline et de la nano-cellulose
- Lasers DFB Quantum Cascade à substrat à faible consommation d'énergie
- Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LE…
- Performance photovoltaïque d'une cellule solaire hybride à nanostructure à nanofils/points quantiques
- Photoconductivité interbande des points quantiques métamorphiques InAs/InGaAs dans la fenêtre 1,3–1,55 μm
- Comprendre le mécanisme de croissance des couches épitaxiales de GaN sur du graphite exfolié mécaniquement



