Redistribution des porteurs entre deux types d'états localisés dans les puits quantiques InGaN/GaN étudiés par photoluminescence
Résumé
Les puits multi-quantiques InGaN/GaN (MQW) sont préparés dans les mêmes conditions par dépôt chimique en phase vapeur métal-organique (MOCVD), à l'exception de l'épaisseur des couches de couverture en plus développées sur chaque couche de puits InGaN. L'intensité de photoluminescence (PL) de l'échantillon de couche de couverture mince est beaucoup plus forte que celle d'un échantillon de couche de couverture plus épaisse. Fait intéressant, l'échantillon de couche de couverture épaisse a deux pics de photoluminescence sous une puissance d'excitation élevée, et les courbes énergie-température de pic PL montrent une transition anormale de la forme en V inversé à la forme en S régulière avec une puissance d'excitation croissante. Pendant ce temps, il présente une stabilité thermique plus faible de l'échantillon de couche de couverture épaisse sous une puissance d'excitation plus élevée que celle sous une puissance d'excitation plus faible. Un tel phénomène atypique est attribué à la redistribution des porteurs entre les deux types d'états localisés qui est induite par la distribution non homogène de la composition d'indium dans l'échantillon de couche de couverture épaisse. De plus, la luminescence des états localisés profonds a une meilleure stabilité thermique, et la luminescence des états localisés peu profonds a une mauvaise stabilité thermique. En fait, une telle distribution inhomogène d'indium peut être causée par la dégradation de la croissance épitaxiale ultérieure de la région InGaN/GaN MQW en raison du temps de croissance plus long de la couche de couverture de GaN à basse température.
Introduction
La structure multi-puits quantique InGaN/GaN (MQW) a reçu une grande attention en raison de sa large utilisation dans les diodes électroluminescentes (LED) et les diodes laser (LD) [1,2,3,4,5,6]. Bien que la densité élevée de dislocations de filetage et la réduction du chevauchement des fonctions d'onde causées par la polarisation spontanée et piézoélectrique des MQW InGaN/GaN, leur efficacité de luminance est encore étonnamment élevée [7,8,9,10]. L'une des principales raisons est que la localisation des excitons dans les minima potentiels en raison des fluctuations de la teneur en indium conduit à la formation d'états de type point quantique dans les puits quantiques InGaN/GaN [11]. Cependant, le rôle joué par les états de localisation sur le mécanisme de luminescence reste ambigu. Plusieurs études ont rapporté l'effet des fluctuations de la composition d'InGaN sur les recombinaisons radiatives et Auger [12,13,14]. Les simulations théoriques de la liaison étroite atomistique utilisées par Jones ont montré que la localisation augmente à la fois les taux de recombinaison radiative et Auger, mais le taux de recombinaison Auger augmente d'un ordre de grandeur supérieur à celui radiatif [15]. Expérimentalement, la localisation des porteurs conduit à l'assouplissement de la règle de sélection k dans le processus de recombinaison Auger, et améliore ainsi fortement le processus de recombinaison Auger dans les QW polaires InGaN/GaN sous forte excitation optique [16]. Il est bien connu que le comportement en forme de S dépendant de la température de l'énergie de pic de luminescence est une empreinte digitale de la localisation du porteur. De nombreux modèles, tels que le modèle d'ensemble d'états localisés (LSE), sont proposés pour expliquer la localisation des porteurs et le comportement de redistribution thermique, montrant que la variation de l'énergie de pic de luminescence avec la température peut être influencée par un processus unique de redistribution des porteurs sous différents niveaux d'excitation [17, 18,19,20,21]. Généralement, les dispositifs fabriqués comme les diodes laser fonctionnent toujours avec une densité de porteurs injectés plus élevée [22]. Dans ce cas, les spectres de photoluminescence d'états localisés peuvent présenter un comportement unique à différents niveaux d'excitation associé à l'uniformité des états localisés. D'autres études sont donc nécessaires pour comprendre l'effet des fluctuations d'alliage sur les dispositifs InGaN.
Dans ce travail, deux échantillons typiques avec différentes épaisseurs de couches de couverture de GaN qui sont en outre cultivées sur chaque couche de puits d'InGaN sont préparés par un système de dépôt chimique en phase vapeur métal-organique (MOCVD). Les propriétés des MQW sont caractérisées en détail par des mesures de diffraction des rayons X à haute résolution (HRXRD), de photoluminescence dépendante de la température (TDPL) et de photoluminescence dépendante de la puissance (PDPL). On constate que l'échantillon de couche de couverture épaisse présente un pic anormal du côté de l'énergie plus élevée sous une puissance d'excitation optique élevée. Cela implique une coexistence de deux types différents d'états localisés. Pendant ce temps, l'intensité PL décroît plus rapidement à basse température lorsque la puissance d'excitation augmente plus. Par conséquent, nous pouvons supposer que la photoluminescence des états localisés profonds a une meilleure stabilité thermique, et la photoluminescence des états localisés peu profonds a une stabilité thermique médiocre.
Méthodes
Matériaux
Les échantillons InGaN/GaN MQW avec différentes épaisseurs de couche de couverture cultivés sur un substrat de saphir plan c par un AIXTRON 3 × 2 dans un réacteur à pomme de douche monobloc sont étudiés. Triméthylgallium (TMGa), triméthylindium (TMIn) et ammoniac (NH3 ) ont été utilisés pour la croissance épitaxiale en tant que précurseurs de source Ga, In et N, respectivement, dans lesquels H2 et N2 étaient respectivement le gaz vecteur de la croissance du GaN et de l'InGaN. MQW est composé de deux périodes de QW InGaN/GaN. Pendant la croissance de chaque couche de puits, le débit de TMIn a été maintenu constant. Ensuite, une couche de couverture de GaN a été développée à la même température que la couche également, c'est-à-dire à 710 °C. Ensuite, la température a augmenté jusqu'à 830 °C et y est restée plusieurs secondes, puis la couche barrière a été développée à 830 °C. Les deux échantillons A et B sont cultivés dans les mêmes conditions, à l'exception du temps de croissance de la couche de couverture de GaN, c'est-à-dire qu'il est de 30 s pour l'échantillon A et de 200 s pour l'échantillon B. Le diagramme schématique de la structure et des paramètres de croissance de deux InGaN/GaN MQW A et B sont illustrés à la Fig. 1.
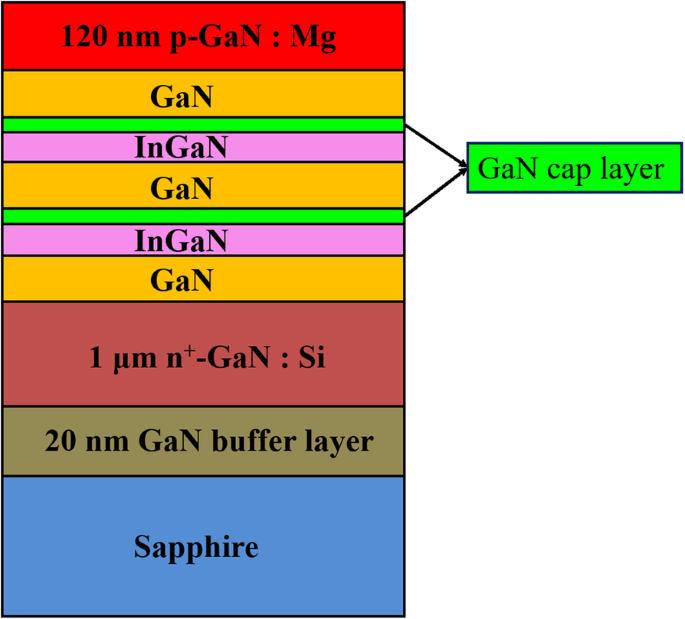
Le diagramme schématique en coupe transversale des structures épicouches de deux MQW
Caractérisation
Pour déterminer la teneur moyenne en indium, l'épaisseur de période et la qualité du matériau de deux MQW InGaN/GaN, une mesure de diffraction des rayons X à haute résolution (HRXRD) est effectuée avec Rigaku Ultima IV avec un rayonnement Cu-Ka (λ = 1,54 Å) qui a fonctionné à 40 kV et 30 mA. Pour les mesures de photoluminescence dépendante de la température (TDPL) et de PL dépendant de la puissance d'excitation (PDPL), un laser de 405 nm a été utilisé comme source de lumière d'excitation avec une taille de spot de 0,5 mm 2 , et la puissance d'excitation variait de 0,01 à 50 mW. Les échantillons ont été montés dans un cryostat He à cycle fermé et la température a été contrôlée de 10 à 300 K.
Résultats et discussions
Pour étudier les propriétés structurelles de deux échantillons A et B, les balayages symétriques ω-2θ (0002) ont été effectués, comme le montre la figure 2a. Le pic du substrat provient du plan GaN (002) et les pics satellites proviennent des MQW. Des pics satellitaires jusqu'au quatrième ordre peuvent être clairement observés dans les deux échantillons, indiquant une bonne périodicité des couches. De plus, la composition moyenne en indium et l'épaisseur périodique peuvent être obtenues en ajustant les courbes mesurées, comme indiqué dans le tableau 1. On peut voir que lorsque l'épaisseur de la couche de couverture augmente, l'épaisseur de la barrière GaN et l'épaisseur et la composition en indium de l'InGaN bien les couches augmentent légèrement. En fait, étant donné que le taux de croissance de la couche de couverture est aussi faible que 0,006 nm/s et que la température de croissance est aussi basse que 710 K, le changement d'épaisseur de la barrière est relativement faible. Cependant, notant que la croissance de couches de couverture de GaN supplémentaires peut avoir des influences non seulement sur l'épaisseur de la couche barrière, mais également sur la diffusion, l'évaporation et la redistribution des atomes d'In dans les couches de puits d'InGaN, comme nous le verrons en détail plus tard.

Les analyses d'oméga-2thêta et la cartographie spatiale réciproque des deux échantillons sont effectuées par HRXRD. un Courbes HRXRD Omega-2theta sur plan GaN (0002) pour les échantillons A et B. b Cartographie de l'espace réciproque (RSM) pour la diffraction GaN (10-15) de l'échantillon A
Pendant ce temps, pour examiner l'état de déformation des couches GaN QB et InGaN QW, une cartographie de l'espace réciproque (RSM) au voisinage du plan GaN (10-15) est effectuée. Le résultat de l'échantillon A est illustré à la figure 2b (la figure RSM de B est similaire, mais n'est pas illustrée ici). Nous pouvons observer que pour l'échantillon A, les pics satellites de MQW et GaN s'alignent bien sur la même ligne verticale, indiquant que les MQW des deux échantillons sont complètement tendus sans aucune relaxation [23].
La figure 3 montre les mesures PDPL pour deux échantillons à 10 K. Il est intéressant de constater que les deux échantillons présentent des comportements assez différents. Pour l'échantillon A, il y a un petit pic situé du côté de l'énergie inférieure (pic A 1 ) du pic dominant A 2 . Il est confirmé que le pic A 1 est une réplique de phonon qui se trouve à 92 meV du pic principal A 2 . La réplique du phonon de B 2 apparaît également dans l'échantillon B et est appelé pic B 1 . De l'autre côté, sur la figure 3b, on peut observer qu'il n'y a qu'un seul pic de luminescence dominant B 2 avec une puissance d'excitation inférieure à 5 mW. Cependant, lorsque la puissance d'excitation est supérieure à 10 mW, un autre pic B 3 apparaît anormalement du côté à plus haute énergie de B 2 , et le pic B 3 devient progressivement le pic d'émission dominant au lieu du pic B 2 lorsque la puissance d'excitation augmente encore. Ici, nous pouvons supposer que la majorité des porteurs optiques excités ont d'abord été piégés dans le premier type d'états électroniques (par exemple, des états localisés créés par les clusters locaux riches en In), puis se recombinent radiativement, produisant un pic de luminescence A 2 et B 2 . [24].
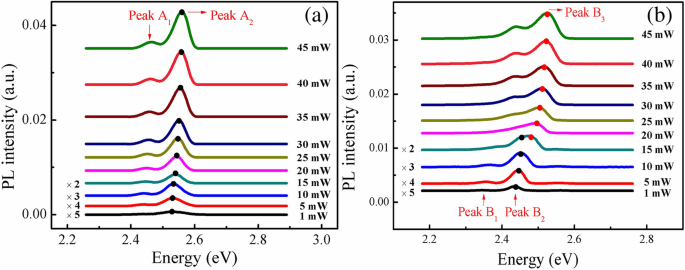
Spectres PL des échantillons A (a ) et B (b ) à plusieurs puissances d'excitation différentes, mesurées à des températures de 10 K
Pour examiner le comportement du pic anormal B 3 de l'échantillon B en outre, nous avons effectué les mesures TDPL sous différentes puissances d'excitation illustrées à la Fig. 4, dans laquelle les Fig. 4a et b sont les spectres PL obtenus sous une puissance d'excitation de 5 mW et 40 mW, respectivement. Notez que le phénomène à deux pics des spectres d'émission de la Fig. 4b a été clairement observé à des températures inférieures à 200 K et est devenu flou vers 300 K. En résumant le comportement des spectres d'émission, on peut voir que la transition du pic d'émission de faible énergie au Le pic d'émission à haute énergie se produit dans une plage étroite de puissance d'excitation et a un caractère de « commutation ». En dehors de la région de transition étroite, seule basse énergie (B 2 ) ou à haute énergie (B 3 ) le pic d'émission domine aux puissances d'excitation faibles et élevées, respectivement.
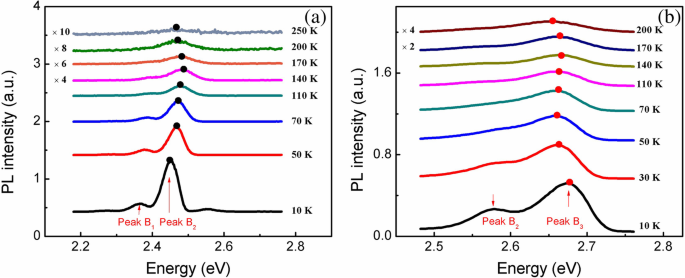
Spectres PL de l'échantillon B à une plage de températures de 10 à 300 K, mesurés sous des puissances d'excitation de 5 mW (a ) et 40 mW (b )
De plus, une inspection plus approfondie de la variation de l'énergie de pic d'émission dominante avec la température des deux échantillons, nous pouvons trouver quelque chose d'unique. Comme le montre la Fig. 5a, lorsque la puissance d'excitation augmente de 5 à 40 mW pour l'échantillon A, la variation de l'énergie de crête PL avec l'augmentation de la température (appelée courbe ET ci-dessous) montre des courbes « en forme de V inversé », ce qui est différent de la normale Forme "S". La forme en V inversé est presque inchangée avec l'augmentation de la puissance d'excitation, à l'exception d'un décalage global vers le bleu de l'énergie de crête. La dépendance à la température en forme de « V » inversé est expliquée comme une action conjointe de l'effet de remplissage du support au niveau des centres de luminescence et de l'effet de rétrécissement de la bande interdite accompagné d'une augmentation de la température [25, 26]. D'autre part, comme le montre la figure 5b, les courbes E-T pour l'échantillon B sous une puissance d'excitation inférieure à 5 mW montrent une forme en V inversé. Cette situation est similaire à l'échantillon A. Cependant, lorsque la puissance d'excitation augmente progressivement jusqu'à 40 mW, un premier décalage vers le rouge apparaît à une plage de température inférieure et les courbes E-T ont une forme en S régulière. Apparemment, ce phénomène contredit l'attente selon laquelle, lorsque la puissance d'excitation est suffisamment grande, l'effet de localisation disparaîtra complètement et le comportement en température de l'énergie de crête suivra de près la loi de Varshni [27].

Énergie de pic d'émission PL en fonction de la température pour les échantillons A (a ) et B (b ) sous différentes puissances d'excitation. Les lignes pleines sont des courbes d'ajustement théoriques utilisant le modèle LSE. Les points sont les données de l'expérience
Ainsi, pour expliquer quantitativement la dépendance de puissance optique excitée anormale observée de la luminescence des états localisés, le modèle de luminescence LSE a été utilisé pour ajuster les courbes E-T, qui est proposé par Q. Li et al. Ce modèle peut être utilisé dans toutes les plages de température, et il peut non seulement s'adapter aux courbes E-T en forme de « S » mais également aux formes en « V » ou en « V » inversé. De plus, il a également été prouvé que le modèle LSE peut être réduit au modèle à queue de bande d'Eliseev et al. à haute température [24, 25]. Dans ce modèle, l'énergie de pointe en fonction de la température peut être décrite comme [18,19,20,21] :
$$ E(T)=\gauche({E}_0-\frac{\alpha {T}^2}{\theta +T}\right)-{xk}_BT $$ (1)où θ est la température de Debye du matériau spécifique et a est le paramètre Varshni, k B est la constante de Boltzmann, et x peut être résolu numériquement par l'équation transcendantale suivante [18,19,20,21] :
$$ {xe}^x=\left[{\left(\frac{\sigma }{k_BT}\right)}^2-x\right]\left(\frac{\tau_r}{\tau_{tr} }\right){e}^{\left({E}_0-{E}_a/{k}_BT\right)} $$ (2)où σ est l'écart type de la distribution des états localisés. En d'autres termes, cela signifie la largeur de la distribution de densité d'état de type gaussien. τ r et τ tr représentent la recombinaison radiative et la durée de vie d'échappement du porteur localisé, et donc τ r /τ tr implique la portion de porteurs qui se recombine de manière non radiative. E 0 est l'énergie centrale des centres localisés, et E un donne un niveau de « marquage » en dessous duquel tous les états localisés sont occupés par des porteurs à 0 K qui est tout comme le niveau de quasi-Fermi dans la distribution de Fermi-Dirac. Il est évident que E 0 et E un ensemble sont liés à l'origine des centres localisés de luminescence [17].
Les paramètres d'ajustement obtenus pour les deux échantillons sont présentés dans le tableau 2. Pour l'échantillon A, l'énergie centrale E 0 et E un passe à 19 meV et 18 meV de 5 à 40 mW, respectivement. On remarque que le E 0 -E un et σ est quasiment inchangé. C'est parce qu'à mesure que la puissance excitée augmente, de plus en plus de porteurs seront excités. Tout d'abord, le fort champ piézoélectrique des puits d'InGaN sera masqué par les porteurs photogénérés, ce qui entraînera une augmentation de l'énergie centrale E 0 . Deuxièmement, de plus en plus de porteurs occuperont des états électroniques plus élevés en fonction de l'effet de remplissage, ce qui se traduit par une augmentation du niveau quasi-Fermi des porteurs localisés E un . Par conséquent, E 0 -E un représente l'action conjointe de l'effet d'écran de polarisation et de l'effet de remplissage des porteurs, et donc un décalage vers le bleu global dans la position du pic pour l'échantillon A est observé. Contrairement à l'échantillon A, pour l'échantillon B, de 5 à 40 mW, il y a des augmentations plus importantes de E 0 et E un , 73 meV et 57 meV, respectivement. E 0 -E un augmenter de 16 meV, τ r /τ tr change de plusieurs ordres de grandeur, et σ diminue un peu. De tels changements sont si importants que nous devons supposer que l'origine des centres de luminescence est différente à différentes puissances d'excitation de 5 mW et 40 mW.
Par conséquent, il est suggéré que pour l'échantillon B, il existe deux types d'états de localisation, répartis à deux profondeurs d'énergie différentes dans les couches de puits en raison de la distribution inhomogène de la composition d'indium, c'est-à-dire avec une composition d'indium plus élevée (états de localisation profonds) et moins composition en indium (états de localisation peu profonds). De plus, pour expliquer le phénomène ci-dessus de l'échantillon B, les diagrammes schématiques indiquant le mécanisme possible de la redistribution des porteurs entre deux types d'états localisés sont tracés sur la Fig. 6. À 10 K, sous une puissance d'excitation inférieure telle que 5 mW, montré sur la figure 6a, la majorité des porteurs optiques excités sont d'abord piégés dans le premier type d'états électroniques (états localisés profonds) et ainsi le pic d'énergie inférieur domine, tandis qu'à 40 mW, illustré sur la figure 6b, de plus en plus photogénérés les porteurs occuperont le niveau d'énergie le plus élevé, puis les états localisés peu profonds avec la densité d'états d'énergie la plus élevée sont également remplis, et ainsi le pic d'énergie plus élevé domine progressivement avec l'augmentation de la puissance excitée. Par conséquent, E 0 et E un augmenter beaucoup, et τ r /τ tr augmenter de plusieurs ordres qui impliquent la capacité d'évasion des porteurs hors d'états localisés. Lorsque la température augmente jusqu'à 30 K, à 5 mW, comme le montre la figure 6c, les porteurs photogénérés avec une certaine quantité d'énergie thermique sont principalement utilisés pour remplir les états localisés les plus profonds, ce qui entraîne un premier décalage vers le bleu des courbes E-T ; cependant, dans la figure 6d, lorsqu'il s'agit de 40 mW, en supposant que les états localisés peu profonds ont plus de capacité que les états localisés profonds, la majorité des porteurs photogénérés restent dans des états localisés peu profonds, et il sera capable de transférer à des états localisés profonds qui ont une forte capacité à se lier aux porteurs. Par conséquent, les courbes E-T sont décalées vers le rouge. En d'autres termes, les changements anormaux d'apparence des courbes ET sont concernés par de multiples types d'états de localisation dus à la distribution inhomogène de l'indium dans les couches de puits d'InGaN de l'échantillon B. Et ces fluctuations de composition sont supposées être principalement dues aux fluctuations aléatoires de l'alliage sur un échelle atomique [28].

Diagrammes schématiques indiquant le mécanisme possible de la variation anormale de l'énergie de crête PL en fonction des courbes T avec différentes puissances d'excitation. Les distributions de porteuses à T inférieur (10 K) sont indiquées dans (a ) et (b ) pour P = 5 mW et 40 mW, respectivement. Les distributions de porteuses à T plus élevé (30 K) sont indiquées dans (c ) et (d ) pour P = 5 et 40 mW, respectivement
De plus, l'apparition d'un pic d'émission à haute énergie sous forte puissance d'excitation de l'échantillon B conduit également à une variation anormale de l'intensité intégrée PL. Sur la figure 7, les courbes intégrées d'intensité en fonction de la température des échantillons A et B mesurées à des puissances d'excitation de 5 mW et 20 mW sont tracées, respectivement. Tout d'abord, notez que la trempe thermique de l'échantillon B est évidemment plus rapide que celle de l'échantillon A. Généralement, la trempe thermique de luminescence des MQW InGaN est dominée par les processus de recombinaison non radiative qui peuvent être décrits par l'équation d'Arrhenius. Par conséquent, la trempe thermique rapide implique une mauvaise stabilité thermique de l'échantillon B. De plus, lorsque la puissance d'excitation est suffisamment élevée, l'impact des centres de recombinaison non radiatifs à des températures relativement basses ne sera pas tellement important, car les centres de recombinaison non radiatifs sont facilement saturés. par les transporteurs excédentaires [27]. Cela peut parfaitement expliquer la variation plus lente de l'intensité intégrée PL par rapport aux courbes 1/T avec l'augmentation de la puissance d'excitation de l'échantillon A. Cependant, il est assez intéressant pour l'échantillon B que l'intensité intégrée normalisée sous une puissance d'excitation de 5 mW soit encore plus élevée que celle sous 20 mW lorsque la température est inférieure à 125 K, et elle s'avère opposée à des températures supérieures à 125 K. Comme mentionné précédemment, on suppose qu'un seul pic d'émission d'énergie inférieur provenant d'états localisés profonds est dominant à 5 mW, tandis qu'un autre plus élevé provenant d'états localisés peu profonds devient dominant à 20 mW. Par conséquent, il est conclu que les centres de luminescence localisés profonds ont une meilleure efficacité de luminescence que les centres de luminescence peu profonds. Ceci est en bon accord avec les résultats de recherche précédents relatifs aux états localisés [28]. Par conséquent, il peut également être prouvé, dans une certaine mesure, qu'il existe deux types d'états localisés excités à 20 mW pour l'échantillon B.
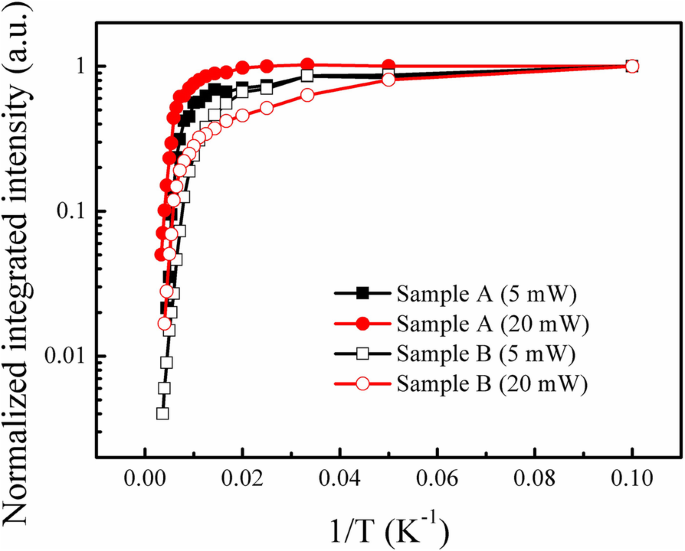
L'intensité intégrée extraite des spectres PL des deux échantillons à une plage de température de 10 à 300 K, mesurée sous des puissances d'excitation de 5 mW et 20 mW
Sur la base de toutes ces analyses, nous démontrons que le pic B 3 provient des états de localisation avec un potentiel plus faible lié à la distribution inhomogène de la composition en indium de l'échantillon B. Il est en bon accord avec les résultats expérimentaux du pic d'énergie d'émission plus élevé B 3 et la réduction de l'IQE de l'échantillon B à basse température sous une puissance d'excitation plus élevée. En fait, dans le processus de croissance des QW, compte tenu des effets d'attraction, les atomes d'indium sont susceptibles de s'accumuler au sommet de la couche d'InGaN QW et de former une couche supplémentaire appelée couche flottante d'indium [29]. Une croissance plus épaisse de la couche de couverture de GaN à basse température est préjudiciable à l'évaporation de ces atomes flottants d'indium. Par conséquent, les atomes d'In peuvent s'incorporer dans la couche de protection et la couche barrière de GaN après la croissance QW [30]. Naturellement, ce comportement entraînera une augmentation de l'épaisseur de la couche de puits, et donc le QCSE est amélioré. La contrainte plus élevée et le champ piézoélectrique plus fort dans le QW actif induiraient une relaxation plus localisée et, par conséquent, des potentiels localisés plus profonds et des barrières plus élevées. Pendant ce temps, davantage de dislocations et de défauts sont introduits dans la croissance ultérieure de la couche barrière de GaN. Généralement, il existe une contrainte de traction importante à proximité des dislocations, et les atomes d'indium peuvent avoir tendance à s'accumuler près des dislocations et à se répartir de manière inhomogène. [31, 32] Par conséquent, dans la croissance de la couche de puits d'InGaN, il y a plus de zones riches et pauvres en indium associées à l'augmentation de la densité de dislocation. Cela signifie que l'échelle des fluctuations de l'indium deviendra plus grande à mesure que l'épaisseur de la couche de recouvrement augmente. Dans nos expériences, cela montre que deux types différents d'états de localisation sont introduits dans l'échantillon B avec une couche de couverture plus épaisse, et le pic PL d'énergie d'émission plus élevée est activé sous une puissance d'excitation plus élevée. D'un autre côté, le support photogénéré restant à des états localisés profonds peut masquer les défauts et a donc une meilleure stabilité thermique, tandis que le support photogénéré restant à des états localisés peu profonds sera capturé par la recombinaison non radiative liée au défaut une fois qu'il pourra surmonter le hauteur de barrière relativement plus faible.
Conclusions
En résumé, les échantillons de puits multi-quantiques InGaN/GaN (MQW) avec différentes épaisseurs de couches de couverture GaN en plus développées sur les couches de puits InGaN sont préparés par un système de dépôt chimique en phase vapeur métal-organique (MOCVD). Leurs propriétés structurelles et optiques sont étudiées par des mesures HRXRD, TDPL et PDPL et analysées. Les résultats du PDPL montrent qu'un pic d'énergie supplémentaire à haute émission est excité à une puissance d'excitation plus élevée uniquement pour l'échantillon B qui est développé avec des couches de couverture épaisses. Pendant ce temps, les résultats TDPL mesurés à différentes puissances d'excitation pour l'échantillon B révèlent que les courbes E-T du pic dominant PL passent d'une forme en V inversé à une forme en S régulière lorsque la puissance d'excitation augmente. De plus, une stabilité thermique plus faible de l'échantillon B à une puissance d'excitation élevée a été trouvée. Ces phénomènes anormaux impliquent qu'il existe deux types d'états localisés de l'échantillon B qui sont induits par la distribution relativement inhomogène de l'indium. Ces conclusions nous permettent de mieux comprendre le mécanisme de photoluminescence des puits quantiques verts InGaN/GaN et l'effet d'inhomogénéité à un niveau d'excitation élevé, ce qui peut nous aider dans la fabrication de diodes laser InGaN/GaN.
Abréviations
- HRXRD :
-
Diffraction des rayons X haute résolution
- LD :
-
Diodes laser
- LED :
-
Diodes électroluminescentes
- LSE :
-
Ensemble d'états localisé
- MOCVD :
-
Système de dépôt chimique en phase vapeur métal-organique
- MQW :
-
Puits multi-quantiques
- NH3 :
-
Ammoniac
- PDPL :
-
Photoluminescence dépendante de la puissance
- RSM :
-
Cartographie de l'espace réciproque
- TDPL :
-
Photoluminescence dépendante de la température
- TMGa :
-
Triméthylgallium
- TMIn :
-
Triméthylindium
Nanomatériaux
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Détection de l'excitation spatialement localisée dans les superréseaux à points quantiques InAs/InGaAs auto-organisés :un moyen d'améliorer l'efficacité photovoltaïque
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Réglage des morphologies de surface et des propriétés des films de ZnO par la conception de la couche interfaciale
- Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LE…
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière



