Croissance directe de nanofils de GaN monocristallin sur de la silice recouverte d'oxyde d'indium
Résumé
Dans ce travail, nous avons démontré la croissance directe de nanofils de GaN sur un substrat de silice fondue recouvert d'oxyde d'indium et d'étain (ITO). Les nanofils ont été cultivés sans catalyseur en utilisant l'épitaxie par faisceau moléculaire assistée par plasma (PA-MBE). L'effet des conditions de croissance sur la morphologie et la qualité des nanofils est systématiquement étudié. La caractérisation structurelle indique que les nanofils croissent dans la direction (0001) directement au-dessus de la couche d'ITO perpendiculairement au plan du substrat. La caractérisation optique des nanofils montre que la luminescence jaune est absente de la réponse de photoluminescence du nanofil, attribuée au faible nombre de défauts. La mesure par microscopie à force atomique conductrice (C-AFM) sur des nanofils de GaN dopés n montre une bonne conductivité pour les nanofils individuels, ce qui confirme le potentiel de l'utilisation de cette plate-forme pour de nouvelles applications de dispositifs. En utilisant un processus de croissance à relativement basse température, nous avons réussi à développer un matériau GaN monocristallin de haute qualité sans dégradation de la couche d'ITO sous-jacente.
Introduction
Les dispositifs à base de nitrure III disponibles dans le commerce dépendent principalement du saphir comme substrat de croissance, car ils peuvent s'adapter à la croissance de GaN avec une qualité de matériau acceptable. Cependant, le défi de produire un substrat en saphir de grand diamètre tout en maintenant une qualité de surface acceptable du substrat reste un obstacle à l'augmentation de la production [1, 2]. Une alternative viable au saphir en tant que substrat de croissance de nitrure III consisterait à utiliser un substrat à base de silice, car ils sont économiquement moins chers et largement utilisés dans les applications industrielles et grand public. Cependant, comme les substrats à base de silice sont intrinsèquement non conducteurs, une couche conductrice non transparente doit être utilisée pour permettre la conductivité électrique [3, 4]. Par conséquent, une méthode pour fournir une conductivité et une transparence simultanées sur le substrat de silice devient très importante. Nous avons déjà utilisé une fine couche intermédiaire de Ti comme site de nucléation des nanofils pour fournir simultanément transparence et conductivité [5]. Cependant, comme une fine couche de Ti est requise, la conductivité électrique de l'échantillon devient limitée.
Une autre méthode possible pour un substrat transparent et conducteur consiste à utiliser de l'oxyde d'indium et d'étain (ITO) comme site de nucléation GaN, car il est transparent et conducteur de l'électricité et peut être déposé sur une grande surface. La technologie ITO est déjà mature et a été largement utilisée dans diverses industries pour les électrodes transparentes. La technique conventionnelle actuelle utilisée pour fabriquer le GaN n'est cependant pas compatible avec l'ITO. La température élevée nécessaire pour décomposer les précurseurs utilisés dans la croissance du dépôt chimique en phase vapeur métal-organique (MOCVD) conduit à la dégradation de la couche d'ITO. Ainsi, un procédé de croissance de GaN à basse température capable de produire un matériau de haute qualité est requis. Des tentatives précédentes de croissance de GaN sur ITO à basse température en utilisant la pulvérisation cathodique et le dépôt chimique en phase vapeur assisté par plasma (PECVD) ont été réalisées [6–12]. Cependant, les méthodes de croissance à basse température conduisent généralement à un matériau polycristallin et à un grand nombre de défauts.
Dans ce travail, nous tentons de contourner ce problème par la croissance directe de nanofils de GaN cristallins sur de la silice fondue recouverte d'ITO en utilisant l'épitaxie par faisceau moléculaire assistée par plasma (PA-MBE). Dans PA-MBE, les espèces d'azote actif sont fournies au système en brisant la liaison entre le N2 pur gaz utilisant la puissance RF. Ainsi, la température de croissance peut être significativement inférieure par rapport à d'autres méthodes de croissance épitaxiale de GaN, empêchant la dégradation de la couche d'ITO. En utilisant des nanofils de GaN, il est possible de faire croître du GaN de haute qualité au-dessus de la couche d'ITO polycristallin. En raison de la relaxation de contrainte et du filtrage de dislocation de filetage attribués au rapport surface/volume élevé des nanofils [13, 14], les nanofils de GaN présentent généralement une monocristallinité et aucune dislocation de filetage malgré l'absence de correspondance de réseau entre les nanofils et le nanofil sous-jacent. couche de nucléation [15].
Nous avons étudié la morphologie des nanofils et leur relation avec la couche d'ITO sous-jacente, les caractéristiques optiques des nanofils et la faisabilité de l'utilisation de cette plate-forme pour des applications de dispositifs. Les caractérisations structurelles par microscopie électronique révèlent que les nanofils croissent directement sur la couche d'ITO perpendiculairement au plan du substrat dans la direction du plan c (0001). La mesure de la photoluminescence donne une bonne valeur d'efficacité quantique interne (IQE), tandis que la luminescence jaune associée au défaut est absente du spectre d'émission. Enfin, la microscopie à force atomique conductrice (C-AFM) sur des nanofils de GaN dopés n confirme que les nanofils sont conducteurs, mettant en évidence la possibilité de fabriquer de nouveaux dispositifs utilisant les nanofils de GaN sur la plate-forme ITO. À partir de nos travaux, nous avons ouvert le potentiel de la croissance de nanofils de nitrure III au-dessus de l'ITO pour les applications de dispositifs où la transparence et la conductivité du substrat sont requises.
Méthodes
Dépôt de couche mince ITO
Le film mince d'ITO utilisé dans cette expérience a été déposé en utilisant la méthode de pulvérisation cathodique magnétron RF. Le dépôt a été effectué à température ambiante avec un plasma d'argon à une puissance RF de 60 W, une pression de chambre de 2,5 mTorr et un débit de gaz standard de 25 centimètres cubes par minute (sccm). Avant le dépôt, les échantillons sont nettoyés avec un solvant de nettoyage standard à l'aide d'acétone et d'alcool isopropylique. Un film mince d'ITO d'environ 100 nm d'épaisseur a été déposé directement sur de la silice nue.
Croissance de nanofils III-Nitride
Les échantillons de nanofils de GaN sont cultivés à l'aide d'un réacteur d'épitaxie par faisceau moléculaire assistée par plasma Veeco Gen 930 (PA-MBE). Avant la croissance du MBE, le substrat de silice recouvert d'ITO a été recuit à l'intérieur d'un four de recuit thermique rapide (RTA) à 650 °C sous Ar ambiant pendant 5 min afin d'améliorer la cristallinité de la couche d'ITO. Avant d'être chargés dans la chambre, les échantillons sont nettoyés à l'aide d'une méthode de nettoyage au solvant standard. Les échantillons subissent ensuite un nettoyage thermique à 200 °C et 650 °C à l'intérieur du sas de chargement MBE et de la chambre de préparation afin d'éliminer l'humidité et d'autres contaminants, respectivement.
Au cours de la croissance des nanofils, nous avons utilisé une valeur de pression équivalente du faisceau de Ga (BEP) de 1 × 10 -7 Torr selon la lecture de la jauge d'ions BFM. Toutes les températures du substrat sont mesurées à l'aide du thermocouple. Afin de favoriser la croissance des nanofils, une première couche d'ensemencement a été déposée à 500 °C. Après le dépôt initial de la couche d'ensemencement, la température du substrat a été portée à 700 °C pour la croissance des nanofils.
Caractérisation structurelle, optique et électrique
La morphologie de surface de la couche d'ITO a été étudiée à l'aide du système de microscopie à force atomique (AFM) Agilent 5500 SPM. La caractéristique électrique de l'échantillon a été mesurée en utilisant un AFM conducteur (C-AFM) en mode contact. Pour améliorer le contact électrique entre les nanofils et la pointe C-AFM, une couche de Ni/Au de 5/5 nm d'épaisseur a été déposée sur les nanofils à l'aide d'une évaporation par faisceau électronique, suivie d'un recuit thermique rapide à 600 °C à température ambiante. La mesure C-AFM a été effectuée en utilisant une pointe AFM revêtue de Pt/Ir et en appliquant un biais à la couche ITO de l'échantillon. Comme dans notre configuration C-AFM, le biais est appliqué sur le substrat, un flux de courant positif indique le courant circulant de l'échantillon vers la pointe de l'AFM.
La qualité structurelle des nanofils de GaN cultivés au-dessus de l'ITO a été étudiée à l'aide de la caractérisation par microscopie électronique à transmission (MET). Un échantillon MET en coupe transversale a été préparé à l'aide d'un SEM à faisceau d'ions focalisé (FIB) FEI Helios Nanolab 400s. L'imagerie SEM a été réalisée à l'aide du système SEM FEI Nova Nano et Zeiss Merlin. Des caractérisations par microscopie électronique en transmission à haute résolution (HRTEM) et STEM annulaire à champ sombre annulaire à haute résolution (HAADF-STEM) ont été réalisées à l'aide d'un microscope électronique à transmission Titan 80-300 ST (Société FEI). La carte de composition élémentaire a été obtenue par spectroscopie de perte d'énergie électronique (EELS).
Afin d'étudier la polarité des nanofils, nous avons utilisé une gravure à base de KOH. Il a été rapporté qu'une gravure chimique humide utilisant du KOH montre une gravure préférentielle pour le GaN à face N. Par conséquent, la polarité peut être déterminée en comparant la morphologie des nanofils avant et après gravure KOH. Nous avons immergé le nanofil de GaN sur des échantillons d'ITO dans une solution à 40 % de KOH pendant 1 h à température ambiante et avons comparé la morphologie avant et après l'immersion chimique pour déterminer la polarité de croissance du nanofil.
Nous avons étudié les propriétés optiques des nanofils de GaN cultivés directement sur l'ITO en utilisant une configuration de mesure de photoluminescence (PL) dépendante de la température et de la puissance. L'échantillon a été chargé dans un cryostat refroidi à l'hélium et excité à l'aide d'un laser à 266 nm (Teem photonics SNU-20F-10x). La température a varié de 10 à 290 K. Nous avons d'abord étudié la réponse de photoluminescence dépendante de la puissance, réalisée à 10 K. La mesure de la transmittance a été réalisée à l'aide d'un spectrophotomètre UV-Vis-NIR (Shimadzu UV-3600).
La mesure par diffraction des rayons X (XRD) a été réalisée à l'aide d'un système de XRD sur poudre Bruker D2 Phaser.
Résultats et discussion
Comme la croissance à haute température des nanofils de GaN pourrait entraîner la dégradation de la couche d'ITO sous-jacente, nous avons d'abord étudié l'effet du recuit thermique sur l'ITO nu déposé sur le substrat de silice. L'expérience a été réalisée à l'intérieur de la chambre tampon du MBE sous typiquement 10 −8 Pression Torr pour simuler les conditions de croissance réelles. Après recuit, la conductivité électrique de l'ITO nu est mesurée à l'aide d'une sonde de mesure à quatre points, et la rugosité de la surface est étudiée à l'aide de la microscopie à force atomique (AFM). À partir de l'expérience de recuit, illustrée à la Fig. 1a, nous constatons que la valeur de la résistance de couche du film mince ITO reste inférieure à 10 \(\Omega / \square \). Cependant, à une température de recuit plus élevée, le film mince d'ITO devient plus rugueux avec une plus grande taille de grain, illustré à la Fig. 1b–d.

Effet de la température de recuit sur les caractéristiques électriques et physiques du film mince d'ITO déposé. un Résistance de feuille mesurée avec une sonde à quatre points après recuit à différentes températures. Topographie de surface AFM du film mince ITO acquise après recuit de l'échantillon à b 500 °C, c 600 °C, et d 700 °C
Le processus de croissance des nanofils est illustré à la Fig. 2
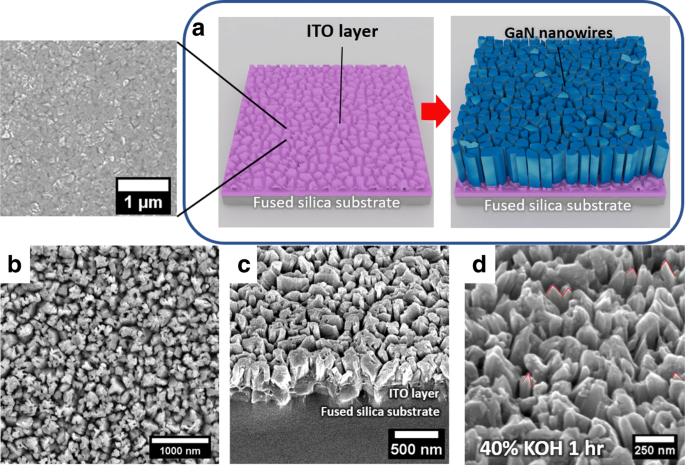
un Schéma illustrant la croissance de nanofils de GaN sur une surface ITO rugueuse. L'encart montre une vue en plan SEM de la surface rugueuse de l'ITO après recuit thermique. b Vue en plan de nanofils de GaN cultivés sur ITO. c Vue en élévation de nanofils de GaN cultivés sur ITO. d Vue en élévation des nanofils de GaN après 1 h de gravure KOH, exposant la pointe du nanofil de GaN gravé
une. Comme le montre le résultat de l'AFM, le recuit de la couche d'ITO à température élevée donnera une surface d'ITO rugueuse avec une grande taille de grain. Au cours de la croissance du MBE, les nanofils de GaN voisins qui se développent à la surface d'un seul grain ont tendance à fusionner et à former un nanofil plus gros composé d'un groupe de nanofils. Par conséquent, la morphologie de l'ITO sous-jacent affectera directement la morphologie des nanofils développés dessus. La vue en plan de la micrographie au microscope électronique à balayage (MEB) est illustrée à la figure 2b. De la vue en plan, la densité de nanofils est statistiquement estimée à 9,3×10 9 cm −2 avec un facteur de remplissage de 73 %. La vue en coupe de l'échantillon est illustrée à la Fig. 2c. Les nanofils se développent perpendiculairement au plan du substrat avec un certain degré d'inclinaison directement au-dessus de la couche d'ITO.
L'image SEM de l'échantillon de nanofil après 1 h d'immersion dans une solution à 40 % de KOH est illustrée à la Fig. 2d. On peut voir qu'après le traitement chimique, les pointes des nanofils sont partiellement gravées, ce qui indique une polarité N. Ce résultat est en accord avec les résultats précédemment rapportés où les nanofils de nitrure III à croissance spontanée sont généralement N-polaires [16–19].
La figure 3a montre la microscopie électronique à transmission à champ sombre annulaire à angle élevé (HAADF-STEM) des nanofils. Les nanofils se développent directement au-dessus de la couche d'ITO. Pour étudier la composition élémentaire de l'interface entre les nanofils et la couche ITO, nous avons effectué un balayage de ligne de cartographie élémentaire pour Ga, In, N et O en utilisant EELS dans la zone délimitée dans une boîte rouge. Le profil de balayage linéaire est illustré à la Fig. 3b. Le profil de la ligne indique une frontière claire entre les nanofils de GaN et l'ITO. Une image MET haute résolution d'un seul nanofil sur la figure 3c montre la disposition en réseau du nanofil, confirmant la monocristallinité du matériau. Le MET haute résolution sur l'interface entre les nanofils de GaN et la couche d'ITO sur la Fig. 3d montre ce qui semble être une couche intermédiaire (IL) composée d'un mélange entre une couche polycristalline et amorphe d'environ 4 nm d'épaisseur entre la base du nanofil et l'ITO . Cette couche mince est suggérée comme étant une couche de transition de GaN, formée entre la couche d'ITO polycristallin et la couche de GaN cristallin. Une couche similaire a déjà été signalée dans laquelle des nanofils de GaN sont cultivés directement au-dessus d'une couche de silice fondue amorphe [15].

Cartographie MET et élémentaire de nanofils de GaN cultivés sur couche ITO. un Image HAADF de nanofils de GaN directement développés au-dessus de la couche d'ITO. La case rouge indique où le balayage linéaire EELS a été effectué. b Profil de balayage linéaire EELS de l'interface entre la base du nanofil de GaN et la couche d'ITO. La cartographie élémentaire pour Ga, In, N et O est montrée dans le graphique. c MET haute résolution du nanofil de GaN, montrant la monocristallinité. La flèche rouge indique le sens de croissance. L'espacement interplan correspond au plan c de GaN. d Image MET haute résolution de l'interface entre le nanofil de GaN et la couche d'ITO. Une couche intermédiaire (IL) partiellement amorphe est visible entre les nanofils de GaN et la couche d'ITO, délimitée par les lignes rouges en pointillés
Le résultat de photoluminescence dépendant de la température est illustré à la Fig. 4a. À partir de la mesure, il est montré que la luminescence jaune couramment associée aux défauts dans les matériaux GaN est d'environ trois magnitudes inférieure à l'émission de bord de bande GaN, mettant en évidence la croissance de matériau GaN de haute qualité. La photoluminescence dépendante de la température est illustrée à la Fig. 4b. Le résultat montre un décalage vers le rouge avec l'augmentation de la température généralement associé à la réduction de la bande interdite de Varshni. L'intensité du pic d'émission diminue avec l'augmentation de la température due à l'activation des centres de recombinaison non radiatifs. L'ajustement d'Arrhenius est effectué sur le changement d'intensité intégrée PL en fonction de la température, illustré à la Fig. 4c. Le raccord donne une énergie d'activation de 195 meV. En utilisant le rapport d'intensité intégrée à 290 K et 10 K, nous estimons l'efficacité quantique interne des nanofils à environ 67%.

un Mesure dépendante de la puissance de nanofils de GaN cultivés sur de l'oxyde d'indium et d'étain effectuée à 10 K. b PL dépendant de la température des nanofils de GaN cultivés sur une couche d'ITO. c Énergie d'activation calculée sur la base d'une mesure PL dépendante de la température. d Transparence du substrat de silice fondue, couche d'ITO recuit sur silice fondue et nanofils de GaN cultivés sur couche d'ITO ; e Les profils XRD pour la silice fondue nue, le film mince ITO tel que déposé, le film mince ITO recuit et les nanofils GaN cultivés sur ITO
La figure 4d montre le changement de transmittance pour l'ITO recuit, la silice fondue et le nanofil de GaN sur ITO/silice. La transmittance de l'échantillon est réduite après la croissance du nanofil de GaN. Comme les nanofils de GaN ne sont pas absorbants dans la gamme de longueurs d'onde visibles, la transmittance réduite peut être attribuée à la diffusion de la lumière causée par les nanofils eux-mêmes.
La figure 4e montre les résultats XRD du substrat de silice nu, du substrat de silice avec ITO tel que déposé, de l'ITO/silice recuit RTP et des nanofils de GaN cultivés sur ITO/silice. Aucun pic XRD ne peut être observé dans la couche d'ITO telle que déposée, indiquant une couche presque amorphe. Après le recuit RTP, des pics d'ITO (211), d'ITO (222), d'ITO (400), d'ITO (440) et d'ITO (622) peuvent être observés, indiquant que le recuit améliore la cristallinité de la couche d'ITO, ce qui est en accord avec les rapports précédents. [20]. Les pics les plus dominants sont le pic ITO(222) et le pic ITO(400). Le pic GaN(0002) mesuré dans les 2 θ Le scan indique que ce plan est parallèle aux plans de l'ITO, ce qui montre que les nanofils de GaN se développent sur la couche d'ITO polycristalline.
Pour tester si les nanofils de GaN sur la plate-forme ITO seraient réalisables pour l'application de l'appareil, nous avons développé des nanofils de GaN avec des nanofils de GaN dopés n utilisant du silicium comme dopant et mesurons la caractéristique I-V de nanofils individuels à l'aide de C-AFM. Grâce à cette méthode, nous avons obtenu les données statistiques I-V de l'échantillon. La mesure résultante est illustrée à la Fig. 5.

un Cartographie C-AFM de la topologie des nanofils. b Courant de pointe correspondant, avec une polarisation de -8V appliquée à l'échantillon. c Courbe I-V d'un seul nanofil avec une tension d'échantillonnage de -10 V à 10 V, montrant différentes caractéristiques I-V entre le balayage initial et le deuxième balayage. d Distribution de la courbe I-V à partir d'un certain nombre de nanofils, après le balayage de perforation initial
La cartographie du courant de la figure 5b montre que les nanofils de la figure 5a sont initialement non conducteurs, avec seulement quelques points montrant le flux de courant. Pour mieux étudier pourquoi les nanofils ne sont pas conducteurs, nous avons effectué une caractérisation I-V sur des nanofils individuels. La plage du balayage de tension d'échantillonnage est de -10 à 10 V, avec le courant de pointe résultant allant de -10 à 10 nA, ce qui est limité par la spécification du système AFM. Le résultat est illustré à la figure 5c. Pour le premier balayage, nous constatons que les nanofils présentent une tension d'activation très élevée, indiquant un comportement de contact Schottky entre la couche n-GaN et ITO. Cependant, après avoir répété la mesure, nous constatons que la tension d'activation de la courbe I-V a été considérablement réduite, attribuée à l'abaissement de la hauteur de la barrière Schottky. Nous avons observé cette tendance de tension de mise sous tension réduite après le balayage de tension de perçage initial sur plusieurs nanofils dans la zone de balayage AFM illustrée à la Fig. 5d, confirmant que cela s'applique à tous les nanofils cultivés sur ITO. Le mécanisme exact de l'abaissement de la tension d'allumage nécessite encore une enquête plus approfondie. Des rapports antérieurs ont montré que l'application d'une haute tension au matériau pouvait induire des chemins porteurs de courant par claquage électrique [21, 22], ou modifier la structure du nanofil de GaN lui-même [23] conduisant à une amélioration de la tension d'allumage.
Conclusions
En conclusion, nous avons réalisé la croissance de nanofils de GaN au-dessus d'un film mince d'ITO déposé sur un substrat de silice fondue. La caractérisation physique par microscopie électronique montre que les nanofils croissent perpendiculairement au plan du substrat, tout en conservant une haute qualité cristalline. Une forte émission de bande GaN a été détectée grâce à la caractérisation par photoluminescence, tandis que la luminescence jaune communément associée aux défauts est absente. Les nanofils ont une polarité N préférée, indiquée par la gravure préférentielle du plan cristallin dans une solution de KOH. Les mesures C-AFM sur des nanofils dopés n montrent une bonne conductivité, soulignant la possibilité de la plate-forme pour l'application de l'appareil.
Abréviations
- AFM :
-
Microscopie à force atomique
- BEP :
-
Pression équivalente du faisceau
- C-AFM :
-
Microscopie conductrice à force atomique
- anguilles :
-
Spectroscopie de perte d'énergie électronique
- FIB :
-
Faisceau d'ions focalisé
- IQE :
-
Efficacité quantique interne
- HAADF :
-
Champ sombre annulaire grand angle
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- ITO :
-
Oxyde d'indium-étain
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- PA-MBE :
-
Epitaxie par jets moléculaires assistée par plasma
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- PL :
-
Photoluminescence
- RF :
-
Fréquence radio
- RTA :
-
Recuit thermique rapide
- sccm :
-
Centimètre cube standard par minute
- SEM :
-
Microscopie électronique à balayage
- STEM :
-
Microscopie électronique à transmission à balayage
- TEM :
-
Microscopie électronique à transmission
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Les scientifiques des matériaux enseignent aux nanofils comment « danser »
- Détection du magnétisme du noyau d'un seul atome
- Nanocristaux d'étain pour la future batterie
- À propos des nanoparticules semi-conductrices
- Croissance auto-catalysée de nanofils verticaux de GaSb sur des tiges d'InAs par dépôt en phase vapeur de produits chimiques organo-métalliques
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Vers des chaînes à un seul atome avec du tellure exfolié
- Croissance directe de structures de ZnO ressemblant à des plumes par une technique de solution facile pour une application de détection photo
- Contrôle de la croissance des nanofils de séléniure d'indium à haute uniformité (In2Se3) via le processus de recuit thermique rapide à basse température



