Étude des propriétés conductrices dépendantes de la taille sur des nanofils de silicium individuels
Résumé
Des réseaux de nanofils de Si alignés verticalement (Si NW) sont fabriqués avec succès par lithographie de nanosphères combinée à une gravure chimique assistée par métal. En ajustant le temps de gravure, le diamètre et la longueur des nanofils peuvent être bien contrôlés. Les propriétés conductrices de ces Si NWs et en particulier leur dépendance de la taille sont étudiées par microscopie à force atomique conductrice (CAFM) sur des nanofils individuels. Les résultats indiquent que la conductance des Si NW est fortement liée à leur diamètre et à leur longueur. Les Si NW avec des diamètres plus petits et des longueurs plus courtes présentent de meilleures propriétés conductrices. Avec la caractérisation de la courbe I-V, un mécanisme possible est supposé du point de vue de la hauteur de barrière Schottky dépendant de la taille, qui est en outre vérifié par les mesures de microscopie à force électrostatique (EFM). Cette étude suggère également que le CAFM peut agir comme un moyen efficace pour explorer la dépendance de la taille (ou d'autres paramètres) des propriétés conductrices sur les nanostructures individuelles, ce qui devrait être essentiel à la fois pour l'optimisation de la fabrication et les applications potentielles des nanostructures.
Introduction
Les nanofils de silicium (Si NW) ont obtenu des applications prometteuses dans les domaines de l'électronique, de la photonique, de l'optoélectronique et de nombreux autres en raison de leur rapport d'aspect élevé et de leurs propriétés électriques, thermoélectriques et photoélectriques uniques, ainsi que de la compatibilité avec la technologie traditionnelle du silicium [1,2,3 ,4,5]. Au cours des dernières décennies, les recherches de Si NWs se sont principalement concentrées sur les améliorations de croissance et les mesures de propriétés. De nombreuses méthodes ont été développées pour préparer les nanoparticules de Si, notamment des méthodes ascendantes telles que la méthode vapeur-liquide-solide, le dépôt chimique en phase vapeur et l'épitaxie par faisceau moléculaire [6,7,8,9,10] et des approches descendantes utilisant des électrons. -lithographie par faisceau, gravure ionique réactive ou gravure chimique assistée par métal [11,12,13,14,15,16]. Parmi ces méthodes, la lithographie par nanosphères (NSL) combinée à la gravure chimique assistée par métal (MACE) a été intensivement adoptée pour fabriquer des réseaux ordonnés de grande surface de Si NW alignés verticalement pour sa simplicité, son faible coût et sa polyvalence [15,16,17 ,18,19,20,21,22,23]. Les Si NW obtenus par MACE ont généralement des surfaces très rugueuses et même poreuses [18,19,20,21], ce qui leur confère simplement une grande surface spécifique et d'excellentes propriétés, conduisant à de grands potentiels d'application dans les biocapteurs, les dispositifs thermoélectriques, le lithium -batteries ioniques, cellules solaires, etc. [22,23,24]. Pour réaliser ces applications, il est essentiel de bien comprendre leurs propriétés électriques. De nos jours, deux types de méthodes ont souvent été appliquées pour étudier les propriétés électriques des nanofils. L'une est réalisée par des méthodes macroscopiques ordinaires, ce qui est relativement facile à faire mais ne peut fournir des résultats moyennés que sur un grand assemblage de nanofils [24, 25]. L'autre est réalisée sur des nanofils individuels avec des dispositifs à nanofils uniques fabriqués [21, 26, 27, 28], ce qui pourrait exclure l'influence de l'inhomogénéité de taille mais n'est pas facile à réaliser, en particulier lors de la mesure de la dépendance des propriétés. Par conséquent, des méthodes plus pratiques pour étudier les propriétés électriques sur des NW individuels sans nanofabrication complexe sont fortement requises.
Au cours des dernières décennies, les mesures électriques basées sur la microscopie à sonde à balayage (SPM) se sont révélées être des techniques puissantes pour les caractérisations électriques à l'échelle nanométrique [29, 30]. Parmi ces techniques SPM, la microscopie à force atomique conductrice (CAFM) a été appliquée avec succès pour étudier les propriétés conductrices sur des nanostructures simples ou individuelles [30,31,32]. Des études CAFM sur une variété de nanofils, tels que ZnO, InAs, CdS, CdSe, GaAs, InAsSb et Si NWs, ont déjà été rapportées [33,34,35,36,37,38]. Alors que la plupart des recherches se sont concentrées sur les propriétés conductrices des nanofils avec des paramètres fixes, certaines enquêtes ont été menées pour explorer la dépendance au dopage des propriétés conductrices [37,38,39]. Les dépendances de taille des propriétés conductrices des nanofils ont été beaucoup moins étudiées à ce jour. Seules quelques études ont été rapportées sur les propriétés conductrices dépendantes du diamètre des nanofils, même non limitées au CAFM, et une partie considérable d'entre elles traitait de la dépendance au diamètre de la résistivité des nanofils [25, 40, 41, 42]. Par exemple, quelques recherches sur les nanofils de GaN ont révélé que la résistivité était élevée à un diamètre critique (20 ~ 80 nm, selon les méthodes de fabrication) et restait inchangée au-delà [41, 43], alors que d'autres recherches sur les nanofils de Si ont rapporté que la résistivité des nanofils diminuait avec l'augmentation du diamètre de l'ordre de dizaines à des centaines de nanomètres [40, 44]. Pour les nanofils semi-conducteurs avec des contacts métalliques, la barrière Schottky peut jouer un rôle important dans leurs propriétés conductrices. Par conséquent, à l'exception de la résistivité, la barrière Schottky doit être prise en considération en présence de nanofils semi-conducteurs. Plusieurs articles se sont concentrés sur la dépendance du diamètre de la hauteur de barrière Schottky (SBH), mais les résultats ne sont pas cohérents. Par exemple, Calahorra et al. a calculé le SBH en résolvant l'équation de Poisson dans le nanofil et a trouvé une tendance claire à l'augmentation de la hauteur de la barrière avec la réduction de la taille [45]. Une dépendance similaire au diamètre a été rapportée expérimentalement par Soudi et al. lors de l'étude de la tension de surface dépendant du diamètre et de la densité de l'état de surface sur un dispositif à nanofil unique de ZnO. Ils ont constaté que la hauteur de la barrière de surface augmentait avec le diamètre décroissant (20 à 60 nm), ce qui était interprété par la densité d'état de surface simulée à l'aide de l'équation de Poisson [46]. En revanche, les mesures de microscopie à photocourant à balayage sur des transistors à effet de champ à nanofil de Si unique par Yoon et al. a révélé une dépendance contraire, c'est-à-dire que la hauteur de la barrière diminue avec la diminution du diamètre en raison de la contribution des états d'interface [47]. Un autre travail expérimental de Mao et al. sur des diodes Schottky à nanoaiguille unique en Pt/ZnO, la hauteur de la barrière diminuait avec la diminution du diamètre, ce qui s'expliquait par un effet de chauffage par effet Joule et/ou une inhomogénéité électronique de l'interface [48]. Par conséquent, jusqu'à présent, la dépendance au diamètre des propriétés conductrices des nanofils n'a pas encore fait l'objet d'un consensus et est loin d'être complètement comprise. En particulier, les propriétés conductrices dépendantes de la taille ainsi que les études SBH dépendantes de la taille n'ont pas été rapportées sur des Si NW individuels fabriqués par la méthode MACE, qui ont une surface assez rugueuse pour des applications prometteuses.
Dans cet article, des tableaux périodiques de Si NWs alignés verticalement avec différents diamètres et longueurs sont préparés par la méthode de NSL combinée avec MACE. Le diamètre et la longueur des SiNW peuvent être bien contrôlés en ajustant le temps de gravure. Les propriétés conductrices de Si NW individuels à l'intérieur du réseau sont étudiées par CAFM sans autre nanofabrication, qui peut étudier les propriétés conductrices dépendantes de la taille sur des Si NW individuels facilement en remplaçant simplement l'échantillon. Les résultats démontrent que le courant mesuré sur les NW Si individuels dépend fortement du diamètre et de la longueur des NW. Les Si NW avec des diamètres plus petits et des longueurs plus courtes présentent de meilleures propriétés conductrices. À partir de l'ajustement de la courbe I-V, des hauteurs de barrière Schottky dépendantes de la taille peuvent être obtenues, qui s'avèrent agir comme un facteur clé pour déterminer les propriétés conductrices dépendantes de la taille des nanofils. De plus, un SBH similaire à la taille a été obtenu par des mesures de microscopie à force électrostatique (EFM). Par conséquent, notre étude révèle non seulement les propriétés dépendantes de la taille des Si NW, mais suggère également que le CAFM peut agir comme un moyen efficace pour explorer la dépendance de la taille (ou d'autres paramètres) des propriétés conductrices sur les nanostructures individuelles.
Matériaux et méthodes
Matériaux
Les plaquettes de Si ont été achetées auprès de MTI (Chine). Les suspensions (2,5 % en poids dans l'eau) de sphères de polystyrène (PS, 490 nm de diamètre) ont été achetées auprès de Duke Scientific (USA). L'acétone, le méthanol, l'acide sulfurique, le peroxyde d'hydrogène et l'acide fluorhydrique pour la fabrication des Si NW ont été achetés auprès de Sinopharm Chemical Reagent (Chine). L'eau déminéralisée (DI, 18,2 MΩ·cm) a été obtenue à partir d'un système d'ultrafiltration (Milli-Q, Millipore, Marlborough, MA).
Fabrication de Si NWs
Des réseaux de nanofils de silicium ordonnés verticalement sont fabriqués par NSL combiné avec MACE, qui ont été décrits en détail dans les littératures précédentes [49, 50]. Le processus de fabrication principal est programmé sur la figure 1a. Tout d'abord, une monocouche de sphères de polystyrène (PS) d'un diamètre de 490 nm a été auto-assemblée sur la plaquette de Si planaire nettoyée chimiquement (type n, 0,01 cm) pour former une monocouche hexagonale compacte. Par la suite, l'échantillon recouvert de PS a été gravé par gravure ionique réactive (RIE, Trion Technology) (50 W, 70 mTorr) avec O2 gaz (20 µsccm) pour réduire le diamètre du PS, qui a servi de couche de masque dans les procédures suivantes. Ensuite, un film d'Au de 20 nm a été déposé par pulvérisation ionique sur l'échantillon masqué par la couche de PS qui a servi de catalyseur pour le traitement MACE suivant. L'échantillon a été traité par MACE en HF (40%) et H2 O2 (30 %) solution mélangée (rapport volumique 4:1) à température ambiante. Dans le procédé MACE, la surface de Si recouverte d'Au a été efficacement gravée tandis que celle recouverte de PS (sans Au) a été protégée, entraînant la formation de Si NWs. Enfin, la couche d'Au restante et les sphères de PS ont été retirées en trempant l'échantillon dans KI/I2 et des solutions de tétrahydrofurane, respectivement. Avec cette méthode de fabrication, des réseaux périodiques de grande surface de réseaux Si NW alignés verticalement peuvent être obtenus.

un Illustration schématique des procédures de fabrication d'un réseau de nanofils Si aligné verticalement. b Schéma de principe des montages expérimentaux pour les mesures CAFM et EFM sur des nanofils de Si individuels
Caractérisation des Si NWs
La morphologie des Si NWs fabriqués a été vérifiée par microscopie électronique à balayage (SEM, SIGMA300) tandis que leurs propriétés structurelles ont été étudiées par spectroscopie Raman (système Jobin Yvon HR-Evolution 2) avec une longueur d'onde d'excitation de 532 nm et une faible puissance d'environ 1 mW .
Les propriétés électriques des Si NW ont été étudiées par CAFM et EFM avec un équipement SPM commercial (Multimode V, Bruker Nano Surfaces), comme le montre la figure 1b. Des pointes revêtues de Cr/Pt (Multi75E-G, capteurs Budget, rayon d'environ 25 nm) ont été utilisées pour les mesures CAFM et EFM. Dans CAFM, la pointe conductrice a été balayée sur la surface de l'échantillon en mode contact avec une tension de polarisation continue appliquée au substrat tandis que la pointe était mise à la terre, et le courant entre la pointe et l'échantillon a été mesuré. Comme l'oxydation anodique de surface est grave sous les biais d'échantillon positifs, toutes les images actuelles ont été mesurées avec des biais d'échantillon négatifs. Diverses tensions négatives allant de - 0,5 à - 3,0 V ont été testées dans les expériences CAFM. Il a été constaté que lorsque la tension de polarisation était réglée en dessous de - 1,5 V, le courant était trop faible pour être détecté pour les échantillons à faible conductance. Alors que la tension de polarisation était fixée à − 2,0 V ou plus, les mesures étaient instables, probablement en raison de l'endommagement de la pointe et/ou de l'échantillon sous un champ électrostatique important. Par conséquent, la tension de polarisation de - 1,5 V a été choisie pour les mesures d'images de courant. Les mesures EFM ont été réalisées sur Si NWs en mode deux passes. Lors du premier passage, il fonctionnait en mode tapotement pour obtenir l'image topographique, tandis que lors du second passage, la pointe était suffisamment élevée pour ignorer la force de Van der Waals. Dans la passe levée, une tension continue a été ajoutée entre l'échantillon et la pointe mise à la terre, et le signal de déphasage induit par la force électrostatique a été détecté. Toutes les expériences ont été opérées dans un N2 fluide ambiante pour des mesures électriques stables et les échantillons ont été préalablement plongés dans la solution HF (5 %) pendant 30 µs pour réduire efficacement l'influence de la couche d'oxyde sur la caractérisation conductrice. Étant donné que les mesures ont été effectuées immédiatement après le trempage HF, la couche d'oxygène reformé doit être suffisamment mince pour être pénétrée par la pointe conductrice et son effet sur la conductance est minime.
Résultats et discussions
Fabrication de Si NWs
La fabrication de réseaux de nanofils de Si ordonnés alignés verticalement de grande surface est illustrée sur la figure 1a. En modifiant le temps RIE, le diamètre des sphères PS peut être réduit aux valeurs souhaitées et, par conséquent, des Si NW avec des diamètres contrôlables peuvent être obtenus. Les images SEM de Si NW obtenues après une gravure RIE de 90, 120 et 150 s sont présentées sur la Fig. 2 a, b et c, respectivement. On peut observer que les Si NWs sont alignés verticalement dans un arrangement périodiquement hexagonal dans une grande zone. Ces Si NWs alignés verticalement ont la même période de 490 nm et la même longueur d'environ 350 nm (même temps MACE de 40 s). Les diamètres des Si NW dans (a), (b) et (c) sont respectivement d'environ 350, 260 et 190 nm. La dépendance du diamètre des NW sur le temps de gravure RIE est tracée sur la figure 2d, montrant une bonne corrélation linéaire. D'autre part, la longueur des nanofils pourrait être ajustée en faisant varier le temps de MACE en HF et H2 O2 solution mixte. Les images SEM en coupe transversale de Si NWs après 40, 60, 80 et 100 s MACE sont montrées sur la Fig. 2e. On peut voir que la longueur des NW augmente de 350 à 960 nm en augmentant le temps MACE. De même, la longueur des Si NW présente une bonne dépendance linéaire du temps MACE, comme le montre la figure 2f. Ces résultats indiquent que les Si NWs ordonnés avec des diamètres et des longueurs contrôlables sont fabriqués avec succès par la méthode de NSL combinée avec MACE.
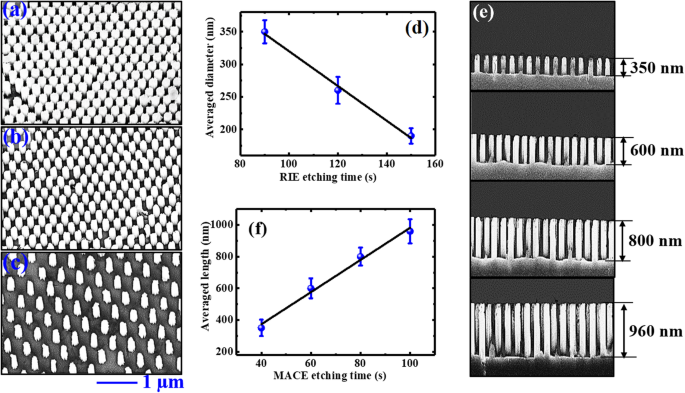
Vue de dessus des images SEM de Si NW avec la même longueur de 350 nm, mais des diamètres différents de a 350 nm ; b 260 nm ; et c 190 nm. La dépendance du diamètre des NWs sur le temps de gravure RIE est tracée en d . e Images SEM en coupe de Si NWs avec le même diamètre de 260 nm, mais des longueurs différentes de 350, 600, 800 et 960 nm. f Présente la dépendance de la longueur des NW sur le temps MACE
À partir des images SEM, on peut également constater que les Si NW ont une surface très rugueuse après gravure chimique, et leur surface de paroi latérale est particulièrement rugueuse. Pour vérifier la microstructure de la couche de surface en fonction du diamètre et de la longueur, des spectres Raman ont été mesurés sur des NW de Si et de Si en vrac avec différents diamètres et différentes longueurs. Chaque spectre a été normalisé en utilisant l'intensité de pic maximale à 520 cm − 1 , et les résultats pour différents diamètres et différentes longueurs ont été montrés dans les Fig. 3 a et b, respectivement. Le spectre du silicium massif montre un pic pointu situé à ~ 520,1 cm − 1 . Le décalage vers le rouge de la position du pic et l'élargissement de la largeur du pic (appelé pleine largeur à mi-hauteur, FWHM) peuvent être observés sur les Si NW, comme représenté sur les Fig. 3 c et d, de manière correspondante. Le pic de décalage vers le rouge et l'élargissement sont plutôt faibles pour les nanofils avec des longueurs courtes de 350 et 600 nm et deviennent relativement évidents à mesure que la longueur des nanofils augmente jusqu'à 800 nm et plus. Un tel décalage vers le rouge et un élargissement du pic Raman sont parfois attribués aux changements de niveau de dopant ou de contenu cristallin. D'après les littératures précédentes [5, 51], pour les Si NW fabriqués par la même méthode MACE, la concentration de dopage pourrait posséder le même niveau de dopage que la plaquette de départ. En raison des limitations de l'équipement, nous n'avons pas pu confirmer ce résultat. D'autre part, bien que ces Si NWs aient une surface rugueuse, les littératures précédentes ont montré que les Si NWs fabriqués par la méthode MACE pouvaient principalement conserver leurs structures cristallines pour le dopage n et p et le dopage léger et lourd [5, 51 , 52]. Seule une fine couche amorphe a été observée à la surface des parois des NW. Des résultats similaires ont été obtenus sur Si NWs avec différents diamètres et longueurs par différents groupes. En tant que tel, on pourrait supposer que les Si NW fabriqués par la méthode MACE peuvent conserver leur niveau de dopant et leur contenu cristallin presque inchangés par rapport à leur homologue en vrac, à l'exception de la fine couche de surface.

Spectres Raman typiques de nanofils de Si et de Si en vrac avec a même longueur de 350 nm mais diamètres différents et b même diamètre de 190 nm mais des longueurs différentes. c et d représentent le redshift de la position du pic et l'élargissement FWHM en fonction de la longueur du nanofil
Par conséquent, le décalage et l'élargissement du pic Raman sont très probablement induits par la surface rugueuse endommagée des nanofils [53]. Plusieurs articles ont rapporté les résultats Raman de Si NW fabriqués par la même méthode MACE. Par exemple, Feser et al. ont constaté que l'élargissement significatif du pic à 520 cm − 1 augmentait avec le temps MACE et attribuait cet élargissement du pic au désordre cristallin (par exemple, des amas de défauts ponctuels) induit par le processus de gravure [23]. Lajvardi et al. ont constaté que le décalage vers le rouge de Raman augmentait avec le temps MACE, i. e. le pic TO Raman était situé à 521,1 cm − 1 pour le Si en vrac et décalé à 518,7 cm − 1 pour des échantillons gravés de 80 min, respectivement [54]. Ils ont déclaré que l'origine du décalage Raman peut être due à la formation de nanocristaux de Si sur la paroi du nanofil. Lin et al. ont observé que le pic TO Raman s'est déplacé de 520 à 516 cm − 1 lorsque la longueur des NW augmente de 0 (Si en vrac) à 2,73 m, tandis que la largeur du pic a été élargie de 3 à 9 cm − 1 avec l'augmentation de la longueur des NW de 0,19 à 2,73 μm [55]. Ils pensaient que l'élargissement du pic Raman était dominé par l'interaction phonon-déformation et que le décalage du pic Raman s'est avéré proportionnel à la distorsion du réseau de surface induite par la déformation. Étant donné que la contrainte induite par la gravure HF augmentait avec la longueur des NW (plus de temps de gravure), le redshift et l'élargissement du pic Raman augmentaient avec la longueur croissante des NW. Dans notre cas, à partir des spectres Raman illustrés sur les figures 3 a et b, nous pouvons constater que le pic Raman TO passe de 520 à 519,4 cm − 1 lorsque la longueur des NWs augmente de 0 (bulk Si) à 960 nm, tandis que le FWHM est élargi de 4,41 à 4,47 cm − 1 à mesure que la longueur des NW augmente de 350 à 960 nm. Nous préférons que ce décalage de pic Raman dépendant de la longueur et l'élargissement proviennent de la surface endommagée (souche ou désordre). Cependant, en raison de la très faible variation du décalage vers le rouge et de l'élargissement du pic pour les nanofils de différents diamètres et de différentes longueurs (< 1,0 cm − 1 ), le changement de souche/trouble avec la taille peut être considéré comme minime. Ainsi, la déformation/le trouble peut modifier la conductance des NW, mais son influence sur la dépendance de la taille de la conductance n'est pas concernée dans les sections suivantes.
Mesures de propriétés conductrices sur des NW Si uniques
Les propriétés conductrices des Si NW sont mesurées par CAFM sur des NW individuels de différents diamètres et longueurs. Des images topographiques typiques des Si NWs alignés verticalement avec la même longueur de 350 nm mais des diamètres différents de 350, 260 et 190 nm sont présentées sur la Fig. 4 a, b et c, respectivement, tandis que leurs images actuelles correspondantes obtenues à l'échantillon des biais de − 1,5 V sont présentés dans (d), (e) et (f). Il convient de noter que, comme la pointe AFM revêtue de Cr/Pt est un coin avec un grand angle, les Si NW présentent un diamètre plus grand que leurs réels. De plus, le courant sortant des nanofils n'a pas pu être correctement détecté car la pointe peut ne pas être en mesure d'entrer en contact avec le substrat, de sorte que seuls les courants mesurés sur les nanofils sont pris en compte. A partir des images actuelles, on peut observer que la plupart des bords des nanofils de Si présentent une conductance un peu meilleure que le centre. Cela peut être dû à un contact latéral entre la pointe de l'AFM et le Si NW avec une plus grande surface de contact. De plus, en raison de la rugosité évidente de la surface supérieure, certaines régions de la zone centrale peuvent également présenter un courant important similaire au bord, ce qui n'entraîne aucune distribution de courant distincte en forme d'anneau. D'autre part, la conductance des Si NWs est évidemment liée au diamètre des nanofils. On peut voir que le rapport de surface conductrice des nanofils et les valeurs de courant absolu augmentent de manière significative lorsque le diamètre diminue de 350 à 190 nm. Les résultats suggèrent que les Si NWs avec des diamètres plus petits sont plus conducteurs que ceux avec des plus grands. Pour obtenir la dépendance du diamètre de manière plus intuitive, les profils actuels le long des lignes marquées sur la figure 4d à f sont affichés sur la figure 4g. Il montre clairement que les Si NW de diamètre 190 nm sont beaucoup plus conducteurs que ceux de diamètre 260 nm et 350 nm. Une telle dépendance du diamètre peut également être obtenue à partir des histogrammes statistiques des distributions de courant sur Si NW avec différents diamètres, comme indiqué dans le fichier supplémentaire 1 :Figure S1(a), qui montre que la distribution de courant passe à des valeurs élevées lorsque le diamètre diminue. Les courants moyennés (I av ) de Si NWs sont calculés en faisant la moyenne du courant sur tous les nanofils dans les images actuelles, qui est tracée sur la figure 4h en fonction du diamètre des NWs. Le courant moyen des Si NWs présente une augmentation spectaculaire de neuf fois lorsque le diamètre des NWs diminue de 350 à 190 nm. Une dépendance actuelle similaire au diamètre a été obtenue sur des nanofils d'InAs simples ainsi que sur des dispositifs à nanofils de Si simples [35, 47].

Les images topographiques de Si NWs avec la même longueur de 350 nm mais des diamètres différents de a 350 nm, b 260 nm, c 190 nm. Leurs images de courant correspondantes obtenues sous le biais d'échantillon de − 1.5 V sont données en d , e et f , respectivement. Profils actuels le long des lignes marquées en d –f sont tracés en g , et h présente le courant moyen (I av ) sur les nanofils en fonction du diamètre des NW. Les lignes correspondantes sont ajoutées dans les images topographiques de a –c et les courbes de profil en g sont décalés verticalement pour le guidage
Des images courantes typiques de Si NWs avec différentes longueurs et le même diamètre de 190 nm mesurés avec un biais d'échantillon de - 1.5 V sont présentées dans la Fig. 5. Les figures 5 a à d montrent les images actuelles de Si NWs avec des longueurs de 350, 600, 800 et 960 nm, respectivement. On voit que dans ces images de courant, les zones conductrices diminuent évidemment avec l'augmentation de la longueur, tandis que la diminution du courant absolu n'est pas si évidente, surtout pour les NW de longueur 350 nm et 600 nm. Peut-être en raison de l'existence d'une rugosité de surface irrégulière locale, un courant encore plus important a été observé à certains endroits sur la figure 5b. Néanmoins, le courant moyen de la figure 5b était beaucoup plus petit que celui de la figure 5a. En utilisant les mêmes analyses que ci-dessus, les profils actuels le long des lignes marquées sont présentés sur la figure 5e, et les histogrammes statistiques sont présentés dans le fichier supplémentaire 1 :figure S1 (b). Les deux présentent clairement une diminution de courant significative avec l'augmentation de la longueur des NW. Les courants moyens des nanofils en fonction des longueurs des NW sont tracés sur la figure 5f, et ils sont de l'ordre de dizaines à centaines de pA, ce qui est beaucoup plus petit que celui illustré sur la figure 5 a à e de l'ordre de nA. . C'est parce que les nanofils présentent un courant relativement important seulement à quelques points conducteurs lorsque la plupart des régions sont non conductrices. D'après la figure 5f, le courant moyen présente une diminution de plus de trois fois lorsque la longueur augmente de 300 à 960 nm, indiquant que la conductance des nanofils diminue avec l'augmentation de la longueur. La dépendance de la résistance des nanofils sur la longueur a déjà été étudiée par des mesures de résistance en quatre points sur des nanofils semi-conducteurs, qui suggèrent que sous contact ohmique, la résistance du nanofil augmente avec sa longueur de manière linéaire avec la pente de résistivité [56, 57]. Dans notre cas, à partir du tracé de I ~ 1/L tel qu'il est donné dans le fichier supplémentaire 1 :figure S2, la dépendance est remarquablement non linéaire ; par conséquent, la résistivité n'a pas pu être obtenue correctement à partir de la pente de la courbe. Il convient de noter dans les mesures CAFM, la résistance totale mesurée comprend la résistance de contact entre les pointes revêtues de Cr/Pt et Si NW (R astuce/NW ), la résistance de Si NW (R NO ) et la résistance des plaques de Si (R en vrac ). Étant donné que la résistance mesurée par CAFM provient principalement de la surface localisée sous la pointe et qu'elle diminue rapidement avec l'augmentation de la surface le long du trajet du courant, R en vrac est beaucoup plus petit que R NO et R astuce/NW . D'autre part, en raison de la très petite surface de contact métal-semi-conducteur entre la pointe et le nanofil, la résistance de contact R astuce/NW est beaucoup plus grande que la résistance du nanofil R NO . La non-linéarité de la dépendance du courant à 1/L indique simplement la présence d'une grande résistance de contact. Par conséquent, dans les mesures effectuées par CAFM, la résistance de contact métal-semi-conducteur doit être considérée avec insistance, dans laquelle la barrière Schottky joue un rôle important.

Les images actuelles de Si NW sous le biais d'échantillon de − 1,5 V avec le même diamètre de 190 nm mais des longueurs différentes de a 350 nm, b 600 nm, c 800 nm et d 960 nm, respectivement. Les profils actuels le long des lignes marquées dans a –d sont tracés en e , et f présente les courants moyens des nanofils (I av ) en fonction de la longueur des NW. Les courbes de profil en e sont décalés verticalement pour le guidage
Pour vérifier l'inférence ci-dessus, des courbes courant-tension (I-V) ont été enregistrées sur des NW de Si individuels pour étudier la barrière Schottky au niveau du contact pointe métallique/nanofil de Si. Des courbes I–V typiques sur les Si NW avec la même longueur de 350 nm mais des diamètres différents sont présentées sur la Fig. 6a et celles sur les Si NW avec le même diamètre de 190 nm mais des longueurs différentes sont affichées sur la Fig. 6b, respectivement. Toutes les courbes I-V présentent des courants plus importants dans la région de tension d'échantillonnage négative, conformément aux courbes I-V typiques avec le contact Schottky entre la pointe métallique et le semi-conducteur de type n. Comme les courbes I-V présentent de bonnes caractéristiques métal-semi-conducteur, cela indique que l'effet de la couche d'oxygène sur la conductance n'est pas grave et donc supposé minimal dans la discussion suivante. Pendant ce temps, les résultats montrent que les nanofils plus petits et plus courts présentent une conductance plus grande que les plus grands et plus longs, ce qui correspond bien aux résultats obtenus à partir des images actuelles. Pour les analyses quantitatives, un modèle d'émission thermoionique bien connu pour un contact métal-semi-conducteur est adopté [58, 59]. Dans ce modèle, les caractéristiques I-V d'un contact Schottky à semi-conducteur de type n en présence d'une résistance série peuvent être approximées comme [59] :
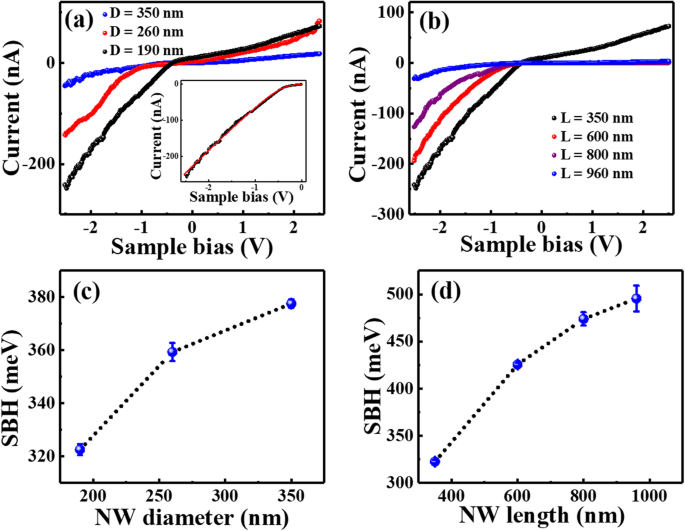
Courbes I-V typiques sur les Si NW avec la même longueur de 350 nm mais des diamètres différents (a ) et le même diamètre de 190 nm mais des longueurs différentes (b ). L'encart dans a montre un résultat d'ajustement typique de Si NWs avec un diamètre de 190 nm et une longueur de 350 nm. c et d représentent les hauteurs de barrière Schottky obtenues à partir des résultats d'ajustement en fonction du diamètre et de la longueur des NW, respectivement
$$ I={I}_S\left[\exp \left(\frac{q\left(VI{R}_S\right)}{\mathrm{n} kT}\right)-1\right], $ $ (1)où n est le facteur idéal et R S est la résistance série. Je S est le courant de saturation, qui peut être exprimé par :
$$ {I}_S=\mathrm{AA}\ast {T}^2\exp \left(-\frac{\varphi_B}{kT}\right), $$ (2)où A est la zone de contact, A* est la constante de Richardson et φ B est la hauteur de barrière Schottky (SBH) entre la pointe métallique et le nanofil de Si. Ainsi, SBH peut être obtenu avec la formule :
$$ {\varphi}_B=kT\ln \left(\frac{\mathrm{AA}\ast {T}^2}{I_{\mathrm{S}}}\right), $$ (3)Les courbes I-V de la Fig. 6 a et b peuvent être bien ajustées par l'équation. (1), et une ligne d'ajustement typique au niveau de la région avant est montrée dans l'encart de la figure 6a. Pour obtenir les valeurs SBH à partir du courant de saturation, la constante de Richardson effective A* est supposée être approximativement égale à celle du silicium massif, c'est-à-dire 112 A cm − 2 K − 2 pour le silicium de type n [59]. La zone de contact est supposée être 2 × 10 − 11 cm 2 en prenant le rayon de la pointe revêtu de Cr/Pt à 25 nm. Les valeurs SBH obtenues sont d'environ 322, 359 et 377 meV pour les Si NW avec la même longueur de 350 nm et des diamètres différents de 190, 260 et 350 nm, respectivement. Pour les Si NW avec le même diamètre de 190 nm et des longueurs différentes de 350, 600, 800 et 960 nm, les valeurs SBH sont de 322, 425, 473 et 495 meV, en conséquence. À titre de comparaison, une courbe I-V typique a été mesurée sur le même type de plaquette de silicium, comme indiqué dans le fichier supplémentaire 1 :figure S3 (a). Cela montre clairement que la conductance de la plaquette de Si est beaucoup plus petite que les NW produits. Detectable current could only be measured at high bias voltages (− 4 ~ − 10 V). After fitting the I–V curves with the above thermionic emission model (Additional file 1:Figure S3(b)), SBH value of 0.60 eV was obtained for bulk Si. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Mao et al. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
EFM Measurements on Single Si NWs
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)où C , V EFM , and V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ sample − φ tip )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)where Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
De l'éq. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ). As E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c and d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a et b are vertically shifted for guidance
Conclusion
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
Disponibilité des données et des matériaux
The datasets used for supporting the conclusion are included in the article and the supporting file.
Abréviations
- CAFM:
-
Conductive atomic force microscopy
- CPD:
-
Contact potential difference
- EFM:
-
Electrostatic force microscopy
- MACE:
-
Metal-assisted chemical etching
- NSL:
-
Nanosphere lithography
- PS:
-
Polystyrene spheres
- RIE:
-
Reactive ion etching
- SBH:
-
Schottky barrier height
- SEM :
-
Microscopie électronique à balayage
- Si NWs:
-
Si nanowires
- SPM:
-
Scanning probe microscopy
Nanomatériaux



