Dépôt en couche atomique de nano-films d'oxyde d'indium pour transistors à couche mince
Résumé
Dépôt de couche atomique (ALD) de In2 O3 nano-films a été étudié à l'aide de cyclopentadiényl indium (InCp) et de peroxyde d'hydrogène (H2 O2 ) comme précurseurs. L'In2 O3 les films peuvent être déposés préférentiellement à des températures relativement basses de 160 à 200 °C, présentant un taux de croissance stable de 1,4 à 1,5 /cycle. La rugosité de surface du film déposé augmente progressivement avec la température de dépôt, ce qui est attribué à la cristallisation améliorée du film à une température de dépôt plus élevée. Lorsque la température de dépôt augmente de 150 à 200 °C, la bande interdite optique (Eg ) du film déposé passe de 3,42 à 3,75 eV. De plus, avec l'augmentation de la température de dépôt, le rapport atomique de In à O dans le film tel que déposé se déplace progressivement vers celui de l'In2 stoechiométrique. O3 , et la teneur en carbone diminue également par degrés. Pour une température de dépôt de 200 °C, le film déposé présente un rapport In:O de 1:1,36 et aucune incorporation de carbone. En outre, de hautes performances In2 O3 transistors à couche mince avec un Al2 O3 diélectrique de grille ont été obtenus par post-recuit dans l'air à 300 °C pendant un temps approprié, démontrant une mobilité à effet de champ de 7,8 cm 2 /V⋅s, une oscillation sous le seuil de 0,32 V/déc et un rapport de courant marche/arrêt de 10 7 . Cela a été attribué à la passivation des lacunes d'oxygène dans le canal de l'appareil.
Contexte
Oxyde d'indium (In2 O3 ) est un semi-conducteur à oxyde métallique transparent, qui présente une large bande interdite d'environ 3,7 eV à température ambiante, une transparence élevée pour la lumière visible et une excellente stabilité chimique [1, 2]. Par conséquent, dans2 O3 a été étudiée pour diverses applications telles que les dispositifs photovoltaïques, les capteurs électrochimiques et les écrans plats [3,4,5]. Jusqu'à présent, plusieurs techniques de dépôt ont été développées pour préparer In2 O3 les films minces, y compris la pulvérisation [6, 7], le sol-gel [8, 9] et le dépôt chimique en phase vapeur (CVD) [10, 11]. Cependant, les techniques de pulvérisation cathodique et sol-gel souffrent généralement d'une mauvaise uniformité sur une grande surface ainsi que d'une composition élémentaire inexacte; la technique CVD nécessite généralement des températures de dépôt relativement élevées de> 300 °C. Ces inconvénients rendent difficile l'obtention d'un In2 uniforme O3 film avec un contrôle précis de l'épaisseur et de la composition à basse température de dépôt.
Ces dernières années, le dépôt de couche atomique (ALD) est devenu une approche prometteuse qui peut donner une excellente couverture des étapes, une contrôlabilité de l'épaisseur à l'échelle atomique, une bonne uniformité et une température de dépôt relativement basse. En conséquence, la croissance de In2 O3 couches minces a été exploré au moyen d'ALD avec différents précurseurs, dont InCl3 -H2 O [12], InCl3 -H2 O2 [13], InCp-O3 [14], InCp-O2 -H2 O [15], et In (CH3 )3 -H2 O [16]. Au niveau des précurseurs d'InCl3 -H2 O et InCl3 -H2 O2 , les températures de dépôt pour In2 O3 les films doivent être augmentés à ~ 300–500 °C [13] ; pendant ce temps, l'InCl3 le récipient doit être chauffé à 285 °C afin d'obtenir suffisamment d'InCl3 vapeur [15]. De plus, le sous-produit de HCl corrosif peut endommager l'équipement ALD et graver l'In2 déposé O3 film [17], et le taux de croissance de In2 O3 est aussi faible que 0,25-0,40 Å/cycle. Bien que d'autres précurseurs tels que TMIn-H2 O et TMIn-H2 O2 ont été adoptés pour ALD In2 O3 films, les températures de dépôt sont encore élevées (c'est-à-dire 200–450 °C) malgré des taux de croissance relativement élevés (1,3–2 /cycle) [18].
Dans ce travail, InCp et H2 O2 ont été proposés comme précurseurs de l'ALD In2 O3 couches minces, donc les In2 O3 des films minces ont été déposés avec succès à des températures plus basses, présentant un taux de croissance satisfaisant. De plus, les propriétés physiques et chimiques des films déposés ont été caractérisées. De plus, le In2 O3 transistors à couche mince (TFT) avec ALD Al2 O3 des diélectriques de grille ont été fabriqués, démontrant de bonnes performances électriques, telles qu'une mobilité à effet de champ de 7,8 cm 2 V −1 s −1 , et un rapport de courant marche/arrêt de 10 7 etc.
Expérimental
Des plaquettes de Si (100) ont été nettoyées en utilisant le procédé standard de Radio Corporation of America, servant de substrats initiaux. Dans2 O3 des couches minces ont été déposées sur les substrats de Si (100) pré-nettoyés à l'aide de l'équipement ALD (Wuxi MNT Micro Nanotech Co., LTD, Chine) à des températures relativement basses de 150 à 210 °C, où les températures d'InCp (Fornano Electronic Technology Co., LTD, Chine, impureté :99,999 %) et H2 O2 Les précurseurs (solution aqueuse à 30 %) ont été maintenus à 130 et 50 °C, respectivement. L'azote gazeux a été utilisé comme gaz de purge. Démontrer la fonction de l'ALD In2 O3 couche mince, le In2 O3 Les TFT de canaux basés sur les canaux ont été fabriqués selon les processus suivants. Tout d'abord, un Al2 38 nm O3 Le film diélectrique de grille a été développé sur un substrat Si (100) de type p pré-nettoyé (< 0,0015 Ω·cm) à 200 °C par ALD en utilisant du triméthylaluminium et H2 O, et un tel substrat de silicium à faible résistivité a servi de grille arrière. Ensuite, un In2 20 nm O3 couche de canal a été développée sur le Al2 O3 filmer à 160°C. Des contacts source/drain d'empilements Ti/Au (30 nm/70 nm) ont été formés à leur tour par lithographie optique, évaporation par faisceau d'électrons et un processus de lift-off. Enfin, les dispositifs fabriqués ont été recuits à 300 °C dans l'air pendant différentes durées.
La cristallinité, la morphologie de la surface, la composition élémentaire, le coefficient d'absorption et l'épaisseur de l'In2 O3 Les films ont été caractérisés par diffraction des rayons X (XRD) (Bruker D8 Discover), microscopie à force atomique (AFM) (Bruker Icon), spectroscopie photoélectronique à rayons X (XPS) (Kratos Axis Ultra DLD), spectroscopie ultraviolet-visible (UV- VIS) et ellipsomètre (Sopra GES-SE, France), respectivement. Les mesures électriques des appareils ont été effectuées à l'aide d'un analyseur de paramètres à semi-conducteur (B1500A, Agilent Technologies, Japon) avec station de sonde Cascade dans l'air ambiant à température ambiante.
Résultats et discussion
La figure 1a montre le taux de croissance de l'In2 O3 film en fonction de la température du substrat. Il a été constaté qu'un taux de croissance stable d'environ 1,46 /cycle est atteint dans la plage de 160 à 200 °C, révélant un taux de croissance rapide et une fenêtre de température bien définie pour ALD In2 O3 cinéma. Lorsque la température du substrat a été réduite à 150 °C ou augmentée à 210 °C, le taux de croissance résultant est devenu plus important [19, 20]. La première est attribuée à la condensation d'InCp sur le substrat, tandis que la seconde est due à la décomposition thermique d'InCp à une température plus élevée. De plus, l'évolution de l'In2 déposé O3 l'épaisseur du film a été évaluée en fonction des cycles ALD, comme le montre la figure 1b. Il est clair que l'In2 O3 l'épaisseur du film augmente linéairement avec le nombre de cycles de dépôt, indiquant une croissance assez uniforme.

un Taux de croissance de l'ALD In2 O3 film sur le substrat Si en fonction de la température du substrat, et b dépendance de l'In2 O3 épaisseur du film sur le nombre de cycles ALD à 160 °C
Pour observer l'évolution de l'In2 O3 texture du film avec température de dépôt, les motifs XRD de l'In2 O3 des films déposés à différentes températures sont présentés sur la figure 2. Lorsque la température de dépôt ne dépasse pas 160 °C, aucun pic de diffraction ne peut être observé. Cela indique que le dépôt In2 O3 les films à basse température sont amorphes. Lorsque la température de dépôt augmente jusqu'à 170 °C, des pics de diffraction commencent à apparaître. De plus, avec l'augmentation progressive de la température de dépôt jusqu'à 210 °C, les intensités des pics de diffraction augmentent considérablement, comme le montrent généralement les pics à 2θ =30,3° et 35,4°. Cela indique que la cristallinité et la taille des grains de l'In2 tel que déposé O3 film sont améliorés progressivement avec l'augmentation de la température de dépôt. La figure 3 montre les morphologies de surface du représentant In2 O3 films déposés à différentes températures. On constate que la surface du film devient de plus en plus rugueuse avec l'augmentation de la température de dépôt, c'est-à-dire que la rugosité résultante de la moyenne quadratique (RMS) augmente de 0,36 à 1,15 nm avec l'augmentation de la température de dépôt de 160 à 210 °C. Cela devrait être lié à la cristallinité de l'In2 O3 film. En termes de température de dépôt de 160 °C, l'In2 déposé O3 le film est amorphe et présente une surface très lisse. Lorsque la température de dépôt atteint 180°C, le film déposé devient polycristallin. Cela signifie que le film résultant contient beaucoup de grains cristallins et que la taille des grains devient de plus en plus grande avec l'augmentation de la température de dépôt, comme le montre la figure 2. Ceci est en bon accord avec notre observation selon laquelle la taille des monticules à la surface du film augmenter progressivement avec l'augmentation de la température de dépôt, ce qui entraîne une augmentation de la valeur RMS.
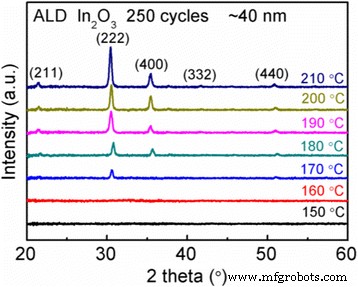
Diagrammes de diffraction des rayons X de l'In2 O3 films déposés à différentes températures pendant 250 cycles

Les images AFM de l'In2 O3 films déposés à différentes températures :a 160 °C, b 180 °C, c 200 °C et d 210 °C. Les cycles de dépôt ont été fixés à 250 pour chaque film
La figure 4 montre les spectres C 1 s, In 3d et O1s XPS haute résolution de l'In2 O3 films déposés à différentes températures. Concernant les spectres C 1 s XPS montrés sur la figure 4a, le film déposé à 160 °C présente un pic à 289,8 eV, qui devrait correspondre à C-O [21]. Lorsque la température de dépôt est augmentée à 180 °C, le pic devient beaucoup plus faible. De plus, en termes de température de dépôt de 200 °C, le pic C 1 s disparaît. Ainsi, il est indiqué que plus la température de dépôt est élevée, moins il y a d'impureté de C dans l'In2 déposé O3 film. La figure 4b représente les spectres XPS In 3d de l'In2 O3 films, démontrant clairement des pics gaussiens à un doublet à 444,7 et 452,3 eV, qui sont associés à In 3d5/2 et en 3d5/2 niveaux de base pour In2 O3 [22, 23]. Les spectres O 1 s XPS sont représentés sur la figure 4c. On constate que le spectre O 1 s pour chaque échantillon peut être bien séparé en trois pics, qui sont respectivement situés à 529,8, 531,0 et 532,0 eV. Ces pics correspondent à O 2− les ions liés au métal (O1), les lacunes d'oxygène (O2) et -OH/CO (O3), respectivement [24, 25]. Lorsque la température de dépôt augmente de 160 à 200 °C, le pourcentage relatif de O1 augmente de 76 à 92 % ; et le pourcentage relatif d'O2 diminue progressivement de 16 à 4%. De plus, le pourcentage relatif d'O3 présente également une tendance à la baisse. Ces résultats indiquent qu'une température de dépôt plus élevée est bénéfique pour réduire la concentration des lacunes d'oxygène dans le film déposé ainsi que les groupes hydroxyle et les liaisons C-0. De plus, les compositions élémentaires de l'In2 O3 les films déposés à différentes températures sont répertoriés dans le tableau 1. Il est intéressant de noter que le rapport atomique In/O dans le film déposé diminue par degrés avec l'augmentation de la température de dépôt. Cependant, même pour le pur In2 O3 film déposé à 200 °C, le rapport atomique (1:1,36) de l'In/O est encore supérieur à celui (1:1,5) de l'In2 stoechiométrique O3 . Cela révèle que l'ALD In2 O3 le film est généralement riche en lacunes d'oxygène.

Haute résolution a C 1s, b En 3D, et c Spectres XPS O 1 s de l'In2 O3 films déposés respectivement à 160, 180 et 200 °C. Pour éliminer les contaminants de surface accidentels, tous les échantillons ont été gravés avec un bombardement d'ions Ar in situ pendant 6 min avant la collecte du signal
La figure 5a montre la variation de (αhν) 2 en fonction de l'énergie des photons pour le In2 tel que déposé O3 films à différentes températures de dépôt. La bande interdite optique (Eg ) de l'In2 O3 film peut être déterminé par la relation de Tauc :αhν = A(hν-Eg ) n [26], où α est le coefficient d'absorption, A est une constante, h est la constante de Plank, ν est la fréquence, et l'exposant n caractérise la nature de la transition de bande. Ici, n = 1/2, indiquant que In2 O3 est un semi-conducteur avec une transition directement autorisée. E g est extrait en extrapolant la portion de ligne droite au biais d'énergie à α = 0. Le E extrait g pour le In2 O3 le film est montré sur la figure 5b. On voit que E g augmente de 3,42 à 3,75 eV avec l'élévation de la température de dépôt de 150 à 200 °C. L'augmentation de l'E g à des températures de dépôt plus élevées, cela pourrait résulter de la réduction des lacunes d'oxygène et de l'impureté C dans le film déposé. En fait, d'autres chercheurs ont également signalé que lorsque de nombreuses lacunes d'oxygène existaient dans le ZnO, les états d'impuretés devenaient plus délocalisés et se chevauchaient avec le bord de la bande de valence, entraînant ainsi un rétrécissement de la bande interdite [27]. De plus, la cristallinité progressivement améliorée en fonction de la température de dépôt pourrait influencer la bande interdite optique de l'In2 O3 film. Cela peut s'expliquer comme suit. Au fur et à mesure que la température de dépôt augmente, la taille des grains de l'In2 déposé O3 film augmente, comme le montre la figure 2. Cela conduit donc à une diminution de la densité des joints de grains dans le film. Puisque les électrons sont facilement piégés dans les joints de grains, le nombre d'électrons libres devrait augmenter dans le In2 O3 film avec moins de joints de grains [28, 29]. Par conséquent, une telle concentration d'électrons accrue entraîne une plus grande bande interdite optique en raison du décalage de Burstein-Moss [30].

un Tracé de (αhν) 2 vs énergie photonique pour l'In2 O3 films déposés à différentes températures; b dépendance de la bande interdite extraite (Eg ) de In2 O3 sur la température de dépôt
Démontrer la fonction de l'ALD In2 O3 film faisant office de chaîne de TFT, l'In2 O3 -TFT basés sur des canaux avec Al2 déposé sur la couche atomique O3 des diélectriques de grille ont été fabriqués. La figure 6a montre les caractéristiques de transfert de In2 O3 TFT. Il s'avère que le dispositif tel que fabriqué ne présente pas les caractéristiques de commutation typiques des transistors à effet de champ, mais un type de conducteur entre la source et le drain. Cela devrait être attribué à l'existence de nombreuses lacunes en oxygène dans l'In2 O3 canal parce que les lacunes d'oxygène peuvent fournir des électrons libres. Par conséquent, dans un souci de réduire la concentration des lacunes d'oxygène dans l'In2 O3 canal, un post-recuit sous air a été réalisé à 300°C. Il est clair que l'In2 O3 Le TFT présente un comportement de commutation typique après un recuit de 2 h. Cela indique que le post-recuit à l'air peut améliorer considérablement les performances de l'appareil. De plus, à mesure que le temps de recuit augmente progressivement jusqu'à 10 h, la tension de seuil (Vth ) du TFT se déplace dans le sens d'un biais positif, et l'oscillation sous le seuil (SS) s'améliore petit à petit. Cependant, lorsque le temps de recuit augmente à 11 h, les performances de l'appareil commencent à dégénérer. Il est à noter que de l'hydrogène peut être incorporé dans le film au cours du processus de fabrication, agissant comme un piège à électrons en formant des liaisons -OH dans le canal ou à l'interface entre le canal et le diélectrique [31]. Ces pièges à électrons entraînent peut-être la dégradation de la SS. Après recuit sous air, les liaisons OH ont été réduites par incorporation de O2 molécules [32]. Cela pourrait conduire à une diminution de la densité des pièges, améliorant ainsi la SS du dispositif. En terme de recuit sous air de 10 h, le In2 O3 TFT présente une mobilité à effet de champ (μEF ) de 7,8 cm 2 V −1 s −1 , un Vème de -3,7 V, un SS de 0,32 V/déc et un rapport de courant marche/arrêt (Ion /Ioff ) sur 10 7 . Les caractéristiques de sortie correspondantes sont également présentées sur la figure 6b, démontrant des comportements clairs de pincement et de saturation de courant sous diverses tensions de grille positives. De plus, les courbes de sortie indiquent également un n -type d'amélioration du mode. A titre de comparaison, le tableau 2 résume les caractéristiques de l'ALD In2 rapportée O3 films et TFT de différents groupes de recherche [33,34,35,36,37]. Il est démontré que notre In2 O3 le film montre un taux de croissance supérieur à une température relativement basse, et le dispositif fabriqué présente également un petit SS. Cependant, les performances générales de l'appareil ne sont pas aussi parfaites, ce qui pourrait être amélioré via certaines optimisations de processus et de structure de l'appareil.
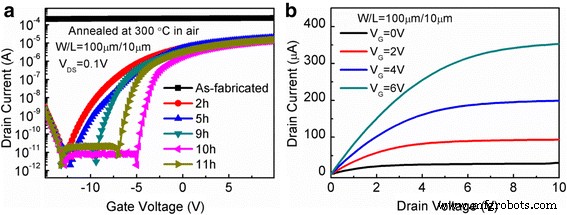
un Caractéristiques de transfert de l'In2 O3 TFT recuits à 300 °C dans l'air pendant différentes durées ; b Caractéristiques de sortie du In2 O3 TFT recuit à 300 °C sous air pendant 10 h
Pour bien comprendre l'influence du post-recuit à l'air sur la composition de l'In2 O3 canal, le In2 O3 les films ont été recuits à 300 °C pendant différentes durées, puis ont été analysés au moyen de XPS. Le tableau 3 répertorie les pourcentages élémentaires de divers films recuits. Au fur et à mesure que le temps de recuit passe de 2 à 11 h, le rapport atomique In:O diminue de 1:1,22 à 1:1,48, se rapprochant progressivement de celui (1:1,5) de l'In2 stoechiométrique. O3 . Cela confirme en outre que l'augmentation du temps de recuit dans l'air a effectivement réduit la densité des lacunes d'oxygène dans l'In2 O3 film. Par conséquent, l'amélioration des performances de l'In2 O3 La TFT devrait être principalement attribuée à la passivation des lacunes d'oxygène qui pourraient être localisées dans le canal massif et/ou l'interface entre le canal et le diélectrique [25]. Cependant, le recuit excessif a dégradé les performances du dispositif, comme l'a révélé un recuit de 11 h. Cela pourrait être attribué au changement de cristallisation de l'In2 O3 couche de canal ainsi qu'une éventuelle oxydation des électrodes de Ti lors d'un post-recuit superflu à l'air. Ainsi, un temps de recuit approprié est nécessaire pour obtenir de bonnes performances de l'In2 O3 TFT.
Conclusions
La croissance rapide de l'ALD de l'In2 O3 films a été réalisé à des températures relativement basses (160-200 °C) avec l'InCp et le H2 O2 précurseurs, présentant un taux de croissance uniforme de 1,46 Å/cycle. Au fur et à mesure que la température de dépôt augmentait, la cristallisation du film déposé s'améliorait progressivement. Pendant ce temps, les lacunes d'oxygène et les impuretés de carbone dans les films déposés ont également été réduites de manière significative. Cela a donc conduit à une augmentation de la E g d'In2 O3 . De plus, avec l'ALD In2 O3 couche canal, les TFT avec un ALD Al2 O3 diélectrique ont été fabriqués. Comme le temps de post-recuit à l'air a été allongé, les performances électriques de l'In2 O3 Le TFT a été nettement amélioré jusqu'à 10 h de recuit. Ceci est principalement dû à la passivation des lacunes d'oxygène situées dans le canal massif et/ou à l'interface entre le canal et le diélectrique après recuit sous air. En termes de recuit de 10 h, l'appareil a montré de bonnes performances telles qu'une mobilité à effet de champ de 7,8 cm 2 /V⋅s, une oscillation sous le seuil de 0,32 V/déc et un rapport de courant marche/arrêt de 10 7 . En termes de température de dépôt de 200 °C, le film déposé présente un rapport In:O de 1:1,36 sans carbone détectable, révélant ainsi l'existence de lacunes d'oxygène dans le film tel que déposé.
Nanomatériaux
- Espaceurs d'air pour puces 10 nm
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Optimisation des couches minces hautement réfléchissantes pour les micro-LED plein angle
- Effet de différents liants sur les performances électrochimiques des anodes à oxyde métallique pour les batteries lithium-ion
- Nanopétales d'oxyde de nickel mésoporeux (NiO) pour la détection ultrasensible du glucose
- Anode à film nanocristallin Fe2O3 préparée par dépôt laser pulsé pour batteries lithium-ion
- Modulateur d'électro-absorption à polarisation de plasmon de surface insensible à la polarisation basé sur l'oxyde d'étain et d'indium Epsilon-Near-Zero
- Développement d'un biocomposite électrofilé de chitosan-oxyde de polyéthylène/fibrinogène pour des applications potentielles de cicatrisation
- Réseau d'antennes haute fréquence à couche mince pour les communications sans fil



