Mémoire résistive ZrO2/ZrO2 − x /ZrO2 sans conformité avec comportement de commutation multi-états interfacial contrôlable
Résumé
Une transformation contrôlable du mode de commutation interfacial au mode de commutation filamentaire est présentée sur un ZrO2 /ZrO2 − x /ZrO2 mémoire résistive à trois couches. Les deux modes de commutation sont étudiés avec des mécanismes de commutation et de transformation possibles proposés. Modulation de résistivité du ZrO2 − x Il est proposé que la couche soit responsable de la commutation dans le mode de commutation interfacial par injection/rétraction des ions oxygène. La commutation est sans conformité grâce à la résistance série intrinsèque des filaments formés dans le ZrO2 couches. En réglant le RESET tensions, une mémoire multi-états contrôlable et stable peut être obtenue, ce qui indique clairement la capacité de développer la mémoire multi-états haute performance de nouvelle génération.
Contexte
Le développement d'une mémoire non volatile plus dense, plus rapide et moins énergivore est d'une grande importance pour les innovations dans les technologies de l'information modernes [1, 2]. Alors que de nombreux prétendants sont devenus la prochaine génération de dispositifs de mémoire, la mémoire à accès aléatoire résistive (RRAM) basée sur des oxydes métalliques est l'un des candidats les plus prometteurs pour ses avantages de vitesse élevée, d'évolutivité élevée, de faible consommation d'énergie et de bonne compatibilité avec le Processus CMOS [3]. Bien que le mécanisme de commutation détaillé de la mémoire résistive reste incertain, il est largement admis que la migration des lacunes d'oxygène sous un champ électrique appliqué joue un rôle clé dans le comportement de commutation [4]. Selon le mécanisme de commutation, la commutation résistive peut être classée en modes filamentaire et interfacial (homogène). Le mode filamentaire est obtenu par la formation et la rupture de filament(s) d'oxygène vacant entre deux électrodes. D'autre part, la commutation de résistance dans le mode interfacial est contrôlée par la répartition des lacunes d'oxygène le long d'une interface. Le courant est localisé dans le(s) filament(s) conducteur(s) en mode filamentaire, tandis qu'il est réparti de manière homogène sur toute la zone du dispositif en mode interfacial [5, 6]. Le mode de commutation résistif caractérisé dans un dispositif mémoire dépend fortement de sa structure. En général, l'exposition du mode interfacial dans le système à base d'oxyde métallique repose sur l'existence d'un profil de gradient d'oxygène le long de l'axe vertical [7, 8]. Récemment, la coexistence des deux modes dans un système matériel a également été rapportée [9,10,11]. En modulant les paramètres de mesure, une transformation entre ces deux modes peut également être réalisée [12]. Cependant, la commutation dans le mode interfacial est généralement attribuée au changement de hauteur de barrière Schottky induit par les processus d'accumulation et d'épuisement des porteurs à travers des états défectueux à l'interface électrode/couche fonctionnelle [7, 9,10,11,12,13, 14,15,16,17,18] plutôt que l'effet de la migration des lacunes d'oxygène aux interfaces oxyde/oxyde.
Au cours des dernières années, d'énormes progrès ont été réalisés pour augmenter la densité de stockage de la RRAM. Outre les efforts visant à réduire les dimensions physiques de la cellule mémoire, l'utilisation des états de résistance intermédiaire (IRS) entre l'état à haute résistance (HRS) et l'état à faible résistance (LRS) pour réaliser le stockage multi-états dans une cellule mémoire est devenue une solution alternative populaire [19, 20]. Ce comportement de stockage multi-états est important pour le stockage haute densité et les dispositifs synaptiques électroniques à base d'oxyde [21,22,23]. Le stockage multi-états en mode de commutation filamentaire est réalisé en contrôlant la largeur et/ou le nombre de filaments conducteurs avec différents RESET tensions ou SET conformités actuelles. Une variété d'oxydes métalliques, y compris TiOx , ZnO, SiOx et HfO2 , ont démontré un comportement multi-états dans les périphériques RRAM [24,25,26,27]. Le stockage multi-états en mode de commutation interfaciale a également été rapporté où l'ajustement des largeurs des régions défectueuses en oxygène a été proposé comme étant responsable de ce comportement [12, 28]. Cependant, les deux modes de commutation nécessitent la conformité actuelle dans le SET processus pour protéger l'appareil contre les pannes et, dans le cas d'une commutation filamentaire, pour obtenir des états de résistance plus faibles. Ces exigences pourraient entraîner une complexité dans la conception des circuits RRAM. Une mémoire résistive sans conformité avec un comportement de commutation multi-états contrôlable pourrait donc être avantageuse car elle minimise le dépassement de courant pendant la commutation et a le potentiel de réduire considérablement le coût de fabrication [29, 30].
Récemment, l'utilisation de ZrO2 car la couche de commutation active a attiré l'attention en raison de sa stabilité thermodynamique élevée, de sa composition simple et de sa compatibilité avec les processus semi-conducteurs [31,32,33]. De plus, l'insertion d'un calque extraterrestre dans le ZrO2 film pour produire une hétérostructure d'oxyde s'est avéré être une méthode efficace pour améliorer les caractéristiques de commutation dans ZrO2 dispositifs basés sur [34, 35]. Dans ce travail, nous démontrons un ZrO2 /ZrO2 − x /ZrO2 -à base de mémoire résistive dans laquelle un ZrO2 − x non stoechiométrique couche est formée dans le ZrO2 couche en insérant une couche de Zr. Les modes interfacial et filamentaire sont observés, et une transformation contrôlable de l'interfacial au filamentaire peut être réalisée. Les caractéristiques de commutation et les performances pour les deux modes sont étudiées. Alors que l'interface oxyde/électrode a un effet sur les comportements de commutation dans le mode filamentaire, la commutation dans le mode interfacial reposait fortement sur les interfaces oxyde/oxyde dans les structures à trois couches. Plus important encore, la commutation résistive en mode interfacial bénéficie d'une propriété intégrée sans conformité ainsi que d'un comportement de stockage multi-états sous différents RESET tensions.
Méthodes
ZrO2 des films minces ont été préparés par pulvérisation cathodique magnétron assistée par plasma moyenne fréquence (Leybold Optics HELIOS Pro XL) à température ambiante. Dans ce processus, le substrat tournait à une vitesse de 180 tr/min pour assurer un dépôt uniforme. Lors de chaque rotation, une fine couche de Zr a d'abord été déposée à partir d'une cible métallique de Zr (pureté 99,99%) en utilisant une puissance de 2000 W dans une atmosphère d'Ar. Ce film mince a été transformé en une couche d'oxyde en faisant passer le substrat sous le O2 plasma de la source RF. Le O2 le débit peut être ajusté pour produire ZrOx films avec des compositions différentes. Les propriétés de composition des films déposés ont été étudiées à l'aide de rayons X à dispersion d'énergie (EDX) où un microscope Zeiss EVO LS 25 équipé d'un détecteur de rayons X Oxford INCA x-act a été utilisé. Des films d'une grande épaisseur de 1 µm ont été déposés directement sur des plaquettes de Si pour minimiser l'influence du substrat. Les diagrammes de diffraction des rayons X (XRD) ont été collectés en incidence rasante (θ = 1°) à l'aide d'un diffractomètre Rigaku Smartlab avec un Cu–K de 9 kWα la source. Les données de spectroscopie photoélectronique à rayons X (XPS) ont été obtenues à l'aide d'un système de sonde thermoscientifique thêta avec Al–Kα rayonnement (énergie photonique = 1486.6 eV). Le profil de profondeur XPS a été réalisé en utilisant un canon à ions Ar à une tension de faisceau de 3 kV sur une zone de trame de 2 x 2 mm. Des échantillons de microscopie électronique à transmission (MET) ont été préparés en utilisant un polissage mécanique conventionnel suivi d'un broyage ionique jusqu'à transparence électronique en utilisant Ar+ à 6 keV. Une dernière étape de broyage à basse énergie a été réalisée à 500 eV. Afin de minimiser les dommages de surface, la structure et la morphologie des échantillons ont été analysées à l'aide d'un MET JEOL 2100 équipé de LaB6 et JEOL ARM200F TEM/scanning TEM (STEM) avec un canon Schottky fonctionnant tous deux à 200 kV. La mesure STEM en champ sombre annulaire (ADF) a été réalisée dans l'ARM200F, avec des correcteurs de sonde et d'aberration d'image CEOS. Les images ADF-STEM ont été obtenues à l'aide d'un détecteur de champ annulaire JEOL avec un courant de sonde d'environ 23 pA, un demi-angle de convergence de ∼25 mrad et un angle interne de 45 à 50 mrad. Un X-Max N d'Oxford Instruments Un détecteur de dérive au silicium (SSD) sans fenêtre 100TLE a été utilisé pour effectuer l'analyse STEM-EDX.
Le comportement de commutation résistif du tri-couche ZrO2 /ZrO2 − x /ZrO2 le film a été étudié en tant que mémoire. Un film TiN de 200 nm d'épaisseur a été pulvérisé réactivement (cible Ti dans un N2 atmosphère) sur le SiO2 couche pour former l'électrode inférieure. Cela a été suivi d'une pulvérisation réactive d'un deuxième SiO2 couche (cible de Si dans un O2 atmosphère). Cette couche de SiO2 a été modelé pour former des zones de dispositif actives par photolithographie et gravure ionique réactive. Par la suite, ZrO2 /ZrO2 − x /ZrO2 Des tricouches (20 nm/5 nm/20 nm) ont été déposées pour former la couche de commutation. La structure tri-couche a été obtenue en arrêtant le plasma d'oxygène pendant le ZrO2 croissance. ZrO2 couche est réalisée sous un O2 débit de 20 sccm tandis que le ZrO2 − x couche est obtenue en éteignant le O2 débit pendant 20 s. Un ZrO2 identique /ZrO2 − x /ZrO2 tri-couche a également été déposée sur substrat Si pour la caractérisation XRD et XPS. Enfin, une couche de TiN de 200 nm a été pulvérisée et modelée sur la tricouche pour former l'électrode supérieure. Toutes les mesures électriques ont été effectuées avec un système de caractérisation des semi-conducteurs Keithley 4200. Pendant les mesures, la polarisation de la tension de programmation a été appliquée à l'électrode supérieure, tout en maintenant l'électrode inférieure à la terre. Les contacts sonde/point avec les électrodes supérieure et inférieure des dispositifs ont été réalisés à l'aide d'une paire d'aiguilles de sonde Wentworth, en utilisant un sondeur semi-automatique AVT 702 des laboratoires Wentworth. Les mesures de balayage de tension CC ont été effectuées à un taux constant de 0,5 V/s.
Résultats et discussion
Les propriétés de la structure tricouche ont d'abord été étudiées par XRD. La figure 1 représente le motif XRD des trois couches telles que déposées (rouge) qui présente deux pics positionnés à 28,2° et 29,8°. Ces deux pics peuvent être attribués au pic -111 de la monoclinique ZrO2 phase et le pic 101 du tétragonal ZrO2 phase, respectivement, indiquant l'existence de deux phases. Caractérisations EDX et XRD réalisées sur un seul ZrO x couches avec des compositions différentes (montrées dans le fichier supplémentaire 1 :Figure S1 et S2) révèlent que la stoechiométrie ZrO2 affiche la phase monoclinique (bleu) tandis que la phase tétragonale (vert) a été détectée à partir du ZrO2 − x pauvre en oxygène couche. Aucun pic XRD de Zr métallique (rose) n'a été observé dans le motif XRD à trois couches. Ceci suggère la coexistence des deux ZrO2 stoechiométriques et ZrO2 − x pauvre en oxygène couche dans la structure tricouche et la couche de Zr incrustée a été oxydée.
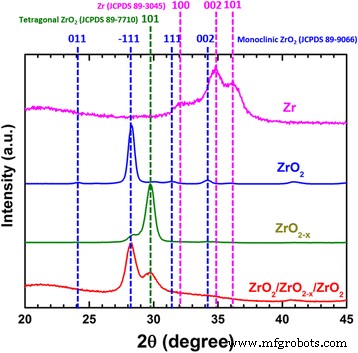
Modèles XRD du ZrO2 tel que déposé /ZrO2 − x /ZrO2 structure à trois couches (rouge ), ZrO2-x pauvre en oxygène couche (vert ), stoechiométrique ZrO2 couche (bleu ) et une couche de Zr métallique pur (rose )
Les figures 2a, b présentent les résultats XPS des profils de pics Zr 3d et O 1s sur un temps de gravure de 800 s. Deux pics positionnés à env. 182,3 et 184,5 eV peuvent être attribués au Zr 4+ entièrement oxydé [36, 37], qui dominent les spectres Zr jusqu'à un temps de gravure d'env. 300 s. Une nette intensité améliorée de deux pics positionnés à env. 178,3 et 180,5 eV peuvent ensuite être observés entre le temps de gravure de 300 à 400 s; cela s'accompagne également de la réduction de O 2− intensité maximale à env. 530,0 eV. Il a été suggéré que ces deux pics de Zr 3d sont associés au Zr 0 métallique ou non oxydé état [36]. Cela indique le ZrO2 − x pauvre en oxygène couche se trouve au milieu de cette structure à trois couches. Après 400 s de temps de gravure, le Zr 4+ les pics reprennent leur dominance et l'intensité de l'O 2− le pic est revenu à la normale. La concentration atomique le long du profil de profondeur de la figure 2c confirme en outre l'oxydation de la couche de Zr incrustée en ZrO2 − x non stoechiométrique. . Il convient également de mentionner que les gradients de composition entre ZrO2 et ZrO2 − x des interfaces ont également été observées, ce qui est suggéré pour faciliter la formation d'un comportement de commutation interfaciale [8]. Compte tenu à la fois des résultats XRD et XPS, il est raisonnable de croire que la phase monoclinique détectée dans le XRD provient des deux ZrO2 stoechiométriques couches. Le ZrO2 − x pris en sandwich, pauvre en oxygène couche, d'autre part, contribue à la phase tétragonale bien que certaines traces de régions amorphes ne peuvent être exclues.
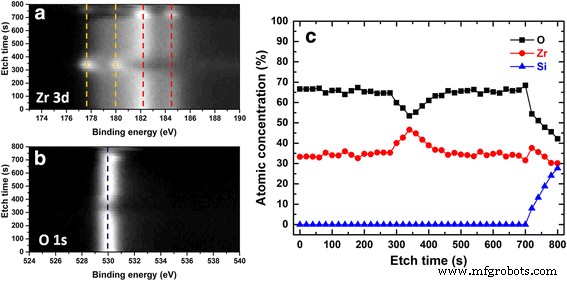
Spectres XPS de a Zr 3d et b O 1s pour le ZrO2 /ZrO2 − x /ZrO2 structure tricouche sur un temps de gravure de 700 s. c Profil de profondeur XPS du ZrO2 /ZrO2 − x /ZrO2 structure à trois couches
La mesure MET confirme en outre la structure tricouche avec le ZrO2 − x pauvre en oxygène couche clairement observée comme le montre la figure 3a. De plus, une autre couche interfaciale entre le ZrO2 couche et électrode TiN inférieure est également visible. Le profil EDX correspondant est illustré sur la figure 3b dans laquelle l'inter-diffusion des atomes de Ti, O, N et Zr est évidente dans les 10 premiers nm. De plus, le rapport O:Zr (carré vide) beaucoup plus élevé dans les 5 premiers nm confirme l'existence d'un TiO x N y couche interfaciale entre le ZrO2 et l'électrode inférieure TiN. En effet, comme ZrO2 est pulvérisé immédiatement après TiN, le O2 le plasma réagira avec la surface TiN pour former un TiO x N y couche lorsque le ZrO2 la couche est encore très fine. Formation similaire de TiO x interfacial N y couche a également été signalée [38, 39].
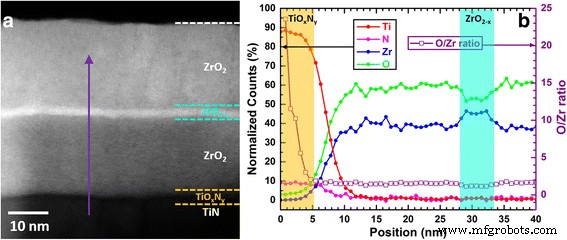
un Image ADF-STEM de la section transversale de l'échantillon et b Profils de lignes élémentaires STEM-EDX du TiN/ZrO2 /ZrO2 − x /ZrO2 structure
Sur la base des résultats de la caractérisation, le schéma du ZrO2 /ZrO2 − x /ZrO2 la mémoire à trois couches est représentée sur la figure 4a. Le dispositif vierge est mesuré pour être dans l'état de haute résistance comme le montre la figure 4b. Une grande tension de formation négative (I CC = 1 mA) est nécessaire pour induire le claquage diélectrique doux et initier la commutation. Assez inhabituel, cela est associé à un processus de formation en deux étapes, ce qui suggère la formation consécutive de deux filaments dans les deux ZrO2 couches et l'appareil est SET dans un état de faible résistance. Une tension positive a ensuite été appliquée à RESET l'appareil dans le HRS comme le montre la figure 4c. Notamment, ce RESET Le processus est caractérisé par une diminution progressive et continue du courant, caractéristique typique de la commutation résistive interfaciale. Le SET processus en appliquant une polarisation de tension négative montre également le comportement similaire, suggérant que la commutation résistive interfaciale est le mode de commutation dominant. Le comportement de commutation interfaciale est en outre prouvé par la dépendance de la zone du courant à la fois dans HRS et LRS (montré sur la figure 4d). Les deux courants augmentent à mesure que la taille de l'électrode augmente, indiquant que la conduction du courant n'est pas filamenteuse. L'augmentation du courant n'est cependant pas entièrement proportionnelle à la zone. Cela pourrait s'expliquer par la modulation moins efficace de la résistivité à des cellules de plus grande taille pendant la commutation interfaciale en raison de la plus grande quantité de joints de grains et de courant de fuite [12]. Un comportement similaire a également été rapporté dans d'autres dispositifs de commutation résistifs interfaciaux bicouches [8, 12]. Le SET processus démontre un comportement d'auto-conformité. Ceci est bénéfique pour l'application en mémoire résistive car il minimise le dépassement de courant pendant la commutation et a le potentiel de réduire considérablement le coût de fabrication [29, 30].
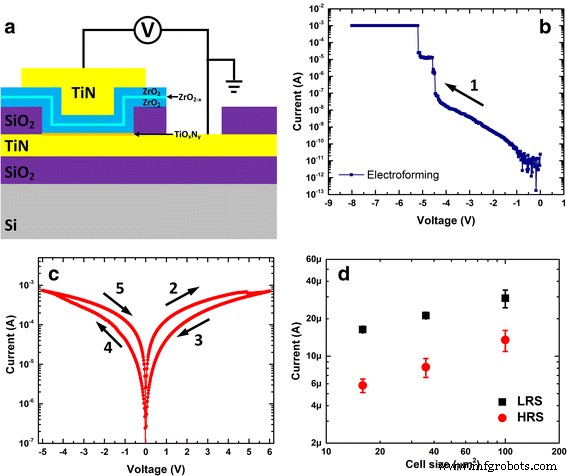
un Schéma du tri-couche TiN/ZrO2 /ZrO2 − x /ZrO2 /Mémoire TiN. b I–V caractéristiques du procédé d'électroformage pour le TiN/ZrO2 /ZrO2 − x /ZrO2 /Périphérique TiN. c I–V caractéristiques de la commutation interfaciale après formage. d Courant en fonction de la taille de l'appareil pour les HRS/LRS en mode de commutation interfacial
La transformation du mode de commutation interfaciale au mode de commutation filamentaire peut être déclenchée par une deuxième étape de formation comme le montre la figure 5a. Un biais plus négatif a été appliqué sur l'appareil à HRS avec une conformité de courant de 20 mA. Cela conduit à une augmentation brutale du courant à env. -8 V, et l'appareil reste par la suite à un état de résistance beaucoup plus faible. Après la RESET processus avec une polarisation positive, le mode de commutation de l'appareil a été complètement transformé en filamentaire, caractérisé par la nette SET (contrôle courant) et RESET transitions. La figure 5b montre la distribution de probabilité cumulée des LRS et HRS des modes de commutation interfacial et filamentaire dans lesquels des différences distinctives peuvent être observées entre ces deux ensembles d'états de résistance, indiquant que l'appareil a été commuté dans différents modes. Pour faire la lumière sur le mécanisme de conduction des deux modes de commutation, le logarithmique I-V tracés de courbes et ajustements linéaires du SET les processus sont présentés. Le I–V la courbe à HRS en mode interfacial suit un comportement ohmique à basse tension avec l'ajout d'un terme quadratique à plus haute tension, c'est-à-dire, I ∝ aV + bV 2 , qui est la caractéristique typique du modèle à courant limité à charge d'espace (SCLC) comme le montre la figure 5c [40,41,42]. Des observations similaires de ce mécanisme de SCLC ont également été rapportées sur d'autres dispositifs de mémoire résistive interfaciale [8, 12]. D'autre part, le logarithmique I–V courbes du SET Le processus de commutation filamentaire après la transformation est illustré à la figure 5d. La courbe suggère que le courant est régi par le modèle SCLC avec pièges [40,41,42]. Bien qu'un modèle de conduction similaire soit utilisé pour expliquer la commutation interfaciale et filamentaire, les deux modes présentent toujours des caractéristiques distinctes, en particulier à un état de faible résistance. La conduction actuelle pour le LRS en mode filamentaire se compose de deux régions :la région ohmique (I V ) et la région Droit de l'enfant (I V 2 ) alors que ce dernier n'a pas été observé dans la conduction LRS de la commutation interfaciale. Cela indique que la commutation filamentaire est médiée par un processus de piégeage/dépiégeage de porteurs [43]. Nous supposons qu'une quantité substantielle de pièges sont générés dans les chemins conducteurs au cours du deuxième processus de formation, conduisant au terme quadratique de courant dans le LRS du mode filamentaire.

un Je –V caractéristiques du processus de transformation (orange ) de la commutation interfaciale (rouge ) à la commutation filamentaire (bleu ). b Graphique de probabilité cumulée de HRS et LRS pour les deux interfaces (V RÉINITIALISER = 6 V) et les modes de commutation filamentaire. Le SET traiter I–V courbes du c interfacial et d modes de commutation filamentaire dans un tracé double-logarithmique
ZrO2 monocouche une mémoire avec une épaisseur de film de 40 nm a également été fabriquée à des fins de comparaison avec le schéma représenté sur la figure 6a. Le procédé d'électroformage (I CC = 1 mA) du TiN/ZrO2 Le dispositif /TiN comporte une seule étape avec une tension beaucoup plus élevée (Fig. 6b). Un comportement de commutation bipolaire a ensuite été observé (Fig. 6c), qui est similaire au mode filamentaire dans le dispositif à trois couches. Cependant, le mode de commutation interfacial n'a pas été observé dans ce dispositif monocouche. La figure 6d montre le logarithmique I–V courbes du SET processus pour les dispositifs à couche unique qui démontre de bons accords avec le modèle SCLC avec pièges. Cela appuie également la conclusion que le sandwich ZrO2 − x couche est cruciale pour la commutation interfaciale qui a lieu soit au niveau du ZrO2 − x couche ou près du ZrO2 − x /ZrO2 interface.
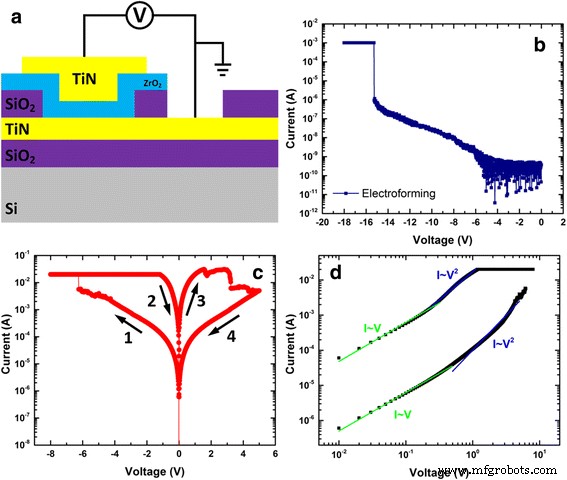
un Schéma de la monocouche TiN/ZrO2 /Périphérique TiN. b I–V caractéristiques du procédé d'électroformage pour le TiN/ZrO2 /Périphérique TiN. c I–V caractéristiques du TiN/ZrO2 /Dispositif TiN après formage. d I–V courbes du SET processus dans un tracé double-logarithmique avec ajustement linéaire
Sur la base des résultats de la caractérisation, un mécanisme détaillé des deux modes de commutation et de la transformation est proposé, comme le montre la figure 7. En appliquant une tension de formation négative, les ions oxygène sont poussés vers l'électrode inférieure tandis que les lacunes d'oxygène migrent vers le haut. électrode et forment un filament conducteur. L'interface TiO x N y couche joue un rôle crucial dans le comportement bipolaire car elle sert de réservoir d'oxygène [38, 44]. Deux filaments faibles sont générés consécutivement dans le ZrO2 inférieur et supérieur couches, caractérisées par le processus de formation en deux étapes (Fig. 7b, c). Bien que certains ions oxygène aient pu être injectés dans le milieu ZrO2 − x couche, le niveau de lacunes d'oxygène est encore suffisamment élevé pour maintenir la couche dans un état de faible résistance. L'appareil a donc basculé dans le LRS (Fig. 7c). Lorsqu'un biais positif est appliqué, les ions oxygène sont attirés par le TiO x N y couche au ZrO2 − x couche, entraînant la formation d'une couche riche en oxygène. Cette modulation stoechiométrique du ZrO2 − x couche change la mémoire en HRS (Fig. 7d). Un autre biais négatif est nécessaire pour SET l'appareil dans le LRS en repoussant les ions d'oxygène de la couche intermédiaire vers le TiO x N y réservoir (Fig. 7e). La propriété de non-conformité du dispositif peut provenir de la faible conductivité des deux filaments, qui servent effectivement de résistances série intrinsèques. La transformation se produit lorsqu'une polarisation significativement importante est appliquée, ce qui induit la formation d'un filament beaucoup plus fort et conducteur à travers toute la structure à trois couches (Fig. 7f). La résistance de l'appareil ne dépend plus du ZrO2 − x couche, et le mode de commutation est transformé d'interface en filamentaire. L'appareil peut ensuite être allumé et OFF en utilisant respectivement un biais positif et négatif (Fig. 7g, h).
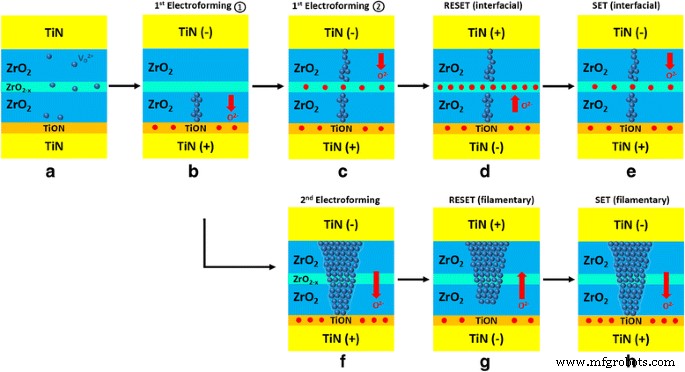
Schémas du mécanisme de commutation sur le tri-couche TiN/ZrO2 /ZrO2 − x /ZrO2 Dispositif /TiN pour le mode de commutation interfacial (a –e ). Le passage du mode interfacial au mode filamentaire (f ) et le mode filamentaire (g , h )
Le mode de commutation interfacial dans ce travail offre un potentiel de stockage multi-états. Comme la résistance de l'appareil en mode interfacial est médiée par le niveau d'ions oxygène dans le ZrO2 − x couche, les états de résistance multipliés peuvent être obtenus en contrôlant la quantité d'ions d'oxygène dans la couche intermédiaire à l'aide de différents RESET tensions. La figure 8a montre le I-V caractéristiques de l'appareil avec RESET tensions de 5,0, 5,5 et 6,0 V avec un SET constant tension de -5 V. Il convient de mentionner que comme la migration des lacunes d'oxygène est entraînée par le champ électrique, ces paramètres sont évolutifs avec l'épaisseur de la couche. Avec une couche fonctionnelle épaisse d'environ 50 nm, ce travail présenté a encore un bon potentiel pour réduire et réduire considérablement à la fois le SET et RÉINITIALISER tensions. La figure 8b affiche les caractéristiques de cyclage de cette opération de mémoire multi-états où la propriété de commutation résistive réversible et reproductible est démontrée pour ca. 100 cycles, indiquant un comportement d'endurance prometteur de cet appareil.
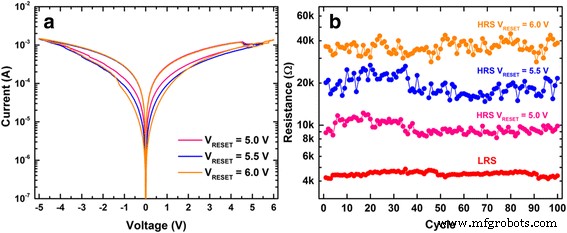
un I–V caractéristiques de la commutation interfaciale pour le tri-couche TiN/ZrO2 /ZrO2 − x /ZrO2 Appareil /TiN avec RESET variable tensions. b Test d'endurance de 100 cycles pour la commutation interfaciale avec différents RESET tensions
Conclusions
Une transformation contrôlable du mode interfacial au mode interfacial filamentaire a été observée dans un ZrO2 /ZrO2 − x /ZrO2 mémoire à trois couches. Le mécanisme de commutation et de transformation possible est proposé. Le ZrO2 − x embarqué La couche est considérée comme une couche cruciale pour le mode de commutation interfacial. Ce mode présente un comportement sans conformité possiblement dû à la résistance série intrinsèque par les deux filaments minces formés dans le ZrO2 couches. En contrôlant le RESET tensions, des résistances multi-états à HRS peuvent être atteintes. Ce comportement de stockage multi-états indique clairement la capacité de développer la mémoire hautes performances multi-états de nouvelle génération.
Abréviations
- ADF-STEM :
-
Microscopie électronique à transmission annulaire à champ sombre
- EDX :
-
Spectroscopie à rayons X à dispersion d'énergie
- HRS :
-
État de haute résistance
- IRS :
-
État de résistance intermédiaire
- LRS :
-
État de faible résistance
- RRAM :
-
Mémoire vive résistive
- SCLC :
-
Charge d'espace courant limité
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Une RRAM SRAM 4T intégrée avec charge de commutation résistive à auto-inhibition par un processus logique CMOS pur
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire
- Convertisseur de polarisation avec biréfringence contrôlable basé sur une métasurface hybride entièrement diélectrique-graphène
- Effet de commutation résistive asymétrique induit par effet de champ ferroélectrique dans les hétérojonctions épitaxiales BaTiO3/Nb:SrTiO3
- Étude de la variabilité de la mémoire à accès aléatoire à résistance de contact par modèle de vacance stochastique
- Fabrication de motifs de commutation optique avec des microfibres colorées structurelles
- Double fonction du périphérique V/SiOx/AlOy/p++Si comme sélecteur et mémoire
- Enquête sur la bande énergétique aux hétérojonctions bisulfure de molybdène et ZrO2
- Amélioration diélectrique des condensateurs MIM Al2O3/ZrO2/Al2O3 déposés par couche atomique par recuit par micro-ondes



