Effet de l'irradiation ultraviolette sur les caractéristiques des diodes 4H-SiC PiN
Résumé
Dans cet article, l'effet de l'irradiation ultraviolette (UV) sur les caractéristiques statiques du 4H-SiC PiN haute tension est étudié. Aucun changement significatif n'est observé dans l'état de marche avant caractéristique des diodes 4H-SiC PiN avant et après l'irradiation par la lumière ultraviolette. Cependant, on constate que la tension de blocage est considérablement augmentée avec l'irradiation UV, qui résulte de l'extension de la largeur de la région d'appauvrissement avec la collecte de charges positives sous l'augmentation de la densité de charge négative de surface. La spectroscopie transitoire de niveau profond révèle que les défauts de niveau profond induits par l'irradiation UV jouent un rôle dominant sur les charges négatives piégées, et conduisent donc à l'augmentation de la tension de blocage des diodes 4H-SiC PiN.
Introduction
Le carbure de silicium (SiC) devrait être un matériau candidat prometteur pour la prochaine génération de dispositifs électroniques haute puissance et haute température, en raison de sa large bande interdite, de sa force de champ électrique critique élevée, de sa vitesse de saturation élevée des électrons et de sa conductivité thermique supérieure [1 ,2,3,4]. Les dispositifs SiC sont en cours de développement pour remplacer de nombreux dispositifs actuellement utilisés dans le silicium, en particulier dans les exigences qui doivent fonctionner à des tensions et des niveaux de courant élevés, et à des températures supérieures à 200 °C. Par rapport aux dispositifs unipolaires, les dispositifs bipolaires SiC suscitent un intérêt considérable en raison des applications à très haute tension en raison de l'effet de modulation de conductivité ces dernières années. En tant que dispositif bipolaire typique, la diode 4H-SiC PiN haute tension a été démontrée, ce qui constitue un choix potentiel pour les applications de redresseur haute tension, notamment les réseaux intelligents avancés, le stockage d'énergie et la puissance pulsée [5,6,7,8]. Dans le processus de fabrication des dispositifs de puissance SiC, plusieurs procédés plasma tels que la gravure sèche et le dépôt par pulvérisation cathodique sont largement utilisés. Plusieurs travaux ont été rapportés sur les dommages induits par le processus dans les dispositifs SiC pour provoquer une dégradation électrique [9, 10]. De plus, des études antérieures révèlent que l'irradiation UV réduit considérablement les performances des transistors à effet de champ (MOSFET) métal-oxyde-semiconducteur SiC par bombardement ionique à haute énergie et photoémission plasma [11, 12]. Récemment, il a été rapporté qu'une irradiation laser UV pulsée sur un métal-oxyde-semiconducteur (MOS) 4H-SiC peut induire le piège à oxyde proche de l'interface et provoquer une dérive des performances du dispositif et une dégradation de la fiabilité [13]. Cependant, à notre connaissance, l'irradiation UV sur les dispositifs SiC PiN n'a pas encore été étudiée et il est nécessaire de comprendre les effets sur les caractéristiques des dispositifs SiC PiN.
Dans cette étude, nous avons étudié l'effet de l'irradiation UV sur les diodes 4H-SiC PiN, les caractéristiques de blocage direct et inverse à l'aide d'une irradiation UV de longueur d'onde de 184,9 nm. L'influence de l'accumulation de charge de surface sur la tension de claquage des diodes SiC PiN est présentée à l'aide d'une simulation de conception assistée par ordinateur (TCAD). SiO2 Les densités d'état /SiC avant et après irradiation ont été caractérisées par un système de spectroscopie transitoire à niveau profond (DLTS) sur SiC MOS. Le DLTS est largement utilisé pour étudier la distribution de la densité des états d'interface (Dit) et les défauts profonds dans le condensateur MOS [14, 15].
Méthodes
La structure schématique de la diode 4H-SiC PiN rapportée dans cet article est illustrée à la Fig. 1. La couche tampon de 2 μm d'épaisseur dopée à 1 × 10 18 cm −3 et couche de dérive n de 60 μm d'épaisseur avec une concentration de dopage de 2 × 10 14 cm −3 ont été cultivés en continu sur des substrats 4H-SiC(0001) de type n fortement dopés à 4° hors axe. Ensuite, la couche supérieure était p + anode avec 2 μm d'épaisseur et une concentration de dopage de 2 × 10 19 cm −3 . Après croissance épitaxiale, une structure de mésa d'isolement circulaire avec une hauteur de 2,5 μm et un diamètre de 300 μm a été modelée à l'aide d'un plasma couplé par induction réagissant à travers la couche p + anode dans la couche de dérive n. Les gaz de gravure et le matériau du masque étaient SF6 /O2 et déposés par dépôt chimique en phase vapeur assisté par plasma, respectivement. Suite à l'isolement mesa, un double implant Al de 1 × 10 17 cm −3 Une extension de terminaison de jonction basée sur la jonction (JTE) a été formée pour atténuer l'encombrement du champ électrique près du bord de la mesa. Les implants ont été activés par recuit dans Ar à 1650 °C pendant 30 min. Un SiO2 sacrificiel couche a été cultivée à 1100 °C pendant 1 h et trempée dans du HF pour fournir une nouvelle surface pour l'oxydation thermique. Ensuite, oxydation thermique en O2 sec ambiante a été réalisée à 1100 °C pendant 3 h avec SiO2 épaisseur des couches d'environ 40 nm, suivi d'un recuit dans Ar ambiant à 1100 °C pendant 1 h. Les matériaux de contact étaient Ni/Ti/Al pour l'anode et Ni pour la cathode. Ces métaux ont subi un recuit à 800 °C et 1000 °C pendant 2 min pour obtenir un contact ohmique de haute qualité, respectivement. Les résistances de contact spécifiques caractérisées par la méthode de longueur de transfert linéaire étaient 1 × 10 −5 Ω cm 2 et 3,75 × 10 −5 Ω cm 2 pour contact ohmique de type Ni n et de type Ni/Ti/Al p, respectivement. Une couche de métal avec de l'Al épais a été déposée sur l'anode et la cathode. La couche de dioxyde de silicium et une couche épaisse de polyimide ont été modelées sur le devant pour éviter les étincelles de surface pendant les mesures à haute tension. De plus, les condensateurs SiC-MOS ont été fabriqués sur un type n de haute qualité (7 × 10 15 cm −3 ) couche d'épitaxie sur un substrat 4H-SiC fortement dopé. L'oxyde thermique de 40 nm a été développé sur la base du processus standard de SiC PiN. L'électrode de grille et le contact ohmique arrière ont été formés avec Al et Ni, respectivement.

Coupe schématique des diodes 4H-SiC PiN
Des diodes 4H-SiC PiN et des condensateurs SiC-MOS ont été irradiés par une lumière UV à l'aide d'une lampe au mercure avec une longueur d'onde de 184,9 nm dans l'air pendant 72 h sans contrainte de polarisation. Les caractéristiques électriques du 4H-SiC PiN avant et après irradiation UV ont été évaluées par la sonde Wentworth et le système de caractérisation des semi-conducteurs Agilent B1505A. Les états d'interface des condensateurs SiC-MOS et les charges fixes ont ensuite été caractérisés par un système DLTS à transformée de Fourier PhysTech. Le biais inverse appliqué V R et la tension d'impulsion de remplissage V P étaient respectivement de 15 V et 2 V. La période d'échantillonnage t w de l'impulsion de polarisation de V R à V P était de 1,5 s.
Résultats et discussion
L'effet de l'irradiation UV sur les caractéristiques statiques du SiC PiN est montré dans les Fig. 2 et 3 où les caractéristiques mesurées avant et après irradiation sont comparées pour le dispositif 1 (D1) et le dispositif 2 (D2). Le diamètre des diodes SiC PiN circulaires est de 3,5 mm et la zone active est d'environ 10 mm 2 . La chute de tension directe pour le SiC PiN est d'environ 3,95 V à une densité de courant de 100 A/cm 2 pour les deux appareils avant l'irradiation UV. Il est clairement observé sur la figure 2 qu'il n'y a pas de changements significatifs dans la caractéristique d'état avant pour deux appareils, passant de 3,95 à 4,0 V après irradiation UV. Les tensions de blocage obtenues du dispositif 1 et du dispositif 2 fabriqués sur une épicouche à dérive n de 60 μm d'épaisseur sont de 7 kV et 7,2 kV à un courant de fuite inférieur à 1 μA, respectivement. Il convient de noter que l'efficacité de blocage des diodes PiN est d'environ 70 % de la valeur théorique de 9,7 kV pour une couche de dérive de 60 μm d'épaisseur, ce que l'imprécision de l'activation des impuretés conduit probablement à un écart par rapport à la fenêtre d'implantation JTE optimale. Après irradiation UV, la tension de blocage du dispositif 1 montre une augmentation remarquable de 7 à 9,2 kV avec une amélioration de 2,2 kV, se rapprochant de la valeur idéale du plan parallèle. En conséquence, une amélioration de 1,7 kV est obtenue pour l'appareil 2 après irradiation aux UV.

Caractéristique d'état avant et après l'irradiation UV de la diode 4H-SiC PiN
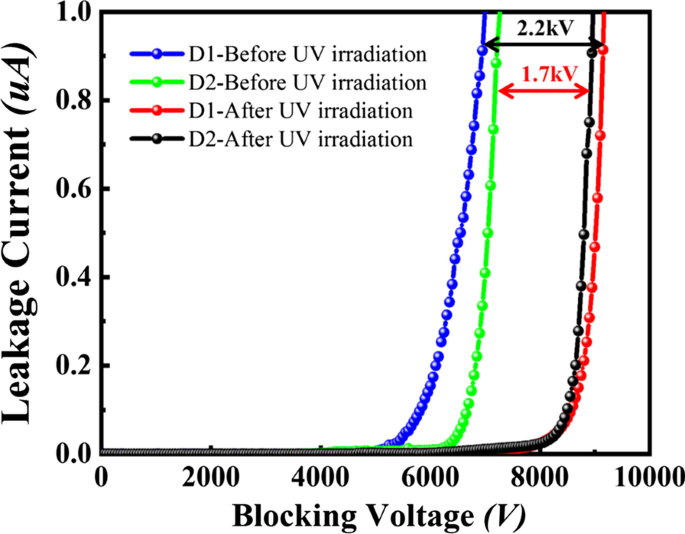
Caractéristique inverse de la diode 4H-SiC PiN avant et après irradiation UV
Il est bien connu que les pièges de surface ont un effet significatif sur la distribution du champ électrique dans la région terminale et affectent ensuite les caractéristiques de blocage inverse dans le dispositif d'alimentation SiC. Ikeguchi et al. ont indiqué que l'éclairage UV à haute énergie avec une énergie photonique 5 eV peut transformer les doubles liaisons C-C tendues préexistantes en pièges à électrons actifs, et conduit ainsi à la production de défauts d'interface chargés négativement observés par V

Tension de claquage simulée par rapport à la concentration d'implant JTE pour une charge négative de surface, y compris sans charge, 1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 , et 1 × 10 13 cm −2 respectivement
La figure 5 compare l'influence de l'accumulation de charge de surface négative sur le profil du champ électrique à la caractéristique de blocage. La distribution du champ électrique avec l'évolution de la région d'appauvrissement dans les diodes 4H-SiC PiN est illustrée à la Fig. 5a. Lorsque la charge négative augmente à 5 × 10 12 cm −2 au SiO2 /SiC (région de structure JTE) de SiC PiN, la charge positive de la couche de dérive N est collectée à la surface de l'interface, conduisant à l'extension significative de la région d'appauvrissement [16]. La Fig. 5b montre la ligne de coupe du champ électrique sous la jonction de la région JTE/n-drift avec la densité de charge négative de surface de 1 × 10 11 et 5 × 10 12 cm −2 . Dans le cas d'une faible charge surfacique de 1 × 10 11 cm −2 , un encombrement important du champ électrique apparaît dans la région de terminaison de bord avec une valeur maximale de 2,5 MV/cm et la tension de claquage est d'environ 8 kV. Lorsque la densité de charges augmente jusqu'à 5 × 10 12 cm −2 , le champ électrique de crête tombe à 2,2 MV/cm et l'encombrement du champ électrique au niveau de la région de terminaison de bord est supprimé en comparaison. Pendant ce temps, la distribution du champ électrique est plus uniforme et la tension de claquage augmente évidemment. Par conséquent, la charge négative de surface peut provoquer l'extension de l'épuisement et atténuer l'encombrement du champ électrique, entraînant une amélioration de la tension de claquage.

Distributions de champ électrique simulées de SiC PiN avec une densité de charge négative de surface de 1 × 10 11 cm −2 et 5 × 10 12 cm −2 :a distribution du champ électrique avec l'évolution de la région d'appauvrissement b ligne de coupe du champ électrique sous la jonction JTE/région de dérive n. La concentration de l'implant est utilisée 6 × 10 16 cm −3
Pour valider davantage les mécanismes physiques de génération des défauts électroniques induits par l'irradiation, une meilleure caractérisation électrique de SiO2 L'interface /SiC est requise pour étudier plus en détail. Les spectres DLTS pour les condensateurs 4H-SiC SiC-MOS ont été caractérisés par un appauvrissement de 15 à 2 V avant et après irradiation UV, comme le montre la Fig. 6. À partir des spectres DLTS, deux pics ont été observés dans les condensateurs 4H-SiC MOS à la fois avant et après irradiation UV, se situant à 210 K et 490 K, respectivement. Des pics DLTS négatifs indiquent que les niveaux P1 et P2 sont des pièges à électrons. Le niveau P2 large et significatif montre une augmentation significative de l'amplitude du pic, ce qui signifie que la concentration du piège à électrons est augmentée par l'irradiation UV. En outre, on constate que le signal DLTS augmente proportionnellement au temps de remplissage, présentant une cinétique de remplissage de piège caractéristique des défauts étendus, tels que des défauts d'interface plutôt que des défauts ponctuels. L'encart montre les distributions de la densité d'état de l'interface en fonction de l'énergie d'activation ET . La densité d'état de l'interface est calculée par \(D_{{{\text{it}}}} =\varepsilon_{{{\text{sic}}}} C_{{{\text{ACC}}}} AN_{{ \text{D}}} \Delta C/\left[ {C_{R}^{3} kT} \right]\) [17]. On peut voir sur la figure que le défaut d'interface donne naissance à une bande d'énergie dans la bande interdite de E C − 0.65 eV à E C − 1.25 eV et sa densité a considérablement augmenté de 2 × 10 12 cm −2 eV −1 à 6 × 10 12 cm −2 eV −1 après irradiation UV. Combinant des mesures de capacité transitoire, une microscopie électronique à transmission haute résolution et des calculs de théorie fonctionnelle de la densité, Dong et al. ont suggéré que ces défauts d'interface provenaient d'un excès de carbone interstitiel divisé chargé négativement à l'interface [18]. Le pic P1 à 210 k correspond à un piège à électrons à E C − 0.41 eV. Sa concentration ne présente aucun changement essentiel après irradiation UV et a provisoirement attribué un piège P1 aux défauts localisés dans l'épicouche de SiC. Cependant, sa configuration atomique n'est toujours pas claire et doit être clarifiée dans une future enquête.
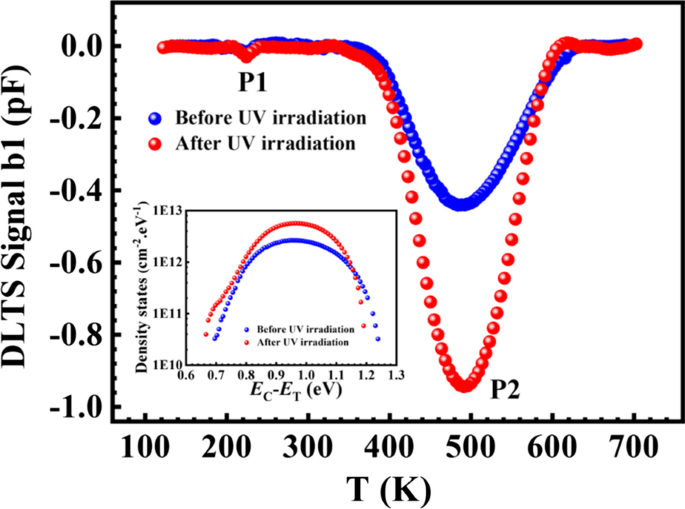
Spectres DLTS pour diodes 4H-SiC PiN avant et après irradiation UV. L'encart montre le D il distributions pour les diodes 4H-SiC PiN avant et après irradiation UV
Conclusions
L'influence de l'irradiation UV sur les caractéristiques électriques des diodes 4H-SiC PiN a été étudiée. D'après les résultats des expériences électriques, un changement insignifiant du courant direct est observé après irradiation UV. Cependant, l'irradiation UV apparaît une augmentation remarquable de la tension de blocage. Il s'avère que l'irradiation UV génère des défauts de niveau profond dans l'interface des diodes PiN, entraînant une augmentation des niveaux d'accepteur profond dans la bande interdite. Ces défauts profonds servent de centre de capture d'électrons et conduisent à l'augmentation significative de la charge négative dans SiO2 /Interface SiC. Les charges positives de la couche de dérive N sont collectées à la surface de l'interface et favorisent en outre l'extension de la région d'appauvrissement avec une distribution de champ électrique plus uniforme, ce qui entraîne une augmentation de la tension de blocage.
Disponibilité des données et des matériaux
Toutes les données sont disponibles sans restrictions.
Nanomatériaux
- Diodes
- diodes spéciales
- Rolling Pin
- Épingle de bowling
- Caractéristiques de la fibre de verre
- Effet de la distribution de nanoparticules d'or dans le TiO2 sur les caractéristiques optiques et électriques des cellules solaires à colorant
- Effet du polyéthylène glycol sur la photocathode NiO
- Effet du recuit sur les microstructures et le durcissement des alliages de vanadium implantés séquentiellement à l'hélium-hydrogène
- Effet du revêtement en nanocouche de tungstène sur l'électrode Si dans la batterie lithium-ion



