Propriétés photoélectroniques du détecteur à réseau de nanofils InAsSb à liaison terminale sous une lumière faible
Résumé
Une fabrication simple de détecteur à matrice de contacts InAsSb NW (nanofils) à faible lumière est démontrée dans cette étude. Le détecteur est fabriqué à l'aide d'un réseau InAsSb NW développé par épitaxie par faisceau moléculaire sur substrat GaAs. Les états d'espacement induits par le métal sont induits par le contact lié aux extrémités qui supprime le courant d'obscurité à différentes températures. L'existence du dipôle d'interface en raison des états d'espace interfacial améliore l'excitation lumineuse autour du champ local et améliore ainsi la photoréactivité et la photodétection à la lumière faible. L'intensité lumineuse de la source de lumière infrarouge dans ce rapport est de 14 nW/cm 2 ce qui est environ 3 à 4 ordres de grandeur inférieur à la source laser. La réactivité du détecteur a atteint 28,57 A/W à température ambiante avec le rayonnement lumineux (945 nm), tandis que la détectivité est de 4,81 × 10 11 cm·Hz 1/2 W −1 . Des performances anormales dépendantes de la température émergent lors des expériences à température variable, et nous avons discuté du mécanisme détaillé derrière la relation non linéaire entre la photoréponse de l'appareil et les températures. En outre, les caractéristiques optoélectroniques du détecteur ont clarifié que l'effet de piégeage de la lumière et l'effet de photo-réaction des NW peuvent améliorer la photoréponse à la lumière faible dans l'ultraviolet au proche infrarouge. Ces résultats mettent en évidence la faisabilité du détecteur matriciel InAsSb NW à la lumière infrarouge faible sans système de refroidissement.
Introduction
En tant que branche importante des semi-conducteurs à bande interdite étroite III-V, l'InAsSb présente les avantages hérités de l'InAs, tels qu'une faible masse effective d'électrons et une mobilité électronique élevée [1, 2]. Lorsque l'élément Sb est introduit dans InAs, la réponse en longueur d'onde de coupure de l'InAsSb ternaire pourrait être étendue à la gamme infrarouge à grande longueur d'onde en raison de l'effet de courbure de la bande interdite [3]. Par conséquent, InAsSb est considéré comme un candidat idéal dans le domaine de la détection infrarouge [4,5,6]. Dans le domaine de l'optoélectronique, les nanostructures unidimensionnelles (1D) [7] ont d'énormes propriétés uniques, notamment une grande surface avec de nombreux états de piège, une longue longueur de trajet pour l'absorption des photons et une structure mécaniquement flexible en raison de leurs rapports d'aspect énormes [8]. De plus, au cours de leur développement, les nanostructures 1D peuvent facilement libérer le décalage de réseau avec les substrats et ainsi atteindre une qualité cristalline élevée [9]. Ici, les applications de l'optoélectronique telles que les photodétecteurs [10], les cellules solaires [11] basées sur des nanostructures 1D suscitent d'énormes intérêts de recherche. Parmi eux, les structures de dispositifs adaptées [12] ont été développées pour obtenir une absorption lumineuse optimisée et une récolte de lumière à large bande, rendant les nanostructures 1D adaptées à des scénarios d'application variés et réalisant les composants compatibles avec les circuits intégrés à base de silicium. Récemment, des photodétecteurs basés sur des InAs NW individuels ont démontré leur potentiel dans la détection infrarouge [13]. Avec l'ajout de Sb, l'InAsSb ternaire peut être accessible sur toute la plage à large spectre pour la détection de la température ambiante [14]. Avec la passivation de Al2 O3 , les détecteurs basés sur InAsSb NWs ont réalisé une détection non froide dans le spectre infrarouge moyen [15]. Cependant, les sources lumineuses conventionnelles largement utilisées dans ces études sont des lasers à haute intensité et la plupart de ces appareils ne peuvent pas fonctionner à température ambiante [16]. En outre, la structure de dispositif conventionnelle basée sur les NW n'est pas adaptée à l'application de masse dans les circuits intégrés compatibles. Il existe trois principaux types de détecteurs traditionnels basés sur les NW InAsSb, y compris le dispositif NW individuel [17], les puits quantiques intégrés dans les NW InAs [3] et le dispositif NW individuel vertical [14]. Tous nécessitent un processus de nanofabrication coûteux, tel que la lithographie par faisceau d'électrons (EBL) et la gravure ionique réactive (RIE). Ici, l'innovation dans la structure du dispositif est urgente pour l'application des NW.
L'interface joue toujours un rôle essentiel dans les performances optiques et électriques de l'appareil malgré sa taille limitée, faisant de l'ingénierie des contacts dans les appareils basés sur NW un autre facteur essentiel [18]. Par exemple, une cellule solaire avec d'excellentes propriétés de photodétection omnidirectionnelle à la lumière faible a été obtenue dans la structure hybride utilisant l'interface entre les points quantiques de graphène et le sulfonate de polystyrène [19]. Dans cette étude, nous modulons les performances optoélectriques du dispositif en utilisant la structure de bande à l'interface entre l'électrode et le semi-conducteur. La redistribution de charge se produit à l'interface métal-semi-conducteur et le transfert de charge se produit entre le métal et les queues des fonctions d'onde métalliques dans le semi-conducteur. La redistribution est appelée MIGS, ce qui pourrait induire des états de gap et un dipôle d'interface aux états interfaciaux [20]. Cependant, les résultats de simulation du modèle MIGS présentent encore des écarts entre les expériences, qui sont considérés comme résultant de défauts d'interface, de défauts induits fabriqués et de l'épinglage au niveau de Fermi [21]. En particulier pour les NW InAsSb avec des états de surface riches, l'épinglage au niveau de Fermi est inévitable de sorte que les états de gap induits filtreraient le transfert de charge. De cette manière, le courant d'obscurité du dispositif pourrait être supprimé dans une plage acceptable. De plus, le dipôle interfacial pourrait améliorer l'excitation lumineuse dans le champ local, ce qui est essentiel pour la détection de la lumière faible. Basé sur la discussion de Chu. et.al, les jonctions à liaison terminale sont plus susceptibles d'atteindre le chevauchement d'état entre le métal et le semi-conducteur que les jonctions à liaison plane [18]. Pourtant, le dispositif à liaison terminale via NW individuel est confronté aux obstacles de la fabrication. Ici, nous proposons une solution en utilisant des matrices NW pour obtenir le contact lié aux extrémités entre les NW et le métal. Par rapport aux photodétecteurs conventionnels, les dispositifs à matrice NW à structure sandwich présentent les avantages d'une fabrication facile et d'une grande adaptabilité environnementale [22, 23]. La charge (AZ5214), qui est enduite par centrifugation et cuite autour des NW pendant le processus de fabrication, rend l'appareil plus stable et anti-oxydant pour l'environnement. Lorsque la lumière est introduite dans le réseau NW, elle se réfléchit et se réfracte plusieurs fois dans différentes directions, augmentant l'absorption de la lumière à l'intérieur [24, 25]. Le trajet lumineux prolongé dans le réseau NW est appelé effet de piégeage de la lumière [26, 27], qui est largement utilisé dans les dispositifs de réseau basés sur NW. La structure de la bande et la structure de l'appareil donnent à l'appareil un potentiel de détection de lumière faible à température ambiante.
Dans cette étude, nous avons fabriqué le dispositif de réseau NW basé sur les NW InAsSb cultivés par MBE (épitaxie par faisceau moléculaire). Les états de gap et le dipôle d'interface induits par le contact métal-semi-conducteur pourraient supprimer le courant d'obscurité et augmenter la détection de la lumière séparément [28]. L'effet de piégeage de la lumière de la structure sandwich du réseau NW contribue à la détection de la lumière faible [29]. Le courant d'obscurité supprimé à température ambiante minimise considérablement le bruit de détection et permet la détection à température ambiante [30]. La structure du dispositif de durcissement permet au dispositif de fonctionner dans un environnement ambiant. De plus, la photoréponse du dispositif fluctue avec la température car les états d'interface compliqués sont anticipés. À température constante, la valeur du photocourant augmente linéairement avec l'intensité lumineuse incidente, ce qui a démontré le potentiel du wattmètre optique.
Méthodes/Expérimental
Les nanoparticules d'InAsSb ont été cultivées sur des substrats de GaAs {111}B en utilisant le système MBE (Riber 32 R&D) avec un système d'évaporation d'Au in situ. Le substrat prêt pour l'épi a été prétraité pour éliminer la contamination. Ensuite, une couche tampon de GaAs a été déposée à 540 °C pendant 15 min et les nanoparticules d'Au ont été formées via le processus d'évaporation et de recuit. Les tiges d'InAs ont été cultivées pendant 20 min avec une température maintenue constamment à 380 °C, puis la source de Sb a été introduite dans la chambre de croissance pendant 60 min. Pendant la croissance NW, le In BEP (pression équivalente du faisceau) a été maintenu à 2,7 × 10 –7 mbar, le BEP As était de 2,2 × 10 –6 mbar, et le Sb BEP était de 7 × 10 –7 mbar, conduisant à un rapport de flux V/III de ~ 11 et le rapport Sb/As de ~ 0.3.
Pour la fabrication du dispositif, AZ5214 (photoresist) a été utilisé comme agent de soutien pour maintenir les orientations des NW. Ensuite, la matrice NW avec le substrat a été revêtue par centrifugation avec AZ5214 à 3000 tr/min pendant 30 s et cuite pendant 2 min à 120 °C. Le gel AZ5214 est transparent ce qui minimise la perte de lumière lors de la mesure. Pour exposer les pointes des NW, la surface du réseau a été polie par une jauge de cisaillement de précision (Logitech). Les couches d'InAsSb formées à la surface du substrat pendant la croissance NW via le mécanisme VS (vapeur-solide) peuvent servir d'électrode de drain. Selon la mesure Hall des épi-couches d'InAsSb (présentée dans le fichier supplémentaire 1 :Figure S1), la concentration en porteurs à température ambiante est d'environ 2 × 10 17 cm −3 , tandis que la mobilité est d'environ 1,6 × 10 4 cm 2 /(V·s) à température ambiante. Après cela, un film d'Au d'une épaisseur nominale de 8 nm a été déposé sur les zones sélectionnées, l'une d'entre elles se trouve sur le dessus de la matrice et l'autre sur l'épi-couche. La faible épaisseur de Au déposé assure la photoperméabilité de l'électrode et une perte de lumière acceptable pendant les mesures.
Les caractéristiques morphologiques, chimiques et structurelles des NW InAsSb obtenus ont été étudiées à l'aide de SEM (FE-SEM, JEOL 7800F) et TEM [TEM, Philips Tecnai F20, équipé d'une spectroscopie à dispersion d'énergie (EDS) pour l'analyse compositionnelle]. Des NW individuels pour l'analyse MET ont été préparés en ultrasonisant les échantillons de NW dans de l'éthanol et en les dispersant sur les grilles de Cu supportées par des films de carbone.
Les mesures de photoconductivité ont été réalisées dans un cryostat à cycle fermé à l'hélium équipé de LED comme sources lumineuses. La température dans ce système peut être modulée entre 2 K et la température ambiante en continu, tandis que l'intensité lumineuse des LED peut être réglée facilement par le courant d'entrée. Des LED avec des longueurs d'onde variées, notamment 260 nm, 620 nm et 945 nm, ont été utilisées dans cette étude. L'intensité lumineuse de la LED est liée à la fois à la température et au courant d'entrée. L'intensité augmente linéairement avec le courant et diminue avec la température. Les valeurs d'intensité lumineuse à température ambiante dans cette mesure sont de 4000 nW/cm 2 pour 260 nm, 558 nW/cm 2 pour 620 nm et 14 nW/cm 2 pour 945 nm. Les informations relatives à l'intensité lumineuse peuvent être trouvées dans la réf. [30]. Une tension constante VDS = 100 mV a été appliqué entre la source et le drain. La réponse de photoconductivité peut être obtenue en réglant l'activation/la désactivation des LED.
Résultats et discussion
La figure 1 montre des études en microscopie électronique des nanoparticules d'InAsSb. La figure 1a est une image SEM à vue inclinée, montrant les diamètres des NWs allant de 100 à 200 nm et la longueur allant de 6 à 8 μm. La figure 1b montre une image MET à fond clair (BF) d'un NW individuel typique, indiquant une structure effilée classique. Le long de sa direction axiale, la composition du NW montre un changement progressif modéré et la concentration moyenne de Sb est élevée jusqu'à 30% sur la base de notre analyse quantitative EDS (détails disponibles dans le fichier supplémentaire 1 :Figure S2). La figure 1c montre l'image HRTEM de la partie médiane du NW, confirmant l'existence des plans jumeaux. Le modèle de diffraction électronique à aire sélectionnée (SAED) illustré sur la figure 1d vérifie également la structure de jumelage, et deux ensembles de diffractions structurées en ZB (blende de zinc) peuvent être distingués. L'élément Sb peut être utilisé comme tensioactif et déprime la phase WZ (wurtzite) de InAs NWs [31], favorisant le changement de phase de structure de WZ à ZB. Dans notre cas, le rapport V/III est ~ 11, conduisant à un environnement riche en V, ce qui favorise la nucléation de la structure ZB [32], mais laissant quelques plans jumeaux. L'enquête sur la structure de jumelage dans InAsSb NWs a affirmé que le déplacement à la frontière provoquerait une distribution locale inégale de Sb [12], favorisant la diffusion des électrons ou le piégeage des porteurs [33].
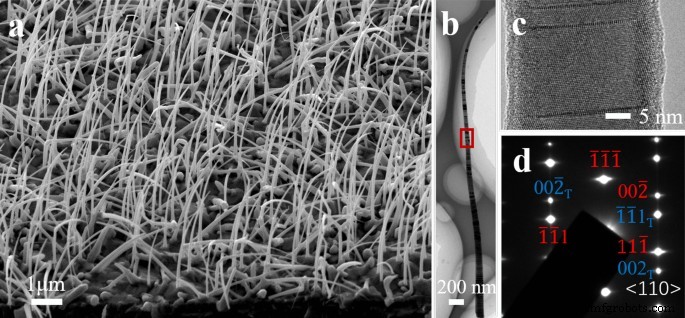
Investigations avancées en microscopie électronique sur les nanoparticules d'InAsSb. un Une image SEM à vue inclinée des NW. b Image TEM à fond clair (BF) d'un NW individuel. c Image TEM haute résolution (HRTEM) prise du milieu du NW de la région marquée en b . d Schéma correspondant SAED (diffraction électronique à zone sélectionnée) tiré de c
La structure du dispositif est illustrée sur la figure 2a, dans laquelle le film Au recouvre le haut et le bas du réseau. L'image SEM de l'appareil est présentée dans le fichier supplémentaire 1 :Figure S3, où la longueur restante est d'environ 3 µm et presque tous les NW sont intégrés. La résine photosensible est utilisée pour maintenir les NW orientés et intégrer les NW dans un dispositif de durcissement ; de cette manière, le dispositif est plus anti-oxydant et adapté à l'application. La structure effilée est utilisée dans un dispositif de réseau NWs en silicium amorphe, démontrant une absorption d'amélioration et est insensible à l'angle incident [34]. La figure 2b est un croquis de l'interface Au-InAsSb déterminée par le modèle MIGS. La figure 2c, d confirme une conductance presque constante indépendante de la température, et la valeur de la conductance est d'environ 1 × 10 –7 Ω −1 . Les courbes I-V à 2 K et 300 K sans lumière incidente sont illustrées à la Fig. 2d. Le nanofil individuel a une valeur beaucoup plus grande de la conductance indiquée dans le fichier supplémentaire 1 :Figure S4. Le dispositif de réseau équivaut à un circuit parallèle qui est relié par des milliers de NW individuels de sorte que la conductance théorique aurait dû être une valeur beaucoup plus considérable. De plus, nous avons deux connaissances de base sur les problèmes liés à la conductance :(1) la conductance du NW individuel montre une forte dépendance à la température; (2) les dispositifs de réseau constitués d'InAs NW dans notre étude ont également une conductance constante. Par conséquent, nous concluons que le contact entre le métal et le semi-conducteur dans ce dispositif a une résistance prévenante dominant les caractéristiques de sortie globales.

Structure et propriétés électriques du dispositif de réseau InAsSb NW. un Croquis de l'appareil, avec l'image SEM affichée dans l'encart. b Le diagramme énergétique des états de l'interface Au-InAsSb. c La conductance de l'appareil en fonction de la température. d Courbes I-V à 2 K et 300 K sans lumière, respectivement
Lorsque Au est joint aux NW d'InAsSb via un contact à liaison terminale, le transfert de charge a lieu à l'interface via les queues des fonctions d'onde des électrons métalliques, ce que l'on appelle le continuum de MIGS [18]. La redistribution des charges à l'interface s'est produite une fois que les formes de contact entraîneraient également le développement de dipôles d'interface [35]. Selon le modèle MIGS, la hauteur de la barrière d'interface est déterminée par \({\Phi }_{\mathrm{Au}}\) (le travail d'extraction du métal), \({\Phi }_{\mathrm{NW }}\) (l'affinité électronique de l'InAsSb NW) et \({\Delta }_{i}\) (la chute de tension due à un dipôle d'interface qui se produit lors de la formation de l'interface). Le \({\delta }_{i}\) est la distance des états de gap induits par le métal. L'état électronique est affiché sur la Fig. 2b. Le dipôle d'interface pourrait créer une barrière supplémentaire pour les électrons [36], mais l'effet est limité dans une région du \({\delta }_{i}\). Surtout, les propriétés intrinsèques du dispositif sont modulées par la grande résistance de contact parasite [37]. Dans notre appareil, la grande résistance de contact diminue efficacement le courant d'obscurité, tandis que la valeur est indépendante de la température. De cette manière, la concentration en porteurs peut être restreinte dans une plage favorable pour la détection de la lumière. Pourtant, le mécanisme de résistance de contact dû au maintien constant du dipôle d'interface avec les différentes températures reste une recherche plus détaillée.
Sur la figure 3a, nous affichons les courants de l'appareil de 2 à 120 K avec et sans éclairage lumineux, et le reste est affiché dans le fichier supplémentaire 1 :figure S5. Les états de la LED sont réglés avec le temps, dans lequel les états "ON" et "OFF" resteraient respectivement pendant 60 s. Les valeurs de courant spécifiques de la LED affichées aux états « ON » sont respectivement de 10, 20, 50, 100, 200, 500, 1000, 2000 et 3000 uA. La mesure est prise à différentes températures de 2 à 300 K. L'encart de la Fig. 3a montre les conditions avec les trois lumières les plus faibles (environ 4 à 10 nW/cm 2 ), indiquant une tendance similaire à celle de la Fig. 3a. Cependant, des comportements optiques différents peuvent être observés avec la lumière la plus faible, en particulier pour la vitesse de réponse plus lente et une photoconductance légèrement persistante. La figure 3b montre le temps de réponse de l'appareil à 20 K, tandis que le courant de la LED est de 2000 μA. A noter que la figure 3c est obtenue dans le milieu ambiant à température ambiante. Plus important encore, la source lumineuse que nous avons utilisée ici est constituée de toutes les LED et les valeurs d'intensité lumineuse sont de 4 000 nW/cm 2 (260 nm), 558 nW/cm 2 (620 nm) et 14 nW/cm 2 (945 nm), respectivement. Outre la photoréactivité, à partir des vitesses de réponse avec différentes longueurs d'onde lumineuses, nous pouvons conclure que les InAsSb NW ont une meilleure réponse à la lumière infrarouge.
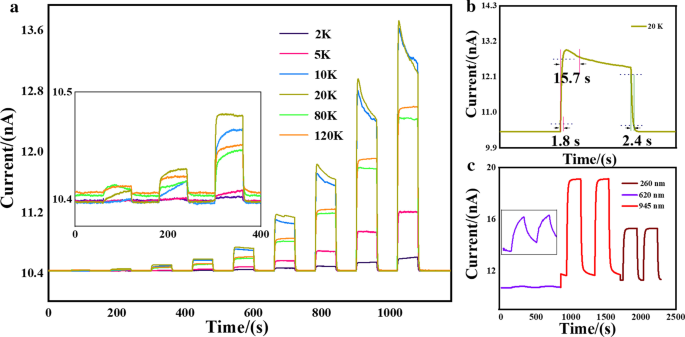
Dépendance temporelle de la conductance source-drain sous différentes températures. un La photoréponse de l'appareil à différentes températures à 620 nm LED avec le courant d'entrée différent. b Le temps de réponse de l'appareil à 20 K, tandis que le courant d'entrée de la LED est de 2000 μA. c Les performances photoélectriques en fonction de la longueur d'onde de l'appareil à température ambiante avec un éclairage de 260 nm, 620 nm et 945 nm. L'encart montre une version agrandie de la photoréponse à 260 nm LED
La figure 3a montre que notre appareil a une réponse positive rapide et évidente lors du changement d'état des LED sous différentes températures, et la photoconductance augmente avec le courant LED. Sans éclairage lumineux, la conductance de l'appareil est d'environ 1,04 × 10 –7 Ω −1 , ce qui correspond au test de sortie illustré à la Fig. 2c. A température fixe, la valeur de ΔG (définie comme la conductance moins la conductance sombre) augmente presque linéairement avec le courant LED représentant l'intensité lumineuse. Lorsque la source lumineuse a été bloquée, le courant de l'appareil revient immédiatement à l'état d'origine. La valeur maximale de ΔG dans ce tracé est de 3,2 × 10 –8 Ω −1 à 10 K. Il convient de noter que deux types de photoréponse peuvent être distingués dans ce graphique :
- 1.
pour la plupart des températures, les courants augmentent rapidement une fois la LED allumée, et les courants sont stables tant que la LED est allumée ;
- 2.
à 10 K et 20 K, le courant augmente également rapidement avec l'éclairement lumineux. Pourtant, le courant a une légère diminution avec la LED allumée, laissant une queue dans le tracé, que l'on ne retrouve pas à d'autres températures.
Pour clarifier le mécanisme intrinsèque dans les deux différents types de photoréponse, les informations sur la vitesse de réponse à 20 K lorsque le courant de la LED est de 2000 μA sont extraites comme preuve et les valeurs spécifiques sont indiquées sur la figure 3b. Le temps de réponse [38, 39] (τ ris représentant l'intervalle de temps entre le pic de courant de 90 % et le pic de courant de 10 %) est déterminé à 1,8 s, tandis que le temps de récupération (τ rec défini de manière opposée) est de 2,4 s, ce qui est presque une constante dans toute la plage de température. Pour 10 K et 20 K, le temps de retard de la structure « queue » est d'environ 15,7 s, ce qui est étonnamment absent lorsque le courant d'éclairage de la LED est inférieur à 500 μA. Combinés à la condition de faible luminosité dans l'encart de la figure 3a, trois types de photoréponse à 10 K et 20 K peuvent être démontrés. Avec la lumière la plus faible (10-50 μA), le courant augmente lentement avec le temps. Lorsque le courant LED est augmenté à 100-500 μA, la réponse devient rapide. Une fois que le courant dépasse 1 000 μA, la queue se forme. En d'autres termes, seule une intensité lumineuse suffisante peut déclencher la structure transitoire de « queue ». Des structures de « queue » similaires ont été largement rapportées dans InAs NWs [40, 41]. Les sources lumineuses dans ces rapports sont toutes des lasers à haute intensité lumineuse, ce qui est cohérent avec notre résultat selon lequel la structure de « queue » n'apparaît que dans les zones lumineuses à haute intensité. Ils ont affirmé que la « queue » provient de l'effet retardé qui correspond au piégeage et au dé-piégeage des porteurs sur les états de surface [42]. Pour InAsSb NWs dans notre cas, les états de surface sont plus inévitables en raison de l'effet tensioactif sévère incorporé avec Sb [43]. Par conséquent, nous prévoyons que la structure "queue" provient des états de défaut de la structure de macle qui ne piègent les électrons qu'à certaines températures avec une assistance lumineuse suffisamment forte.
Pour un photodétecteur donné, la photoréactivité peut être exprimée par [44]
$$\mathrm{R}=\frac{{I}_{\mathrm{p}}}{PA}$$ (1)où \({I}_{\mathrm{p}}\) est le photocourant de l'appareil, \(P\) est la puissance lumineuse de l'appareil et \(A\) représente la surface effective de l'appareil. Pour notre appareil, la surface effective de l'appareil est de 1 mm 2 qui est déterminé par le masque utilisé lors de l'évaporation des électrodes, et la zone de réception de lumière du photomètre est de 0,9 cm 2 . Dans ces circonstances, la photoréactivité de l'appareil peut être déterminée à 4,25 mA/W (260 nm), 1,27 A/W (620 nm) et 28,57 A/W (945 nm), respectivement, ce qui a confirmé le potentiel de l'InAsSb. Dispositif à structure sandwich NW en détection infrarouge.
La photodétection d'un appareil peut être présentée comme [14]
$${D}^{*}=R{A}^\frac{1}{2}/{(2e{I}_{\mathrm{dark}})}^\frac{1}{2}$ $ (2)où R est la photoréactivité de l'appareil et e est la charge électronique. Je sombre représente le courant d'obscurité de l'appareil et la valeur est de 10,8 nA. Avec le courant d'obscurité supprimé dans la structure sandwich InAsSb NW, les valeurs de \({D}^{*}\) du photodétecteur atteignent 7,28 × 10 7 (260 nm), 2 × 10 10 (620 nm) et 4,81 × 10 11 cm·Hz 1/2 W −1 (945 nm), respectivement. Notamment, le rapport cyclique des NW dans cette structure de tableau est inférieur à 50 %, ce qui rend le R réel et \({D}^{*}\) plus grand que le résultat que nous avons calculé. Le haut R et \({D}^{*}\) ne sont pas seulement attribués à l'effet de piégeage de la lumière du dispositif de réseau, mais proviennent également de la structure de l'interface [2]. Par rapport aux photodétecteurs à base de nanofils résumés dans la réf. [45], la température de fonctionnement de 300 K pour notre appareil a un potentiel d'application supérieur dans le monde réel [6]. De plus, à température ambiante, la photoréactivité de notre dispositif de matrice InAsSb NW facile à fabriquer (28,57 A/W à 945 nm) pourrait dépasser les dispositifs NW les plus complexes (WSe2 /Bi2 Te3 :20 A/W à 980 nm [46], PtSe2 /pérovskite :0,12 A/W à 800 nm [47]). Même si le dipôle d'interface est expérimentalement inaccessible, les caractéristiques de sortie de la figure 2 pourraient fournir des preuves solides de son existence dans notre appareil. Comme suggéré dans la discussion précédente, la couche interfaciale du dispositif pourrait fonctionner comme le réseau dipolaire optique avec l'éclairage lumineux, ce qui pourrait contribuer à un plus grand facteur d'amélioration du champ. Cet effet est appelé effet d'amélioration de dipôle d'interface (IDEE) dans des études antérieures [48]. L'IDEE fonctionne pour une plage de longueurs d'onde plus large que l'effet d'amélioration des plasmons de surface qui n'existe que dans la plage de longueurs d'onde de résonance. L'effet d'amélioration autour des états interfaciaux et l'effet de piégeage de la lumière du dispositif matriciel fonctionnent ensemble pour la détection de la lumière faible dans notre appareil.
La figure 4 montre la relation entre la photoréponse du dispositif InAsSb NW en fonction des températures (Fig. 4a) et l'intensité lumineuse (Fig. 4b). La valeur de \({I}_{p}\) est la valeur extrême que le photocourant peut obtenir avec la lumière allumée. La photoréponse est normalisée par l'intensité lumineuse exacte pour masquer son influence sur la tendance. Dans un premier temps, nous pouvons conclure à une tendance similaire avec un éclairage d'intensité lumineuse différente. Dans toutes les parcelles, la photoconductance absolue augmente de 2 à 20 K, puis diminue jusqu'à 80 K, laissant le premier pic autour de 20 K et le deuxième pic autour de 100-120 K. La plage de température de ce pic est en accord avec la température spécifique plage où la « queue » du photocourant transitoire existe. L'autre pic se situe entre 100 et 120 K, et son emplacement spécifique se déplace vers une zone de température plus élevée avec une intensité lumineuse croissante.
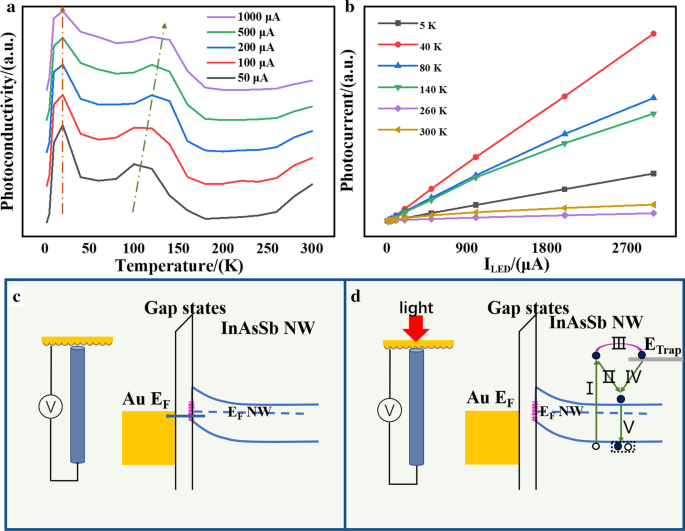
un La dépendance à la température de ΔG mesuré avec différentes intensités lumineuses. b La dépendance en puissance de ΔG mesuré à différentes températures. c La structure de bande de l'appareil avec une tension de polarisation. d La structure de bande de l'appareil avec l'éclairage lumineux
Le photocourant pourrait être exprimé par [28]
$${I}_{p}=qg{V}_{\mathrm{NW}}[\tau {\mu }_{d}/l]$$ (3)où \(q\) est la charge élémentaire, \(g\) est le taux de génération de photoporteur, \({V}_{\mathrm{NW}}\) est le volume NW, \(\tau\) est le durée de vie des porteurs minoritaires, et \({\mu }_{d}\) est la mobilité de dérive et \(l\) est la longueur NW. Cette équation clarifie la durée de vie des porteurs minoritaires et la mobilité de dérive sont deux paramètres clés pour le photocourant [43]. Le processus optoélectrique du dispositif de réseau InAsSb est illustré à la Fig. 4c, d. Avant que la lumière importée, les électrons transférés entre Au et InAsSb NWs forment le courant d'obscurité. Les états d'écart dus au dipôle d'interface sont suffisamment courts pour le transfert de porteur avec suffisamment de quantité de mouvement. Dans notre dispositif, les états d'interface induits par la structure de jumelage native et les défauts induits par la fabrication peuvent tous deux agir comme des états de piégeage. Une fois la lumière allumée, les électrons en excès avec suffisamment d'énergie et de quantité de mouvement seraient piégés dans les états d'interface, comme indiqué dans les processus I et III. La diminution de la concentration en électrons fait augmenter la mobilité dans le canal et prolonge la durée de vie des électrons photogénérés. D'autre part, les électrons piégés dans l'état d'interface dispersent les électrons dans le canal et font diminuer la mobilité. Les électrons libérés reviendraient dans la bande de conductance via le processus IV et participeraient au courant. Les électrons de plus faible énergie seraient motivés sur la bande conductrice et participeraient au courant comme indiqué dans le processus II. Après un certain temps, les électrons se recombinaient avec les trous laissés dans la bande de valence, comme indiqué dans le processus V. Nous pouvons conclure à deux types de processus de diffusion dans le dispositif :les centres de diffusion des électrons piégés et la diffusion électron-électron dans le canal [49] . Plus d'électrons piégés sur les états d'interface diminueraient la mobilité des porteurs et la concentration des porteurs dans le canal. Par la suite, la diffusion électron-électron serait affaiblie et agirait à son tour sur l'augmentation de la mobilité. En conclusion, ces deux processus de diffusion coopéreraient sur le courant et atteindraient un extrême autour de 10-20 K. La caractéristique notable de ce pic est la structure en « queue », le site de pic stable et la photoconductance persistante avec l'éclairage ultrafaible. Avec l'éclairement ultrafaible, la quantité de photons induite n'est pas suffisante pour atteindre d'un coup le photocourant saturé. Par conséquent, l'appareil affiche un photocourant persistant jusqu'à saturation. Lorsque l'intensité lumineuse est augmentée, les porteurs photoexcités augmentent le courant et atteignent la valeur extrême en un temps de réponse court. Cependant, c'est plus compliqué avec une intensité lumineuse plus élevée. Les porteuses en excès sur les états saturés sont piégées dans les états d'interface. Lorsque les électrons piégés sont libérés dans la bande de conductance, la concentration augmente à nouveau. L'augmentation de la diffusion électron-électron fait diminuer le courant, ce que l'on appelle un effet retardé, et crée la structure de « queue ».
Pour le deuxième pic autour de 100-120 K, un décalage de pic similaire a été signalé dans le Bi2 Te3 cinéma [50]. Notre analyse indique l'existence de centres de recombinaison dans cette gamme de température. Le mécanisme intrinsèque est similaire à Bi2 Te3 , tous deux liés à l'équilibre du photocourant (\({I}_{\mathrm{p}}\)) et du courant d'obscurité (\({I}_{\mathrm{d}}\)). Dans notre cas, \({I}_{\mathrm{d}}\) est presque constant dans toute la plage de température de mesure. \({I}_{\mathrm{p}}\) est déterminé par la durée de vie du porteur minoritaire et la mobilité de dérive. A noté que ces deux paramètres de InAsSb NWs ont des relations de dépendance opposée avec la température. Pour la durée de vie des porteurs minoritaires, les porteurs noirs excités thermiquement augmentent avec la température ainsi que le taux de recombinaison des porteurs photogénérés [51]. Ainsi, la durée de vie des porteurs minoritaires est inversement proportionnelle à la température. La mobilité de dérive est proportionnelle à la température car la température élevée produit l'effet d'excitation thermique dans les NW. Le pic apparaît lorsque \({I}_{\mathrm{p}}\) et \({I}_{\mathrm{d}}\) atteignent l'équilibre à une certaine température, qui est d'environ 100-120 K Avec une intensité lumineuse plus élevée, une plus grande quantité de porteurs photogénérés aurait besoin de plus de porteurs thermiquement excités à une température plus élevée pour nécessiter un équilibre. Par conséquent, le deuxième pic passe à une température plus élevée lorsque l'intensité lumineuse augmente. La figure 4b montre la photoconductivité en fonction de l'intensité lumineuse du dispositif InAsSb NW, où le ΔG les valeurs ne sont pas normalisées. Comme on peut le voir, l'intensité lumineuse de la LED augmente strictement linéairement avec le courant d'entrée (voir Fichier complémentaire 1 :Figure S6). Hence, this result represents the relationship between the photoresponse and the light intensity, demonstrating the potential of the InAsSb NW array device in optical power meter.
Conclusions
In summary, the sandwich-structured photodetector based on InAsSb NW array has achieved a splendid optical performance due to the MIGS induced by the end-bonded contact. Interface dipole and gap states suppress the dark current and enhance detection ability of the device. The native defects and the fabricated-induced defects in the device act as the interface states to modulate the optical properties. Even with the ultraweak light (4–20 nW/cm 2 ) illumination, the device shows obvious photoresponse at room temperature. The response to LEDs with different wavelengths indicated that the InAsSb NW array device has the strongest response to the infrared light (945 nm). The photoresponsivity and photodetectivity are 40 A/W and 7 × 10 11 cm Hz 1/2 W −1 , respectivement. These results confirmed that the sandwich structure in this study favors the repeatability and reliability of the NW devices, which paves a way for the fabrication of NW-based devices. Most importantly, the device may work in an ambient environment at room temperature, which is a great breakthrough for infrared detection.
Disponibilité des données et des matériaux
All data are fully available without restriction. Les ensembles de données utilisés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- MBE:
-
Epitaxie par faisceau moléculaire
- 1D:
-
Unidimensionnel
- NW :
-
Nanofil
- BEP :
-
Pression équivalente du faisceau
- VS :
-
Vapor–solid
- VLS :
-
Vapor–liquid–solid
- EBL :
-
Lithographie par faisceau d'électrons
- RIE :
-
Gravure ionique réactive
- WZ :
-
Wurtzite
- ZB :
-
Zinc blende
- BFTEM:
-
Bright-field scanning electron microscope
- HRTEM :
-
Microscope électronique à transmission haute résolution
- SAED :
-
Diffraction électronique à zone sélectionnée
- EDS :
-
Spectroscopie à dispersion d'énergie
- MIGS :
-
Metal-induced gap state
- IDEE:
-
Interface dipole enhancement effect
- LED :
-
Light emitting diode
Nanomatériaux
- Le transport quantique devient balistique
- Nanoparticules semi-conductrices
- Les nanocups peuvent courber la lumière
- Absorption de la lumière améliorée par le plasmon dans les cellules solaires à nanofils GaAs à jonction (p-i-n) :étude d'une méthode de simulation FDTD
- Performance photovoltaïque d'une cellule solaire hybride à nanostructure à nanofils/points quantiques
- Dépendances de la température et de la pression des propriétés élastiques des monocristaux de tantale sous charge de traction <100> :une étude de dynamique moléculaire
- Utiliser l'IA pour contrôler les propriétés de la lumière | Génération de supercontinuum
- C# - Propriétés
- Matrice de détecteurs d'inductance cinétique à micro-ondes dans l'infrarouge lointain (FIR MKID)



