HEMT double canal AlGaN hautes performances avec une densité de courant de drain améliorée et une tension de claquage élevée
Résumé
Dans ce travail, l'hétérostructure à double canal AlGaN est proposée et développée par dépôt chimique en phase vapeur métal-organique (MOCVD), et des transistors à haute mobilité électronique (HEMT) à double canal AlGaN haute performance sont fabriqués et étudiés. La mise en œuvre de la fonctionnalité de double canal améliore efficacement les propriétés de transport des hétérostructures de canal AlGaN. D'une part, la densité totale de gaz d'électrons en deux dimensions (2DEG) est favorisée en raison des doubles puits de potentiel le long de la direction verticale et du confinement accru des porteurs. D'autre part, la densité moyenne de 2 DEG dans chaque canal est réduite et la mobilité est élevée en raison de la suppression de l'effet de diffusion porteuse-porteuse. En conséquence, la densité de courant de drain maximale (I max ) des HEMT à double canal AlGaN atteint 473 mA/mm avec une tension de grille de 0 V. De plus, les performances de claquage supérieures des HEMT à double canal AlGaN sont également démontrées. Ces résultats montrent non seulement le grand potentiel d'application des HEMT à double canal AlGaN dans l'électronique de puissance micro-ondes, mais développent également une nouvelle réflexion pour les études de dispositifs électroniques à base de nitrure de groupe III.
Introduction
Les transistors à haute mobilité électronique (HEMT) à base de nitrure du groupe III ont été identifiés comme le candidat le plus prometteur pour l'électronique de puissance à micro-ondes de nouvelle génération en raison de leur vitesse de commutation rapide et de leurs faibles pertes de commutation [1,2,3,4,5] . Dernièrement, les HEMT au nitrure les plus avancés ont atteint une commercialisation initiale jusqu'à 650 V. Cependant, avec la maturité de la technologie de fabrication des dispositifs, il est devenu de plus en plus difficile d'augmenter davantage les tensions de claquage (V b ) et améliorer la fiabilité de l'appareil à haute température. Par conséquent, compte tenu de la plus grande bande interdite et de la stabilité thermique supérieure de l'AlGaN par rapport au GaN, les dispositifs à canal AlGaN ont été proposés comme candidats prometteurs pour améliorer encore les limites de performance des HEMT au nitrure dans les applications haute tension et haute température [6,7,8 ,9,10,11,12,13,14,15].
Nanjo et al. a démontré l'amélioration remarquable de la tension de claquage des HEMT à canal AlGaN, et les tensions de claquage maximales obtenues étaient de 1650 V dans le Al0,53 Ga0.47 S/O0.38 Ga0.62 N HEMT avec des distances grille-drain de 10 μm [6]. Par la suite, Nanjo et al. a encore favorisé la tension de claquage de l'Al0.40 Ga0,60 S/O0,15 Ga0,85 N HEMT à 1700 V [8]. Zhang et al. ont fabriqué les HEMT à canal AlGaN avec un nouveau contact de drain hybride ohmique/Schottky, et une tension de claquage record de plus de 2200 V a été obtenue pour les HEMT à canal AlGaN [11]. Xiao et al. a proposé les hétérostructures de canal AlGaN avec une mobilité 2DEG élevée de 807 cm 2 /V·s, et les enregistrements du courant de drain maximal et Ion /Ioff ont été rapportés pour les HEMT à canal AlGaN fabriqués [14]. Par la suite, Xiao et al. a proposé pour la première fois les HEMT normalement éteints avec une couche de canal AlGaN à super-réseau, et les dispositifs fabriqués ont montré une tension de claquage supérieure à 2000 V, une densité de courant élevée de 768 mA/mm et une tension de seuil (V T ) de 1,0 µV [15]. Récemment, Baca et al. ont évalué les performances radiofréquence (RF) des HEMT à canal AlGaN avec une porte de 80 nm de long. Le fT de 28,4 GHz et fMAX de 18,5 GHz ont été déterminés à partir de mesures des paramètres S de petits signaux [12]. Ces résultats illustrent la promesse des HEMT à canal AlGaN pour les applications de puissance RF.
Cependant, les limitations des dispositifs de canal AlGaN précédemment rapportés sont tout aussi évidentes. D'une part, en raison de l'effet de diffusion désordonnée de l'alliage ternaire, la mobilité bidimensionnelle du gaz d'électrons (2DEG) dans le canal AlGaN est beaucoup plus faible que celle dans le canal GaN. En conséquence, la capacité d'entraînement actuelle des dispositifs à canal AlGaN est bien inférieure à celle des dispositifs à canal GaN traditionnels. D'autre part, afin d'induire la même quantité de 2DEG dans le canal AlGaN, la composante AlN dans la couche barrière AlGaN doit être supérieure à celle des hétérostructures classiques du canal GaN, ce qui augmentera les difficultés du processus de croissance du matériau. Ces contradictions inhibent sérieusement l'application généralisée des dispositifs à canaux AlGaN, et les optimisations de la disposition de l'hétérostructure sont nécessaires de toute urgence.
La technique à double canal est une approche intéressante pour promouvoir la densité de porteurs de canaux des hétérostructures à base de nitrure sans aucun impact négatif sur la mobilité des électrons, et la capacité de conduction actuelle des dispositifs sera améliorée [16,17,18]. Cependant, il y a eu peu de rapports sur les hétérostructures à double canal AlGaN ou les dispositifs électroniques jusqu'à présent. Dans ce travail, pour la première fois, l'hétérostructure à double canal AlGaN est proposée et développée pour résoudre les contradictions entre la capacité d'entraînement actuelle et les performances de claquage du dispositif électronique à base de nitrure. En outre, des HEMT à double canal AlGaN hautes performances basés sur la nouvelle hétérostructure sont fabriqués et étudiés en détail.
Méthodes
Le schéma en coupe transversale de l'hétérostructure à double canal AlGaN est illustré à la figure 1a, et les processus de croissance peuvent être résumés comme suit. Tout d'abord, une couche tampon GaN de 1600 nm a été développée sur le substrat de saphir. Ensuite, une couche tampon d'AlGaN de 500 nm avec une composition en AlN augmentant de 0 à 10 % a été cultivée, ce qui a été bénéfique pour supprimer la formation de canaux parasites. Ensuite, un canal AlGaN inférieur de 100 nm, une couche intermédiaire d'AlN de 1 nm et une barrière inférieure d'AlGaN de 23 nm ont été cultivés successivement, et les compositions d'AlN dans les couches de canal et de barrière sont de 10 % et 31 %, respectivement. Enfin, un canal supérieur d'AlGaN de 30 nm, une couche intermédiaire d'AlN de 1 nm et des couches barrières supérieures d'AlGaN de 23 nm ont été développés, pour lesquels les compositions étaient les mêmes avec les couches inférieures. Le diagramme de bande de conduction de l'hétérostructure à double canal AlGaN peut être calculé en résolvant de manière auto-cohérente l'équation de Poisson-Schrödinger unidimensionnelle, qui utilise la méthode des différences finies avec une taille de maillage non uniforme [19]. Le diagramme de bande de conduction et la distribution de densité électronique extraite de l'hétérostructure à double canal AlGaN sont illustrés sur la figure 2a, et les résultats de l'hétérostructure à canal unique AlGaN sont également fournis sur la figure 2b pour la composition. Deux puits de potentiel profonds se forment à l'interface des intercalaires AlN et Al0.10 Ga0.90 N couches de canaux pour l'hétérostructure double canal AlGaN, correspondant aux canaux doubles 2DEG. De plus, on peut observer que la densité 2DEG dans le canal supérieur est plus élevée que celle dans le canal inférieur, ce qui peut s'expliquer par deux aspects. D'une part, la barrière inférieure en AlGaN fait office de barrière arrière du canal supérieur, ce qui est bénéfique pour favoriser le confinement 2DEG du canal supérieur. D'autre part, la principale source d'approvisionnement du canal 2DEG dans les hétérostructures de nitrure sont les états de surface de type donneur [20], qui sont plus proches du canal supérieur.
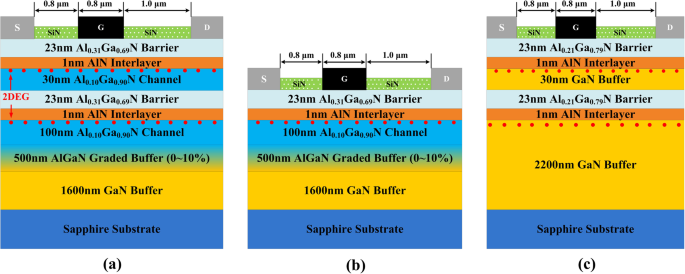
Vue en coupe (pas à l'échelle) de a Double canal AlGaN, b canal unique AlGaN, et c Hétérostructures à double canal GaN (HEMT)
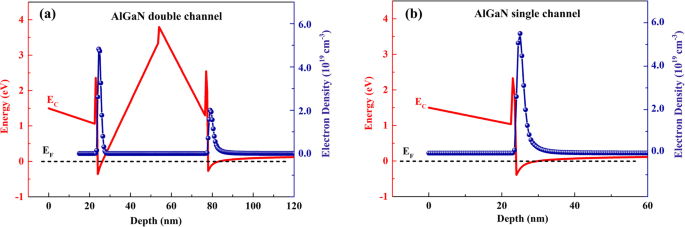
Diagrammes de bandes de conduction et distributions de densité électronique des hétérostructures à double canal et à canal unique en AlGaN
Résultats et discussion
La figure 3 affiche le résultat du balayage ω-2θ par diffraction des rayons X à haute résolution (HRXRD) de l'hétérostructure à double canal AlGaN à partir d'une réflexion symétrique (0004). L'intensité de diffraction de la couche de nucléation AlN, du tampon GaN, du tampon gradué AlGaN, du canal AlGaN et des couches barrières AlGaN peut être observée. De plus, le balayage du spectre de 71,0 à 73,2° est présenté sur la figure 2b avec un grossissement pour plus de clarté, et la fonction de Lorentz est appliquée pour s'adapter aux multi-pics. Les pics de diffraction du tampon GaN, du canal AlGaN et de la barrière AlGaN se situent à 71,6°, 72,2° et 72,8°, et le tampon gradué AlGaN donne une plate-forme entre les pics du tampon GaN et du canal AlGaN. Ces résultats indiquent la structure multicouche distincte et le contrôle sophistiqué du processus de croissance, et les compositions d'AlN de 10 % et 31 % dans le canal et la barrière d'AlGaN peuvent être extraites.

Balayage plan ω-2θ HRXRD (0004) de l'hétérostructure double canal AlGaN
Une mesure de capacité-tension (C-V) avec une configuration de sonde à mercure a été réalisée pour étudier les caractéristiques à double canal de l'hétérostructure. Comme le montre l'encadré de la figure 4, deux échelons de capacité distincts peuvent être observés à environ − 2,5 V et − 10 V avec la tension appliquée balayée de 0 à − 15 V, correspondant à l'épuisement de 2DEG à AlN/Al0.10 Ga0.90 interfaces. De plus, les propriétés de distribution des porteurs peuvent être extraites de la courbe C-V et le résultat est illustré à la Fig. 4. Deux pics de concentration des porteurs se situent à 24 et 78 nm avec les valeurs de 6,1 × 10 19 et 2,5 × 10 19 cm −3 , ce qui est conforme au résultat calculé comme le montre la figure 2. En particulier, aucun canal de conduction parasite ne peut être observé jusqu'à ce que la profondeur d'essai atteigne 1 m, ce qui suggère la réussite des propriétés de double canal de l'hétérostructure. De plus, la densité et la mobilité de la feuille 2DEG ont été déterminées à 1,3 × 10 13 cm −2 et 1130 cm 2 /V∙s par la mesure de l'effet Hall.
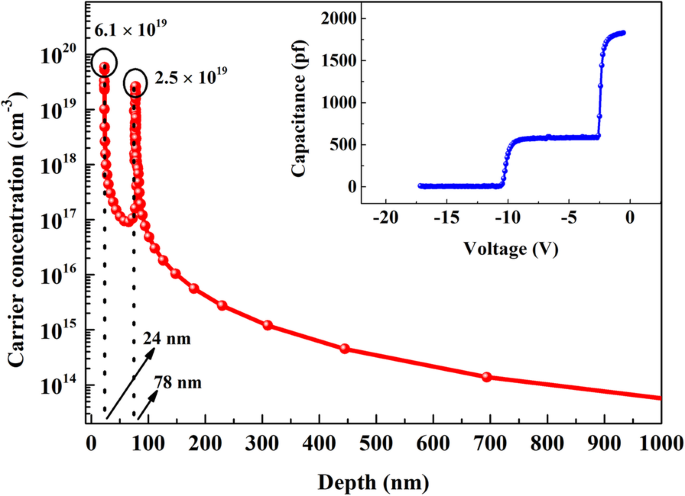
Caractéristiques C-V et courbe de distribution électronique de l'hétérostructure à double canal AlGaN
Le processus de fabrication standard des HEMT a été réalisé sur l'hétérostructure à double canal AlGaN. Le processus de fabrication du dispositif a commencé par un contact ohmique formé avec un empilement métallique multicouche Ti/Al/Ni/Au déposé par évaporation par faisceau d'électrons, suivi d'un recuit thermique rapide à 850 °C pendant 30 s dans N2 atmosphère. Ensuite, l'isolement mesa a été réalisé par Cl2 /BCl3 gravure au plasma à couplage inductif à une profondeur de 200 nm, et une couche de passivation SiN de 100 nm d'épaisseur a été formée par dépôt chimique en phase vapeur assisté par plasma. Ensuite, une zone de porte d'une longueur (L G ) de 0,8 μm a été défini par photolithographie après gravure du SiN supérieur avec CF4 plasma, puis une électrode de grille schottky Ni/Au a été déposée. La porte-source (L GS ) et vanne d'évacuation (L GD ) les distances sont respectivement de 0,8 et 1 µm. À des fins de comparaison, deux échantillons HEMT supplémentaires basés sur les hétérostructures classiques à canal unique AlGaN et à double canal GaN ont également été fabriqués, et les schémas de section transversale sont présentés sur les figures 1 b et c. Le processus de l'appareil et les paramètres caractéristiques des échantillons HEMT supplémentaires sont exactement les mêmes avec les HEMT à double canal AlGaN. Les propriétés de sortie et de transfert des dispositifs ont été réalisées avec l'analyseur de paramètres à semi-conducteurs Keithley 4200, et les caractéristiques de claquage ont été réalisées à l'aide du système d'analyseur de semi-conducteurs haute tension Agilent B1505A.
Les caractéristiques de sortie typiques des HEMT sont illustrées à la Fig. 5, pour laquelle le VGS et VDS ont été balayés de 0~− 10 V et 0~10 V. La densité de courant de drain maximale (I max ) et la résistance différentielle à l'état passant (R sur ) de l'échantillon à canal unique AlGaN sont respectivement de 265,3 mA/mm et 27,1 Ω∙mm. Ces résultats sont en accord avec les rapports précédents, suggérant l'insuffisance des HEMT à canal AlGaN dans la capacité d'entraînement actuelle. Pour les HEMT à double canal AlGaN, le I max augmente considérablement jusqu'à 473 mA/mm, ce qui est 1,8 fois supérieur à celui des HEMT à canal unique AlGaN. Nous attribuons l'amélioration de I max aux propriétés de transport supérieures de l'hétérostructure à double canal AlGaN. D'une part, la structure à double canal possède deux puits potentiels le long de la direction verticale, et la capacité de stockage de porteurs du canal de conduction AlGaN est favorisée. D'autre part, bien que la densité totale de porteurs de canal soit augmentée, la densité électronique moyenne dans chaque canal est réduite. En conséquence, l'effet de diffusion porteur-porteur est supprimé et la mobilité électronique du canal est élevée. Cependant, on peut observer que le R sur des HEMT double canal AlGaN est de 12,5 Ω∙mm, encore plus grand que celui des HEMT double canal GaN. Ce phénomène est lié à la grande hauteur de barrière de contact des couches barrières en AlGaN, dont la composition en AlN atteint jusqu'à 31 %. En raison de l'effet d'auto-échauffement résultant de la dissipation de puissance élevée, l'effet de résistance différentielle négative peut être observé pour les HEMT à double canal GaN lorsque V GS>− 4 V et V DS> 6 V. Néanmoins, pour les HEMT à canal AlGaN (à la fois monocanal et double canal), cet effet de résistance différentielle négative est considérablement supprimé, ce qui témoigne des performances supérieures des HEMT à canal AlGaN dans des conditions de température élevée.

Caractéristiques de sortie des HEMT double canal AlGaN, monocanal AlGaN et double canal GaN
La figure 6 illustre les propriétés de transfert typiques des HEMT avec V DS de 10 V. Les HEMT monocanal AlGaN présentent une tension de seuil (V T ) de − 3,8 V, avec une transconductance extrinsèque de crête inférieure (G m,max ) de 80,5 mS/mm au voisinage de V GS =− 1,5 V. Pour les HEMT double canal AlGaN et double canal GaN, le V T diminue remarquablement à - 9,2 et - 11,2 V, ce qui est dû à la densité élevée de porteurs de canal et à la distance relativement longue entre l'électrode de grille et le canal 2DEG inférieur. Le haut V T peut entraîner une perte de puissance élevée des dispositifs à l'état éteint, et ce problème peut être amélioré en optimisant davantage les paramètres de croissance des structures à double canal, telles que la réduction appropriée de l'épaisseur de la barrière et des couches de canal supérieures. En particulier, des caractéristiques de double bosse peuvent être observées sur les courbes de transconductance des HEMT à double canal AlGaN et à double canal GaN. Pour les HEMT à double canal AlGaN, deux valeurs de crête de 97,9 et 42,5 mS/mm peuvent être extraites à V G =− 1,0 et − 6,0 V. La valeur sous-crête atteint 43 % de la Gm,max , indiquant la capacité de contrôle de porte décente et la linéarité des HEMT à double canal AlGaN. De plus, sur la base de nos recherches précédentes [21], les résultats peuvent être encore améliorés en modulant les paramètres de structure, tels que l'épaisseur et la composition des doubles canaux AlGaN, et l'effet de couplage entre les doubles canaux et la linéarité du dispositif peut être amélioré.

Caractéristiques de transfert des HEMT double canal AlGaN, monocanal AlGaN et double canal GaN
Les caractéristiques de claquage à l'état bloqué des HEMT basées sur différentes hétérostructures sont mesurées et illustrées à la figure 7. Le V b est défini par les critères de courant de fuite atteignant 5 μA/mm. On peut observer que les trois échantillons présentent des caractéristiques de claquage dur, et les performances de claquage des HEMT à canal AlGaN sont évidemment meilleures que celles des HEMT à canal GaN. Le V b des HEMT double canal AlGaN est de 143,5 V, plus de deux fois supérieur à celui des HEMT double canal GaN. Prendre le L GD =1 μm en considération, le V b,standard (défini par V b /L GD ) atteint 143,5 V/μm pour les HEMT à double canal AlGaN. Le Je max et V b,standard les résultats des HEMT à double canal AlGaN dans ce travail sont comparés aux HEMT à canal GaN et à canal AlGaN rapportés par d'autres groupes sur la figure 8, et les résultats des dispositifs en mode d'épuisement (DM) et en mode d'amélioration (EM) sont distingués. De plus, les indices de base des HEMT du canal AlGaN (hétérostructures) dans les rapports précédents et ce travail sont résumés dans le tableau 1. Comme le montre la figure 8, il est évident que les performances de claquage des HEMT du canal AlGaN sont généralement meilleures que celles du GaN. HEMT canal, accompagnant la détérioration de I max . Notamment, le I max du double canal AlGaN dans ce travail est comparable à la plupart des résultats des HEMT à canal GaN. De plus, il faut noter que le I max la valeur dans ce travail est obtenue à V GS =0 V, ce qui est prudent et peut être encore amélioré par une tension de grille positive appliquée. Par conséquent, ces résultats démontrent de manière convaincante l'énorme potentiel des HEMT à double canal AlGaN dans les applications de dispositifs de puissance micro-ondes.

Caractéristiques de panne des HEMT double canal AlGaN, canal unique AlGaN et double canal GaN
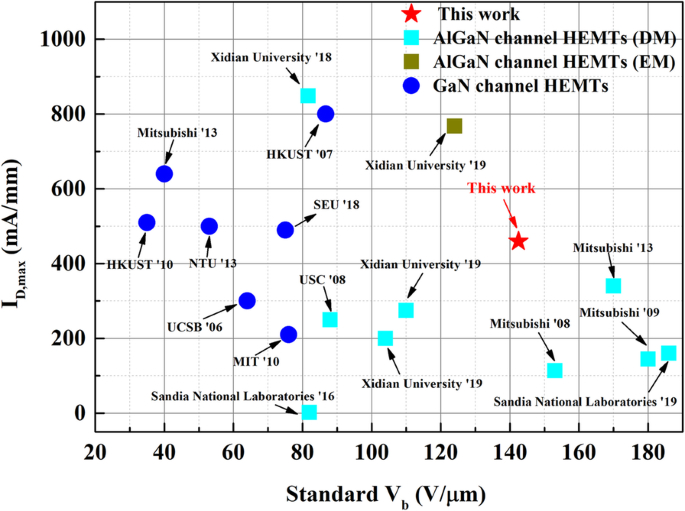
Référence de I max et V b,standard pour les HEMT du canal AlGaN et du canal GaN
Conclusions
En résumé, l'hétérostructure à double canal AlGaN est proposée pour fabriquer des HEMT de haute performance. Les propriétés de transport supérieures de l'hétérostructure à double canal AlGaN sont révélées, ce qui conduit à une meilleure capacité d'entraînement du courant des HEMT. De plus, l'excellente performance de claquage des HEMT à double canal AlGaN est démontrée. Les résultats de ce travail montrent le grand potentiel des dispositifs à double canal AlGaN dans les applications de puissance micro-ondes à l'avenir.
Disponibilité des données et des matériaux
Toutes les données générées ou analysées au cours de cette étude sont incluses dans cet article publié et ses fichiers d'informations supplémentaires.
Abréviations
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- HEMT :
-
Transistors à haute mobilité électronique
- 2DEG :
-
Gaz d'électrons bidimensionnel
- Je max :
-
Densité de courant de drain maximale
- V b :
-
Tension de claquage
- V T :
-
Tension de seuil
- RF :
-
Fréquence radio
- HRXRD :
-
Diffraction des rayons X haute résolution
- C-V :
-
Capacité-tension
- L G :
-
Longueur du portail
- L GS :
-
Distance porte-source
- L GD :
-
Distance porte-drain
- R sur :
-
Sur résistance
- G m :
-
Transconductance
- DM :
-
Mode d'épuisement
- EM :
-
Mode d'amélioration
Nanomatériaux
- Tension et courant
- Tension et courant dans un circuit pratique
- Tension de claquage de l'isolateur
- Condensateurs et calcul
- Calculs de tension et de courant
- Calculs complexes de tension et de courant
- Inductance mutuelle et fonctionnement de base
- Qu'est-ce que la maintenance des pannes et comment y faire face
- Matériaux et conception de PCB pour haute tension



