Étude théorique et expérimentale sur la diode barrière Schottky AlGaN/GaN sur substrat Si à double hétérojonction
Résumé
Une diode à barrière Schottky (SBD) AlGaN/GaN à double hétérojonction est étudiée théoriquement et expérimentalement sur le GaN/AlGaN/GaN/Si-sub. Le gaz de trou bidimensionnel (2DHG) et le gaz d'électrons (2DEG) sont formés respectivement à l'interface GaN-top/AlGaN et AlGaN/GaN. A l'état off, le 2DEH et le 2DHG sont partiellement épuisés puis disparaissent complètement. Il reste les charges fixes de polarisation positive et négative, formant la jonction de polarisation. Par conséquent, un champ électrique plat dans la zone de dérive et une tension de claquage élevée (BV) sont obtenus. De plus, l'anode est en retrait pour réduire la tension d'allumage (V ON ). Le processus de gravure ICP à faible endommagement permet d'obtenir des contacts Schottky améliorés, un faible courant de fuite et un faible V ON Est obtenu. Le SBD fabriqué présente un BV de 1109 V avec une distance anode-cathode (L CA ) de 11 μm. Les SBD fabriqués atteignent un faible V ON de 0.68 V avec une bonne uniformité, un rapport courant marche/arrêt élevé ∼ 10 10 à température ambiante, une faible résistance à l'état passant (R ON,SP ) de 1,17 mΩ cm 2 , et une figure de mérite (FOM) de Baliga élevée de 1051 MW/cm 2 .
Introduction
La diode latérale à base d'hétérostructure AlGaN/GaN est un dispositif attrayant en raison de la mobilité élevée des électrons du gaz d'électrons bidimensionnel (2DEG), de la vitesse de saturation élevée des électrons et du champ électrique de claquage élevé [1,2,3]. Des efforts considérables ont été déployés pour obtenir une faible tension de mise sous tension (V ON ), un faible courant de fuite inverse et une tension de claquage (BV) élevée pour les diodes GaN utilisées dans les convertisseurs et onduleurs pour les alimentations et les corrections de facteur de puissance [4,5,6,7,8,9,10,11,12] . Diverses approches ont été proposées pour résoudre la distribution non uniforme du champ électrique. L'une d'entre elles est la technologie des plaques de champ (FP) [5, 13]. Une anode SBD entièrement encastrée avec une plaque à double champ atteint une tension de claquage élevée de 1,9 kV avec 25 m L CA [5]. Il peut également réduire considérablement la tension d'allumage tout en maintenant une tension de claquage élevée. De plus, le concept de champ de surface réduit conventionnel (RESURF) couramment utilisé dans la technologie du silicium a été démontré dans GaN HEMT [14]. De plus, la jonction de polarisation (PJ) constituée du gaz de trou bidimensionnel (2DHG) au-dessus du 2DEG est proposée pour améliorer la relation entre la résistance active spécifique (R ON,SP ) et BV [15,16,17,18]. Des dispositifs à base de GaN basés sur le concept PJ ont été démontrés sur substrat Saphir et SiC, tandis que le coût élevé et les petits diamètres du GaN sur substrats SiC vont à l'encontre de l'application commerciale de masse. GaN-on-Si avec un grand diamètre est considéré comme un choix prometteur en raison de son faible coût [19,20,21,22]. Par conséquent, les performances de la diode PJ sur des substrats de silicium méritent d'être étudiées.
Dans ce travail, nous avons proposé et démontré expérimentalement une diode barrière Schottky GaN/AlGaN/GaN-on-Si à double hétérojonction (DJ). L'effet de jonction de polarisation est confirmé par des simulations et des expériences. Le champ électrique plat (champ E) entre les électrodes d'anode et de cathode est obtenu. Le processus ICP pour graver la tranchée Schottky est optimisé pour obtenir un faible courant de fuite inverse et un faible V ON avec une excellente uniformité de gravure. Le processus de contact ohmique est également optimisé pour obtenir une faible résistance de contact (pour 2DEG) basée sur la couche épitaxiale personnalisée (avec 45 nm GaN-top). Par conséquent, une tension de claquage de 1109 V est atteinte pour les SBD avec 11 μm L CA et la figure de mérite (FOM) de Baliga est de 1051 MW/cm 2 . La dépendance à la température et la dynamique R ON,SP les performances sont également étudiées.
Méthode et expérience
La couche épitaxiale a été développée par dépôt chimique en phase vapeur métal-organique sur du silicium de type p de 6 pouces, composé d'une couche tampon GaN de 3,5 m, d'une couche de canal GaN de 150 nm, d'une couche intermédiaire d'AlN de 1 nm, d'Al 45 nm 0,25 Ga0,75 Couche barrière N et couche supérieure GaN à 45 nm de bas en haut. La couche supérieure de GaN comprend une couche de p-GaN de 35 nm et une couche de GaN non dopée de 10 nm. Pour une épaisseur d'AlGaN donnée de 45 nm, la densité de 2DHG augmente avec l'augmentation de l'épaisseur de GaN-top [22]. L'épaisse couche supérieure de GaN est vitale pour le 2DHG haute densité, alors qu'elle va à l'encontre de la faible résistance de contact ohmique (pour le 2DEG). Les vues schématiques de la diode à barrière Schottky à double hétérojonction (DJ SBD) proposée sont illustrées à la figure 1a. La fabrication du SBD a commencé avec l'isolement de la mesa par Cl2 /BCl3 -gravure plasma à couplage inductif (ICP) à une profondeur de 300 nm. Ensuite, la tranchée ohmique et la tranchée d'anode Schottky ont été formées avec le processus de gravure ICP à faible endommagement. La profondeur de la tranchée ohmique et de la tranchée d'anode Schottky était de 50 nm et 90 nm, respectivement, ce qui a été confirmé en utilisant la microscopie à force atomique (AFM). Une solution d'hydroxyde de tétraméthylammonium (TMAH) à 85 °C pendant 15 min a été introduite pour éliminer les résidus de post-gravure et pour modifier la paroi latérale de la tranchée après avoir terminé le processus de gravure [23]. Puis, le recuit à 400 °C pendant 10 min en N2 ambiante a été réalisée. La cathode ohmique a ensuite été formée par e-beam évaporé Ti/Al/Ni/Au (20/140/55/45 nm), recuit à 870 °C pendant 35 s dans N2 ambiante, avec une résistance de contact (R C ) de 0,49 Ω·mm. Enfin, le métal de l'anode et les interconnexions ont été déposés par Ni/Au pour compléter le flux de fabrication. Les appareils comportaient divers L CA de 7 à 11µm. La figure 1b montre l'image MET en coupe transversale haute résolution de l'anode après ICP et dépôt de métal, et la structure de la couche a été clairement observée.
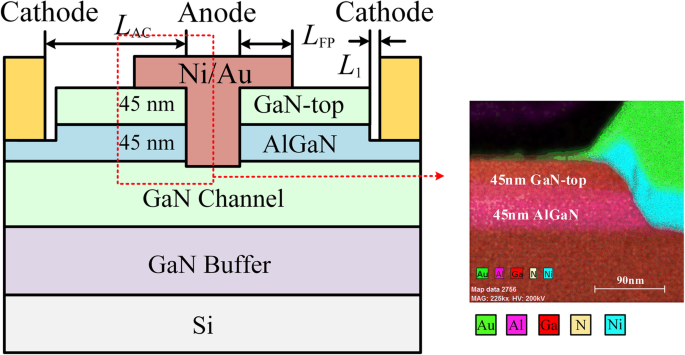
un Coupe transversale du SBD AlGaN/GaN à double hétérojonction proposé et procédé de fabrication principal. L CA est la longueur de l'anode à la cathode. L FP et L 1 sont respectivement de 1 µm et 2 µm. b Image HR-TEM de l'anode après ICP et dépôt de métal
Le 2DEG est induit par les charges de polarisation positive le long de l'interface AlGaN/GaN. L'interface supérieure GaN/AlGaN a des charges de polarisation négatives et génère donc du 2DHG à l'interface supérieure [15]. L'espace entre la zone de dérive et la cathode (L 1 ) est utilisé pour couper le chemin du courant de trou comme le montre la Fig. 2. Nous avons seulement étudié l'influence de L 1 de 2 à 3 μm sur les caractéristiques de blocage avant et arrière en raison de la limite de la conception d'implantation d'origine. Le V ON et R ON,SP n'affiche aucun changement car L 1 n'affecte pas le contact Schottky et le chemin du courant électronique. De plus, le BV diminue légèrement avec l'augmentation de L 1 en raison de la zone de dérive raccourcie. Le mécanisme de fonctionnement des SBD DJ sous polarisation directe est presque le même que celui des SBD conventionnels, ce qui signifie que le 2DHG affecte à peine le chemin du courant électronique de la cathode à l'anode. Avec l'augmentation de la tension de polarisation inverse, les 2DEG et 2DHG sont complètement épuisés. Il reste des charges fixes de polarisation positive et négative, qui forment la jonction de polarisation. En conséquence, une distribution plate du champ E entre la cathode et l'anode est obtenue (Fig. 3).
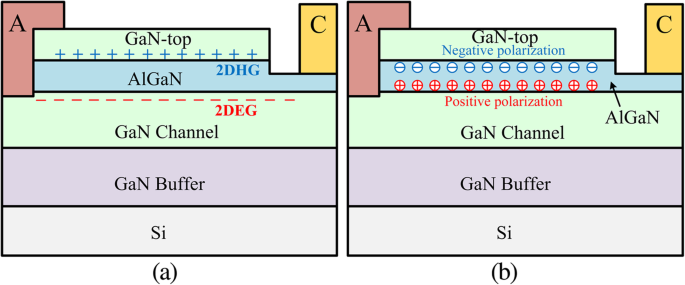
Analyse du mécanisme de fonctionnement des DJ SBD a biais zéro et b biais inversé

Distribution du champ électrique le long de l'hétérointerface canal AlGaN/GaN par simulation TCAD. La fraction Al est définie comme 0,25. La densité nette d'accepteurs (niveau profond) dans la couche tampon est fixée à 1,5 × 10 16 cm −3 et le niveau d'énergie est de 0,45 eV en dessous du minimum de la bande de conduction. La densité d'accepteurs de l'interface AlGaN/GaN est fixée à 6 × 10 12 cm −3 et le niveau d'énergie est de 0,23 eV en dessous du minimum de la bande de conduction
Comme le montre la figure 3, la caractéristique de claquage et le mécanisme de polarisation-jonction ont été confirmés par Sentaurus TCAD 2-D de Synopsys. Nous avions pris en compte plusieurs phénomènes physiques importants dans la simulation, notamment le rétrécissement de la bande interdite, la polarisation, la mobilité électron/trou, l'ionisation par impact et la recombinaison SRH.
La mesure par effet Hall a été adoptée pour déterminer les valeurs de densité et de mobilité 2DHG ou 2DEG [22]. Les mesures ont été effectuées par la méthode de Van der Pauw à température ambiante. Pour mesurer 2DHG selon Réf. [17], les échantillons de mesure Hall ont été fabriqués avec des contacts ohmiques Ni/Au. La densité et la mobilité du 2DHG étaient de 9 × 10 12 cm −2 et 15 cm 2 /V s, respectivement. Le 2DEG a été mesuré par les échantillons avec évidement GaN-top et partiellement AlGaN fabriqués avec des contacts ohmiques Ti/Al/Ni/Au (pour 2DEG). La densité et la mobilité du 2DEG étaient de 8,5 × 10 12 cm −2 et 970 cm 2 /V s, respectivement. Les mesures de Hall ont montré que la mobilité des trous était encore bien inférieure à la mobilité en vrac sur 100 cm 2 /Vs. La dégradation de la mobilité a été attribuée à la diffusion de Mg du p-GaN au GaN non dopé au cours de la croissance MOCVD.
Résultats et discussion
Le I-V mesuré caractéristiques avancées des SBD avec divers L CA sont tracés sur les Fig. 4a et b. La tension de mise sous tension (V ON ) est de 0,68 V avec une petite variation de 0,02 V. Le facteur d'idéalité et la hauteur de barrière des SBD sont calculés respectivement comme 1,44 ± 0,15 et 0,76 ± 0,04 eV. La figure 4a montre que la densité de courant directe élevée de 183 mA/mm et 144 mA/mm (@ polarisation directe de 2,5 V) et la résistance à l'état passant de 0,642 et 1,17 mΩ cm 2 sont atteints à L CA =7 et 11 μm, respectivement. De plus, un excellent rapport courant marche/arrêt ∼ 10 10 est obtenu comme le montre la figure 4b. La pente sous-seuil (SS) est de 63,0 mV/dec, ce qui est proche de la SS idéale (59,6 mV/dec).
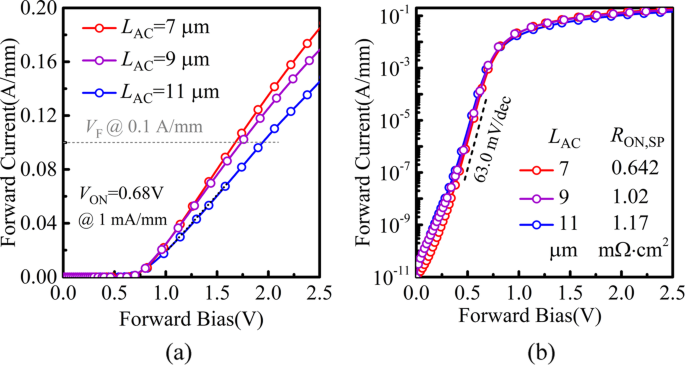
Biais avant mesuré I-V caractéristiques des DJ SBD en a linéaire et b échelle semi-log avec différents L CA
La figure 5a montre le blocage inverse mesuré I-V caractéristiques des SBD avec divers L CA à 300 K. La tension de claquage des appareils avec différents L CA est de 803 V, 940 V et 1109 V, respectivement, à un courant de fuite de 1 mA/mm. Les densités de 2DEG et 2DHG sont supposées les mêmes lors de la simulation. Cependant, les résultats expérimentaux montrent que les densités de 2DHG (9 × 10 12 cm −2 ) sont légèrement supérieurs à ceux du 2DEG (8,5 × 10 12 cm −2 ). La différence entre les charges fixes de polarisation positive et négative pendant l'état bloqué affecte l'équilibre des charges et dégrade ainsi la tension de claquage. L'influence du L CA sur le BV et le R ON,SP est représenté sur la figure 5b. Une relation presque linéaire entre BV et L CA est obtenu, impliquant le champ E latéral plat relatif dans la région de dérive. En raison de l'effet de jonction de polarisation, l'appareil démontre une haute figure de mérite de Baliga (FOM =BV 2 /R ON,SP ) de 1051 MW/cm 2 (@ L CA =11 μm).
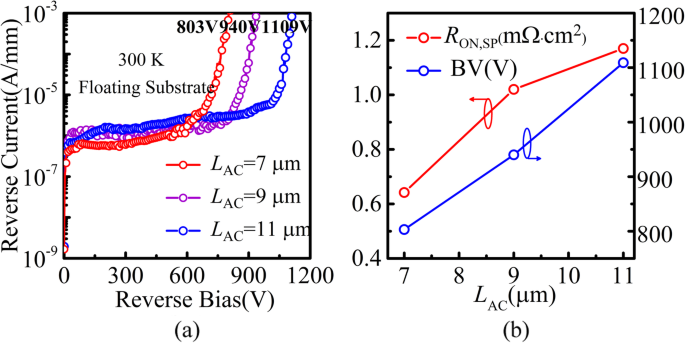
un Blocage inverse mesuré I-V caractéristiques des DJ SBD avec différents L CA (b ) R ON,SP et BV en tant que fonctions de L CA
Le processus de gravure est vital pour l'interface Schottky et le contact ohmique de haute qualité. La figure 6a montre la morphologie de surface de la tranchée en retrait après la gravure ICP (@ 5 °C) et la solution de TMAH. Le taux de gravure est d'environ 4,9 nm/min, et la recette finale sélectionnée est avec un Cl2 de 4 sccm, une puissance ICP de 50 W et une puissance RF de 15 W. La rugosité moyenne quadratique (RMS) est de 0,244 nm avec une zone de balayage de 2 × 2 μm 2 .
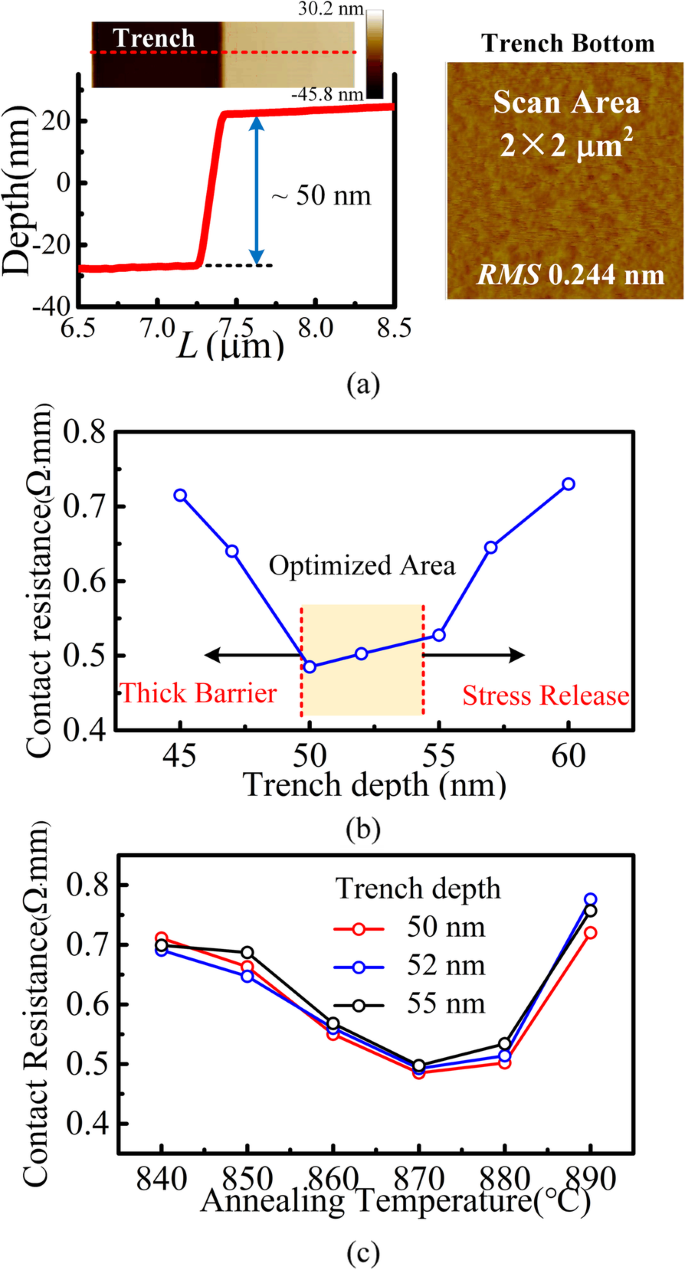
un Morphologie AFM de la tranchée après gravure ICP. b Influence de la profondeur de gravure sur la résistance de contact ohmique par test TLM. c Résistance de contact en fonction de la température de recuit avec la profondeur de tranchée de 50 à 55 nm. Le temps de recuit était de 35 s
Étant donné que la couche épitaxiale personnalisée comprend une couche supérieure de GaN de 45 nm et une couche d'AlGaN de 45 nm, le processus de contact ohmique (pour 2DEG) est différent des SBD conventionnels. Sans évidement à la fois des couches barrière GaN-top et AlGaN, une faible résistance de contact est difficile à obtenir par recuit en raison de la barrière de potentiel entre le métal ohmique et le 2DEG. Cependant, si la barrière est trop en retrait, le relâchement des contraintes conduit à une réduction de la concentration en 2DEG. Les processus supplémentaires sont adoptés pour réduire la résistance de contact ohmique. Les surfaces des échantillons sont traitées par la solution d'HCl pour éliminer la couche d'oxyde natif avant dépôt. De plus, le traitement de surface plasma est adopté (puissance ICP 50 W BCl3 10 sccm 3 min) pour introduire des états donneurs de surface [24]. La figure 6b montre la dépendance de la résistance de contact sur la profondeur de la tranchée. La profondeur optimisée est obtenue de 50 à 55 nm. Le recuit thermique rapide (RTA) à haute température pour le contact Ti/Al/Ni/Au est étudié sur la figure 6c. La température de recuit est de 840 à 890 °C et les 870 °C donnent la résistance de contact la plus faible. Le recuit à haute température, c'est-à-dire 870°C, est propice à la formation de TiN à l'interface Ti/nitrure. Cependant, une température plus élevée (par exemple, 890 °C) augmente l'interdiffusion d'Au et d'Al, ce qui est désavantageux pour la formation de bons contacts ohmiques.
Les figures 7a–c présentent les graphiques statistiques des caractéristiques statiques, y compris V ON , V F , et BV. Les données sont extraites de 72 SBD avec L CA de 7, 9 et 11 m fabriqués en 3 cycles de processus distincts. Les appareils affichent des caractéristiques de mise en marche avant stables et le V ON est indépendant avec L CA , parce que V ON est principalement déterminé par le contact Schottky. Le processus de gravure ICP à faible endommagement, la profondeur de tranchée contrôlée avec précision et l'interface Schottky de haute qualité contribuent à l'excellente uniformité du V ON et V F . De plus, avec l'augmentation de L CA (de 7 à 11 μm), il y a une augmentation monotone (∼ 100 V/μm) de la BV observée dans les structures proposées. La figure 7d montre les statistiques de l'histogramme du V ON pour 72 appareils, et la valeur moyenne est de 0,68 V avec une petite dérivation standard de 0,02 V.

Graphiques statistiques de a tension d'allumage, b tension directe et c tension de claquage extraite de 72 SBD avec L CA de 7, 9 et 11 m fabriqués en 3 cycles de processus distincts. d Distribution de V ON pour 72 appareils
La dépendance à la température des caractéristiques inverse et directe est évaluée sur la figure 8. Comme le montre la figure 8a, une augmentation de la température ambiante de 300 à 475 K entraîne une augmentation du R ON,SP par un facteur de 1,94.
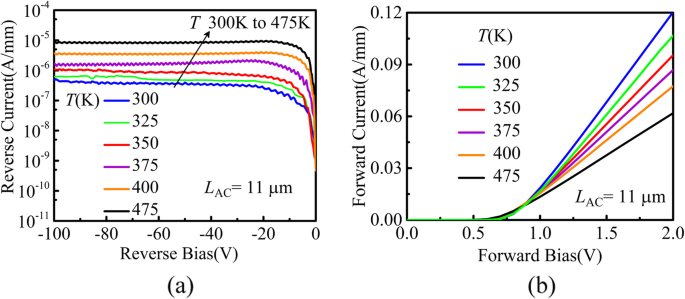
un Courant de fuite inverse et b caractéristiques avancées pour les DJ SBD à différentes températures
Les caractéristiques dynamiques des DJ SBD sont mesurées par l'analyseur de dispositif de puissance Agilent B1505A. Les points de polarisation au repos de l'impulsion d'anode sont définis sur − 10 V, − 20 V, − 30 V, − 40 V, − 70 V et − 100 V, avec une largeur et une période d'impulsion d'anode de 0,5 ms/500 ms. La figure 9b montre le R dynamique ON,SP en fonction de la tension de contrainte. Le R dynamique ON,SP même à 100 V, la tension de contrainte de réserve n'est que de 1,18 fois celle sans contrainte inverse, ce qui est comparable à la réf. [8]. L'augmentation limitée de la dynamique R ON,SP contribue à la réduction de l'état de l'interface. La dégradation du R dynamique ON,SP a besoin de plus de travail.
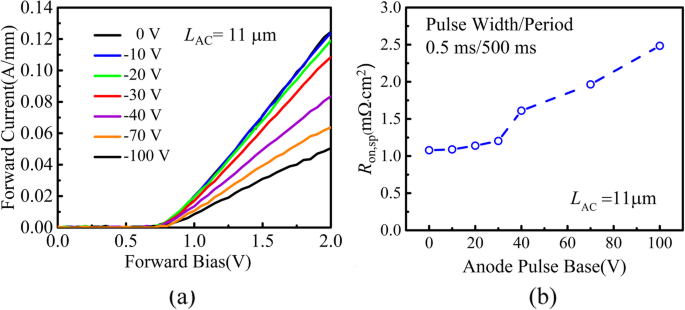
un I-V caractéristiques sous la mesure du pouls. b R extrait ON,SP par rapport à la base d'impulsions d'anode avec largeur/période d'impulsion =0,5 ms/500 ms
La figure 10 présente le graphique de référence de BV par rapport à R ON,SP pour diode de puissance GaN sur substrats Si/SiC/saphir [8, 10, 22, 25,26,27,28,29,30,31]. L'appareil proposé avec L CA de 11 μm démontre un BV de 1109 V avec un R correspondant ON,SP de 1,17 mΩ cm 2 , conduisant à un FOM de Baliga élevé de 1051 MW/cm 2 . Cette valeur est le meilleur résultat parmi la diode de puissance latérale GaN sur substrat Si.
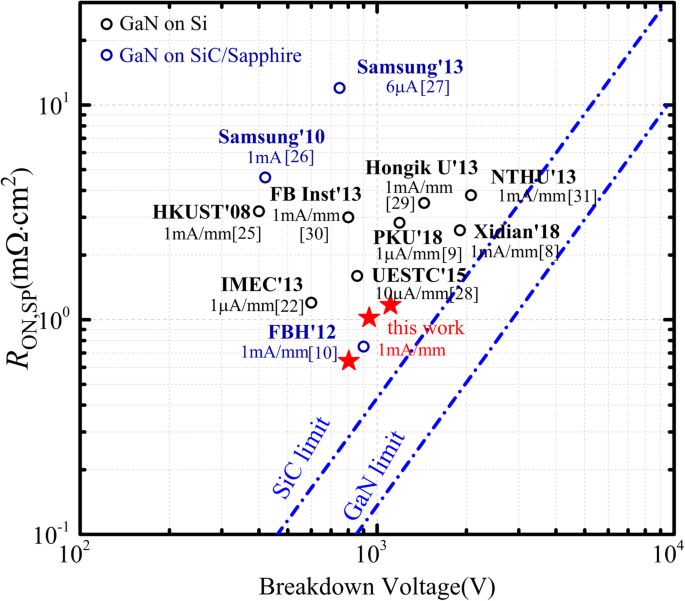
Graphique de référence de BV par rapport à R ON,SP de diode de puissance GaN sur substrats SiC/saphir/Si. La fuite inverse utilisée pour définir la panne est également donnée
Conclusion
Un SBD GaN/AlGaN/GaN-on-Si à double hétérojonction avec un facteur de mérite élevé est fabriqué. Le processus de gravure ICP à faible endommagement permet d'optimiser les contacts ohmiques et Schottky pour le dispositif proposé. Par conséquent, un faible V ON de 0,68 V avec une bonne uniformité et un faible R ON,SP de 1,17 mΩ cm 2 sont obtenus dans l'appareil avec L CA de 11 μm. Un FOM de Baliga élevé de 1051 MW/cm 2 est obtenu grâce à l'effet de jonction de polarisation. Les hautes performances associées à la technologie GaN-on-Si à faible coût présentent un grand potentiel pour les futures applications d'alimentation.
Disponibilité des données et des matériaux
Toutes les données générées ou analysées au cours de cette étude sont incluses dans cet article.
Abréviations
- SBD :
-
Diode barrière Schottky
- 2DEG/2DHG :
-
Gaz électron/trou bidimensionnel
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- ICP :
-
Plasma à couplage inductif
- TEM :
-
Microscope électronique à transmission
- AFM :
-
Microscope à force atomique
- BV :
-
Tension de claquage
- R ON,SP :
-
Sur-résistance spécifique
- V ON :
-
Tension de mise sous tension
- FOM :
-
Figure de mérite
Nanomatériaux
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Recherche expérimentale sur la stabilité et la convection naturelle du nanofluide TiO2-eau dans des enceintes avec différents angles de rotation
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- RGO et réseaux tridimensionnels de graphène co-modifiés TIM avec de hautes performances
- Étude expérimentale sur les caractéristiques d'écoulement et de transfert de chaleur de nanofluides TiO2-eau dans un tube cannelé en spirale
- Aérogel de graphène/polyaniline avec superélasticité et haute capacité en tant qu'électrode de supercondensateur hautement tolérante à la compression
- Étude expérimentale d'éthosomes encapsulés de 5-fluorouracile combinés à un laser fractionné au CO2 pour traiter les cicatrices hypertrophiques
- Présentation de la diode barrière Schottky à base de semi-conducteur Ga2O3 à bande interdite ultra-large pour les applications d'électronique de puissance
- Avantages et inconvénients des angles d'hélice élevés et faibles



