Transistor mémoire ferroélectrique 2D MoS2 fonctionnant à basse tension avec structure de porte Hf1-xZrxO2
Résumé
Le transistor à effet de champ ferroélectrique (FeFET) apparaît comme une technologie de mémoire non volatile intrigante en raison de sa vitesse de fonctionnement et de son endurance prometteuses. Cependant, l'inversion de la polarisation nécessite une tension élevée par rapport à celle de la lecture, impactant la consommation électrique de l'écriture d'une cellule. Ici, nous rapportons une cellule FeFET compatible CMOS avec une faible tension de fonctionnement. Nous concevons le ferroélectrique Hf1-x Zrx O2 (HZO) film mince pour former des diélectriques de grille à capacité négative (NC), qui génère une boucle d'hystérésis à contre-horloge du domaine de polarisation dans le disulfure de molybdène à quelques couches (MoS2 ) FeFET. Le condensateur négatif non stabilisé prend en charge de manière inhérente le taux d'oscillation sous-thermionique et permet ainsi de commuter la polarisation ferroélectrique avec la fenêtre d'hystérésis bien inférieure à la moitié de la tension de fonctionnement. Le FeFET affiche un rapport courant marche/arrêt élevé de plus de 10 7 et une fenêtre de mémoire (MW) dans le sens inverse des aiguilles d'une montre de 0,1 V à une tension minimale de programme (P)/effacement (E) de 3 V. Endurance robuste (10 3 cycles) et la rétention (10 4 s) les propriétés sont également démontrées. Nos résultats démontrent que le HZO/MoS2 Le transistor de mémoire ferroélectrique peut offrir de nouvelles opportunités dans les applications de mémoire non volatile évolutives en taille et en tension.
Contexte
Le marché de la mémoire embarquée système sur puce (SoC) est actuellement dans une ère de croissance énorme, ce qui nécessite que la mémoire soit capable d'atteindre un fonctionnement plus rapide, une taille de cellule plus petite et une consommation d'énergie moindre [1,2,3,4,5,6 ]. La mémoire ferroélectrique, l'un des candidats les plus prometteurs, a été reconsidérée, en raison de la découverte de l'oxyde ferroélectrique d'hafnium en 2011 [7].
Au cours des dernières décennies, le FeFET n'a pas bien fonctionné dans tous ces aspects, notamment les exigences de basse tension pour le fonctionnement de la mémoire, la simplicité de l'étape du processus et le processus d'intégration métal-oxyde-semiconducteur (CMOS) minimalement complémentaire et les problèmes de contamination limités [8,9,10, 11]. Pour résoudre ce problème, récemment, une enquête considérable sur la mémoire non volatile (NVM) FeFET 2D a été réalisée sur la base de divers matériaux ferroélectriques, y compris PbZrTiO3 (PZT) et le polymère [P(VDF-TrFE)] [12,13,14,15,16,17,18], ce qui est dû aux propriétés prometteuses du matériau 2D dans « plus que l'ère Moore ». Dans le FeFET, les deux états de polarisation spontanée stables d'un matériau ferroélectrique incorporé dans un empilement de grille de transistor sont utilisés pour le stockage de données via la tension de seuil contrôlable permise par les tensions de grille P/E rétrécies appliquées. Il est rapporté que les comportements d'hystérésis reproductibles, un rapport marche/arrêt élevé de 10 4 , bonnes propriétés de rétention jusqu'à 10 4 s, et un fonctionnement de commutation stable ont été obtenus dans PZT/MoS2 FeFET [19]. Notamment, une mobilité maximale de 625 cm 2 /V∙s, un grand MW de 16 V pour une plage de tension de grille ± 26 V et un rapport marche/arrêt élevé de 8 × 10 5 ont également été démontrés par un polymère de type n [P(VDF-TrFE)]/MoS2 FeFET [15]. Cependant, il y a tellement de problèmes fondamentaux qui pourraient empêcher son application pratique, comme la compatibilité CMOS, la capacité de mise à l'échelle et les états d'interface entre Fe et le matériau 2D. L'oxyde d'hafnium ferroélectrique, une sorte de nouveau matériau ferroélectrique, a une excellente compatibilité CMOS et une capacité de mise à l'échelle, qui pourraient servir pour le FeFET NVM avancé au nœud technologique inférieur à 5 nm au cours des 5 à 10 prochaines années [20]. En conséquence, un lot de HfO2 des empilements diélectriques ont été incorporés dans des FeFET 2D, qui visent à obtenir des transistors à effet de champ à capacité négative (NCFET) avec une commutation ON/OFF abrupte via une pente inférieure à 60 mV/décennie et des caractéristiques sans hystérésis [21,22,23 ,24,25,26], Bien que des expériences de masse basées sur un empilement diélectrique NC avec des matériaux de canaux 2D alternatifs aient tiré des conclusions fantastiques, elles ont mis en évidence les exigences de surtension pour faire la distinction entre les NCFET et les FeFET. Il y a encore un manque d'investigation systématique concernant la physique et la viabilité de la technologie de l'appareil sur la mémoire ferroélectrique à un transistor basée sur MoS2 et ferroélectrique HZO.
Dans ce travail, un FeFET avec un HZO MoS2 à quelques couches transistor a été proposé. Il est capable de mettre à l'échelle la tension P/E via l'effet NC induit par l'ingénierie de la pile de grilles sous une tension P/E réduite. Nous avons démontré expérimentalement qu'un MW dans le sens inverse des aiguilles d'une montre de 0,1 V avec une pente inférieure à 60 mV/décade a été atteint dans HZO MoS2 FeFET, qui peut être attribué à la modulation de densité de porteurs locale dans le canal 2D par retournement rapide du dipôle ferroélectrique. Nous avons attribué la diminution de l'hystérésis du HZO/MoS2 FeFET en tant que tension de drain augmentant jusqu'à l'effet négatif d'abaissement de la barrière induite par le drain (DIBL). De plus, il a également été systématiquement étudié la rétention, les caractéristiques d'endurance et la dépendance de la tension de seuil à la tension de drain du HZO MoS2 FeFET, ouvrant une voie possible pour concevoir HZO MoS2 FeFET NVM et ses applications pratiques.
Méthodes
6 nm Hf1-x Zrx O2 film et 2 nm Al2 O3 a été déposé le p + Substrat Si utilisant ALD à 300 °C, avec [(CH3 )2 N]4 Hf(TDMAHf), [(CH3 )2 N]4 Zr(TDMAZr) et H2 O vapeur comme précurseur Hf, précurseur Zr et précurseur oxydant, respectivement. Par la suite, le substrat a subi un recuit thermique rapide (RTA) à 450 °C pendant 30 s dans N2 ambiant. Après cela, MoS à quelques couches2 les flocons ont été exfoliés mécaniquement et transférés sur le substrat. Le diamètre de p + Substrat Si utilisé pour déposer HZO (6 nm)/AI2 O3 (2 nm) est de 6 pouces. Nous avons utilisé la lithographie par faisceau d'électrons (EBL) pour modeler les plots de contact en résine poly(méthacrylate de méthyle) (PMMA) A5. Les paramètres d'essorage, les paramètres de cuisson et les paramètres d'imagerie sont de 500 r/min (9 s) + 4000 r/min (40 s), 170 °C (5 min), MIBK:IPA =1:3 (15 s), respectivement . Ensuite, les électrodes source/drain (Ti/Au, 5/65 nm d'épaisseur) ont été évaporées à l'aide d'un système d'évaporation par faisceau électronique (EBE) et gravées par une solution d'acétone. Après le décollage, le dispositif a été recuit à 300 °C pendant 2 h pour améliorer le contact. Nous avons réalisé la caractérisation électrique de nos MoS2 fabriqués /Transistors à effet de champ HZO utilisant une station de sonde avec un micromanipulateur. La tension de la grille arrière (V GS ) a été appliqué sur le substrat Si fortement dopé de type p. Un système de caractérisation des semi-conducteurs (PDA) a été utilisé pour mesurer la tension source-drain (V DS ), la tension de la grille arrière (V GS ), et le courant source-drain (I DS ).
Résultats et discussion
Nous avons préparé un MoS2 à quelques couches par exfoliation mécanique du cristal massif et transfert du MoS2 nanoflake sur le 2 nm Al2 O3 /6 nm HZO/p + Substrat Si (voir plus de détails dans la section « Expérimental »). Les figures 1a et b affichent une vue schématique 3D et une coupe transversale du HZO/MoS2 structure FeFET, respectivement. Une image de microscopie électronique à balayage (MEB) vue de dessus du HZO/MoS2 FeFET est représenté sur la figure 1c. La largeur et la longueur du MoS2 canal sont 2 μm et 12 μm, respectivement. Comme le montre la figure 1d, l'épaisseur du MoS2 canal a été confirmée par microscopie à force atomique (AFM). L'épaisseur mesurée de 1,57 nm indique la présence de 4 couches de MoS2 [26].
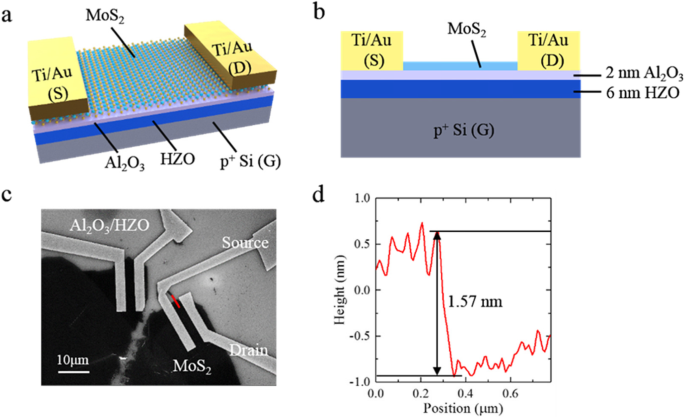
Structure de l'appareil et propriétés de base du MoS2 /HZO FeFET. un Représentation schématique en trois dimensions du MoS2 /HZO FeFET. b Coupe schématique du MoS2 /HZO FeFET. c Image SEM vue de dessus du MoS2 fabriqué /HZO FeFET avec électrodes de source/drain Ti/Au, isolateurs de grille ferroélectriques HZO et MoS2 canaux. d Profil de hauteur utilisant l'AFM en mode contact le long de la ligne rouge en c , validant la hauteur du MoS2 chaîne.
Comme le montrent les figures S1c et d, la composition élémentaire et de liaison de HZO a été examinée par les mesures de photoélectrons à rayons X (XPS). Les pics sont de 19,05 eV, 17,6 eV, 185,5 eV et 183,2 eV, ce qui correspond au Hf 4f5/2 , Hf 4f7/2 , Zr 3d3/2 , et Zr 3d5/2 , respectivement [27]. La concentration atomique le long du profil de profondeur de la figure S1e confirme en outre la distribution de l'Al2 O3 /HZO/p + Structure tricouche en Si. Tout ce qui précède confirme que le film HZO développé via notre système de dépôt de couche atomique (ALD) est hautement cristallin.
Avant d'étudier la caractérisation de HZO/MoS2 FeFET, le comportement ferroélectrique de l'Au/2 nm Al2 O3 /6 nm HZO/p + L'empilement de grilles en Si utilisant une mesure de tension de polarisation est illustré à la figure 2a. De toute évidence, notre fabriqué 6 nm HZO/2 nm Al2 O3 les condensateurs présentent des boucles d'hystérésis de tension de polarisation (mesurées à 1 kHz). Pendant ce temps, la polarisation résiduelle P r et la tension coercitive V c augmenter avec l'augmentation de la tension de balayage maximale, impliquant le P-V les boucles d'hystérésis se transforment de boucle mineure en boucle majeure. Lorsque la tension de balayage maximale passe de 2 à 4 V, P r atteint 0,66 μC/cm 2 , 0.86 μC/cm 2 , et 1,1 μC/cm 2 , respectivement et V c atteint respectivement 1,12 V, 1,9 V et 2,04 V. P extrait r et V c dans les 10 5 des cycles de balayage continus durables sont illustrés sur les figures 2b et c. De toute évidence, des effets de réveil et de fatigue importants dans les 10 5 des cycles sont observés dans le 6 nm HZO/2 nm Al2 O3 condensateur. Le réveil et la fatigue peuvent être attribués à la diffusion et à la redistribution des lacunes d'oxygène sous le champ électrique. L'effet de fatigue est généralement associé à un piégeage de charges au niveau des sites de défauts liés aux lacunes en oxygène [28]. Les comportements d'hystérésis pour la PRphase et boucle en forme de papillon pour le PRampl utilisant la microscopie à force de réponse piézoélectrique (PFM) sont affichées sur les figures S1b et c, indiquant une commutation de polarisation en fonction de la tension de polarisation de balayage. Compte tenu des différentes résistances de contact entre la mesure de tension de polarisation et la mesure de tension de réponse piézo, le V mesuré c dans la Fig. S1b et c n'est pas si cohérent avec les valeurs obtenues dans la Fig. 2a.

un Boucles d'hystérésis P-V pour le HZO (6 nm)/Al2 O3 (2 nm) condensateur avec différentes plages de balayage de tension. Dépendance de (b ) P r et c V c sur le cyclisme pour le HZO (6 nm)/Al2 O3 Condensateur (2 nm) avec cyclage ± 4 V/1 kHz
De plus, il est observé qu'il y a une augmentation de MW accompagnée d'une plage de tension de balayage élevée de la tension de grille (V GS,gamme ). Habituellement, le film polycristal HZO existe sous forme d'état multi-domaines [29], et la distribution du champ coercitif de ces domaines satisfait la distribution gaussienne. Ainsi, il doit y avoir une dépendance accrue vis-à-vis du V élevé GS,gamme . La coercition déposée E C correspond à la valeur du champ électrique extérieur qui peut réduire la polarisation rémanente à zéro. Par conséquent, le V GS ,plage utilisé pour changer la polarisation dans le film HZO devient plus grand avec une tension coercitive associée plus élevée V C . C'est la raison pour laquelle les boucles de polarisation-tension du film HZO sont étendues avec un plus grand V GS,gamme , ce qui a été démontré sur la figure 2a. En d'autres termes, l'intensité de polarisation améliorée et la commutation ferroélectrique se produisent avec le V élevé GS,gamme , conduisant aux phénomènes susmentionnés du MW étendu dans le sens antihoraire produit par l'augmentation de V GS,gamme . Au V GS,gamme =(−2, 2 V), les MW sont presque disparus et des caractéristiques presque sans hystérésis apparaissent, ce qui signifie la compensation presque complète entre les effets de la commutation ferroélectrique et du piégeage/dépiégeage de charge.
Afin d'étudier plus avant l'effet de la commutation ferroélectrique, le V GS,gamme a été continuellement augmenté à (−6, 6 V) et (−6,5, 6,5 V). Le I mesuré DS -V GS courbes du HZO MoS2 FeFET à V GS,gamme =(−6, 6 V) et (−6,5, 6,5 V) sont illustrés à la Fig. 3a. De même, la fenêtre de mémoire dans le sens antihoraire est augmentée avec le V étendu GS,gamme . Au V GS,gamme =(−6,5, 6,5 V), le MW dans le sens inverse des aiguilles d'une montre est supérieur à 4 V et le rapport marche/arrêt augmente également jusqu'à 10 7 , ce qui est dû à la commutation de polarisation améliorée sous une tension appliquée externe plus importante. Généralement, le mécanisme sous-jacent aux comportements d'hystérésis montré dans le I DS -V GS courbes lors du balayage bidirectionnel de V GS est le décalage de tension de seuil, qui peut être modifié par les effets prédominants de la commutation de polarisation, c'est-à-dire l'effet NC [30,31,32], entraînant une hystérésis dans le sens inverse des aiguilles d'une montre. Une étude plus approfondie des caractéristiques inférieures au seuil améliorées a été réalisée dans l'autre appareil sous un V rétréci. GS,gamme . Le I mesuré DS -V GS et extrait le point SS—I DS courbes de l'autre appareil en V GS,gamme =(−3, 3 V) sont tracés sur la figure 3b. Il est démontré qu'à V GS,gamme =(−3, 3 V), HZO/MoS2 FeFET expose SSFor =51,2 mV/décade et SSRev =66,5 mV/décade, respectivement. C'est-à-dire que la SS de moins de 60 mV/décade et un MW de 0,48 V peuvent être atteints simultanément dans HZO/MoS2 FeFET à température ambiante, ce qui sera un indice pour faire la distinction entre NCFET et FeFET.
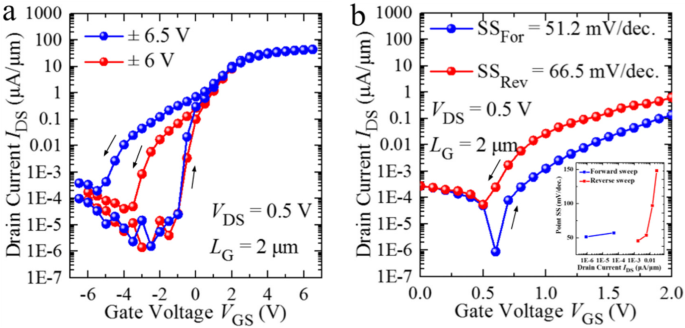
Le test de courant continu (CC) du HZO/MoS2 FeFET lorsque la tension de drain (V DS ) est de 0,5 V. a La comparaison entre les courbes de transfert avec 6 V et 6,5 V comme maximum de la tension de grille arrière. b Vue agrandie des courbes de transfert à intervalle de 0 à −2 V de V GS,gamme =(−3, 3 V). Point de pente sous-seuil (SS) en fonction du courant de drain (I DS ) du HZO/MoS2 FeFET est (b ) en médaillon. L'appareil affiche SSFor =51,2 mV/déc
Comme on le sait, dans le NCFET, le SS peut être inférieur à 60 mV/décade à température ambiante en raison de l'incorporation de la capacité diélectrique de grille négative (C ins ), qui peut être obtenu via le segment de pente négative de dP /dE <0 induit par le film ferroélectrique, contribuant au facteur d'empilement de grille (m) <1. Le mécanisme sous-jacent à l'effet NC [33] est le champ de dépolarisation généré par le film ferroélectrique [34,35,36,37,38]. Il est rapporté expérimentalement qu'en raison de l'écran incomplet à l'interface du film ferroélectrique [39], la charge de polarisation résiduelle pourrait produire un champ électrique interne à travers le film ferroélectrique, qui a la direction opposée à la tension appliquée de l'extérieur, conduisant à la re- distribution de la tension aux bornes de la pile de grilles et du potentiel de surface du canal amplifié, appelé « effet d'amplification de tension » [40,41,42]. L'amplification de tension peut généralement être divisée en deux parties, la variation accélérée du potentiel de surface du canal et la valeur amplifiée qui s'ensuit, fournissant la commutation marche/arrêt abrupte et l'amélioration I ON /Je OFF , respectivement. Cependant, pour FeFET, il y a une autre histoire. Selon le concept d'adaptation de capacité entre la capacité ferroélectrique (C FE ) et la capacité métal-oxyde-semiconducteur (C MOS ) [43,44,45], lorsque |C FE |> C MOS , la capacité théorique totale (C total ) est positif et le système est stable, ce qui entraîne les mêmes comportements de polarisation lors du balayage bidirectionnel de V GS et le NCFET stable sans hystérésis. Cependant, une bonne correspondance entraînant une amélioration de la SS et de la transconductance est très difficile à réaliser, car les deux C MOS et C FE sont des condensateurs très non linéaires et dépendants de la polarisation. De plus, |C FE |> C MOS doit être assuré pour toute la plage de tension de fonctionnement afin d'éviter l'hystérésis. Au lieu de cela, une fois |C FE | <C MOS , le C théorique total est négatif et le système est instable, un comportement de polarisation séparé doit se produire pendant la bi-commutation de V GS pour garder le C total positif, ce qui pourrait produire l'hystérésis dans le sens inverse des aiguilles d'une montre dans FeFET pour l'application NVM. Ici, il est mentionné que les comportements hystérétiques sont l'effet ultérieur de la commutation de polarisation séparée, ce qui signifie que la largeur de la fenêtre d'hystérésis peut être facilement modifiée en fonction du concept d'adaptation de capacité, tel que, qui peut être manipulé par la variation de V DS . Avec une adaptation de capacité appropriée, même avec un V très rétréci GS,gamme =(−3, 3 V), HZO/MoS2 FeFET présente toujours une fenêtre d'hystérésis évidente et la commutation abrupte de SSFor =51,2 mV/dec en même temps, ce qui suggère en outre l'existence de l'effet NC (effet de polarisation ferroélectrique) dans la région sous-seuil également. Bien que NCFET et FeFET soient différents, FeFET peut également être adopté en tant que dispositifs logiques avec un MW plus petit comparable, maintenant un SS profond inférieur à 60 mV/dec et un I plus élevé. ON /Je OFF également en raison de l'effet NC.
L'impact de V DS sur la largeur de MW a été soigneusement étudiée. Le Je DS -V GS courbes sur des échelles logarithmiques sous différents V DS sont caractérisés sur la figure S3. Il est démontré que, à un V fixe GS,gamme =(−2, 2 V), les valeurs de V GS extrait à I DS =70 nA pour le balayage bidirectionnel de V GS tout bascule dans le sens négatif. Pendant ce temps, il est également démontré que la variation du balayage vers l'avant de V GS est beaucoup plus évidente que celle du balayage inversé, indiquant les phénomènes importants de DIBL négatif. Il est à noter que l'effet DIBL négatif se produit toujours avec un effet NC [46, 47].
Après le test de courant continu (CC) ci-dessus du HZO/MoS2 FeFET, nous avons en outre effectué les MW mesurés pour différents P/E V GS impulsions d'une largeur de 10 µms sur la figure 4a. MW est défini comme le changement maximum ΔV TH après P/E V GS impulsions. Pendant le V pulsé GS application, les autres terminaux ont été fixés sur V S =V D =0 V. Pour l'opération de lecture (R), V GS était compris entre −1 V et 1 V avec V D =0.5 V et V S =0 V. Comme le montre la figure 4a, les MW extraits deviennent plus grands que P/E V GS les impulsions augmentent. Lorsque le P/E imposé V GS l'impulsion est de ± 3 V, le MW extrait est de 0,1 V. Lorsque le P/E imposé V GS l'impulsion est de ± 5,5 V, la MW extraite est de 0,275 V. Par rapport aux MW dans le sens inverse des aiguilles d'une montre de 4 V et 0,48 V sur les figures 3a et b, les MW extraits après P/E V GS le pouls est fortement réduit. Ceci est peut-être dû à une densité plus élevée d'états de piégeage induite par une humidité élevée dans l'air [48]. Ainsi, le mécanisme de piégeage/dépiégeage de charge est amélioré et la boucle d'hystérésis dans le sens inverse des aiguilles d'une montre est finalement diminuée. De plus, nous avons étudié l'endurance à vélo et la rétention des données du HZO/MoS2 FeFET sous des impulsions P/E avec une hauteur de ± 5,5 V sur la figure 4b. Le programme V GS le pouls était large de 10 ms avec V S =V D =0 V. La figure 4b illustre les MW mesurés en fonction des cycles d'endurance. Le cycle d'endurance est formé par des impulsions périodiques P/R/E/R de tension de grille arrière. Les tensions appliquées à la grille arrière de la hauteur de P, E, R étaient respectivement de + 5,5 V, -5,5 V et 0 V. Et la largeur d'impulsion de P et E était de 10 µms. En clair, un MW de 0,3 V peut être maintenu sans dégradation significative après 10 3 Cycles P/E. Au fur et à mesure que le nombre de cycles d'endurance augmente, le MW augmente à 0,38 V après 10 cycles, puis diminue à 0,28 V après 600 cycles. Le premier MW élargi est appelé effet de réveil et le dernier MW rétréci est appelé effet de fatigue. L'effet de réveil correspond au débrochage de la paroi du domaine, conduisant à une augmentation des domaines de polarisation commutables du film HZO [49]. L'effet de fatigue correspond aux charges nouvellement injectées qui épinglent les parois du domaine après un grand nombre de cycles P/E [50]. La conservation des données à température ambiante est illustrée à la figure 4c. Ici, la dégradation MW est négligeable après 10 4 s. Par conséquent, on peut s'attendre à ce qu'un MW d'environ 0,3 V soit durable sur 10 ans d'après les lignes d'extrapolation en pointillés. Comme présenté sur la Fig. 4d, l'appareil est stable après 10 3 cycles sous les impulsions P/E avec des hauteurs de ± 3 V. La stabilité du HZO/MoS2 FeFET montre une grande perspective d'applications dans la technologie de mémoire non volatile.

Performances mémoire du HZO/MoS2 FeFET sous impulsions P/E. un MWs extraits (MWs) sous des impulsions P/E avec des hauteurs de ± 3 V, ± 4 V, ± 5 V, ± 5,5 V et ± 6 V. b Mesures d'endurance dans des conditions d'impulsion P/E. c Caractéristique de rétention du HZO/MoS2 FeFET. d Endurance du HZO/MoS2 FeFET pour 10 3 cycles sous les impulsions P/E avec des hauteurs de ± 3 V
Une comparaison de la figure de mérite avec des appareils basés sur FeFET combinant MoS2 et les diélectriques de grille ferroélectrique sont fournis dans le tableau 1. Ici, la structure du dispositif, la polarisation résiduelle, le champ électrique coercitif, la direction de la boucle d'hystérésis, le MW, la tension de fonctionnement, les cycles d'endurance et le temps de rétention sont répertoriés. Il est évident que le dispositif que nous avons fabriqué présente la couche ferroélectrique la plus fine de 6 nm HZO et la tension de fonctionnement la plus faible par rapport à d'autres travaux [12,13,14,15,16,17,18], ce qui est important pour le futur 2 nm ou nœud de processus 3 nm de la mémoire de fin de ligne (BEOL). En mettant à l'échelle l'épaisseur de la couche ferroélectrique, un MW d'environ 0,1 V a été atteint sous une faible tension de fonctionnement de ± 3 V. Une telle tension de fonctionnement faible peut être attribuée aux caractéristiques intrinsèques de la couche HZO par rapport à leurs homologues, tels que P (VDF-TrFE) ou HfO2 , qui a une épaisseur beaucoup plus élevée. De plus, notre appareil possède une polarisation résiduelle inférieure P r de 1,1 μC/cm 2 par rapport aux autres FeFET signalés. La décroissance rapide de la perte de rétention dans un FeFET est due à l'existence d'un champ de dépolarisation E départ , qui provient de la compensation de charge incomplète due à l'existence de l'Al2 O3 couche. Ici, E départ est directement proportionnel à la polarisation rémanente P r [51]. Ainsi, le haut E c et faible P r faire le rapport E départ /E c en MoS2 /HZO FeFET très faible, conduisant à une perte de rétention très faible associée à l'effet de champ de dépolarisation. Bien que les performances de rétention de MoS2 Les FeFET basés sur HZO et P(VDF-TrFE) sont tous deux d'environ 10 4 s, le film P(VDF-TrFE) doit être de 150 nm [17].
Conclusions
En conclusion, nous avons étudié MoS2 à quelques couches à base de transistors ferroélectriques à mémoire utilisant un diélectrique de grille arrière HZO. Nos dispositifs fabriqués présentent une hystérésis antihoraire induite par la polarisation ferroélectrique. De plus, notre HZO/MoS2 Le transistor à mémoire ferroélectrique affiche d'excellentes performances de l'appareil :un rapport courant marche/arrêt élevé de plus de 10 7 et un MW dans le sens inverse des aiguilles d'une montre de 0,1 V à une tension P/E de 3 V, qui a l'endurance (10 3 cycles) et la rétention (10 4 s) performances. Nous pensons donc que les résultats de notre MoS2 Les transistors à mémoire ferroélectrique non volatile présentent des perspectives prometteuses pour l'avenir des applications de mémoire non volatile 2D à faible consommation.
Disponibilité des données et des matériaux
Les auteurs déclarent que les matériaux, les données et les protocoles associés sont à la disposition des lecteurs, et toutes les données utilisées pour l'analyse sont incluses dans cet article.
Nanomatériaux
- Cotations et packages de transistors (BJT)
- Quelques exemples avec des circuits CA
- American Control Electronics :variateur CC basse tension avec option de carte programmable encliquetable
- MoS2 avec épaisseur contrôlée pour l'évolution électrocatalytique de l'hydrogène
- Nanosphères de carbone monodispersées à structure poreuse hiérarchique comme matériau d'électrode pour supercondensateur
- Électrode porte d'argent imprimée par jet d'encre et durcie aux UV avec une faible résistivité électrique
- Amélioration de la modulation et de l'absorption de fréquence du microbolomètre THz avec structure en micropont par antennes de type spirale
- Morphologie, structure et propriétés optiques des films semi-conducteurs avec des nano-îlots GeSiSn et des couches tendues
- Croissance du marché du contrôle basse tension



