Fabrication de microdisques GeSn de haute qualité et sans contrainte en intégrant des méthodes de croissance épitaxiale sélective et de gravure humide sélective
Résumé
Le GeSn est un matériau prometteur pour la fabrication de dispositifs photoniques et nanoélectroniques sur puce. Des techniques de traitement dédiées au GeSn ont ainsi été développées, parmi lesquelles l'épitaxie, le recuit, l'implantation ionique et la gravure. Dans ce travail, des microdisques GeSn suspendus, détendus et de haute qualité sont réalisés par une nouvelle approche sans aucune gravure de l'alliage GeSn. L'alliage GeSn a été développé sur un substrat Ge (001) pré-structuré par épitaxie par faisceau moléculaire à basse température. La microscopie électronique à transmission et la microscopie électronique à balayage ont été réalisées pour déterminer les microstructures des échantillons de GeSn. Les microdisques avec différents diamètres de socles Ge ont été fabriqués en contrôlant le temps de gravure humide sélectif, et les résultats micro-Raman montrent que les microdisques avec différentes dimensions des socles Ge restants ont différents degrés de relaxation de contrainte. La contrainte de compression des microdisques est presque complètement relâchée dans des conditions appropriées. La technologie de traitement des semi-conducteurs présentée dans ce travail peut être une méthode alternative pour fabriquer des micro/nano-structures innovantes à base de GeSn et d'autres matériaux pour une gamme d'applications photoniques compatibles Si, 3D-MOSFET et microélectromécaniques.
Introduction
Le germanium-étain (GeSn), un matériau complémentaire compatible métal-oxyde-semiconducteur (CMOS) du groupe IV, a beaucoup attiré l'attention ces dernières années pour ses applications en électronique et en optoélectronique. Allier plus de Sn dans Ge peut améliorer la mobilité des porteurs ainsi que changer la bande interdite d'une transition indirecte à une transition directe [1, 2]. Les travaux théoriques [3,4,5] et les études expérimentales basées sur la photoluminescence [6,7,8] montrent que la transition indirecte-directe pour l'alliage GeSn relaxé se produit à une teneur en Sn d'au moins 6,5 %. Cependant, la faible solubilité à l'équilibre (1%) du Sn dans Ge [9, 10] et le grand décalage de réseau (~ 15%) entre Ge et -Sn introduisent d'énormes défis pour la réalisation d'un alliage GeSn sans défaut avec même un quelques % atomiques de Sn de substitution. L'utilisation de techniques de croissance hors équilibre telles que l'épitaxie par faisceau moléculaire à basse température (MBE) [11,12,13,14,15], le dépôt chimique en phase vapeur (CVD) [16,17,18,19,20], et l'épitaxie en phase solide [21, 22] est grandement nécessaire.
Dans le cas de l'alliage GeSn développé sur un substrat virtuel ou un substrat Ge à contrainte de relaxation, la plus haute qualité de GeSn devrait être obtenue dans la condition pseudomorphique ou entièrement contrainte, ce qui peut éviter la formation de décalages et de dislocations de filetage. Néanmoins, un tel alliage GeSn est soumis à une contrainte de compression (~ 0,15% pour 1% de Sn) et cette contrainte induite par l'épitaxie annule l'effet de l'alliage de Sn avec Ge pour la conversion de la bande interdite. En conséquence, une teneur en Sn beaucoup plus élevée de 17% pour l'épi-couche pseudomorphique de GeSn sur Ge (001) [23] est nécessaire pour atteindre la bande interdite directe, ce qui entraîne des défis extrêmement élevés pour l'épitaxie et une faible qualité du matériau. Par conséquent, la manipulation de la déformation sans sacrifier la qualité du cristal des épi-couches de GeSn devient un enjeu très important. L'élimination sélective du substrat virtuel de Ge induisant des contraintes ou du substrat de Ge sous les épi-couches de GeSn pour former des microstructures partiellement suspendues est une technique prometteuse pour surmonter la contrainte de compression dans les films de GeSn. Par exemple, des microdisques GeSn suspendus avec un pilier de support au centre ont été fabriqués [24,25,26,27,28]. La structure peut non seulement détendre la contrainte de compression dans la couche de GeSn par déformation élastique au niveau des surfaces libres, mais aussi confiner les modèles optiques près du bord du microdisque en raison du fort contraste d'indice de réfraction entre le GeSn et le milieu environnant (air), tel que le chuchotement -galerie-mode [16, 25]. Jusqu'à présent, une seule méthode de préparation du microdisque GeSn par lithographie optique post-croissance et gravure descendante du film GeSn bidimensionnel est décrite [16, 24, 29, 30]. Cependant, le processus peut subir des effets de décalage thermique pendant le processus de gravure post-croissance, ce qui entraînera une dégradation de la qualité du matériau des microdisques GeSn. Récemment, P. Ponath et al. ont signalé la croissance sélective de la zone de c hautement cristallin -axe BTO orienté [31], qui nous a inspiré pour la fabrication de microstructures GeSn. En déposant directement des microdisques GeSn en dernière étape sur un SiO2 pré-structuré Substrat /Ge puis gravure sélective du substrat Ge suivant le SiO2 sacrificiel élimination de la couche, les microdisques GeSn suspendus peuvent être fabriqués sans le processus de gravure post-croissance conventionnel et complexe. Un tel procédé, si possible, peut éviter les problèmes mentionnés ci-dessus et ainsi obtenir une microstructure GeSn de meilleure qualité et détendue en déformation. De plus, c'est également une méthode très prometteuse qui permet d'obtenir des motifs arbitraires avec une grande précision et un bon rapport hauteur/largeur, en particulier pour l'intégration tridimensionnelle de structures de dispositifs complexes qui nécessitent un contrôle précis de l'épaisseur des couches.
Dans cet article, les structures de microdisques GeSn ont été fabriquées avec succès par une nouvelle méthode. C'est la première fois que l'on prépare des microdisques GeSn en combinant une croissance épitaxiale sélective avec une simple étape de gravure humide sélective. L'épaisseur, la concentration en Sn et la qualité cristalline de l'épi-couche de GeSn ont été caractérisées par microscopie électronique à transmission à haute résolution (HRTEM) et spectrométrie de masse d'ions secondaires (SIMS). La microscopie électronique à balayage (MEB) et la spectroscopie micro-Raman (μ-Raman) ont été utilisées pour mieux comprendre les microstructures des microdisques GeSn fabriqués. Les résultats μ-Raman à température ambiante (RT) montrent que les microdisques avec différentes dimensions des socles Ge restants ont des degrés différents de relaxation de contrainte. La contrainte de compression des microdisques est presque complètement relâchée dans des conditions appropriées. Cette méthode de fabrication de microdisques sans avoir besoin de graver le GeSn lui-même est bénéfique pour obtenir des nanostructures de GeSn et d'autres matériaux détendues et de haute qualité.
Méthodes
Matériaux
Les plaquettes Ge ont été achetées à la société AXT. L'acétone, l'alcool isopropylique, l'acide fluorhydrique, l'alcool éthylique, le peroxyde d'hydrogène, l'ammoniaque et l'hydroxyde de potassium ont été fournis par Sinopharm Chemical Reagent (Chine). H2 désionisé O (18,2 MΩ·cm) a été obtenu à partir d'un système d'ultrafiltration (Milli-Q, Millipore, Marlborough, MA).
Préparation du substrat Ge à motifs
Les plaquettes Ge (001) (type n, 0,025-0,031 cm) ont d'abord été immergées dans de l'acétone et de l'alcool isopropylique pendant 3 min, puis nettoyées chimiquement à l'aide d'une solution d'acide fluorhydrique dilué (HF:H2 O =1:20) pendant 20 s à TA. Ceci a été suivi d'un rinçage en exécutant H2 désionisé O (DI–H2 O). La procédure de nettoyage est importante, en particulier le traitement HF pour décoller la couche d'oxyde natif et pour garantir que la surface du Ge est propre et en contact étroit avec le prochain SiO2 couche. Dans ce cas, le profil de décollage est réalisé par le dépôt d'un Si/SiO2 couche composite. Ensuite, les plaquettes ont été séchées en soufflant à sec N2 et rapidement chargé dans la chambre à ultravide (UHV) de dépôt chimique en phase vapeur assisté par plasma (PECVD) et recuit à 300 ° C pendant 20 min pour dégazer complètement. Ensuite, un SiO2 à 300 nm couche a été déposée à la même température par PECVD suivi d'un dépôt de 50 nm de Si polycristallin non dopé par pulvérisation magnétron à température ambiante, comme le montre la figure 1a. Ouvertures circulaires dans le Si/SiO2 Les couches composites sont modelées à l'aide d'une technique de photolithographie standard (Fig. 1b) et de processus de gravure en deux étapes (Fig. 1c, d).
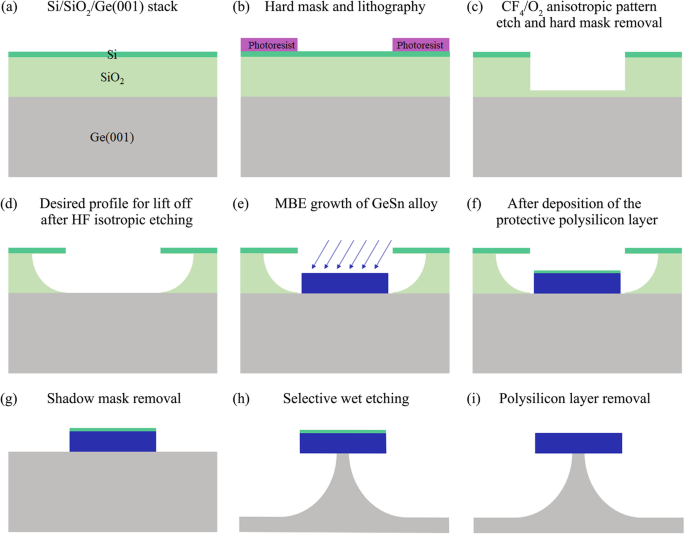
L'illustration des schémas en coupe pour la fabrication des microdisques GeSn suspendus
En détail, avant de modeler le Si/SiO2 /Ge plaquette, la plaquette a été nettoyée par de l'acétone, de l'alcool éthylique et du DI-H2 O, puis brushé avec N2 et précuit au four à 90 °C. Par la suite, il a été revêtu par centrifugation par une résine photosensible AZ5214 à l'aide d'une tournette à une vitesse de 4000 tr/min pendant 30 s, puis placé sur une plaque chauffante pour une cuisson douce à 90 °C pendant 2 min. La machine de fabrication de plaques (Heidelberg, uPG501) a ensuite été utilisée pour créer des réseaux de motifs en forme de cercle sur le Si/SiO2 /Ge piles. Les motifs circulaires sont fixés à 5 µm les uns des autres, tandis que le diamètre varie de 3 à 5 µm. Les motifs ont ensuite été transférés sur le fond SiO2 couche par gravure en deux étapes. La gravure sèche anisotrope par gravure ionique réactive avec un mélange gazeux de CF4 et O2 a d'abord été employé pour graver Si/SiO2 couches et arrêté avec environ 20 nm de SiO2 à gauche. Ensuite, la dissolution de la résine photosensible et la gravure humide à l'aide de HF dilué à température ambiante ont été engagées pour éliminer le SiO2 gauche. couche à la fois pour exposer le germanium dans les ouvertures circulaires et également pour graver latéralement sous le bord de polysilicium défini pour créer un surplomb qui est le profil souhaité pour le décollage.
Croissance GeSn et fabrication de microdisques
Pour le dépôt de couche mince GeSn, un système MBE à source solide (Riber SSC) avec une pression de base de 2 × 10 −10 Torr a été utilisé [32]. Un évaporateur à faisceau d'électrons et une cellule d'effusion pyrolytique de BN utilisant des sources solides de haute pureté sont équipés pour l'évaporation du Ge et du Sn dans le système MBE. Un moniteur à cristal de quartz a été utilisé pour calibrer la vitesse de dépôt. Avant de charger les substrats à motifs dans le système UHV, les substrats ont été nettoyés par O2 plasma pour éliminer tout résidu organique induit par la gravure sèche. Suivi d'un rinçage à l'acétone, à l'alcool isopropylique et à l'HF dilué, les substrats ont été transférés dans la chambre MBE pour la croissance du GeSn. Après désorption thermique à 450 °C pendant 15 min, les substrats ont été refroidis in situ à 150 °C pour la croissance de la couche d'alliage GeSn avec une vitesse de croissance du Ge de 0,5 Å s −1 et un flux de Sn contrôlé comme source de dopant. Cette température de croissance est suffisamment basse pour restreindre efficacement la ségrégation de surface de Sn. Afin d'éviter l'oxydation, une couche de protection de 10 nm de Ge a finalement été déposée à la même température.
Après croissance, des alliages GeSn avec une concentration nominale de Sn de 4 % et 10 % seront utilisés pour la fabrication de microdisques. Une couche supplémentaire de polysilicium de 30 nm d'épaisseur a ensuite été déposée sur le dessus des échantillons à température ambiante en utilisant une pulvérisation magnétron pour protéger la couche de GeSn de la gravure suivante. Ensuite, le SiO2 sacrificiel couche a été retirée à l'aide de HF dilué (1:1), ce qui conduit également à l'élimination de la couche de polysilicium superposée et du film de GeSn déposé dessus. Comme on peut le voir sur la figure 2, des mesas circulaires isolées de GeSn ont été révélées après le SiO2 la couche a été supprimée. Cependant, la périphérie de la mesa circulaire n'est pas si lisse, ce qui est mauvais pour les effets de confinement optique. La situation inattendue est causée par le dépôt de GeSn sur le bord du fond SiO2 couche qui résulte de la gravure latérale insuffisante du fond SiO2 et le dépôt à angle non normal (30°). Par la suite, une simple étape de gravure humide sélective sape les mesas circulaires à température ambiante, résultant en des structures de microdisques GeSn suspendues. Le décapant sélectif (APM) comprend H2 O2 (31 % en poids), NH4 OH (28 % en poids) et DI-H2 O avec un rapport volumique de 2:0,5:80 [30]. Enfin, la couche protectrice supérieure de polysilicium a été enlevée par KOH. Un schéma des étapes du processus est illustré à la Fig. 1e–i.
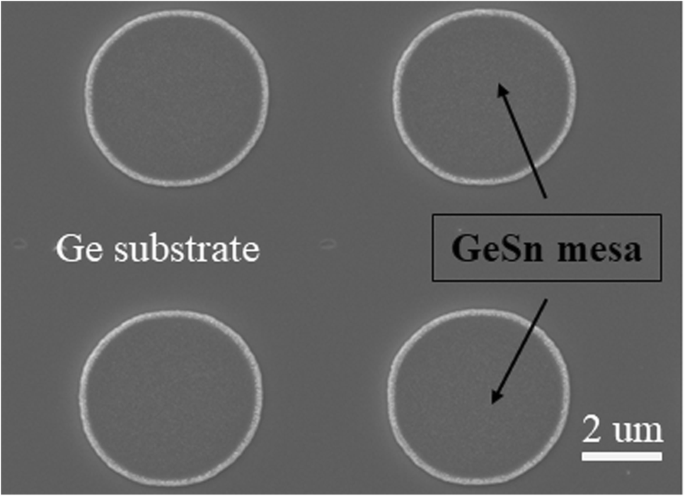
Image SEM vue de dessus de mesas circulaires GeSn isolés de 5 m de diamètre après retrait du masque d'ombre
Dans notre méthode de fabrication de microdisques GeSn, la gravure humide sélective finale est importante en raison des différentes vitesses de gravure pour les matériaux GeSn avec différentes concentrations de Sn. La sélectivité de gravure de Ge sur Ge1−x Snx variera également avec la concentration en Sn. Plus la concentration de Sn dans GeSn est élevée, plus la couverture surfacique de SnOy est élevée sera développé [33]. Cela réduira la vitesse de gravure humide du GeSn et conduira à une sélectivité de gravure plus élevée du Ge par rapport au GeSn. L'étude précédente a rapporté que le H2 O2 gravure humide à base (H2 O2 :NH4 OH : H2 O =2:0,5:80), le même avec ce travail, atteint une sélectivité de gravure de Ge sur Ge0.928 Sn0,072 de 9:1 [30].
Résultats et discussion
La figure 3a montre la micrographie MET en coupe transversale de la mesa circulaire GeSn de 5 um de diamètre sans la couche supérieure de polysilicium. Les figures 3b, c sont les micrographies TEM à haute résolution (HRTEM) pour les régions A et B, correspondant respectivement à l'interface GeSn/Ge et à la région médiane de la couche GeSn. L'épaisseur du film de la couche de GeSn est d'environ 250 nm (Fig. 3a) en dessous de l'épaisseur du masque perforé. Comme on peut le voir sur la figure 3b, les défauts sont principalement localisés à l'interface GeSn/Ge de 30 nm d'épaisseur, entraînant la croissance de GeSn monocristallin suivante. L'image HRTEM de la région B montre des franges de réseau claires de la couche de GeSn, indiquant que l'alliage est hautement cristallin et que le modèle de transformation de Fourier rapide (FFT) de la région B correspond bien au modèle de diffraction de GeSn comme le montre la figure 3c. De plus, pour confirmer la concentration en Sn de l'alliage GeSn, la mesure SIMS a été effectuée comme indiqué dans l'encart de la Fig.3a. La concentration en Sn est de 9,8 ± 0,5 %, en accord avec la valeur nominale d'environ 10 %. En dehors de cela, la distribution des atomes de Sn est très uniforme dans le profil de profondeur du film GeSn tel que développé.
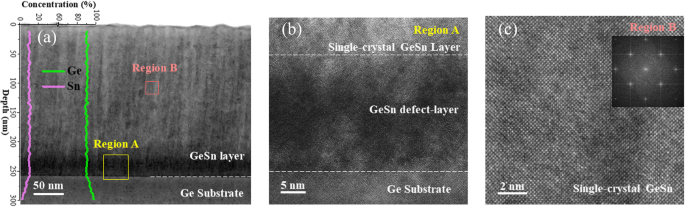
un Image MET en coupe transversale de la mesa circulaire GeSn de 5 m de diamètre sans couche supérieure de polysilicium. Encart :profil de profondeur SIMS de la couche GeSn. b Image MET haute résolution de l'interface GeSn/Ge (région A). c Image MET haute résolution de la région médiane de la couche GeSn (région B). Encart :motif FFT de la région B
La structure de surface des échantillons a été étudiée par SEM. La figure 4a montre l'image SEM vue de dessus du Ge0.96 de 5 m de diamètre Sn0,04 mesas circulaires après 510 s de gravure humide sélective par solution APM à température ambiante. Il faut mentionner que les agents de gravure sont préparés juste avant les expériences pour éviter les effets du vieillissement chimique. L'image SEM indique que non seulement le substrat Ge mais aussi une partie de la mesa GeSn sont gravés. L'échec de former une structure de disque pour Ge0.96 Sn0,04 L'alliage est dû à la faible concentration de Sn qui se traduit par la faible sélectivité de gravure du Ge par rapport au GeSn. Contrairement au Ge0.96 Sn0,04 échantillons, l'échantillon de mesa circulaire GeSn de 5 m de diamètre avec une concentration de Sn plus élevée de 9,8 % a également été gravé par APM à température ambiante. Comme le montre la figure 4b, c. c, des structures de microdisques ont été formées avec succès pour Ge0.902 Sn0,098 alliage après gravure humide de 510 s. Auparavant, Han et al. [30] ont signalé qu'ils fabriquaient des Ge0.928 partiellement suspendus Sn0,072 microdisques (5 m de dimension) avec une contre-dépouille d'environ 1,2 m en utilisant le H2 O2 à base de gravure humide avec une sélectivité de 7:1. Cependant, après la gravure humide sélective, les bords de leur disque se plient et se fracturent en raison de fortes forces capillaires attractives développées entre la structure suspendue et le substrat lorsque le liquide de gravure est éliminé, ce qui tire la structure du microdisque libérée en contact avec le substrat. 24]. Mais ce phénomène ne se produit pas dans nos expériences, même en prolongeant la gravure sélective pour supprimer presque complètement le socle Ge sous-jacent. Cela pourrait s'expliquer par la sélectivité de gravure plus élevée et la couche de GeSn plus épaisse d'environ 250 nm. Fait intéressant, les socles présentent des facettes inattendues avec des orientations différentes qui peuvent être causées par une vitesse de gravure latérale dépendante de l'orientation pendant le processus de gravure humide sélective.
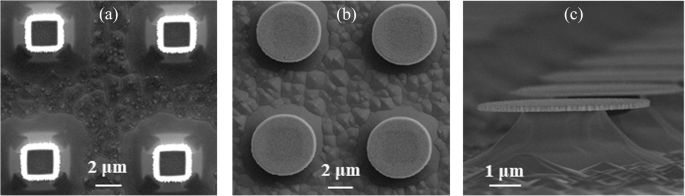
Images MEB après gravure humide sélective. un 5 m de diamètre Ge0.96 Sn0,04 mesas circulaires après 510 s de gravure. b , c 5 m de diamètre Ge0.902 Sn0,098 mesas circulaires après 510 s de gravure
De plus, les microdisques avec des socles Ge de différents diamètres ont été fabriqués en contrôlant le temps de gravure sélective. La figure 5a montre le diamètre du socle de Ge restant en fonction du temps de gravure en APM. Les barres d'erreur représentent l'écart type des données de cinq microdisques différents dans le même échantillon. La tendance de ligne similaire indique que le taux de gravure de Ge est à peu près égal pour Ge0.902 Sn0,098 disques de diamètres différents de 3 m et 5 m, et est en accord avec la valeur de la vitesse de gravure de la Réf. [30]. De plus, le diamètre minimum du socle Ge pour un microdisque GeSn debout est d'environ 300 nm. Les microdisques GeSn suspendus seront tirés vers le bas par les fortes forces capillaires attractives si les socles Ge devenaient plus petits.
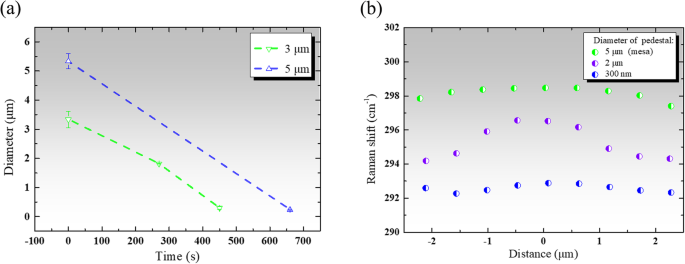
un Le diamètre du socle Ge en fonction du temps de gravure humide sélective pour les diamètres Ge0.902 Sn0,098 disques. b Mesures de balayage de ligne de décalage Raman effectuées le long du diamètre de 5 m Ge0.902 Sn0,098 mesa (point vert) et microdisques avec socle Ge de 2 m de diamètre (point violet) et socle Ge de 300 nm de diamètre (point bleu)
Afin d'étudier la distribution des contraintes élastiques des microdisques GeSn, μ-Raman a été effectué à température ambiante sur des disques de 5 m de diamètre, en utilisant un laser de 633 nm pour l'excitation avec une taille de spot d'environ 600 nm. La puissance laser n'est que de 1% de la puissance maximale (15 mw) pour minimiser les effets thermiques [34], et la profondeur de pénétration du laser d'excitation dans les films de GeSn est d'environ 50 nm [26]. Le décalage Raman a été mesuré en ajustant les spectres avec des fonctions lorentziennes.
La figure 5b montre les balayages de ligne Raman unidimensionnels pour Ge0.902 Sn0,098 microstructures. Il est clairement noté (1) pour la mesa de 5 m de diamètre sans contre-dépouille, le pic Raman associé au mode de phonon Ge-Ge LO se décale sans évidence vers les nombres d'onde inférieurs du centre vers le bord de la mesa, et le grand décalage Raman indique que il y a une grande contrainte de compression dans la mesa GeSn; (2) pour le microdisque de 5 m de diamètre avec un socle Ge de 2 m de diamètre, le pic Raman associé au mode de phonons Ge-Ge LO se décale manifestement vers des nombres d'onde inférieurs du centre vers le bord du disque, révélant un gradient de déformation dû à l'ancrage au piédestal Ge relativement grand. Et le microdisque GeSn de 5 µm avec un socle de 2 µm de diamètre maintient encore à sa périphérie une certaine contrainte de compression; (3) les positions des pics Ge-Ge mesurées le long du diamètre des 5 μm Ge0.902 Sn0,098 Les microdisques avec un socle Ge de 300 nm de diamètre restent cohérents et ont un décalage Raman manifestement réduit. Par conséquent, les disques avec des socles Ge étroits (environ 300 nm de diamètre) devraient être complètement détendus.
Sur la figure 6, nous présentons le spectre de diffusion Raman typique de 5 m de diamètre Ge0.902 Sn0,098 microdisque avec socle Ge de 300 nm de diamètre. Pour les disques, les spectres Raman montrent un pic asymétrique à une fréquence de 292,4 cm −1 correspondant au mode Ge-Ge LO. Les spectres Raman enregistrés pour la mesa de 5 m de diamètre et le substrat de référence Ge (001) en vrac sont également tracés à des fins de comparaison. Notez qu'après le dégagement, nettoyez le décalage Raman (− 6,3 cm −1 ) du pic Ge-Ge peut être observé pour des microdisques de 9,8 % de Sn, car le décalage de fréquence Raman dans les alliages semi-conducteurs est principalement influencé par la déformation et la composition. Des études Raman antérieures [33, 35, 36, 37] ont montré que le décalage Raman du mode phonon Ge-Ge LO dans GeSn peut être exprimé en fonction de la concentration en Sn x Sn et la déformation biaxiale dans le plan ε ∥ suivant l'Éq. (1) :

Comparaison des spectres Raman des 5 μm Ge0.902 Sn0,098 microdisque avec socle Ge de 300 nm de diamètre, 5 m Ge0.902 Sn0,098 diamètre mesa et un substrat Ge en vrac comme référence. En médaillon :vue agrandie des spectres Raman. Les pics Ge-Sn peuvent également être observés vers 260 cm −1 , et vers le bas en diminuant le diamètre des plots Ge
$$ \Delta \omega ={\omega}_{\mathrm{Ge}\mathrm{Sn}}-{\omega}_{\mathrm{Ge}}=\mathrm{A}\cdotp {x}_{ \mathrm{Sn}}+\mathrm{B}\cdotp {\varepsilon}_{\parallel } $$ (1)où ω GeSn et ω Bon sont la position de crête du mode phonon Ge-Ge LO dans GeSn et dans le Ge en vrac, respectivement, tandis que A et B sont des coefficients.
Les pics Ge-Ge LO Raman pour la mesa et les disques montrent un décalage de − 1.4 cm −1 et − 7,7 cm −1 par rapport au pic Ge en vrac (300,1 cm −1 ). En prenant les coefficients des résultats expérimentaux précédents [37], la valeur de la coloration biaxiale dans le plan ε ∥ est calculé comme étant − 1,18 % pour la mesa GeSn cultivée. Pour les microdisques fabriqués, la coloration biaxiale dans le plan ε ∥ est approximativement égal à 0, confirmant la relaxation presque complète de la déformation des microdisques. D'après le récent calcul théorique de Ge1-x Snx structure de bande électronique [38], le Ge0.902 tel que cultivé Sn0,098 La couche est un matériau à bande interdite indirecte avec une énergie de bande interdite d'environ 0,56 eV, tandis que le Ge0,902 complètement relaxé Sn0,098 Le microdisque est un matériau à bande interdite directe avec une énergie de bande interdite de 0,50 eV.
Conclusions
En conclusion, les microdisques GeSn ont été fabriqués avec succès en combinant une croissance épitaxiale sélective avec un processus de gravure humide sélectif. HRTEM et SEM ont été effectués pour confirmer que l'alliage GeSn est hautement cristallin et que la structure du microdisque GeSn est facilement formée par une simple gravure humide sélective. Les mesures μ-Raman révèlent que la relaxation de contrainte du microdisque GeSn sera plus grande avec la diminution du diamètre du socle de Ge en raison de la contrainte mécanique simultanément décroissante du plus petit socle de Ge. Et enfin, les microdisques GeSn de haute qualité et complètement à relaxation de contrainte ont été obtenus par cette méthode plus rentable. Le processus de fabrication est également une méthode très prometteuse pour obtenir une taille de mesa GeSn plus petite jusqu'à ce que l'effet latéral de taille quantique devienne important, et pour obtenir d'autres nanostructures GeSn telles que les points quantiques GeSn, le nanomesh GeSn et les nanofils GeSn pour les futurs nanofils photoniques et électroniques compatibles avec Si. applications de l'appareil.
Disponibilité des données et des matériaux
Les données qui appuient les conclusions de ce travail sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- APM :
-
Mélange de peroxyde d'ammoniac (graveur humide)
- FFT :
-
Transformation de Fourier rapide
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- MBE :
-
Epitaxie par faisceau moléculaire
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- RT :
-
Température ambiante
- SEM :
-
Microscopie électronique à balayage
- SIMS :
-
Spectrométrie de masse ionique secondaire
- μ-Raman :
-
Spectroscopie Micro-Raman
Nanomatériaux
- Classe abstraite Java et méthodes abstraites
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Fabrication de couches minces SrGe2 sur des substrats Ge (100), (110) et (111)
- Fabrication, caractérisation et activité biologique de systèmes de nano-administration d'avermectine avec différentes tailles de particules
- Progrès récents dans les méthodes de synthèse et les applications des nanostructures d'argent
- Fabrication et caractérisation de nano-clips de ZnO par le procédé à médiation par polyol
- Fabrication de nanofibres hélicoïdales CA/TPU et son analyse de mécanisme
- Fabrication et propriété photocatalytique de nouveaux nanocomposites SrTiO3/Bi5O7I
- Gravure au laser et gravure au laser



