Optimisation des contacts ohmiques vers les nanofils p-GaAs
Résumé
Les performances des contacts ohmiques appliqués aux nanofils semi-conducteurs (NW) sont un aspect important pour permettre leur utilisation dans des dispositifs électroniques ou optoélectroniques. En raison des petites dimensions et de l'orientation de surface spécifique des NW, la technologie de traitement standard largement développée pour les hétérostructures planes ne peut pas être directement appliquée. Nous rapportons ici la fabrication et l'optimisation de contacts ohmiques Pt/Ti/Pt/Au pour les nanofils de GaAs de type p cultivés par épitaxie par faisceau moléculaire. Les dispositifs ont été caractérisés par des mesures courant-tension (IV). La linéarité des courbes de caractéristiques IV des nanofils individuels a été optimisée en ajustant la disposition des couches métalliques de contact, le traitement de surface avant l'évaporation du métal et le recuit thermique post-traitement. Nos résultats révèlent que la résistance de contact est remarquablement diminuée lorsqu'une couche de Pt est déposée sur le nanofil de GaAs avant la disposition multicouche traditionnelle Ti/Pt/Au utilisée pour les GaAs planaires de type p. Ces résultats s'expliquent par une meilleure qualité de l'interface métal-GaAs, qui a été mise en évidence par des mesures de diffraction des rayons X à incidence rasante dans des films minces métalliques similaires déposés sur des substrats de GaAs (110). En particulier, nous montrons que le Ti présente un faible degré de cristallinité lorsqu'il est déposé sur une surface de GaAs (110) qui affecte directement la résistance de contact des dispositifs NW. Le dépôt d'une fine couche de Pt sur les NW avant Ti/Pt/Au entraîne une diminution de 95 % de la résistance électrique totale des NW GaAs dopé au Be qui est associée au degré de cristallinité plus élevé du Pt que du Ti lorsqu'il est déposé directement sur GaAs (110).
Introduction
Une étape importante dans la fabrication de dispositifs électroniques et optoélectroniques à semi-conducteurs consiste à obtenir des contacts ohmiques de haute qualité et fiables à l'interface métal-semi-conducteur. À cette fin, GaAs est un matériau important et largement utilisé dans des applications technologiques telles que les dispositifs laser, les cellules solaires et les photodétecteurs. Par conséquent, la fabrication de contact ohmique sur des couches de GaAs dopés de type p et de type n a fait l'objet d'un grand nombre d'investigations [1]. D'une manière générale, la fabrication de contacts ohmiques sur des matériaux semi-conducteurs comprend quatre étapes :(1) l'élimination de l'oxyde natif de surface, (2) la passivation des états de surface à l'interface semi-conducteur-métal, (3) le dépôt de couches métalliques agissant comme le contacts électriques, et (4) recuit thermique [2, 3]. Partant de la sélection de métaux offrant une faible résistance de contact et une excellente stabilité thermique, les alliages à base d'Au ont été largement exploités, en particulier pour les GaAs de type p sous la forme Au/Zn/Au [1, 3, 4] et Ti/ Couches Pt/Au [1, 5]. D'autre part, les nanofils semi-conducteurs III-V (NW) sont apparus comme une nouvelle classe de matériaux prometteurs à l'échelle nanométrique pour des applications comme les LED [6, 7], les cellules solaires [8, 9] et les photodétecteurs [10], et ceux-ci ont déclenché développements spécifiques sur le traitement des appareils.
La majorité de la technologie rapportée dans la littérature pour la fabrication de contacts ohmiques a été développée pour des films minces et des structures massives de GaAs (100), tandis que la croissance auto-catalysée de GaAs NWs donne une orientation de surface (110) au niveau des parois latérales [11,12,13, 14,15]. Différentes orientations de surface présentent différents états électroniques [16] qui affectent les propriétés d'interface et les hauteurs de barrière Schottky [17,18,19]. De plus, l'orientation de la surface peut affecter la dynamique de cristallisation des films métalliques déposés. De bons contacts ohmiques avec les NW de p-GaAs ont été précédemment rapportés [20,21,22,23,24,25,26,27,28] en utilisant une variation de traitements chimiques pour éliminer l'oxyde natif, la passivation de surface et différentes multicouches métalliques déposés sur les NW. Ensuite, il a été rapporté que l'utilisation de contacts électriques Pt/Ti/Pt/Au sur des films minces de GaAs de type p produisait une faible résistivité de contact ohmique même pour des concentrations modérées de dopants en raison de la faible hauteur de barrière Schottky de Pt/GaAs [29]. De plus, le Pt s'est avéré thermiquement stable avec de faibles vitesses de réaction au GaAs pour les traitements thermiques à des températures allant de 300 à 500 °C [29,30,31]. La multicouche métallique Pt/Ti/Pt/Au est le contact ohmique le plus fréquemment rapporté [20, 23, 25, 26, 28] avec les p-GaAs NW. Cependant, une compréhension plus complète des propriétés des métaux sur la formation des contacts ohmiques est la clé pour améliorer encore la qualité des contacts électriques sur les dispositifs nanométriques. En raison du large éventail de techniques de croissance NW et de concentrations de dopants dans les NW de p-GaAs récemment signalés, il ne serait pas viable de faire une comparaison des résistances de contact, lorsqu'elles sont disponibles. Au lieu de cela, une étude complète des différentes voies de fabrication par contact sur le même ensemble d'échantillons NW serait plus appropriée pour exclure l'effet des propriétés NW.
Ici, nous abordons les effets de différents contacts électriques et traitements de surface à base de Pt et de Ti avant l'évaporation du métal sur les caractéristiques globales courant-tension (IV) des NW GaAs dopés Be auto-catalysés cultivés sur des substrats Si [11, 32 ]. Nous analysons les changements de la résistance totale des canaux NW sur la base d'une étude structurelle par diffraction des rayons X de couches minces de Ti, Pt et Pt/Ti déposées sur des substrats de GaAs (110). Nous montrons qu'une résistance de contact élevée est associée à un faible degré de cristallinité du Ti lorsqu'il est déposé directement sur GaAs (110), tandis que les contacts électriques Pt/Ti/Pt/Au entraînent une diminution remarquable de la résistance de contact, qui est attribuée à l'amélioration de la qualité de la couche métallique observée dans les premières couches de Pt/Ti déposées sur la surface de GaAs (110).
Matériaux et méthodes
Croissance des nanofils
Les NW GaAs dopés au Be auto-catalysés ont été cultivés par épitaxie par faisceau moléculaire (MBE) à source solide sur des motifs d'oxyde sans lithographie fabriqués sur des substrats de p-Si (111) par épitaxie de gouttelettes et oxydation spontanée [32]. La température de croissance NW était de 640°C, telle que déterminée par pyromètre, et un flux de Ga correspondant à un taux de croissance planaire de 0,3 μm/h sur GaAs (100) a été utilisé. Un mouillage de 60 s Ga a précédé la croissance NW, qui a été initiée en fournissant As2 avec un rapport de pression équivalente du faisceau V/III de 9 et un flux de Be correspondant à 2,0 × 10 19 cm −3 concentration de dopage de type p; ceci a été déterminé à partir de la croissance d'échantillons d'étalonnage de GaAs (100) plan dopé au Be par des mesures Hall à température ambiante. La durée de croissance était de 60 min. Plus de détails sur la méthodologie de croissance et les propriétés structurelles des NW non dopés et dopés au Be peuvent être trouvés dans les réfs. [11, 32, 33]. En bref, les NW sont composés de zinc pur blende GaAs avec la formation de quelques plans jumeaux [33]. Les NW ont une forme hexagonale avec des parois latérales composées exclusivement de (110) facettes orientées, comme cela a été précédemment déterminé à partir de l'analyse structurelle des NW dopés au Be [33] et confirmé en outre dans des NW GaAs non dopés cultivés dans des conditions similaires [12].
Fabrication et caractérisation des contacts
Les NW ont été transférés mécaniquement sur un substrat p-GaAs (100) recouvert d'un SiO2 de 200 nm d'épaisseur couche, qui a été pré-structurée par photolithographie et évaporation par faisceau d'électrons de tampons Ti/Au pour la caractérisation du transport. La position des fils transférés sur le substrat a été identifiée par imagerie par microscopie électronique à balayage (MEB) à faible grossissement. Une réserve positive de faisceau d'électrons a été appliquée par centrifugation sur le substrat et exposée avec un faisceau d'électrons sur les zones de contact électrique. La réserve a été développée dans une solution MIBK:IPA après exposition au faisceau d'électrons et éventuellement suivie d'un traitement au plasma d'oxygène pour éliminer la réserve résiduelle des parois latérales NW, comme décrit dans le tableau 1. Les effets du traitement au plasma d'oxygène sur les performances de l'appareil seront discuté plus tard dans le texte. Avant l'évaporation du métal des couches de contact, les échantillons ont été traités chimiquement pour éliminer l'oxyde natif et passiver les parois latérales NW exposées, comme décrit plus loin dans le texte. Le lift-off a été effectué en trempant l'échantillon dans de l'acétone chauffée, en rinçant dans de l'IPA et en séchant avec de l'azote.
Nous avons développé cinq procédés distincts combinant différents traitements de surface des parois latérales NW exposées avec différentes multicouches métalliques utilisées comme contacts électriques. Cela nous a permis de déterminer les contributions individuelles de chaque paramètre dans la résistance de contact résultante lorsqu'elle est appliquée aux NW GaAs de type p. Pour l'élimination de l'oxyde natif de surface, nous avons utilisé soit un NH à 2,8%4 OH ou 3.7% HCl dilué dans H2 O suivi de H2 O rinçage. Pour la passivation de surface, nous avons utilisé une solution à 15 % de (NH4 )2 Sx dilué dans H2 O (chauffé à 45 °C) suivi de H2 O rinçage. Les multicouches métalliques ont été déposées par évaporation par faisceau d'électrons et étaient soit en Ti/Pt/Au (20/20/200 nm) soit en Pt/Ti/Pt/Au (5/10/10/200 nm). Un recuit thermique rapide (RTA) de 400 °C pendant 30 s a été utilisé pour la multicouche Pt/Ti/Pt/Au. Les processus utilisés pour chaque échantillon sont spécifiés dans le tableau 1. Pour chaque échantillon, 4 contacts électriques régulièrement espacés ont été fabriqués le long de l'axe NW. Dans ce travail, nous limitons l'analyse IV aux paires de contacts situées dans la région centrale du NW. Les données IV ont été obtenues à température ambiante à l'aide d'une station de sonde Keysight.
Enquête structurelle par diffraction des rayons X à incidence rasante
Afin d'étudier les propriétés structurelles des contacts électriques sur les NW, des diagrammes de diffraction des rayons X à incidence rasante (GIXRD) ont été mesurés à partir de films minces de référence Ti, Pt et Pt/Ti évaporés sur des substrats GaAs (110) non dopés. Nous avons préparé les échantillons de film mince décrits dans le tableau 2 en utilisant l'élimination de l'oxyde natif par HCl :H2 O et passivation surfacique par (NH4 )2 Sx de la même manière que pour les appareils NW. Le faible angle d'incidence des rayons X utilisés dans GIXRD nous permet d'analyser des films métalliques de même épaisseur que ceux utilisés dans les contacts NW en raison de la faible profondeur de pénétration. Les modèles GIXRD ont été mesurés en utilisant un rayonnement Cu Kα avec une longueur d'onde de 1,54 Å et un angle d'incidence de ω = 0.75° par rapport à la surface de l'échantillon. Les positions des pics de diffraction sont indexées selon les fichiers ICDD #00-044-1294 et #00-004-0802 pour le Ti hexagonal compact (HCP) et le Pt cubique à faces centrées (FCC), respectivement, et sont corrigées en tenant compte de l'effet de réfraction des rayons X dans les expériences GIXRD comme décrit dans la réf. [34].
Résultats et discussion
La figure 1a montre les caractéristiques IV des échantillons P1 à P5, et la figure 1b une image SEM d'un GaAs NW dopé au Be avec des contacts électriques utilisés pour la caractérisation du transport. La forme presque symétrique et non linéaire des IV pour P1 à P4 sur la figure 1a indique que les contacts sont de type Schottky avec des hauteurs de barrière similaires pour chaque contact [35]. La non-linéarité de l'IV pour l'échantillon P1 montre évidemment que le procédé standard p-GaAs comme dans P1 ne donne pas de contacts ohmiques comme c'est le cas pour les couches minces planes de GaAs. Habituellement, dans les NW GaAs dopé, l'élimination de l'oxyde HCl est utilisée, éventuellement suivie par (NH4 )2 Sx passivation de surface avant évaporation du métal pour la formation du contact ohmique [20, 21, 36, 37] au lieu de NH4 OH. De plus, un traitement au plasma d'oxygène de la surface exposée NW a été précédemment utilisé pour éliminer la réserve résiduelle des parois latérales NW [36, 38]. Cependant, comme effet secondaire, ce processus peut induire des défauts de surface dans GaAs tels que des lacunes d'As, résultant en des pièges de type donneur responsables de la compensation des porteurs et augmentant ainsi la largeur de la couche d'appauvrissement [5].
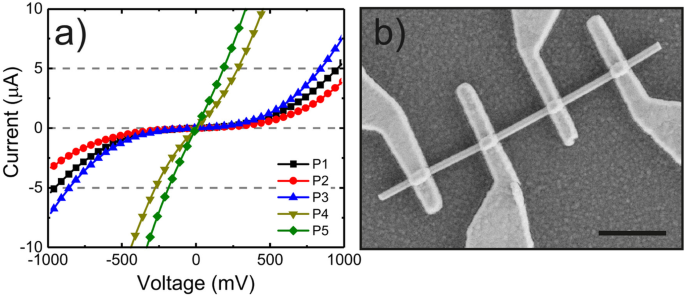
un IV à partir de NW GaAs dopé au Be avec des contacts électriques fabriqués en utilisant les processus P1-P5 comme décrit dans le tableau 1. b Image MEB d'un GaAs NW dopé au Be représentatif avec quatre contacts électriques régulièrement espacés. La barre d'échelle est de 1 μm
Pour évaluer l'effet du traitement plasma d'oxygène sur la résistance de contact de p-GaAs NWs, nous comparons la IV d'un échantillon avec (P2) et sans (P3) nettoyage plasma d'oxygène avant le traitement de surface par HCl et (NH4 )2 Sx dans la figure 1a. P2 donne les pires performances IV (définies comme la valeur du courant électrique pour la même tension appliquée) dans tous les échantillons, mais l'échantillon P3 à son tour présente de meilleures performances IV que le processus p-GaAs standard P1 et le plasma d'oxygène nettoyé P2. Ceci implique deux résultats significatifs :(i) l'effet du traitement plasma oxygène est néfaste sur la résistance de contact, et (ii) le P3 avec élimination des oxydes HCl combiné avec (NH4 )2 Sx la passivation de surface s'ajoute à une hauteur de barrière Schottky inférieure de l'interface métal-semi-conducteur par rapport à P1.
Les performances IV et le caractère ohmique (évalués qualitativement par la linéarité IV) ont été fortement améliorés dans P4 par rapport à P3 en ajoutant une couche de Pt de 5 nm sous la multicouche Ti/Pt/Au, comme le montre la Fig. 1a. La résistance de contact est encore diminuée dans P5 après 30 s de RTA à 400 °C, ce qui permet d'obtenir un comportement IV linéaire et des performances IV améliorées par rapport à P4.
Afin de quantifier l'effet des paramètres de traitement sur la résistance de contact des échantillons P1-P5 (traitements chimiques, multicouches métalliques), nous montrons sur la Fig. 2a les IV de P1-P5 en utilisant une plage de polarisation plus petite ; dans ce cas, les IV présentent un comportement linéaire et sont principalement régis par la résistance de contact [35]. La résistance totale du canal (contacts + NW) dans la plage de 100 mV de la figure 2a a été calculée à partir d'un ajustement linéaire de la courbe caractéristique IV, et les résultats sont présentés sur la figure 2b. Étant donné que les diamètres de tous les NW étudiés sont similaires et qu'il n'y a qu'une faible variation de fil à fil dans la concentration de dopant, comme nous l'avons signalé précédemment [33], tout changement de la résistance totale a été attribué à la résistance de contact. La résistance plus élevée de P2 par rapport à P1 et P3 confirme l'effet néfaste du traitement par plasma d'oxygène à partir de l'analyse qualitative des IV de la Fig. 1a. Un résultat remarquable est la diminution de la résistance totale de 1400 kΩ dans P3 à 72 kΩ dans P4 et une nouvelle diminution à 40 kΩ après RTA dans P5, obtenue en déposant une couche de Pt supplémentaire avant la multicouche Ti/Pt/Au utilisée dans échantillons P1–P3.
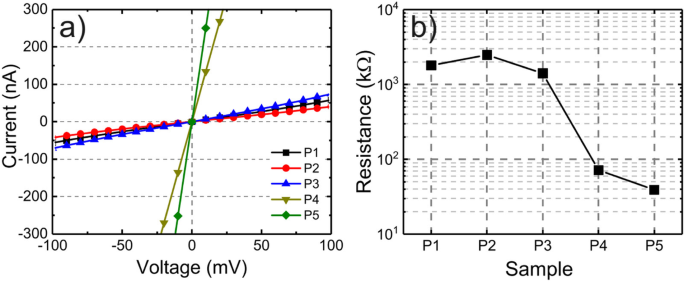
un IV de P1 à P5 dans la plage de tension appliquée 100 mV. b Résistance de canal totale de P1-P5 obtenue à partir d'un ajustement linéaire des IV dans a
Une compréhension plus complète de la microstructure de l'interface métal-semi-conducteur après la fabrication du contact est nécessaire pour établir une corrélation des changements de la résistance de contact observés dans les échantillons P1-P5. L'utilisation de Ti et de Pt dans la fabrication de contacts ohmiques avec GaAs a déjà été rapportée [39, 40], et les propriétés structurelles des films minces de Ti et de Pt évaporés à la surface de GaAs (100) [41] et des substrats de verre amorphe [42, 43 ] ont également été analysés. Cependant, aucune étude détaillée de ce type n'a été trouvée pour la surface de GaAs (110). L'orientation de surface différente devrait influencer la dynamique de cristallisation des films minces de Ti et de Pt. De plus, la passivation chimique de surface par (NH4 )2 Sx pourrait influencer davantage les films minces résultants. Le degré de cristallisation de films minces de Pt (5 nm), Ti (20 nm) et Pt/Ti (5/20 nm) déposés sur un substrat GaAs (110) non dopé a été étudié par le GIXRD afin d'obtenir des informations sur les propriétés structurelles des premières couches métalliques en contact avec les NW en P1-P5. Avant l'évaporation du métal, les substrats GaAs (110) ont subi l'élimination de l'oxyde natif par HCl:H2 O et le (NH4 )2 Sx étapes de passivation de surface lorsque le NW échantillonne P3-P5. Les détails des traitements de surface et des couches minces métalliques évaporées sur substrat GaAs (110) sont résumés dans le tableau 2.
Les diagrammes GIXRD des échantillons S1 à S4 sont représentés dans la plage d'angles de diffraction de 30 à 60 ° sur la figure 3a et dans la plage de 60 à 90 ° sur la figure 3b. Les motifs de diffraction de la figure 3 sont décalés verticalement et séparés en deux plages d'angles de diffraction pour fournir une meilleure mise à l'échelle pour la visualisation. Tout d'abord, nous nous concentrons sur l'effet de (NH4 )2 Sx passivation de surface sur le degré de cristallinité des films de Ti évaporés sur substrat GaAs (110) en comparant les échantillons S1 et S2. Sur la figure 3a, nous observons des pics de Ti (002) et Ti (101) de faible intensité qui se chevauchent, centrés à 38,4 et 40,2°, respectivement, pour S1 et S2. De plus, un pic Ti (102) significativement plus large centré à 53,0 ° est également observé pour les deux échantillons, ce qui suggère un caractère amorphe. Le pic Ti (103) centré à 70,6° sur la figure 3b n'est observé que pour S1, qui est la seule disparité significative entre les échantillons. En général, les faibles intensités et les pics larges de S1 et S2 indiquent une mauvaise cristallinité des films de Ti lorsqu'ils sont déposés sur une surface de GaAs (110) après élimination de l'oxyde HCl et quelle que soit l'utilisation de (NH4 )2 Sx passivation. Dans le cas de S3, pour lequel Pt a été déposé sur substrat GaAs (110) avec le même traitement de surface que dans S2, on observe beaucoup plus prononcé de Pt (111), Pt (200), Pt (220), Pt (311), et des pics de diffraction Pt (222) centrés à 39,8°, 46,3°, 67,5°, 81,3° et 85,7°, respectivement. Cela indique que le film de Pt dans S3 présente un degré de cristallinité plus élevé par rapport aux échantillons de Ti. La même chose s'applique à S4 qui montre des signatures de diffraction Pt similaires à celles de S3 sur les Fig. 3a, b. Les pics larges et asymétriques entre 35°–45°, 65°–75° et 75°–90° pour S4 sont formés en raison du chevauchement de Ti (002)-Ti (101)-Pt (111), Ti ( 103)-Pt (220) et Ti (004)-Pt (311)-Pt (222) pics de diffraction, respectivement. Une comparaison qualitative des motifs GIXRD de S2, S3 et S4 implique que le degré de cristallinité du Ti dans S4 est au moins au même niveau que dans S1. Le pic Ti (103) à 70,6° est observé comme un épaulement clair sur le pic Pt (220) sur la figure 3b et le pic Ti (102) à 53,0° sur la figure 3a est présent avec une faible intensité mais une largeur de raie étroite dans S4 tout en présentant un pic très large, de type amorphe, dans S1 et S2. Ce résultat suggère un degré amélioré de cristallinité du Ti lorsqu'il est déposé sur du Pt au lieu de la surface de GaAs (110), qui sera par la suite directement corrélé aux propriétés des contacts électriques décrites dans les Fig. 1 et 2.
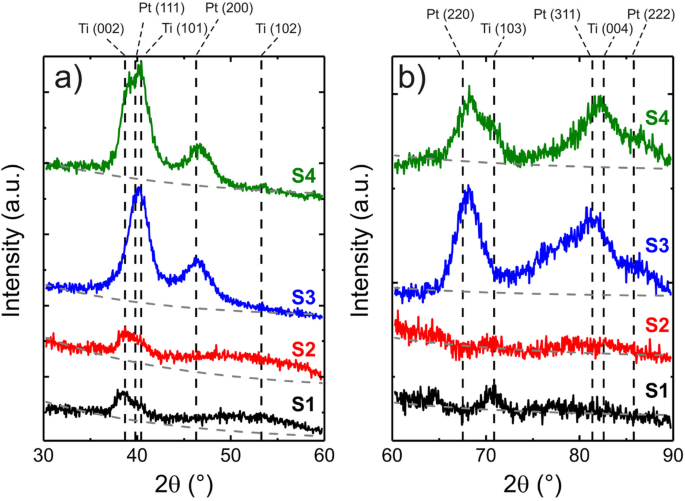
Modèles GIXRD des échantillons S1 à S4 du a Plage d'angle de diffraction de 30 à 60° et (b ) Plage de 60 à 90°. Les lignes grises en pointillés représentent des lignes de base de décroissance exponentielle qui proviennent de la diffusion diffuse des rayons X. Les lignes noires pointillées verticales correspondent aux différents plans de diffraction de Ti et Pt, étiquetés en haut de a et b
L'analyse GIXRD des couches métalliques dans S1-S4 nous permet de corréler le degré de cristallinité du Ti et du Pt déposés sur le substrat GaAs (110) et la résistance totale résulte de P1-P5 sur la Fig. 2b. Il est important de souligner que dans ce travail, nous basons nos corrélations des changements de la résistance totale de P1-P5 principalement sur les données GIXRD obtenues à partir de S1-S4. Nous supposons que d'autres facteurs, tels que la qualité de l'interface métal-NW due à la géométrie hexagonale des parois latérales NWs, ont des contributions négligeables dans les changements de résistance totale observés dans P1-P5. Le (NH4 )2 Sx la passivation de surface a un effet bénéfique sur les propriétés de l'interface GaAs-métal comme il apparaît en comparant la résistance IV et totale des échantillons P1 et P3, mais avec un faible degré de cristallinité du film de Ti lorsqu'il est déposé directement sur la surface de GaAs (110) , comme observé dans S1 et S2. Cela pourrait être le résultat d'une réaction du soufre avec le Ti envahi par la végétation. De plus, il a été rapporté que le Ti est très réactif avec les impuretés restantes dans la chambre d'évaporation pendant le dépôt du métal [41], formant des couches supplémentaires entre le métal/GaAs et augmentant ainsi la résistance de contact [5]. Comme discuté précédemment, l'augmentation de la résistance de contact dans P2 a été attribuée aux dommages de surface possibles causés par le nettoyage au plasma d'oxygène. L'ajout d'une fine couche de Pt entre la surface Ti et GaAs (110) comme dans S4 entraîne un degré de cristallinité plus élevé du film de Ti par rapport à S1 et S2. Ce résultat peut être corrélé à la diminution de la résistance totale du canal de 1400 kΩ dans P3 à 72 kΩ dans P4 qui est associée à une diminution de la résistance de contact. Le RTA diminue encore la résistance totale du canal à 40 kΩ dans P5 en plus de l'augmentation du caractère ohmique de l'IV représenté sur la figure 2a. Ce résultat indique qu'aucune réaction préjudiciable ne se produit entre la surface du Pt et du GaAs à la température et au temps de recuit utilisés [29,30,31].
Conclusions
L'influence du traitement chimique de surface avant l'évaporation du métal et la formation de contacts ohmiques sur les NW GaAs auto-catalysés dopés au Be a été étudiée en corrélant la caractérisation du transport de NW uniques et l'analyse structurelle de couches minces de Ti, Pt et Pt/Ti déposées sur Substrats GaAs. Nous montrons que le Ti présente un faible degré de cristallinité lorsqu'il est déposé sur une surface GaAs (110) qui affecte directement la résistance de contact des dispositifs NW. Le dépôt d'une fine couche de Pt sur les NW avant Ti/Pt/Au entraîne une diminution de 95 % de la résistance électrique totale des NW GaAs dopé au Be qui est associée au degré de cristallinité plus élevé du Pt que du Ti lorsqu'il est déposé directement sur GaAs (110). De plus, nous montrons que le recuit thermique des couches métalliques diminue encore la résistance de contact. Ces résultats sont d'une importance technologique lors de la conception de contacts ohmiques pour des dispositifs à base de GaAs NW et montrent les contributions individuelles de chaque étape de traitement, décrites dans le tableau 1, dans la résistance totale et le caractère ohmique des dispositifs NW. Pour améliorer encore les performances de l'appareil, une optimisation systématique des paramètres de chaque étape individuelle serait nécessaire. En particulier, nous montrons que l'interface métal-semi-conducteur au niveau des parois latérales NW joue un rôle majeur dans les performances du dispositif et ouvre la voie à d'autres investigations sur le processus de cristallisation de films minces métalliques déposés sur différentes orientations de surface de matériaux semi-conducteurs III-V.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de cette étude sont inclus dans l'article.
Abréviations
- FCC :
-
Cube à faces centrées
- GIXRD :
-
Diffraction des rayons X en incidence rasante
- HCP :
-
Emballage hexagonal fermé
- IV :
-
Courant-tension
- NW :
-
Nanofil
- RTA :
-
Recuit thermique rapide
- SEM :
-
Microscopie électronique à balayage
Nanomatériaux
- Contacts en tungstène pour appareils électriques
- Modifier le modèle de contact
- Contacter « Bounce »
- Relais temporisés
- Fonctions de logique numérique
- lentilles de contact
- Les scientifiques des matériaux enseignent aux nanofils comment « danser »
- Optimisation des couches minces hautement réfléchissantes pour les micro-LED plein angle
- Transistors multicouches à effet de champ SnSe Nanoflake avec contacts Au Ohmic à faible résistance



