Etude de la bande d'énergie aux hétérojonctions AZO/β-Ga2O3 (\( \overline{2}01 \)) déposées dans la couche atomique
Résumé
Les effets dopés Al sur les décalages de bande de ZnO/β-Ga2 O3 les interfaces sont caractérisées par spectroscopie photoélectronique aux rayons X et calculées par des simulations de premier principe. Les décalages de bande de conduction varient de 1,39 à 1,67 eV, les décalages de bande de valence diminuent de 0,06 à - 0,42 eV, présentant une dépendance quasi linéaire par rapport au taux de dopage Al variant de 0 à 10 %. Par conséquent, un alignement de bande de type I se forme à l'interface ZnO/β-Ga2 O3 hétérojonction et l'AZO/β-Ga2 O3 l'interface a un alignement de bande de type II. En effet, l'incorporation d'Al dans le ZnO ouvrirait les bandes interdites en raison du fort mélange d'électrons Al et O, et les bords des bandes de conduction et de valence se déplaceraient par conséquent vers le niveau inférieur.
Contexte
Récemment, un oxyde semi-conducteur Ga2 O3 a suscité un intérêt généralisé en raison de ses caractéristiques uniques telles que la grande bande interdite, la vitesse de saturation élevée des électrons et la résistance à haute température [1]. Il existe cinq types d'isomères pour Ga2 O3 :α, β, , et ε, où β-Ga2 O3 peut être cultivé plus facilement et a été largement étudié [2]. En particulier, -Ga2 O3 a un champ électrique de claquage plus important que celui des matériaux semi-conducteurs traditionnels de troisième génération, tels que le SiC et le GaN [3]. Les propriétés conductrices de type n peuvent être modulées par dopage Sn [4] ou Si [5]. Donc β-Ga2 O3 Les dispositifs basés sur [6, 7] ont de larges perspectives d'application dans les domaines des technologies de l'information, de la conservation de l'énergie et de la réduction des émissions. Cependant, -Ga2 O3 -les appareils basés ont une limitation commune :le contact entre β-Ga2 O3 et la plupart des métaux ont tendance à être Schottky en raison de la grande barrière induite par la large bande interdite et la concentration finie de porteurs. Ces dernières années, l'insertion d'un intercalaire, comme ITO [8] et AZO [9], entre Ga2 O3 et les métaux s'avèrent être une méthode valable pour réduire la barrière énergétique entre β-Ga2 O3 et métal.
L'oxyde de zinc dopé à l'Al (ZnO) a attiré beaucoup d'attention en raison de sa faible résistivité et de son coût de fabrication inférieur à celui de l'ITO [10]. En particulier, la stabilité thermique élevée, la mobilité élevée et la concentration en porteurs en font un candidat prometteur pour la couche semi-conductrice intermédiaire (ISL) [11]. Jusqu'à présent, les films de ZnO dopé à l'Al peuvent être cultivés grâce aux techniques suivantes :épitaxie par faisceau moléculaire (MBE) [12], pulvérisation cathodique par magnétron [13], dépôt chimique en phase vapeur (CVD) [14] et dépôt de couche atomique (ALD) [ 15]. En particulier, l'ALD est une méthode renommée pour préparer un film de nano-épaisseur qui présente une excellente uniformité sur une grande surface et unit le taux de croissance par cycle en raison de la réaction de surface auto-limitante, y compris l'adsorption chimique auto-limitante et la réaction séquentielle auto-limitante [16]. De plus, l'ALD peut réduire le trouble de l'interface et moduler plus précisément la concentration de dopage Al en modifiant les rapports des cycles de croissance.
Notez que le décalage de bande de conduction (CBO) détermine la barrière énergétique pour le transport des électrons, donc un CBO plus petit est bénéfique pour former un contact ohmique. Sur la base de nos travaux précédents [17], en augmentant la concentration de dopage Al, le film de ZnO dopé Al passe de la nature polycristalline à la nature amorphe, et sa bande interdite s'élargit également. Cependant, les décalages de bande de différents ZnO/β-Ga2 dopés Al O3 les hétérojonctions n'ont pas été largement étudiées. Dans ce travail, les films de ZnO avec différents taux de dopage Al ont été respectivement déposés sur β-Ga2 O3 substrats par ALD. Les résultats montrent que le VBO et le CBO dépendent presque linéairement du taux de dopage Al.
Méthodes
Les substrats sont en vrac β-Ga2 O3 (\( \overline{2}01 \)) et la concentration de dopage est d'environ 3 × 10 18 /cm 3 . Le processus de nettoyage pour Ga2 O3 les substrats ont été soumis à un lavage aux ultrasons dans de l'acétone et de l'isopropanol toutes les 10 minutes, répété trois fois. Par la suite, le Ga2 O3 les substrats ont été rincés à l'eau déminéralisée. Ensuite, les films de ZnO dopés à l'Al ont été cultivés sur le Ga2 O3 substrat par ALD (Wuxi MNT Micro Nanotech Co., LTD, Chine). Trois types d'échantillons ont été préparés. Premièrement, les films de ZnO non dopés ont été cultivés par ALD avec les précurseurs de Zn (C2 H5 )2 (DEZ) et H2 O à 200 o C. Deuxièmement, les films de ZnO dopé Al ont été réalisés en ajoutant une impulsion de triméthylaluminium (TMA) et H2 O tous les 19 cycles de DEZ et H2 O pulsé (appelé dopage à 5 % d'Al) à une température de substrat de 200 o C pendant l'ALD. Troisièmement, les films de ZnO dopés à l'Al de rapport 9:1 (indiqués par un dopage à 10 % d'Al) ont également été préparés. Le taux de croissance de ZnO et Al2 O3 était de 0,16 et 0,1 nm/cycle, respectivement. Chaque type de film comprenait deux épaisseurs différentes, c'est-à-dire 40 nm et 10 nm pour le film épais et le film mince, respectivement. De plus, le -Ga2 O3 substrat a été utilisé pour étudier le matériau en vrac. Ga 2p , Zn 2p Les CL et le maximum de la bande de valence (VBM) ont été mesurés par spectroscopie à rayons X (XPS) (AXIS Ultra DLD, Shimadzu) et le pas de résolution des spectres XPS est de 0,05 eV. Pour éviter la contamination de surface de l'échantillon pendant le processus de transfert de l'ALD à la chambre XPS, une gravure aux ions Ar a été effectuée avant la mesure XPS. A noter que l'effet de charge peut décaler le spectre XPS, et le BE de C 1s Le pic est calibré à 284,8 eV pour résoudre le problème.
Résultats et discussions
Le décalage de bande de valence (VBO) du ZnO/β-Ga2 dopé Al O3 l'hétérojonction peut être obtenue par la formule suivante [18] :
$$ \Delta {E}_V=\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_{ \mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}\right)-\left({E}_{\mathrm{Zn}\ 2p}^{\mathrm{ AZO}}-{E}_{\mathrm{VBM}}^{\mathrm{AZO}}\right)-\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga }}_2{\mathrm{O}}_3}-{E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}}\right) $$ (1)où\( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) fait référence à l'énergie de liaison (BE) de Ga 2p niveau de base (CL) en vrac β-Ga2 O3 , \( {E}_{\mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) désigne le BE de VBM en vrac β-Ga2 O3 , \( {E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}} \) fait référence au BE de Zn 2p CL dans les films épais de ZnO dopé Al, \( {E}_{\mathrm{VBM}}^{\mathrm{AZO}} \) fait référence au BE de VBM dans les films épais de ZnO dopé Al. Ce dernier \( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) et \( {E}_{\mathrm{Zn }\ 2p}^{\mathrm{AZO}} \) se réfère au BE de Ga 2p et Zn 2p CL dans des films minces de ZnO dopés à l'Al, respectivement.
Par la suite, sur la base du E g et ∆E V , le CBO au ZnO/β-Ga2 dopé Al O3 l'interface peut être calculée par l'équation suivante :
$$ \Delta {E}_C={E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_g^{\mathrm{AZO}}-\Delta {E }_V $$ (2)où\( {E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) est la bande interdite de Ga2 O3 et \( {E}_g^{\mathrm{AZO}} \) est la bande interdite du ZnO dopé Al. Les bandes interdites pour le ZnO non dopé, 5% Al dopé, 10% Al dopé ZnO et β-Ga2 O3 sont respectivement de 3,20 eV, 3,25 eV, 3,40 eV et 4,65 eV [17, 19]. La bande interdite augmente avec un rapport de dopage Al plus élevé, en accord avec la simulation de la partie suivante.
La figure 1 montre les éléments CL et VBM Ga et Zn du -Ga2 en vrac O3 , épais non dopés et films de ZnO dopés à 5% et 10% Al. L'ajustement de la zone linéaire et de la zone de bande plate du spectre VBM permet de déduire le VBM [20]. La figure 2 montre Ga 2p et Zn 2p CL de divers ZnO/β-Ga2 minces dopés à l'Al O3 hétérojonctions. Les différences BE de Ga 2p et Zn 2p CLs pour le ZnO/β-Ga2 dopé à 5% Al non dopé O3 , et 10 % de ZnO/β-Ga2 dopé Al O3 sont respectivement de 96,12 eV, 96,16 eV et 95,94 eV. Ensuite, les VBO aux interfaces sont déterminés à 1,39 eV, 1,52 eV et 1,67 eV pour le ZnO/β-Ga2 non dopé à 5 % d'Al. O3 , et 10 % de ZnO/β-Ga2 dopé Al O3 échantillons, respectivement.
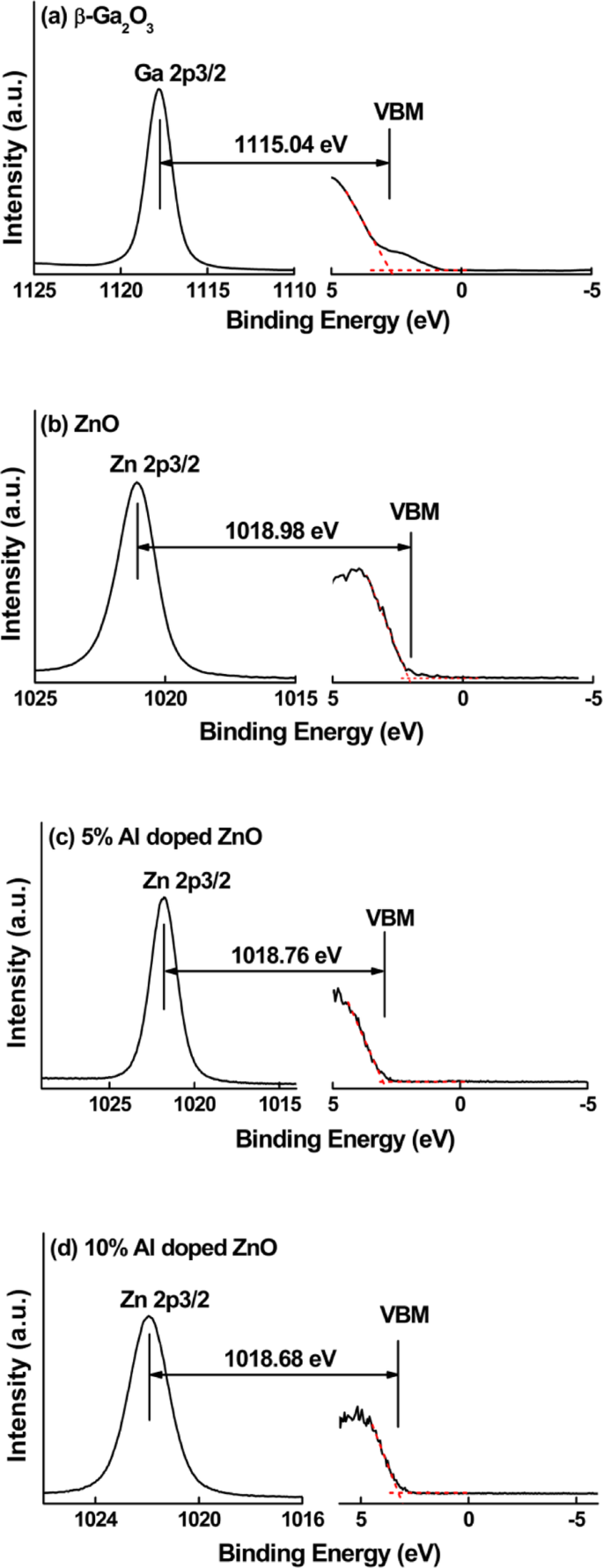
Spectres XPS haute résolution pour le niveau de base et le maximum de bande de valence (VBM) de a Ga 2p spectre de niveau de base et VBM à partir de β-Ga2 nu O3 , b Zn 2p spectre de niveau de base et VBM à partir de ZnO/β-Ga2 pur et épais O3 , c Zn 2p spectre de niveau de base et VBM à partir de ZnO/β-Ga2 épais dopé à 5 % d'aluminium O3 , et d Zn 2p spectre de niveau de base et VBM à partir de ZnO/β-Ga2 épais dopé à l'Al à 10 % O3

Les spectres de niveau cœur de Ga 2p et Zn 2p obtenu à partir des spectres XPS haute résolution de a mince ZnO/β-Ga2 O3 , b mince 5% Al dopé ZnO/β-Ga2 O3 , et c ZnO/β-Ga2 mince dopé à l'Al 10 % O3
L'alignement systématique des bandes pour le ZnO/β-Ga2 dopé à l'Al à 0 %, 5 % et 10 % O3 les hétérojonctions sont calculées par les équations ci-dessus, comme le montre la figure 3. Le décalage de bande de ZnO/β-Ga2 non dopé O3 l'hétérojonction appartient au type I. Alors que le ZnO/β-Ga2 dopé à 5 % et 10 % d'Al O3 les hétérojonctions ont des décalages de bande de type II. La figure 4 illustre les alignements de bandes de ZnO/β-Ga2 dopé Al O3 les interfaces ont une relation linéaire similaire avec la concentration de dopage Al. Le CBO varie de 1,39 à 1,67 eV avec la concentration dopé Al augmentant de 0 à 10 %. Alors que le VBO diminue de 0,06 à − 0,42 eV avec la concentration dopée Al passant de 0 à 10 %. Il est à noter que le CBO et le VBO pour l'AZO/β-Ga2 pulvérisé O3 sont respectivement de 0,79 eV et 0,61 eV [9]. La bande de conduction et la bande de valence se déplacent vers le bas dans ce travail, ce qui pourrait être dû au rapport de composition et à la structure cristalline différents introduits par les méthodes déposées.

Schéma d'alignement de bande de a pur ZnO/β-Ga2 O3 , b 5% ZnO/β-Ga2 dopé Al O3 , et c 10% ZnO/β-Ga2 dopé Al O3

Les décalages de bande de conduction et de valence de l'AZO/β-Ga2 déposé sur la couche atomique O3 hétérojonctions fabriquées à différents taux de dopage Al
En dehors de cela, des simulations de premier principe ont été effectuées par le Vienna Ab-initio Simulation Package (VASP) [21,22,23,24] pour étudier la structure de bande électronique et l'alignement de bande de ZnO/Ga2 dopé Al. O3 hétérojonctions. Lors du calcul, les interactions électron-ion ont été traitées par les pseudo-potentiels ultra-doux, et les fonctions d'onde et les potentiels ont été élargis par la base d'onde plane [25]. En outre, l'approximation du gradient généralisé (GGA) proposée par Perdew, Burke et Ernzerhof (PBE) a été mise en œuvre pour décrire les énergies d'échange-corrélation [26]. Avant de lancer la simulation, des tests de convergence ont été effectués. Il a montré que l'énergie de coupure de 450 eV pour la base d'onde plane et les grilles d'espace k de 3 × 3 × 3 avec le schéma du pack de Monkhorst ont donné des résultats bien convergents. Dans l'optimisation de la structure, une méthode de gradient conjugué a été utilisée et la force résiduelle a été libérée jusqu'à ce qu'elle soit inférieure à 0,01 eV/Å. De plus, les fonctions de densité hybrides basées sur l'approximation PBE semi-locale ont été implémentées. Pour corriger la bande interdite sous-estimée, 35% de l'échange PBE a été remplacé par l'exact [27]. Pour identifier le décalage de bord de bande avec le changement du niveau de dopage Al, le potentiel électrostatique moyen (AEP) a été calculé et aligné sur le niveau de vide qui a été mis à l'échelle à 0 V. Le VBM et le minimum de bande de conduction (CBM) ont par conséquent été alignés sur l'AEP sur la base du diagramme de bande [28]. Dans ce travail, du ZnO en vrac avec 16 atomes d'O et 16 atomes de Zn dans la supercellule a été utilisé. Pour introduire le dopage Al, un ou deux atomes de Zn dans la supercellule ont été remplacés par les atomes d'Al, créant la structure dopée Al avec une concentration de dopage de 3,21 % et 6,25 %, respectivement.
La figure 5 a–c montre les diagrammes de bandes calculés des structures de ZnO non dopé, 3,21 % dopé Al et 6,25 % ZnO dopé Al, respectivement. Il montre clairement que le ZnO est un semi-conducteur à bande interdite directe avec une bande interdite de 3,42 eV, et que le CBM ainsi que le VBM étaient situés au point Γ de la zone Brillouin. Ces résultats de simulation théorique correspondent assez bien à la valeur expérimentale [29]. Avec le dopage Al, il a pu être constaté que les niveaux de Fermi se sont déplacés vers le haut dans la bande de conduction, ce qui convertit le ZnO pur en un semi-conducteur de type n. Pendant ce temps, les bandes interdites ont également augmenté à 4,83 eV et 5,42 eV pour 3,21 % de ZnO dopé Al et 6,25 % de ZnO dopé Al, respectivement. Bien que les bandes interdites ici pour le ZnO dopé soient plus élevées que nos résultats expérimentaux ; cependant, cela pourrait être attribué à la négligence des états de défauts interfaciaux ainsi que d'autres défauts cristallins.
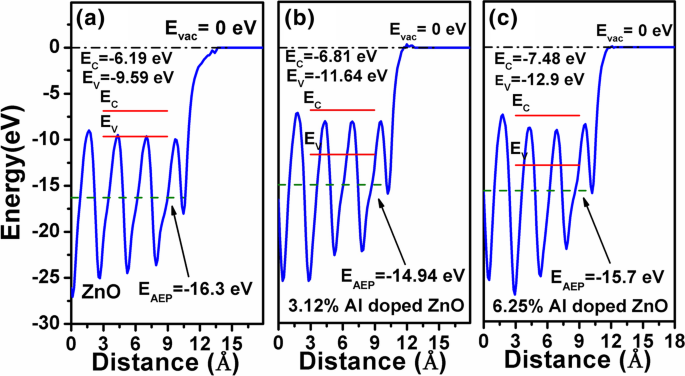
Le diagramme de bande calculé de a ZnO non dopé, b 3,21 % de ZnO dopé à l'Al et c Structure ZnO dopée Al à 6,25 %. Les niveaux de Fermi ont été fixés à 0 eV
La figure 6 a–c présente les alignements de bandes de ZnO non dopé, 3,21 % dopé Al et 6,25 % ZnO dopé Al au niveau du vide. Pour les bandes de conduction des matériaux, en raison du fort mélange d'électrons entre l'élément Al et O, il a pu être constaté que le niveau d'énergie diminue de − 6.19 eV du ZnO à − 6.81 eV pour le ZnO dopé à 3,21 % Al ( ΔE = 0,62 eV ) et diminue encore jusqu'à − 7,48 eV pour le ZnO dopé à 6,25 % Al (ΔE = 1,29 eV ). Pendant ce temps, en raison de l'ouverture de la bande interdite, il a également pu être constaté que le bord de la bande de valence se déplace vers le bas de − 9,59 eV pour le ZnO à − 11,64 eV pour 3,21 % de ZnO dopé Al (ΔE = 2,05 eV ) et − 12,9 eV pour le ZnO dopé à 6,25 % Al (ΔE = 3,31 eV ). Dans l'ensemble, attribué au fort mélange d'électrons Al et O, on pouvait comprendre que l'incorporation d'Al dans le ZnO ouvrirait les bandes interdites. De plus, cela déplacerait à la fois la bande de conduction et le bord de la bande de valence vers le niveau d'énergie inférieur lorsqu'il est aligné sur le niveau de vide.
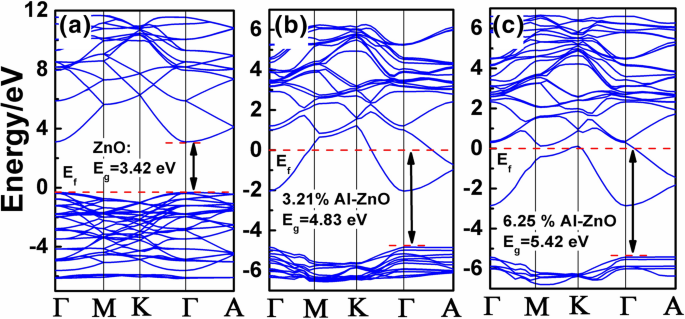
L'alignement des bandes AZO/β-Ga2 O3 hétérojonctions avec a non dopé, b 3,21 %, et c 6,25 % de ZnO dopé à l'Al. Les niveaux de vide ont été mis à l'échelle à 0 eV
Conclusions
En conclusion, les alignements de bandes de différents ZnO/β-Ga2 dopés Al O3 (\( \overline{2} \)01) les interfaces ont été étudiées par XPS. Un alignement de bande de type I se forme à l'interface ZnO/β-Ga2 O3 hétérojonction. Tandis que l'AZO/β-Ga2 O3 l'interface a un alignement de bande de type II. Les CBO varient de 1,39 à 1,67 eV et les VBO diminuent de 0,06 à − 0,42 eV avec la concentration dopé Al passant de 0 à 10 %. De plus, les calculs de la fonction de densité montrent que les décalages de bande changent en raison du fort mélange d'électrons Al et O lorsque Al est incorporé dans ZnO. Ces résultats suggèrent que le ZnO pur est un ISL valide pour réduire la hauteur de la barrière et favoriser le transport des électrons.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de ce manuscrit sont inclus dans le manuscrit.
Abréviations
- AEP :
-
Potentiel électrostatique moyen
- ALD :
-
Dépôt de couche atomique
- BE :
-
Énergie de liaison
- CBM :
-
Bande de conduction minimum
- CBO :
-
Décalage de la bande de conduction
- CL :
-
Niveau de base
- CL :
-
Niveaux de base
- CVD :
-
Dépôt chimique en phase vapeur
- DEZ :
-
Zn (C2 H5 )2
- Ga2 O3 :
-
Oxyde de gallium
- GaN :
-
Nitrure de gallium
- GGA :
-
Approximation de gradient généralisé
- ISL :
-
Couche semi-conductrice intermédiaire
- PBE :
-
Perdew, Burke et Ernzerhof
- SiC :
-
Carbure de silicium
- TMA :
-
Triméthylaluminium
- VASP :
-
Package de simulation ab initio de Vienne
- VBM :
-
Bande de valence maximum
- VBO :
-
Décalage de la bande de valence
- XPS :
-
Spectroscopie aux rayons X
- ZnO :
-
Oxyde de zinc
Nanomatériaux
- Théorie des bandes des solides
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Propriétés photocatalytiques des poudres de TiO2 revêtues de Co3O4 préparées par dépôt de couche atomique amélioré par plasma
- Réglage au niveau de Fermi des films ZnO par dépôt de couche atomique supercyclée
- Enquête sur une cellule solaire au silicium cristallin avec une couche de silicium noir à l'arrière
- Dépendance de l'épaisseur sur les propriétés interfaciales et électriques dans la couche atomique déposée AlN sur le plan c GaN
- Enquête sur la bande d'énergie aux hétérojonctions de ZnO/β-Ga2O3 (\( \overline{2}01 \)) déposées sur la couche atomique
- Enquête sur la bande énergétique aux hétérojonctions bisulfure de molybdène et ZrO2



