Tension de claquage élevée et faible résistance dynamique à l'état ON AlGaN/GaN HEMT avec implantation d'ions fluor dans la couche de passivation SiNx
Résumé
Dans cette étude, nous avons proposé et démontré expérimentalement une tension de claquage (BV) élevée et une faible résistance dynamique ON (R ON, D ) Transistor à haute mobilité électronique (HEMT) AlGaN/GaN par implantation d'ions fluor dans le SiNx épais couche de passivation entre les électrodes de grille et de drain. Au lieu de l'implantation d'ions fluor dans la couche barrière mince d'AlGaN, la position des pics et les distributions de lacunes sont loin du canal bidimensionnel de gaz d'électrons (2DEG) dans le cas de l'implantation d'ions fluor dans la couche de passivation épaisse, ce qui supprime efficacement la dégradation des caractéristiques statiques et dynamiques pulsées du courant (CC). Les ions fluor dans la couche de passivation étendent également la région d'appauvrissement et augmentent l'intensité moyenne du champ électrique (champ E) entre la grille et le drain, conduisant à un BV amélioré. Le BV du HEMT proposé augmente à 803 V à partir de 680 V du HEMT AlGaN/GaN conventionnel (Conv. HEMT) avec les mêmes paramètres dimensionnels. Le R mesuré ON, D du HEMT proposé n'est augmenté que de 23% à un biais de repos à drain élevé de 100 V, tandis que le R ON, D de l'HEMT avec implantation d'ions fluor dans la fine couche barrière d'AlGaN est augmenté de 98%.
Contexte
Au cours des dernières décennies, de nouveaux matériaux semi-conducteurs, tels que le GaN, les oxydes métalliques et les matériaux 2D, ont été largement étudiés pour améliorer davantage la conversion d'énergie et l'efficacité du stockage, en raison de leurs propriétés supérieures de matériau et de dispositif [1,2,3,4, 5,6,7,8]. Parmi eux, les transistors à haute mobilité électronique (HEMT) AlGaN/GaN à base de GaN sont de bons candidats pour les applications à haute puissance, haute fréquence et faible perte en raison du champ de claquage critique élevé et de la mobilité électronique élevée [9,10,11,12,13 ,14]. La tension de claquage (BV) est l'un des objectifs de conception les plus importants, et les valeurs rapportées sont encore bien en deçà de la limite théorique [15, 16]. Par conséquent, il est d'une grande importance d'améliorer encore la BV, surtout pas au prix d'une augmentation de la taille de l'appareil. Plusieurs techniques de terminaison ont été proposées pour améliorer la BV, telles que la plaque de champ [17,18,19], l'implantation d'ions fluor [20,21,22] et la terminaison de bord de grille en retrait [23, 24]. Les ions fluor implantés dans la couche barrière mince d'AlGaN (FBL) [22] ont un processus de fabrication simple sans induire de capacité parasite supplémentaire; cependant, la position maximale du profil du fluor et des distributions de lacunes est proche du canal bidimensionnel de gaz d'électrons (2DEG), ce qui entraînerait inévitablement une dégradation significative des caractéristiques statiques et dynamiques.
Dans ce travail, une tension de claquage élevée et une faible résistance dynamique ON (R ON, D ) AlGaN/GaN HEMT avec implantation d'ions fluor dans le SiNx couche de passivation (FPL HEMT) est étudiée expérimentalement. Contrairement à l'implantation d'ions fluor dans la couche barrière mince d'AlGaN, l'implantation d'ions fluor dans la couche de passivation épaisse pourrait maintenir la position de crête des distributions de fluor et de lacunes loin du canal 2DEG, supprimant ainsi efficacement la dégradation caractéristique statique et dynamique . Les ions fluor dans la couche de passivation en tant que technique de terminaison sont également utilisés pour optimiser la distribution du champ électrique de surface (champ E), obtenant ainsi un BV amélioré. En conclusion, le FPL HEMT démontre d'excellentes caractéristiques statiques et dynamiques.
Méthodes de fabrication
La figure 1 est le schéma tridimensionnel de FPL HEMT, FBL HEMT et Conv. HEMT, respectivement. Tous les appareils disposent d'une longueur de porte L G de 2,5 μm, une distance grille-source L GS de 1,5 μm, et une distance vanne-drain L GD de 10 μm. L'hétérostructure épitaxiale AlGaN/GaN utilisée pour fabriquer le FPL HEMT a été développée sur un substrat de silicium de 6 pouces (111) par dépôt chimique en phase vapeur métal-organique (MOCVD). Les couches épitaxiales sont constituées d'une coiffe GaN 2 nm, Al 23 nm0,25 Ga0,75 Barrière N, couche intermédiaire AlN 1 nm, canal GaN 150 nm et tampon GaN 3,5 µm. La densité et la mobilité mesurées par effet Hall du 2DEG étaient de 9,5 × 10 12 cm −2 et 1500 cm 2 /V s, respectivement. Le HEMT FPL proposé a commencé avec une isolation mesa qui a été mise en œuvre par un Cl2 haute puissance /BCl3 -gravure plasma à couplage inductif (ICP). Ensuite, un dépôt chimique en phase vapeur à basse pression (LPCVD) de 40 nm d'épaisseur SiNx couche a été déposée à 780 °C/300 mTorr avec un NH3 débit de 280 sccm et un SiH2 Cl2 flux de 70 sccm, ce qui donne une vitesse de dépôt de 3,7 nm/min. L'indice de réfraction est mesuré par ellipsomètre comme 1,978, et le rapport N/Si de SiNx est de 1,31 [25]. La cristallinité du LPCVD SiNx est amorphe, ce qui est confirmé par une micrographie au microscope électronique à transmission à haute résolution (HR-TEM) (voir l'encart de la figure 1a). Après ouverture des fenêtres de contact source et drain par SF6 gravure sèche plasma, le contact ohmique Ti/Al/Ni/Au (20/150/45/55 nm) a été déposé et recuit à 890 °C pendant 30 s sous N2 ambiant. La résistance de contact de 1 Ω mm et la résistance de feuille de 400 Ω/carré ont été extraites par la méthode de la ligne de transmission linéaire. Ensuite, l'électrode de métal de grille est formée par un processus de dépôt et de décollement Ni/Au (50 nm/150 nm). Ensuite, la fenêtre d'implantation des ions fluor (Longueur de la fenêtre = 3 μm) est formée par le photoresist AZ5214, et les ions fluor ont été implantés par l'implanteur d'ions SEN NV-GSD-HE à une énergie de 10 keV à une dose de 1 × 10 12 cm −2 . Enfin, les échantillons ont été recuits à 400 °C pendant 15 min dans N2 ambiant pour terminer le flux de fabrication du transistor [26].
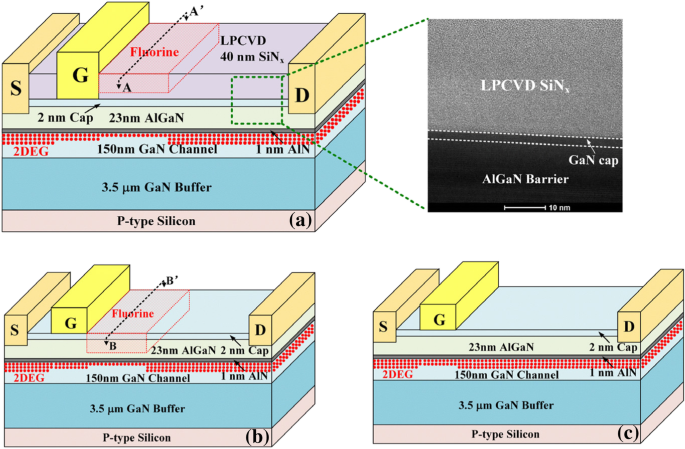
Schéma tridimensionnel de a FPL HEMT (en médaillon :micrographie HR-TEM de LPCVD SiNx ), b FBL HEMT, et c Conv. HEMT
Résultats et discussion
La figure 2 montre le profil mesuré par spectroscopie de masse d'ions secondaires (SIMS) de la concentration en ions fluor et de la concentration de lacunes simulées par TRIM le long des lignes de coupe :(a) A-A′ de FPL HEMT et (b) B-B′ de FBL HEMT, respectivement. À la même énergie et dose d'implantation d'ions fluor, la position du pic mesuré à partir de la surface et la concentration maximale du profil du fluor sont presque les mêmes pour les deux structures. Dans le cas de l'implantation d'ions fluor dans la couche barrière mince d'AlGaN, les lacunes induites par le fluor s'étendent jusqu'à la région du canal 2DEG. La distribution de la concentration de lacunes est discontinue à chaque interface car l'énergie de liaison de chaque matériau est différente [27]. Cependant, dans le cas de l'implantation d'ions fluor dans le SiNx épais couche de passivation, la distribution des lacunes est située dans le SiNx couche de passivation et loin du canal 2DEG. Les lacunes induites par l'implantation ionique piégeraient le canal 2DEG, et le 2DEG pourrait être facilement piégé si la distribution des lacunes est proche du 2DEG [28]. En conclusion, l'implantation d'ions fluor dans le SiNx épais La couche de passivation pourrait réduire considérablement l'influence de l'implantation ionique sur le canal 2DEG et supprimer efficacement la dégradation des caractéristiques statiques et dynamiques.

Profil SIMS mesuré de la concentration en ions fluor et concentration de lacunes simulées par TRIM le long des lignes de coupe. un A-A′. b B-B′
La figure 3 éclaire le I-V mesuré caractéristiques de transfert et caractéristiques de sortie de courant continu (CC). Par rapport à la Conv. HEMT, le FPL HEMT et le FBL HEMT montrent une diminution de I DS et une augmentation de la résistance statique ON (R ON ), car les ions fluor provoquent l'appauvrissement assisté du 2DEG dans la zone de dérive et diminuent ainsi la densité du 2DEG [29]. De plus, l'implantation ionique diminue également la mobilité 2DEG. Les mobilités 2DEG mesurées par effet Hall des HEMT FPL et FBL sont de 228 cm 2 /V s et 203 cm 2 /V s après implantation ionique, respectivement. En raison de la même dose d'ions fluor, les caractéristiques de sortie et R ON de FPL HEMT et FBL HEMT sont presque les mêmes à une faible tension de drain (par exemple, V DS < 3µV). Cependant, lorsque V DS> 3 V, l'effondrement du courant de drain de saturation se produit dans le FBL HEMT, car le profil de lacune du fluor s'étend jusqu'à la région du canal 2DEG, et le 2DEG pourrait être facilement piégé par ces lacunes de niveau profond induites par le fluor lorsque la tension de drain est supérieure à critique tension de drain (par exemple, V DS> 3 V) [30], diminuant ainsi le courant de drain. La distribution des lacunes du FPL HEMT est loin du canal 2DEG, supprimant ainsi efficacement l'effondrement du courant de drain de saturation.

Mesuré a I-V caractéristiques de transfert, et b Caractéristiques de sortie CC pour trois HEMT
La figure 4 montre le I-V mesuré caractéristiques et distributions de champ E de surface simulées sur l'état de blocage. Les BV du FPL/FBL/Conv. Les HEMT sont respectivement de 803/746/680 V. Le BV est défini comme la tension drain-source au courant de drain (I DS ) de 1 μA/mm avec V GS = − 4 V. Les ions fluor entre la grille et le drain en tant que technique de terminaison réduisent le pic de champ E au bord de la grille et provoquent un nouveau pic de champ E à la fin de la région d'implantation ionique, et donc, FPL HEMT et FBL HEMT permet d'obtenir une distribution de champ E de surface plus uniforme et un BV plus élevé que celui du Conv. HEMT. Par rapport au FPL HEMT, le FBL HEMT a un effet de modulation de champ électrique amélioré, car le profil des ions fluor est proche du canal 2DEG. Cependant, pour le FBL HEMT, l'implantation ionique induirait inévitablement des dommages supplémentaires dans la barrière AlGaN [31, 32], conduisant à un chemin de courant de fuite continu de la couche barrière-grille-2DEG; par conséquent, le BV du FBL HMET est légèrement inférieur à celui du FPL HEMT.

un État désactivé mesuré I-V caractéristiques avec une tension de grille de -4 V, maintenant le substrat flottant. b Distributions de champ E de surface simulées à V DS = 150 V
I pulsé DS -V DS des mesures [33] sous commutation lente ont été effectuées pour caractériser le comportement de la résistance dynamique ON (R ON, D ) des HEMT fabriqués en AlGaN/GaN. La figure 5a est le schéma illustrant l'application d'une tension de contrainte pendant le I pulsé DS -V DS des mesures. En I-V pulsé mesures, les électrodes de grille et de drain des HEMT GaN ont été soumises à de courtes impulsions de tension avant chaque I-V mesure pour s'assurer que les appareils étaient à l'état éteint. La largeur d'impulsion est de 3 ms et la période est de 5 ms. La figure 5 b–d montre la comparaison des caractéristiques de sortie pulsée des appareils sous (V GS0 , V DS0 ) de (0 V, 0 V) et (0 V, 100 V). On peut voir qu'il y a une moindre dégradation (12,3%) de la résistance dynamique ON pour le Conv. HEMT, en raison de l'absence de processus d'implantation d'ions fluor. En comparaison avec le FBL HEMT, le FPL HEMT a une faible dégradation de la résistance dynamique ON. En raison de la couche de passivation, la distribution des lacunes est éloignée du canal 2DEG et se situe à l'intérieur de la couche de passivation, ce qui supprime le piégeage de charge dans le FPL HEMT. La figure 6 résume les valeurs de rapport de R ON, D /R ON pour les trois HEMT sous (V GS0 , V DS0 ) de (0 V, 0 V) et (0 V, 100 V) au pas de 20 V. Pour le FBL HEMT, le R mesuré ON, D est déjà augmenté de 98% de la statique à (V GS0 , V DS0 ) de (0 V, 0 V) et (0 V, 100 V), tandis que le R ON, D du FPL HEMT est augmenté de seulement 23% à une polarisation de repos à drain élevé de 100 V.
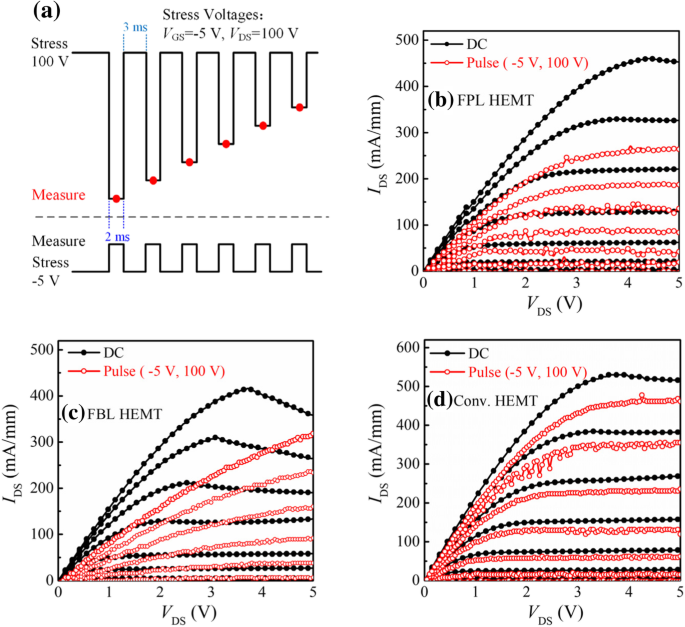
un Schéma illustrant l'application de la tension de contrainte pendant le I pulsé DS -V DS des mesures. I pulsé DS -V DS caractéristiques des HEMT fabriqués en AlGaN/GaN avec b FPL HEMT, c FBL HEMT, et d Conv. HEMT (V GS = − 4~0 V; pas :0,5 V)
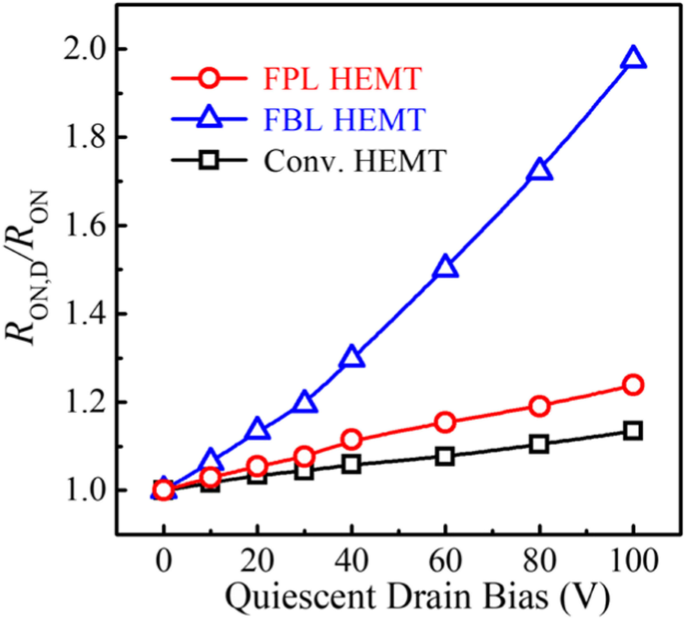
Rapport de R ON, D /R ON pour les HEMT fabriqués à différents points de polarisation de drain au repos. La largeur et la période d'impulsion sont respectivement de 3 ms et 5 ms
Conclusions
En conclusion, nous avons proposé un nouveau HEMT AlGaN/GaN avec une tension de claquage élevée et une faible résistance dynamique ON. Il dispose d'une implantation d'ions fluor dans le SiNx épais couche de passivation. L'implantation d'ions fluor dans la couche de passivation pourrait supprimer efficacement la dégradation des caractéristiques électriques. La résistance ON dynamique n'est que 1,23 fois plus grande que la résistance ON statique après l'état désactivé V DS contrainte de 100 V, alors qu'elle est de 1,98 fois pour le FBL HEMT. De plus, les ions fluor dans la couche de passivation modulent également la distribution du dépôt E et étendent la région d'appauvrissement; ainsi, le BV du HEMT proposé augmente à 803 V à partir de 680 V du HEMT AlGaN/GaN conventionnel.
Disponibilité des données et des matériaux
Toutes les données générées ou analysées au cours de cette étude sont incluses dans cet article publié.
Abréviations
- 2DEG :
-
Gaz d'électrons bidimensionnel
- HEMT :
-
Transistor à haute mobilité électronique
- ICP :
-
Plasma à couplage inductif
- LPCVD :
-
Dépôt chimique en phase vapeur à basse pression
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- SIMS :
-
Spectroscopie de masse ionique secondaire
- TEM :
-
Microscope électronique à transmission
Nanomatériaux
- Qu'est-ce que la maintenance des pannes et comment y faire face
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- RGO et réseaux tridimensionnels de graphène co-modifiés TIM avec de hautes performances
- Aérogel de graphène/polyaniline avec superélasticité et haute capacité en tant qu'électrode de supercondensateur hautement tolérante à la compression
- Dépendance de l'épaisseur sur les propriétés interfaciales et électriques dans la couche atomique déposée AlN sur le plan c GaN
- RRAM Atomic Layer-Deposited HfAlOx avec basse tension de fonctionnement pour le calcul d'applications en mémoire
- Transistor semi-conducteur latéral à double diffusion à résistance active spécifique ultra-faible avec double grille améliorée et couche partiellement enterrée P
- Matériaux et conception de PCB pour haute tension



