Un CRD à blocage inversé AlGaN/GaN de haute précision (RB-CRD) avec cathode de tranchée hybride
Résumé
Une diode de régulation de courant à blocage inverse latéral AlGaN/GaN (RB-CRD) avec anode Schottky en tranchée et cathode en tranchée hybride a été proposée et démontrée expérimentalement sur un substrat de silicium. La diode à barrière Schottky (SBD) intégrée dans l'anode présente une tension d'activation de 0,7 V et une tension de claquage inverse de 260 V. La cathode à tranchée hybride agit comme un CRD, qui est en série avec l'anode SBD. Une tension de coude de 1,3 V et une tension de fonctionnement direct supérieure à 200 V peuvent être obtenues pour le RB-CRD. Le RB-CRD est capable de fournir un excellent courant constant dans une large plage de températures de 25 à 300 °C. De plus, le courant de régulation directe présente de petits coefficients de température négatifs inférieurs à − 0,152%/ o C.
Contexte
Les semi-conducteurs à large bande interdite ont attiré une attention considérable pour la prochaine génération de dispositifs à haute puissance, haute fréquence et haute température. Le GaN est l'un des semi-conducteurs à large bande interdite les plus prometteurs en raison de ses propriétés supérieures telles qu'une large bande interdite, une mobilité électronique élevée et un champ électrique critique élevé [1,2,3,4,5]. De plus, en raison de la combinaison de la polarisation spontanée et de la polarisation piézoélectrique, un gaz d'électrons bidimensionnel à haute densité (2DEG) peut être obtenu à l'hétérointerface AlGaN/GaN. Ces excellentes propriétés permettent aux dispositifs d'alimentation à base d'AlGaN/GaN de fonctionner avec une faible résistance à l'état passant tout en maintenant une tension de claquage élevée. La plate-forme GaN-on-silicium (GaN-on-Si) [6,7,8] a été considérée comme la technologie la plus prometteuse pour les dispositifs d'alimentation haute performance et à faible coût, en raison de la disponibilité de plaquettes de silicium de grand diamètre et de la compatibilité avec le processus de fabrication CMOS déjà mûri. À ce jour, une variété de dispositifs d'alimentation [9,10,11,12,13,14,15,16] ont été démontrés sur AlGaN/GaN-on-Si et certains d'entre eux sont disponibles dans le commerce. Dans le même temps, le développement du dispositif AlGaN/GaN avec de nouvelles fonctionnalités peut étendre le potentiel d'application d'AlGaN/GaN-on-Si, ce qui est bénéfique pour stimuler la commercialisation à grande échelle de la technologie AlGaN/GaN.
Comme présenté dans la Fig. 1a, dans ce travail, un nouveau type de dispositif appelé diode de régulation de courant à blocage inverse (RB-CRD) a été démontré expérimentalement sur AlGaN/GaN-on-Si. Le RB-CRD comprend une anode Schottky à tranchée et une cathode à tranchée hybride. Une diode à barrière Schottky en tranchée (SBD) est formée au niveau de l'anode tandis qu'un CRD est réalisé dans la cathode en tranchée hybride. Le RB-CRD peut être considéré comme un SBD en série avec un CRD. Une application typique du RB-CRD est la charge de la batterie, comme illustré à la Fig. 1b. Dans le circuit de charge de batterie susmentionné, le CRD agit comme une source de courant constant, qui délivre un courant constant pour charger la batterie [17, 18, 19] quelle que soit la fluctuation de la tension directe entre l'entrée et la batterie. Si la tension d'entrée tombe en dessous de la tension de la batterie, le SBD polarisé en inverse dans le circuit empêchera la batterie de se décharger.
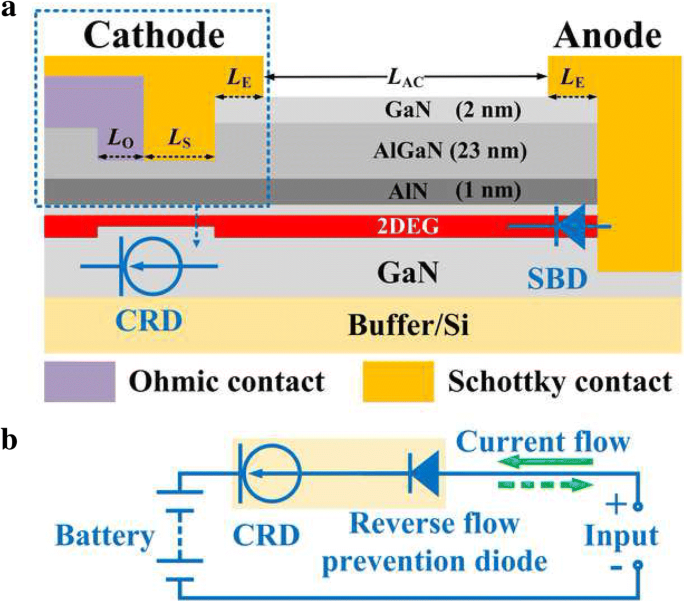
un Coupe schématique du RB-CRD. b Schéma de circuit de charge de la batterie à l'aide du RB-CRD
Méthodes
L'hétérostructure épitaxiale AlGaN/GaN utilisée pour fabriquer les RB-CRD a été développée sur un substrat de silicium de 6 pouces (111) par dépôt chimique en phase vapeur métal-organique (MOCVD). Les couches épitaxiales se composent d'une coiffe GaN de 2 nm, d'une barrière d'AlGaN de 23 nm, d'une couche intermédiaire d'AlN de 1 nm, d'un canal GaN de 300 nm et d'un tampon de 3,5 μm. La densité et la mobilité mesurées par effet Hall du 2DEG étaient de 9,5 × 10 12 cm −2 et 1500 cm 2 /V·s, respectivement. Le processus de fabrication du dispositif est illustré à la Fig. 2. Premièrement, une tranchée peu profonde (voir Fig. 3) a été gravée dans la cathode du RB-CRD par un Cl2 de faible puissance. /BCl3 -Technique de gravure par plasma à couplage inductif (ICP). Une vitesse de gravure de 7 nm/min a été observée en utilisant la recette de gravure développée avec une puissance RF de 20 W, une puissance ICP de 60 W, un Cl2 débit de 5 sccm, et un BCl3 débit de 10 sccm. Ensuite, un isolement mesa d'une profondeur de 300 nm a été formé en utilisant la même technique de gravure ICP pour déconnecter les appareils. La tranchée d'anode a été réalisée par ce processus simultanément. Après cela, les empilements métalliques Ti/Al/Ni/Au (20/150/55/60 nm nm) ont été déposés par évaporation par faisceau d'électrons, suivi du recuit thermique rapide à 880 °C pendant 35 s dans N 2 ambiant. La résistance de contact ohmique de 1,1 mm et la résistance de couche de 400 Ω/carré ont été extraites par la méthode de la ligne de transmission. Enfin, le processus de fabrication du dispositif s'est terminé par le dépôt de Ni/Au (50/300 nm) en empilement métallique Schottky. La distance entre l'anode et la cathode (L CA ) est de 4 μm. Les longueurs du contact ohmique (L O ) et le contact Schottky (L S ) dans la tranchée cathodique sont respectivement de 0,5 µm et 1 µm. Le porte-à-faux étendu (L E ) du contact Schottky est de 0,5 μm.
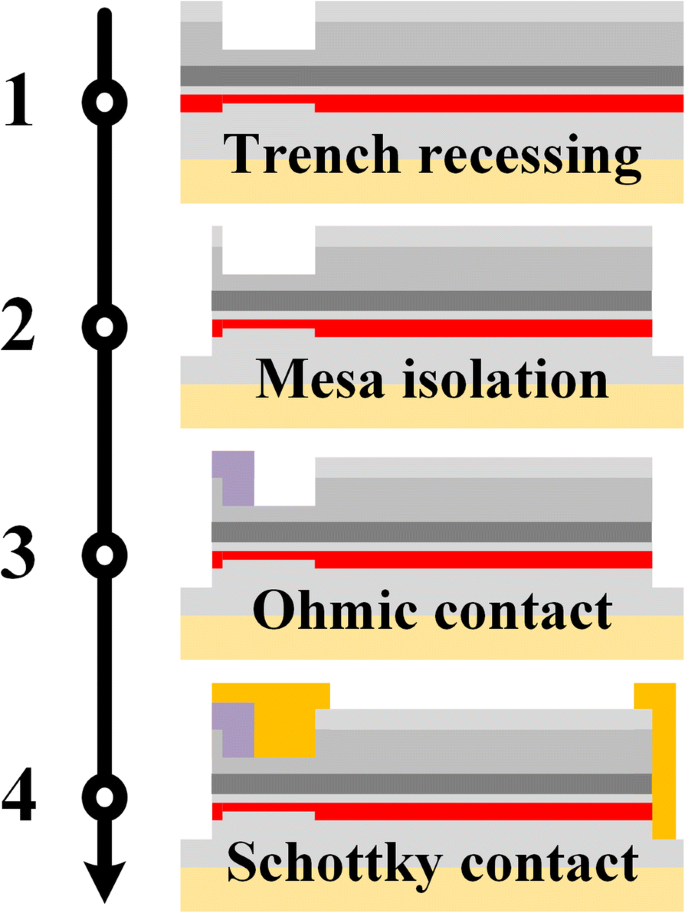
Flux de processus de fabrication du RB-CRD
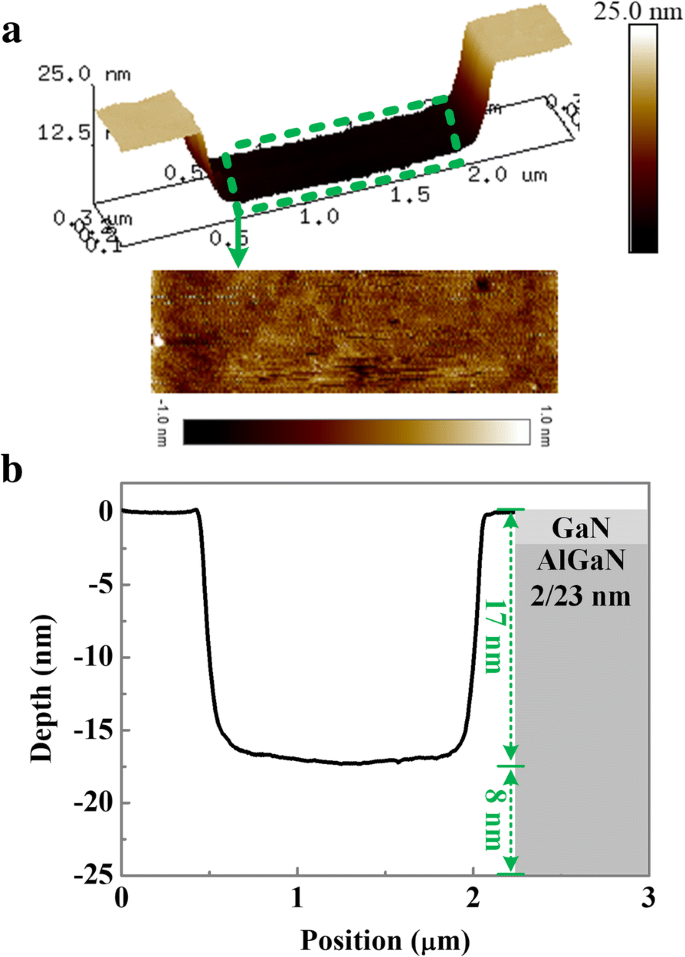
un Images AFM de la tranchée cathodique. b Profil de hauteur tiré de la tranchée cathodique
Résultats et discussion
La figure 3a montre l'image au microscope à force atomique (AFM) 3D de la tranchée cathodique fabriquée. La rugosité de surface du fond de la tranchée cathodique est de 0,3 µnm. Une rugosité de surface aussi faible est bénéfique pour le contact métal-semi-conducteur suivant. Comme le montre la figure 3b, avec un évidement de tranchée cathodique de 17 nm de profondeur, la couche barrière d'AlGaN de 8 nm reste dans la région de tranchée cathodique. Une telle couche barrière d'AlGaN restante permet au canal 2DEG dans la région de tranchée cathodique d'exister toujours avec une polarisation nulle.
La figure 4 illustre le mécanisme de fonctionnement du RB-CRD. Lorsqu'un biais nul est appliqué à l'anode (V CA = 0 V) (voir Fig. 4a), le RB-CRD est analogue à un HEMT en mode d'épuisement du drain Schottky avec les électrodes grille-source connectées. Lorsqu'un biais négatif est appliqué à l'anode (V CA < 0 V) (voir Fig. 4b), les électrons s'accumuleront dans la région de la tranchée cathodique tandis que le canal 2DEG sera épuisé dans la région de l'anode en raison de la jonction Schottky polarisée en inverse. Il n'y a pas de courant souhaité entre l'anode et la cathode, et le RB-CRD agit comme un SBD polarisé en inverse. Comme le montre la Fig. 4c, lorsqu'une polarisation positive qui est au-delà de la tension d'activation (V T , à 1 mA/mm) de l'anode SBD est appliqué à l'anode (V CA> V T ), les électrons circuleront entre le contact ohmique dans la cathode et le contact Schottky dans l'anode. Pendant ce temps, la jonction Schottky dans la cathode est polarisée en inverse et le canal 2DEG sous le contact Schottky sera progressivement épuisé avec l'augmentation de la polarisation directe. Par conséquent, le courant de sortie augmentera initialement avec la tension d'anode appliquée, puis atteindra progressivement la saturation. Dans ce cas, un courant de sortie stable peut être obtenu.
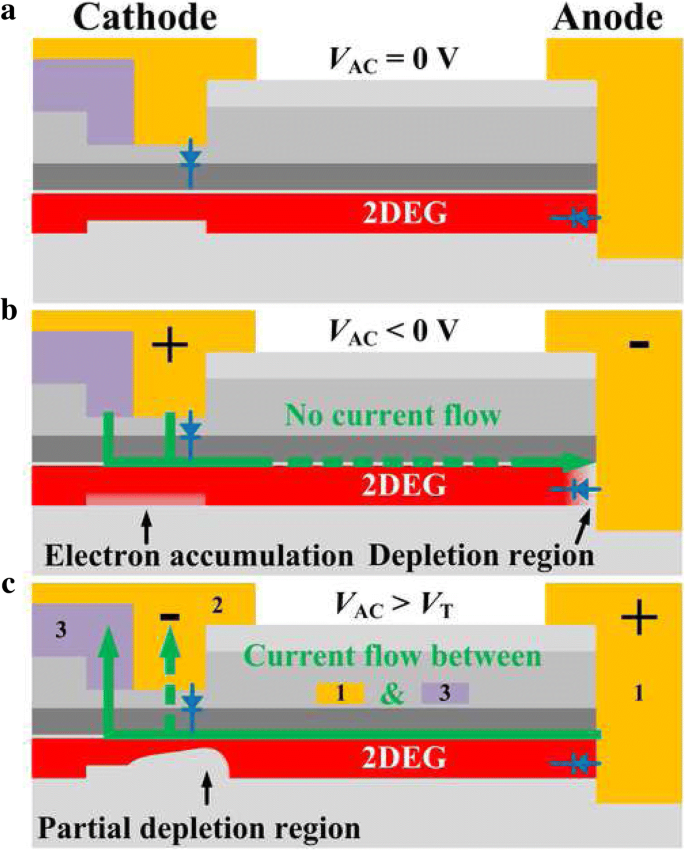
Mécanisme de fonctionnement schématique du RB-CRD sous a zéro biais, b biais inverse, et c conditions de polarisation directe
L'avance dépendant de la température I-V Les caractéristiques du RB-CRD sur la plaquette sont illustrées à la Fig. 5. Comme illustré à la Fig. 5a, pour le RB-CRD, une tension au coude (V K , à 80 % du courant de régulation constant) de 1,3 V est obtenu, ce qui est supérieur à celui de nos CRD précédemment rapportés (par exemple, valeur typique de 0,6 V) [20, 21]. Cela est dû à la chute de tension supplémentaire (par exemple, valeur typique de 0,7 V) sur l'anode SBD du RB-CRD. Avec l'augmentation de la température de 25 à 300 °C (voir Fig. 5a), un décalage négatif du V T est observée, ce qui peut s'expliquer par le modèle d'émission thermoionique (c'est-à-dire que moins d'énergie est nécessaire pour que les électrons franchissent la barrière de Schottky à des températures plus élevées). Le RB-CRD est capable de produire un courant de régulation constant jusqu'à 200 V (voir Fig. 5b), ce qui est supérieur à la tension de fonctionnement maximale signalée des CRD commerciaux à base de Si [22,23,24]. A 25°C, le rapport de courant de régulation (I 200 V /Je 25 V ) du RB-CRD proposé est de 0,998, ce qui indique que le courant de sortie est assez stable. Grâce à la capacité intrinsèque de fonctionnement à haute température de la plate-forme AlGaN/GaN, le RB-CRD présente une dégradation négligeable de la stabilité du I A jusqu'à 200 V à des températures aussi élevées que 300 °C. Pendant ce temps, avec la température augmentant de 25 à 300 °C, l'avance I A réduit de 31,1 à 23,1 mA/mm en raison de la diminution de la mobilité des électrons à des températures élevées, comme le montre la figure 5b. Les coefficients de température (α ) du courant de régulation à différentes plages de température peut être calculé par la formule suivante
$$ \alpha =\frac{I_1-{I}_0}{I_0\left({T}_1-{T}_0\right)}\times 100\% $$où je 0 est le courant de sortie à la température T 0 et Je 1 est le courant de sortie à la température T 1 . Un petit coefficient de température inférieur à − 0,152%/ o C est observé, indiquant que le RB-CRD fabriqué présente une excellente stabilité thermique.

Biais direct dépendant de la température I -V caractéristiques du RB-CRD. Plages de tension d'anode :a 0–2 V, b 0–200 V
Comme indiqué dans l'encadré de la Fig. 6, la tension de claquage inverse du RB-CRD est de 260 V à 25°C. Le champ électrique critique moyen correspondant est calculé à 0,65 MV/cm. L'inverse dépendant de la température I-V Les caractéristiques du RB-CRD sont illustrées à la Fig. 6. L'augmentation de la température ambiante de 25 à 300 °C entraîne une augmentation du courant de fuite de deux ordres de grandeur.

Biais inverse dépendant de la température I -V caractéristiques du RB-CRD
Conclusions
En conclusion, un nouveau RB-CRD AlGaN/GaN-on-Si comportant une anode Schottky en tranchée et une cathode en tranchée hybride a été démontré avec succès pour la première fois. Le RB-CRD fabriqué présente un V K de 1,3 V, une tension de fonctionnement directe supérieure à 200 V et une tension de claquage inverse de 260 V. Une excellente précision ainsi qu'un faible coefficient de température négatif inférieur à − 0,152%/ o C ont été obtenus pour le RB-CRD. Le RB-CRD multifonctionnel à haute précision a un grand potentiel pour être incorporé dans les systèmes d'électronique de puissance GaN émergents.
Abréviations
- 2DEG :
-
Gaz d'électrons bidimensionnel
- AFM :
-
Microscope à force atomique
- ICP :
-
Plasma à couplage inductif
- MOCVD :
-
Dépôt chimique en phase vapeur métal-organique
- RB-CRD :
-
Diode de régulation de courant de blocage inverse
- SBD :
-
Diode barrière Schottky
Nanomatériaux
- Créer des applications hybrides blockchain/cloud avec Ethereum et Google
- Amélioration de la fabrication additive avec la rétro-ingénierie
- Infineon :IGBT à conduction inversée avec fonctions de protection
- Tableaux Python :créer, inverser, pop avec des exemples de tableaux Python
- Impact des états de surface et de la fraction molaire d'aluminium sur le potentiel de surface et 2DEG dans les HEMT AlGaN/GaN
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Les propriétés électriques des composites hybrides à base de nanotubes de carbone multiparois avec des nanoplaquettes de graphite
- Synthèse et propriétés électrochimiques des matériaux cathodiques LiNi0.5Mn1.5O4 avec dopage composite Cr3+ et F− pour batteries lithium-ion
- PEDOT:Couche de transport de trous transparents PSS hautement conducteur avec traitement au solvant pour cellules solaires hybrides silicium/organique hautes performances



