Amélioration diélectrique des condensateurs MIM Al2O3/ZrO2/Al2O3 déposés par couche atomique par recuit par micro-ondes
Résumé
Pour les condensateurs métal-isolant-métal (MIM) appliqués dans les domaines des circuits intégrés RF, DRAM et analogiques/à signaux mixtes, une densité de capacité élevée est impérative avec la réduction d'échelle de la taille des fonctionnalités du dispositif. Dans ce travail, la technique de recuit par micro-ondes est étudiée pour améliorer les caractéristiques diélectriques de Al2 O3 /ZrO2 /Al2 O3 à base de condensateurs MIM. Les résultats montrent que la permittivité de ZrO2 est augmenté à 41,9 (~ 40 % amélioré) avec un recuit micro-ondes à 1400 W pendant 5 min. La température du substrat est inférieure à 400 °C, ce qui est compatible avec le processus de fin de ligne. Les densités de courant de fuite sont de 1,23 × 10 −8 et 1,36 × 10 −8 A/cm 2 pour l'échantillon tel que déposé et l'échantillon de 1400 W, respectivement, indiquant que la propriété de fuite n'est pas détériorée. Le mécanisme de conduction est confirmé comme étant un tunnel assisté sur le terrain.
Contexte
Les condensateurs métal-isolant-métal (MIM) ont été largement utilisés dans les domaines des radiofréquences (RF), de la mémoire vive dynamique (DRAM) et des circuits intégrés analogiques/à signaux mixtes. Avec la réduction de la taille des caractéristiques du dispositif, il est souhaitable d'obtenir une densité de capacité toujours plus élevée. Par exemple, la densité de capacité doit être supérieure à 10 fF/μm 2 selon le nœud 2020 de la feuille de route technologique internationale pour les semi-conducteurs (ITRS) [1]. En conséquence, un grand nombre de matériaux à haut κ ont été étudiés, tels que HfO2 [2,3,4,5,6], ZrO2 [7,8,9,10,11,12,13,14], Ta2 O5 [15,16,17,18] et TiO2 [19,20,21,22,23,24]. Parmi ces matériaux à élevé, le ZrO2 a une constante diélectrique (κ) de 16~25 (phase monoclinique) et une bande interdite de 5,8 eV. Cependant, la valeur de ZrO2 peut être augmenté à 36,8 et 46,6 lorsqu'il est cristallisé en phase cubique et tétragonale, respectivement [25]. Par conséquent, la densité de capacité peut être encore augmentée. La technique de recuit par micro-ondes (MWA) a été énormément explorée pour l'activation du dopant dans le silicium [26,27,28] et la formation de siliciure [29, 30] en raison de sa température de traitement inférieure par rapport aux techniques de traitement thermique conventionnelles. De plus, Shih et al. [31] ont étudié l'effet du MWA sur les caractéristiques électriques de TiN/Al/TiN/HfO2 /Condensateurs Si MOS. Certains paramètres clés tels que l'épaisseur d'oxyde équivalente, la densité d'état d'interface et la densité de courant de fuite ont tous été améliorés.
Dans ce travail, l'effet de MWA sur les propriétés électriques de TaN/Al2 O3 /ZrO2 /Al2 O3 /TaN (TaN/A/Z/A/TaN) Les condensateurs MIM sont étudiés. Avec l'utilisation de MWA, la permittivité de ZrO2 est remarquablement amélioré et la densité de courant de fuite est légèrement augmentée. De plus, le mécanisme de conduction sous-jacent est également étudié.
Méthodes
Tout d'abord, un SiO2 de 500 nm d'épaisseur le film a été cultivé sur un substrat de Si par PECVD, suivi du dépôt de films de TaN (20 nm)/Ta (100 nm), et TaN a été cultivé par pulvérisation cathodique de Ta cible dans N2 /Ar plasma. Par la suite, la plaquette de Si revêtue des films TaN/Ta a été transférée dans la chambre ALD, et la nano-pile d'Al2 O3 (2 nm)/ZrO2 (20 nm)/Al2 O3 (2 nm) ont été déposés à 250°C. Al2 O3 et ZrO2 les films ont été cultivés à partir d'Al (CH3 )3 /H2 O et [(CH3 )2 N]4 Zr/H2 O, respectivement. Il convient de mentionner qu'un Al2 ultrafin O3 couche entre l'électrode TaN inférieure et le ZrO2 couche a été insérée pour restreindre la formation de la couche interfaciale pendant l'ALD et le recuit post-dépôt. Ensuite, les échantillons ont été soumis au recuit micro-ondes. La MWA a été réalisée dans une chambre octogonale DSGI à 5,8 GHz. Lors du recuit, les échantillons ont été placés au milieu de la chambre, là où le champ électromagnétique est le plus uniforme. La température in situ des échantillons a été surveillée par un pyromètre infrarouge de la série Raytek XR faisant face à l'arrière des échantillons. La puissance a varié de 700 W à 1400 W avec un temps de recuit fixe de 5 min. Enfin, une électrode supérieure en TaN de 100 nm d'épaisseur a été formée à son tour par pulvérisation cathodique réactive, lithographie et gravure ionique réactive.
Les épaisseurs des films ALD ont été mesurées avec un ellipsomètre (SOPRA GES 5E) et confirmées au microscope électronique à transmission (MET). Capacité-tension (C-V ) a été mesurée par un analyseur d'impédance de précision (Agilent 4294A) avec une amplitude de 50 µmV AC. Courant-tension (I-V ) les mesures ont été effectuées avec un analyseur de dispositif à semi-conducteur (Agilent B1500) dans une boîte noire. Le biais a été appliqué à l'électrode supérieure.
Résultats et discussion
Les structures schématiques du condensateur MIM basé sur A/Z/A et de la chambre MWA sont illustrées aux Fig. 1a et b, respectivement. La figure 1c présente l'image TEM en coupe transversale du condensateur MIM basé sur A/Z/A qui est soumis au MWA à 1400 W pendant 5 min. On observe que le ZrO2 couche est entièrement cristallisée et les couches empilées peuvent être distinguées clairement, voir l'encart. La figure 2a montre le tracé de probabilité cumulée de la densité de capacité à différentes puissances de recuit. Les résultats montrent que les densités de capacité des condensateurs MIM sont de 7,34, 8,87, 8,96 et 9,06 fF/μm 2 respectivement pour 0, 700, 1050 et 1400 W avec une probabilité cumulée de 50 %. Par conséquent, la densité de capacité est augmentée sous l'effet des micro-ondes. La distribution très étroite de la densité de capacité pour les condensateurs MIM d'empilement A/Z/A avec MWA indique une très bonne uniformité de recuit. L'encart de la Fig. 2a présente les courbes CV typiques de tous les échantillons. Hors effet de Al2 O3 (κ ≈ 8), les constantes diélectriques du ZrO2 les films sont extraits comme 28,3, 40,1, 41 et 41,9 pour 0, 700, 1050 et 1400 W, respectivement, révélés par la figure 2b. Concernant la puissance micro-onde de 1400 W, la constante diélectrique du ZrO2 film augmente de 40 % par rapport à l'échantillon tel que déposé. L'amélioration significative de la permittivité de ZrO2 peut être attribuée à la cristallisation à haut degré pendant le recuit par micro-ondes, illustré à la Fig. 1c. Comme mentionné ci-dessus, la constante diélectrique de ZrO2 peut être augmenté à 36,8 et 46,6 lorsqu'il est cristallisé en phase cubique et tétragonale, respectivement [25]. Par conséquent, la mesure XRD a été effectuée pour étudier plus avant le mécanisme de l'amélioration de la constante diélectrique. Comme le montre l'encadré de la figure 2b, un pic existait à ~ 30, 7° après le traitement MWA à 1400 W, indiquant l'apparition de la phase tétragonale (111) dans ZrO2 [32, 33]. La présence de cette phase tétragonale est responsable de l'augmentation de la constante diélectrique de 28,3 à plus de 40.

un La structure schématique de Al2 O3 /ZrO2 /Al2 O3 -à base de condensateur MIM. b La structure schématique de la chambre MWA. c Image TEM d'Al2 O3 /ZrO2 /Al2 O3 -Condensateur MIM avec MWA à 1400 W pendant 5 min

un Le tracé de probabilité cumulée de la densité de capacité pour différents échantillons ; l'encart affiche la densité de capacité contre la polarisation. b Le graphique de probabilité cumulée de la permittivité de ZrO2 pour différents échantillons ; l'encart présente les modèles XRD des échantillons tels que déposés et 1400 W
Étant donné que les condensateurs MIM sont fabriqués dans l'extrémité arrière de la ligne (BEOL) des circuits intégrés, la température du processus doit être inférieure à 400 °C [34]. Comme le montre la figure 3, les courbes de température de MWA indiquent que les températures les plus élevées du substrat sont de 260, 350 et 400 °C pour 700, 1050 et 1400 W, respectivement. Par conséquent, MWA est compatible avec le processus CMOS du point de vue de la température du processus. De plus, dans le travail précédent [13], Al2 O3 (2 nm)/ZrO2 Les condensateurs MIM à base de 20 nm ont été soumis à un recuit thermique rapide (RTA) à 420 °C pendant 10 min dans N2 /H2 ambiante et la constante diélectrique résultante de ZrO2 a été évalué à 40. Pour le RTA, le temps de recuit a été maintenu constant à 420°C pendant 10 min, de sorte que le budget thermique était beaucoup plus important que celui du MWA. Pour MWA [35, 36], la polarisation dipolaire est considérée comme le mécanisme le plus important pour le transfert d'énergie au niveau moléculaire. Lorsque les matériaux en contact ont des propriétés diélectriques différentes, les micro-ondes se coupleront sélectivement avec les matériaux à perte diélectrique plus élevée. En revanche, le RTA conventionnel transfère la chaleur le plus efficacement aux matériaux à haute conductivité.
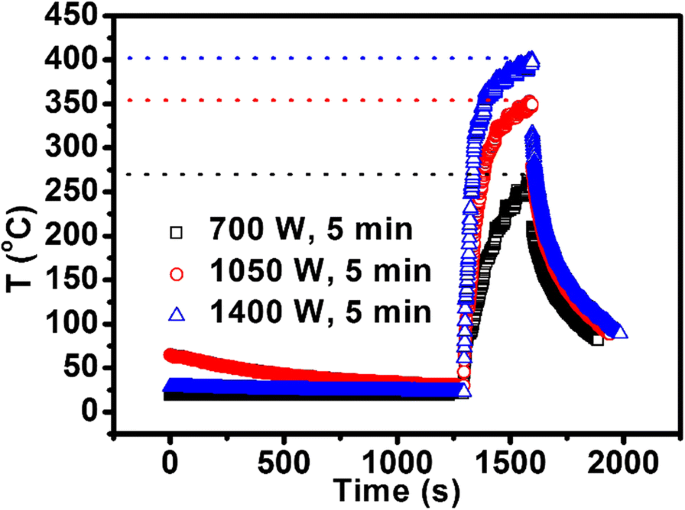
Les courbes de température du substrat pour différents échantillons lors du recuit micro-ondes
Le courant de fuite est un autre paramètre important pour les condensateurs MIM. Comme le montre la figure 4a, la courbe du courant de fuite peut être divisée en deux sections pour tous les échantillons, car il existe un tournant évident, indiquant différents mécanismes de conduction électronique. Comme pour les échantillons avec traitement MWA, la tension correspondant au point de retournement est plus faible par rapport à l'échantillon tel que déposé. Le tableau 1 répertorie la densité de courant de fuite à ± 4 V pour tous les échantillons. Prenez 4 V par exemple, la densité de courant de fuite est augmentée de 1,06 × 10 −7 à 1,92 × 10 −5 A/cm 2 , c'est-à-dire deux ordres d'amplitude améliorés lorsque la puissance micro-ondes est augmentée de 0 à 1400 W. En raison d'une forte cristallisation du ZrO2 film, un grand nombre de joints de grains apparaîtront et serviront de chemin de fuite, améliorant ainsi la conduction électronique sous un champ électrique élevé. Cependant, en considérant une tension de fonctionnement de 2 V, les densités de courant de fuite sont de 1,23 × 10 −8 et 1,36 × 10 −8 A/cm 2 pour l'échantillon tel que déposé et l'échantillon de 1400 W, respectivement. De toute évidence, le recuit micro-ondes a peu d'effet sur les performances de fuite sous un champ électrique faible. De plus, la tension de claquage a été extraite du I -V test et tracé sur la Fig. 4b. Pour l'échantillon tel que déposé, la tension de claquage est d'environ 9,8 µV avec une probabilité cumulée de 50 %. Avec l'application de MWA, la tension de claquage est réduite à ~ 9 V. Cette réduction de la tension de claquage pourrait être liée au changement du ZrO2 microstructure.
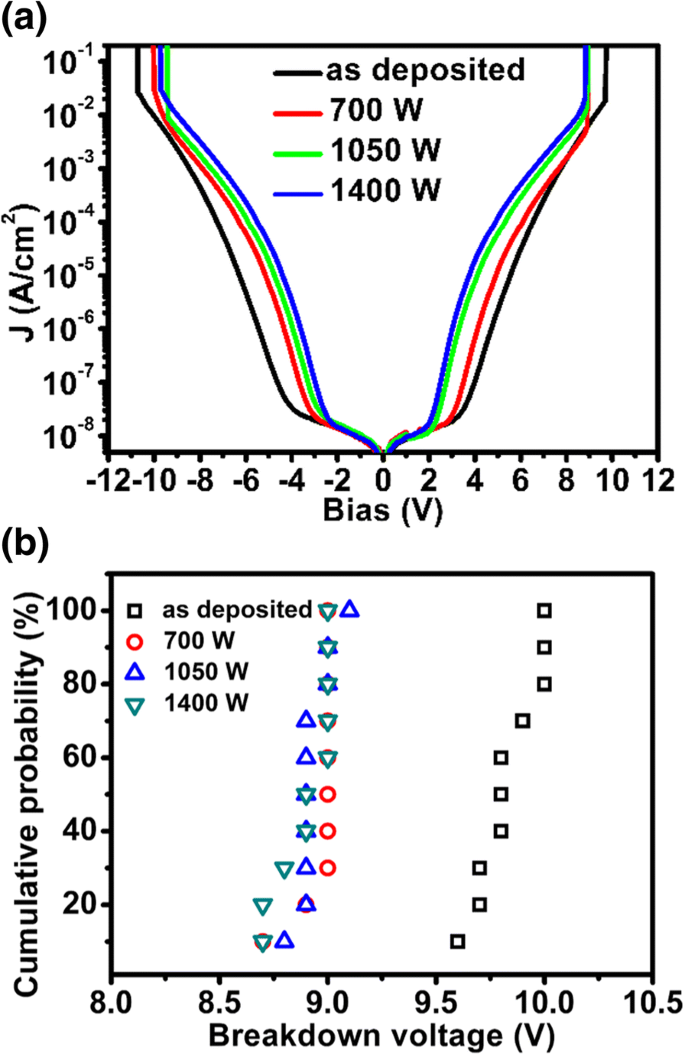
un Le tracé de la densité de courant de fuite (J ) vs biais et b le tracé de probabilité cumulée de la tension de claquage pour différents échantillons
Afin de mieux comprendre l'effet de MWA sur le courant de fuite, les mécanismes de conduction des condensateurs MIM sont étudiés. Basé sur les recherches précédentes sur Al2 O3 (2 nm)/ZrO2 Condensateur MIM basé sur (20 nm) [13, 14], le mécanisme de conduction dominant dans un champ électrique élevé a été confirmé comme étant l'effet tunnel assisté par champ (FAT). Pour le FAT, qui est un effet tunnel lié aux pièges, les électrons sont d'abord capturés par les pièges dans l'isolant, puis tunnelés directement vers la bande de conduction de l'isolant [37]. Dans l'ouvrage en cours, l'Al2 O3 et ZrO2 les films dans les condensateurs MIM basés sur A/Z/A ont été déposés dans les mêmes conditions, de sorte que le courant de fuite est probablement également prédominant par FAT. Le modèle FAT peut être exprimé par l'équation. (1) [37]
$$ J={AE}^2\exp \left(-\frac{8\pi \sqrt{2{m}^{\ast }q{\varphi}_t^3}}{3 hE}\right) $$ (1)où A est une constante, E est le champ électrique, q est la charge électronique, m * représente la masse effective des électrons (environ 0,25 m 0 , où m 0 est la masse de l'électron libre), k est la constante de Boltzmann, φ t est la barrière énergétique séparant les pièges de la bande de conduction, et h est la constante de Planck.
En termes de diélectriques empilés, le champ électrique appliqué à chaque couche diffère les uns des autres en raison de la permittivité et de l'épaisseur différentes. Par conséquent, l'utilisation du champ électrique moyen sur l'ensemble de la pile entraînera de graves erreurs lors de la discussion du mécanisme de conduction. En conséquence, le champ électrique à travers le ZrO2 couche doit être extraite avec précision. Les champs électriques à travers ZrO2 sont 3.125 × 10 7 × V pile , 2,5 × 10 7 × V pile , 2,47 × 10 7 × V pile , et 2,44 × 10 7 × V pile respectivement pour un échantillon tel que déposé, 700 W, 1050 W et 1400 W selon la loi de Gauss et la loi de tension de Kirchhoff [38, 39] :
$$ \left\{\begin{array}{c}{k}_A{E}_A={\kappa}_Z{E}_Z\\ {}{d}_A{E}_A+{d}_Z{E }_Z={V}_{stack}\end{array}\right. $$ (2)où k A et κ Z représentent les constantes diélectriques de Al2 O3 et ZrO2 , respectivement; E A et E Z désignent les champs électriques à travers Al2 O3 et ZrO2 , respectivement; d A et d Z égale les épaisseurs de Al2 O3 et ZrO2 , respectivement; et V pile est la tension appliquée à la pile. En conséquence, Ln (J /E Z 2 ) versus 1/E Z a été arbitrairement tracée sur la figure 5, où un ajustement en ligne droite a été réalisé dans la région de champ élevé pour chaque échantillon sous injection d'électrons par le bas (voir Fig. 5a) ou par injection d'électrons par le haut (voir Fig. 5b). Cela signifie que le mécanisme FAT est dominé à des champs électriques élevés. Le φ extrait t est de 0,73, 0,51, 0,38 et 0,35 eV respectivement pour un échantillon tel que déposé, 700 W, 1050 W et 1400 W sous injection électronique par le bas. En termes d'injection par le haut d'électrons, le φ correspondant t est de 0,82, 0,53, 0,47 et 0,43 eV, respectivement. Par conséquent, certains pièges peu profonds sont induits par la MWA. Les pièges peu profonds proviendraient des défauts aux joints de grains qui peuvent introduire des états électroniques supplémentaires près de la bande de conduction [40]. De plus, le mécanisme de conduction à faible champ est très probablement un effet tunnel assisté par piège (TAT).
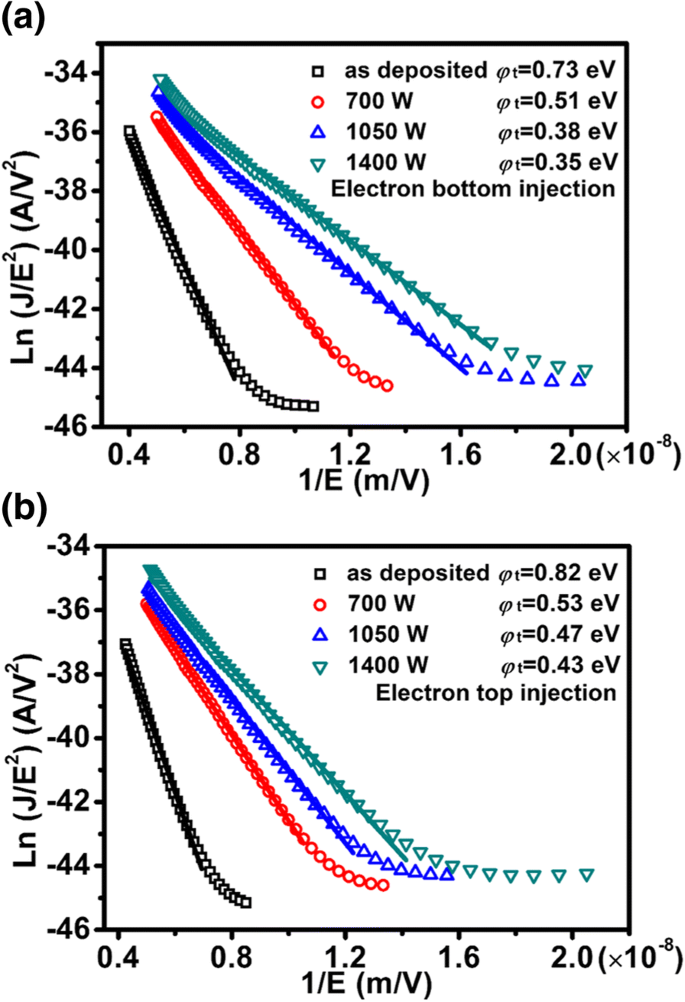
L'intrigue de Ln (J /E 2 ) vs 1/E pour différents échantillons. un Injection d'électrons par le bas et b injection par le haut d'électrons
Conclusions
Al2 déposé par couche atomique O3 /ZrO2 /Al2 O3 nano-stack est utilisé comme isolant des condensateurs MIM. Avec l'effet de MWA à 1400 W pendant 5 min, la densité de capacité est augmentée à 9,06 fF/μm 2 , environ 23,4% de la capacité améliorée. Découplage de l'influence d'Al2 O3 , la constante diélectrique est déduite de 41,9 pour un échantillon de 1400 W (~ 40 % de permittivité augmentée). Une telle amélioration de la permittivité provient d'une forte cristallisation du ZrO2 film. De plus, la température du substrat est inférieure à 400°C, ce qui permet un MWA compatible avec le procédé BEOL. Cette température de substrat inférieure peut être attribuée au chauffage sélectif sur les matériaux de MWA. En termes de tension de fonctionnement de 2 V, les densités de courant de fuite sont de 1,23 × 10 −8 et 1,36 × 10 −8 A/cm 2 pour l'échantillon tel que déposé et l'échantillon de 1400 W, respectivement. Le mécanisme de conduction dominé dans les champs électriques élevés est confirmé comme un processus FAT. Le courant de fuite dans les champs électriques faibles est probablement dicté par le TAT. Sur la base des faits ci-dessus, le recuit par micro-ondes est une technique prometteuse utilisée dans le processus CMOS pour améliorer les performances diélectriques des condensateurs MIM.
Abréviations
- A/Z/A :
-
Al2 O3 /ZrO2 /Al2 O3
- ALD :
-
Dépôt de couche atomique
- BEOL :
-
Fin de ligne
- C-V :
-
Capacité-tension
- DRAM :
-
Mémoire vive dynamique
- FAT :
-
Tunneling assisté sur le terrain
- ITRS :
-
Feuille de route technologique internationale pour les semi-conducteurs
- I-V :
-
Courant-tension
- MIM :
-
Métal-isolant-métal
- MWA :
-
Recuit micro-ondes
- PECVD :
-
Dépôt chimique en phase vapeur amélioré par plasma
- RF :
-
Fréquence radio
- RTA :
-
Recuit thermique rapide
- TAT :
-
Tunneling assisté par piège
- TEM :
-
Microscope électronique à transmission
Nanomatériaux
- AVX lance de nouveaux condensateurs de ligne de transmission ultra-miniatures à couche mince pour les applications hyperfréquences et RF hautes performances
- Imagerie d'atomes sur des cristaux atomiques 2D dans des liquides
- Ocean Carbon imagé à l'échelle atomique
- Mémoire résistive ZrO2/ZrO2 − x /ZrO2 sans conformité avec comportement de commutation multi-états interfacial contrôlable
- Formation et propriétés luminescentes de nanocomposites Al2O3:SiOC à base de nanoparticules d'alumine modifiées par le phényltriméthoxysilane
- Effets de l'épaisseur de la bicouche sur les propriétés morphologiques, optiques et électriques des nanolaminés Al2O3/ZnO
- Capteur plasmonique basé sur des nanoprismes diélectriques
- Photodétecteur à longueur d'onde contrôlée basé sur une seule nanoceinture CdSSe
- Effet du recuit post-thermique sur les propriétés optiques des films InP/ZnS Quantum Dot



