Enquête sur la bande énergétique aux hétérojonctions bisulfure de molybdène et ZrO2
Résumé
L'alignement de la bande d'énergie au multicouche-MoS2 /ZrO2 interface et les effets de CHF3 Les traitements plasma sur le décalage de bande ont été explorés par spectroscopie photoélectronique aux rayons X. Le décalage de bande de valence (VBO) et le décalage de bande de conduction (CBO) pour le MoS2 /ZrO2 l'échantillon est d'environ 1,87 eV et 2,49 eV, respectivement. Alors que le VBO a été agrandi d'environ 0,75 eV pour l'échantillon avec CHF3 traitement au plasma, qui est attribué à l'augmentation du niveau de base de Zr 3d. Les résultats des calculs ont démontré que les atomes F ont de fortes interactions avec les atomes de Zr et que le décalage d'énergie de la bande de valence pour l'orbitale d des atomes de Zr est d'environ 0,76 eV, ce qui est cohérent avec le résultat expérimental. Cette découverte intéressante encourage l'application de ZrO2 comme matériaux de porte dans MoS2 -basé sur des appareils électroniques et fournit un moyen prometteur d'ajuster l'alignement de la bande.
Introduction
Au cours des dernières décennies, SiO2 Les matériaux à base de /Si ont joué un rôle dominant dans la fabrication de dispositifs électroniques, tels que les circuits logiques intégrés, la mémoire non volatile, etc. Cependant, comme la taille des dispositifs diminuait sans cesse de micromètres à moins de 10 nm, les semi-conducteurs traditionnels ont été difficiles à satisfaire aux exigences de capacité spécifique améliorée, de faible courant de fuite de grille et de mobilité élevée des porteurs. Par conséquent, l'exploration de nouveaux semi-conducteurs en tant que canaux du dispositif et des oxydes à haute teneur en κ en tant qu'isolants devient difficile. Depuis la découverte du graphène, la fabrication réussie de matériaux bidimensionnels (2D), en particulier les semi-conducteurs avec une bande interdite appropriée, a fourni un moyen prometteur de surmonter cet inconvénient.
Parmi les matériaux 2D, le bisulfure de molybdène (MoS2 ) avec des propriétés ajustables basées à la fois sur le nombre de couches et le choix des matériaux du substrat a attiré une attention croissante en raison non seulement de sa bonne stabilité chimique et de sa flexibilité mécanique, mais également d'excellentes propriétés optiques et électriques [1, 2]. La bande interdite énergétique de la monocouche MoS2 est d'environ 1,80 eV tandis que 1,20 eV pour le vrac. Les performances prometteuses des dispositifs électroniques et optoélectroniques en MoS2 telles que les transistors à effet de champ [3,4,5], les capteurs [6] et les photodétecteurs [7], s'avère être un substitut potentiel du Si dans l'électronique conventionnelle et des semi-conducteurs organiques dans les systèmes portables et flexibles [8, 9,10,11]. Même si MoS monocouche2 -Les transistors à effet de champ (FET) ont présenté d'excellentes performances avec un rapport marche/arrêt de courant élevé d'environ 10 8 et une faible oscillation sous le seuil ~ 77 mV/décennie [3], ses applications étendues ont été entravées par la synthèse de MoS monocouche de haute qualité de grande surface2 et la stabilité des dispositifs [12,13,14]. MoS multicouche2 pourrait être plus attrayant en raison de la forte densité d'états, ce qui contribue à un courant d'entraînement élevé dans la limite balistique [15]. De plus, la mobilité des porteurs du MoS multicouche2 peut être encore amélioré de manière significative par des oxydes à haute teneur en κ en raison des effets d'écran diélectrique [16, 17]. Par conséquent, il est essentiel et important d'étudier le MoS multicouche2 /Hétérojonctions d'oxydes à haute teneur en κ.
Dans les dispositifs électroniques à hétérojonction, les propriétés de transport d'électrons sont contrôlées avec précision par les profils de bande d'énergie à l'interface entre le semi-conducteur et l'oxyde isolant en termes de décalage de bande de valence (VBO) et de décalage de bande de conduction (CBO). Le VBO et le CBO doivent être aussi grands que possible pour fonctionner comme une barrière afin de réduire le courant de fuite formé par l'injection de trous et d'électrons, en particulier le CBO joue un rôle central dans la sélection des oxydes à k élevé appropriés pour une grille terminal et doit être au moins supérieur à 1 eV pour éviter les fuites de courant [18,19,20]. Pendant ce temps, les charges d'interface situées au niveau des semi-conducteurs/oxydes imposent un effet important sur l'ingénierie de la bande et doivent être optimisées grâce à la technologie de passivation, telle que SiH4 passivation, et CHF3 traitement. Dans cet article, nous avons étudié l'alignement des bandes de MoS multicouche2 / ZrO2 systèmes puisque la nature de l'interface a une incidence directe sur les caractéristiques des appareils, et l'effet de CHF3 traitement plasma sur la bande offset à MoS2 /ZrO2 l'interface a été explorée.
Méthodes et expériences
Dans les expériences, le multicouche MoS2 les films ont été développés sur SiO2 Substrats /Si par des systèmes de dépôt chimique en phase vapeur (CVD) avec MoO3 et de la poudre de soufre comme sources de Mo et précurseurs de S, respectivement. Pendant le processus de croissance, le gaz Ar a été utilisé comme gaz porteur et la température de croissance était de 800 °C pendant 5 min. Puis le MoS2 /ZrO2 les échantillons ont été préparés en transférant le MoS multicouche de grande surface2 filmer sur le ZrO2 Substrats /Si utilisant la méthode du poly méthacrylate de méthyle (PMMA). Le ZrO2 (15 nm) a été déposé sur Si à 200 °C en utilisant le système de dépôt par couche atomique (BENEQ TFS-200) avec le précurseur Tetrakis Dimethyl Amido Zirconium (TDMAZr) comme source de zirconium et de l'eau (H2 O) comme source d'oxygène. Afin d'étudier les effets du CHF3 traitement sur l'alignement des bandes au MoS2 /ZrO2 interfaces, pour un échantillon, le ZrO2 Le substrat /Si a été traité par CHF3 plasma avec une puissance RF d'environ 20 W et un débit d'environ 26 scccm. Pendant ce temps, le temps de traitement au plasma est d'environ 60 s et la pression a été maintenue à 1 Pa pendant le processus. Par conséquent, la dose F résultante est d'environ 2,0 × 10 14 atomes/cm 2 estimée par des mesures de spectrométrie de masse à ions secondaires (SIMS). Lors du processus d'optimisation du temps de traitement plasma, le CHF3 le plasma a sérieusement détérioré la qualité du matériau en introduisant du fluor diffusé dans le ZrO2 en grande partie lorsque le temps a été fixé à 70 s. Alors que lorsque le temps de traitement au plasma était de 50 s, inférieur à 60 s, les résultats SIMS n'ont démontré aucun pic F évident à la surface de l'oxyde. Pour l'autre échantillon, pas de CHF3 un traitement au plasma a été mis en place. Les caractéristiques Raman des échantillons ont été prélevées dans un système RENISHAW à température ambiante. La spectroscopie photoélectronique aux rayons X (XPS) a été mesurée à l'aide d'un système VG ESCALAB 220i-XL. L'énergie photonique de la source de rayons X Al Kα monochromatisée est d'environ 1486,6 eV. Lors des mesures, l'énergie de passage a été fixée à 20 eV afin d'obtenir les spectres XPS. De plus, le pic de C 1 (284,8 eV) a été utilisé pour corriger l'énergie de liaison au niveau du cœur afin d'éliminer l'effet de charge différentielle de la surface de l'échantillon.
Résultats et discussions
Les spectres Raman du MoS multicouche tel que cultivé et après transfert 2 ont été caractérisés à température ambiante comme le montre la figure 1. Deux modes Raman importants étiquetés A 1g et \( {\mathrm{E}}_{2g}^1 \) ont été observés dans le spectre. Plus précisément, le mode \( {E}_{2g}^1 \) résulte du mouvement opposé des atomes S dans le plan par rapport à l'atome Mo central dans la région de fréquence inférieure, alors que A 1g est relatif aux vibrations hors du plan des atomes S dans la région de fréquence plus élevée [21]. Il a été observé que le \( {\mathrm{E}}_{2g}^1 \) et A 1g modes de MoS2 subissent respectivement un décalage vers le rouge et un décalage vers le bleu, de la monocouche aux échantillons en vrac, ce qui est dû à la force de restauration de Van der Waals intercouche différente et à l'influence des changements de structure induits par l'empilement [21]. Par conséquent, la différence de fréquence (Δk) entre le A 1g et \( {\mathrm{E}}_{2g}^1 \) sont souvent utilisés pour évaluer le nombre de couches ou l'épaisseur de MoS2 film. Ici, k du MoS cultivé2 le film mesure environ 25,32 cm −1 , indiquant que le film compte plus de six couches. De plus, le résultat de la microscopie électronique à transmission (MET) en coupe transversale affiché dans l'encart de la figure 1 a démontré le nombre de couches du MoS2 développé. était d'environ 8 correspondant à l'épaisseur d'environ 4,5 nm. De plus, la position du pic Raman et la pleine largeur à mi-hauteur (FWHM) de MoS2 est presque le même avant et après le transfert, indiquant que le processus de transfert exerce une petite influence sur la qualité du matériau.
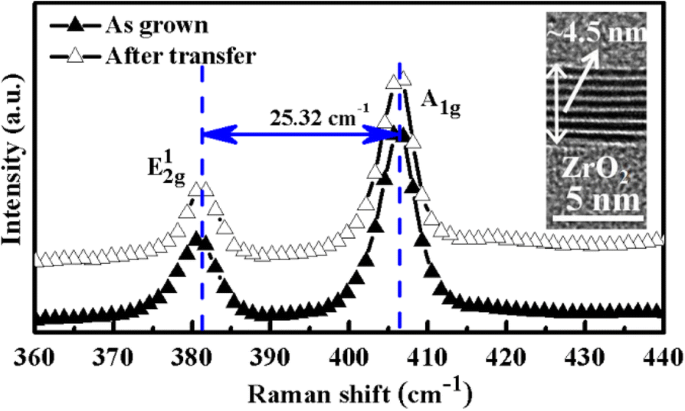
La spectroscopie Raman de l'ultra-mince MoS2 film avant et après transfert. L'encart est l'image en coupe transversale de microscopie électronique à transmission (MET) du MoS2 sur ZrO2 Substrat /Si, qui montre les couches de MoS2
XPS s'est avéré être un moyen efficace pour déterminer le décalage de bande à l'interface d'hétérojonction [22, 23]. Dans MoS2 /ZrO2 hétérojonction, la valeur VBO a été obtenue à partir du changement des spectres de bande de valence du ZrO2 entre celles de l'oxyde nu et avec MoS2 matériel [24]. Les figures 2a, b ont montré le niveau de base et les spectres de bande de valence du ZrO2 nu et multicouche-MoS2 /ZrO2 , respectivement. L'intersection entre la ligne de base et la pente du bord d'attaque donne le maximum de la bande de valence (VBM) de l'échantillon, où le niveau de Fermi est pris comme niveau de référence. Les résultats ont démontré que le VBM de ZrO2 et multicouche-MoS2 /ZrO2 systèmes sont d'environ 1,88 eV et 0,06 eV, respectivement. De plus, le spectre de niveau central Zr 3d de ZrO2 nu présente des pics de doublet bien séparés appelés Zr 3d5/2 et 3d3/2 avec des valeurs énergétiques de 182,05 eV et 184,45 eV, respectivement, tandis que les valeurs correspondantes pour le MoS2 /ZrO2 échantillon sont de 182,10 eV et 184,50 eV, respectivement. Le changement au niveau de base de Zr 3d5/2 ou 3d3/2 ~ 0,05 eV se situe dans la plage d'erreur de mesure et de traitement des données. En comparaison avec le ZrO2 nu échantillon, multicouche MoS2 a exercé peu d'effets sur le spectre 3d du Zr, comme le montre la figure 2b. Ensuite, la différence d'énergie entre le Zr 3d5/2 et VBM est de 180,17 eV et de 182,04 eV pour le ZrO2 nu échantillon et MoS2 /ZrO2 échantillon, respectivement. Par conséquent, la valeur VBO pour le multicouche-MoS2 /ZrO2 l'interface est d'environ 1,87 ± 0,05 eV, principalement due à la différence VBM entre le ZrO2 nu et MoS2 /ZrO2 . De même, pour le multicouche-MoS2 /ZrO2 échantillon avec CHF3 traitement plasma avant MoS2 transfert, le VBM est d'environ 0,02 eV comme le montre la figure 2c, presque identique à l'échantillon sans CHF3 traitement. Cependant, le spectre Zr 3d se déplace vers une énergie plus élevée d'environ 0,75 eV, Zr 3d5/2 ~ 182,85 eV et 3d3/2 ~185,25 eV, indiquant que la valeur VBO a été augmentée d'environ 0,75 ± 0,04 eV après la gravure au plasma. Ensuite, la valeur CBO ∆E C peut être obtenu selon la formule
$$ \Delta {\mathrm{E}}_{\mathrm{C}}={E}_{G, ZrO2}-{E}_{G, MoS2}-\Delta {E}_V. $$ (1)où E G , ZrO 2 et E G , MoS 2 sont la bande interdite de ZrO2 et MoS2 , respectivement, et ∆E V correspond à la valeur VBO. Normalement, l'énergie de la bande interdite de l'isolant en oxyde peut être obtenue à partir du spectre d'énergie de perte de O 1 [25]. La figure 3a montre le spectre d'énergie de perte de O 1 de ZrO2 , et le E G , ZrO 2 est d'environ 5,56 eV calculé à partir de la différence d'énergie en extrapolant la ligne de base de bord linéaire (535,95 eV) ajustée à l'énergie au niveau du cœur des liaisons Zr-O (530,39 eV). La bande interdite du MoS2 dans ce travail est d'environ 1,2 eV. Par conséquent, la valeur CBO pour l'échantillon sans CHF3 le traitement est d'environ 2,49 eV et 1,74 eV pour l'échantillon avec CHF3 traitement. Ensuite, les structures schématiques de l'ingénierie de bande pour les échantillons sans et avec CHF3 le traitement au plasma sont illustrés à la Fig. 3b. Évidemment, le multicouche-MoS2 /ZrO2 système a un alignement de type I, ce qui facilite les électrons et les trous confinés dans le MoS2 . Pendant ce temps, le grand ∆E C et ∆E V pour MoS2 /ZrO2 interface implique que ZrO2 pourrait être un bon diélectrique de grille pour les multicouches MoS2 à canaux n ou p -Application des FET en termes de suppression du courant de fuite de grille. De plus, l'échantillon avec traitement plasma a un VBO ∆E plus élevé V (inférieur CBO ∆E C ) par rapport à l'échantillon sans traitement au plasma, ce qui est meilleur dans l'application des FET à canal p.
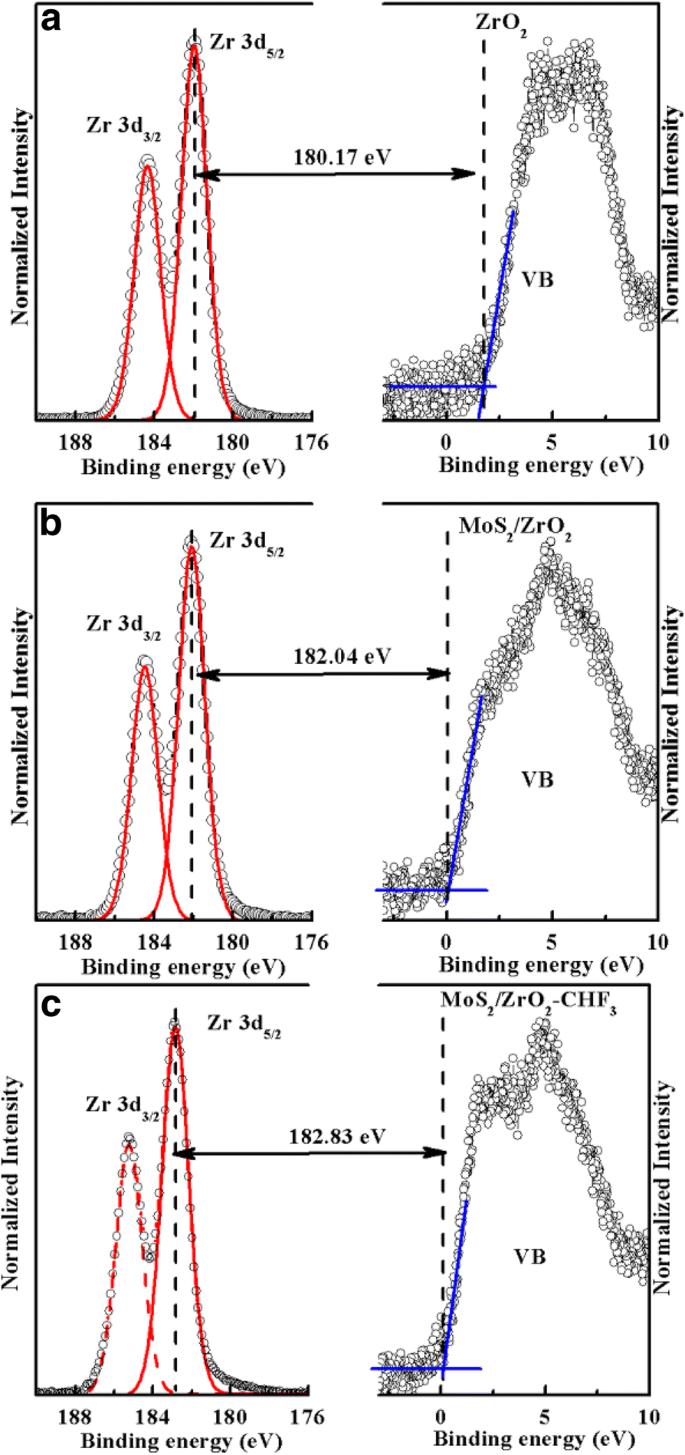
Les spectres de base Zr 3d et de bande de valence pour a nu ZrO2 oxyde, b multicouche-MoS2 /ZrO2 échantillon, et c CHF3 multicouche traité au plasma-MoS2 /ZrO2 échantillon

un Spectres de perte d'énergie des photoélectrons O 1 s pour le ZrO2 oxyde. b La structure schématique de l'alignement des bandes d'énergie au MoS2 /ZrO2 interface sans (en haut) et avec (en bas) CHF3 traitement plasma. c Les profils de profondeur SIMS (Si, Zr et F) pour l'échantillon avec CHF3 traitement plasma
Le changement de l'alignement des bandes au niveau du MoS multicouche2 /ZrO2 On pense que l'interface est étroitement liée à la couche interfaciale riche en F induite par le CHF3 traitement plasma. La figure 3c a affiché le résultat SIMS de l'échantillon traité au plasma pour les éléments Zr, F et Si, présentant un pic évident d'ions F à l'interface. Pendant ce temps, certains ions F ont été diffusés dans le ZrO2 sous-jacent couche en raison de sa petite taille. Au MoS2 /ZrO2 interface avec CHF3 traitement au plasma, l'élargissement du VBO (réduction du CBO) est principalement attribué à la montée des niveaux de noyau de Zr 3d illustré sur la figure 2c, indiquant que les ions F ont une forte interaction avec les atomes de Zr. Puis les effets de CHF3 traitement sur les propriétés électroniques du ZrO2 ont été étudiés à l'aide de Material Studio combiné avec le Cambridge Sequential Total Energy Package (CASTEP) basé sur la théorie de la fonctionnelle de la densité (DFT) [26]. L'approximation du gradient généralisé pour le potentiel d'échange et de corrélation proposée par Perdew-Burk-Ernzerhof (PBE) [27] a été utilisée pour traiter les interactions ion-électron avec le potentiel d'onde augmenté du projecteur (PAW) [28]. L'énergie de coupure de l'onde plane est choisie pour être de 750 eV, et un maillage k de Monkhorst–Pack de 1 × 1 × 1 est utilisé pour échantillonner la zone de Brillouin dans l'optimisation de la structure et le calcul de l'énergie totale [29]. Tous les atomes ont été détendus vers leurs positions d'équilibre jusqu'à ce que l'énergie totale change au cours de l'optimisation ait finalement convergé à moins de 10 −6 eV/ atome, la force et la contrainte sur chaque atome ont convergé à 0,003 eV/nm et 0,05 GPa, respectivement, et le déplacement a convergé à 1 × 10 −4 nm. La figure 4a, b montre la densité d'états totale et partielle (DOS) pour les deux MoS2 /ZrO2 échantillons, où zéro eV correspond au niveau de Fermi. De toute évidence, les ions F ont une forte interaction avec les atomes de Zr, ce qui fait qu'une partie de l'orbitale d des atomes de Zr qui est projetée sur la bande de valence se déplace vers le bas d'environ 0,76 eV de − 0,06 à − 0,82 eV en dessous du niveau de Fermi, ce qui est en accord avec l'élargissement du décalage de bande de cantonnière ∆E V ~ 0,75 eV. Les atomes F ont tendance à attirer les électrons en raison de la grande électronégativité (4,0) et deviennent partiellement chargés négativement, puis forment en outre des dipôles avec des atomes de Zr, contribuant finalement au changement du décalage de bande. Par conséquent, la bande change au MoS2 /ZrO2 interface introduite par le CHF3 le traitement au plasma offre un moyen prometteur d'ajuster l'alignement des bandes aux hétérojonctions, ce qui facilite la conception des dispositifs associés.

La densité totale d'états (TDOS) et la densité partielle d'états (PDOS) calculées pour les échantillons sans CHF3 traitement (a ) et avec CHF3 traitement (b )
Conclusions
Dans cet article, nous avons exploré l'ingénierie des bandes d'énergie au MoS multicouche2 /ZrO2 interface et étudié les effets de CHF3 traitement par spectroscopie photoélectronique aux rayons X. Les résultats ont démontré qu'un alignement de type I s'est formé au niveau du MoS2 /ZrO2 interface d'hétérojonction avec CBO et VBO d'environ 2,49 eV et 1,87 eV, respectivement. Alors que le CHF3 le traitement au plasma augmente le VBO d'environ 0,75 ± 0,04 eV principalement en raison du décalage vers le haut de l'énergie au niveau du cœur de Zr 3d, ce qui est cohérent avec les résultats des calculs. Ce travail prouve le grand potentiel d'applications du ZrO2 à κ élevé oxyde en multicouche MoS2 et fournit un moyen possible de modifier l'alignement de la bande d'énergie de l'interface.
Abréviations
- 2D :
-
Bidimensionnel
- CASTEP :
-
Ensemble d'énergie totale séquentielle Cambridge
- CBO :
-
Décalage de la bande de conduction
- CVD :
-
Dépôt chimique en phase vapeur
- DFT :
-
Théorie fonctionnelle de la densité
- DOS :
-
Densité d'états
- FET :
-
Transistors à effet de champ
- FWHM :
-
Pleine largeur à mi-hauteur
- MoS2 :
-
Bisulfure de molybdène
- PAW :
-
Projecteur vague augmentée
- PBE :
-
Perdew-Burk-Ernzerhof
- PMMA :
-
Poly méthacrylate de méthyle
- SIMS :
-
Spectrométrie de masse ionique secondaire
- TDMAZr :
-
Tétrakis Diméthyl Amido Zirconium
- TEM :
-
Microscopie électronique à transmission
- TMD :
-
Dichalcogénures de métaux de transition
- VBO :
-
Décalage de la bande de valence
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- ZrO2 :
-
Dioxyde de zirconium
Nanomatériaux
- Utilisations du molybdène dans l'industrie sidérurgique
- Utilisations du molybdène dans l'industrie chimique
- Quels sont les types et les utilisations de la tige de molybdène?
- Applications du molybdène et des alliages de molybdène
- Impact de l'état sur l'efficacité et la fiabilité du moteur
- Utiliser les angles pour améliorer l'avenir de l'électronique
- Passer au vert :avantages et inconvénients de l'énergie éolienne
- Sécuriser l'OT dans le secteur de l'énergie et des services publics
- L'histoire du sciage à ruban et ses idées novatrices



