Progrès récents dans le β-Ga2O3–Contacts métalliques
Résumé
Oxyde de bêta-gallium à bande interdite ultra-large (β-Ga2 O3 ) a suscité une attention considérable en tant que matériau semi-conducteur prometteur pour l'électronique de puissance de nouvelle génération. Il possède d'excellentes propriétés matérielles telles qu'une large bande interdite de 4,6 à 4,9 eV, un champ électrique de claquage élevé de 8 MV/cm et une figure de mérite exceptionnelle de Baliga (BFOM), ainsi qu'une stabilité chimique et thermique supérieure. Ces caractéristiques suggèrent son grand potentiel pour de futures applications dans les dispositifs de puissance et optoélectroniques. Cependant, la question critique des contacts entre le métal et le Ga2 O3 limite les performances du β-Ga2 O3 dispositifs. Dans ce travail, nous avons passé en revue les avancées sur les contacts de β-Ga2 O3 MOSFET. Pour améliorer les propriétés de contact, quatre approches principales sont résumées et analysées en détail, notamment le prétraitement, le post-traitement, l'électrode métallique multicouche et l'introduction d'une couche intermédiaire. Par comparaison, ces deux dernières méthodes sont étudiées intensivement et plus favorables que le pré-traitement qui générerait inévitablement des dommages incontrôlables. Enfin, les conclusions et les perspectives futures pour améliorer davantage les contacts ohmiques sont présentées.
Introduction
Récemment, l'oxyde de gallium (Ga2 O3 ) a été considéré comme un candidat prometteur pour la préparation de dispositifs à haute puissance et à haut rendement en raison de ses excellentes propriétés matérielles [1,2,3]. Ga2 O3 a cinq polymorphes différents, désignés comme α-Ga2 O3 , -Ga2 O3 , -Ga2 O3 , -Ga2 O3 , et -Ga2 O3 , dont β-Ga2 O3 est la plus stable thermodynamiquement et a été largement étudiée [4]. Avec une bande interdite ultra-large de 4,6 à 4,9 eV [5,6,7], le champ électrique de claquage théorique (E br ) de 8 MV/cm pour le β-Ga2 O3 est environ trois fois plus grand que celui du SiC ou du GaN [8,9,10], ce qui permet au β-Ga2 O3 -appareils basés pour gérer des tensions de commutation gigantesques. L'adéquation des semi-conducteurs aux applications de dispositifs de puissance est généralement évaluée par la figure de mérite de Baliga (BFOM) [11]. Le BFOM de β-Ga2 O3 est presque le triple de celui du SiC et du GaN, ce qui réduit considérablement la perte de conduction [3, 12, 13, 14]. De plus, la vitesse de saturation des électrons est théoriquement estimée à environ 2 × 10 7 cm/s, ce qui le rend attrayant pour les opérations à haute fréquence [15,16,17,18,19,20]. Autre intérêt distinctif du β-Ga2 O3 parmi les semi-conducteurs à large bande interdite est que des monocristaux de haute qualité peuvent être synthétisés de manière rentable en utilisant des techniques de croissance à l'état fondu [21,22,23,24]. De plus, -Ga2 de type n de haute qualité O3 les films épitaxiaux peuvent être réalisés en dopant précisément avec Sn, Si, Ge et Mg, et la densité électronique obtenue varie de 10 16 à 10 19 cm −3 [25,26,27,28]. En raison des avantages mentionnés ci-dessus par rapport aux autres semi-conducteurs à large bande interdite, β-Ga2 O3 montre que ses capacités sont un matériau prometteur pour l'électronique de puissance ainsi que pour l'électronique dans les environnements extrêmes (haute température, haute tension et rayonnement élevé) [29,30,31].
Beaucoup de β-Ga2 prometteurs O3 dispositifs ont été signalés, y compris les diodes à barrière Schottky [32], les MOSFET [1,2,3] et divers types de photodétecteurs solaires [33, 34]. Parmi ces dispositifs, les MOSFET sont la configuration la plus répandue pour le fonctionnement à haute fréquence et à haute puissance [35], faisant pleinement jouer son E élevé. br et BFOM. Cependant, l'un des défis pour β-Ga2 O3 L'application dans les dispositifs MOSFET est la difficulté à former des contacts ohmiques par rapport aux semi-conducteurs à bande interdite étroite [36]. Habituellement, un excellent contact ohmique entre le semi-conducteur et l'électrode métallique est essentiel pour les dispositifs semi-conducteurs hautes performances [37, 38]. Des contacts à faible résistance pourraient réduire la chute de tension sur le contact et par conséquent augmenter la tension à travers le canal, garantissant la densité de courant conçue et des vitesses de commutation élevées. De plus, les contacts à faible résistance contribuent à réduire la génération de chaleur qui pourrait aggraver l'effet d'auto-échauffement.
En conséquence, la fabrication de contacts ohmiques de haute qualité est une condition préalable à la réalisation de dispositifs performants. Dans cette revue, nous commençons par les concepts fondamentaux des contacts métal/semi-conducteur. Dans la section « Approches des contacts ohmiques », un résumé des récentes avancées significatives sur les contacts ohmiques à β-Ga2 O3 est présenté, et les approches des contacts ohmiques sont discutées et analysées. Enfin, quelques perspectives sont proposées pour améliorer les contacts ohmiques en β-Ga2 O3 à l'avenir.
Physique de base des contacts ohmiques
Un contact ohmique est une jonction métal/semi-conducteur dans laquelle il n'y a pas de barrière à l'interface empêchant le transport des porteurs, comme illustré sur la Fig. 1a. Au contraire, une barrière énergétique existant à l'interface inhibera le transport de porteurs entre le métal et le semi-conducteur, comme le montre la figure 1b. Notamment, les contacts formés entre les semi-conducteurs à large bande interdite et les métaux sont toujours Schottky. Ainsi, la résistance de contact dépend normalement de la hauteur de barrière Schottky métal/semi-conducteur (SBH) ΦB . Pour un semi-conducteur de type n, il obéit à l'équation :
$$ {q\Phi}_B={q\Phi}_m-{\chi}_s $$ (1)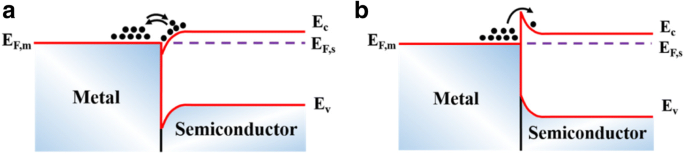
Illustrations schématiques de a Contacts ohmiques et b Contacts Schottky. E C , E V , E F , m , et E F , s sont les niveaux d'énergie du bord de la bande de conduction, du bord de la bande de valence, de l'énergie de Fermi du métal et du semi-conducteur, respectivement
où Φm est le travail d'extraction du métal et χ s est l'affinité électronique du semi-conducteur.
Comme décrit dans l'Éq. (1), il est important de réduire le SBH pour former le contact ohmique. De plus, un dopage élevé dans les semi-conducteurs pourrait faciliter la formation de contacts ohmiques, par exemple pour les semi-conducteurs fortement dopés (ND> ~ 10 18 cm −3 ), la barrière deviendra suffisamment étroite et permettra aux électrons de passer directement à travers l'interface en raison de la courbure importante de la bande de conduction [39], comme le montre la Fig. 2. Néanmoins, les niveaux de dopage pouvant être atteints dans β- Ga2 O3 sont généralement inférieurs à ce qui peut être obtenu dans Si, comme c'est le cas avec d'autres semi-conducteurs larges. En dehors de cela, les états de surface jouent également un rôle important dans la formation de contacts ohmiques qui sont fréquemment définis comme des régions de recombinaison à haut débit. Ces niveaux de défaut de bande interdite moyenne induits par les états de surface sont capables d'aider le transport des porteurs. Cela implique qu'un bon contact ohmique peut être formé en introduisant des états de surface appropriés dans les semi-conducteurs [40,41,42,43].
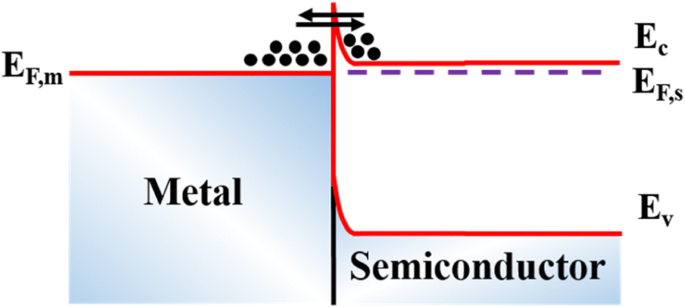
Le diagramme de bande d'énergie à l'interface métal/semi-conducteur avec des semi-conducteurs fortement dopés
Une quantification électrique des caractéristiques de contact est nécessaire pour évaluer la qualité des contacts. Actuellement, la résistivité de contact spécifique ρ C est l'un des paramètres couramment utilisés pour accéder aux performances des contacts ohmiques, généralement exprimée en Ω ∙ cm 2 [44]. La résistivité de contact spécifique est une grandeur très utile qui est indépendante de la géométrie du contact et se réfère uniquement à l'interface métal/semi-conducteur. Jusqu'à présent, le plus bas ρ C de 4,6 × 10 −6 cm 2 a été signalé pour les contacts Ti/Au à β-Ga2 O3 [45]. Wong et al. a également obtenu un faible ρ C de 7,5 × 10 −6 cm 2 avec contacts Ti/Au [46]. Jusqu'à présent, de nombreux efforts ont été consacrés pour obtenir la mise en contact avec de faibles ρ C , et les valeurs typiques des résistivités de contact spécifiques réparties sur une plage de 10 −5 –10 −6 cm 2 pour de bons contacts ohmiques [36].
Approches des contacts ohmiques
A ce jour, des investigations sur les propriétés intrinsèques du β-Ga2 O3 la plupart ont été réalisées sur sa structure MOSFET, dans laquelle deux types de méthode de synthèse de canal sont généralement adoptés. L'un est le flocon exfolié par micromécanique (nanomembrane); l'autre est l'épitaxie β-Ga2 O3 film sur son substrat natif, comme résumé dans le tableau 1.
Normalement, -Ga2 exfolié O3 les flocons peuvent être transférés sur n'importe quel substrat de manière pratique et économique. On constate que les propriétés matérielles du β-Ga2 O3 les flocons ne dégénéreraient pas pendant l'exfoliation comme en témoignent la spectroscopie Raman et la microscopie à force atomique [19], ce qui signifie que les performances des MOSFET basés sur les flocons exfoliés sont comparables à celles basées sur les couches épitaxiées. En raison de ces avantages, cette méthode est recommandée pour étudier les caractéristiques électriques consistant en la densité des défauts interfaciaux, la tension de claquage, la diffusion des phonons optiques de surface [47,48,49] et la propriété thermique, c'est-à-dire l'effet d'auto-échauffement [50, 51].
Comme résumé dans le tableau 1, les méthodes utilisées pour améliorer les contacts ohmiques peuvent être généralement classées en trois types :(1) pré-traitement, (2) post-traitement et (3) électrode métallique multicouche. En outre, l'introduction d'une couche intermédiaire peut également obtenir des contacts ohmiques supérieurs, ce qui n'est pas indiqué dans le tableau 1.
Pré-traitement
Le prétraitement est effectué avant le dépôt du métal, y compris l'implantation ionique, le bombardement plasma et la gravure ionique réactive (RIE). Higashiwaki et al. ont démontré que les contacts formés en utilisant l'empilement Ti/Au avec le processus de prétraitement RIE présentaient un comportement presque ohmique, tandis que l'échantillon sans traitement RIE présentait un comportement Schottky, comme illustré sur la figure 3 [1]. La différence significative pourrait être attribuée à la diffusion externe des atomes d'oxygène libres générés par le bombardement continu en brisant les liaisons Ga-O exposées, laissant de nombreuses lacunes d'oxygène qui agissent comme des donneurs dans β-Ga2 O3 . D'autre part, le traitement RIE en continu générerait également des états de surface considérables qui jouent un rôle important lors de la formation du contact [41]. La figure 4 montre les caractéristiques de sortie CC associées à partir desquelles un courant quasi-linéaire à faible tension de drain peut être observé. Dans leurs travaux ultérieurs, comme le montre la figure 5, les caractéristiques de sortie ont montré une bonne relation de linéarité entre le courant et la tension de drain dans lesquels l'implantation d'ions Si et le RIE ont été appliqués à β-Ga2 O3 ensemble et une résistivité de contact spécifique extrêmement faible de 8,1 × 10 −6 cm 2 a été atteint [12]. Evidemment, le comportement Ohmique obtenu par RIE et Si + l'implantation ensemble surpasserait celle par RIE uniquement puisque les atomes de Si sont connus pour être des donneurs peu profonds avec de petites énergies d'activation dans β-Ga2 O3 [34]. De plus, Zhou et al. a signalé la haute performance β-Ga2 O3 transistors à effet de champ avec bombardement plasma d'Ar avant dépôt de métal par contact [52]. Au contraire, l'échantillon sans bombardement Ar présentait un contact Schottky. La différence peut être attribuée à la génération de lacunes d'oxygène et d'états de surface au cours du processus de bombardement par plasma Ar, le même que le traitement RIE.
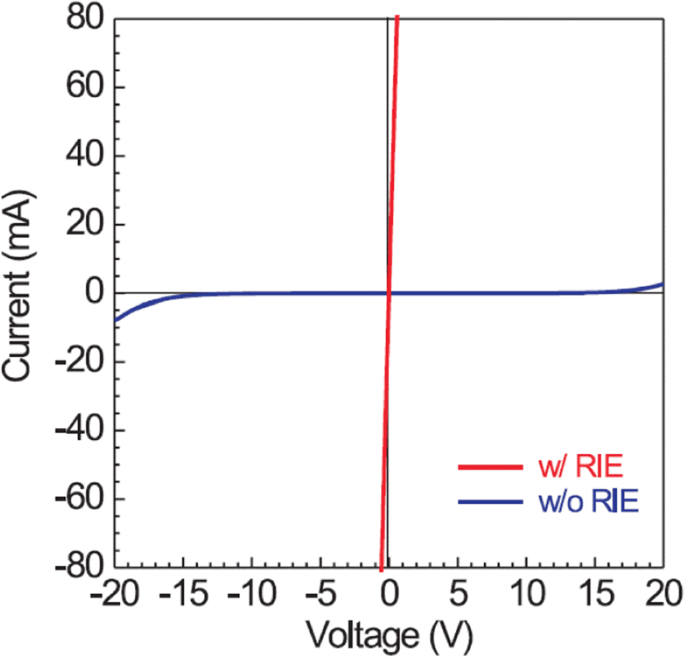
(Couleur en ligne) Courbes I-V mesurées entre deux contacts (Ti/Au tel que déposé) fabriqués avec et sans traitement RIE sur n-Ga2 O3 substrats. Reproduit de la Réf. [1]
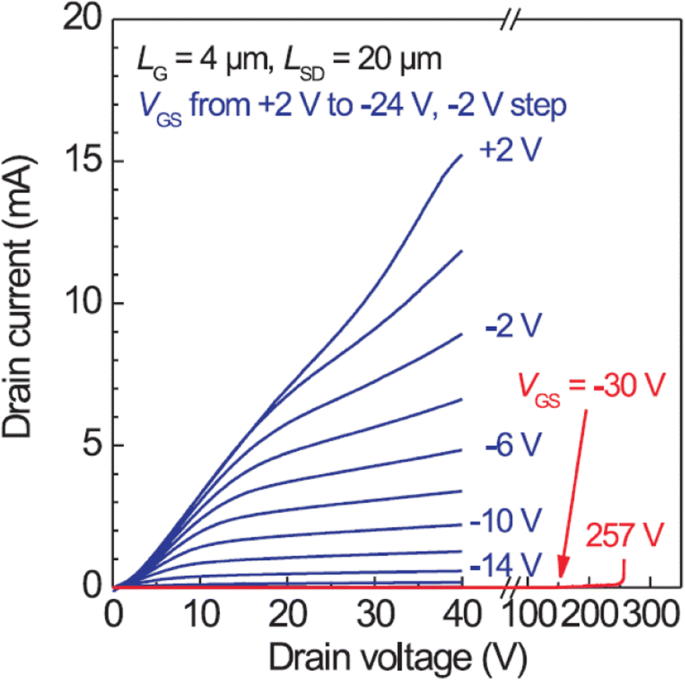
(Couleur en ligne) Caractéristiques de sortie CC de Ga2 O3 transistors à effet de champ métal/semi-conducteur. Reproduit de la Réf. [1]
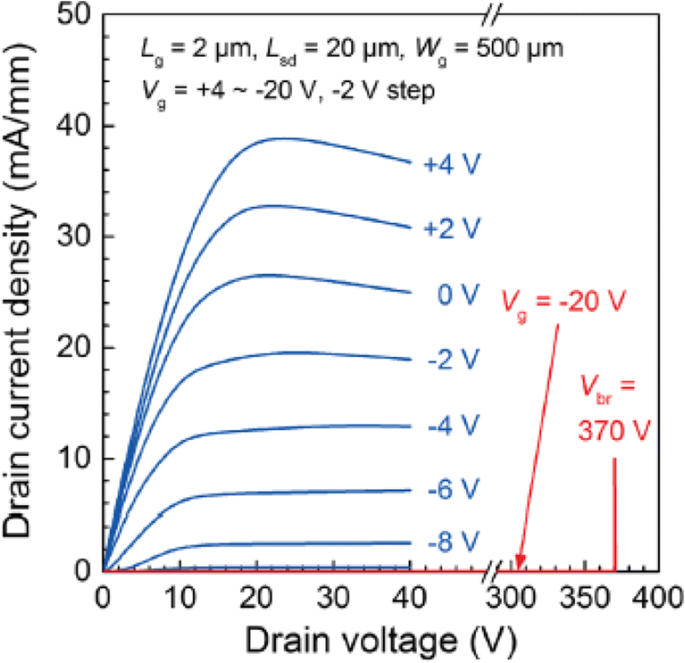
Courbes DC I–V de Ga2 O3 MOSFET (L g = 2 μm) mesuré à TA. Reproduit de la Réf. [12]
Bien que les techniques mentionnées ci-dessus puissent améliorer les performances des contacts ohmiques, ces technologies ne sont pas applicables dans la pratique car les dommages induits sont généralement la dernière chose que les ingénieurs de procédés souhaitent dans les dispositifs à semi-conducteurs, et de plus, les contacts ohmiques induits par les dommages ne sont pas toujours reproductibles.
Pour cette raison, en dehors des techniques traditionnelles susmentionnées fréquemment utilisées pour former des contacts ohmiques à faible résistance, une technique relativement nouvelle - le dopage sur verre (SOG) - a été récemment adoptée [53], et une résistivité de contact spécifique de 2,1 ± 1,4 × 10 −5 cm 2 a été atteint, ce qui a permis de vérifier l'efficacité de la technique de dopage SOG. La figure 6 montre les caractéristiques de sortie du -Ga2 dopé SOG O3 MOSFET qui présentaient un excellent comportement linéaire à faible tension de drain. Par rapport à l'implantation ionique, le dopage SOG réduit la diffusion des espèces induite par les dommages et réduit les coûts en abandonnant le coûteux implanteur ionique. Semblable aux implantations ioniques, le principe de base de cette technologie consiste à doper la région S/D avec des donneurs peu profonds. Évidemment, le contact ohmique supérieur peut être obtenu avec du β-Ga2 intentionnellement dopé O3 . Par exemple, le -Ga2 hautement dopé O3 a été utilisé pour fabriquer du β-Ga2 O3 transistors à effet de champ avec des courants de drain supérieurs à 1,5 A/mm [50]. Le courant de drain élevé record est dû au fort dopage dans β-Ga2 O3 ce qui provoque une couche d'appauvrissement très mince, et les électrons peuvent facilement traverser cette barrière, conduisant à un comportement de contact ohmique. Fait intéressant, l'orientation du -Ga2 O3 surface peut également exercer une influence sur le comportement de contact. Baïk et al. ont rapporté que les mêmes électrodes sur β-Ga2 O3 ont montré différentes propriétés de contact, dans lesquelles l'échantillon sur le substrat (\( \overline{2} \)01) se comportait comme des contacts ohmiques tandis que l'échantillon de contrôle sur (010) présentait un comportement Schottky. Cela pourrait être attribué à un rapport Ga/O différent et à une densité de liaisons pendantes à des orientations spécifiques [54].
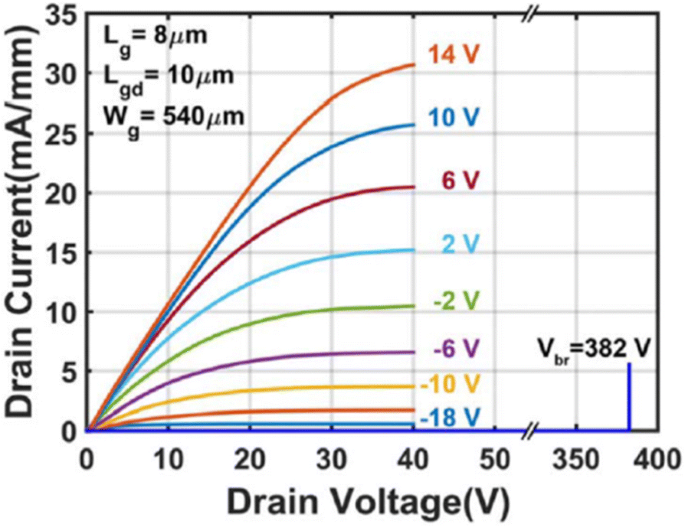
Caractéristiques de sortie du MOSFET dopé S/D SOG avec L g = 8 μm, espacement des vannes de vidange L gd = 10 μm. Reproduit de la Réf. [53]
Post-traitement
Le post-traitement est effectué après dépôt de métal, se référant principalement au processus de recuit. Le recuit joue un rôle dans la réduction des dommages induits par les technologies de traitement antérieures telles que l'implantation ionique et le bombardement plasma. De plus, il contribue à la formation d'une couche intermédiaire qui peut réduire la discontinuité de la bande de conduction entre le métal et le β-Ga2 O3 . Remarquablement, les paramètres tels que la température, l'atmosphère et le temps de recuit exercent une influence importante sur les performances des appareils. L'expérience sur le recuit sous air et N2 a été mis en œuvre pour comparer l'effet de l'atmosphère de recuit sur β-Ga2 O3 -à base de contacts ohmiques [55]. Comme on peut le voir sur la Fig. 7, les performances du recuit dans N2 a surpassé celui dans l'air, ce qui pourrait être attribué au fait qu'une pression partielle d'oxygène plus élevée dans l'air a supprimé la formation de lacunes d'oxygène. Cependant, la dépendance des caractéristiques de contact sur la température, l'atmosphère et le temps de recuit sur les caractéristiques de contact n'est pas claire; par conséquent, il est en outre nécessaire d'optimiser les paramètres du processus de recuit.
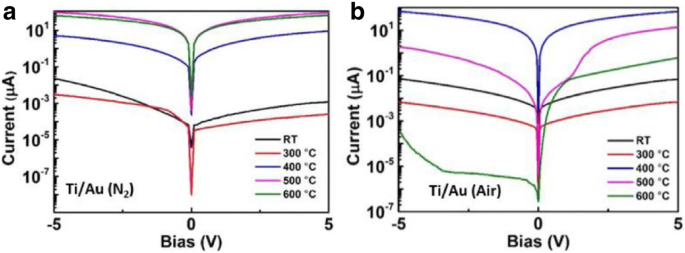
Propriétés électriques du β-Ga2 O3 flocons avec différentes atmosphères de recuit thermique et température de recuit. Contacts Ti/Au sous a N2 et b air. Reproduit de la Réf. [55]
Électrode métallique multicouche
Une autre approche pour former des contacts ohmiques consiste à réduire le SBH à l'interface métal/semi-conducteur. Le SBH est égal à la différence entre le travail de sortie du métal et l'affinité électronique du semi-conducteur. Sur la base de cette reconnaissance, on pourrait s'attendre à ce que les métaux à faible travail d'extraction forment des contacts ohmiques sur β-Ga2 O3 . Néanmoins, il a été prouvé que le travail de sortie n'est pas le facteur dominant de formation du contact ohmique [56].
Neuf métaux déposés sur β-Ga2 O3 ont été sélectionnés en fonction des propriétés telles que le travail d'extraction, la température de fusion et la stabilité de l'oxyde [57]. La fonction de travail du métal du Ti et l'affinité électronique du β-Ga2 dopé non intentionnellement O3 sont connus pour être de 4,33 eV et 4,00 ± 0,05 eV, respectivement [19, 58, 59], donc une barrière de 0,22 eV devrait exister à l'interface menant au contact Schottky. Néanmoins, il s'est avéré que les contacts Ti avec une couche de recouvrement Au étaient ohmiques avec la plus faible résistance parmi neuf métaux après recuit. Entre-temps, Bae et al. a exploré la dépendance des propriétés de contact sur le Ti/Au et Ni/Au pour des dispositifs basés sur le β-Ga2 exfolié O3 flocons [55]. Il a été observé que les performances des MOSFET avec des électrodes métalliques Ti/Au surpassaient celles des électrodes métalliques Ni/Au dans les mêmes conditions de recuit. Au début, on considérait que les fonctions de sortie de Ni et Ti sont respectivement de 5,01 eV et 4,33 eV, de sorte que Ti peut former un contact ohmique plus facilement que Ni ; cependant, des études par spectroscopie à dispersion d'énergie (EDS) ont démontré que le pourcentage atomique d'oxygène dans le -Ga2 O3 région a diminué tandis que le pourcentage atomique d'oxygène dans Ti près de l'interface a augmenté après recuit, comme illustré sur la Fig. 8 [55]. Ce phénomène est attribué à la diffusion externe des atomes d'oxygène du -Ga2 O3 en Ti métal, conduisant à la formation de lacunes d'oxygène agissant comme donneurs. De plus, pendant le processus de recuit, la diffusion accélérée des atomes d'oxygène dans le β-Ga2 O3 pourrait réagir avec Ti et former Ti2 O3 ce qui est utile pour former des contacts ohmiques en raison de son faible travail de sortie (3,6-3,9 eV). Par conséquent, la réaction interfaciale entre les métaux et le β-Ga2 O3 est un facteur important dans la formation de contacts ohmiques à l'interface métal/semi-conducteur.
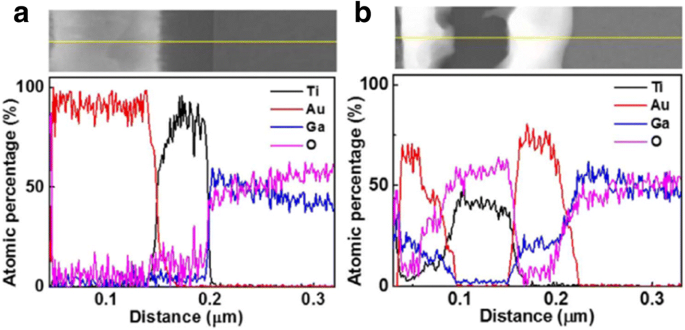
Profils de pourcentage atomique par EDS de métallisation et β-Ga2 O3 un pré- et b post-recuit à une température de 500 ° C. Reproduit de la Réf. [55]
De plus, on constate que la plupart des électrodes métalliques Ti/Au utilisées pour former des contacts ohmiques ont été recuites à 450 ° C [45, 53] ou 470 ° C [12, 46, 57, 60] par procédé thermique rapide. Un comportement de dégradation similaire des caractéristiques de contact a été observé lorsque le recuit a été effectué au-dessus de 500 ° C dans Réf. [55, 56], comme illustré sur les Fig. 7 et 9, respectivement. Yao et al. ont émis l'hypothèse qu'une couche d'oxyde isolante s'était formée éventuellement à une température de recuit élevée, entraînant la détérioration des contacts. Néanmoins, Bae et al. observé que la surface du métal déposé était beaucoup plus rugueuse après 700 ° Recuit C dû au mélange de métaux et à la diffusion d'atomes de gallium et d'oxygène dans les électrodes métalliques, qui a été attribué à la cause du comportement de dégradation. Évidemment, les mécanismes de dégradation des contacts Ti/Au en β-Ga2 O3 après recuit à haute température sont encore en débat.
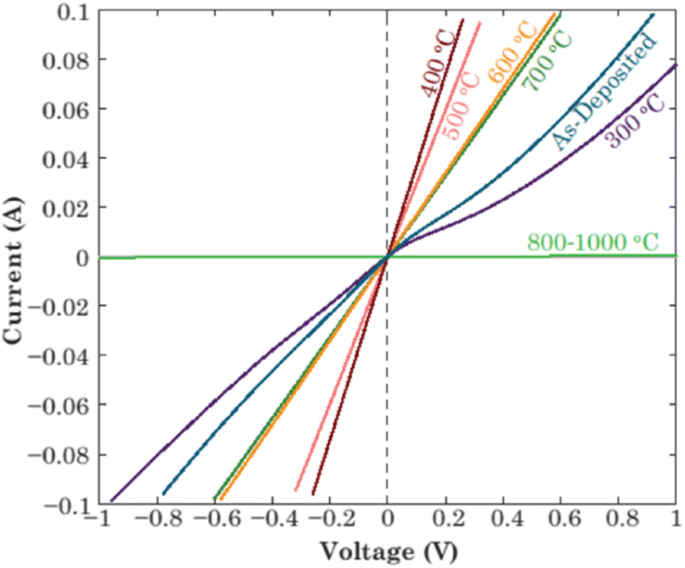
Tracés I–V pour les contacts Ti/Au sur Ga2 dopé au Sn (\( \overline{2} \)01) O3 plaquette en fonction de la température de recuit en Ar (temps de recuit 1 min). Reproduit de la Réf. [56]
-Ga2 O3 -Les appareils à base de contacts Ti/Au ne peuvent pas répondre à la demande de travail à haute température. Par conséquent, pour éviter la dégradation des caractéristiques de contact à une température de recuit élevée, des empilements métalliques plus complexes doivent être adoptés. De loin, des empilements métalliques Ti/Al/Au [50, 52], Ti/Au/Ni [61, 62] et Ti/Al/Ni/Au [13, 21, 63, 64] ont été utilisés pour former contacts sur β-Ga2 O3 . Mais une comparaison complète des caractéristiques de contact entre ces empilements métalliques est encore insuffisante.
Mohammad [65] et Greco et al. [36] ont discuté du rôle de chaque couche métallique dans les empilements métalliques complexes, fournissant quelques lignes directrices pour améliorer les contacts ohmiques. Le schéma des empilements métalliques est illustré à la Fig. 10. Notez que cette approche est actuellement en cours de développement pour les dispositifs d'alimentation à base de GaN [66,67,68,69].
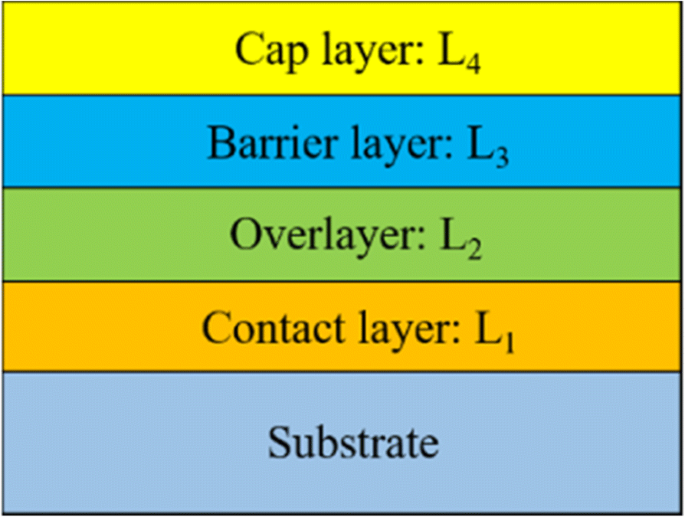
Le schéma des empilements métalliques permettant d'obtenir des contacts ohmiques vers des semi-conducteurs à large bande interdite
La première couche métallique sur le substrat, appelée couche de contact, doit avoir un faible travail d'extraction et une bonne adhérence au substrat. De plus, il peut également bloquer la diffusion des métaux de la couche supérieure avec des fonctions de sortie importantes dans le substrat. Actuellement, Ti est le métal principal comme couche de contact avec β-Ga2 O3 en raison de sa faible fonction (4,33 eV) et de sa bonne adhérence au substrat. Par ailleurs, la formation de Ti2 O3 et Ti3 O5 avec des fonctions de travail inférieures à celles du Ti à l'interface est favorisée pour former des contacts ohmiques car les oxydes réduisent le SBH et laissent des lacunes d'oxygène agissant comme donneurs. Cependant, d'autres métaux à faible travail de sortie, notamment Ta (3,1 eV) et Hf (3,9 eV) n'ont pas encore été explorés. La deuxième surcouche à faible travail d'extraction doit être capable de former des composés intermétalliques avec la couche de contact pour empêcher leur diffusion dans l'interface. Actuellement, Al est utilisé comme couche de recouvrement car il peut répondre à ces exigences. La troisième couche métallique (couche barrière) sert à limiter l'indiffusion de la couche métallique supérieure et la diffusion externe des couches métalliques inférieures [70, 71]. Ni est la couche barrière la plus couramment utilisée pour le β-Ga2 O3 . Il existe d'autres bons candidats comme Mo, Nb et Ir avec des points de fusion élevés pour substituer Ni qui devraient avoir une réactivité et une solubilité plus faibles pour Au que Ni [72,73,74,75]. La quatrième couche de protection agit comme une couche protectrice pour empêcher ou minimiser l'oxydation des métaux sous-jacents. Dans la pratique, Au est couramment utilisé pour atteindre cet objectif.
Présentation d'un intercalaire
Il existe principalement deux méthodes pour introduire une couche intermédiaire au niveau du métal/β-Ga2 O3 interface. L'une consiste à former une couche semi-conductrice intermédiaire (ISL) avec un faible travail d'extraction par recuit, par exemple Ti2 O3 . L'autre consiste à insérer l'ISL déposé entre le métal et le β-Ga2 O3 , qui a été intensivement étudié [76,77,78]. Par rapport à la première méthode, cette dernière est plus favorable pour former des contacts ohmiques en raison de la forte concentration en porteurs de l'ISL. Les bandes interdites des ISL vont de 3,5 à 4,0 eV [79,80,81], comme AZO (~ 3,2 eV) [82], In2 O3 (~ 2,9 eV) [83, 84] et IGZO (~ 3,5 eV) [85]. Typiquement, les SBH de divers métaux déposés sur β-Ga2 O3 sont compris entre 0,95 et 1,47 eV [86, 87], comme le montre la figure 11a. Néanmoins, l'incorporation d'un ISL mince réduit le SBH, facilitant le transport des électrons du métal vers la bande de conduction de β-Ga2 O3 , comme illustré à la Fig. 11b. De plus, la haute densité d'électrons dans l'ISL pourrait réduire davantage la résistance de contact.
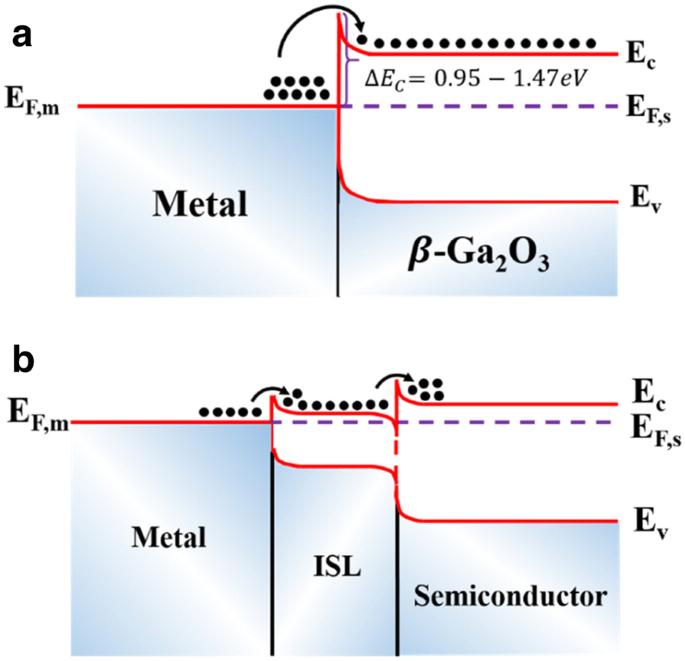
Le schéma des décalages de bande pour a métal/β-Ga2 O3 et b métal/ISL/β-Ga2 O3 . ∆E c est égal à la différence d'énergie entre l'énergie de Fermi des métaux et la bande de conduction des semi-conducteurs
Dernièrement, AZO/Ti/Au a été utilisé comme électrodes sur Si + -implant -Ga2 O3 , et la résistivité de contact spécifique obtenue était de 2,82 × 10 −5 cm 2 après recuit [76]. Oshima et al. obtenu des contacts ohmiques platine/indium-oxyde d'étain (Pt/ITO) à β-Ga2 O3 avec une large plage de fenêtre de température de processus [77]. La grande fenêtre de traitement de 900 à 1150 ° C permet la réalisation d'un fonctionnement à haute température. Et électrodes ITO/Ti/Au vers β-Ga2 O3 ont également été démontrés par Carey et al. [78] dans lequel l'échantillon a montré un comportement ohmique avec ρ C de 6,3 × 10 − 5 Ω∙cm 2 après recuit. Sans l'ITO, le même recuit n'a pas fourni de caractéristiques courant-tension linéaires. Ces résultats vérifient l'efficacité de l'ajout d'ISL pour obtenir des contacts ohmiques.
Notamment, une bulle à la surface des contacts ITO/Ti/Au a été observée alors qu'aucune bulle n'a été observée sur la seule couche d'ITO sans couche métallique au-dessus [78]. Il a été considéré comme le résultat de la diffusion externe d'atomes d'oxygène dans la couche d'ITO dans les couches métalliques supérieures. Par conséquent, il est nécessaire de choisir des empilements métalliques ou métalliques appropriés comme couches de recouvrement sur ITO pour éviter la dégradation de la morphologie de la surface.
Conclusions
Dans ce travail, nous avons résumé les progrès significatifs en R&D du β-Ga2 O3 MOSFET. Néanmoins, les contacts sur β-Ga2 O3 sont l'un des principaux problèmes limitant son application potentielle en tant que dispositifs haute fréquence et haute tension à l'avenir. Bien que cette revue donne un aperçu des méthodes de pointe pour former des contacts ohmiques, il reste encore beaucoup d'espace à explorer, et un ensemble de perspectives concises peut être digéré comme suit :(i) La dépendance à la température et le mécanisme de dégradation des caractéristiques de contact nécessite des investigations supplémentaires pour une clarification claire ; (ii) Les métaux à faible travail d'extraction comme Ta et Hf et les métaux à point de fusion élevé comme Mo, Nb et Ir méritent d'être criblés pour servir respectivement de couche de contact et de couche barrière ; (iii) Les empilements de métaux optimaux sur β-Ga2 O3 n'ont pas encore été pleinement réalisés, et une étude complète et systématique des empilements métalliques à β-Ga2 O3 est impératif pour obtenir des contacts ohmiques à faible résistance et thermiquement stables ; et (iv) D'autres ISL potentiels constitués de ZnO, IZO, IGZO, etc. restent inexploités, ainsi que l'influence de l'épaisseur variable et de la proportion d'ingrédients des ISL sur la performance des contacts. En résumé, les études sur les contacts ohmiques au β-Ga2 O3 sont encore assez superficiels; nous pensons que ce sujet continuera d'être l'une des questions prioritaires à l'avenir. Espérons que les approches pour former des contacts ohmiques présentées dans cette revue contribueraient à l'obtention de hautes performances β-Ga2 O3 appareils.
Nanomatériaux
- Contacts en tungstène pour appareils électriques
- Modifier le modèle de contact
- Fonctions de logique numérique
- Les fabricants font encore progresser le flash NAND 3D
- Surveillance des progrès des dispositifs médicaux
- Des articles récents détaillent l'évolutivité des nanotubes de carbone, les avancées en matière d'intégration
- Les 10 principales avancées de la technologie de fabrication des composites
- 5 grandes lectures récentes sur la convergence IT/OT
- 5 grandes lectures récentes dans l'IIoT



