Une simulation théorique des réponses de rayonnement de Si, Ge et de superréseau Si/Ge à une irradiation à basse énergie
Résumé
Dans cette étude, les réponses aux rayonnements à basse énergie des superréseaux Si, Ge et Si/Ge sont étudiées par une méthode de dynamique moléculaire ab initio et les origines de leurs différents comportements de rayonnement sont explorées. On constate que la résistance au rayonnement des atomes de Ge qui se trouvent autour de l'interface du super-réseau Si/Ge est comparable à celle du Ge massif, alors que les atomes de Si autour de l'interface sont plus difficiles à déplacer que le Si massif, montrant une tolérance au rayonnement améliorée comme par rapport au Si massif. Les mécanismes de génération de défauts dans les structures en vrac et en super-réseau présentent un caractère quelque peu différent, et les défauts associés dans le super-réseau sont plus complexes. Les calculs de formation et de migration des défauts montrent que dans la structure du super-réseau, les défauts ponctuels sont plus difficiles à former et les lacunes sont moins mobiles. La tolérance au rayonnement améliorée du super-réseau Si/Ge bénéficiera à ses applications en tant que dispositifs électroniques et optoélectroniques dans un environnement de rayonnement.
Contexte
Au cours des dernières décennies, le super-réseau Si/Ge (SL) a attiré beaucoup d'attention dans la recherche sur les semi-conducteurs en raison de sa contribution potentielle au développement de nouveaux dispositifs électroniques et optoélectroniques [1,2,3,4,5,6]. Par exemple, l'étude de la photoconductivité de Si/Ge SL est d'une importance remarquable pour les photodiodes en tant qu'émetteur et récepteur pour la communication optique rapide [5]. Dans ses applications comme le composant électronique spatial, le composant microélectronique, la cellule solaire et l'électronique spatiale [1, 4, 6], les propriétés optiques et électroniques de Si/Ge SL peuvent être altérées en raison du bombardement de haute les ions énergétiques de l'environnement spatial, entraînant une dégradation des performances des appareils électroniques. Par conséquent, il est nécessaire d'étudier les réponses aux rayonnements de ce matériau semi-conducteur dans des conditions de travail extrêmes.
Récemment, de nombreux chercheurs ont étudié les effets des dommages causés par les radiations du super-réseau Si/Ge [7,8,9,10,11,12,13,14,15,16]. Sobolev et al. ont étudié les influences de l'irradiation électronique sur la photoluminescence (PL) de Si/Ge SL contenant une monocouche de Ge pur, et une résistance au rayonnement améliorée de la structure SL a été trouvée par rapport au silicium massif [12]. Fonseca et al. ont irradié le Si/Ge SL avec des points quantiques de Ge intégrés (QD) en utilisant l'irradiation de protons de 2,0 MeV et ont trouvé une résistance au rayonnement extraordinairement élevée de la structure QD-in-SL [13]. Des résultats similaires ont été obtenus par Leitão et al., qui ont rapporté que les puits quantiques Ge (QW) déposés sur une structure de diode contenant une structure multicouche Si/Ge étaient plus résistants à l'irradiation protonique que les QW Ge simples [14]. En tant que matériaux thermoélectriques prometteurs, les caractéristiques thermoélectriques du système Si/Ge peuvent également être affectées dans l'environnement de rayonnement [11, 15]. Zheng et al. irradié les multiples couches périodiques de Si1 − x Ge x /Si utilisant des ions Si de 5 MeV, et ils ont constaté que le facteur de mérite thermoélectrique augmente avec l'augmentation de la fluence des ions Si [11]. Les défauts et le désordre structurel réduisent la conductivité thermique du plan transversal en absorbant et en dissipant les phonons le long du réseau, et la densité d'états électroniques dans la minibande de la structure QD augmente la conductivité électrique et le coefficient de Seebeck, qui contribuent tous à l'augmentation de la figure du mérite [11].
Théoriquement, Sayed et Windl ont tous deux étudié les déplacements atomiques du Si massif en utilisant la méthode classique de la dynamique moléculaire (MD) [17, 18]. Ils ont trouvé que les énergies de déplacement de seuil (Ed s) dépendent de la direction d'accrochage et les états endommagés sont principalement des défauts de paire de Frenkel (FP) [17, 18]. Caturla et al. ont étudié les effets de la masse et de l'énergie des ions sur les dommages radiatifs du Si massif en utilisant la méthode MD [19]. Ils ont rapporté que la production d'amorphisation ainsi que les défauts ponctuels isolés et les petits amas ont une forte dépendance à la masse ionique et une faible relation à l'énergie ionique [19]. Holmström et al. calculé le Ed s pour le germanium en utilisant la méthode MD et a trouvé que les défauts stables sont des défauts FP [20]. Shaw et al. appliqué une méthode ab initio pour étudier les effets des défauts d'antimoine et de germanium sur la structure électronique des hétérostructures Si/Ge et a constaté que ces défauts interagissent avec les interfaces Si/Ge, entraînant des résonances localisées liées à l'interface et de grandes perturbations locales de l'électronique structure [21]. Malgré ces recherches mentionnées, aucune simulation théorique du processus dynamique de dommages dus au rayonnement de Si/Ge SL n'a été rapportée dans la littérature jusqu'à présent. Il manque encore une compréhension au niveau atomique de l'évolution microstructurale et du mécanisme sous-jacent de génération de défauts dans les super-réseaux semi-conducteurs.
La méthode de dynamique moléculaire ab initio (AIMD) s'est avérée être un outil important pour faire la lumière sur les processus d'endommagement par rayonnement et a en effet réussi à simuler les événements de recul d'une série de matériaux semi-conducteurs et céramiques [22,23,24, 25,26,27]. Par rapport à la méthode MD classique, les potentiels interatomiques sont obtenus à partir de calculs de structure électronique plutôt que d'un ajustement empirique des résultats expérimentaux. Par conséquent, de nombreux paramètres physiques comme Ed s peut être déterminé avec une précision ab initio. Dans cette étude, la méthode AIMD est utilisée pour comparer les comportements de réponse de Si, Ge et Si/Ge SL en vrac sous irradiation à basse énergie. Les énergies de déplacement de seuil ont été déterminées, et la distribution des défauts et la voie de génération des défauts ont été fournies. L'origine possible de l'écart de tolérance au rayonnement entre le Si massif (Ge) et le Si/Ge SL est également explorée. Les résultats présentés fournissent un aperçu fondamental du mécanisme microscopique des événements de déplacement dans le Si, le Ge et le Si/Ge SL en vrac et font progresser la compréhension des réponses aux rayonnements de ces matériaux dans un environnement de rayonnement.
Méthodes
Les événements de déplacement à basse énergie de Si, Ge et Si/Ge SL en vrac sont simulés par le code de l'Initiative espagnole pour les simulations électroniques avec des milliers d'atomes (SIESTA). Les pseudopotentiels de Troullier-Matrins à conservation de norme [28] sont utilisés pour déterminer l'interaction entre les ions et les électrons, et le potentiel d'échange-corrélation est décrit par l'approximation de densité locale (LDA) dans la paramétrisation Ceperly-Alder [29]. Les fonctions d'onde de valence sont étendues par un ensemble de base d'orbitales atomiques localisées, et des ensembles de base à un seul plus orbitale de polarisation (SZP) sont utilisés, avec un échantillonnage au point K de 1 × 1 × 1 dans la zone de Brillouin et une coupe- hors énergie de 60 Ry. Dans la présente étude, un Si2 /Ge2 SL, qui se compose de deux couches de Si alternant avec deux couches de Ge et au total 288 atomes, est considéré. La figure 1 illustre la configuration géométrique pour le Si massif et le Si/Ge SL. Un atome spécifique est sélectionné comme atome d'entraînement primaire (PKA), et il reçoit une énergie cinétique pour initier un événement de recul. Si le PKA revient à sa position d'origine à la fin de l'événement de déplacement, la simulation est redémarrée à une énergie de recul plus élevée avec un incrément d'énergie de 5 eV. Une fois que le PKA est déplacé de façon permanente de son site de réseau, des passes supplémentaires sont préformées pour améliorer la précision à 0,5 eV. Pour chaque type d'atome, quatre et cinq directions d'incidence principales sont prises en compte pour le Si (Ge) massif et le Si/Ge SL, respectivement. Les simulations sont réalisées avec un ensemble NVE et la durée maximale de chaque exécution est de 1,2 ps pour éviter l'instabilité du système.

Vue schématique des structures géométriques de a en vrac Si et b Superréseau Si/Ge. Les sphères bleues et vertes représentent respectivement les atomes Si et Ge
Résultats et discussion
Les événements de déplacement dans le silicium en vrac et le germanium
La constante de réseau du Si massif est déterminée à 5,50 Å, ce qui est en bon accord avec le résultat théorique de 5,48 Å [30] et le résultat expérimental de 5,43 Å [31]. Par rapport au Si massif, la constante de réseau du Ge massif est plus grande, c'est-à-dire 5,71 Å, ce qui est cohérent avec le résultat calculé de 5,65 Å [30] et la valeur expérimentale de 5,77 Å [31]. Nos énergies de déplacement de seuil calculées pour le Si et le Ge en vrac sont résumées dans le tableau 1, ainsi que les défauts associés après les événements de déplacement. Les configurations pour les états finaux d'endommagement des reculs du Si et du Ge sont tracées sur les Fig. 2 et 3, respectivement.

un –d Vue schématique des structures géométriques de l'endommagement Si après des événements de recul. Les sphères vertes et rouges représentent respectivement les lacunes et les défauts interstitiels. VSi :lacune de silicium; Siint :interstitiel en silicium

un –d Vue schématique des structures géométriques de l'endommagement Ge après des événements de recul. Les sphères rouges et bleues représentent respectivement les lacunes et les défauts interstitiels. VGe :vacance de germanium; Geint :interstitiel germanium
Pour le Si en vrac, le E d les valeurs sont légèrement inférieures aux résultats expérimentaux de 21 eV pour [001] [32], ~ 47,6 eV pour [110] [33] et ~ 12,9 eV pour [111] [34] directions, et l'expérience et nos calculs révèlent que les états finaux endommagés sont un défaut de paire de Frenkel (FP). Il est également noté que E d les valeurs de la présente étude sont généralement comparables aux résultats de DM rapportés par Windl et al. [18], sauf le cas de [110], pour lequel notre valeur calculée de 47 eV est bien supérieure au résultat MD de 24 eV. Une précédente simulation AIMD des interactions ion-solide dans le SiC a révélé que l'événement de déplacement est en fait un processus de transfert de charge et que le transfert de charge vers et depuis les atomes en recul peut modifier les barrières énergétiques et la dynamique pour la formation de défauts stables [35]. Les valeurs inférieures de E d trouvés par AIMD par rapport à ceux déterminés par MD classique peut être dû au fait que le transfert de charge qui se produit pendant les événements de recul est pris en compte par la méthode AIMD, alors que dans la simulation MD classique, la charge des atomes est fixe. Dans l'étude de Windl et al., l'énergie cinétique est transférée au PKA pour générer une lacune de silicium (VSi ) et un interstitiel en silicium (Siint ) défauts [18]. En revanche, dans notre étude, les défauts associés pour l'événement de déplacement Si[110] contiennent deux VSi et deux Siint défauts, entraînant des énergies plus élevées pour la formation des états endommagés. Le E d les valeurs de Si[111] et Si\( \left[\overline{1}\overline{1}\overline{1}\right] \) sont très proches l'une de l'autre, c'est-à-dire 9,5 et 10 eV, respectivement. Dans les deux cas, les défauts créés sont VSi et Siint (voir Fig. 2c, d), alors que les mécanismes de génération de défauts présentent un caractère différent. Dans le cas de Si[111], le Si PKA se déplace le long de la direction \( \left[11\overline{1}\right] \) en raison des interactions répulsives et entre en collision avec son atome de Si voisin. Le Si PKA se disperse alors pour occuper un site interstitiel (Siint ), et le Si remplacé revient au site du réseau de PKA. Les défauts associés sont un VSi et un Siint défauts. Quant à Si\( \left[\overline{1}\overline{1}\overline{1}\right] \), l'événement de déplacement est relativement plus simple, c'est-à-dire que le Si PKA s'éloigne de 4,69 Å de son site de réseau pour former un Siint défaut. Dans les cas de Si[001] et Si[110], le Ed s sont déterminés à 20 et 47 eV, respectivement, indiquant que les atomes de Si sont plus difficiles à déplacer le long de la direction [110]. Les états de fin d'endommagement pour Si[001] et Si[110] sont quelque peu différents. Dans le cas de Si[001], la PKA reçoit de l'énergie cinétique et se déplace dans la direction [001] pour entrer en collision avec ses atomes voisins. L'atome de Si remplacé continue de se déplacer et occupe un site interstitiel, comme le montre la figure 2a. Quant au Si[110], le PKA se disperse vers la direction\( \left[11\overline{1}\right] \) en raison des interactions répulsives entre le PKA et ses atomes voisins et heurte un atome de Si voisin (Si1) . Ensuite, le Si PKA rebondit vers la direction [111] pour remplacer un autre atome de Si (Si2), et l'atome de Si2 occupe finalement un site interstitiel. L'atome Si1 reçoit suffisamment d'énergie pour se déplacer dans la direction [110] et remplace son atome Si voisin (Si3), ce qui forme un défaut interstitiel. Au final, les défauts associés sont deux VSi et deux Siint défauts, comme illustré à la Fig. 2b.
Pour le Ge en vrac, les valeurs de E d sont en bon accord avec la valeur expérimentale de ~ 18 eV [36] et la valeur théorique de 18,5 eV [20] pour la direction [001]. Il est à noter que la valeur actuelle de 9,5 eV est comparable au résultat de Holmström de 12,5 eV [20] pour la direction [111], qui est inférieur à la valeur expérimentale de ~ 15 eV [36]. Pour Ge[111] et Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \), le E déterminé d les valeurs sont aussi petites que 9,5 eV, ce qui indique que les atomes de Ge se déplacent facilement le long de ces deux directions. Dans les deux cas, les défauts associés sont la lacune en germanium et le germanium interstitiel (voir Fig. 3c, d). Pour Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \), le Ge PKA ne suit pas un chemin rectiligne, mais est fortement dévié par l'un de ses plus proches voisins pour occuper un site interstitiel (Geint ). En revanche, dans le cas de Ge[111], le Ge PKA se déplace de 4,92 Å le long de la direction [111] pour former un défaut interstitiel (Geint ). Par rapport au E d de Ge[001], la valeur de Ge[110] est supérieure de 10 eV, ce qui indique que l'atome de Ge est plus difficile à déplacer le long de la direction [110]. Bien que les défauts associés pour Ge[001] et Ge[110] soient similaires, les mécanismes de génération de défauts sont quelque peu différents. Le Ge PKA reçoit de l'énergie cinétique et se déplace dans la direction [001] pour entrer en collision avec ses atomes voisins. L'atome de Ge remplacé continue de se déplacer et occupe un site interstitiel, comme le montre la figure 3a. Quant à Ge[110], le recul de Ge entre en collision avec son premier atome de Ge voisin (Ge1) le long de la direction [110] et rebondit le long de la direction [111], entraînant la formation de Geint . L'atome Ge1 quitte son site réticulaire et remplace son voisin Ge (Ge2). Par la suite, l'atome Ge2 retourne au site du réseau de Ge1 et finalement un seul VGe et un Geint des défauts se forment, comme le montre la figure 3b. Ces résultats suggèrent que dans le Si et le Ge en vrac, le Ed s dépendent fortement de la direction cristallographique, et les atomes sont plus difficiles à déplacer le long de la direction [110]. Les états finaux des dommages par rayonnement dans le Si et le Ge en vrac sont principalement des défauts FP, c'est-à-dire des lacunes et des défauts interstitiels.
Les événements de déplacement dans le super-réseau Si/Ge
Dans cette étude, les événements de déplacement de Si2 /Ge2 SL, qui contient deux couches de Si alternant avec deux couches de Ge (voir Fig. 1b), sont considérées. Les atomes Si et Ge adjacents à l'interface Si/Ge sont choisis comme PKA. L'Ed s pour les reculs Si et Ge et les défauts associés sont répertoriés dans le tableau 2. Les configurations de défauts pour les reculs Si et Ge sont illustrées dans les Fig. 4 et 5, respectivement. Il est à noter que dans le cas de Si[111], aucun défaut n'est créé même à des énergies allant jusqu'à 100 eV. En raison des restrictions de calcul, nous n'avons pas effectué d'autres simulations d'événements de recul à des énergies supérieures à 100 eV, et le E exact d la valeur pour Si[111] n'est pas déterminée.

un –d Vue schématique des structures géométriques du super-réseau Si/Ge endommagé après des événements de recul de Si. Les sphères bleue et verte représentent respectivement les atomes Si et Ge. V X :X poste vacant (X = Si ou Ge); X int :X interstitiel (X = Si ou Ge); X Oui :X occupant le Y site en treillis (X et Oui = Si ou Ge). Les sphères violettes et rouges représentent respectivement les lacunes et les défauts interstitiels
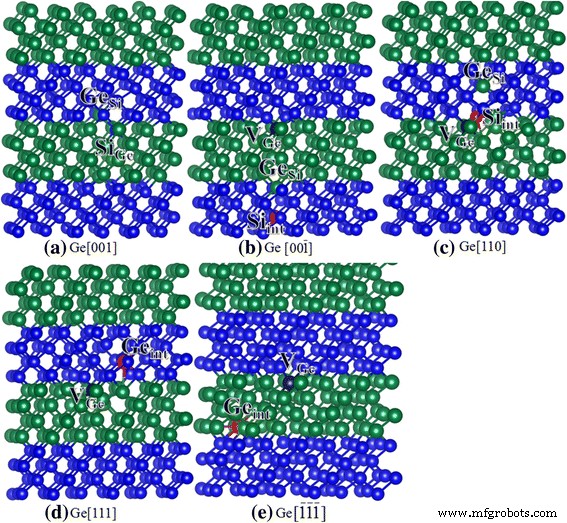
un –e Vue schématique des structures géométriques d'endommagement du super-réseau Si/Ge après des événements de recul de Ge. Les sphères bleue et verte représentent respectivement les atomes Si et Ge. V X :X poste vacant (X = Si ou Ge); X int :X interstitiel (X = Si ou Ge); X Oui :X occupant le Y site en treillis (X et Oui = Si ou Ge). Les sphères violettes et rouges représentent respectivement les lacunes et les défauts interstitiels
Dans la structure Si/Ge SL, le Si PKA se déplace facilement le long de la direction \( \left[\overline{1}\overline{1}\overline{1}\right] \), comme indiqué par le petit E d valeur de 10 eV. La voie de génération des défauts est très simple, c'est-à-dire que le Si PKA s'éloigne de 4,61 Å de son site de réseau et forme un Siint défaut. Pour Si[001] et Si\( \left[00\overline{1}\right] \), le Ed s sont déterminés à 46,5 et 42,5 eV, respectivement, et les défauts endommagés sont différents comme prévu. Dans le cas de Si[001], le Si PKA se déplace dans la direction [001] pour remplacer son atome de Ge voisin (SiGe ), et l'atome de Ge remplacé entre en collision avec son atome de Si adjacent et occupe son site de réseau, formant un GeSi défaut antisite. L'atome Si remplacé reçoit suffisamment d'énergie et remplace en outre un autre atome Ge (SiGe ), qui occupe finalement un site interstitiel. Finalement, les défauts associés sont un VSi , un Geint , et trois défauts antisites. Quant à Si\( \left[00\overline{1}\right] \), deux atomes Ge voisins et un atome Si voisin sont également impliqués dans l'événement de déplacement, et les états endommagés contiennent deux lacunes, deux interstitiels et deux défauts antisites, comme le montre la figure 4b. Dans le cas de Si [110], l'atome de Si se déplace pour frapper son atome de Si voisin et se disperse vers la direction \( \left[11\overline{1}\right] \). Ensuite, le Si PKA remplace un atome de Ge voisin, qui occupe finalement un site interstitiel. Après les événements de déplacement, les défauts associés contiennent un VSi , un SiGe, et un Geint défauts. Par rapport au Si massif, les atomes de Si dans Si/Ge SL sont généralement plus difficiles à déplacer sauf dans le cas de [110] et les mécanismes de génération de défauts sont plus complexes, indiquant que le Si massif et Si/Ge SL présentent différentes réponses de rayonnement à l'irradiation. Nos résultats sont cohérents avec les expériences menées par Fonseca et al. et Leitão et al. [13, 14], qui ont également constaté que la résistance aux radiations de la structure SL était améliorée par rapport au silicium massif.
Pour les reculs de Ge dans Si/Ge SL, les atomes de Ge se déplacent facilement le long des directions [111] et \( \left[\overline{1}\overline{1}\overline{1}\right] \), qui sont similaires aux événements de recul Ge en vrac Ge. Bien que les états finaux des dommages causés par les radiations pour Ge[111] et Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \) soient très similaires, c'est-à-dire les défauts Ge FP, les mécanismes de génération de défauts sont différents. Dans le cas de Ge[111], le Ge PKA s'éloigne de 4,77 Å de son site de réseau et forme un Geint défaut. Pour le Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \), l'atome de Ge se déplace le long du \( \left[\overline{1}\overline{1} \overline{1}\right] \) direction pour remplacer son atome Ge voisin. L'atome de Ge en collision se déplace dans cette direction et occupe finalement un site interstitiel. Il est à noter que le Ed les valeurs de 16 eV pour Ge[001] et 17,5 eV pour Ge\( \left[00\overline{1}\right] \) sont comparables à la valeur de 18 eV pour Ge[001] dans le Ge massif, tandis que les valeurs associées les défauts présentent un caractère différent. Dans le cas de Ge[001], le Ge PKA reçoit suffisamment d'énergie mais se disperse le long de la direction [111] pour remplacer son atome de Si voisin, formant un GeSi défaut antisite. Ensuite, l'atome Si remplacé occupe le site du réseau Ge PKA et forme un défaut antisite (SiGe ). Dans le cas de Ge\( \left[00\overline{1}\right] \), le Ge PKA s'éloigne de 5,63 Å pour remplacer son atome de Si voisin. L'atome de Si se déplace dans cette direction et forme un Siint défaut. Par rapport au Ge[110] en vrac Ge, le Ed pour Ge[110] dans Si/Ge SL est de 8,5 eV plus petit, et les défauts associés sont plus complexes, comme indiqué par un VGe , un GeSi , et un Siint défauts. En comparant les événements de recul de Ge dans Ge et SL en vrac, nous trouvons que les atomes de Ge dans Si/Ge SL sont plus résistants le long de la direction [110]. Pour les autres événements de déplacement, le Ed s sont généralement comparables à ceux des états de masse. Cependant, les états finaux des dommages par rayonnement dans le Ge massif et le Si/Ge SL sont différents, et certains défauts antisites sont créés dans la structure Si/Ge SL. Ces résultats suggèrent que les reculs de Ge dans la structure Si/Ge SL présentent différentes réponses de rayonnement à l'irradiation. En comparant les reculs de Si et Ge dans la structure SL, nous constatons que les événements de déplacement des atomes de Si sont beaucoup plus affectés que Ge, c'est-à-dire le Ed s pour les atomes de Si dans la structure SL sont généralement augmentés, ce qui peut conduire à une résistance au rayonnement améliorée de Si/Ge SL. Sobolev et al. ont découvert que les SL Si/Ge présentent une dureté de rayonnement extraordinairement élevée par rapport au Si massif [12], ce qui est cohérent avec nos résultats.
L'énergie de formation de défauts et la barrière de migration dans les superréseaux Si, Ge et Si/Ge en vrac
Dans le Si et le Ge massifs, les états endommagés sont principalement des lacunes et des défauts interstitiels. Comme pour Si/Ge SL, les défauts associés contiennent des défauts de lacune, interstitiels et antisites et les mécanismes de génération de défauts sont généralement plus complexes. L'écart dans la résistance à la formation de défauts entre les matériaux des composants en vrac et Si/Ge SL peut entraîner des tolérances de rayonnement différentes. Pour étudier plus avant l'origine des différentes réponses aux rayonnements de ces matériaux semi-conducteurs, nous calculons les énergies de formation des lacunes, des défauts interstitiels et antisites dans les états en vrac et les structures SL et la barrière de migration des défauts les plus favorables en utilisant la méthode de la théorie fonctionnelle de la densité. Les calculs sont basés sur une supercellule composée de 64 atomes, avec un échantillonnage de 6 × 6 × 6 points k dans l'espace réel et une énergie de coupure de 500 eV.
Les énergies de formation de défauts dans le Si, le Ge et le Si/Ge SL en vrac sont répertoriées dans le tableau 3, ainsi que d'autres résultats calculés. Dans le Si massif, les énergies de formation pour VSi , Siint , et les défauts Si FP sont calculés à 3,60, 3,77 et 4,62 eV, respectivement, ce qui est en accord raisonnable avec d'autres calculs [37,38,39,40]. Nos résultats indiquent que le VSi le défaut est plus facile à créer dans le Si en vrac. De même, le VGe le défaut en vrac Ge est énergétiquement plus favorable que le Geint et les défauts Ge FP, comme indiqué par la plus petite énergie de formation de défaut de 2,23 eV, ce qui se compare bien à la valeur théorique de 2,09 eV [39]. Quant au Si/Ge SL, l'énergie de formation de VGe est déterminé à 2,73 eV, ce qui est inférieur aux énergies de formation des autres défauts. Le prochain défaut favorable est le VSi défaut, et l'énergie de formation est déterminée à 2,85 eV. Il est à noter que la valeur de 3,52 eV pour Geint est inférieur à la valeur de 3,77 eV pour Siint défaut. En ce qui concerne le défaut FP, l'énergie de formation est évidemment plus grande, c'est-à-dire 5,19 eV pour le Si FP et 5,01 eV pour le Ge FP, ce qui suggère que les défauts FP sont difficiles à créer. Par rapport aux états en vrac, les énergies de formation de défauts pour la structure Si/Ge SL sont généralement plus grandes, sauf pour les défauts de VSi et Siint , indiquant que dans la structure SL, les défauts ponctuels sont généralement plus difficiles à former. Un tel écart dans la résistance à la formation de défauts entre les états en vrac et la structure Si/Ge SL peut entraîner des réponses différentes à l'irradiation.
Sur la base des structures optimisées, les comportements de migration du VGe et VSi les défauts qui sont les défauts les plus favorables dans les structures en vrac et Si/Ge SL sont davantage étudiés. Le VGe et VSi les défauts adjacents à l'interface Si/Ge sont pris en compte, et les barrières de migration sont résumées dans le tableau 4. Il est à noter que les barrières de migration le long des directions [100] et [110] pour VGe les défauts sont plus petits que ceux de VSi défauts, et la barrière énergétique pour VGe la migration le long de la direction [111] est légèrement plus importante que celle de VSi migration, qui sont cohérents avec les résultats rapportés par Cowern et al. [41].
Les paysages énergétiques de la migration des défauts le long des directions [100], [110] et [111] sont tracés sur la figure 6. Sur la figure 6a, les barrières de migration du VSi le défaut le long de la direction [100] sont déterminés à 4,32 et 3,92 eV dans le Si massif et Si/Ge SL, respectivement. Quant à la direction [110], la barrière migratoire de 2,14 eV pour VSi dans la structure Si/Ge SL est très proche de la valeur de 2,12 eV dans le Si massif. En comparant la barrière de migration le long de chaque direction, nous trouvons que la direction [111] est la direction de migration la plus favorable pour les lacunes de Si et de Ge, comme indiqué par les barrières de migration significativement plus petites. Surtout, le VSi les défauts migrent plus facilement le long de la direction [111] dans le Si massif que Si/Ge SL, car la barrière énergétique de 0,11 eV dans l'état massif est beaucoup plus petite (voir Fig. 6e). Quant au VGe défauts, les barrières de migration le long de la direction [100] sont calculées comme étant de 3,67 eV dans le Ge massif et de 2,87 eV dans Si/Ge SL. Dans le cas de la direction [110], les barrières énergétiques sont déterminées à 1,94 et 1,39 eV dans les structures en vrac et SL, respectivement. Similaire au cas de la migration des postes vacants Si, le VGe les défauts sont plus faciles à migrer le long de la direction [111]. De plus, la migration se produit plus facilement dans le Ge massif que dans le Si/Ge SL, comme le montre la figure 6f. Nos calculs suggèrent que les lacunes de Si et de Ge sont plus mobiles dans les états massifs que la structure SL, ce qui peut entraîner la formation de vides et même un gonflement du volume. Cela peut contribuer à des réponses différentes à l'irradiation pour les structures en vrac et SL.
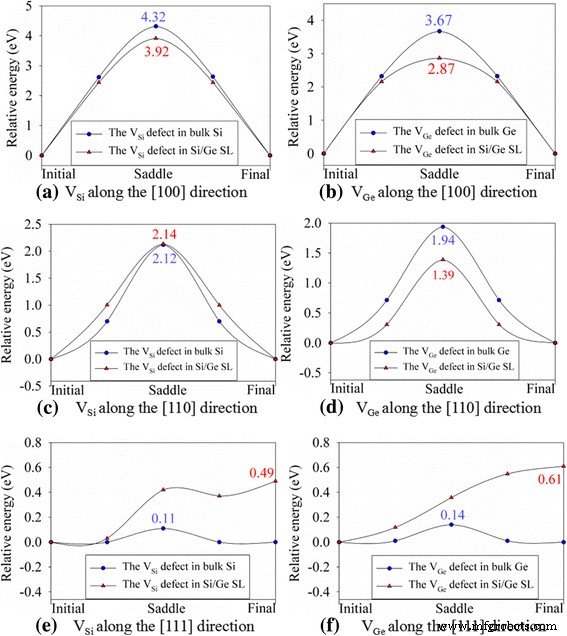
La barrière de migration de la lacune de silicium (VSi ) et la vacance de germanium (VGe ) défauts obtenus par une méthode de bande élastique nudged cluster. un VSi le long de la direction [100] ; b VGe le long de la direction [100] ; c VSi le long de la direction [110] ; d VGe le long de la direction [110] ; e VSi le long de la direction [111] ; f VGe le long de la direction [111]
Conclusions
En résumé, les événements de déplacement de faible énergie dans les superréseaux Si, Ge et Si/Ge (SL) massifs ont été étudiés par une méthode de dynamique moléculaire ab initio. Dans le Si et le Ge massifs, les énergies de déplacement de seuil dépendent de la direction cristallographique et les atomes sont plus difficiles à déplacer le long de la direction [110]. Les états endommagés dans les états en vrac sont principalement des lacunes et des défauts interstitiels. Dans la structure Si/Ge SL, les atomes de Si sont plus résistants selon la direction [111], tandis que les atomes de Ge sont plus difficiles à déplacer selon la direction [110]. Nos calculs montrent que les énergies de recul du Ge dans la structure SL sont généralement comparables à celles du Ge massif, tandis que les énergies des reculs du Si dans la structure SL sont généralement beaucoup plus importantes que celles du Si massif, ce qui indique une résistance accrue aux radiations. du Si/Ge SL. Les calculs d'énergie de formation de défauts montrent que les défauts ponctuels dans le Si/Ge SL ont généralement des énergies de formation plus élevées, indiquant que dans la structure SL, les défauts ponctuels sont généralement plus difficiles à former. On trouve également que la direction [111] est le chemin de migration le plus favorable pour les lacunes Si et Ge, et les deux lacunes sont plus mobiles dans les états en vrac que dans la structure SL. Nos calculs suggèrent que la résistance aux radiations améliorée du Si/Ge SL est bénéfique pour son application en tant que dispositifs électroniques et optoélectroniques dans des conditions de travail extrêmes telles que les radiations.
Abréviations
- AIMD :
-
Dynamique moléculaire ab initio
- Ed :
-
Seuil d'énergie de déplacement
- FP :
-
Paire de Frenkel
- Voir :
-
Germanium
- Geint :
-
Interstitiel Germanium
- GeSi :
-
Germanium occupant le site du réseau de silicium
- LDA :
-
Approximation de la densité locale
- MD:
-
Molecular dynamics
- NVE:
-
Microcanonical ensemble
- PKA:
-
Primary knock-on atom
- PL :
-
Photoluminescence
- QD :
-
Quantum dot
- QW:
-
Quantum well
- Si:
-
Silicon
- SIESTA:
-
Spanish Initiative for Electronic Simulations with Thousands of Atoms
- SiGe :
-
Silicon occupying the germanium lattice site
- Siint :
-
Silicon interstitial
- SL:
-
Superlattice
- SZP:
-
Single-ζ basis sets plus polarization orbital
- VGe :
-
Germanium vacancy
- VSi :
-
Silicon vacancy
Nanomatériaux
- Évaluer l'IoT et l'impact de la 5G
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- Modélisation et simulation de dynamique moléculaire de la coupe de diamant de cérium
- Étude des premiers principes sur la stabilité et l'image STM du borophène
- Étude des propriétés structurelles, électroniques et magnétiques des amas Ag n V (n = 1–12)
- Effet du recuit sur les microstructures et le durcissement des alliages de vanadium implantés séquentiellement à l'hélium-hydrogène
- Le monde de la simulation en évolution rapide
- La différence entre les moteurs à courant continu et à courant alternatif
- La puissance de la modélisation et de la simulation 3D stimule les innovations en matière de processus de fabrication



