Analyse de la réflectance infrarouge de couches de GaN dopées épitaxiales de type n cultivées sur du saphir
Résumé
La spectroscopie de réflectance infrarouge (IR) est appliquée pour étudier les multicouches dopées Si n + /n0 /n + -Structure GaN développée sur tampon GaN avec GaN-template/substrat saphir. L'analyse de la structure étudiée par les méthodes de photogravure, SEM et SIMS a montré l'existence de la couche supplémentaire avec la différence drastique des niveaux de dopage Si et O et située entre le tampon et le gabarit épitaxiés de GaN. La simulation des spectres de réflectivité expérimentaux a été réalisée dans une large gamme de fréquences. Il est montré que la modélisation du spectre de réflectance IR par la méthode de la matrice de transfert 2 × 2 et incluant dans l'analyse la couche additionnelle permet d'obtenir le meilleur ajustement du spectre expérimental, ce qui suit dans l'évaluation des épaisseurs de couches de GaN qui sont en bon accord avec les données SEM et SIMS. La dépendance spectrale des modes couplés plasmon-LO-phonon pour chaque couche de GaN est obtenue à partir de la dépendance spectrale du diélectrique de l'impureté dopante Si, qui est attribuée aux effets de compensation par les états accepteurs.
Contexte
Ces dernières années, il y a eu un grand intérêt pour les matériaux nitrure III, en particulier pour GaN [1, 2]. En raison de la percée dans les techniques de croissance, les films de GaN épitaxiés ont trouvé une large application dans les dispositifs optoélectroniques tels que les diodes électroluminescentes bleues et ultraviolettes (DEL) [3], les lasers [4] et les dispositifs microélectroniques, par ex. ex., transistors à effet de champ haute puissance et haute fréquence [5, 6]. La concentration et la mobilité des porteurs libres sont les paramètres clés qui déterminent les performances du dispositif dans les applications. La mesure Hall de la concentration et de la mobilité des porteurs libres dans les structures de dispositifs multicouches à base de GaN n'est pas une tâche technologique triviale et chronophage qui nécessite des contacts ohmiques attachés à chaque couche de mesure et des procédures de mesure dédiées.
La spectroscopie de réflectance infrarouge (IR) à transformée de Fourier et la spectroscopie Raman sont des méthodes sans contact et non destructives qui permettent d'étudier non seulement les vibrations des phonons mais aussi de caractériser les propriétés des porteurs [7]. Cependant, le problème connu de la spectroscopie micro-Raman confocale est une détérioration de la résolution spatiale en profondeur due à la réfraction de la lumière [8]. Il a été montré dans la réf. [6] qu'au balayage en profondeur d'une structure GaN multicouche avec une longueur d'onde d'excitation de 488,0 nm, la résolution en profondeur n'est que d'environ 1,8 µm tandis que la résolution latérale est d'environ 210 nm. La spectroscopie IR surmonte ce problème en raison de la sensibilité élevée à l'épaisseur de la couche due aux effets d'interférence et à l'impact de la dispersion de l'indice de réfraction dans une large gamme spectrale.
Les spectres de réflectance IR des films minces de GaN ont été étudiés dès 1973 par A.S. Baker [9], mais l'inhomogénéité spatiale et la faible qualité structurelle globale de tels films ont considérablement limité l'application pratique des résultats obtenus. Néanmoins, une possibilité de déterminer les paramètres des phonons optiques et de l'absorption des porteurs libres dans les films minces de GaN a été démontrée. Les études détaillées du phonon optique longitudinal– Les modes couplés au plasmon (LOPC) dans le GaN massif ont été réalisés par Perlin et al. [10] par spectroscopie Raman et par Shubert et al. [11] par ellipsométrie IR. L'effet de différents substrats sur les propriétés optiques des films GaN cubiques et wurtzites a également été étudié en détail [12, 13]. Compte tenu du manque de substrats de GaN natifs, il a été montré que l'utilisation de substrats en saphir pour la croissance épitaxiale du film de GaN est optimale pour l'exploitation dans des dispositifs fonctionnant à haute température. Les études de spectroscopie de réflexion IR du saphir hexagonal [14] ont montré un spectre complexe, dont la forme dépend fortement de la polarisation et de l'angle d'incidence. Cela complique considérablement les mesures et la détermination des caractéristiques spectrales des modes de phonons et des propriétés des porteurs libres dans un film mince de GaN développé sur des substrats de saphir.
Ainsi, une sélection appropriée de l'algorithme d'analyse spectrale et la forme de la fonction diélectrique sont d'une grande importance pour l'analyse des spectres de réflectance IR des structures multicouches GaN sur saphir [15,16,17]. Cet article montre une possibilité d'application de la spectroscopie de réflectance IR et de la méthode de matrice de transfert 2 × 2 pour l'analyse de structures multicouches planes à base de GaN avec une profondeur et des profils de dopage non uniformes, qui en pratique peuvent être différents types de semi-conducteur III-nitrure- structures de dispositifs à base de conception verticale, telles que les diodes électroluminescentes et redresseuses, les diodes Gunn, les transistors à haute mobilité électronique (HEMT), etc.
Méthodes
Expérimental
Le n + enquêté /n0 /n + -Les structures GaN ont été développées sur des modèles MOCVD GaN sur Al2 O3 (0001) substrats à une température de 800 °C par épitaxie par jets moléculaires assistée par plasma à l'aide d'un N2 débit de 0,5 sccm et une puissance plasma RF de 350 W (Fig. 1). Cela se traduit par un taux de croissance de 0,27 ML s −1 . Tout d'abord, un tampon GaN de 0,3 µm d'épaisseur a été cultivé sur une matrice MOCVD GaN. Une couche de GaN dopé Si d'une épaisseur de 0,8 µm a été suivie d'une couche de GaN non dopé Si d'une épaisseur de 1,75 µm et d'une couche de GaN dopé Si d'une épaisseur de 0,4 µm (Fig. 1). La concentration nominale de dopage Si du n + -Les couches GaN étaient ∼ 10 19 cm −3 .
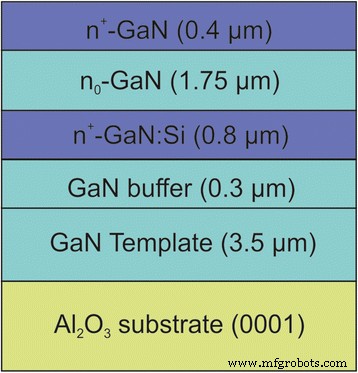
Schéma du n + enquêté /n0 /n + -Structure GaN développée sur GaN-template/(0001) substrat de saphir
Afin d'examiner les zones de différentes concentrations de porteurs, le bord clivé de la structure étudiée a été examiné par la méthode de photogravure dans une configuration autocatalytique en utilisant K2 S2 O8 –Solution aqueuse de KOH (système de gravure KSO-D) [18]. Cette méthode permet de révéler les zones de différentes concentrations de porteurs et de visualiser les différences relatives de concentration de porteurs en mesurant la vitesse de gravure à l'aide du profilage de surface [19, 20]. Une coupe transversale de l'échantillon étudié a été photogravée pendant 3 min. Ensuite, les échantillons ont été examinés par microscopie électronique à balayage (MEB).
Des études de spectroscopie de masse d'ions secondaires (SIMS) d'échantillons ont été réalisées sur un système CAMECA IMS6F en utilisant un césium (Cs + ) faisceau primaire, avec le courant maintenu à 400 nA afin de trouver le profil de la concentration en impuretés. La taille du raster était d'environ 50 × 50 μm 2 , et les ions secondaires ont été collectés à partir d'une région centrale de 30 µm de diamètre. Pour H, C, O et Si, les concentrations ont été dérivées des espèces H–, O–, C–, Si–, respectivement, et le signal matriciel Ga– a été pris comme référence.
Les mesures de spectroscopie de réflectance infrarouge dans la gamme spectrale de 300 à 4000 cm −1 avec une résolution spectrale de 1 cm −1 ont été effectuées à température ambiante à l'aide d'un spectromètre FTIR Bruker Vertex 70 V équipé d'une source Globar et d'un détecteur de sulfate de triglycine deutéré (DLaTGS) avec fenêtre en polyéthylène. L'angle d'incidence était de 11°. S -les spectres polarisés ont été mesurés en utilisant un polariseur KRS-5. Le spectre de réflectance d'un miroir en or a été utilisé comme référence.
Description du modèle d'analyse optique
La réflectance du système couches/substrat a été calculée en utilisant la méthode de la matrice de transfert 2 × 2 [17, 21] dans laquelle un nombre arbitraire de couches peut être inclus et les effets d'interférence au sein des films sont automatiquement pris en compte. La méthode de la matrice de transfert 2 × 2 pour les systèmes en couches isotropes permet un calcul indépendant de s - et p -spectres de réflexion et de transmission polarisés dans le cas de systèmes stratifiés constitués de dalles isotropes homogènes biaxiales ou uniaxiales dont l'axe c est aligné sur l'axe z des coordonnées du laboratoire. Dans ce cas, la matrice de transfert de système en couches 2 × 2 peut être représentée dans la vue suivante [21] :
$$ {\left(\begin{array}{c}\hfill {E}_0^{+}\hfill \\ {}\hfill {E}_0^{-}\hfill \end{array}\right) }_{s/p}=\frac{1}{t_{0,1}^{s/p}}\left(\begin{array}{cc}\hfill 1\hfill &\hfill -{r} _{1,0}^{s/p}\hfill \\ {}\hfill {r}_{1,0}^{s/p}\hfill &\hfill 1\hfill \end{array}\right ){\displaystyle \prod_{l=1}^N{T}_{l/\left(l+1\right)}^{s/p}{\left(\begin{array}{c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array }\right)}_{s/p}}={\left(\begin{array}{cc}\hfill {T}_{11}\hfill &\hfill {T}_{12}\hfill \\ {}\hfill {T}_{21}\hfill &\hfill {T}_{22}\hfill \end{array}\right)}_{s/p}{\left(\begin{array}{ c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array}\right)}_{s/p}. $$ (1)Les astérisques dans les index supérieurs d'amplitude de champ dans le milieu de sortie sont utilisés dans l'équation. (1) pour tenir compte des valeurs des composantes du champ électrique juste à droite du N /N + 1 interface.
La matrice de transfert \( 2\times 2\kern0.24em {T}_{l,\left(l+1\right)}^{s/p} \) rend compte de la propagation des ondes planes depuis le l -ème couche, réflexions multiples au sein de cette couche et influence de l/(l + 1) interface. Une telle matrice peut être déterminée comme [17] :
$$ {T}_{l/\left(l+1\right)}^{s/p}=\frac{1}{t_{l/\left(l+1\right)}^{s/ p}}\left(\begin{array}{cc}\hfill \exp \left(i{\delta}_l^{s/p}\right)\hfill &\hfill -{r}_{l+1 ,l}^{s/p} \exp \left(i{\delta}_l^{s/p}\right)\hfill \\ {}\hfill {r}_{l,l+1}^{ s/p} \exp \left(-i{\delta}_l^{s/p}\right)\hfill &\hfill \exp \left(-i{\delta}_l^{s/p}\right )\hfill \end{array}\right), $$ (2)où \( {r}_{l,l+1}^{s/p} \) et \( {t}_{l,l+1}^{s/p} \) désignent des coefficients de réflexion partielle et de transmission pour l/(l + 1) interface, \( {\delta}_l^{s/p} \) est le déphasage, imposé à la lumière après propagation par le l- ème couche pour s - et p -lumière polarisée.
Déphasage pour les s - et p -lumière polarisée après avoir traversé le l- la couche peut être déterminée comme [17] :
$$ {\delta}_l^{s/p}=\frac{2\pi {d}_l}{\lambda }{n}_{l,s/p} \cos {\theta}_{l, s/p}=\frac{2\pi {d}_l}{\lambda }{n}_l\sqrt{1-{\left(\frac{1}{n_{l,s/p}} \sin \theta \right)}^2}, $$ (3)où n l est le indice de réfraction complexe pour le l- ème couche, d l est l'épaisseur du l- e couche, et θ est l'angle d'incidence.
Coefficients de réflexion partielle et de transmission pour les s - et p -les polarisations peuvent être calculées à l'aide des équations de Fresnel. Par exemple, les coefficients de réflexion partielle et de transmission pour les s -polarisation ont la forme suivante [21] :
$$ \begin{array}{l}{r}_{l,l+1}^s=\frac{n_{ls} \cos {\theta}_{ls}-{n}_{\left( l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}{n_{ls} \cos {\theta}_{ls}-{n}_{\ left(l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}\\ {}{t}_{l,l+1}^s=\frac {2{n}_{ls} \cos {\theta}_{ls}}{n_{ls} \cos {\theta}_{ls}+{n}_{\left(l+1\right) s} \cos {\theta}_{\left(l+1\right)s}}\end{array} $$ (4)Les rapports de réflectance complexes de l'empilement multicouche peuvent ainsi être obtenus en substituant les coefficients de réflexion partielle et de transmission aux N + 1 (Eqs. (4)) dans l'Eq. (1) et déphasages de tous les N couches (Eq. (3)) :
$$ {R}_{s/p}={\gauche|{r}_{0,N+1}^{s/p}\right|}^2={\gauche|\frac{T_{21 }}{T_{11}}\right|}^2. $$Modèle de fonction diélectrique IR
L'indice de réfraction dépend de la fonction diélectrique complexe ε (ω ), qui peut s'écrire :
$$ \varepsilon \left(\omega \right)={\varepsilon}^{\mathrm{lat}}\left(\omega \right)+{\varepsilon}^{\mathrm{fc}}\left(\ oméga \droit). $$ (5)Le premier terme correspond à la contribution de la dispersion modale du réseau, et le second aux excitations des porteurs libres.
La contribution des modes de réseau à la réponse IR ε lat (ω ) à l'énergie du phonon ℏω peut être décrit à l'aide d'un modèle factorisé avec élargissement lorentzien [22] :
$$ {\varepsilon}^{\mathrm{lat}}\left(\omega \right)={\varepsilon}_{\infty }{\displaystyle \prod_{k=1}^M\frac{\omega_{ \mathrm{LO}k}^2-{\omega}^2-i\omega {\gamma}_{\mathrm{LO}k}}{\omega_{\mathrm{TO}k}^2-{\ oméga}^2-i\omega {\gamma}_{\mathrm{TO}k}}}, $$ (6)où M est le nombre de modes de phonons polaires actifs dans l'infrarouge pour les s - ou p -polarisations au c- axe; ωLOk et ωTOk sont la fréquence (cm −1 ) du k- les phonons LO et TO ; γLOk et γTOk sont leurs constantes d'amortissement (cm −1 ). Pour GaN les paramètres ωLOk et ωTOk compte pour le E 1 (LO), A 1 (LO) et E 1 (À), et A 1 (TO) modes de vibration [23].
La contribution de l'espèce libre ε fc (ω ) à la fonction diélectrique peut être décrite en utilisant l'approximation classique de Drude [15] :
$$ {\varepsilon}^{\mathrm{fc}}\left(\omega \right)=-{\varepsilon}_{\infty}\frac{\omega_p^2}{\omega \left(\omega + i{\gamma}_p\right)}, $$ (7)avec
$$ {\omega}_p={\left(\frac{N{e}^2}{\varepsilon_{\infty }{\varepsilon}_0{m}^{\ast }}\right)}^{1 /2} $$ (8) $$ {\gamma}_p=\frac{e}{m^{\ast}\mu } $$ (9)Les fréquences plasma blindées ω p (Eq. (8)) dépendent de la concentration en porteurs libres N , permittivité diélectrique haute fréquence ε ∞ , et la masse effective m ∗ des transporteurs gratuits (ε 0 est la permittivité du vide et e est l'unité de charge électrique). Le paramètre d'amortissement du plasmon γ p dépend de la mobilité du porteur optique μ (Éq. (9)) [24].
Paramètres de ωLO et les modes LOPC peuvent être déterminés à partir de la partie imaginaire de la fonction de perte d'énergie—\( \mathrm{I}\mathrm{m}\left(-\frac{1}{\varepsilon \left(\omega \right)}\ à droite) \) [7], où ε (ω ) est la fonction diélectrique complexe, obtenue à partir de l'équation. (5).
Résultats et discussion
L'image SEM (Fig. 2) montre la coupe transversale photogravée de n + /n0 /n + -Structure GaN développée sur un tampon GaN/gaN-modèle/substrat en saphir, où six couches distinctes sont clairement visibles, qui sont cinq couches de GaN avec une concentration de porteurs et un substrat en saphir différents. Il convient de noter que l'épaisseur globale de la structure de GaN étudiée telle que mesurée par SEM est en accord avec celle technologique, et les couches de GaN observées selon la Fig. 1 peuvent être attribuées provisoirement au sommet nominal dopé Si n + région (couche 1), non dopée n0 région (couche 2), fond n + dopé Si région (couche 3), tampon GaN non dopé (couche 4) et modèle GaN.
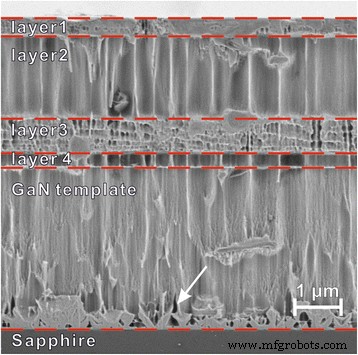
Image SEM d'une coupe transversale du n + étudié /n0 /n + -Structure GaN. Le motif irrégulier de lignes verticales s'est formé pendant le clivage (c'est-à-dire avant la photogravure) et est caractéristique des clivages non polis de Al2 O3 /Hétérostructures GaN. Couche pyramidale rugueuse (trous d'épingle ) au gabarit saphir/GaN indiqué par la flèche a été révélé par photogravure
De plus, afin d'avoir un aperçu plus approfondi du niveau d'impureté/dopage des échantillons étudiés, des mesures SIMS ont été effectuées. Les profils SIMS obtenus (Fig. 3) sont en bonne corrélation avec l'épaisseur nominale des couches de GaN et l'épaisseur globale de la structure multicouche étudiée. Tous les éléments examinés (H, C, O, Si) étaient au-dessus de la limite de détection (3 à 5 × 10 16 à/cm 3 ) de la technique SIMS.
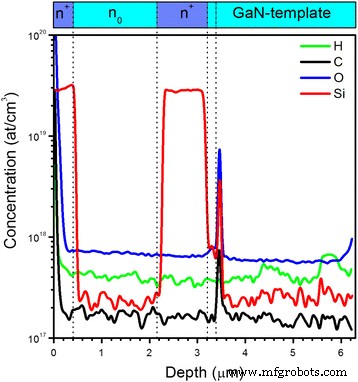
Profils d'éléments d'impuretés des n + étudiés /n0 /n + -Structure GaN mesurée par SIMS à partir de la surface de l'échantillon
Le profil de dopage intentionnel au Si, en général, correspond au profil de dopage nominal avec une concentration d'environ 2,8 × 10 19 cm −3 dans le haut et le bas dopés n + régions et d'environ 2,3 × 10 17 cm −3 dans le n0 non dopé Région. Cependant, comme le montrent les données SIMS, il existe également une couche mince (<50 nm)-delta avec une concentration en Si de 1,1 × 10 19 cm −3 entre le tampon GaN et le gabarit GaN. Il convient de noter que la couche delta dopée Si contient également des concentrations plus élevées d'impuretés non intentionnelles d'oxygène et de carbone de 2,4 × 10 19 cm −3 et 1,4 × 10 18 cm −3 , en conséquence. Cette couche delta est liée à l'interface de repousse homéoépitaxiale, qui résulte généralement de la contamination du modèle GaN par des impuretés O, Si et C, absorbées par l'atmosphère lors du processus technologique de chargement ou au début de la repousse [25, 26].
Comme discuté ci-dessus, la section efficace SEM et l'analyse SIMS donnent la structure des couches de GaN, qui diffère des paramètres nominaux par l'excitation de la région GaN supplémentaire, mais avec l'épaisseur globale en accord avec l'épaisseur nominale. Afin de clarifier l'influence de la couche delta supplémentaire de GaN trouvée ci-dessus sur le spectre de réflectance IR de la structure étudiée, la simulation du spectre expérimental a été réalisée en construisant des modèles constitués de six couches, qui correspondent à des paramètres technologiques nominaux, des images SEM ( Fig. 1), et sept couches selon SIMS. Les spectres calculés sur la base des modèles décrits ci-dessus sont donnés sur la figure 4.

Simulations des spectres de réflectance IR avec différents nombres de couches. Le spectre expérimental des n + étudiés /n0 /n + -La structure GaN est représentée par un ligne continue . un Région de Reststrahlen. b Les spectres élargis dans la plage au-dessus de 750 cm −1
Comme on peut le voir sur la figure 4, le modèle à sept couches du profil SIMS donne la meilleure approximation du spectre de réflectance IR expérimental. Ainsi, d'autres simulations et analyses sont effectuées à l'aide de ce modèle ayant des paramètres modifiés, par rapport aux paramètres technologiques nominaux (Fig. 1), et qui tient compte de la couche supplémentaire entre la couche tampon GaN technologique et le gabarit GaN (Fig. 5).
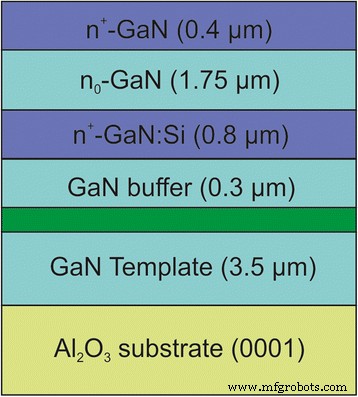
Le modèle à 7 couches utilisé pour simuler les spectres de réflectance IR des n + étudiés /n0 /n + -Structure GaN. Une couche supplémentaire (vert ) est une fine couche d'interface entre le modèle GaN et les couches GaN étudiées
La figure 6 montre des s théoriques expérimentaux et ajustés -spectres de réflectance polarisés de la structure étudiée à l'angle d'incidence de 11°. Le spectre calculé est basé sur le modèle décrit ci-dessus (Fig. 5). La dispersion de l'indice de réfraction complexe pour les couches de GaN et le substrat de saphir a été déterminée en utilisant l'équation. (5). Le substrat de saphir a été considéré comme semi-infini, ce qui a permis de négliger les réflexions internes au sein du substrat et de la face arrière non polie. La structure compliquée observée dans la région reststrahlen du spectre est due à une combinaison du chevauchement du GaN et de l'Al2 O3 bandes reststrahlen avec effets d'interférence. La comparaison de ces données avec les spectres calculés peut non seulement fournir des informations sur l'épaisseur des différentes couches des échantillons, mais peut également aider à interpréter la structure compliquée de la région reststrahlen en termes de contributions des différents matériaux.

Expérimental (ligne continue ) et le meilleur ajustement calculé (ligne tiret-point ) Spectres de réflectance IR du n + /n0 /n + -Structure GaN développée sur GaN-template/Al2 O3 . un Région de Reststrahlen. b Région d'interférence
La détermination des épaisseurs de couche à partir de la comparaison des données de réflectance au spectre calculé est un processus en deux étapes [27]. Premièrement, les franges dans la région transparente au-dessus des bandes reststrahlen (ω > 1200 cm −1 ) sont dues à des effets d'interférence sur les couches de la structure multicouche. De cette façon, l'épaisseur globale de la structure étudiée, qui est la somme de toutes les couches, peut être estimée.
Une fois que l'épaisseur de l'empilement est connue, les épaisseurs individuelles de chaque couche peuvent être déterminées en adaptant les spectres calculés aux effets d'interférence dans la région reststrahlen du spectre. Les épaisseurs de couche ont été modifiées en tenant compte de l'épaisseur globale précédemment déterminée. Sous cette contrainte, la réflectance au-dessus de 1200 cm −1 ne change pas de manière significative. Les effets d'interférence dans la région reststrahlen peuvent être distingués d'autres caractéristiques telles que les modes vibrationnels TO et LO sur la base du fait que les franges d'interférence changent de position lorsque les épaisseurs de couche varient [28].
Lors de l'approximation du spectre expérimental dans la région reststrahlen, les paramètres du modèle suivants ont été modifiés :paramètres d'amortissement γLO et γÀ pour E 1 (LO) et E 1 (TO) modes phonons ; fréquence plasma ω p ; paramètre d'amortissement plasmon γ p ; et épaisseurs de couche. Il convient de noter que seul E 1 les phonons de symétrie sont IR actifs dans s -polarisation [9]. Fréquences initiales de E 1 (LO) et E 1 Les phonons (TO) pour le GaN et le substrat de saphir ont été extraits des expériences de réflectance IR [29] et de diffusion Raman [6, 14]. Les valeurs typiques de la fréquence des phonons GaN sont ωTO = 560 cm −1 et ωLO = 740 cm −1 . Les fréquences de phonons pour chaque couche ont été affinées lors du processus d'ajustement. Les paramètres de meilleur ajustement obtenus avec les barres d'erreur sont donnés dans le tableau 1. Il convient de noter que les épaisseurs de couche obtenues lors du processus d'ajustement sont en bon accord avec les données SEM.
En se référant à la figure 6a, le pic de réflectance à ~450 cm −1 peut être attribué au substrat de saphir. Les caractéristiques observées dans la plage de 500 à 740 cm −1 sont dues à une combinaison de caractéristiques qui se chevauchent des couches de GaN et des bandes de saphir reststrahlen. Pour une analyse plus approfondie, les spectres de réflectance IR du GaN en vrac et de la couche de GaN de 6,78 μm d'épaisseur sur du saphir, avec l'épaisseur de GaN correspondant à l'épaisseur globale de la structure étudiée, ont été simulés dans la région de la bande reststrahlen (Fig. 7) . Comme on peut le voir sur la figure 7, les spectres de réflectance d'une couche de GaN de 6,78 d'épaisseur sur du saphir et du GaN en vrac dans la plage de 500 à 740 cm −1 sont similaires au spectre expérimental. La petite caractéristique à ~511 cm −1 est associé au substrat de saphir. Il convient de mentionner qu'à ~736 cm −1 , il y a un faible creux qui correspond à A 1 (LO) du modèle GaN. Selon les règles de sélection, A 1 Le mode (LO) est interdit dans les s -spectres IR polarisés [9]. La raison possible de l'enregistrement de ce mode interdit pourrait être une fuite de polarisation due à l'ouverture de l'accessoire de réflectance ainsi que des microinhomogénéités de la structure cristalline du GaN. Plus précisément, cela peut être causé par l'inclinaison du c -axe de la structure wurtzite en forme de colonne de GaN par rapport à la direction perpendiculaire au plan de croissance du film. Ce mode n'a pas été pris en compte dans notre modélisation en raison de son faible impact sur le spectre résultant. Les caractéristiques dans la plage de 750 à 1200 cm −1 sont dues au chevauchement des bandes GaN:Si et du saphir reststrahlen et aux effets d'interface. La chute à ~775 cm −1 est liée à l'effet d'interface sur le bord de la bande reststrahlen des couches de GaN et du saphir. Le large pendage à ~825 cm −1 est associée au chevauchement de la branche haute fréquence du mode couplé plasmon-LO-phonon (LPP + ) du n + calques.
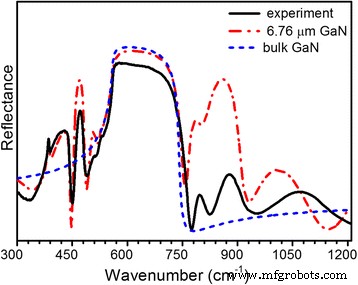
Expérimental (ligne continue ) Spectres de réflectance IR des n + étudiés /n0 /n + -Structure GaN et spectres de réflectance calculés d'une couche GaN de 6,78 μm d'épaisseur sur du saphir (ligne tiret-point ) et GaN en vrac (ligne tiret )
La figure 8 montre les parties imaginaires calculées de la fonction de perte d'énergie pour chaque couche en fonction des paramètres d'oscillateur donnés dans le tableau 1 pour l'estimation de E 1 -Modes LOPC. Comme on le voit, la branche haute fréquence des modes LOPC (LPP + ) à des concentrations de porteurs inférieures à 10 17 cm −3 (n0 calque et modèle) coïncident presque avec E 1 (LO) mode phonon. L'augmentation de la concentration de porteurs de l'ordre de 2 × 10 17 –3 × 10 18 cm −3 (Fig. 5) entraîne un décalage important des hautes fréquences et un élargissement de la LPP + branche, qui indique l'augmentation de l'interaction entre le phonon LO et le plasmon et la diminution de la mobilité des porteurs de charge. Ce comportement de LPP + branche est en bon accord avec les données expérimentales sur la réflectance IR des films de GaN dopé Si cultivés sur du saphir par Z.F. Li et al. [30], et mesure Raman dans le GaN massif [10] et les couches épitaxiales [31]. Il est à noter que le LPP basse fréquence − branche de la LOPC ne peut pas être définie de manière fiable dans notre cas, comme s -les spectres de réflectance IR polarisés n'ont pas été mesurés dans la plage de basses fréquences inférieure à 300 cm −1 .

Partie imaginaire calculée de la fonction diélectrique obtenue pour chaque couche de GaN analysée à partir de l'analyse de données la mieux adaptée
Les valeurs de concentration et de mobilité des porteurs répertoriées dans le tableau 2 ont été calculées en utilisant les équations. (8) et (9) avec une masse effective d'électrons m* de 0,2 m0 [32]. On peut voir que le profil de concentration en porteurs calculé est similaire au profil de concentration en impuretés Si obtenu par les mesures SIMS (Fig. 3), mais avec des concentrations en porteurs inférieures d'un ordre de grandeur par rapport à la concentration en impuretés Si. Un tel écart dans les concentrations de porteurs et d'impuretés dopantes a été observé précédemment par M. Bockowski et al. [33], et était liée aux effets de compensation par les états accepteurs (probablement par des lacunes de gallium), dont l'énergie de formation diminue avec l'augmentation du dopage de type n [34]. Il convient de mentionner que la concentration de porteurs pour le n + couches de l'ordre de ~10 18 cm −3 est en bon accord avec les résultats de nos études Raman de structures GaN similaires basées sur l'analyse des modes LOPC [6]. La diminution obtenue de la mobilité des porteurs μ avec la concentration des porteurs est également en bon accord avec les expériences de Hall dans GaN [35] et la modélisation théorique [36].
Les valeurs de permittivité diélectrique haute fréquence ε∞ se situaient entre 4,99 et 5,35 (tableau 1). L'augmentation de ε∞ pour le n + dopé couches par rapport à n0 Les couches peuvent être liées au décalage vers le rouge de la bande interdite α-GaN [37]. Il convient de noter que les valeurs de ε∞ peut être déterminé avec une erreur relativement faible uniquement pour les films à faible conductivité. Précision dans la détermination de ε∞ diminue avec la concentration en porteurs, ce qui est lié au fait que le ε∞ Ce paramètre rend compte de la limite « haute fréquence » lorsque la fonction du modèle diélectrique est extrapolée à des nombres d'onde plus courts que ceux étudiés ici [11]. La large gamme spectrale de 300 à 4000 cm −1 a été analysé afin de diminuer l'erreur dans la détermination de ε∞ et d'autres paramètres impliqués dans la modélisation des spectres de réflectance IR de n + calques.
Conclusions
Les spectres de réflectance IR de la structure multicouche constituée de couches de GaN cultivées sur un substrat de saphir et dopées avec différentes concentrations d'impuretés Si ont été mesurés et analysés en détail. L'analyse de la structure étudiée par SEM de section efficace photogravée a montré une bonne corrélation avec les paramètres technologiques des couches de GaN. L'analyse SIMS a également révélé la présence d'une fine couche delta près de l'interface tampon GaN/gaN-gabarit avec une teneur plus élevée en impuretés Si et O, qui est liée à l'interface de repousse homéoépitaxiale. La modélisation du spectre de réflectance IR de la structure multicouche étudiée en incluant dans l'analyse la couche supplémentaire a permis d'obtenir le meilleur ajustement du spectre expérimental. Les épaisseurs obtenues des couches de GaN sont en bon accord avec les données SEM et SIMS. Calculated from the spectral dependence of dielectric permittivity LOPC modes for each GaN layer showed high-frequency shift and broadening of LPP + branch with the increase in carrier concentration. Concentration and mobility of charge carrier for each GaN layer were calculated from the plasmon frequency and damping parameter. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Abréviations
- IR:
-
Infrared
- FTIR :
-
Spectroscopie infrarouge à transformée de Fourier
- SEM:
-
Scanning electron microscopy
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Nanomatériaux
- Structure et propriétés électroniques de la nanoargile de kaolinite dopée par un métal de transition
- Étude sur la polarisation de surface de l'hétérostructure GaN/AlGaN/GaN coiffée d'Al2O3 par spectroscopie photoélectronique à rayons X à résolution angulaire
- Nouveaux nanocomposites de polystyrène avec polyaniline dopé à l'acide lauryl sulfurique
- Dépendance de la température de la bande interdite dans le MoSe2 cultivé par épitaxie par faisceau moléculaire
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Cibler les cellules endothéliales avec des nanoparticules GaN/Fe multifonctionnelles
- Analyse de cartographie Raman des résonateurs à micro-anneaux en silicium intégrés au graphène
- Couches de dopage au silicium optimal des barrières quantiques dans la séquence de croissance formant un potentiel de confinement souple de huit périodes In0.2Ga0.8N/GaN Puits quantiques de bleu LE…
- Modification de la structure du GaN entre le réseau Nanowall, la nanocolonne et le film compact développé sur Si (111) par MBE



