Modèle de rétention de TaO/HfO x et TaO/AlO x RRAM avec caractéristiques de commutateur auto-rectifiant
Résumé
Un modèle de comportement de rétention pour TaO/HfO x auto-rectifié - et TaO/AlO x La mémoire résistive à accès aléatoire (RRAM) est proposée. La RRAM de type piégeage peut avoir un état à haute résistance (HRS) et un état à faible résistance (LRS); la dégradation dans un LRS est généralement plus sévère que celle dans un HRS, car le LRS pendant le processus SET est limité par la couche de résistance interne. Cependant, si TaO/AlO x éléments sont empilés en couches, la rétention LRS peut être améliorée. Le temps de rétention du LRS estimé par la méthode d'extrapolation est supérieur à 5 ans à température ambiante. Les deux TaO/HfO x - et TaO/AlO x Les structures RRAM basées sur la technologie ont la même couche de recouvrement de TaO et les niveaux d'énergie d'activation des deux types de structures sont de 0,38 eV. De plus, l'AlO x supplémentaire couche de commutation d'un TaO/AlO x la structure crée une barrière de diffusion O plus élevée qui peut considérablement améliorer la rétention, et le TaO/AlO x La structure montre également un LRS assez stable dans des conditions biaisées.
Contexte
Étant donné que la technologie flash NAND est confrontée à une limite d'échelle, les conceptions de mémoire à accès aléatoire résistif verticale (VRRAM) avec de faibles piles de films, des rendements de fabrication élevés et aucun problème de couplage croisé sont des candidats prometteurs pour les applications de mémoire haute densité [1,2,3 ]. L'architecture 1TnR avec une structure verticale tridimensionnelle (3D) permet d'obtenir un coût binaire ultra-faible pour des matrices denses très compactes [4,5,6]. Plusieurs chercheurs ont proposé de faire fonctionner la RRAM à de faibles niveaux de courant en changeant le mécanisme de commutation de résistance d'un modèle de type filamentaire à un modèle de chemin conducteur de type piégeage de défauts, modulation d'inoccupation ou interface [7,8,9]. Cependant, les questions centrales des échecs de rétention et de la migration des lacunes d'oxygène ne sont toujours pas résolues [3, 10]. Dans certaines études de rétention de type filamentaire, de nombreux modèles différents ont été proposés pour expliquer les pertes de rétention [11,12,13]. Le changement de mécanisme de commutation indique également une direction différente qui pourrait améliorer la rétention [11]. Nos études précédentes ont montré que TaO/HfO x les appareils peuvent afficher des valeurs de non-linéarité favorables d'environ 40, des valeurs d'endurance dépassant 1 000 cycles et une rétention des données de 85 °C [6, 7]. Néanmoins, obtenir une rétention stable à des niveaux de courant de fonctionnement aussi faibles est toujours un défi. Dans cette lettre, un modèle de rétention est proposé pour réaliser la perte de rétention dans deux dispositifs différents de type piège à défauts avec la méthode d'Arrhenius. L'énergie d'activation extraite n'explique pas de manière convaincante l'amélioration de la rétention par l'AlO x couche. Même si l'original était ambigu, l'interprétation la plus probable est qu'une liaison dense facilite la rétention.
Méthodes
Dans la fabrication de TaO/HfO x et TaO/AlO x dispositifs pour la présente étude, l'électrode inférieure (BE) est composée de métal TiN déposé par dépôt physique en phase vapeur (PVD) sur 8-in. substrats d'oxyde thermique/Si. Chaque BE a été modelée et gravée avec un procédé de lithographie et de gravure conventionnel. Après que chaque TiN BE ait été gravé avec du gaz à base de chlore, la résine photosensible restante (PR) et les résidus de gravure ont été éliminés à l'aide d'un système plasma à distance qui a appliqué O2 et H2 O à 180 °C. Au cours du processus d'élimination du PR, une fine couche d'oxydation de TiON s'est formée à la surface de chaque TiN BE. Ensuite, des couches de commutation résistives de HfO x et AlO x ont été préparés par dépôt de couche atomique (ALD) avec HfCl4 -H2 O et TMA-H2 O précurseurs, respectivement. Les deux éléments résistifs HfO x et AlO x ont été déposés à 300 et 250 °C. Au-dessus des couches de commutation résistives, la couche de TaO a ensuite été déposée par PVD par oxydation plasma à basse température (LTPO) [14]. Cette fabrication dépose du Ta métal à un taux ultra-faible (0,2 Å/s). Une oxydation plasma stable a été réalisée avec un mélange d'Ar et d'O2 des gaz. Cette couche de TaO servait de résistance d'auto-conformité interne, qui était relativement fuyante par rapport aux films de commutation résistifs antérieurs [7]. L'électrode supérieure était également en PVD-TiN. Les vues en coupe et les informations d'épaisseur du TaO/HfO x et TaO/AlO x les dispositifs de mémoire sont illustrés sur les Fig. 1a, b respectivement. L'épaisseur du film de TaO/HfO x a été vérifié par microscopie électronique à transmission (non représentée). Après que les cellules aient été modelées, l'oxyde à basse température a été déposé pour passivation à 250 °C. Enfin, un processus back-end conventionnel a été appliqué pour terminer la fabrication des structures de contact et de plots métalliques.

Diagrammes schématiques de cellules avec des informations sur l'épaisseur pour a TaO/HfO x appareils et b TaO/AlO x dispositifs. Les deux graphiques décrivent des dispositifs pour lesquels PVD a déposé les couches de TaO avec des processus LTPO, et les couches interfaciales de TiON inférieures ont été formées par oxydation au plasma lors de l'élimination de la résine photosensible
Résultats et discussion
Les mesures électriques ont été effectuées avec un analyseur de paramètres à semi-conducteurs HP4156C. La densité de courant définie et réinitialisée (J ) en fonction de la tension (J –V ) courbes de TaO/HfO x et TaO/AlO x les appareils sont représentés sur les Fig. 2a, b respectivement. Les deux états de résistance initiale (R initial ) du TaO/HfO x et TaO/AlO x appareils étaient HRS. Les dispositifs de mémoire vierges ont été programmés sur LRS avec une polarisation positive et ont été balayés en arrière. Ensuite, chaque cellule a été commutée de LRS à HRS par une tension négative appliquée. Les deux J–V les tracés contiennent trois tailles de cellule, à savoir 0,1, 0,56 et 25 μm 2 . Dans le J–V tracés, toutes les courbes des appareils avec des zones différentes se ressemblent, ce qui indique à la fois TaO/HfO x et TaO/AlO x les appareils avaient (i) la même densité de courant à l'état initial, (ii) des tensions de réglage et de réinitialisation similaires, et (iii) la même densité de courant en LRS et HRS. De plus, la propriété de densité de courant constante est clairement illustrée par la résistance en fonction de la surface (R –A ) tracés dans la Fig. 2c, d. La forte dépendance à la zone dans les deux R initial et LRS peut être observé par le contrôle de la densité de courant. Indépendamment de l'échelle de la surface de la cellule et du courant de conformité, le même rapport de résistance marche/arrêt est conservé dans les deux appareils. Cette caractéristique de commutateur à densité de courant constante implique que les cellules de mémoire sont uniformément programmées ou effacées par le champ électrique. Ces dispositifs sont considérés comme ayant des propriétés de commutation de type trapping, qui sont fortement liées à la modulation des lacunes [8]. Dans le cas de la RRAM de type piégeage, aucun saut de courant brusque n'a été observé pendant le processus de prise, mais des sauts de courant brusques ont été couramment observés pour la RRAM de type filamentaire. Dans la présente recherche, différentes tensions de commutation ont été observées pour les différentes couches de commutation avec HfO x ou AlO x . La plage de tension définie d'un TaO/AlO x l'appareil est de 4 à 4,5 V, ce qui est supérieur à celui d'un TaO/HfO x appareil (3 à 4 V). La plage de tension de réinitialisation d'un TaO/AlO x appareil est de -1,5 à -2,5 V, ce qui est supérieur à celui d'un TaO/HfO x (-0,5 à -1,5 V). Un AlO x le système consomme plus d'énergie pour terminer le réglage et la réinitialisation des commutateurs qu'un HfO x le système consomme. Lors du réglage des interrupteurs, les couches de commutation HfO x et AlO x réaliser des pannes douces à des tensions d'environ 3 et 3,5 V, respectivement. Dans les deux types de dispositifs, avant la formation de filaments dans la couche de commutation, le courant est limité par la résistance interne de la couche de TaO. Au cours du processus d'auto-conformité de la RRAM de type piégeage, des lacunes d'oxygène excessives sont générées à l'intérieur de la couche de commutation [7]. Ces lacunes d'oxygène sont recombinées pendant le processus de réinitialisation de la polarisation négative. Contrairement à la RRAM de type filamentaire, le HRS est toujours inférieur à l'état de résistance initial (IRS) après une opération de réinitialisation [15,16,17]. Pour résumer, le piégeage des défauts est un processus qui module les lacunes par recombinaison ion oxygène-lacune pour contrôler la variation de résistance dans la couche de commutation. Par rapport à un HfO x couche de commutation, le piégeage des défauts provoque une tension et une puissance plus élevées dans l'AlO x couche pendant le réglage et la réinitialisation d'un interrupteur.
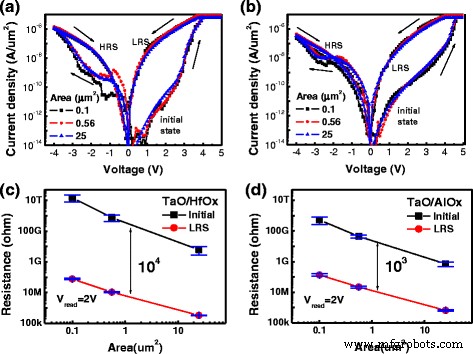
Densité de courant avec tracé de tension de a TaO/HfO x appareils avec différentes tailles de cellules. b TaO/AlO x appareils avec différentes tailles de cellules. La résistance par rapport au tracé de l'aire de c a TaO/HfO x appareil et d a TaO/AlO x appareil. Les deux graphiques contiennent l'IRS et le LRS avec une tension de lecture = 2 V. Chaque point de données fournit la moyenne de 10 appareils et l'écart type correspondant
Après avoir étudié le comportement de commutation, les comportements de rétention HRS et LRS des unités de mémoire de type piégeage ont été étudiés. Les tracés de variation de résistance en fonction du temps à 85 °C et 1 V pour le TaO/HfO x et TaO/AlO x les appareils sont illustrés à la Fig. 3a, b. Dans les deux graphiques, la variation LRS est plus prononcée que la variation HRS. La stabilité de résistance de TaO/AlO x est supérieur à celui de TaO/HfO x . Les chiffres montrent que les HRS avaient tendance à dériver vers les IRS pour les deux types d'appareils ; les IRS sont marqués par des lignes pointillées sur la Fig. 3a, b. La tendance de la résistance à revenir à l'état vierge de l'appareil est illustrée à la Fig. 3c pour TaO/AlO x et dans la Fig. 3d pour TaO/HfO x . Pour réaliser cela, les deux types d'appareils ont été initialement programmés pour le LRS à température ambiante, comme indiqué dans le I–V balayages (ligne noire). Ensuite, le TaO/AlO x et TaO/HfO x Les appareils ont été cuits dans des fours à 150 °C pendant 48 h et à 120 °C pendant 120 h, respectivement. Dans les deux cas, le I–V balayage après avoir été cuit était similaire au balayage initial. Par cette procédure, les LRS des dispositifs de type piégeage ont été ramenés à leur état d'origine après un certain temps dans un environnement à haute température. Contrairement aux dispositifs de type filament, qui présentent un mouvement notable des atomes d'oxygène, les dispositifs de type piégeage ont des paires d'ions oxygène et des lacunes séparées par de courtes distances. La tendance de la résistance à dériver vers l'état initial est liée à sa cristallinité d'origine, qui est principalement contrôlée par la température de traitement de l'ALD. En conséquence, les LRS des deux types d'appareils peuvent être réinitialisés en HRS (ou IRS) par biais négatif ou par énergie thermique. Cette propriété est différente avec la RRAM filamentaire.
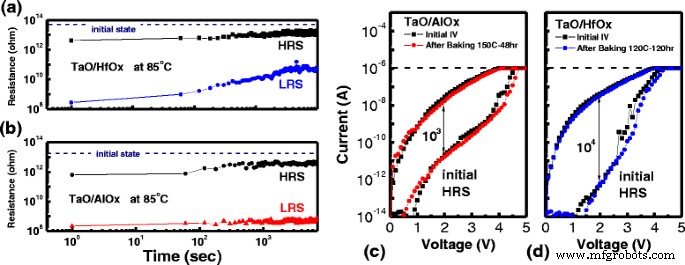
Graphiques de variation de résistance en fonction du temps pour a TaO/HfO x et b TaO/AlO x dispositifs. Les deux graphiques contiennent la variation HRS et LRS à la tension de lecture = 1 V à 85 °C. Après le Je –V des balayages de chaque appareil vierge avaient été définis, l'appareil était cuit puis reprogrammé sur LRS :c TaO/AlO x (150 °C pendant 48 h); d TaO/HfO x (120 °C pendant 120 h)
Dans les tests de rétention standard pour la mémoire non volatile, la rétention des données est testée à la fois à température ambiante et à haute température; les appareils doivent être capables de conserver les données à la fois à température ambiante et à haute température pour être utiles dans des applications réelles. Énergie d'activation (E un ) l'extraction par la méthode d'Arrhenius dans le tracé de rétention est une méthode courante pour évaluer la rétention des données [18, 19]. Comme on peut le voir sur la figure 3a, la variation LRS est plus prononcée que la variation HRS. Par conséquent, le rapport de résistance (R rapport ) du LRS en fonction du temps de cuisson à des températures allant de 30 à 150 °C a été analysé. Un exemple d'extraction de temps de rétention à partir d'un TaO/AlO x l'appareil est illustré à la Fig. 4a. Le taux de dégradation de la résistance peut être calculé par la pente de l'ajustement linéaire en log(R rapport )-log (temps) échelle. En considérant le rapport de résistance marche/arrêt maximal d'environ 10 3 pour un TaO/AlO x l'appareil, comme le montre la figure 3c, un temps de rétention de 10 3 fois la variation LRS peut être calculée. La rétention des données LRS estimée à des températures de mesure allant de 30 à 150 °C est illustrée à la Fig. 4b. Chaque point de données représente des informations provenant de plus de 18 appareils pour les deux types d'appareils. Dans un TaO/AlO x appareil, la rétention des données peut atteindre 10 6 s à 150 °C et 2 × 10 8 s (environ 5 ans) à température ambiante ; ces temps sont presque 10 1,5 fois plus longues que celles d'un TaO/HfO x appareil. Le point le plus intéressant est que TaO/HfO x et TaO/AlO x les appareils affichent le même E un = 0,38 eV, calculé à partir de la pente extraite. Le même E un implique que les deux types de dispositifs subissent des réactions chimiques similaires dans le processus de dégradation du LRS. Ce E un est impliqué dans tous les processus cinétiques activés thermiquement, y compris la libération d'ions d'oxygène près des interfaces TaO et les processus de diffusion d'oxygène dans AlO x et HfO x couches. Cependant, les coefficients d'autodiffusion d'oxygène de HfO x et AlO x les couches sont différentes à haute température (>1000 °C) ; des mesures exactes peuvent être trouvées dans la littérature [20, 21]. Le coefficient de diffusion de l'oxygène à basse température (<200 °C) dépend également de l'épaisseur de HfO x diélectriques [22]. Si les processus de diffusion dans les couches de commutation dominent la réaction chimique, alors le E un les valeurs doivent être différentes en raison des différents coefficients de diffusion dans HfO x et AlO x couches. Les deux types d'appareils dans ce travail présentaient le même E un = 0,38 eV ; cela était lié au fait que les deux types de dispositifs avaient la même couche de recouvrement de TaO au-dessus des couches de commutation. La dégradation du LRS est un processus de recombinaison de lacunes et d'ions, ce qui signifie que la couche de TaO contrôle cette réaction chimique et que la plupart des lacunes sont entassées près de l'interface entre le TaO et la couche de commutation. Ces postes vacants préfèrent rester sur l'interface TaO/couche de commutation ; ce phénomène pourrait être soutenu par le point de vue de la stabilité thermodynamique, comme rapporté par Zhong et al. [23]. Dans leur simulation de TiN/Ta/HfO x /TiN, les ions oxygène ont préféré rester sur le Ta/HfO x interface car une faible différence d'énergie existait entre Ta et HfO x [23]. Dans leur simulation, comme dans les expériences actuelles, la couche résistive de TaO a piégé la plupart des ions oxygène et a dominé ce processus de recombinaison de lacunes. La dégradation du LRS est schématisée sur la figure 4c. Les ions oxygène reviennent à l'état d'équilibre thermique précédent pendant le processus de cuisson, ce qui entraîne une perte de rétention. Des différences peuvent être notées entre le Ta/HfO x dispositif tel que proposé par Zhong et al. et le TaO/HfO x dispositif dans cette étude, mais dans les deux études, la couche de TaO a été formée par plusieurs cycles de dépôt de Ta métallique et de processus LTPO [14]. Grâce au procédé LTPO, le TaO/HfO x riche en métaux L'interface peut être considérée comme un réservoir d'ions oxygène. Au cours du processus de recombinaison des ions oxygène et des lacunes, la densité de tassement des atomes joue un rôle essentiel. Les propriétés supérieures de rétention du LRS obtenues dans l'AlO x couche de commutation pourrait s'expliquer par la densité atomique élevée de l'AlO x couche. Il est bien connu que la longueur de liaison de Al–O est plus courte que celle de Hf–O [24, 25]. L'obligation courte dans l'AlO x réduit la mobilité des ions d'oxygène en raison d'une interaction de Coulomb élevée, ce qui entraîne une barrière de diffusion élevée pour les lacunes d'oxygène. Cette barrière allonge le temps de rétention dans un TaO/AlO x dispositif que dans un TaO/HfO x un.
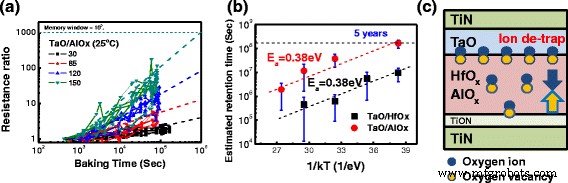
un Rapport de variation de résistance en fonction du temps de cuisson pour différentes températures en TaO/AlO x dispositifs. La résistance initiale moyenne était de 179 MOhm avec une tension de lecture de 2 V, et le taux de dégradation de la résistance LRS a été calculé par la méthode d'ajustement linéaire en log (R rapport Échelle )–log(T). b Temps de rétention estimé (1000×) par rapport au tracé 1/kT. Chaque point contient les données de 18 appareils prises à une tension de lecture de 2 V. Les énergies d'activation extraites étaient de 0,38 eV dans le TaO/AlO x et TaO/HfO x dispositifs. c Diagramme schématique de rétention de différentes barrières de diffusion d'oxygène dans HfO x ou AlO x avec une couche de coiffage TaO
De plus, le modèle de perte de rétention d'un dispositif de type filamentaire est différent de celui d'un dispositif de type piégeage de défauts. Le comportement de rétention des RRAM de type filamentaire est lié à la rupture des filaments et la direction de diffusion des lacunes est latérale [11, 19, 24]. Dans la RRAM de piégeage des défauts, la direction de diffusion des défauts est longitudinale, qui est parallèle au champ électrique externe. Par conséquent, le comportement de rétention peut être affecté par la direction et l'amplitude de la polarisation. La figure 5a, b montre la rétention en polarisation à travers le rapport de résistance pour les deux appareils. Le rapport de résistance est défini comme la résistance du dispositif de contrainte à la résistance du LRS. Un biais positif peut aider à maintenir le LRS, mais un biais négatif accélère le processus de dégradation. Ces propriétés de polarisation pourraient s'expliquer par l'interaction entre le champ localisé de paires d'ions oxygène et de lacunes et le champ électrique externe. Si la direction du champ externe est la même que la direction définie (positive), cela allonge le temps de rétention; si le champ externe est dans le sens de réinitialisation (négatif), cela provoque une dégradation. Dans un champ électrique faible avec ±100 mV, la dégradation sur polarisation est la même que la dégradation sans polarisation dans les deux types d'appareils. Ce biais de ±100 mV peut être couvert par les décalages de bande de TiON-HfO x , TiON-AlO x , et les jonctions TiN-TaO. A TaO/AlO x l'appareil soumis à une polarisation positive élevée de 500 mV ne montre aucune dégradation évidente.
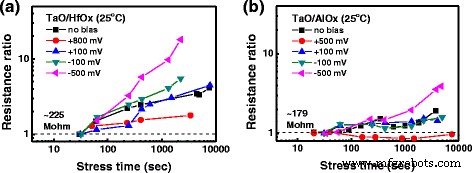
Ratio de résistance sur biais par rapport au temps de contrainte pour a TaO/HfO x et b TaO/AlO x appareils à température ambiante
Conclusions
En résumé, nous avons comparé deux types de périphériques RRAM auto-rectifiés à travers leurs caractéristiques de commutation et analysé leurs comportements de rétention. Le TaO/AlO x l'appareil a montré une tension de commutation plus élevée et une stabilité thermique LRS plus robuste que le TaO/HfO x l'appareil a fait. L'avantage d'une rétention robuste de l'AlO x couche de commutation est due à la barrière de diffusion d'oxygène élevée plutôt qu'à l'énergie d'activation. L'énergie d'activation de la perte de rétention est liée au processus de dé-piégeage des ions dans la couche résistive de TaO. La haute densité atomique d'AlO x le film peut améliorer la rétention du LRS. Un modèle schématique de perte de rétention a été proposé et les résultats de rétention en biais ont soutenu ce modèle. Ce modèle pourrait être bénéfique pour le développement de dispositifs RRAM à faible courant, à longue rétention et à auto-rectification pour les futures applications de mémoire haute densité.
Nanomatériaux
- Caractéristiques et applications du titane
- Circuit avec interrupteur
- Diriger avec persévérance et persévérance
- switch…case in C (Switch Statement in C) avec exemples
- Nanomatériau et nanocomposite intelligents dotés d'activités agrochimiques avancées
- Caractéristiques de commutation résistive bipolaire des dispositifs RRAM à structure tricouche HfO2/TiO2/HfO2 sur des substrats revêtus de Pt et de TiN fabriqués par dépôt de couche atomique
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Caractéristiques optiques et électriques des nanofils de silicium préparés par gravure autocatalytique
- Synthèse facile de composite CuSCN coloré et conducteur revêtu de nanoparticules CuS



