Sur la couche de diffusion de courant p-AlGaN/n-AlGaN/p-AlGaN pour les diodes électroluminescentes ultraviolettes profondes à base d'AlGaN
Résumé
Dans ce rapport, des diodes électroluminescentes ultraviolettes profondes (LED DUV) à base d'AlGaN avec différentes couches d'étalement de courant structurées p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) ont été décrites et étudiées. Selon nos résultats, la structure PNP-AlGaN adoptée peut induire une barrière énergétique dans la couche d'injection de trous qui peut moduler la distribution latérale du courant. Nous constatons également que l'effet d'étalement du courant peut être fortement affecté par l'épaisseur, la concentration de dopage, la boucle PNP et la composition d'AlN pour la couche de n-AlGaN insérée. Par conséquent, si la structure PNP-AlGaN est correctement conçue, la tension directe, l'efficacité quantique externe, la puissance optique et l'efficacité de la prise murale pour les LED DUV proposées peuvent être considérablement améliorées par rapport à la LED DUV conventionnelle sans le PNP. -Structure AlGaN.
Introduction
Depuis la première occurrence en 2003, les diodes électroluminescentes ultraviolettes profondes (LED DUV) à base d'AlGaN suscitent un grand intérêt en raison de leur large éventail d'applications telles que la stérilisation de l'eau et la purification de l'air [1,2,3,4,5, 6,7]. Cependant, l'efficacité quantique externe (EQE) des LED DUV est inférieure à 10 % lorsque la longueur d'onde d'émission est inférieure à 300 nm [8], ce qui limite considérablement leur application ultérieure. Le faible EQE provient en partie de la faible efficacité quantique interne (IQE). Une attention considérable a été attirée sur le fait que l'IQE est remarquablement influencé par l'injection de porteurs et les luxations étendues [8]. Les LED DUV à base d'AlGaN qui sont cultivées sur des substrats de saphir isolants utilisent la structure flip-chip pour une meilleure efficacité d'extraction de la lumière. Néanmoins, la structure de LED DUV flip-chip nécessite que l'électrode n et l'électrode p soient du même côté. Par conséquent, il se produit facilement la distribution de courant latéral non homogène, c'est-à-dire l'effet d'encombrement du courant [9]. L'effet d'encombrement actuel peut facilement provoquer l'effet de chauffage Joule local et l'émission de lumière inégale [10,11,12]. Il est à noter que la surchauffe locale détériore sérieusement la durée de vie des LED DUV. De plus, la très mauvaise efficacité de dopage en Mg de la couche d'injection de trous à base de p-AlGaN riche en Al conduit à une mauvaise conductivité électrique [13], ce qui démontre en outre l'importance d'améliorer la propagation du courant pour les LED DUV. Bien que Khan et al. ont souligné que l'encombrement actuel doit être pris en compte dans leur article de synthèse [14], une analyse détaillée concernant l'encombrement actuel et les solutions pour cela sont moins discutées pour les LED DUV jusqu'à présent.
Des techniques étendues pour favoriser l'étalement du courant ont été rapportées pour les LED bleues à base de GaN, et l'étalement du courant peut être amélioré, par exemple, en implantant sélectivement des ions dans la couche p-GaN [15, 16], en insérant une couche de blocage de courant (CBL) [17,18,19], produisant sélectivement des lacunes d'azote pour compenser les trous dans la couche de p-GaN [20], optimisant le processus de recuit pour le contact ohmique [21]. Outre l'utilisation des approches post-fabrication, la couche d'étalement de courant peut également être obtenue par croissance épitaxiale in situ dans le système de dépôt chimique en phase vapeur métal-organique (MOCVD). Des exemples importants sont les suivants :la structure de super-réseau p-GaN/i-InGaN à courte période entre la structure à puits quantiques multiples (MQW) et la couche p-GaN [22, 23], les jonctions tunnel [24, 25] et la barrière jonctions [10]. Néanmoins, les rapports sur les épi-structures pour améliorer la propagation du courant pour les LED DUV peuvent être rarement trouvés. Dans cette lettre, nous proposons d'utiliser la couche p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) pour mieux répartir le courant latéral pour les LED DUV. La structure PNP-AlGaN peut générer la barrière énergétique dans la bande de valence de la couche d'injection de trous de type p. La barrière d'énergie peut moduler la résistivité électrique pour la couche d'injection de trous de type p, et par conséquent, le chemin de circulation du courant peut être réglé. En concevant correctement la couche d'étalement de courant PNP-AlGaN, l'EQE, l'efficacité de la prise murale (WPE) et la tension directe peuvent être améliorés. En outre, ce travail étudie également de manière approfondie la sensibilité de l'étalement du courant, l'EQE, le WPE et la tension directe vers la boucle PNP-AlGaN, la concentration de dopage Si, l'épaisseur et la composition en AlN pour la couche n-AlGaN insérée. de l'architecture PNP-AlGaN.
Méthodes de recherche et modèles physiques
Pour mieux clarifier les mécanismes de propagation actuels des LED DUV à base d'AlGaN, différents dispositifs LED DUV sont conçus (voir Fig. 1a). Toutes les LED DUV sont constituées d'un Al0,60 de type n de 4 μm d'épaisseur Ga0.40 Couche N avec une concentration de dopage Si de 5 × 10 18 cm −3 . Ensuite, cinq périodes de 3 nm Al0.45 Ga0,55 N/12 nm Al0,56 Ga0.44 N MQW suivent. Nous plafonnons ensuite les MQW avec un Al0.60 de type p de 18 nm d'épaisseur Ga0.40 Couche de blocage d'électrons N (p-EBL), sur laquelle un Al de type p de 198 nm d'épaisseur0.40 Ga0,60 Une couche N et une couche de couverture en GaN de type p de 50 nm d'épaisseur sont utilisées comme couche d'injection de trous. La concentration de trous pour les couches de type p est fixée à 3 × 10 17 cm −3 . Pour les LED DUV avec les structures PNP-AlGaN proposées, la masse conventionnelle de type p Al0.40 Ga0,60 La couche N est remplacée par p-Al0.40 Ga0,60 N/n-Alx Ga1-x N/p-Al0.40 Ga0,60 couche N. La figure 1b présente le schéma de structure de la couche PNP-AlGaN. La figure 1c montre le diagramme schématique des bandes de valence pour la structure PNP-AlGaN, à partir duquel nous pouvons voir la barrière pour les trous. La barrière est générée en raison de l'épuisement des dopants Si dans le n-Alx mince Ga1-x couche N [26]. Cette barrière est très importante pour déterminer le chemin du courant et les performances de l'appareil pour les LED DUV. Une analyse détaillée sera donnée ultérieurement.
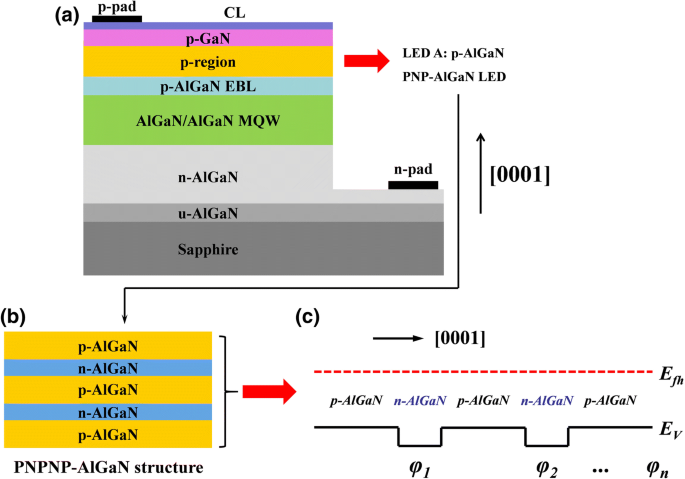
un Schémas de principe des dispositifs étudiés (référence LED A et LED PNPNP-AlGaN), b schémas de principe de la structure PNP-AlGaN avec deux jonctions PNP-AlGaN, c diagramme de bande de valence schématique pour la structure PNP-AlGaN avec plusieurs jonctions PNP-AlGaN, dans laquelle φ 1 , φ 2 , et φ n désignent la hauteur de barrière pour chaque jonction PNP-AlGaN le long de l'orientation [0001] et n représente le numéro de jonction PNP-AlGaN
Pour illustrer davantage le mécanisme de la structure PNP-AlGaN dans la propagation du courant, nous montrons le circuit équivalent simplifié et les chemins de circulation du courant pour la LED DUV développée sur des substrats de saphir sur la Fig. 2a. Le courant circule à la fois verticalement et latéralement de la région p-AlGaN vers la région n-AlGaN. Normalement, l'épaisseur de la couche d'étalement (CL) actuelle (c'est-à-dire 200 nm pour nos appareils) est beaucoup plus petite que celle de la couche n-AlGaN (c'est-à-dire 4 μm pour nos appareils). Par conséquent, la résistance électrique de la CL est beaucoup plus grande que celle de la couche d'injection d'électrons n-AlGaN. Ensuite, le courant a tendance à s'entasser sous l'électrode p, c'est-à-dire J 1> J 2> J 3> J 4> .....> J n , qui est connu comme l'effet d'encombrement actuel [27]. Heureusement, l'effet d'encombrement du courant peut être supprimé en incorporant la jonction PNP-AlGaN dans la couche d'injection de trous de type p, et le mécanisme sous-jacent peut être interprété en utilisant la figure 2b, de sorte que nous divisons le courant total en une partie verticale ( J 1 ) et une partie horizontale (J 2 ). Selon Réf. [27], la relation entre J 1 et J 2 peut être lié par l'Eq. (1) comme suit,
$$ \frac{J_1}{J_2}\cong \frac{l}{\frac{\rho_p}{\rho_{\mathrm{CL}}}{t}_p+\frac{N\cdot {\rho}_ {\mathrm{PNP}}}{\rho_{\mathrm{CL}}}}, $$ (1)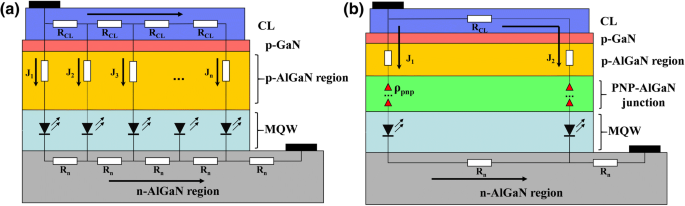
un Circuit équivalent de LED DUV avec schéma d'injection de courant latéral (J 1> J 2> J 3> J 4> …… > J n ) et b circuit équivalent simplifié de la LED à structure PNP-AlGaN, les chemins de courant (J 1 et J 2 ) sont également affichés
où l est la longueur du chemin de courant horizontal, t p est l'épaisseur, ρ p représente la résistivité verticale pour la couche d'injection de trous de type p, ρ CL désigne la résistivité de la couche d'étalement de courant déposée ex situ, ρ PNP désigne la résistivité interfaciale spécifique induite dans chaque jonction PNP-AlGaN, et N représente le numéro de la jonction PNP-AlGaN. Basé sur l'éq. (1), on en déduit que l'on peut augmenter J 2 en réduisant ρ CL . L'équation (1) indique également que l'augmentation appropriée de la résistance verticale (c'est-à-dire, ρ p × t p ) contribue également à améliorer J 2 . Alternativement, la résistance verticale peut devenir plus grande en incluant le N·ρ PNP . Cependant, la valeur de N·ρ PNP peut être affecté par le nombre de jonctions PNP-AlGaN. De plus, la valeur de ρ PNP est soumis à la concentration de dopage, à l'épaisseur et à la composition en AlN du n-Alx Ga1-x couche N. Ainsi, les détails concernant les différentes jonctions PNP-AlGaN seront discutés par la suite.
Les recherches sur la physique du dispositif sont menées à l'aide d'APSYS [28]. Le rapport de décalage de bande d'énergie entre le décalage de bande de conduction et le décalage de bande de valence pour l'hétérojonction AlGaN/AlGaN est fixé à 50:50 [29]. Le niveau de polarisation est fixé à 40 % pour le calcul des charges induites par la polarisation aux interfaces à mésappariement de réseau [30, 31]. Le coefficient de recombinaison Auger et la durée de vie de la recombinaison Shockley-Read-Hall (SRH) sont définis sur 1,0 × 10 −30 cm 6 /s [27] et 10 ns [32], respectivement. L'efficacité d'extraction de la lumière est fixée à ~ 8% pour les LED DUV [33]. D'autres paramètres sur les semi-conducteurs III-V contenant de l'azote peuvent être trouvés ailleurs [34].
Résultats et discussions
Preuve de l'efficacité de la jonction PNP-AlGaN dans la propagation du courant pour les LED DUV
Pour montrer l'efficacité de la structure PNP-AlGaN dans la propagation du courant pour la LED DUV, la LED DUV de référence (c'est-à-dire la LED A) sans structure PNP-AlGaN et la LED DUV avec la structure PNP-AlGaN (c'est-à-dire la LED B) sont étudié. Notez que les informations architecturales pour les LED DUV ont été données dans la section Méthodes de recherche et modèles de physique, à l'exception de la configuration PNP-AlGaN pour la LED B. La LED B a deux boucles PNP-AlGaN, c'est-à-dire la structure PNPNP-AlGaN. Chaque jonction PNP-AlGaN comprend le p-Al0.40 Ga0,60 N/n-Al0.40 Ga0,60 N/p-Al0.40 Ga0,60 Structure N, pour laquelle la concentration de dopage Si dans le n-Al de 20 nm d'épaisseur0,40 Ga0,60 La couche d'insertion N est de 5,3 × 10 17 cm −3 . Nous calculons et montrons le diagramme de bande d'énergie pour la LED B à la densité de courant de 170 A/cm 2 dans la figure 3a. Nous pouvons voir que, par rapport à la LED A (les bandes d'énergie ne sont pas représentées ici), les trous rencontreront deux barrières avant d'être injectés dans les MQW. Les barrières dans la bande de valence permettent ici de répartir efficacement le courant et de mieux homogénéiser les trous latéralement. Pour approfondir notre propos et aux fins de la démonstration, nous montrons le profil de concentration de trous latéraux dans le puits quantique le plus proche du p-EBL [c'est-à-dire le dernier puits quantique (LQW)] sur la figure 3b, qui constate que le la distribution des trous dans la LED B montre en effet un profil plus uniforme dans le LQW. Les observations de la figure 2b concordent bien avec les diagrammes de bandes d'énergie de la figure 3a et notre analyse précédente, de sorte que la structure PNP-AlGaN s'avère utile pour améliorer l'effet d'étalement du courant.
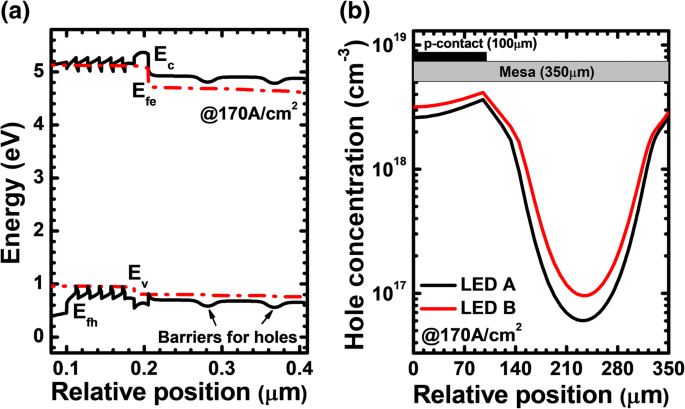
un Diagramme de bande d'énergie pour LED B à la densité de courant de 170 A/cm 2 . E c , E v , E fe , et E fh désignent la bande de conduction, la bande de cantonnière et les niveaux quasi-Fermi pour les électrons et les trous, respectivement, b distribution latérale des trous dans le dernier puits quantique pour les LED A et B à la densité de courant de 170 A/cm 2 , respectivement
Ensuite, nous montrons les profils pour la concentration de trous et le taux de recombinaison radiative dans la région MQW pour les LED A et B sur les Fig. 4a, b, respectivement. Notez que pour surveiller l'effet d'étalement du courant, les données des Fig. 4a, b sont collectées à une position distante de 230 μm du bord gauche de la mesa. Il s'avère que l'étalement de courant amélioré pour la LED B permet également l'injection de trous favorisée dans les MQW. L'amélioration de la concentration de trous dans les MQW génère le taux de recombinaison radiative amélioré pour la LED B selon la Fig. 4b.

un Profils de concentration de trous et b taux de recombinaison radiative dans la région MQW pour les LED A et B à la densité de courant de 170 A/cm 2 , respectivement
La figure 5a montre ensuite l'EQE et la densité de puissance optique en termes de niveau de densité de courant d'injection pour les LED A et B. Les niveaux d'EQE pour les LED A et B sont respectivement de 3,38 % et 4,13 %, montrant une amélioration des performances de 22,2 % à la densité de courant de 170 A/cm 2 . Ces améliorations observées sont attribuées au meilleur effet de propagation du courant et à l'injection améliorée de trous dans la région MQW pour la LED B. Comme cela a été mentionné précédemment, l'adoption de la structure PNP-AlGaN peut conduire à la barrière énergétique dans la bande de valence, qui peut influencer la tension directe. La spéculation est prouvée en se référant à la figure 5b qui démontre la tension directe légèrement augmentée pour la LED B. Malgré la tension directe plus élevée pour la LED B, l'efficacité de la prise murale pour la LED est toujours plus grande que celle de la LED A selon la figure 5c. , de sorte que les nombres sont de 3,56 % et 4,27 % pour les LED A et B au niveau de densité de courant de 170 A/cm 2 , respectivement. Si nous comparons davantage les Fig. 5a, c, nous pouvons constater que le WPE a un statisme plus prononcé pour la LED B, ce qui est attribué à la chute de tension supplémentaire à la jonction PNP-AlGaN. Par conséquent, il est essentiellement important de mener une étude plus complète révélant la sensibilité de l'EQE, de la tension directe et du WPE à différentes conceptions PNP-AlGaN.
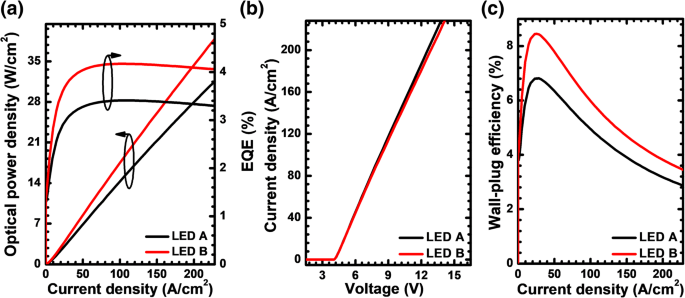
un Densité de puissance de sortie optique et EQE en fonction du courant d'injection, b caractéristique courant-tension, c WPE en termes de courant d'injection pour les LED A et B, respectivement
Impact de l'épaisseur de la couche n-AlGaN sur les performances de l'appareil
Selon l'éq. (1), nous pouvons conclure qu'un flux de courant horizontal amélioré peut être obtenu en augmentant la valeur de N·ρ PNP . La hauteur de barrière dans la jonction PNP-AlGaN augmente lorsque le n-Al0.40 Ga0,60 N couche devient épaisse de sorte qu'un plus grand ρ PNP peut être obtenu, ce qui est bénéfique pour l'effet d'étalement du courant amélioré. Cependant, une fois que le n-Al0.40 Ga0,60 La couche N est trop épaisse, plus de trous dans le p-Al0.40 Ga0,60 La couche N peut être épuisée, ce qui peut sacrifier la conductivité électrique. Par conséquent, pour mieux illustrer la relation entre l'épaisseur de n-Al0.40 Ga0,60 Couche N et performances pour les LED DUV, il est nécessaire d'étudier l'impact du n-Al0.40 Ga0,60 Épaisseur de couche N pour la jonction PNP-AlGaN sur l'étalement du courant, l'injection de trous, l'EQE, la tension directe et le WPE. Pour cela, on fait varier les valeurs du n-Al0.40 Ga0,60 N épaisseur de couche parmi 6, 13, 20, 27 et 34 nm, et les dispositifs sont appelés LED T1, T2, T3, T4 et T5, respectivement. Le tableau 1 résume la hauteur de barrière de bande de valence pour chaque jonction PNP-AlGaN, ce qui montre que la hauteur de barrière augmente à mesure que le n-Al0,40 Ga0,60 L'épaisseur de la couche N augmente, prouvant que l'augmentation du n-Al0.40 Ga0,60 L'épaisseur de couche N permet le grand N·ρ PNP , augmentant ainsi le courant horizontal J 2 . La figure 6a montre ensuite les profils de concentration de trous latéraux dans le dernier puits quantique pour la LED A sans la couche d'étalement de courant structurée PNP-AlGaN et les LED avec divers n-Al0.40 Ga0,60 N épaisseurs de couche à la densité de courant de 170 A/cm 2 . On peut voir apparemment que les trous deviennent plus uniformément répartis dans le dernier puits quantique que l'épaisseur pour le n-Al0.40 Ga0,60 N couche d'insertion augmente.
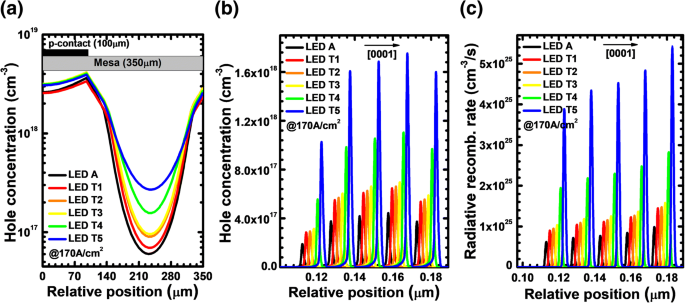
un Distribution latérale des trous dans le dernier puits quantique, b profils de concentration de trous et c profils de taux de recombinaison radiative dans la région MQW pour les LED A, T1, T2, T3, T4 et T5 à la densité de courant de 170 A/cm 2 . Les courbes tracées pour les panneaux b et c sont volontairement décalés de 2 nm pour une meilleure résolution
Ensuite, nous montrons les profils de concentration de trous et les profils de taux de recombinaison radiative dans la région MQW pour tous les appareils étudiés à la densité de courant de 170 A/cm 2 dans la Fig. 6b, c, respectivement. Les profils de concentration de trous et de taux de rayonnement sont collectés à une distance de 230 μm du bord gauche de la mesa. Pour une meilleure résolution visuelle, les profils de concentration de trous et de taux de recombinaison radiative pour les LED A, T1, T2, T3, T4 et T5 sont décalés spatialement de 2 nm sur les Fig. 6b, c, respectivement. Il est clairement démontré que la LED A a la plus faible concentration de trous et donc le plus faible taux de recombinaison radiative dans la région MQW. La concentration de trous et le taux de recombinaison radiative dans la région MQW augmentent avec l'augmentation de l'épaisseur du n-Al0.40 Ga0,60 Couche N.
Les résultats observés montrés sur la figure 6c concordent bien avec l'EQE et la densité de puissance optique qui sont présentés sur la figure 7a, de sorte que l'épaisseur croissante du n-Al0,40 Ga0,60 La couche N dans la jonction PNP-AlGaN peut améliorer l'EQE et la densité de puissance optique. Cependant, la hauteur de barrière de bande de valence pour les trous dans chaque jonction PNP-AlGaN devient grande une fois que le n-Al0.40 Ga0,60 La couche N est épaissie conformément au tableau 1, ce qui augmente en conséquence la tension directe pour les LED DUV proposées, comme indiqué sur la figure 7b. Par conséquent, l'impact du n-Al0.40 Ga0,60 L'épaisseur de la couche N pour le courant PNP-AlGaN s'étalant sur les performances de la LED doit être évaluée en démontrant la relation entre le WPE et la densité de courant d'injection (voir Fig. 8). Nous pouvons voir que le WPE n'augmente pas de façon monotone avec l'augmentation de n-Al0.40 Ga0,60 N épaisseur de couche. L'EQE et le WPE en termes de n-Al0.40 Ga0,60 L'épaisseur de la couche N est illustrée dans l'encadré de la figure 8. Pour les architectures de dispositifs proposées dans ce travail, le WPE atteint la valeur la plus élevée lorsque le n-Al0,40 Ga0,60 La couche d'insertion N a une épaisseur de 20 nm et elle diminue à mesure que le n-Al0.40 Ga0,60 La couche d'insertion N devient plus épaisse. Nous attribuons ce phénomène à l'augmentation de la résistance verticale lorsque le n-Al0.40 Ga0,60 L'épaisseur de la couche N s'épaissit, ce qui consomme plus d'énergie électrique. Par conséquent, l'épaisseur de la couche d'insertion n-AlGaN pour la jonction PNP-AlGaN doit être soigneusement optimisée. Dans cette section, nous définissons la composition en AlN de 40 %, c'est-à-dire n-Al0.40 Ga0,60 N à des fins de démonstration, et nous pensons que l'épaisseur optimisée pour la couche d'insertion n-AlGaN deviendra plus petite si l'on augmente la composition en AlN.
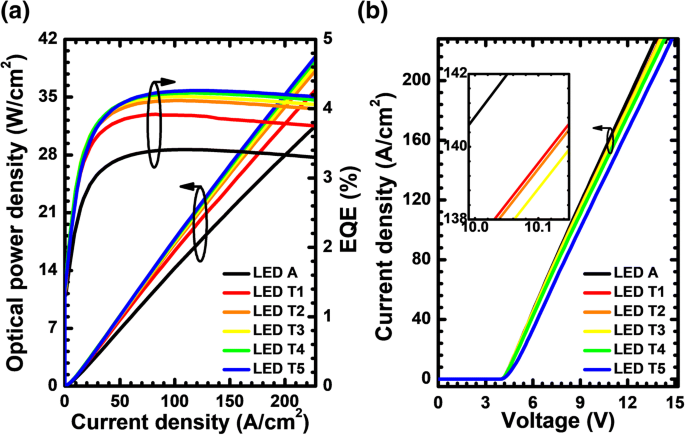
un Densité de puissance de sortie optique, b caractéristiques courant-tension pour les LED A, T1, T2, T3, T4 et T5. La figure en médaillon montre les courbes courant-tension de zoom avant
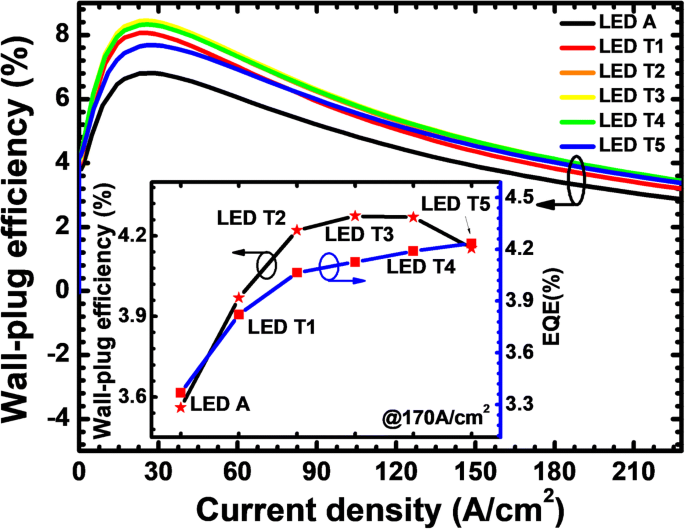
WPE en fonction du courant d'injection pour les LED A, T1, T2, T3, T4 et T5. La figure en médaillon montre les WPE et EQE pour les LED étudiées avec différentes épaisseurs du n-Al0.40 Ga0,60 Couche N pour la jonction PNP-AlGaN à la densité de courant de 170 A/cm 2
Impact de la concentration de dopage de la couche n-AlGaN sur les performances de l'appareil
Outre l'épaisseur de la couche de n-AlGaN, la concentration de dopage pour la couche de n-AlGaN peut également modifier la hauteur de barrière de la bande de valence pour les trous, affectant ainsi N·ρ PNP . Pour étudier plus précisément l'impact de la concentration de dopage de la couche n-AlGaN sur l'effet d'étalement du courant et les performances optiques des LED DUV avec les jonctions PNP-AlGaN, nous avons fixé la concentration de dopage à 1,3 × 10 17 , 5,3 × 10 17 , 9.3 × 10 17 , 1,33 × 10 18 , et 1,73 × 10 18 cm −3 des couches n-AlGaN pour les LED D1, D2, D3, D4 et D5, respectivement. L'épaisseur de la couche n-AlGaN est fixée à 20 nm et deux jonctions PNP-AlGaN sont adoptées. La composition en AlN est de 40 %, c'est-à-dire n-Al0,40 Ga0,60 N.
Le tableau 2 montre que la hauteur de barrière de la bande de valence pour les trous augmente lorsque la concentration de dopage Si pour le n-Al0,40 Ga0,60 La couche N de la jonction PNP-AlGaN devient haute. L'augmentation de la hauteur de barrière de la bande de valence indique le grand N·ρ PNP , qui produit simultanément le courant horizontal élevé de J 2 . Selon l'éq. (1), l'augmentation de la propagation du courant s'accompagne d'un profil de concentration de trous latéraux plus uniforme, et par conséquent, nous montrons, sur la Fig. 9a, que la distribution des trous latéraux dans le dernier puits quantique s'avère plus homogénéisée une fois que le PNP-AlGaN La jonction est dopée pour les LED DUV par rapport à la LED A. De plus, les trous latéraux deviennent plus uniformément répartis une fois la concentration de dopage Si pour le n-Al0.40 Ga0,60 La couche N de la jonction PNP-AlGaN augmente.
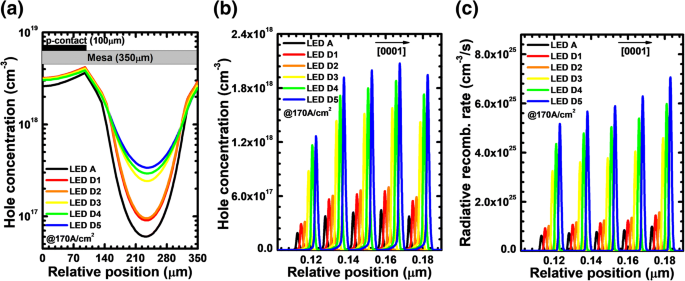
un Distribution latérale des trous dans le dernier puits quantique, b profils de concentration de trous, et c profils de taux de recombinaison radiative dans la région MQW ou LED A, D1, D2, D3, D4 et D5 à la densité de courant de 170 A/cm 2 . Les courbes tracées pour les panneaux b et c sont volontairement décalés de 2 nm pour une meilleure résolution
Ensuite, nous montrons les profils de concentration de trous et les profils de taux de recombinaison radiative dans la région MQW pour tous les appareils étudiés à la densité de courant de 170 A/cm 2 dans la Fig. 9b, c, respectivement, qui sont collectées à une position de 230 μm à part du bord gauche de la mesa. Il est clairement démontré que la LED A a la concentration de trous la plus faible et le taux de recombinaison radiative le plus faible dans la région MQW. La concentration de trous et le taux de recombinaison radiative dans la région MQW augmentent avec l'augmentation des concentrations de dopage du n-Al0.40 Ga0,60 N couches pour les LED avec jonctions PNP-AlGaN. Le niveau de concentration de trous amélioré dans le MQW pour les LED D1, D2, D2, D3, D4 et D5 est attribué au meilleur effet de propagation du courant, grâce à la jonction PNP-AlGaN.
Nous calculons et présentons ensuite l'EQE et la densité de puissance optique en termes de densité de courant d'injection pour les dispositifs étudiés sur la figure 10a. L'EQE observé est cohérent avec les résultats des Fig. 9b, c, de sorte que l'EQE peut être amélioré une fois que la jonction PNP-AlGaN est utilisée. Plus que cela, comme la concentration de dopage Si dans le n-Al0.40 Ga0,60 La couche N pour la jonction PNP-AlGaN augmente, l'EQE peut être encore amélioré, grâce à un meilleur étalement du courant. La figure 10b compare la tension de fonctionnement directe pour les appareils étudiés. Il est montré que la tension de fonctionnement directe augmente avec l'augmentation de la concentration de dopage dans le n-Al0.40 Ga0,60 couche N. Notez que les concentrations de dopage Si sont de 1,33 × 10 18 et 1,73 × 10 18 cm −3 , la tension d'allumage montre une augmentation significative, ce qui indique que la jonction intégrée PNP-AlGaN comporte une diode parasite lorsque le Si dopant dans le n-Al0.40 Ga0,60 La couche N augmente à un niveau très élevé. Pour évaluer plus précisément les performances des LED DUV avec différentes jonctions PNP-AlGaN, la figure 11 présente le WPE en fonction de la densité de courant d'injection pour les LED A, D1, D2, D3, D4 et D5. Clairement, nous pouvons voir que le WPE est le plus bas pour la LED D5, ce qui est dû à la plus grande consommation de tension directe. L'encart de la Fig. 11 indique également que le WPE est plus sensible à la concentration de dopage Si du n-Al0.40 Ga0,60 couche N que l'EQE. Il convient de conclure que la forte concentration de dopage Si du n-Al0,40 Ga0,60 La couche N peut en effet améliorer la couche d'étalement du courant et augmenter le taux de génération de photons. Néanmoins, la chute de tension directe supplémentaire aux jonctions PNP-AlGaN consomme plus d'énergie électrique, limitant ainsi le WPE. Les résultats de cette section illustrent également que la concentration de dopage Si dans le n-Alx Ga1-x La couche de N doit être correctement réduite si l'on augmente la composition en AlN et/ou l'épaisseur du n-Alx Ga1-x Couche N pour la jonction PNP-AlGaN, car ce faisant, on peut obtenir à la fois l'EQE amélioré et le WPE décent.
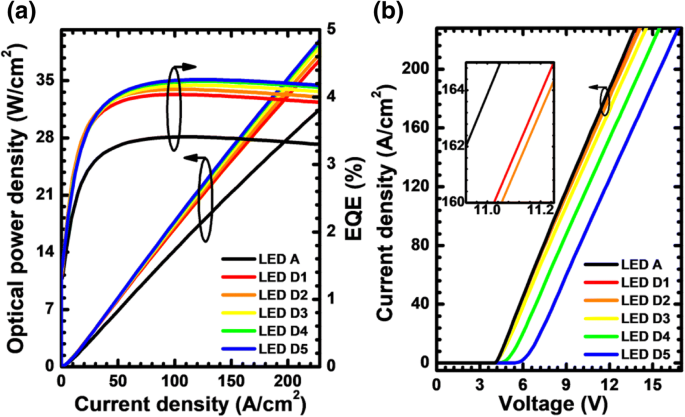
un Densité de puissance de sortie optique et EQE en fonction du courant d'injection, b caractéristiques courant-tension pour les LED A, D1, D2, D3, D4 et D5. La figure en médaillon montre les courbes courant-tension de zoom avant
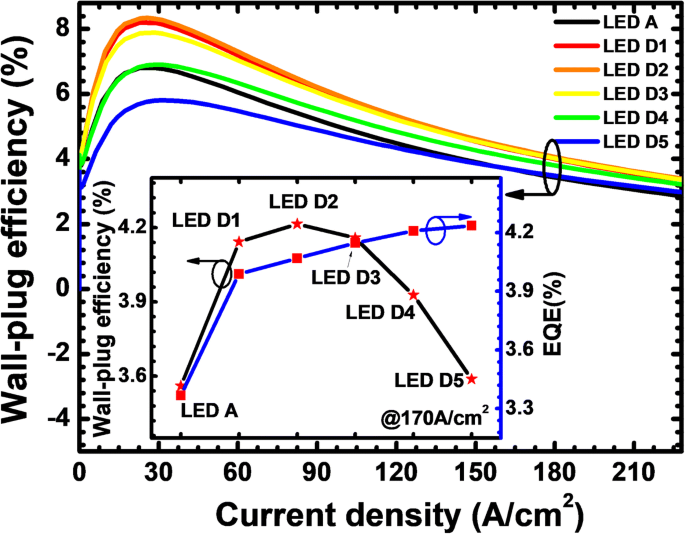
WPE en fonction du courant d'injection pour les LED A, D1, D2, D3, D4 et D5. La figure en médaillon montre le WPE et l'EQE pour les LED étudiées avec différentes concentrations de dopage du n-Al0.40 Ga0,60 Couche N à la densité de courant de 170 A/cm 2
Impact du numéro de jonction PNP-AlGaN sur les performances de l'appareil
Dans cette section, l'impact du nombre de jonction PNP-AlGaN sur les performances électriques et optiques des LED DUV est étudié. A des fins de démonstration, nous fixons la concentration de dopage et l'épaisseur de la couche de n-AlGaN à 5,3 × 10 17 cm −3 et 20 nm, respectivement. La composition en AlN est choisie à 0,40 telle que n-Al0,40 Ga0,60 N. Nous adoptons différentes boucles pour la jonction PNP-AlGaN, c'est-à-dire que les numéros de boucle sont définis sur 1, 2, 3 et 4 pour les LED N1, N2, N3 et N4, respectivement. Nous calculons et présentons d'abord la hauteur de barrière de bande de valence pour chaque jonction PNP-AlGaN dans le tableau 3. On peut évidemment lire que l'augmentation du nombre de jonction PNP-AlGaN rend le N·ρ global PNP haut. Nous calculons et démontrons ensuite la distribution latérale des trous dans le dernier puits quantique pour les LED A, N1, N2, N3 et N4 à la densité de courant de 170 A/cm 2 (voir Fig. 12a). Cela montre que la distribution des trous dans le dernier puits quantique devient plus uniforme à mesure que davantage de jonctions PNP-AlGaN sont incorporées. Les résultats de la figure 12a appuient en outre les prédictions faites par l'équation. (1).
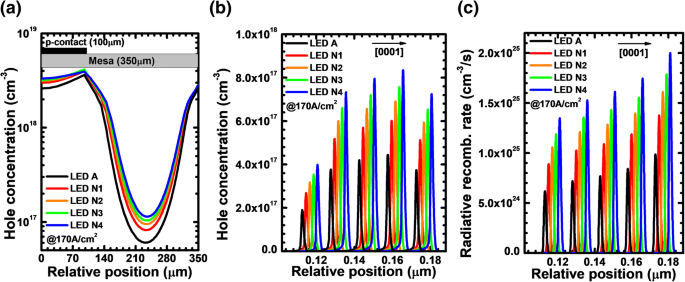
un Distribution latérale des trous dans le dernier puits quantique, b profils de concentration de trous, et c profils de taux de recombinaison radiative dans la région MQW pour les LED A, N1, N2, N3 et N4 à la densité de courant de 170 A/cm 2 . Les courbes tracées pour les panneaux b et c sont volontairement décalés de 2 nm pour une meilleure résolution
Then, we show the hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, N1, N2, N3, and N4 at the current density of 170 A/cm 2 in Fig. 12b, c, respectively. The hole and radiative recombination rate profiles are probed at the position of 230 μm apart from the left mesa edge. It is indicated that the hole concentration and radiative recombination rate increase if the number of the PNP-AlGaN junction is more. It is worth mentioning here that we do not increase the value of N beyond 4, since when the N is further increased, the thickness of the remaining p-Al0.40 Ga0.60 N layer becomes so thin that the holes may be depleted by the ionized Si dopants and the hole supply can be insufficient.
Thanks to the improved current spreading effect, the enhanced hole concentration in the MQW region, LEDs N1, N2, N3, and N4 consequently promote the EQE and optical power density when compared with LED A (see Fig. 13a). Figure 13b demonstrates that the forward operating voltage for the suggested DUV LEDs also increases if more PNP-AlGaN junctions are incorporated. Fortunately, the increase of the forward voltage for LEDs N1, N2, N3, and N4 does not reduce the WPE according to Fig. 14. Further investigations into the inset of Fig. 14 can illustrate that both the EQE and WPE tend to approach a saturation level as the number of the PNP-AlGaN junction increases. Therefore, we believe that, as has also been pointed out previously, further increase of the number for the PNP-AlGaN junction may deplete the holes and correspondingly degrade the hole supply capability, hence making little contribution in enhancing the EQE and the WPE for the proposed device architectures in this work.
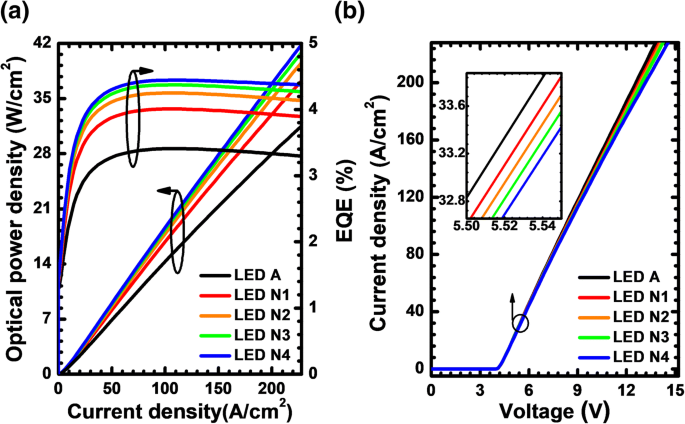
un Optical output power density and EQE as a function of the injection current, b current-voltage characteristic for LEDs A, N1, N2, N3, and N4. Inset figure shows the zoom-in current-voltage curves
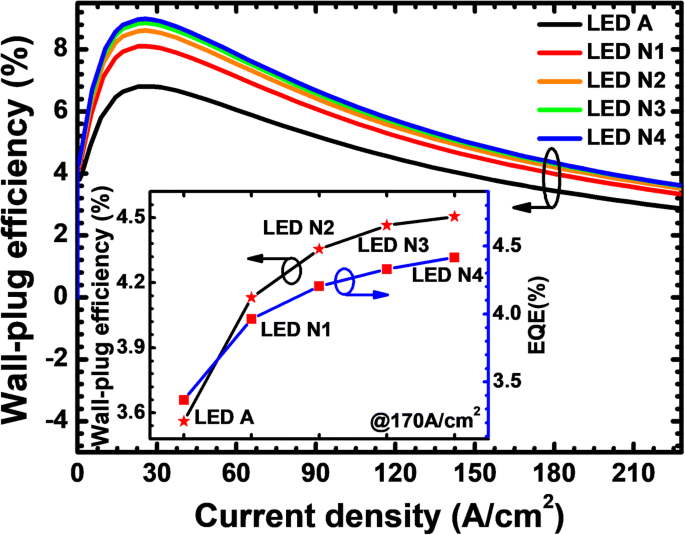
WPE as a function of the injection current for LEDs A, N1, N2, N3, and N4. Inset figure shows the WPE and EQE for LEDs with various number of PNP-AlGaN junction at the current density of 170 A/cm 2
Impact of the AlN Composition for n-AlGaN Layer on the Device Performance
Lastly, we modify the ρ PNP by varying the AlN composition of the n-AlGaN layer for the PNP-AlGaN junction. The values for the AlN composition of the n-AlGaN layer are set to 0.40, 0.43, 0.46, 0.49, and 0.51 for LEDs C1, C2, C3, C4, and C5, respectively. The thickness and the Si doping concentration of the n-AlGaN layer are set to 20 nm and 5.3 × 10 17 cm −3 , respectivement. We adopt two PNP-AlGaN junctions for LEDs C1, C2, C3, C4, and C5. The AlN composition for the rest p-AlGaN layers is fixed to 0.40. Table 4 demonstrates the valence band barrier height for the PNP-AlGaN junction with different AlN compositions in the n-AlGaN insertion layer. It is easily understandable that the increased AlN composition in the n-AlGaN layer gives rise to the larger valence band barrier height for holes. Figure 15a exhibits the lateral distributions for holes in the last quantum well for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The current spreading effect is significantly improved as the AlN composition of the n-AlGaN layer increased up to 0.43. It seems that the holes cannot be further soundly spreaded when the AlN composition of the n-AlGaN layer exceeds 0.43 for our structures, because a too much high AlN composition in the n-AlGaN may block the hole injection.

un Lateral hole distribution in the last quantum well, b hole concentration profiles, and c radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The plotted curves for panels b et c are purposely shifted by 2 nm for better resolution
The hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 are presented in Fig. 15b, c, respectively. The data are also collected at the position of 230 μm apart from the left mesa edge. The conclusions here are similar to that for Fig. 6b, Fig. 9b and Fig. 12b, i.e., the adoption of the PNP-AlGaN current spreading layer increases the hole injection, and the hole concentration in the MQW region becomes even more improved once the AlN composition in the n-AlGaN layer increases. We then further calculate and present the EQE and the optical power density in terms of the injection current for the investigated devices in Fig. 16a. Clearly, we can see that the EQE can be improved once the PNP-AlGaN junction is employed. In addition, as the AlN composition in the n-AlGaN layer for the PNP-AlGaN junction increases, the EQE can be further promoted, thanks to the better current spreading, which homogenizes the hole concentration in each quantum well plane as has been shown previously.
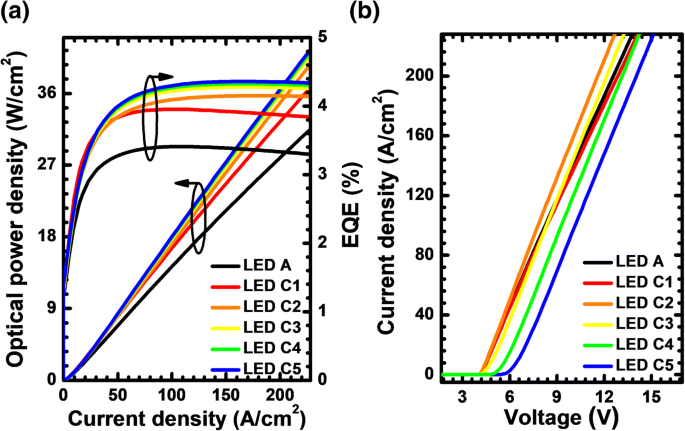
un Optical output power density and EQE as a function of the injection current and b current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5
Figure 16b investigates the current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5. The device exhibits a slight increase in the forward operating voltage for LED C1 with the PNP-Al0.40 Ga0.60 N junction when compared to the LED A. Meanwhile, the device consumes more forward voltage for LEDs C4 and C5. The observation here is consistent with that in Fig. 7b, Fig. 10b and Fig. 13b, such that the adoption of the PNP-AlGaN junction causes the additional valence band barrier height for holes, which, as a result, increases the forward voltage and even the turn-on voltage (e.g., LEDs C4 and C5). However, it is worth mentioning that the forward operating voltage for LEDs C2 and C3 decreases when compared to LED A. The underlying mechanism is not clear at this moment. However, we tentatively attribute the reduced forward voltage for LEDs C2 and C3 to the hole acceleration effect [35].
Figure 17 shows the relationship between the WPE and the injection current density for the tested LEDs. We can get that the WPE can be enhanced for all the proposed LEDs especially when the injection current density is beyond 89 A/cm 2 . Insightful study into LED C5 shows that the WPE for LED C5 is lower than that for LED A when the current density is smaller than 89 A/cm 2 . Nevertheless, the WPE for LED C5 overwhelms that for LED A when the injection current density become higher (i.e.,> 89 A/cm 2 ). As is well known, the current easily gets crowded when the LED device is biased at a high current level. The WPE for LED C5 reflects that the PNP-Al0.51 Ga0.49 N junction is indeed effective in improving the current spreading effect. However, considering the additional voltage consumption in the PNP-AlGaN junction, one shall be very careful when setting the AlN composition for the n-AlGaN layer so that the WPE can be maximized according to the inset in Fig. 17.
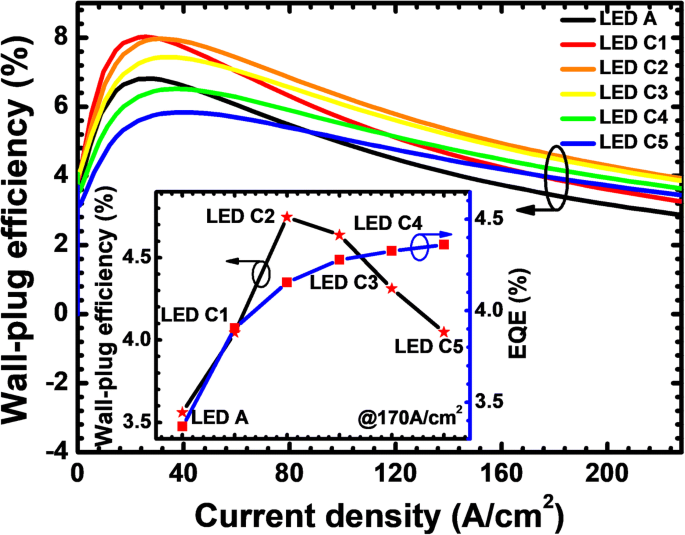
WPE as a function of the injection current for LEDs A, C1, C2, C3, C4, and C5. Inset figure shows the WPE and the EQE for the studied LEDs with various AlN compositions for the n-AlGaN layer at the current density of 170 A/cm 2
Conclusions
To summarize, the PNP-AlGaN junction for DUV LEDs are explored and demonstrated. Assisted by the proposed PNP-AlGaN junctions, the current spreading effect can be improved. The improved current spreading effect is well attributed to increased the vertical resistance and the enhanced horizontal current flow. Moreover, we have also conducted the parametric study to reveal different PNP-junctions on the current spreading effect, the EQE and the WPE. We find that by properly increasing the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction, the current spreading effect can be improved. On the other hand, we also find that the current spreading effect can indeed enhance the EQE. However, the forward voltage may be increased if the PNP-AlGaN junction is not fully optimized, the cost of which is the reduced WPE. It is also worthy pointing out that the current spreading feature is the cooperative function of the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction. As a result, there is no unique answer for the best design of the PNP-AlGaN current spreading layer for DUV LEDs. However, we strongly believe that the findings in this work introduce the additional physical understanding to the PNP-AlGaN current spreading layer and the current spreading effect for DUV LEDs. Hence, this work is very useful for the community of optical semiconductor devices.
Abréviations
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CBL:
-
Current blocking layer
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE :
-
Efficacité quantique externe
- IQE :
-
Efficacité quantique interne
- LQW:
-
Last quantum well
- MOCVD:
-
Metal-organic chemical vapor deposition
- MQWs:
-
Multiple quantum wells
- PNP-AlGaN:
-
p-AlGaN/n-AlGaN/p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Wall-plug efficiency
Nanomatériaux
- Présentation des arguments en faveur des puces neuromorphiques pour l'IA informatique
- Les scientifiques d'IBM inventent un thermomètre pour l'échelle nanométrique
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Synthèse verte de points quantiques InP/ZnS Core/Shell pour une application dans des diodes électroluminescentes sans métaux lourds
- Le précurseur de titane optimal pour la fabrication de la couche compacte de TiO2 pour les cellules solaires à pérovskite
- Diodes émettant de la lumière ultraviolette à base d'AlGaN presque efficace et sans chute avec une couche de blocage d'électrons de type p à super-réseau spécialement conçue pour une efficacit…
- Diodes électroluminescentes à pérovskite haute luminance avec solvant alcoolique à haute polarité traitant le PEDOT:PSS comme couche de transport de trous
- Influence de la largeur du puits quantique sur les propriétés d'électroluminescence des diodes électroluminescentes ultraviolettes profondes AlGaN à différentes températures
- Quelles sont les applications les plus courantes pour le courant alternatif ?



