Une méthode pratique et efficace pour déposer des couches minces nc-Si:H à faible densité de défauts par PECVD
Résumé
Le film mince de silicium nanocristallin hydrogéné (nc-Si:H) a reçu beaucoup d'attention en tant que matériau prometteur pour les transistors d'affichage à écran plat, les cellules solaires, etc. Cependant, la structure multiphasée du nc-Si:H entraîne de nombreux défauts. L'un des principaux défis est de savoir comment réduire les défauts de manière pratique. Dans ce travail, nous avons développé une méthode simple et efficace pour déposer un film mince de nc-Si:H à faible densité de défauts. Cette méthode consiste simplement à régler la pression de dépôt dans une plage de pressions élevées dans le processus de dépôt chimique en phase vapeur assisté par plasma (PECVD). Les microstructures du nc-Si:H ont été caractérisées par Raman, AFM et SEM. De plus, nous nous sommes concentrés sur la densité de défauts qui était la caractéristique clé des matériaux photovoltaïques et avons atteint la densité de défauts de 3,766 × 10 16 cm −3 . Cette densité de défauts est inférieure à celle des études précédentes sur la fabrication de nc-Si:H à faible densité de défauts par d'autres méthodes complexes dans le processus PECVD. La durée de vie des porteurs minoritaires de nc-Si:H est ainsi grandement améliorée. De plus, nous avons démontré le mécanisme de l'effet de la pression de dépôt sur le bombardement ionique et prouvé que la densité de défauts est la caractéristique clé du matériau photovoltaïque nc-Si:H.
Contexte
Le développement de silicium nanocristallin hydrogéné de haute qualité (nc-Si:H) est un jalon important dans les progrès de la technologie du silicium à couche mince. Comparé au silicium amorphe hydrogéné (a-Si:H), le nc-Si:H a une mobilité beaucoup plus élevée, une bien meilleure réponse aux longueurs d'onde supérieures à 800 nm et est beaucoup moins sensible à la dégradation de Staebler-Wronski [1, 2]. Le film mince nc-Si:H peut être déposé par dépôt chimique en phase vapeur assisté par plasma (PECVD), ce qui le rend compatible avec l'industrie des circuits intégrés bien développée. Par conséquent, le film mince nc-Si:H a une large application dans divers dispositifs, tels que les transistors à couche mince [3], les photodétecteurs [4] et les cellules solaires [5].
Cependant, en tant que matériau multiphasique, le film mince nc-Si:H a ses propres défauts tels que des vides et des liaisons pendantes aux interfaces cristaux/phase amorphe et entre les cristaux. Il est connu que l'hydrogène atomique est la clé du dépôt de nc-Si:H de haute qualité qui a moins de défauts [6]. L'hydrogène atomique peut saturer les liaisons pendantes, et il a été souligné [7] que l'hydrogène atomique sur la surface en croissance donne lieu à une croissance cristalline à une température bien inférieure à celle de fusion. Ainsi, plus d'hydrogène atomique est bénéfique pour le dépôt de nc-Si:H de haute qualité. Afin d'augmenter le flux d'hydrogène atomique sur la surface de croissance, une dilution élevée en hydrogène ou un appauvrissement en silane serait essentiel pour la croissance de nc-Si:H.
L'épuisement du silane dans le PECVD consiste à augmenter la puissance des radiofréquences (RF) [7]. Mais le simple fait d'augmenter la puissance augmentera considérablement le bombardement ionique sur la surface de croissance, ce qui entraînera probablement plus de défauts. Ainsi, une polarisation en courant continu (CC) doit être utilisée pour supprimer le bombardement ionique. Cependant, si la puissance RF est augmentée pour obtenir plus d'hydrogène atomique, la polarisation CC doit également être modifiée. Sinon, la polarisation CC ne peut pas soulager efficacement le bombardement ionique. Et la polarisation CC appropriée sous une certaine puissance RF ne peut être trouvée sans de vastes expériences. Une autre méthode pour augmenter la teneur en hydrogène atomique consiste à augmenter la pression de dépôt. La fréquence de collision électron-molécule augmente avec la pression de dépôt. Il fait le taux de dissociation de SiH4 et H2 en hausse. Une dissociation de SiH4 et H2 génère l'hydrogène atomique [8]. En conséquence, l'augmentation de la pression de dépôt pourrait augmenter la teneur en hydrogène atomique.
Dans cet article, nous proposons donc d'ajuster la pression de dépôt dans une plage de pression élevée pour obtenir plus d'hydrogène atomique (la pression de dépôt conventionnelle est de 50 à 100 Pa). C'est une méthode pratique et efficace dans le processus PECVD. En utilisant cette méthode, le film déposé sous une certaine pression a une densité de défauts plus faible par rapport aux études précédentes sur la fabrication de nc-Si:H à faible densité de défauts [5, 9, 10]. Et une durée de vie élevée des porteurs minoritaires a été atteinte. De plus, par rapport aux rapports précédents sur l'effet de différentes pressions de dépôt sur les propriétés macroscopiques ou générales des échantillons [11, 12], nous avons considérablement étendu la plage de pression de dépôt et nous nous sommes concentrés sur son effet non seulement sur les propriétés générales (par exemple, la cristallinité) mais aussi sur la densité de défauts et la durée de vie des porteurs minoritaires qui sont des caractéristiques clés pour un matériau photovoltaïque de haute qualité. De plus, nous avons démontré le mécanisme de l'effet de la pression de dépôt sur le bombardement ionique, alors que les rapports précédents ne donnaient que des discussions générales. Et nous avons en outre prouvé que le bombardement ionique n'est pas le plus faible possible pour la croissance du film (le degré de bombardement ionique doit être approprié). Au final, nous avons prouvé que la densité de défauts est la caractéristique clé du matériau photovoltaïque nc-Si:H.
Méthodes/Expérimental
Les films minces de nc-Si:H ont été développés sur du verre Corning par un système PECVD à couplage capacitif (le schéma du réacteur est représenté sur la figure 1a) à différentes pressions de dépôt. La pression de dépôt a été augmentée de 150 à 1050 Pa, avec un pas de 150 Pa. Tous les échantillons ont été déposés en utilisant une RF de 13,56 MHz et une densité de puissance de 0,32 W/cm 2 , avec un gaz total (SiH4 et H2 ) débit de 110 sccm (le SiH4 la concentration était de 0,727 %). La température du substrat a été maintenue à 250 °C, et le temps de dépôt était de 2 h.
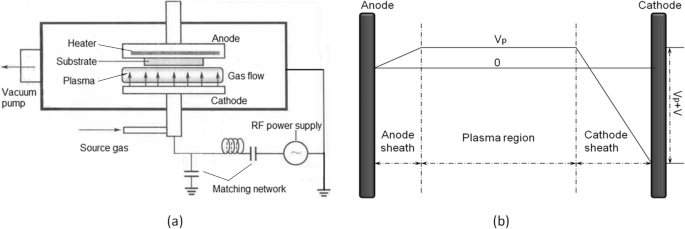
Le diagramme schématique de a le réacteur PECVD et b la distribution de potentiel entre électrodes (V p , le potentiel plasmatique; V , la moyenne quadratique du potentiel RF)
La cristallinité X c a été calculé à partir des spectres Raman mesurés avec un spectromètre UV micro-Raman (Jobin Yvon LabRam, HR800) en mode rétrodiffusion à l'aide d'un laser Ar-ion à 514,5 nm. La densité de puissance laser a été maintenue à 1 mW/mm 2 pour éviter toute cristallisation induite par le faisceau. La densité de défauts des échantillons a été caractérisée par la densité de spin Ns, qui a été calculée à partir des résultats mesurés par un spectromètre à résonance de spin électronique (ESR) (Bruker, bande EMX-8X) à 9,8 GHz et 5 mW. La durée de vie effective du porteur minoritaire τ a été mesuré à l'aide d'un Semilab WT-1200A. La morphologie de surface de ces films a été observée au microscope à force atomique (AFM, SII Nanonavi E-Sweep), et la micromorphologie a été observée au microscope électronique à balayage (SEM, Sirion 200).
Résultats et discussion
Enquête structurelle par analyse Raman
Pour l'étude structurale du film mince de nc-Si:H déposé sous diverses pressions, des mesures micro-Raman ont été effectuées. Sur la figure 2, quatre échantillons représentatifs ont été choisis pour montrer les spectres Raman. Ils se déposent respectivement sous 300 Pa, 450 Pa, 750 Pa et 1050 Pa. Chaque spectre (cercles vides) sous une certaine pression peut être déconvolué en trois pics gaussiens :(1) une large distribution gaussienne autour de 480 cm −1 , qui est attribuée à l'optique transverse (TO1 ) mode du silicium amorphe; (2) un pic proche de 520 cm −1 , qui appartient au TO2 asymétrique mode vibrationnel du silicium cristallin [13, 14]; et (3) le pic autour de 506 cm −1 qui est attribué à l'ordre de portée intermédiaire [1, 15]. La cristallinité (X c ) dans nc-Si:H peut être calculé par [16, 17] :
$$ {X}_c=\gauche({I}_{520}+{I}_{506}\right)/\gauche({I}_{520}+{I}_{506}+\gamma {I}_{480}\right) $$ (1)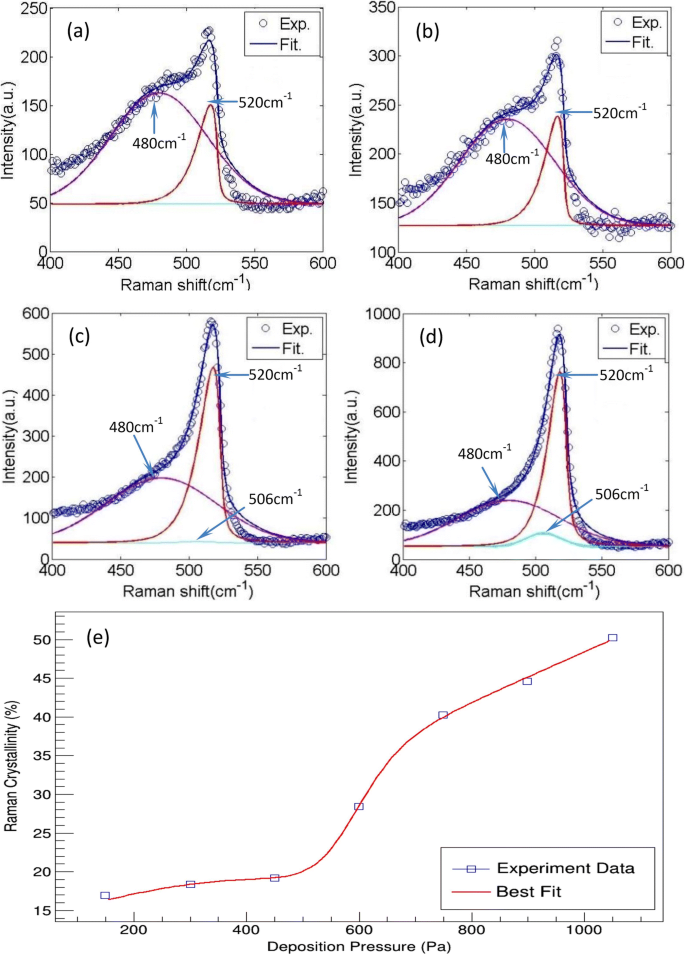
Spectres Raman et leur déconvolution d'échantillons types déposés sous 300 Pa (a ), 450 Pa (b ), 750 Pa (c ) et 1050 Pa (d ) et la cristallinité calculée de couches minces de nc-Si:H déposées sous différentes pressions (e )
où γ est le rapport de la section efficace Raman intégrée pour c-Si à a-Si (γ = 1 [17, 18]), et I 520 , Je 506 , Je 480 sont l'intensité intégrée des pics observés à 520, 506, 480 cm −1 , respectivement. La cristallinité en fonction des différentes pressions de dépôt est représentée sur la figure 2e.
Il est connu que l'hydrogène atomique (H), est principalement généré à partir des deux collisions suivantes dans un plasma de silane dilué à l'hydrogène [8] :
- une.
La réaction primaire électron-silane
- b.
La réaction électron-hydrogène
D'après les formules S(1) et S(2) du fichier Additionnel 1, on obtient \( {n}_e=\frac{P}{RT}\bullet \mu \) (P , pression de dépôt; R , constante des gaz parfaits ; T , température absolue du gaz avant rejet ; μ , taux d'ionisation; et n e , Densité d'électron). μ est constant en raison de la puissance RF inchangée, et T est également constant. La densité électronique n e augmente donc avec la pression de dépôt P . Selon les équations chimiques. (2) et (3), la densité de H qui est produite dans le plasma augmente avec n e . C'est l'analyse théorique dans une condition idéale. Le processus de décharge est si complexe que l'analyse du processus de décharge (c'est-à-dire les diagnostics de plasma) devient une discipline indépendante. Le changement de H avec la pression de dépôt dans les conditions réelles doit être mesuré par des diagnostics plasma. Yang et al. mesuré l'intensité de \( {H}_{\alpha}^{\ast } \) (\( {I}_{H_{\alpha}^{\ast }} \)) par spectre d'émission optique (OES) et démontre que \( {I}_{H_{\alpha}^{\ast }} \) augmente d'abord puis diminue [19]. Selon les rapports de diagnostics plasma précédents, l'intensité de \( {H}_{\alpha}^{\ast } \) indique la quantité d'hydrogène atomique [20, 21]. Ainsi, la densité de H dans le plasma augmente d'abord puis diminue lorsque la pression de dépôt continue d'augmenter. Cette tendance est un peu différente de notre analyse théorique. La différence est liée à la réaction secondaire de H :
$$ \mathrm{H}+{\mathrm{SiH}}_4\à {\mathrm{H}}_2+{\mathrm{SiH}}_3 $$ (4)où SiH4 est celui qui n'est pas décomposé, c'est-à-dire le SiH4 restant . Dans notre expérience, la pression de dépôt est augmentée en réduisant le débit de gaz dont le SiH4 . Autrement dit, cela équivaut à augmenter le supplément de SiH4 .Lorsque la pression de dépôt atteint un certain niveau, la vitesse de SiH4 supplément dépasse sa vitesse de décomposition. Ainsi, il y a plus de quantités de SiH4 à gauche. Il y a une distance pour H entre sa sortie du plasma et son arrivée à la surface de croissance du film. H réagira avec le SiH4 restant à cette distance, comme indiqué dans l'équation chimique secondaire. (4). La densité de H diminue donc. En conséquence, la densité atomique d'hydrogène augmente d'abord puis diminue lorsque la pression de dépôt continue d'augmenter. Il est connu qu'une plus grande quantité de H est bénéfique pour le dépôt de nc-Si:H à faible densité de défauts. Par conséquent, la densité de défauts de nc-Si:H déposé dans notre expérience montre la même tendance de la densité d'hydrogène atomique, c'est-à-dire que la densité de défauts diminue d'abord puis augmente. Les discussions sur la tendance de la densité de défauts en détail sont présentées dans la dernière section.
Sur la figure 2e, on peut clairement voir que la cristallinité de nc-Si:H, X c , augmente avec la pression de dépôt. Cela indique que l'augmentation de la pression peut augmenter X c . La cristallinité n'est pas seulement affectée par l'hydrogène atomique mais également influencée par la teneur en précurseur de croissance SiHn (n = 1,2,3, principalement n = 3) qui peut être indiqué par SiH * dans la mesure de l'OES [21, 22]. Hsieh et al. ont démontré que \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ (le rapport d'intensité \( {H}_{\alpha}^{\ast } \)/SiH * ) augmente avec la pression de dépôt [20]. Il est généralement admis que \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ est l'indice de X c , c'est-à-dire X c augmente avec l'augmentation de \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ [21, 23]. Par conséquent, le \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ tendance appuient fortement notre résultat sur la tendance de X c .
La taille moyenne des grains d peut aussi être déduit du spectre Raman, selon la formule [24, 25] :
$$ d=2\pi \sqrt{B/\Delta \upnu} $$ (5)où ∆ν est la fréquence en unité de cm −1 décalage, qui a été défini comme la différence entre la valeur de fréquence de crête observée et celle du Si massif. En utilisant la valeur habituelle de B de 2,0 cm −1 nm 2 [25], d = 4.07~4.50 nm.
Morphologie de surface et mécanisme sur l'influence de la pression de dépôt sur le bombardement ionique
Outre l'analyse structurelle par spectroscopie Raman, la morphologie des échantillons a également été caractérisée par AFM, comme le montre la figure 3. Pour détecter l'évolution de la rugosité des surfaces des films, la racine carrée (RMS) en fonction de la pression de dépôt a été représenté sur la figure 3h (la valeur RMS a été moyennée sur plusieurs emplacements différents dans chaque film). Sur la figure 3h, la RMS diminue à mesure que la pression de dépôt augmente. La pression croissante provoque une collision aggravée entre les particules et une perte subséquente d'énergie cinétique lorsque ces particules atteignent la surface de croissance du film. Les ions de plus faible énergie arrivant à la surface de croissance du film conduisent à un bombardement ionique plus faible. Cela suggère que la pression croissante est bénéfique pour la suppression du bombardement ionique, qui a également été mentionné dans le rapport précédent [7]. Cependant, le mécanisme de l'influence de la pression de dépôt sur le bombardement ionique n'a pas été démontré. Il sera étudié comme suit.

Images AFM de films minces de nc-Si:H montrant un changement de morphologie de surface par différentes pressions de dépôt. un 150 Pa, b 300 Pa, c 450 Pa, d 600 Pa, e 750 Pa, f 900 Pa, et g 1050 Pa. Les cratères de a et b sont marqués par des cercles en pointillés et la rugosité moyenne quadratique (RMS) des surfaces du film sous différentes pressions de dépôt marquées par h
La distribution de potentiel entre les deux électrodes peut être divisée en trois régions :la région de plasma au centre, la gaine anodique et la gaine cathodique (voir Fig. 1b). Les ions qui conduisent au bombardement ionique doivent diffuser hors de la région du plasma et traverser la gaine anodique. Le potentiel du plasma est plus élevé que celui de toute autre section du réacteur car les électrons diffusent plus rapidement que les ions. Comme la paroi de notre réacteur est mise à la terre, le potentiel du plasma est positif (voir Fig. 1). Les anions sont ainsi piégés dans la région du plasma; seuls les particules neutres et les cations peuvent diffuser jusqu'à la gaine anodique et finalement atteindre la surface filmogène. En d'autres termes, le bombardement ionique dans notre expérience est causé uniquement par des cations. Les cations traversent la gaine de l'anode sans collision car la largeur de la gaine est très petite (la preuve en détail est présentée dans le fichier supplémentaire 1). De ce fait, les cations ne sont accélérés par le champ électrique de la gaine anodique que lorsqu'ils pénètrent dans la gaine. Par conséquent, la force du bombardement ionique ne dépend que de la vitesse initiale des cations lorsqu'ils entrent juste dans la gaine anodique (v 0 ) et le degré d'accélération par le champ électrique de la gaine anodique par la suite.
Premièrement, la corrélation de v 0 avec la pression de dépôt seront analysés. Les particules comprenant des cations perdent leur énergie cinétique dans la région du plasma en raison de la collision aggravante lorsque la pression de dépôt augmente. Alors, v 0 diminue à mesure que la pression augmente. Ensuite, la variation du degré d'accélération par le champ électrique de la gaine avec la pression de dépôt sera démontrée. On sait que [22] :
$$ {V}_p-{V}_f=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$où m e est la masse de l'électron ; m i est la masse de l'ion ; T e et T i sont respectivement la température de l'électron et de l'ion ; V p est le potentiel plasmatique; et V f est le potentiel flottant. Comme le substrat est suspendu dans notre réacteur, la tension de la gaine d'anode, V gaine est égal à V p − V f , alors nous avons :
$$ {V}_{\mathrm{gaine}}=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$ (6)Dans la région du plasma, T e diminue à mesure que l'augmentation de la pression de dépôt aggrave la collision entre les particules (y compris les électrons et les ions). Hsieh et al. ont démontré que T e diminue avec l'augmentation de la pression de dépôt par la mesure OES [20]. Cela suggère que la tendance de T e par notre analyse théorique est absolument correcte. Par rapport à T e , T i diminue si peu qu'il peut être considéré comme inchangé. En conséquence, V gaine diminue lorsque la pression augmente selon la formule (6). Il affaiblit le degré d'accélération par la gaine anodique. Couplé à la chute v 0 , nous pouvons conclure que l'énergie cinétique des cations qui atteignent la surface de croissance du film devient beaucoup plus petite lorsque la pression augmente. En d'autres termes, l'augmentation de la pression de dépôt rend l'effet de bombardement ionique plus faible. Par conséquent, la RMS de la surface du film continue de diminuer de 150 à 1050 Pa. Selon le rapport précédent, plus l'énergie ionique est faible, meilleure est la cristallinité [7]. Cela appuie également la conclusion sur la corrélation entre la cristallinité et la pression de dépôt que nous avons déjà établie. De plus, les surfaces des films qui se déposent sous des pressions beaucoup plus faibles (150 Pa et 300 Pa) sont plus rugueuses, et l'on constate également que ces surfaces contiennent de nombreux cratères comme le montre la figure 4a, b. C'est la conséquence d'un fort bombardement ionique. D'après la figure 3, on peut apparemment conclure que le film déposé sous 450 Pa est le plus compact (notamment représenté sur les figures 5c et 6d) et uniforme.
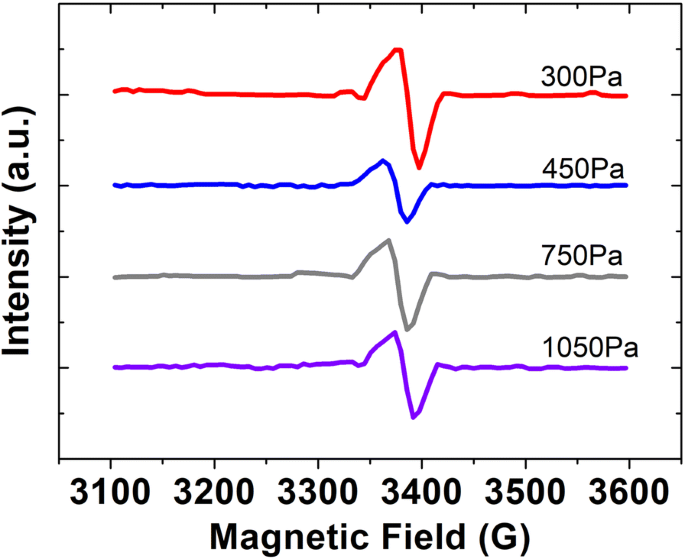
Les spectres ESR d'échantillons types déposés sous 300 Pa, 450 Pa, 750 Pa, 1050 Pa
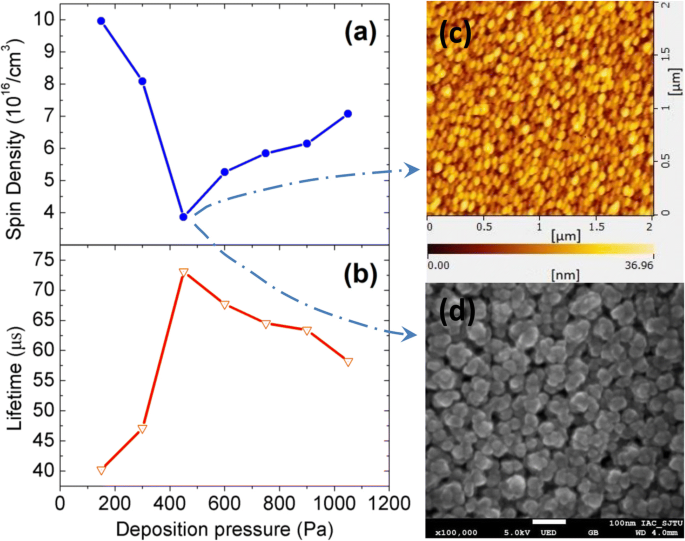
Dépendance de la densité de spin (a ) et la durée de vie effective du porteur minoritaire (b ) sur différentes pressions de dépôt. L'image AFM haute résolution (c ) et image SEM (d ) de couche mince de nc-Si:H déposée sous 450 Pa

Diagramme schématique de la diffusion des particules sur la surface de croissance
Densité des défauts et propriété électrique
L'effet de la pression de dépôt sur la densité de défauts du film mince de nc-Si:H a été étudié par la technique ESR. La figure 4 montre les quatre spectres ESR d'échantillons typiques qui ont été déposés sous 300 Pa, 450 Pa, 750 Pa, 1050 Pa, respectivement. Les données de la figure 5a sont calculées à partir du spectre ESR de chaque échantillon. Comme le montre la figure 5a, lorsque la pression augmente, la densité de rotation diminue d'abord puis augmente. Il y a un minimum à 450 Pa. Selon le principe ESR, le nombre de spins non appariés est directement proportionnel à la densité de liaisons neutres pendantes. Ces liaisons résident principalement dans la surface de croissance du film et constituent le défaut à l'état stable de la surface de croissance du film, tandis que la densité de défauts dans le film résultant est essentiellement déterminée par cette densité de défauts à l'état stable [26]. Par conséquent, les résultats calculés à partir des spectres ESR sont bien la densité de défauts du film résultant. Ces résultats de la figure 5a révèlent que la densité de défauts dans nc-Si:H atteint un minimum à 450 Pa, soit 3,766 × 10 16 cm −3 . Chowdhury et al. ont étudié comment fabriquer du nc-Si:H à faible densité de défauts. Lorsqu'ils ont utilisé une source RF de 13,56 MHz, ils ont fait de leur mieux pour obtenir une faible densité de défauts. Les valeurs étaient de 1,1 × 10 17 et 7.0 × 10 16 cm −3 . Lorsqu'ils ont utilisé une source d'excitation à très haute fréquence (VHF) (54,24 MHz), ils ont atteint la densité de défauts la plus faible de 4,3 × 10 16 cm −3 [dix]. Il est connu que l'énergie ionique dans le plasma VHF est faible et que la densité du flux ionique est élevée. En raison de ces deux facteurs, le film mince déposé par VHF-PECVD contient une faible densité de défauts et est donc de haute qualité [27]. Cependant, la densité de défauts est plus élevée que la nôtre, et la source d'excitation 54,24 MHz est beaucoup plus chère que son homologue 13,56 MHz. Afin d'obtenir une faible densité de défauts, Wen et al. en plus appliqué une polarisation CC. Cependant, le minimum est 4.0 × 10 16 cm −3 [9]. Trouver une puissance RF appropriée n'est pas facile, encore moins une polarisation CC appropriée. La raison en est que la polarisation CC doit être réglée une fois que la puissance RF est modifiée. Sinon, la polarisation CC ne peut pas soulager efficacement le bombardement ionique. En revanche, notre méthode est simple. Récemment, Jadhavar et al. ont déposé un nc-Si:H de haute qualité par PECVD qui a une faible densité de défauts. La densité de défauts est d'environ 8.75 × 10 16 cm −3 [5]. Par conséquent, notre méthode pour obtenir un film mince à faible densité de défauts est pratique et efficace. Tenant compte du fait que plus la densité de défauts est faible, plus la durée de vie des porteurs minoritaires doit être élevée, nous avons directement effectué la mesure de la durée de vie des porteurs minoritaires. Comme le montre la figure 5b, la durée de vie effective des porteurs minoritaires atteint son maximum à 450 Pa. La tendance de la durée de vie des porteurs minoritaires se synchronise avec celle de la densité de défauts calculée à partir des spectres ESR. Cela révèle que la densité de défauts des films peut être absolument mesurée par ESR.
Relation entre le bombardement ionique et la densité des défauts
L'augmentation de la pression peut supprimer le bombardement ionique. En un sens, la densité de défauts devrait décroître en continu de 150 à 1050 Pa. En fait, elle diminue puis augmente. Il y a un autre facteur qui ne doit pas être ignoré :la diffusion de H et SiH3 (dans le plasma, le précurseur principal du film est le SiH3 [26]). Le diagramme schématique de la diffusion des particules sur la surface en croissance est illustré à la figure 6. De 150 à 1050 Pa, l'énergie cinétique des particules diminue. L'effet de bombardement ionique est certainement de plus en plus faible. Cependant, l'énergie cinétique des particules diminue considérablement de 450 à 1050 Pa en raison de l'augmentation de la fréquence de collision des particules. L'hydrogène atomique, qui est la clé du dépôt de nc-Si:H de haute qualité, perd tellement son énergie cinétique qu'il ne peut plus diffuser pour saturer davantage de liaisons pendantes, et encore moins sa densité commence à diminuer, ce qui est montré dans le « Enquête structurelle par analyse Raman. » D'un autre côté, les particules, y compris l'hydrogène atomique, perdent considérablement leur énergie cinétique de sorte qu'elles ne peuvent pas transférer plus d'énergie à la surface en croissance. Ainsi, la longueur de diffusion de SiH3 précurseur ne peut pas être amélioré. On sait que si SiH3 absorbé à la surface pourrait trouver les sites de croissance énergétiques favorables, une structure atomiquement plus ordonnée se forme. Mais maintenant, SiH3 n'a pas une durée de diffusion suffisante pour trouver leurs sites de croissance énergétiquement favorables. Par conséquent, la structure ordonnée ne peut pas être formée. Autrement dit, le film déposé présente plus de défauts. En conséquence, la densité de spin sur la figure 5a commence à augmenter à partir de 450 Pa au contraire. Cependant, il convient de noter que les densités de spin de 600 à 1050 Pa sont encore inférieures à celles de 150 à 300 Pa. C'est le résultat du bombardement ionique plus faible. De plus, du fait de sa longueur de diffusion réduite, SiH3 précurseur a tendance à s'entasser pour former des agrégats. Comme le montre la figure 3, les agrégats ont commencé à apparaître à 750 Pa, et ils se sont progressivement agglomérés de manière intensive lorsque la pression de dépôt a continué d'augmenter. D'après les points ci-dessus, le bombardement ionique n'est pas le plus faible, mieux c'est pour la croissance du film. Le degré de bombardement ionique doit être approprié.
Densité de défaut :la caractéristique clé du matériau photovoltaïque nc-Si:H
La cristallinité et la densité de défauts sont deux caractéristiques des matériaux de cellules solaires nc-Si:H. Le premier augmente avec la pression de dépôt. Dans un sens, ce dernier devrait continuer à baisser. Cependant, ce n'est pas le cas. Selon la caractérisation Raman, bien que la cristallinité augmente, la variation de la taille des grains est très faible (4,07 ~ 4,50 nm). Il indique que seul le nombre de grains augmente et non la taille des grains. Dans ces conditions, le volume des joints de grains augmente. On sait que les joints de grains sont des défauts massifs et des centres de recombinaison. Plus de joints de grains augmenteront la densité de défauts. Lorsque la cristallinité atteint un certain niveau, l'effet négatif d'une augmentation du volume aux joints de grains sur la densité de défauts surmonte l'effet positif de l'augmentation du nombre de grains. Par conséquent, la densité de défauts ne continue pas à diminuer au fur et à mesure que la cristallinité augmente; au contraire, il augmente lorsque la cristallinité atteint un certain niveau. Ce résultat suggère que les films minces de nc-Si:H avec une cristallinité plus élevée n'ont pas nécessairement une meilleure qualité, ce qui est confirmé par un autre groupe de recherche. Ces dernières années, il a été rapporté que la couche optimale de nc-Si:H pour les cellules solaires est obtenue près de la limite de transition de phase, c'est-à-dire que l'optimum est obtenu juste après le a-Si:H-à-nc-Si:H transition. La cristallinité des couches optimales de nc-Si:H n'est pas élevée [28,29,30]. Mukhopadhyay et al. ont en outre démontré que les couches de nc-Si:H à haute cristallinité, et donc à faible dégradation induite par la lumière, ne produisent pas de cellules solaires de haute qualité. L'efficacité stabilisée des cellules déposées juste après la transition a-Si:H-à-nc-Si:H est supérieure à celle des cellules dans lesquelles la couche i a une cristallinité élevée, bien que la première se dégrade plus que la seconde avant stabilisation [31]. Han et al. ont en outre prouvé que la dégradation induite par la lumière de la couche nc-Si:H est introduite par la formation de liaisons pendantes métastables. Alors que le changement structurel induit par la lumière est un processus précurseur de la formation de liaisons pendantes métastables [30]. La liaison pendante métastable est l'un des défauts [32]. Par conséquent, la caractéristique clé des matériaux photovoltaïques nc-Si:H de haute qualité est la densité des défauts plutôt que la cristallinité, la stabilité à la lumière ou d'autres caractéristiques.
Conclusions
Des couches minces de nc-Si:H ont été déposées en faisant varier la pression entre 150 et 1050 Pa. La plage de pression de dépôt est plus élevée que le dépôt conventionnel dans le procédé PECVD. On constate que la cristallinité augmente et que la rugosité des surfaces du film diminue avec une augmentation de la pression de dépôt. La taille moyenne des grains d =4,07 ~ 4,50 nm. De plus, nous nous sommes concentrés sur l'influence de la pression de dépôt non seulement sur les propriétés macroscopiques ou habituelles des échantillons mais aussi sur la densité de défauts et la durée de vie des porteurs minoritaires qui sont des caractéristiques plus importantes. On constate que la densité de défauts des échantillons diminue d'abord puis augmente lorsque la pression de dépôt augmente. La densité de défauts atteint son minimum (3.766 × 10 16 cm −3 ) à 450 Pa. Il est inférieur à celui des études précédentes sur la fabrication de couches minces de nc-Si:H à faible densité de défauts. Ce travail fournit un moyen pratique et efficace de déposer du nc-Si:H à faible densité de défauts par PECVD. Et nous avons démontré le mécanisme de l'effet de la pression de dépôt sur le bombardement ionique. De plus, il est prouvé que le bombardement ionique n'est pas d'autant plus faible qu'il est meilleur pour la croissance du film. Le degré de bombardement ionique doit être approprié.
Abréviations
- AFM :
-
Microscope à force atomique
- DC :
-
Courant continu
- H :
-
Hydrogène atomique
- nc-Si:H :
-
Silicium nanocristallin hydrogéné
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- SEM :
-
Microscopie électronique à balayage
- VHF :
-
Très haute fréquence
Nanomatériaux
- Méthode et analyse du courant de maillage
- Classe abstraite et méthode C#
- Classe partielle C# et méthode partielle
- Classe et méthode scellées C#
- Film PC antibuée pour visières, lentilles et lunettes
- Méthode Java String replace(), replaceAll() et replaceFirst()
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Une conception efficace et efficiente des nanofils InP pour une récupération maximale de l'énergie solaire
- Service d'outillage rapide et ses applications efficaces



