Transistor à effet de champ à capacité négative ZrOx avec comportement d'oscillation sous-seuil inférieur à 60
Résumé
Nous rapportons ici le ZrOx FET à capacité négative (NC) avec une oscillation sous-seuil (SS) de 45,06 mV/décade sous ± 1 V V GS gamme, qui peut offrir de nouvelles opportunités dans les futures applications NCFET évolutives en tension. Le comportement de type ferroélectrique du Ge/ZrOx Il est proposé que les condensateurs /TaN proviennent des dipôles à vide d'oxygène. L'effet NC du HfO2 amorphe et ZrOx les dispositifs de films peuvent être prouvés par la chute soudaine de la fuite de grille, le phénomène de résistance différentielle négative (NDR), l'amélioration de I DS et oscillation sous-seuil inférieure à 60. 5 nm ZrOx -Les NCFET atteignent une hystérésis dans le sens des aiguilles d'une montre de 0,24 V, inférieure à 60 mV/décade SS et un I de 12 % Amélioration DS par rapport au dispositif de contrôle sans ZrOx . L'effet NC supprimé de Al2 O3 /HfO2 NCFET comparé à ZrOx Le NCFET est lié à la commutation partielle des dipôles de lacunes d'oxygène dans le balayage vers l'avant en raison de dipôles interfaciaux négatifs au niveau de l'Al2 O3 /HfO2 interface.
Contexte
Alors que les dispositifs semi-conducteurs à oxyde métallique complémentaire (CMOS) diminuent constamment, la technique des circuits intégrés (CI) est entrée dans l'ère de « plus que l'ère Moore ». La force motrice de l'industrie et de la technologie des circuits intégrés devient la réduction de la consommation d'énergie, au lieu de la miniaturisation des transistors [1, 2]. Cependant, la tyrannie de Boltzmann des MOSFET, plus de 60 mV/décade SS a restreint l'efficacité énergétique/de puissance [3]. Ces dernières années, de nombreux nouveaux dispositifs proposés ont la capacité d'atteindre une oscillation de seuil inférieure à 60 mV/décennie, y compris les MOSFET à ionisation par impact, les FET à tunnel et les NCFET [4,5,6,7]. En raison de la structure simple, du SS raide et du courant d'entraînement amélioré, les NCFET avec un film ferroélectrique (FE) ont été considérés comme une alternative intéressante parmi ces dispositifs émergents [8,9,10]. Les expériences rapportées sur les NCFET incluent principalement PbZrTiO3 (PZT), P(VDF-TrFE) et HfZrOx (HZO) [11,12,13,14,15,16,17]. Cependant, la température élevée du processus et le courant de fuite de grille indésirable le long des joints de grains des matériaux ferroélectriques polycristallins ont limité leur développement pour les nœuds technologiques de pointe [18,19,20,21,22,23,24,25 ,26]. Récemment, la ferroélectricité dans l'Al2 amorphe O3 et ZrOx Les films activés par les dipôles de lacune d'oxygène modulés en tension ont été étudiés [27,28,29]. Par rapport à la contrepartie cristalline, les films amorphes de type ferroélectrique présentent des avantages significatifs en termes de température de processus et de courant de fuite réduits. Ainsi, il existe des recherches de masse sur les FeFET avec isolant de grille amorphe pour les applications de mémoire non volatile et de synapse analogique [27, 30, 31, 32, 33, 34]. Cependant, l'investigation systématique sur un transistor ZrOx -basé sur le NCFET n'a pas été effectué.
Dans ce travail, Ge NCFET avec 5 nm ZrOx couche diélectrique ferroélectrique et 5 nm Al2 O3 /HfO2 des couches diélectriques ferroélectriques ont été proposées, respectivement. Nous avons observé expérimentalement une pente raide inférieure à 60 mV/décennie dans le ZrOx (5 nm) NCFET, qui peut être attribué à l'effet NC de ZrOx couche ferroélectrique. Et nous avons analysé la polarisation P en fonction de la tension appliquée V pour le Ge/ZrOx /Condensateurs Tan. Le comportement de type ferroélectrique du Ge/ZrOx Les condensateurs /TaN sont induits par les dipôles à vide d'oxygène induits par la tension. De plus, nous avons attribué l'amélioration de I DS et la chute soudaine de I G dans l'Al2 O3 /HfO2 NCFET et ZrOx NCFET à effet NC. Nous avons également observé le phénomène NDR dans l'Al2 O3 /HfO2 NCFET et ZrOx NCFET. De plus, nous avons analysé plus en détail le mécanisme physique de la diminution de l'effet NC induit par les dipôles interfaciaux dans l'Al2 O3 /HfO2 NCFET. Le ZrOx Les NCFET avec une pente raide inférieure à 60 mV/décennie, une tension de drain améliorée et une faible tension de fonctionnement conviendront à la conception de NCFET à faible consommation d'énergie à l'ère « plus que Moore ».
Méthodes
Étapes clés du processus pour les NCFET avec ZrOx et Al2 O3 /HfO2 la fabrication est illustrée à la Fig. 1a. Différents isolants diélectriques de grille, y compris Al2 O3 /amorphe HfO2 Films (5 nm) et ZrOx amorphe Des films (4,2 nm) ont été développés sur des substrats de n-Ge (001) par dépôt de couche atomique (ALD) à 300 °C. TMA, TDMAHf, TDMAZr et H2 Les vapeurs d'O ont été utilisées comme précurseurs d'Al, Hf, Zr et O, respectivement. Le temps d'impulsion et le temps de purge des précurseurs de Hf et Zr sont respectivement de 1,6 s et 8 s. Le temps d'impulsion et le temps de purge des précurseurs d'Al sont respectivement de 0,2 s et 8 s. Une électrode de grille supérieure en TaN a ensuite été déposée sur HfO2 ou ZrOx surfaces par pulvérisation cathodique réactive. Les régions source/drain (S/D) ont été définies par lithographie et gravure sèche. Après cela, le bore (B + ) et le nickel (Ni) s'est déposé dans les régions source/drain (S/D). Enfin, recuit thermique rapide (RTA) à 350 °C pendant 30 s dans un 10 8 Pa d'azote ambiant a été réalisé. Les figures 1b, d montrent les schémas de l'Al2 fabriqué O3 /HfO2 NCFET et ZrOx NCFET. L'image au microscope électronique à transmission à haute résolution (HRTEM) de la figure 1c représente le HfO2 amorphe Film (5 nm) sur Ge (001) avec Al2 O3 couche interfaciale. L'image HRTEM de la Fig. 1e représente le ZrOx amorphe Film (4,2 nm) sur Ge (001). La courbe C–V de ZrOx Les NCFET et les spectres de photoélectrons X (XPS) de TaN/ZrOx Les condensateurs (4,2 nm)/Ge ont été mesurés dans le fichier supplémentaire 1 :Fig. S1.
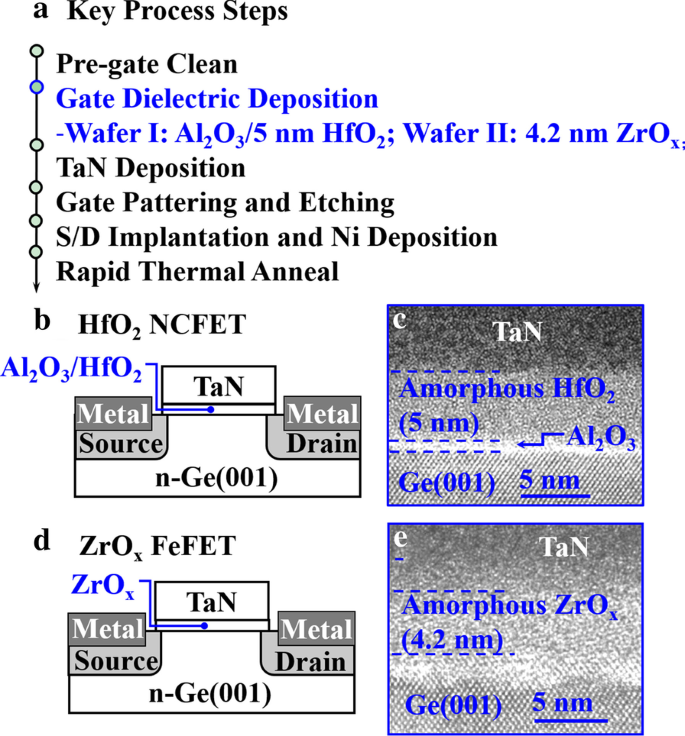
un Étapes clés du processus pour la fabrication de l'Al2 O3 /5 nm HfO2 NCFET et 4,2 nm ZrOx NCFET. b Schémas et c Images HRTEM du ZrOx fabriqué NCFET. d Schémas et e Images HRTEM de l'Al2 fabriqué O3 /HfO2 NCFET
Résultats et discussion
La figure 2a montre les courbes mesurées de polarisation P vs. tension appliquée V caractéristiques pour le Ge/ZrOx Condensateurs /TaN à 3,3 kHz. La longueur du portail (L G ) des condensateurs sont de 8 μm. On observe que la polarisation résiduelle P r du Ge/ZrOx Les condensateurs /TaN peuvent être améliorés avec une plage de balayage plus large de V . Le comportement de type ferroélectrique du ZrOx amorphe film de la Fig. 2a est proposé pour provenir des dipôles de lacune d'oxygène commandés par la tension [35]. La figure 2b montre le P–V mesuré courbes pour le Ge/ZrOx Condensateurs /TaN sous différentes fréquences de 200 à 10 kHz. Nous pouvons voir que le comportement de type ferroélectrique du ZrO amorphex film restent stables pour toutes les fréquences. Cependant, le P r du ZrOx amorphe le film est réduit avec l'augmentation des fréquences. Ce phénomène peut s'expliquer par la commutation incomplète des dipôles sous des fréquences de mesure élevées [36, 37]. Au fur et à mesure que les fréquences de mesure augmentent, le temps nécessaire au changement de direction du champ électrique dans le ZrOx amorphe le film diminue. Ainsi, une partie de la commutation diploes d'absence d'oxygène est incomplète, fournissant une diminution de P r .

P mesuré contre V caractéristiques du ZrO de 4,2 nmx condensateurs avec a différentes plages de balayage de V et b différentes fréquences de mesure
La figure 3a montre le I mesuré DS –V GS courbes d'un ferroélectrique Al2 O3 /HfO2 NCFET au V DS de − 0,05 V et − 0,5 V. Le L G des appareils est de 3 μm. Les boucles d'hystérésis de 0,14 V (V DS = − 0,05 V, I ds = 1 nA/μm) et 0,08 V (V DS = − 0,5 V, I ds = 1 nA/μm) sont démontrés, respectivement. Les boucles d'hystérésis dans le sens horaire sont attribuées à la migration des lacunes d'oxygène et accompagnées de charges négatives. Les dipôles à lacunes d'oxygène s'accumulent (s'épuisent) dans le Ge/Al2 O3 interface sous V positif (négatif) GS . Par conséquent, la tension de seuil (V TH ) augmente (diminue) sous le balayage direct (inverse) des tensions de grille. Comme le montre la figure 3b, les caractéristiques de sortie de l'Al2 O3 /HfO2 Le NCFET et le FET de contrôle sont comparés. Le courant de saturation de l'Al2 O3 /HfO2 Le NCFET dépasse 26 μA/μm, avec une augmentation de 23 % par rapport à celui du FET témoin à |V GS –V TH | =|V DS |= 0,8 V. L'augmentation du courant est induite par l'augmentation de l'intensité de charge d'inversion (Q inv ) dans le champ électrique de polarisation inverse et l'amplification du potentiel de surface [38, 39]. En plus de l'amélioration actuelle, le NDR évident obtenu prouve l'effet NC du HfO2 amorphe film. L'effet NDR est causé par la commutation incomplète des dipôles de lacunes d'oxygène en raison du couplage drain-canal en tant que V DS augmente [40, 41]. La figure 3c compare la fuite de grille mesurée I G –V GS courbes pour le 5 nm Al2 O3 /HfO2 NCFET au V DS de − 0,05 V et − 0,5 V. Les chutes soudaines de I G seulement pendant le balayage inverse indiquent la diminution de la tension dans le HfO2 amorphe film et l'amplification du potentiel de surface [42]. L'absence d'effet NC pendant le balayage vers l'avant est causée par la commutation partielle des dipôles de lacunes d'oxygène dans le HfO2 amorphe cinéma [43]. La capacité différente de contenir des atomes d'oxygène entre Al2 O3 et HfO2 couche conduit à une redistribution de l'oxygène et à des dipôles interfaciaux négatifs au niveau de l'Al2 O3 /HfO2 interface [44, 45]. En raison de la présence de dipôles interfaciaux négatifs, il est difficile pour le HfO2 amorphe film pour réaliser une commutation de polarisation complète (effet NC) dans le balayage avant (Fichier supplémentaire 1).
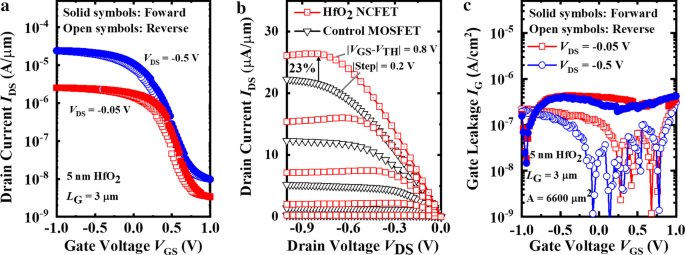
un Mesuré I DS –V GS courbes du 5 nm HfO2 NCFET lorsque V DS = − 0,5 V et V DS = − 0,05 V. b Mesuré I DS –V DS courbes du HfO2 NCFET et le MOSFET de contrôle. c Mesuré I G –V GS courbes du 5 nm HfO2 NCFET lorsque V DS = − 0,5 V et V DS = − 0,05 V
La figure 4a montre les courbes de transfert mesurées d'un ferroélectrique ZrOx NCFET au V DS de − 0,05 V et − 0,5 V. Le L G des deux appareils sont de 4 μm. Les boucles d'hystérésis dans le sens horaire de 0,24 V (V DS = − 0,05 V, I ds = 1 nA/μm) et 0,14 V (V DS = − 0,5 V, I DS = 1 nA/μm) sont démontrés, respectivement. Comme le montre la Fig. 4b, les caractéristiques de sortie du ZrOx Le NCFET et le FET de contrôle sont comparés. Le courant de saturation du ZrOx Le NCFET dépasse 30 μA/μm, avec une augmentation de 12 % par rapport à celui du FET de contrôle à |V GS –V TH | =|V DS |= 1 V. L'amélioration du courant et le NDR plus évident indiquent l'effet NC amélioré du ZrOx amorphe film (5 nm) contraste avec celui de 5 nm HfO2 film. La figure 4c compare la fuite de grille mesurée I G –V GS courbes pour le 5 nm ZrOx NCFET au V DS de − 0,05 V et − 0,5 V. Par rapport à la soudaine I G gouttes d'Al2 O3 /HfO2 NCFET uniquement pendant le balayage inverse sur la figure 3c, les chutes soudaines de I G à la fois dans le balayage avant et arrière de la Fig. 4c prouvent également l'effet NC amélioré dans le ZrO amorphex filmer.
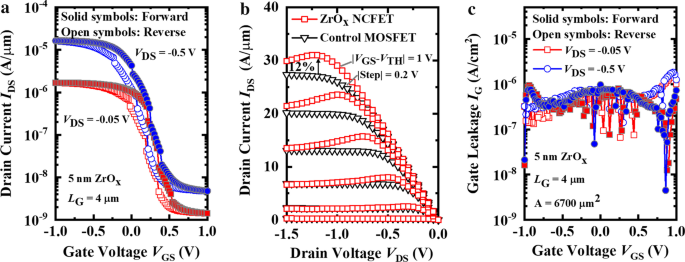
un Mesuré I DS –V GS courbes du 5 nm ZrOx NCFET lorsque V DS = − 0,5 V et V DS = − 0,05 V. b Mesuré I DS –V DS courbes du ZrOx NCFET et le MOSFET de contrôle démontrant le phénomène évident de NDR. c Mesuré I G –V GS courbes du 5 nm ZrOx NCFET lorsque V DS = − 0,5 V et V DS = − 0,05 V
La figure 5a, b montre le point SS en fonction de I DS pour l'Al2 O3 /HfO2 et ZrOx NCFET au V DS de − 0,05 V et − 0,5 V. Comme le montre la Fig. 5b, une oscillation sous-seuil (SS) inférieure à 60 mV/décade peut être atteinte pendant le balayage avant ou arrière de V GS au V DS de− 0,05 V et− 0,5 V. Lorsque V DS is− 0,05 V, un point avant SS de 45,1 mV/déc et un point inverse SS de 55,2 mV/déc ont été atteints. Quand V DS is− 0,5 V, un point avant SS de 51,16 mV/déc et un point arrière SS de 46,52 mV/déc ont été atteints. En raison de la capacité différente d'effet de balayage pour l'Al2 O3 /HfO2 et ZrOx couche, la commutation partielle des dipôles est provoquée dans l'Al2 O3 /HfO2 NCFET. Par conséquent, l'effet NC le plus évident avec un SS inférieur à 60 mV/décade est obtenu en 5 nm ZrOx NCFET.
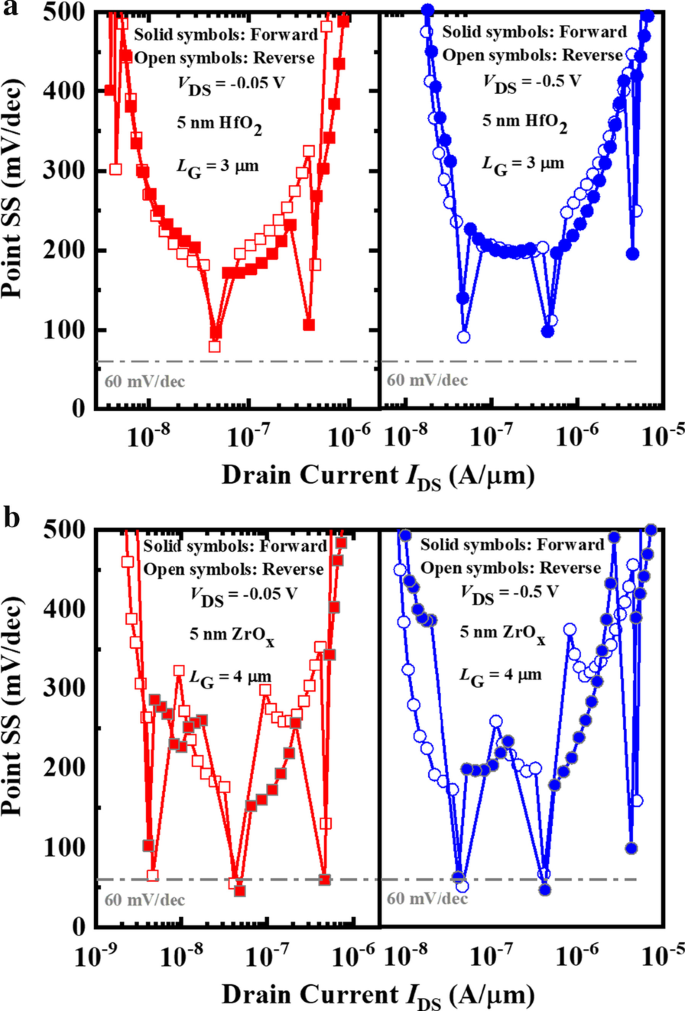
Point SS en fonction de I DS pour le a Al2 O3 /5 nm HfO2 NCFET et b 5 nm ZrOx NCFET
Conclusions
Nous rapportons la démonstration du ferroélectrique NC ZrOx pFET avec un SS inférieur à 60 mV/décade, une faible tension de fonctionnement de 1 V et une hystérésis inférieure à 60 mV. L'impact du ZrOx amorphe films sur le comportement ferroélectrique s'explique par les dipôles à lacunes d'oxygène. Le I amélioré DS et le phénomène NDR sont également obtenus dans Al2 O3 /HfO2 NCFET et ZrOx NCFET par rapport au dispositif de contrôle. L'effet NC supprimé de l'Al2 O3 /HfO2 Le NCFET peut être attribué à une commutation partielle des dipôles due aux dipôles interfiques au niveau de l'Al2 O3 /HfO2 interface. Le ZrOx Les NCFET avec une pente raide inférieure à 60 mV/décennie, une tension de drain améliorée et une faible tension de fonctionnement ouvrent une nouvelle voie pour la conception future de NCFET à faible consommation d'énergie.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de cet article sont inclus dans l'article.
Abréviations
- TaN :
-
Nitrure de tantale
- ZrOx :
-
Dioxyde de zirconium
- TDMAZr :
-
Tétrakis (diméthylamido) zirconium
- P r :
-
Polarisation résiduelle
- E c :
-
Champ électrique coercitif
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- Voir :
-
Germanium
- ALD :
-
Dépôt de couche atomique
- B + :
-
Ion bore
- Al2 O3 :
-
Oxyde d'aluminium
- HRTEM :
-
Microscope électronique à transmission haute résolution
- Non :
-
Nickel
- RTA :
-
Recuit thermique remboursé
- Je DS :
-
Courant de vidange
- V GS :
-
Tension de grille
- V TH :
-
Tension de seuil
- NCFET :
-
Transistor à effet de champ à capacité négative
Nanomatériaux
- Le transistor à effet de champ à jonction (JFET) en tant que commutateur
- Matériaux :Mousse EPP avec propriétés de surface améliorées et comportement de remplissage optimisé
- Transistors multicouches à effet de champ SnSe Nanoflake avec contacts Au Ohmic à faible résistance
- Comportement de frittage d'un SiC fritté par plasma d'étincelle avec des nanoparticules composites Si-SiC préparées par un procédé plasma thermique à courant continu
- Aérogel de graphène/polyaniline avec superélasticité et haute capacité en tant qu'électrode de supercondensateur hautement tolérante à la compression
- Transistors à effet de champ ferroélectrique à base de motifs à rayures micrométriques à dominance de nanotubes de carbone à simple paroi avec couche de contrôle des défauts HfO2
- Performances analogiques/RF du transistor à effet de champ à tunnel double source T-Shape Gate
- Transistor à canal à vide nanométrique à base de graphène
- Capacité de tournage haute performance avec faible encombrement



