Transistors ferroélectriques à effet de champ ZrO2 activés par les dipôles à vide d'oxygène commutable
Résumé
Cet article étudie les impacts du recuit thermique post-rapide (RTA) et l'épaisseur de ZrO2 sur la polarisation P et caractéristiques électriques de TaN/ZrO2 Condensateurs /Ge et FeFET, respectivement. Après le RTA allant de 350 à 500 °C, TaN/ZrO2 Condensateurs /Ge avec ZrO2 amorphe 2,5 et 4 nm d'épaisseur exposition de films l'écurie P . Il est proposé que le comportement ferroélectrique provient de la migration des dipôles commandés en tension formés par les lacunes d'oxygène et les charges négatives. FeFET avec 2,5 nm, 4 nm et 9 nm ZrO2 démontrer la fenêtre de mémoire décente (MW) avec des impulsions de programme/effacement de 100 ns. Un ZrO2 de 4 nm d'épaisseur FeFET a considérablement amélioré les caractéristiques de fatigue et de rétention par rapport aux appareils avec 2,5 nm et 9 nm ZrO2 . Les performances de rétention du ZrO2 Le FeFET peut être amélioré avec l'augmentation de la température du RTA. Un MW de ~0,46 V est extrapolé pour être maintenu sur 10 ans pour l'appareil avec 4 nm ZrO2 .
Contexte
Poly-HfO dopé2 Les transistors ferroélectriques à effet de champ (FeFET) ont suscité un intérêt considérable dans les applications de mémoire non volatile (NVM) en raison de leur compatibilité avec les processus CMOS [1]. Bien que les performances électriques décentes aient été démontrées dans le HfO2 dopé à base de FeFET [2], certaines limitations fondamentales entravent encore leurs applications pratiques, notamment le budget thermique élevé du recuit de 500 °C requis pour former des phases cristallines orthorhombiques et le courant de fuite indésirable le long des joints de grains avec la réduction de l'épaisseur ferroélectrique. La ferroélectricité a été largement observée dans une variété de matériaux différents, par exemple, Sb2 S3 nanofils [3], GaFeO3 film [4], LaAlO3 -SrTiO3 film [5], et Al2 amorphe O3 contenant des nanocristaux [6, 7]. Récemment, nous avons signalé les FeFET avec du ZrO2 partiellement cristallisé isolant de porte fonctionnant comme NVM et synapse analogique [8]. Bien que le ZrO2 les transistors ont présenté des performances électriques décentes avec une épaisseur plus fine par rapport au HfO dopé signalé 2 , le mécanisme sous-jacent de la ferroélectricité dans ZrO2 le film reste flou. Il est essentiel et important d'élucider l'origine de la polarisation commutable P pour évaluer la limite de performance de ZrO2 FeFET.
Dans ce travail, TaN/ZrO2 Des FeFET /Ge avec des isolants de 2,5 nm, 4 nm et 9 nm d'épaisseur sont fabriqués. Le P commutable en TaN/ZrO2 Il est proposé que le condensateur /Ge provienne de la migration des lacunes d'oxygène et des charges négatives entraînées par la tension. Les impacts du ZrO2 épaisseur et le recuit thermique post-rapide (RTA) sur le P de TaN/ZrO2 /Ge et les caractéristiques de fenêtre de mémoire (MW), d'endurance et de rétention des FeFET sont étudiées.
Méthodes
FeFET avec ZrO2 l'isolateur de grille ont été fabriqués sur 4 pouces. Substrat n-Ge(001) en utilisant un processus similaire dans [8, 9]. Après le nettoyage de pré-grille dans la solution diluée de HF (1:50), les plaquettes de Ge ont été chargées dans une chambre de dépôt de couche atomique (ALD). ZrO2 des films d'épaisseur 2,5 nm, 4 nm et 9 nm ont été déposés à 250 °C en utilisant TDMAZr et H2 O comme précurseurs de Zr et O, respectivement. Une électrode de grille TaN de 100 nm d'épaisseur a été déposée par pulvérisation cathodique réactive. Après la formation de l'électrode de grille, les régions source/drain (S/D) ont été implantées par BF2 + à la dose de 1 × 10 15 cm −2 et une énergie de 20 keV. Au total, des contacts S/D en nickel (Ni) de 15 nm ont été formés par un processus de décollement. Enfin, le RTA à 350, 450 et 500 °C pendant 30 s a été réalisé.
La figure 1a montre le schéma du transistor fabriqué. La figure 1b–d montre les images au microscope électronique à transmission (MET) du TaN/ZrO2 /Ge échantillons avec 2,5, 4 et 9 nm d'épaisseur ZrO2 , respectivement. Tous les échantillons ont subi un RTA à 500 °C pendant 30 s. Le 2.5 nm ZrO2 l'échantillon reste un film isolant après le recuit. Pour l'échantillon de 4 nm, bien que quelques nanocristaux soient observés, ZrO2 reste une couche amorphe. Alors que la cristallisation complète se produit pour le 9 nm ZrO2 film. Notamment, une couche interfaciale (IL) de GeOx existe entre le ZrO2 et la région du canal Ge, bien qu'elle soit trop mince pour être observée dans les images MET.
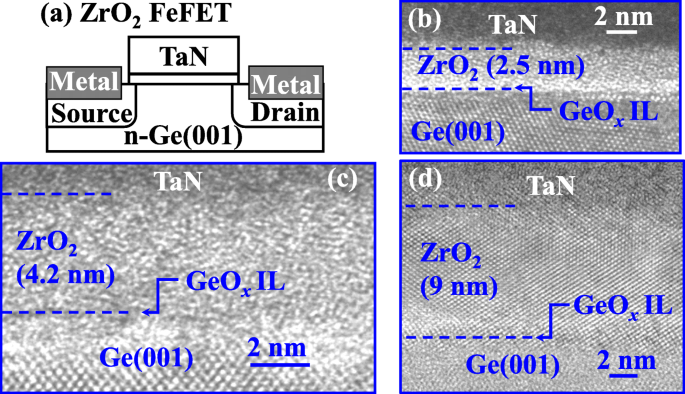
un Schéma du TaN/ZrO2 fabriqué /Ge FeFET. b , c , et d Images HRTEM du TaN/ZrO2 /Ge stacks avec différents ZrO2 épaisseurs. Les échantillons ont subi un RTA à 500 °C pendant 30 s
Résultats et discussion
La figure 2 montre le P en fonction de la tension (V ) pour les courbes TaN/ZrO2 Condensateurs /Ge avec différents ZrO2 épaisseurs et différentes températures de recuit. Les lignes pleines de différentes couleurs représentent les boucles mineures avec diverses plages de tension de balayage (V plage ). La fréquence de mesure est de 1 kHz. Les 2,5 nm et 4 nm ZrO2 les appareils peuvent présenter une ferroélectricité stable après un RTA à 350 °C. La figure 3 trace le P restant (P r ) en fonction du V de balayage courbes de gamme pour les condensateurs recuits à différentes températures.

P mesuré contre V caractéristiques du TaN/ZrO2 Condensateurs /Ge avec différents ZrO2 épaisseurs et différentes températures de recuit
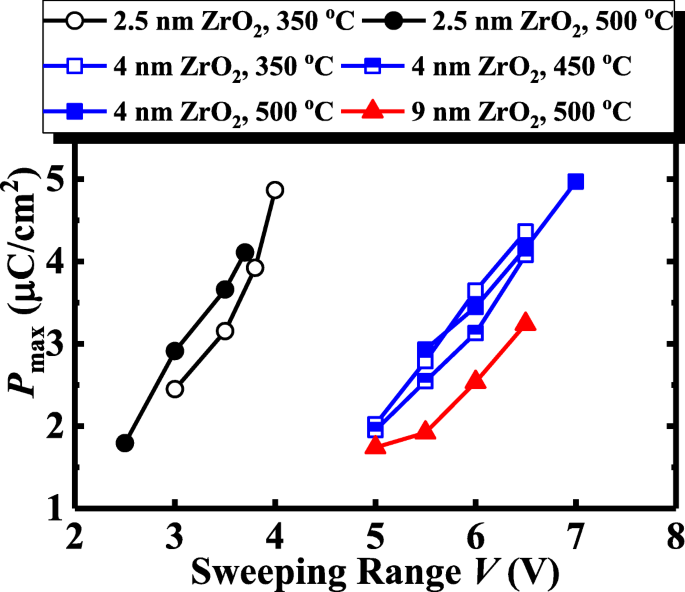
Comparaison de P max en fonction de V plage pour le TaN/ZrO2 Condensateurs /Ge avec différents ZrO2 épaisseurs et différentes températures de recuit
La figure 3 montre la comparaison de P max en fonction de V plage pour le TaN/ZrO2 Condensateurs /Ge avec les différents ZrO2 épaisseurs et les différentes températures RTA. Pour le 4 nm ZrO2 appareils, lorsque la température de recuit augmente de 350 à 450 °C, un V plus grand plage est nécessaire pour obtenir un P fixe max . Ceci est attribué au fait que la température de recuit plus élevée produit des couches interfaciales (IL) plus épaisses entre à Ge/ZrO2 et ZrO2 /TaN, conduisant à une plus grande épaisseur équivalente de capacité unifiée (CET). Pour le 2.5 nm ZrO2 condensateurs, l'échantillon avec un recuit de 500 °C a un V inférieur plage que l'échantillon de recuit à 350 °C avec le même P max . Bien que les IL s'épaississent avec l'augmentation de la température du RTA, certains ZrO2 a été consommée par le piégeage de l'oxygène et l'interdiffusion à l'interface. Pour le très fin ZrO2 dispositif, ce dernier est dominant. Par rapport au 2.5 nm ZrO2 condensateur, un V beaucoup plus grand plage est nécessaire pour obtenir un P similaire max . Cependant, le 9 nm ZrO2 le condensateur ne présente pas le V le plus élevé plage en comparaison avec l'appareil 4 nm. Ceci est dû au cristal ZrO2 qui a un κ beaucoup plus élevé valeur que le film amorphe, ce qui réduit considérablement le CET du dispositif 9 nm.
La figure 4a montre l'évolution extraite des P positifs et négatifs r , noté \( {P}_{\mathrm{r}}^{+} \)et \( {P}_{\mathrm{r}}^{-} \), respectivement, pour le 4 nm- épais ZrO2 condensateurs avec RTA à différentes températures sur 10 6 cycles de balayage mesurés à 1 kHz. Les appareils recuits à 350 °C et 450 °C présentent un effet de réveil évident. Aucun réveil ni empreinte n'est observé pour le 4 nm ZrO2 condensateur ferroélectrique a subi un recuit à 500 ° C. La figure 4b compare le P r en fonction des cycles de balayage pour les appareils avec les différents ZrO2 épaisseurs. Le 4 nm ZrO2 le condensateur ferroélectrique permet d'améliorer la stabilité de P r endurance par rapport aux appareils 2.5 nm et 9 nm pendant les 10 6 épreuve d'endurance.

un P r par rapport au nombre de cycles de balayage d'impulsions en ms pour 4 nm ZrO2 condensateurs avec différentes températures RTA. b P r par rapport au nombre de cycles de balayage d'impulsions en ms pour le ZrO2 condensateurs après recuit à 500 °C
La commutation P est observé dans ZrO2 amorphe capacité, et on en déduit que le mécanisme doit être différent de celui du poly-HfO dopé rapporté2 films ferroélectriques. Nous proposons que le mécanisme sous-jacent du comportement ferroélectrique est lié aux dipôles de la lacune d'oxygène. Il est bien connu que, à mesure que le métal TaN se dépose, les couches de piégeur d'oxygène de Ta augmenteront la concentration d'oxygène manquant à l'intérieur de ZrO2 [dix]. Des lacunes en oxygène apparaissent également au niveau du ZrO2 /Ge interface. La figure 5 montre les schémas du P commutable en TaN/ZrO2 /Ge provenant de la migration des lacunes d'oxygène et des charges négatives pour former les dipôles positifs et négatifs. Il est supposé que les charges négatives dans ZrO2 sont liés à la vacance Zr [11], qui est similaire à celles de Al2 O3 cinéma [12]. La migration des lacunes d'oxygène induites par la tension a été largement démontrée dans les dispositifs de mémoire vive résistive [13, 14]. Il s'agit notamment de la première démonstration de transistors non volatils à trois bornes dominés par les lacunes d'oxygène commandées par la tension.
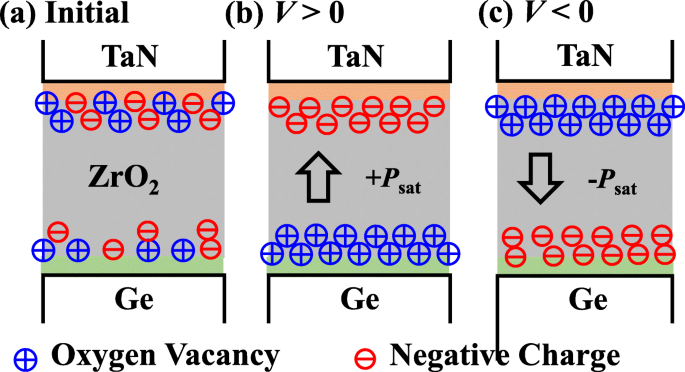
Schémas du mécanisme pour P commutable en ZrO2 condensateurs, ce qui est attribué à la migration des lacunes d'oxygène et des charges négatives entraînées par la tension pour former des dipôles
Le P-V l'hystérésis active le ZrO2 FeFETs pour obtenir un MW important et stable pour les applications NVM embarquées (eNVM). La figure 6 montre le I mesuré DS -V GS courbes de 2,5, 4 et 9 nm ZrO2 FeFET pour les deux états de polarisation avec des conditions de programmation/effacement (P/E) de 1 µs. Les transistors ont été recuits à 500 °C. L'opération de programme (effacement) est obtenue en appliquant des impulsions de tension positives (négatives) à la grille du ZrO2 FeFET, pour augmenter (baisser) sa tension de seuil (V TH ). V TH est défini comme V GS à 100 nA·W/L, et MW est défini comme la variation maximale de V TH . Tous les FeFET avec divers ZrO2 les épaisseurs ont un MW supérieur à 1 V avec des impulsions P/E de 1 μs. Pour atteindre un MW similaire, une tension d'effacement plus élevée est nécessaire pour le 9 nm ZrO2 FeFET par rapport aux deux autres transistors. On voit qu'une plus grande magnitude efface V GS est nécessaire pour obtenir le décalage à peu près égal de I-V par rapport à la courbe initiale par rapport au programme V GS . Il est supposé que les lacunes d'oxygène contribuant au P proviennent principalement de la réaction entre TaN et ZrO2 , comme l'état initial du dispositif sur la figure 5a. En tant que V positif GS (programme) est appliqué, les lacunes d'oxygène diffusent et s'accumulent dans la couche proche du ZrO2 /Ge (Fig. 5b), où la distribution des dipôles de lacunes d'oxygène est assez différente de l'état initial. Il est donc facile de déplacer le I-V courbe vers un |V plus élevé TH | avec un V positif GS . Cependant, en tant que V négatif GS (effacement) est appliqué, la rétrodiffusion des lacunes d'oxygène ramène l'empilement de grilles à son état d'origine (Fig. 5c). Donc l'amplitude du négatif efface V GS doit être augmenté pour obtenir le décalage équivalent de I-V au programme positif V GS .
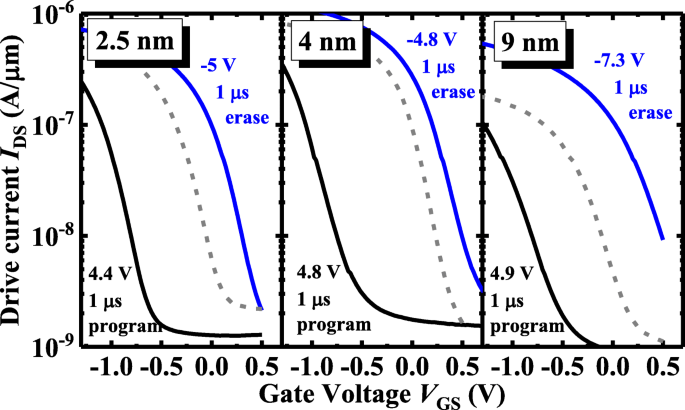
Mesuré I DS -V GS courbes du ZrO2 de 2,5, 4 et 9 nm d'épaisseur FeFET pour l'état initial et les deux états de polarisation avec des impulsions P/E de 1 s
Comme la largeur d'impulsion P/E est réduite à 100 ns, le ZrO2 Les FeFET démontrent toujours un MW décent, comme le montre la figure 7a. Surtout, le transistor avec 2.5 nm ZrO2 recuit à 350 ° C atteint un MW de 0,28 V. La figure 7b trace le MW en fonction du nombre de cycles pour les FeFET avec divers ZrO2 épaisseurs avec une condition d'impulsion P/E de 100 ns. Le 4 nm ZrO2 l'appareil atteint des performances d'endurance considérablement améliorées par rapport aux 2,5 nm et 9 nm ZrO2 FeFET, qui présentent un effet de réveil et une fatigue évidents dans les 10 3 cycles.
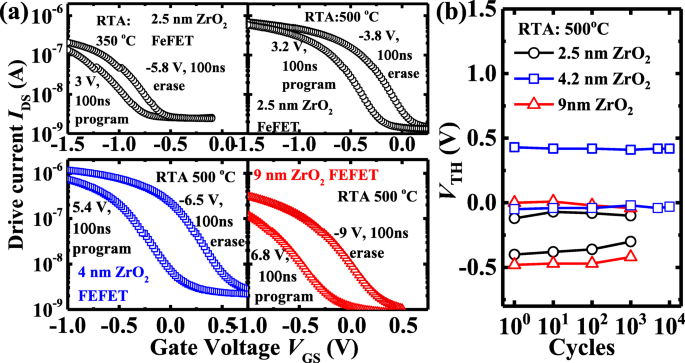
un Je DS -V GS courbes du ZrO2 de 2,5, 4 et 9 nm d'épaisseur FeFET pour les deux états de polarisation avec des impulsions P/E de 100 ns. Les appareils ont subi une RTA à 500 °C. b FeFET avec 4 nm ZrO2 a une endurance améliorée par rapport aux 2,5 et 9 nm ZrO2 transistors
Enfin, le test de rétention du ZrO2 Les FeFET sont caractérisés et représentés sur les Fig. 8 et 9. La figure 8a montre l'évolution de I DS -V GS courbes pour les deux états de polarisation du 4 nm ZrO2 Les FeFET ont subi une RTA à 350, 450 et 500 °C. Le piégeage des charges conduit à la réduction des appareils avec le temps. Comme le montre la figure 8b, les performances de rétention des dispositifs peuvent être améliorées avec l'augmentation de la température RTA. Un MW de ~ 0,46 V est extrapolé pour être maintenu sur 10 ans. La figure 9 compare les caractéristiques de rétention des FeFET avec différents ZrO2 épaisseurs. Le 4 nm ZrO2 l'appareil a une performance de rétention améliorée par rapport aux transistors avec 2,5 et 9 nm d'épaisseur ZrO2 .
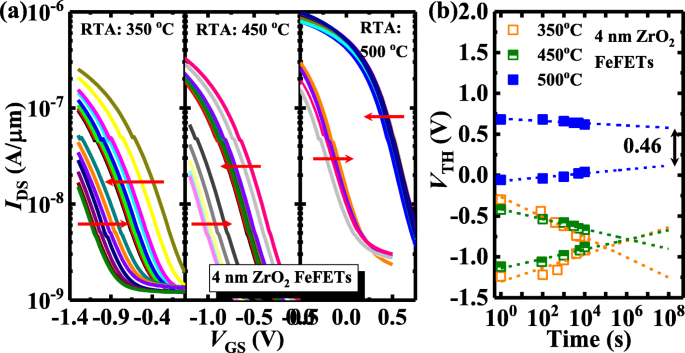
un L'évolution de I DS -V GS courbes pour les deux états de polarisation du 4 nm ZrO2 FeFET avec différentes températures RTA. b Le 4 nm ZrO2 le dispositif recuit à 500 °C a une bien meilleure performance de rétention par rapport aux transistors avec RTA aux températures plus basses
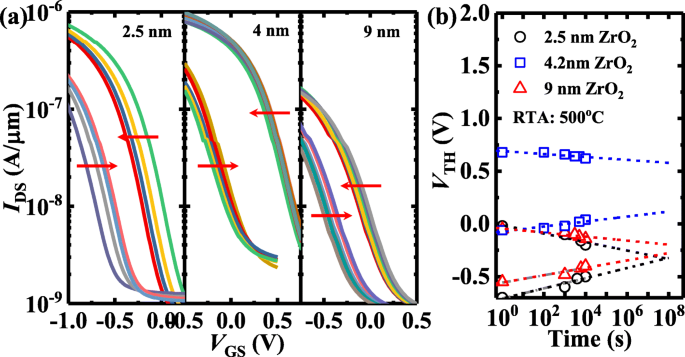
un L'évolution de I DS -V GS courbes pour les deux états de polarisation pour le ZrO2 de 2,5, 4 et 9 nm d'épaisseur Les FeFET ont subi un RTA à 500 °C. b Le 4 nm ZrO2 l'appareil a une performance de rétention améliorée par rapport aux transistors avec 2,5 et 9 nm d'épaisseur ZrO2
Conclusions
En résumé, amorphe ZrO2 des condensateurs ferroélectriques sont démontrés expérimentalement, et la ferroélectricité est supposée être due à la migration des dipôles commandés en tension formés par les lacunes d'oxygène et les charges négatives. FeFET avec 2,5 nm, 4 nm et 9 nm ZrO2 avoir le MW au-dessus de 1 V avec des impulsions P/E de 1 μs. Les caractéristiques de fatigue et de rétention améliorées sont obtenues dans le ZrO2 de 4 nm d'épaisseur FeFET en comparaison avec les appareils avec 2,5 nm et 9 nm ZrO2 . Le test de rétention indique que le 4 nm ZrO2 le transistor conserve un MW extrapolé sur 10 ans de ~ 0,46 V.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de cet article sont inclus dans l'article.
Abréviations
- RTA :
-
Recuit thermique rapide
- IL :
-
Couche interfaciale
- TaN :
-
Nitrure de tantale
- FeFET :
-
Transistors ferroélectriques à effet de champ
- TDMAZr :
-
Tétrakis (diméthylamido) zirconium
- Voir :
-
Germanium
- ZrO2 :
-
Dioxyde de zirconium
- ALD :
-
Dépôt de couche atomique
- HF :
-
Acide fluorhydrique
- BF2 + :
-
Ion fluorure de bore
- MW :
-
Fenêtre mémoire
- NVM :
-
Mémoire non volatile
- P r :
-
Polarisation résiduelle
- TEM :
-
Microscope électronique à transmission
- Non :
-
Nickel
- P max :
-
Polarisation maximale
- RTA :
-
Recuit thermique remboursé
- V plage :
-
Plage de tension de balayage
Nanomatériaux
- DDS activé par le Web, l'IoT et le cloud
- Transistors, jonction effet de champ (JFET)
- Transistors, effet de champ à grille isolée (IGFET ou MOSFET)
- Transistors à effet de champ de jonction
- Transistors à effet de champ à grille isolée (MOSFET)
- Introduction aux transistors à effet de champ à jonction (JFET)
- Introduction aux transistors à effet de champ à grille isolée
- Adaptation de la toxicité des espèces réactives à l'oxygène à la thérapie tumorale avancée
- Les avantages de la génération d'oxygène sur site



