Développement d'un miroir absorbant saturable à points quantiques InAs/GaAs à 1550 nm avec une structure de coiffage à super-réseau à courte période vers des applications de laser à fibre femtoseconde
Résumé
Les points quantiques (QD) III-V InAs/GaAs de faible dimension ont été appliqués avec succès à des miroirs à absorbeur saturable à semi-conducteurs (SESAM) fonctionnant dans une plage de longueurs d'onde de 900 à 1310 nm pour des applications laser pulsées ultrarapides bénéficiant de leur large bande passante, flexibilité de longueur d'onde, et une faible fluence de saturation. Cependant, il est très difficile d'obtenir un QD-SESAM haute performance fonctionnant dans la gamme de longueurs d'onde plus longue autour de 1550 nm en raison de l'énorme obstacle à la croissance par épitaxie des structures QD. Dans ce travail, pour la première fois, il est révélé que, le système InAs/GaAs QD conçu pour la gamme d'émission lumineuse de 1550 nm, le très faible processus de relaxation des porteurs des couches de recouvrement (CLs) aux QDs est principalement responsable de la de faibles performances d'émission, selon lesquelles nous avons développé un super-réseau à courte période (In0.20 Ga0,80 As/In0.30 Ga0,70 Comme)5 comme CL pour les QD et a réalisé une émission ~ 10 fois plus forte à 1550 nm par rapport au CL InGaAs conventionnel. Sur la base de la structure QD développée, des QD-SESAM hautes performances ont été obtenus avec succès, présentant une très faible intensité de saturation de 13,7 MW/cm 2 et une grande profondeur de modulation non linéaire de 1,6 %, simultanément, ce qui permet la construction d'un laser à fibre à verrouillage de mode femtoseconde de 1550 nm avec une excellente stabilité de fonctionnement à long terme.
Introduction
Les lasers femtoseconde à verrouillage de mode à 1550 nm ont de larges applications dans les communications optiques, l'optique ultrarapide et l'optique non linéaire en raison de leur puissance de crête élevée, de leur faible effet thermique et de leur énergie d'impulsion élevée [1,2,3,4,5] . L'absorbeur saturable (SA) avec la large bande passante optique, le temps de réponse rapide et les propriétés de faible perte sont le composant optique critique pour de tels lasers pulsés ultracourts [6,7,8,9]. De plus, un seuil de dommage élevé du SA est hautement souhaitable pour un fonctionnement stable à long terme d'un laser à mode verrouillé [10,11,12,13]. Récemment, les matériaux bidimensionnels (2D) tels que le graphène, les isolants topologiques, le phosphore noir et les dichalcogénures de métaux de transition ont attiré beaucoup d'attention pour leur application en tant que SA pour les lasers femtosecondes à mode verrouillé [14,15,16,17,18, 19,20,21]. Cependant, leur seuil d'endommagement bas et leur faible stabilité de travail ont gravement entravé leurs larges applications [22, 23]. Les SESAM basés sur des puits quantiques (QW) sont considérés comme un candidat commercial pour les lasers ultrarapides à verrouillage de mode en raison de leur haute répétabilité et de leur excellente stabilité de fonctionnement, mais les bandes passantes de fonctionnement étroites et la faible profondeur de modulation restent les énormes obstacles à la réalisation de l'ultracourt femtoseconde. impulsions [24].
Récemment, dotés d'une bande passante de fonctionnement de carte et d'un temps de récupération de porteuse rapide [25,26,27,28,29,30,31], les points quantiques InAs auto-assemblés (QD) développés via le mode Stranski-Krastanow sont apparus comme un excellent choix pour que les SESAM construisent des lasers pulsés à mode verrouillé. Pour atteindre la longueur d'onde de travail autour de 1550 nm, des QW InGaAsP à base d'InP sont généralement utilisés. Les bandes interdites des QD InGaAs à base de GaAs peuvent généralement être conçues pour couvrir la gamme spectrale de 980 à 1310 nm, et une longueur d'onde plus longue au-delà de 1310 nm nécessite une teneur en indium beaucoup plus élevée dans les couches de recouvrement QD (CL). Des alliages quaternaires InGaAsSb (InGaNAs) et des InGaAs CL à très haute teneur en In (> 30 %) ont été utilisés pour concevoir la bande interdite QD vers la grande longueur d'onde de 1550 nm [32, 33]. Cependant, les CL en alliage quaternaire compliquent considérablement le processus de croissance épitaxiale, et la teneur élevée en In dans les CL en InGaAs dégrade la qualité cristalline et optique des QD, ce qui introduit davantage de centres de recombinaison non radiatifs. L'émission à 1550 nm a été obtenue avec des QD InAs/GaAs cultivés sur des substrats métamorphiques, mais une fiabilité et une répétabilité médiocres restent les problèmes graves pour une telle technique [34]. Dans nos travaux précédents, les QD asymétriques InAs/GaAs fonctionnant à 1550 nm ont été fabriqués, grâce auxquels un oscillateur en verre dopé Er à verrouillage de mode a été réalisé avec une largeur d'impulsion de 2 ps [24]. Et récemment, un QD-SESAM de 1550 nm avec une structure InAs/GaAs coiffée d'InGaAs a été fabriqué, avec lequel un laser à fibre dopée à l'erbium (EDF) à commutation Q passive à double longueur d'onde a été réalisé [35]. Cependant, les performances des lasers obtenus étaient limitées en raison de la faible profondeur de modulation de 0,4% de ces QD-SESAM. Par conséquent, il est hautement souhaitable d'explorer de nouvelles techniques pour optimiser les structures QD InAs/GaAs à 1550 nm dans le but d'améliorer la profondeur de modulation de ces QD-SESAM.
Dans ce travail, nous avons développé différentes structures QD InAs/GaAs conçues pour les SESAM fonctionnant dans une plage de 1550 nm, avec des CL en alliage InGaAs et des CL de superréseau à courte période (SSL) InGaAs, respectivement, et avons étudié en profondeur leurs propriétés optiques. La caractérisation par spectroscopie de photoluminescence (PL) révèle une très faible émission lumineuse à température ambiante (RT) à la longueur d'onde d'environ 1550 nm, qui ne peut être observée à une température inférieure à 250 K. Ce phénomène contraste remarquablement avec le phénomène bien connu dépendant de la température. comportements des systèmes QD, à savoir, l'intensité PL est plus forte à des températures plus basses, ce qui devient très faible ou même non observable à RT en raison de l'excitation thermique des porteurs confinés dans les QD. Les phénomènes anormaux observés dans les QD InAs/GaAs à 1550 nm peuvent être attribués au processus de relaxation des porteurs faibles de CL aux QD, qui peut être considérablement réduit en développant une CL SSL pour les QD. Les structures SSL fournissent des modes de phonons abondants de grandes densités vibrationnelles d'états, qui stimulent efficacement la relaxation des porteurs des CL aux QD. Par conséquent, une émission à 1550 nm 10 fois plus forte que les QD non plafonnés SSL est observée. La dynamique de support supérieure dans les QD de 1550 nm confère aux QD-SESAM des performances d'absorption hautement saturables, se manifestant par une très faible intensité de saturation de 13,7 MW/cm 2 et une plus grande profondeur de modulation non linéaire de 1,6 %, soit 4 fois la valeur rapportée dans [24, 35]. Bénéficiant des performances élevées du QD-SESAM avec SSL CL, nous avons construit avec succès un laser EDF et obtenu le laser à verrouillage de mode stable à 1556 nm, avec une durée d'impulsion de 920 fs.
Méthodes
Croissance MBE des QD InAs/GaAs
Trois structures QD InAs/GaAs ont été développées avec la technique d'épitaxie par faisceau moléculaire (MBE). Tous les échantillons contiennent trois périodes de couches de points, dont chacune est auto-assemblée à partir de 2,9 monocouches (ML) d'InAs. Comme le montre la figure 1, dans les échantillons 1 et 2, les QD d'InAs ont été cultivés sur GaAs et un In0,18 1 nm Ga0.82 En tant que couche tampon (BL), respectivement, et tous coiffés d'un In0.33 de 6 nm d'épaisseur Ga0.67 Comme couche. Pour l'échantillon 3, les QD InAs de 2,9 ML ont également été cultivés sur un In0,18 d'1 nm d'épaisseur Ga0.82 Comme BL mais plafonné avec un SSL de 10 nm d'épaisseur composé de 5 périodes de In0.20 Ga0,80 As (1 nm) et In0.30 Ga0,70 Sous forme de couches (1 nm). La température de croissance et le taux de croissance des QD d'InAs étaient respectivement de 510 °C et de 0,01 ML/s. Les QD-SESAM ont été fabriqués en faisant croître une structure de couche de points sur un réflecteur de Bragg distribué inférieur (DBR) qui contient 31 paires de GaAs non dopé (115 nm) et Al0.98 Ga0,02 Sous forme de couches (134 nm). Les températures de croissance pour GaAs et InGaAs étaient respectivement de 565 et 530 °C.
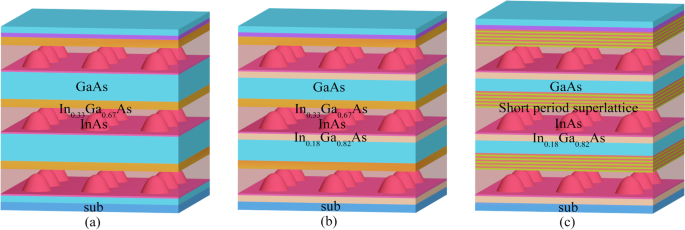
Diagrammes schématiques des structures QD. Diagrammes schématiques de trois structures de test de a échantillon 1, b échantillon 2, et c échantillon 3, respectivement
Méthodes de caractérisation
Les mesures de PL ont été effectuées à des températures variées allant de 11 à 300 K avec un laser à solide de 532 nm. Les structures cristallographiques de ces échantillons QD ont été caractérisées par diffraction des rayons X à haute résolution en utilisant la raie d'émission Cu Kα. Les morphologies des structures QD ont été examinées avec la technique du microscope à force atomique (AFM) dans des conditions ambiantes en mode sans contact sur un Nanoscope Dimension TM Système AFM 3100 SPM. Des images de microscopie électronique à transmission (MET) ont été obtenues sur un microscope JEOL-2010 de 200 keV.
Résultats et discussion
Les figures 2a, b et c présentent les spectres PL dépendant de la température des échantillons 1, 2 et 3, respectivement, acquis à des températures allant de 11 à 300 K avec une puissance d'excitation de 200 mW. Il révèle deux pics PL caractéristiques, un pic étroit situé dans la région de courte longueur d'onde et un large à la longue longueur d'onde. Le pic étroit positionné à environ 1170 nm à 11 K et environ 1280 nm à 300 K provient de la luminescence des CL, tandis que le pic large à environ 1550 nm à 300 K est attribué à l'émission QD. Comme le montre la Fig. 2a, aux températures les plus basses, seule l'émission CL peut être observée, et l'émission à environ 1550 nm des QD InAs commence à apparaître lorsque la température augmente jusqu'à 250 K et devient progressivement plus forte avec une température encore plus élevée. . Le comportement similaire est également observé avec l'échantillon 2, comme le montre la figure 2b. Généralement, pour les structures QD InAs/GaAs conçues pour une émission de longueur d'onde plus courte (par exemple, 1300 nm), l'émission des QD domine les spectres PL à basse température, et l'émission des CL ou des couches de mouillage peut difficilement être observée. Cela est dû aux niveaux d'énergie inférieurs des structures QD et à la réduction des fuites thermiques des porteurs des QD à basse température [36]. Avec l'augmentation de la température, l'intensité d'émission des QD diminue progressivement en raison de l'échappement thermique accru des porteurs des QD. Contrairement aux QD InAs/GaAs conçus pour les applications à 1310 nm, nos échantillons pour 1550 nm présentent des comportements d'émission de lumière dépendants de la température complètement opposés, indiquant une dynamique de porteur distinguée dans ce nouveau système QD. Comme le montre la Fig. 2e, la bande interdite des QD est beaucoup plus étroite que celle des CL et les niveaux d'énergie les plus bas pour les électrons et les trous sont tous dans la structure QD, et il est donc prévu que les porteurs photo-générés peuvent de préférence résider dans les QD après avoir relâché leurs énergies excessives. Cependant, le résultat PL observé est que l'émission CL domine le PL et l'émission QD est invisible à la température inférieure à 250 K, ce qui révèle qu'à basse température, les porteurs photo-générés sont majoritairement confinés dans les CL plutôt que dans les QD. Ce fait peut s'expliquer par les effets de blocage sévère de la relaxation des porteuses du fait qu'il y a trop peu de phonons participant au processus de diffusion des porteuses, ce qui entraîne une faible efficacité de relaxation des porteuses des CL aux QD. Avec l'augmentation de la température, davantage de populations de phonons sont excitées thermiquement et l'interaction des phonons avec les porteurs photo-générés est progressivement améliorée, conduisant à davantage de porteurs dispersés des CL aux QD. La plus forte intensité PL de l'émission QD à 1550 nm apparaissant à RT indique que le processus de relaxation énergétique des porteurs de CL à QD domine le processus d'échappement thermique de QD à CL.

Caractérisation des matériaux et diagramme schématique des bandes. Spectres PL mesurés à 11-300 K à partir de a échantillon 1, b échantillon 2, et c échantillon 3, respectivement. d Balayages ω/2θ haute résolution montrant le pic du substrat GaAs (008) et le diagramme de diffraction CL pour les échantillons 1, 2 et 3, respectivement. Diagramme de bande schématique pour e échantillon 2 et f échantillon 3, respectivement
Les caractérisations PL des échantillons 1 et 2 révèlent que, dans le système QD InAs/GaAs conçu pour les applications à 1550 nm, une caractéristique de relaxation des porteurs inefficace existe et une plus grande densité de phonons favorise la relaxation des porteurs jusqu'aux QD. Essentiellement, le processus de relaxation des porteurs faibles est enraciné dans les structures de bandes électroniques déterminées par le CL. Les matériaux QD dans lesquels leurs décalages de bande sont beaucoup plus importants que les énergies des phonons optiques longitudinaux (LO) des CL et les porteurs des CL doivent se détendre aux niveaux QD en émettant plusieurs phonons plutôt qu'un seul. Le processus de relaxation des porteurs faibles ne peut pas être éliminé dans les QD InAs/GaAs pour 1550 nm en raison du décalage de bande beaucoup plus important dans la structure de bande CL et QD, mais nous pouvons modifier le processus de diffusion de phonons multiples en ajustant les structures de bande électroniques ainsi que les structures des bandes de phonons. Pour atteindre cet objectif d'amélioration de la relaxation des porteurs dans les QD de 1550 nm, nous avons utilisé un (In0.20 Ga0,80 As/In0.30 Ga0,70 Comme)5 Structure SSL en tant que CL pour remplacer les CL InGaAs. Les CL SSL devraient fournir plus de modes vibrationnels de phonons et des densités de phonons beaucoup plus grandes en raison des effets de repliement de la zone de Brillouin dans SSL [37]. Comme le montre la figure 1c, l'échantillon 3 a été cultivé avec la même structure que l'échantillon 2, à l'exception de l'utilisation de cinq périodes de 10 nm d'épaisseur In0,20 Ga0,80 As/In0.30 Ga0,70 Comme les SSL comme les CL. La figure 2d montre les diagrammes XRD obtenus pour les échantillons 1, 2 et 3. Tous les échantillons présentent un fort pic à 66,1 °, qui peut être attribué à la diffraction des plans (008) de GaAs cubique. Effacer les pics satellites résultant de l'In0,33 de 6 nm d'épaisseur Ga0.67 Comme la structure CL est observée à environ 64,0° pour les échantillons 1 et 2. Une inspection plus approfondie révèle que In0,20 Ga0,80 As/In0.30 Ga0,70 Comme SSL dans l'échantillon 3 présente un pic satellite à environ 64,4°, et le décalage vers des degrés plus grands par rapport à celui de In0.33 Ga0.67 Comme CLs suggère une diminution de la teneur moyenne en In [38, 39]. Pour comprendre l'effet des CL SSL sur les propriétés optiques des QD InAs/GaAs, les spectres PL dépendant de la température pour l'échantillon 3 sont également mesurés, comme le montre la figure 2c. Semblable aux échantillons 1 et 2, aucune émission PL évidente à 1550 nm des QD InAs/GaAs ne peut être observée à des températures inférieures à 200 K et l'émission devient progressivement intense avec des températures plus élevées. Il convient de noter que le pic d'émission QD à 1550 nm dans l'échantillon 3 émerge à une température beaucoup plus basse de 200 K (environ 250 K pour les échantillons 1 et 2). Son intensité relative par rapport à l'émission CL à RT est beaucoup plus élevée que les échantillons 1 et 2, et son intensité PL est environ 10 fois plus forte que l'échantillon 2. Ces résultats indiquent que les CL SSL augmentent considérablement la relaxation des porteurs des CL jusqu'au QDs, résultant en une recombinaison radiative beaucoup améliorée dans les QDs. La raison responsable de la relaxation accrue des porteurs des CL aux QD réside dans les CL SSL de haute qualité avec une teneur réduite en indium. Cela module efficacement les comportements de relaxation des porteurs et améliore la capture des porteurs par les QD.
Pour mieux comprendre le processus de diffusion des porteuses facilité par plusieurs phonons, les structures de bande du système QD InAs/GaAs avec différents types de CL sont comparées. Dans un souci de simplicité, la différence d'énergie entre les bandes interdites CL et QD peut être estimée comme la différence de leurs énergies de crête PL. Comme le montrent les figures 2e et f, les différences de bande interdite dans les échantillons 2 et 3 entre les QD CL et InAs à 300 K sont déterminées à 143 et 114 meV, respectivement, selon les mesures PL. En supposant que les décalages de bande représentent environ 60 % des différences énergétiques entre les bandes de conduction de CL et de QD [40], les électrons doivent se détendre de 86 et 68 meV pour l'échantillon 2 et l'échantillon 3, respectivement, pour être diffusés à partir des niveaux d'énergie du couches de recouvrement aux niveaux d'énergie les plus bas des QD InAs. Les énergies des phonons des modes LO et acoustique longitudinal (LA) dans les alliages InGaAs sont de 34 et 9 meV [40, 41]. Pour le processus de diffusion de phonons multiples, la combinaison de 2 phonons LO dans l'échantillon 3 peut réaliser la diffusion d'un électron des CL aux QD tandis que 2 phonons LO plus 1 LO ou 2 phonons LA sont nécessaires pour l'échantillon 2. Il a été démontré que le taux de relaxation des électrons est considérablement réduit lorsque davantage de modes de phonons sont impliqués dans un processus de diffusion de phonons multiples [42,43,44,45]. Par conséquent, le taux de relaxation des électrons dans l'échantillon 3 est supérieur à celui de l'échantillon 2, ce qui explique l'intensité PL beaucoup plus élevée des QD dans l'échantillon 3. En fait, la diminution du contenu en In dans les CL SSL et l'affaiblissement de l'effet de goulot d'étranglement des phonons dans le processus de relaxation des porteurs sont les principales raisons de l'augmentation de l'intensité PL des QD dans l'échantillon 3.
Pour vérifier davantage l'effet de relaxation accru des porteurs causé par les CL SSL, des spectres PL dépendants de la puissance d'excitation ont été acquis à 300 K. Comme le montrent les figures 3a, b et c, l'intensité PL de la CL (Peak 1) et InAs Les pics QD (Peak 2) augmentent progressivement avec l'augmentation de la puissance d'excitation, et aucun décalage évident des positions de pic ne peut être observé. Il est clairement observé que l'intensité du pic 1 est beaucoup plus forte que celle du pic 2 dans les échantillons 1 et 2, comme le montrent les figures 3a et b à la puissance d'excitation la plus élevée, tandis que l'échantillon 3 présente une émission QD beaucoup plus forte dans toutes les excitations mesurées. plage de puissance. Les rapports d'intensité PL du pic 2 et du pic 1 de ces échantillons en fonction de la puissance d'excitation ont été résumés sur la figure 3d. À la puissance d'excitation de 2000 mW, les rapports d'intensité PL du pic 2 et du pic 1 sont de 0,21 et 0,29 correspondant aux échantillons 1 et 2, respectivement, comme le montre la figure 3d. Cela indique que de nombreux porteurs se recombinent dans InGaAs CL et que la relaxation des porteurs de la couche de coiffage aux QD InAs est gravement entravée en raison du taux de relaxation des porteurs inefficace. Par rapport à l'échantillon 1, le rapport d'intensité de couche du pic 2 au pic 1 dans l'échantillon 2 peut être attribué à la densité de points plus élevée obtenue par plus de centres de nucléation causée par In0.18 Ga0.82 En tant que couche tampon [24]. L'intensité du pic 2 dans l'échantillon 3 est environ 2,1 fois plus forte que celle du pic 1 à la puissance d'excitation de 2000 mW, indiquant une efficacité de relaxation des porteurs bien améliorée dans les QD InAs plafonnés SSL. De plus, on constate que bien que la teneur moyenne en In soit d'environ 25 % dans la couche de recouvrement SSL qui soit inférieure à 33 % dans les CL des échantillons 1 et 2, la longueur d'onde d'émission du pic 1 (à ~1337 nm) dans l'échantillon 3 est légèrement plus longue que celle (à ~ 1310 nm) pour les échantillons 1 et 2. Nous pensons que la principale raison responsable des résultats est l'effet de confinement quantique réduit dans la couche SSL beaucoup plus épaisse (10 nm) par rapport à la couche 6 nm Couche de coiffage InGaAs.

Mesures PL dépendantes de la puissance. Spectres PL dépendant de la puissance à température ambiante mesurés à 20–2000 mW à partir de a échantillon 1, b échantillon 2, et c échantillon 3, respectivement. d Radio d'intensité de Peak 2/Peak 1 par rapport à la puissance de pompage dans les échantillons 1, 2 et 3, respectivement.
Sur la base des bonnes propriétés optiques obtenues dans les QD InAs/GaAs plafonnés SSL, nous démontrons en outre son application en tant que QD-SESAM pour la génération d'impulsions femtosecondes. Le QD-SESAM InAs/GaAs coiffé SSL à 1550 nm se compose d'une couche de QD InAs/GaAs coiffés SSL comme couche d'absorption et d'un miroir DBR inférieur composé de 31 périodes de GaAs non dopé (115 nm) et d'Al0,98 Ga0,02 Sous forme de couches (134 nm). La structure détaillée du QD-SESAM est illustrée par l'image MET en coupe transversale, comme le montre la Fig. 4. La densité de points moyenne des QD dans la couche d'absorption est estimée à 4,4 × 10 10 cm -2 , et la hauteur moyenne et la taille latérale du point sont respectivement de 7,5 et 40 nm, comme le montre l'image AFM de la Fig. 4. Le SESAM est caractérisé par une configuration typique à double détecteur équilibré [46] et une intensité de saturation de 13,7 MW /cm 2 et une profondeur de modulation non linéaire de 1,6 % sont obtenues. Comme le montre la figure 4, avec le QD-SESAM inséré dans la cavité laser EDF, nous avons construit un laser à verrouillage de mode passif. Avec une fibre monomode standard de 23,75 m et un EDF de 0,75 m comme milieu à gain, la cavité obtenue mesure 24,5 µm de longueur. Une diode laser DFB (LD) à semi-conducteur émettant à 980 nm sert de source de pompage, et un multiplexeur par répartition en longueur d'onde (WDM) 980/1550 nm est utilisé pour coupler l'énergie de pompage dans la cavité laser à fibre. Un isolateur indépendant de la polarisation (PI-ISO) et un contrôleur de polarisation (PC) sont utilisés pour assurer respectivement la transmission unidirectionnelle de la lumière et l'optimisation de l'état de verrouillage de mode dans la cavité. Le port 1 d'un circulateur optique (CIR) 1550 nm est connecté au PC, le port 2 est lié au QD-SESAM et le port 3 de ce CIR est connecté au coupleur de sortie 10/90 (OC) (sortie 10 % et 90 % d'entrée).
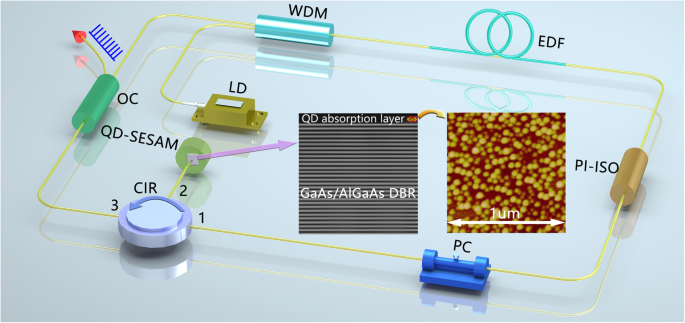
Configuration expérimentale d'un laser à fibre à verrouillage de mode avec QD-SESAM à 1550 nm. En médaillon :image MET en coupe du QD-SESAM et 1 × 1 μm 2 Image AFM des QD 1550 nm
Le comportement de verrouillage de mode peut être obtenu lorsque la puissance de la pompe est supérieure à 50 mW. Comme le montre la figure 5a, la puissance de sortie de ce laser à mode verrouillé augmente linéairement avec l'augmentation de la puissance de la pompe et l'efficacité de la pente est d'environ 4,82 % déterminée par le traitement d'ajustement linéaire. Comme présenté dans la Fig. 5b, le spectre typique du soliton conventionnel avec une bande passante de 3 dB de 3,2 nm a été observé. La longueur d'onde centrale est de 1556 nm. Le spectre RF avec un taux de répétition de 8,16 MHz est illustré à la Fig. 5c, correspondant à la longueur de cavité de 24,5 m. Le rapport signal sur bruit est d'environ 51 dB, ce qui indique le grand potentiel pour obtenir un fonctionnement de verrouillage de mode stable avec les QD-SESAM à plafonnement SSL. Des mesures de verrouillage de mode stables à long terme ont été effectuées à la puissance de pompage seuil de 50 mW, et plus d'une semaine de fonctionnement continu stable a été obtenue. La figure 5d est la trace d'autocorrélation équipée d'un profil d'ajustement gaussien, qui illustre la durée d'impulsion réelle d'environ 920 fs. A titre de comparaison, avec le QD-SESAM basé sur la structure comme dans l'échantillon 2 présentant une intensité de saturation de 15.7 MW/cm 2 et une profondeur de modulation non linéaire de 0,4 %, et le laser à mode verrouillé génère des impulsions de 2,7 µps de large [47]. La durée d'impulsion très réduite obtenue avec les QD plafonnés SSL basés sur QD-SESAM peut être attribuée à la profondeur de modulation accrue, et nous pensons que l'efficacité améliorée de relaxation des porteurs induite par les couches de coiffage SSL explique la diminution de l'intensité de saturation. De plus, cinq autres QD-SESAM plafonnés SSL ont été sélectionnés pour construire les lasers à fibre à mode verrouillé, et tous les lasers à mode verrouillé ont présenté une stabilité à long terme, par laquelle la répétabilité et la fiabilité élevées des SESAM sont démontrées.

Caractéristiques du laser à fibre à verrouillage de mode développé. un Puissance de sortie par rapport à la puissance de la pompe. b Spectres optiques de sortie. c Spectre RF du laser à fibre à mode verrouillé. d Trace d'autocorrélation
Conclusions
En conclusion, les QD InAs/GaAs conçus pour des applications à 1550 nm ont été développés par la technique MBE avec des couches d'alliage InGaAs et SSL, respectivement, comme couches de recouvrement pour les QD. Avec la caractérisation de la spectroscopie PL dépendante de la température et de la puissance, il est révélé que le décalage de la bande de conduction des structures CL et QD est modifié de 86 meV à 68 meV en changeant le In0.33 Ga0.67 Comme alliage CL à a (In0.20 Ga0,80 As/In0.30 Ga0,70 Comme)5 SSL CL, et une diffusion plus efficace des porteurs impliquant plusieurs phonons est donc obtenue, ce qui conduit à une recombinaison radiative de plus de porteurs dans la structure QD et à l'émission considérablement améliorée à 1550 nm. Le QD-SESAM cultivé avec les QD InAs/GaAs plafonnés SSL présente une intensité de saturation beaucoup plus élevée de 13,7 MW/cm 2 et une profondeur de modulation non linéaire de 1,6 % et une durée d'impulsion de 920 fs sont obtenues dans un laser à fibre à mode verrouillé fonctionnant à 1556 nm construit avec le QD-SESAM. Le QD-SESAM développé avec la conception SSL en tant que CL pour les QD ouvrira une nouvelle voie vers des lasers ultrarapides hautes performances.
Disponibilité des données et des matériaux
Les ensembles de données générés et/ou analysés au cours de la présente étude sont entièrement disponibles sans restriction auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- 2D :
-
Bidimensionnel
- AFM :
-
Microscope à force atomique
- BL :
-
Couche tampon
- CIR :
-
Circulateur
- CL :
-
Couches de recouvrement
- DBR :
-
Réflecteur Bragg distribué
- EDF :
-
Fibre dopée Erbium
- LA :
-
Acoustique longitudinale
- LD :
-
Diode laser
- LO :
-
Optique longitudinale
- MBE :
-
Epitaxie par faisceau moléculaire
- ML :
-
Monocouches
- OC :
-
Coupleur de sortie
- PC :
-
Contrôleur de polarisation
- PI-ISO :
-
Isolateur indépendant de la polarisation
- PL :
-
Photoluminescence
- QD :
-
Points quantiques
- QW :
-
Puits quantique
- RT :
-
Température
- SA :
-
Absorbeur saturable
- SESAM :
-
Miroirs absorbants saturables semi-conducteurs
- SSL :
-
Super-réseau à courte période
- TEM :
-
Microscopie électronique à transmission
- WDM :
-
Multiplexeur de longueur d'onde
Nanomatériaux
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Source lumineuse à photon unique à 1,3 μm basée sur un point quantique à double couche InAs dans un micropilier
- Détection de l'excitation spatialement localisée dans les superréseaux à points quantiques InAs/InGaAs auto-organisés :un moyen d'améliorer l'efficacité photovoltaïque
- Effets bipolaires en photovoltage des hétérostructures à points quantiques métamorphiques InAs/InGaAs/GaAs :solutions de caractérisation et de conception pour les dispositifs sensibles à la lum…
- Contrôle électrochimique réversible de la luminescence photoexcitée d'un film à points quantiques CdSe/ZnS à noyau/enveloppe
- Performance photovoltaïque d'une cellule solaire hybride à nanostructure à nanofils/points quantiques
- Élimination de la taille bimodale dans les points quantiques InAs/GaAs pour la préparation de lasers à points quantiques de 1,3 μm
- Stimulation de la luminescence des points quantiques CdSe/ZnS revêtus de cystéine par la porphyrine méso-tétrakis (p-sulfonato-phényl)
- Diodes émettant de la lumière ultraviolette à base d'AlGaN presque efficace et sans chute avec une couche de blocage d'électrons de type p à super-réseau spécialement conçue pour une efficacit…



