Enquête sur la nitruration sur l'alignement des bandes aux interfaces MoS2/HfO2
Résumé
L'effet du traitement de nitruration sur l'alignement des bandes entre MoS à quelques couches2 et HfO2 a été étudiée par spectroscopie photoélectronique aux rayons X. Les décalages de bande de valence (conduction) de MoS2 /HfO2 avec et sans traitement de nitruration ont été déterminés à 2,09 ± 0,1 (2,41 ± 0,1) et 2,34 ± 0,1 (2,16 ± 0,1) eV, respectivement. L'alignement de la bande accordable pourrait être attribué à la formation de liaison Mo-N et à la flexion de la bande de surface pour HfO2 déclenchée par la nitruration. Cette étude sur l'ingénierie des bandes d'énergie de MoS2 /HfO2 les hétérojonctions peuvent également être étendues à d'autres diélectriques à k élevé pour s'intégrer à des matériaux bidimensionnels afin de concevoir et d'optimiser leurs dispositifs électroniques.
Contexte
Actuellement, les dichalcogénures de métaux de transition en couches (TMDC) ont suscité un grand intérêt en raison de leurs propriétés fascinantes pour des applications potentielles dans l'électronique et l'optoélectronique modernes [1, 2]. En particulier, le bisulfure de molybdène (MoS2 ) a attiré une attention considérable en tant que matériau de canal prometteur pour poursuivre la mise à l'échelle au-delà du nœud technologique de 7 nm [3, 4]. Structurellement, le MoS2 le cristal est constitué d'un plan Mo disposé hexagonalement, pris en sandwich par deux plans S disposés hexagonalement. Un arrangement prismatique triangulaire a été formé via les unités S-Mo-S liées de manière covalente [5, 6]. MoS2 possède une bande interdite dépendante de la couche, variant d'une bande interdite directe (1,8 eV) pour le MoS à couche unique (SL)2 à une bande interdite indirecte (1,2 eV) pour le MoS en vrac2 [sept]. Différente du graphène avec une bande interdite nulle, la modulation des bandes interdites en fonction de l'épaisseur a motivé l'exploration de MoS2 dans les dispositifs optiques et électriques [3, 8]. Basé sur la physique de MoS2 , la densité d'états de MoS à quelques couches2 est le triple de celui du MoS monocouche2 , entraînant des courants d'entraînement élevés dans la limite balistique [8]. Dans ce contexte, MoS à quelques couches2 peut offrir des avantages significatifs pour les applications de transistors que SL MoS2 [3].
D'autre part, les dispositifs électroniques basés sur les diélectriques traditionnels en dioxyde de silicium approchent de la limite physique en raison de sa faible constante diélectrique [9]. Pour obtenir une épaisseur d'oxyde équivalente mince (EOT), il est crucial d'intégrer des diélectriques à k élevé avec MoS2 . À ce jour, de nombreux diélectriques à k élevé ont été étudiés avec MoS2 , y compris Al2 O3 , ZrO2 , HfO2 , et h-BN [10,11,12,13,14]. DiStefano et al. obtenu les décalages respectifs des bandes de conduction et de valence de 3,3 ± 0,2 et 1,4 ± 0,2 eV pour le MoS à quelques couches2 croissance par dépôt en phase vapeur d'oxyde sur BN amorphe [13]. Tao et al. a signalé que le décalage de bande de conduction (CBO) pour la monocouche MoS2 /Al2 O3 (ZrO2 ) l'hétérojonction a été déduite à 3,56 eV (1,22 eV), tandis que le décalage de la bande de valence (VBO) était de 3,31 eV (2,76 eV) [15]. Et un CBO de 2,09 ± 0,35 eV et un VBO de 2,67 ± 0,11 eV au MoS2 /HfO2 l'interface ont été rapportés par McDonnell et al. [12]. Parmi ces diélectriques de grille, HfO2 a été considéré comme l'un des candidats les plus prometteurs en raison de sa constante diélectrique élevée (k ∼ 20), de sa compatibilité avec le poly-SiGe, les grilles TaN et la grille en silicium polycristallin [16]. Cependant, HfO2 a une mauvaise stabilité thermique, un courant de fuite élevé, une densité de piège d'oxyde élevée, une densité de piège d'interface, etc. [17]. Ces limitations ont motivé des recherches approfondies sur la recherche de techniques de passivation, telles que les technologies de nitruration d'interface ou de traitement de fluoration [18, 19]. Dans ce travail, nous avons étudié les alignements de bandes d'énergie de MoS à quelques couches2 sur HfO2 diélectriques avec et sans nitruration plasma, dans lesquels l'effet de la nitruration de surface a été caractérisé par spectroscopie photoélectronique aux rayons X (XPS).
Méthodes
Le SiO2 (280 nm)/la plaquette de Si a été alternativement nettoyée avec de l'acétone et de l'isopropanol par nettoyage aux ultrasons toutes les 10 min, suivi d'un rinçage à l'eau déminéralisée et de N2 sec. Le MoS à quelques couches2 les films ont été déposés sur SiO2 Substrat /Si par dépôt chimique en phase vapeur (CVD) utilisant des précurseurs de MoO3 (0,08 mg, 99%, Alfa Aesar) et poudre de S (1 g, 99%) [20, 21]. Après la procédure de croissance, le MoS2 le film serait transféré à HfO2 Substrat /Si par la méthode poly (méthacrylate de méthyle) (PMMA) [22], comme illustré sur la figure 1a. Dans ce processus, le PMMA a d'abord été revêtu par centrifugation sur MoS2 /SiO2 /Si échantillons comme couche de support. Ensuite, les échantillons ont été immergés dans une solution de KOH pour éliminer le SiO2 , après quoi le MoS2 couche de PMMA flotterait au sommet de la solution. Au final, la couche de PMMA serait dissoute dans de l'acétone après le transfert de l'échantillon sur HfO2 /Si substrat. Le HfO2 les films ont été développés sur la plaquette de silicium par dépôt de couche atomique (ALD) à une température de 200 °C en utilisant Hf [N (CH3 )(C2 H5 )]4 [tétrakis (éthylméthylamido) hafnium, TEMAH] et H2 O vapeur comme précurseurs [23, 24]. Au cours du processus d'optimisation du temps de traitement au plasma, il a été constaté que l'azote diffuserait fortement dans l'oxyde après un traitement de nitruration de 70 s par des mesures SIMS, ce qui détériorerait gravement la qualité de l'oxyde. Alors que le temps de traitement au plasma est de 30 s, aucun pic N évident à la surface de l'oxyde n'a été observé à partir des résultats SIMS. Pour l'échantillon témoin, 50 s N2 le traitement plasma a été mis en œuvre sur HfO2 Substrat /Si à une pression de 3 Pa avant le MoS2 transfert. Dans les conditions plasmatiques, la dose de N résultante est d'environ 8,4 × 10 14 atomes/cm 2 estimée à partir des résultats de la spectrométrie de masse à ions secondaires (SIMS). Et la concentration d'azote a été calculée à environ 1,5% après nitruration sur la base des données XPS. Quatre échantillons 1–4# ont été préparés pour les mesures XPS :1# MoS à quelques couches2 film sur SiO2 Substrat /Si (peu de couches MoS2 ), 2# d'épaisseur HfO2 film sur substrat Si (bulk HfO2 ), 3# MoS transférés2 film sur HfO tel que cultivé2 Substrat /Si (moS cultivé2 /HfO2 hétérojonction), et 4# transféré MoS2 film sur N2 HfO2 traité au plasma Substrat /Si (MoS nitruré2 /HfO2 hétérojonction).
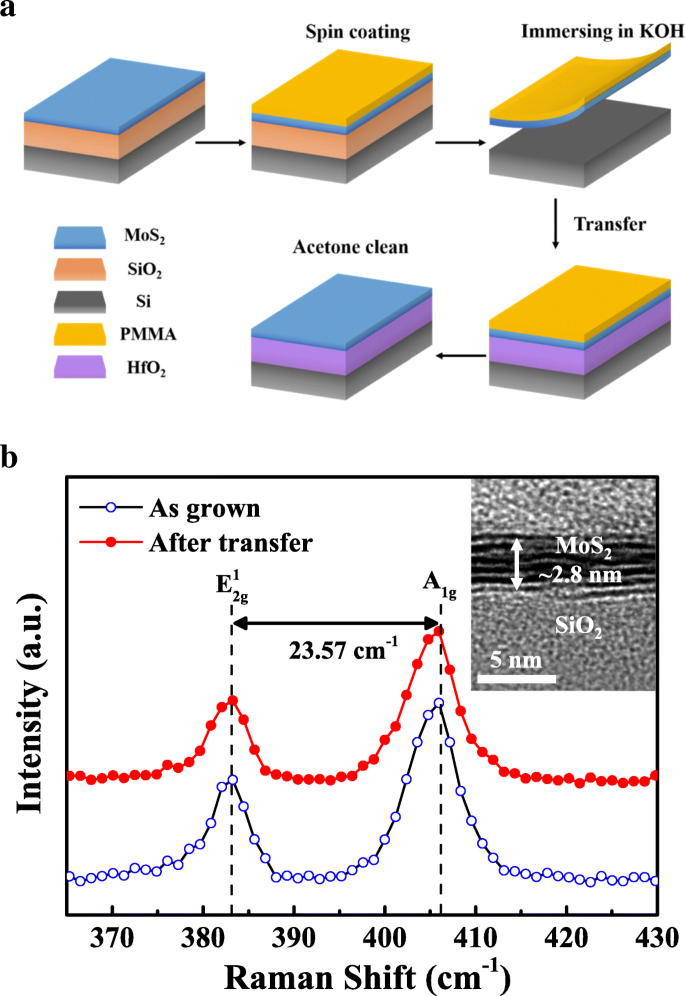
un Flux de processus de la méthode de transfert humide assistée par PMMA pour le MoS2 /ALD-HfO2 formation d'hétérojonctions. b Spectres Raman respectifs des MoS cultivés et transférés2 film. L'encart est la coupe transversale des images de microscopie électronique à transmission de MoS tel que cultivé2 sur SiO2 /Substrat Si
Résultats et discussions
La spectroscopie RENISHAW inVia Raman a été utilisée pour caractériser les spectres Raman de MoS à quelques couches2 film avant et après la procédure de transfert, comme illustré sur la Fig. 1b. Deux pics Raman peuvent être vus à environ 382,86 cm −1 et 406,43 cm −1 , correspondant aux dans-plan (\( {E}_{2g}^1 \)) et hors-plan (A 1g ), respectivement [25, 26]. Il a été constaté qu'il n'y a presque pas de décalage Raman dans \( {E}_{2g}^1 \) et A 1g fréquences de mode après le processus de transfert, indiquant une modification minimale de la structure. La différence de fréquence (∆k ) entre \( {E}_{2g}^1 \) et A 1g le mode a été déduit à environ 23,57 cm −1 , désignant environ quatre à cinq couches de MoS2 cinéma [27]. Comme le montre l'encart de la figure 1b, l'épaisseur de MoS2 film a été vérifié comme étant d'environ 2,8 nm au microscope électronique à transmission à haute résolution (HRTEM), ce qui est en accord avec les spectres Raman susmentionnés. De plus, nous avons présenté les profils de profondeur SIMS des MoS transférés2 film sur HfO nitruré2 /Si substrat. La mesure SIMS a été réalisée sur un instrument SIMS d'électronique physique ADEPT 1010 avec un faisceau d'ions primaires Cs à l'énergie de 1 keV, dans lequel des ions positifs ont été collectés et une compensation de charge a été effectuée. Dans cette mesure SIMS, l'élément azote a été quantifié tandis que les autres éléments (Mo, Hf et Si) ne sont que des marqueurs de couche et non quantifiés. Comme illustré sur la figure 2a, les profils de profondeur pour le MoS transféré2 film sur HfO nitruré2 Le substrat /Si a été déterminé par SIMS, dans lequel les signaux des composants principaux représentés par Mo, N, Hf et Si sont tracés en fonction de la profondeur. La diffusion de N dans le HfO2 a été observée, ce qui pourrait être intrigué par l'injection d'azote dans la couche sous-jacente lors de bombardements de faisceaux primaires ou de traitements plasma. Il convient également de noter que les profils de profondeur près de la couche de surface sont normalement compliqués et dénués de sens en raison de la contamination de surface et des effets de surface, par exemple, l'intensité anormale de l'élément N près de la surface [28]. Le signal le plus élevé du profil N près du HfO2 L'interface /Si pourrait être attribuée au fait que l'azote a tendance à diffuser vers le HfO2 /Si, conduisant à l'accumulation de N près de l'interface [29]. La queue de Mo dans HfO2 film pourrait être principalement causé par des bombardements de faisceaux primaires dans les mesures SIMS [30]. La figure 2b illustre les spectres XPS Nis respectifs pour les échantillons 3# et 4#; les pics de haute intensité pour les deux hétérojonctions étaient Mo 3p3/2 tandis qu'un pic de faible intensité à ~ 395,80 eV a été détecté pour l'hétérojonction nitrurée, indiquant la formation de liaisons Mo-N [31].
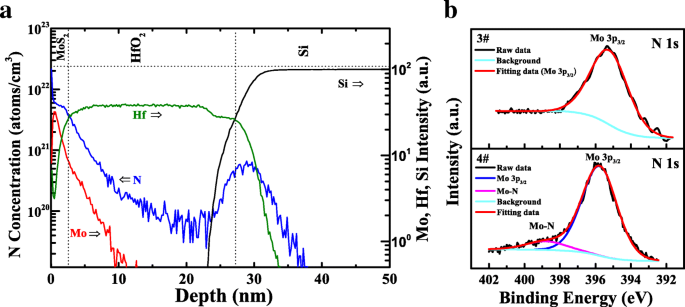
un Profils de profondeur SIMS des MoS transférés2 film sur HfO nitruré2 /Si substrat. b Spectres XPS N 1s pour MoS2 /HfO2 hétérojonctions avec et sans traitement de nitruration, respectivement
Pour obtenir les alignements de bandes entre MoS à quelques couches2 et HfO2 avec et sans traitement de nitruration, des mesures XPS au pas de 0,05 eV ont été réalisées sur système VG ESCALAB 220i-XL en utilisant une source de rayons X monochromatique Al Kα (hν = 1486.6 eV). L'énergie de passage constante a été fixée à 20 eV. De plus, le C 1s standard (284,8 eV) a été utilisé pour l'étalonnage de l'énergie de liaison (BE) [32]. Pour évaluer les valeurs VBO pour MoS2 /HfO2 les hétérojonctions, les niveaux de noyau Mo 3d et Hf 4f (CL) ont été sélectionnés pour l'échantillon 1–4#, respectivement. La figure 3a présente le balayage étroit XPS des spectres de Mo 3d et de bande de valence de l'échantillon 1# [33]. Ainsi, la différence d'énergie de liaison (BED) entre Mo 3d5/2 le niveau de base et le maximum de bande de valence (VBM) pour l'échantillon 1# ont été calculés à 228,49 ± 0,1 eV. La figure 3b illustre les CL de Hf 4f7/2 et VBM pour l'échantillon 2# ; le BED correspondant a été déterminé à 14,10 ± 0,1 eV. La figure 3c illustre les spectres XPS mesurés des CL Mo 3d et Hf 4f pour MoS2 /HfO2 hétérojonctions avec/sans traitement de nitruration. Il est à noter que le Mo 3d5/2 CL est passé de 229,45 ± 0,05 eV pour l'échantillon 3# à 229,90 ± 0,05 eV pour l'échantillon 4#. Cela pourrait être attribué au fait qu'une couche interfaciale de nitruration a été introduite au MoS2 /HfO2 après traitement plasma, aboutissant à la liaison Mo-N précitée. Avec la présence de la liaison Mo-N, le transfert de charge conséquent entre Mo et N éléments a contribué au Mo 3d5/2 mesuré Changement de CL. De plus, le Hf 4f7/2 CL de 17,40 ± 0,05 eV pour l'échantillon 3# a été déplacé vers une énergie de liaison plus élevée de 17,60 ± 0,05 eV pour l'échantillon 4 # tandis que O 1s a également montré un décalage de 0,20 eV vers un BED plus élevé, comme le montre la figure 3d. Ces décalages de pic impliquaient la flexion de la bande vers le bas au niveau de HfO2 surface, ce qui pourrait être interprété comme le fait que le plasma d'azote a induit des défauts de type donneur pour HfO2 [34]. Basé sur la méthode Kraut [35], le VBO (∆E V ) les valeurs peuvent être calculées à partir de l'équation suivante :
$$ \Delta {E}_V=\gauche({E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S }}_2}-{E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2}\right)-\left({E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2}-{E}_{\mathrm{VBM}}^{{\mathrm{Hf }\mathrm{O}}_2}\right)-{\Delta E}_{\mathrm{CL}} $$ (1)où \( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2} \) et \( {E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2} \) sont des énergies de liaison de Mo 3d5/2 CL et VBM pour MoS2 , \( {E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) et \( {E}_{\mathrm{VBM}}^{{\mathrm{HfO}}_2} \) sont des énergies de liaison de Hf 4f7/2 CL et VBM pour ALD-HfO2 , ∆E CL =\( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2}-{E}_ {\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) fait référence au BED entre Mo 3d 5/2 et Hf 4f7/2 CL pour ALD-HfO2 /MoS2 hétérojonctions. Par conséquent, le ∆E V du MoS2 sur ALD-HfO2 avec et sans traitement de nitruration ont été calculés à 2,09 ± 0,1 et 2,34 ± 0,1 eV, respectivement.

un Spectres XPS de Mo 3d CL et bande de valence pour le MoS à quelques couches2 . b Spectres XPS de Hf 4f CL et bande de valence pour HfO en vrac2 . Spectres XPS de c Mo 3d, Hf 4f et d O 1s CLs pour MoS transféré2 film sur vrac HfO2 avec/sans traitement de nitruration
Pour évaluer l'influence de N2 traitement plasma sur la bande de conduction offset (CBO, ∆E C ) entre ALD-HfO2 et MoS à quelques couches2 , les bandes interdites de 5,9 ± 0,1 eV pour HfO2 et 1,4 ± 0,1 eV pour MoS2 ont été utilisés ici, respectivement [7, 36]. Ainsi, le CBO peut être atteint par l'équation suivante :
$$ {\Delta E}_C={E}_g^{{\mathrm{HfO}}_2}-{E}_g^{\mathrm{Mo}{\mathrm{S}}_2}-{\Delta E }_V $$ (2)où \( {E}_g^{{\mathrm{HfO}}_2} \) et \( {E}_g^{\mathrm{Mo}{\mathrm{S}}_2} \) sont les bandes interdites de HfO 2 et MoS2 , respectivement. Selon l'éq. (2), le ∆E C entre MoS2 et ALD-HfO2 avec et sans traitement de nitruration ont été calculés à 2,41 ± 0,1 et 2,16 ± 0,1 eV, respectivement. Les diagrammes de bandes correspondants sont illustrés sur la figure 4. Remarquablement, les valeurs VBO et CBO de ces deux hétérojonctions fournissent d'excellents confinements d'électrons et de trous, garantissant leur adéquation pour MoS2 à base de FET [37]. De plus, l'hétérojonction nitrurée a un CBO plus élevé que l'hétérojonction non nitrurée, ce qui est mieux pour les applications FET à canal n.
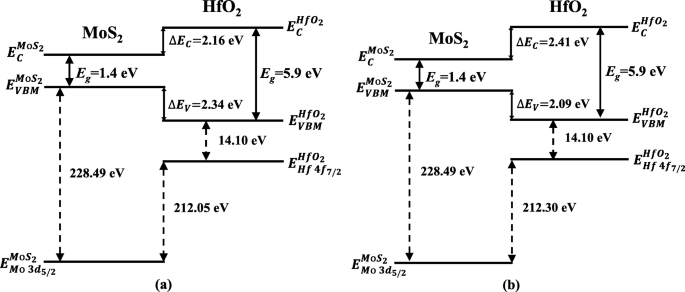
Diagrammes de bande de MoS2 /HfO2 hétérojonction a sans traitement de nitruration et b avec traitement de nitruration
Conclusions
En conclusion, les mesures XPS ont révélé que l'alignement des bandes au MoS2 /HfO2 l'interface pourrait être modifiée en introduisant la nitruration sur HfO2 surface avant d'empiler MoS2 film. Le CBO et le VBO ont été déterminés à 2,16 ± 0,1 et 2,34 ± 0,1 eV pour le MoS non nitruré2 /HfO2 hétérojonction, alors que le CBO a été altéré jusqu'à 2,41 ± 0,1 eV et le VBO a été altéré jusqu'à 2,09 ± 0,1 eV pour le MoS nitruré2 /HfO2 hétérojonction, respectivement. Une couche interfaciale de nitruration a été introduite à l'interface, ce qui a entraîné la formation de liaisons Mo-N. De plus, le plasma d'azote pourrait induire des défauts de type donneur, entraînant une courbure de la bande de surface pour HfO2 . De cette façon, l'ingénierie de l'alignement des bandes interfaciales fournirait des voies prometteuses vers la conception flexible et l'optimisation de l'électronique moderne.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de ce manuscrit sont inclus dans le manuscrit.
Abréviations
- ALD :
-
Dépôt de couche atomique
- BE :
-
Énergie de liaison
- LIT :
-
Différence d'énergie de liaison
- CBO :
-
Décalage de la bande de conduction
- CL :
-
Niveau de base
- CVD :
-
Dépôt chimique en phase vapeur
- FET :
-
Transistor à effet de champ
- HfO2 :
-
Oxyde d'hafnium
- HRTEM :
-
Microscope électronique à transmission haute résolution
- MoS2 :
-
Disulfure de molybdène
- PMMA :
-
Poly (méthacrylate de méthyle)
- SIMS :
-
Spectrométrie de masse ionique secondaire
- SL :
-
Monocouche
- TEMAH :
-
Tetrakis (éthylméthylamido) hafnium
- TMDC :
-
Dichalcogénure de métal de transition
- VBM :
-
Bande de valence maximum
- VBO :
-
Décalage de la bande de valence
- XPS :
-
Spectroscopie photoélectronique aux rayons X
Nanomatériaux
- Introduction à la bande térahertz
- MoS2 avec épaisseur contrôlée pour l'évolution électrocatalytique de l'hydrogène
- Caractéristiques d'alignement interfacial, électrique et de bande des piles HfO2/Ge avec une couche intermédiaire de SiO2 formée in situ par dépôt de couche atomique amélioré par plasma
- Cristallisation en fonction de la température de nanoflocons de MoS2 sur des nanofeuillets de graphène pour l'électrocatalyse
- Grand effet photovoltaïque latéral dans l'hétérojonction MoS2/GaAs
- Les principaux composants des scies à ruban
- Comment choisir la vitesse de sciage ?
- La puissante scie à ruban à métaux
- Présentation de la scierie à ruban vertical



