Suppression de la prolifération des filaments dans la mémoire à accès aléatoire du pont conducteur par la structure bicouche Ta2O5/TaOx
Résumé
La structure bicouche a été largement adoptée pour améliorer la fiabilité de la mémoire vive à pont conducteur (CBRAM). Dans ce travail, nous avons proposé une solution pratique et économique pour atteindre un Ta2 O5 /TaOx structure bicouche en utilisant un processus de recuit à basse température. L'ajout d'un TaOx La couche a agi comme une résistance externe supprimant le courant de débordement pendant la programmation définie, réalisant ainsi la commutation d'auto-conformité. En conséquence, les distributions des états à haute résistance et des états à faible résistance sont améliorées en raison de la suppression du phénomène de dépassement. De plus, la rétention LRS de la CBRAM est évidemment améliorée en raison de la récupération des défauts dans le film de commutation. Ce travail fournit une méthode simple et économique pour améliorer la fiabilité de la CBRAM.
Introduction
La mémoire à commutation résistive à pont conducteur (CBRAM) est une technologie révolutionnaire et est considérée comme la mémoire non volatile (NVM) de nouvelle génération en raison de sa grande évolutivité, de sa structure simple, de sa facilité d'intégration 3D et de son fonctionnement à grande vitesse [1,2, 3]. Pour une application pratique, les problèmes de fiabilité, y compris la conservation et l'endurance des données, entravent l'introduction définitive de ces dispositifs de mémoire sur le marché de la mémoire. L'ingénierie de la structure est l'approche la plus populaire pour améliorer la fiabilité de la CBRAM [4,5,6,7]. Zhao et al. injection de cations confinés pour améliorer les performances de CBRAM par une couche de graphène à nanopores [8]. Bien que la fiabilité du dispositif se soit fortement améliorée, il rend les coûts difficiles sur le contrôle des matériaux et ne peut pas être utilisé dans un processus CMOS standard. Afin de résoudre ce problème, Gong et al. ont proposé une méthode compatible CMOS et auto-alignée pour former une couche interfaciale CuSiN dans une électrode en Cu pour améliorer la rétention de l'état de faible résistance (LRS) [9]. Cao et al. ont proposé une couche barrière TiN pour améliorer la fiabilité du dispositif dans les dispositifs CBRAM en éliminant le phénomène de prolifération des nanofilaments et le comportement négatif-SET [10]. Les méthodes ci-dessus ont utilisé la structure bicouche pour optimiser efficacement la fiabilité de la CBRAM. Cependant, ils entraînent des coûts liés au flux de processus complexe ou à la vitesse de programmation.
Dans ce travail, nous proposons une méthode compatible CMOS pour former un dispositif bicouche par un simple processus de recuit à basse température. Le dispositif double couche de Ta2 O5 /TaOx La structure s'est formée spontanément, ce qui montre de meilleures caractéristiques de fiabilité par rapport au dispositif non recuit. La fiabilité accrue du dispositif recuit peut s'expliquer par les filaments concentrés formés le long du joint de grain lors de la programmation. De plus, pour un dispositif de recuit bicouche, du fait de l'existence de TaOx , le comportement d'auto-conformité est obtenu parce que le TaOx couche sert de résistance en série avec un Ta2 O5 -couche résistive. Ce résultat fournit une méthode simple et compatible CMOS pour former un dispositif à double couche et améliorer la fiabilité de la CBRAM.
Méthodes
La fiche W d'un diamètre de 1 µm après CMP sert d'électrode inférieure (BE). Après avoir déposé une couche de Ta de 5 nm par pulvérisation cathodique magnétron DC, le Ta2 O5 s'est formé par un processus d'oxydation thermique, sous 350°C, dans le plasma O2 pendant 300 s par dépôt chimique en phase vapeur assisté par plasma (PECVD). Ensuite, une électrode supérieure en Cu de 40 nm (TE) est pulvérisée et modelée par lithographie. Les cellules mémoire sont modelées par le processus de gravure avec un mélange gazeux de SF6 et C3 F8 en utilisant le TE comme masque dur. Ensuite, le BE est extrait par le tampon Al. Enfin, le dispositif est complété par un recuit basse température compatible CMOS sous 400°C pendant 30 min. La taille de l'appareil est définie par la surface de l'électrode inférieure, qui est de 1 μm 2 . A titre de référence, le dispositif sans le processus de recuit est également préparé. Les mesures de courant continu électrique sont effectuées à l'aide d'un analyseur de paramètres à semi-conducteurs Keithley 4200-SCS. Pour toutes les mesures, la tension est appliquée au Cu TE avec le W BE mis à la terre.
Résultats et discussion
Pour un aperçu approfondi du processus de recuit, de la composition et de l'état de liaison chimique dans le Ta2 O5 les films avant et après le processus de recuit sont analysés par spectroscopie photoélectronique aux rayons X (XPS). La vitesse de gravure de l'échantillon est de 0,5 µnm/point. Sur la figure 1a, les pics de Ta2 O5 Doublet 4f avec des énergies de liaison maximales de 26,70 eV (Ta2 O5 4f7/2 ) et 28,60 eV (Ta2 O5 4f5/2 ) avec une séparation des pics de 1,9 eV sont observés en surface [11,12,13]. Ce cas démontre l'existence de Ta2 O5 couche.

Le XPS montre le profil de profondeur de Ta avant (a ) et après (d ) recuit. b , e Profil de profondeur de O avant et après recuit, respectivement. c, f Profil de concentration atomique de O et Ta avec la profondeur avant et après recuit, respectivement
Avec l'augmentation de la profondeur, les pics de Ta2 O5 Le doublet 4f disparaît et les pics à 22,33 eV, 23,96 eV correspondant à Ta 4f7/2 , Ta 4f5/2 apparaître. La figure 1b vérifie qu'il n'y a pas de signal O à la même profondeur où le Ta 4f7/2 et Ta 4f5/2 exister. En d'autres termes, il y a du Ta métallique à la surface de Ta2 O5 pour le dispositif non recuit. Les profondeurs du Ta2 O5 et Ta analysés à partir de la figure 1c sont respectivement de 4 nm et 2,5 nm. De plus, il y a le pic de la concentration atomique en O à la profondeur de 7 nm, indiquant l'existence de l'oxygène absorbé. Les figures 1d et e montrent les profils de profondeur des spectres XPS du Ta2 O5 films après le processus de recuit. Les pics de Ta 4f doublet et Ta2 O5 Le doublet 4f existe ensemble à une certaine profondeur. L'intensité du Ta 5+ l'état d'oxydation s'affaiblit progressivement avec l'augmentation de la profondeur. Combiné avec le signal d'oxygène tout autour de la profondeur du film, nous confirmons que le TaOx existe à la surface de Ta2 O5 [11, 14]. Calculée à partir de la Fig. 1f, l'épaisseur du Ta2 O5 est de 4 nm et TaOx est de 3,5 nm. Par conséquent, le TaOx est formé en changeant l'oxygène adsorbé en oxygène de réseau dans le processus de recuit. La redistribution de l'oxygène atteindrait un point de saturation saturé après le processus de recuit. L'épaisseur de TaOx ainsi que la tension de formage n'augmenteront pas même si le temps de recuit augmente, ce qui prouve la grande marge de traitement de ce processus de recuit.
Les figures 2a et b sont les caractéristiques de commutation résistive de Cu/Ta2 O5 /W avant et après recuit en mode de balayage DC. Les résistances initiales (R initial ) des deux appareils sont tous deux en état de résistance élevée (HRS) avec des valeurs de ~ 10 9 Ω et 10 10 , respectivement. Le R le plus élevé initial du dispositif recuit est dû au film d'oxyde plus épais formé sous le processus thermique. Notamment, ce dispositif n'a pas besoin d'un processus de formage, ce qui est tout à fait attendu dans une application pratique. Pour le dispositif non recuit, il passe brusquement au LRS lorsque la tension appliquée atteint une valeur critique pendant le balayage de tension positive. Certains LRS ultra-faibles se sont produits pendant le processus de réglage. Le courant de RESET dans un tel cas est beaucoup plus élevé que le courant de conformité préréglé, indiquant que le phénomène de dépassement s'est produit dans cet appareil. La figure 3b présente les LRS et HRS instables dans les 200 cycles pour le dispositif non recuit. La grande variation entre cycle à cycle conduit à une fenêtre de mémoire réduite à 20. La figure 2b montre le comportement de commutation des dispositifs recuits. Le courant circulant dans la cellule augmente progressivement et atteint le courant de conformité. Aucun point de commutation évident n'est observé, évitant le phénomène de dépassement qui s'est produit dans les dispositifs non recuits. Une fenêtre de mémoire pouvant atteindre 10 4 a été atteint au cours des cycles de commutation, grâce à la répartition uniforme des HRS et LRS.

Courbes I-V typiques des dispositifs Cu/TaOx/W avant recuit (a ) et après recuit (b ) avec 200 cycles
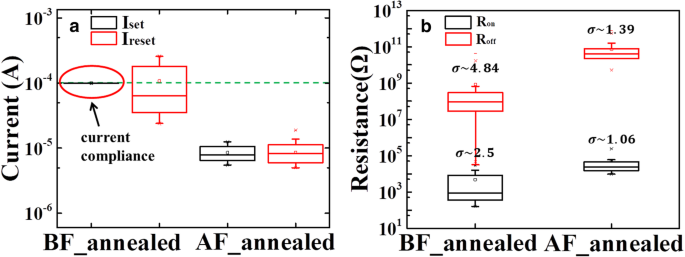
un Set et RESET Distributions actuelles avant et après recuit, respectivement. b La distribution de résistance de HRS et LRS avant/après recuit
La suppression du phénomène d'overset dans le dispositif recuit pourrait également être vérifiée par l'amélioration de la répartition du courant de RESET (I RÉINITIALISER ) et Régler le courant (I Définir ) dans le dispositif recuit, comme illustré sur la Fig. 3a. Le Je Définir du dispositif non recuit est bloqué au niveau du I CC mais Je RÉINITIALISER diffuse largement. En revanche, pour le dispositif recuit, le I RÉINITIALISER est similaire à I Définir . L'uniformité d'un appareil à l'autre est évaluée en analysant le R sur et R désactivé dans 20 appareils différents en mode DC. Comme le montre la figure 3 (b), le R sur extrait sous V lire de 0,1 V pour le dispositif non recuit distribue à partir de 10 2 Ω à 10 5 Ω, tandis que le R sur du dispositif recuit distribue de 10 4 Ω à 10 5 . Le R relativement plus élevé sur du dispositif recuit résulte de la résistance série du TaOx couche. De plus, la distribution HRS du dispositif recuit est également beaucoup améliorée. Comme le montre la figure 3b, l'écart type (SD) de R désactivé est réduit de 4,84 à 1,39.
Les résultats de cyclage sous balayage DC sont illustrés aux Fig. 4a et b. Pour le dispositif non recuit, le rapport HRS/LRS est d'environ 10 5 au début, puis diminue progressivement et finalement colle au LRS. Notez que quelques erreurs logicielles peuvent être observées pendant le cyclisme, sous la forme de HRS (points rouges) et LRS (points bleus) qui vont et viennent de temps en temps. Pour le dispositif recuit, le rapport HRS/LRS reste stable (~ 10 4 ) sans aucune dégradation. Pendant les mesures d'impulsions, les conditions de programmation d'impulsions appropriées sont optimisées comme 3 V/100 ns pour le fonctionnement défini, − 2 V/200 ns pour le fonctionnement RESET et 0,1 V/50 ns pour le fonctionnement en lecture. Le temps de détection pour l'opération Set/RESET/Read est de 15 ns/12 ns/25 ns, respectivement. Comme le montre la figure 4c, l'endurance du dispositif non recuit est généralement inférieure à 5 × 10 4 cycles de commutation. Cependant, d'après la figure 4d, il est surprenant que le dispositif recuit fonctionne toujours bien sans défaillance après plus de 10 6 cycles de commutation. Sur la base de notre étude précédente [15], la défaillance d'endurance dans la CBRAM est liée à l'opération RESET instable résultant de la prolifération du filament dans la contre-électrode. D'une part, le filament envahi par la végétation a besoin de plus d'énergie pour se rompre et a tendance à provoquer un RESET incomplet et une HRS inférieure. D'un autre côté, la prolifération de filaments dans la contre-électrode conduit à des ions Cu résiduels dans la contre-électrode, qui pourraient servir de réservoir d'ions métalliques et créer un SET négatif inattendu. Pour le dispositif recuit, la prolifération des filaments est bien supprimée par l'incorporation de TaOx couche et résulte en une opération RESET plus stable. En conséquence, la fenêtre de mémoire est bien conservée et la caractéristique de cyclisme est bien améliorée.

Les résultats cyclistes de a les appareils sans recuit sous 300 DC cycles et b les appareils avec recuit sous 400 DC cycles. c, d Caractéristiques d'endurance en mode AC avec la configuration de fonctionnement optimisée :régler 3 V/100 ns ; RÉINITIALISATION − 2 V/200 ns. Jusqu'à 10 6 cycles ont été obtenus pour l'appareil après recuit
Considérant que la caractéristique de rétention joue un rôle crucial pour l'application pratique de CBRAM [16]. Les caractéristiques de rétention sont mesurées sous 150°C à l'aide de l'étuve à vide. La résistance de chaque cellule est vérifiée après refroidissement à température ambiante à chaque décennie d'intervalle. Les figures 5a et b montrent la dépendance du RHRS /RLRS sur le temps de cuisson pour le dispositif sans recuit et avec recuit, respectivement. Pour les appareils non recuits (Fig. 5a), au fur et à mesure que le temps augmente, les appareils tombent en panne progressivement dans les 10 4 s. Cependant, pour le dispositif recuit (Fig. 5b), parmi les 20 dispositifs enregistrés, les résistances du LRS et du HRS ne montrent aucune dégradation au fur et à mesure que le temps de cuisson augmente. C'est-à-dire que la rétention des dispositifs est fortement améliorée par le processus de recuit. La durée de vie du dispositif recuit à 85 °C pourrait être extraite à 10 ans par le graphique d'Arrhenius, ce qui est en bon accord avec les CBRAM rapportées [17, 18]. L'obtention d'une meilleure caractéristique de rétention pour le dispositif recuit est due au fait que le processus de recuit récupère certains défauts dans le film de commutation, ce qui ralentirait la diffusion de l'espèce Cu.
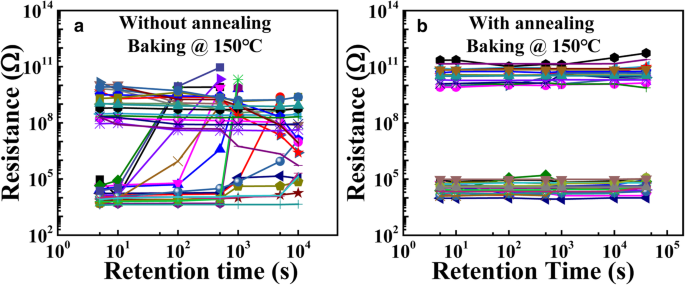
Caractéristiques de rétention du HRS/LRS pour a appareil non recuit et b appareil recuit à 150 °C
Sur la base des résultats ci-dessus, un modèle physique pour le comportement de commutation des dispositifs recuits et non recuits est illustré à la Fig. 6a–d. La croissance des filaments dans la CBRAM est associée au transport des ions Cu dans le réseau d'électrolyte [19]. Le phénomène de dépassement qui s'est produit dans le dispositif non recuit provoque une prolifération du filament dans la contre-électrode. Pendant l'opération de RÉINITIALISATION, les ions Cu résiduels stockés dans la contre-électrode dériveront dans l'espace tunnel entre la pointe du filament et la contre-électrode, entraînant le Cu + résiduel. à la fin de l'opération de RESET et variation importante de HRS. Comme le coefficient de diffusion de Cu dans TaOx (4,9 × 10 − 20 cm 2 /s) est bien inférieur à celui de Ta (1,0 × 10 − 6 cm 2 /s), le Cu diffuse dans TaOx est beaucoup plus difficile sous le champ électrique lors de l'opération Set dans l'échantillon de Cu/Ta2 O5 /TaOx /W [20, 21]. Par conséquent, le comportement excessif et la prolifération des filaments pourraient être bien supprimés et l'opération RESET devient plus stable.
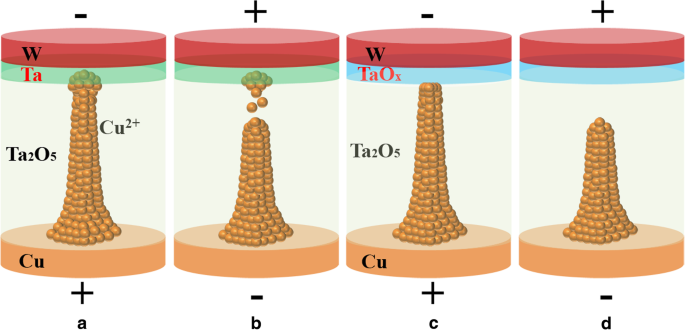
La modélisation physique du comportement de commutation des dispositifs recuits et non recuits. Le a Définir et b Processus de RESET pour le dispositif non recuit avec la structure Cu/Ta2 O5 /Ta/W. c Définir et d Processus de RESET pour le dispositif recuit avec la structure Cu/Ta2 O5 /TaOx /W. La prolifération des filaments est supprimée par le TaOx couche formée pendant le processus de recuit
Conclusions
Dans cette lettre, nous avons étudié les caractéristiques de commutation d'un TaOx périphérique CBRAM basé. Un Ta2 O5 /TaOx L'empilement bicouche a été formé après un traitement de recuit post-thermique. Le TaOx La couche pourrait agir comme une résistance externe supprimant le courant de débordement pendant le fonctionnement défini. Les distributions HRS et LRS sont considérablement améliorées en raison de la suppression du phénomène de dépassement. De plus, la rétention des données de la CBRAM est améliorée en raison de la récupération des défauts dans le film de commutation pendant le recuit thermique. Ce travail fournit la solution la plus pratique et la plus économique pour réaliser la structure bicouche et améliorer la fiabilité de la CBRAM.
Abréviations
- CBRAM :
-
Mémoire vive à pont conducteur
- HRS :
-
États à haute résistance
- LRS :
-
États de faible résistance
- NVM :
-
Mémoire non volatile
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- TE :
-
Électrode supérieure
Nanomatériaux
- Débuts de FPGA de niveau défense avec accès anticipé
- Nano graphème, mémoire transparente flexible à base de silicium
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- Structure et propriétés électroniques de la nanoargile de kaolinite dopée par un métal de transition
- Préparation et performances photocatalytiques des photocatalyseurs à structure creuse LiNb3O8
- Étude collective sur la modélisation et la simulation de mémoires résistives à accès aléatoire
- Structure électronique et caractéristiques I-V des nanorubans InSe
- Structure électronique dépendante du spin et de la vallée dans le silicium sous potentiels périodiques
- Considérations relatives à la recherche de périphériques d'accès à distance pour la sécurité



