Transistors à effet de champ à capacité négative au germanium :impacts de la composition du Zr dans Hf1−xZrxO2
Résumé
Transistors à effet de champ à capacité négative (NCFET) en germanium (Ge) avec diverses compositions de Zr dans Hf1−x Zrx O2 (x =0,33, 0,48 et 0,67) sont fabriqués et caractérisés. Pour chaque composition de Zr, le NCFET présente la chute soudaine de certains points d'oscillation sous le seuil (SS), qui est induite par l'effet NC. Courant d'entraînement I DS augmente avec l'augmentation de la température de recuit, ce qui devrait être dû à la réduction de la résistance source/drain et à l'amélioration de la mobilité des porteurs. Les points SS raides sont reproductibles et stables grâce à de multiples mesures de balayage DC prouvant qu'ils sont induits par l'effet NC. Les valeurs de la tension de grille V GS correspondant aux SS raides sont cohérents et dans le sens des aiguilles d'une montre I DS -V GS sont maintenus par les multiples balayages CC. A température de recuit fixe, appareil NC avec Hf0,52 Zr0.48 O2 atteint le I le plus élevé DS mais hystérésis plus importante par rapport aux autres compositions. NCFET avec Hf0.67 Zr0.33 O2 peut obtenir d'excellentes performances avec des courbes sans hystérésis et un I élevé DS .
Contexte
Le transistor à effet de champ à capacité négative ferroélectrique (NCFET) avec un film ferroélectrique inséré dans la pile de grilles est un candidat prometteur pour les applications de dissipation de faible puissance en raison de sa capacité à surmonter la limitation fondamentale de l'oscillation sous-seuil (SS) pour le métal conventionnel. transistor à effet de champ oxyde-semiconducteur (MOSFET) [1]. Les phénomènes de capacité négative (NC) dans les NCFET ont été largement étudiés dans différents matériaux de canaux, notamment le silicium (Si) [2, 3], le germanium (Ge) [4], le germanium-étain (GeSn) [5], III–V [6], et les matériaux 2D [7]. De plus, les caractéristiques NC ont été démontrées dans des NCFET avec divers ferroélectriques, tels que BiFeO3 [8], PbZrTiO3 (PZT) [9], PVDF [10] et Hf1−x Zrx O2 [11]. Comparé à d'autres ferroélectriques, Hf1−x Zrx O2 a l'avantage d'être compatible avec l'intégration CMOS. Des études expérimentales ont montré que les performances électriques des NCFET peuvent être optimisées en faisant varier l'épaisseur et la surface de Hf1−x Zrx O2 , ce qui affecte la correspondance entre la capacité MOS (C MOS ) et la capacité ferroélectrique (C FE ) [12, 13]. On s'attend à ce que la composition de Zr dans Hf1−x Zrx O2 a également un impact important sur les performances des NCFET, car il détermine les propriétés ferroélectriques de Hf1−x Zrx O2 . Cependant, il manque encore une étude détaillée sur les impacts de la composition du Zr sur les caractéristiques électriques des NCFET.
Dans cet article, nous étudions de manière approfondie les influences de la température de recuit et de la composition en Zr sur les performances du Ge NCFET.
Méthodes
Étapes clés du processus de fabrication des NCFET Ge à canal p avec les différentes compositions de Zr dans Hf1−x Zrx O2 sont illustrés à la figure 1(a). Après le nettoyage de la prégrille, les substrats n-Ge (001) ont été chargés dans la chambre de dépôt de couche atomique (ALD). Un mince Al2 O3 (25 cycles) un film a été déposé, qui a été suivi par le O3 passivation. Ensuite, le Hf1-x Zrx O2 des films (x = 0.33, 0.48 et 0.67) ont été déposés dans la même chambre ALD en utilisant [(CH3 )2 N]4 Hf (TDMAHf), [(CH3 )2 N]4 Zr (TDMAZr) et H2 O comme précurseurs Hf, Zr et O, respectivement. Après cela, la grille métallique TaN a été déposée en utilisant la pulvérisation cathodique réactive. Après structuration de grille et gravure, les ions bore (B + ) ont été implantés dans des régions source/drain (S/D) à une énergie de 20 keV et une dose de 1 × 10 15 cm −2 . Des métaux S/D non auto-alignés ont été formés par un processus de décollement. Enfin, un recuit thermique rapide (RTA) a été effectué à différentes températures pour l'activation du dopant, la métallisation S/D et la cristallisation de Hf1−x Zrx O2 film. Ge contrôle les pMOSFET avec l'Al2 O3 /HfO2 pile a également été fabriqué.

(un ) Étapes clés du processus pour la fabrication de Ge NCFET avec les différentes compositions de Zr dans Hf1−x Zrx O2 ferroélectriques. (b ) Schéma du transistor NC fabriqué. (c ) Image TEM de la pile de portes du dispositif NC illustrant le 7 nm H0,52 Zr0.48 O2 couche et 2 nm Al2 O3 couche
La figure 1(b) montre le schéma du NCFET fabriqué. L'image au microscope électronique à transmission haute résolution (HRTEM) de la figure 1(c) montre l'empilement de grilles sur le canal Ge de l'appareil avec Hf0,52 Zr0.48 O2 ferroélectrique. Les épaisseurs d'Al2 O3 et Hf0,52 Zr0.48 O2 les couches sont respectivement de 2 nm et 7 nm.
Pour confirmer les stoechiométries de Hf1−x Zrx O2 , la mesure par spectroscopie photoélectronique aux rayons X (XPS) a été réalisée. Les figures 2(a) et (b) montrent le Hf4f et Zr3d spectres de niveau de coeur de photoélectrons, respectivement, pour le Hf0.67 Zr0.33 O2 , Hf0,52 Zr0.48 O2 , et Hf0.33 Zr0.67 O2 cinéma. Les compositions de matériaux ont été calculées sur la base du rapport de surface des pics et des facteurs de sensibilité correspondants. Les deux pics de Zr3d 5/2 et Zr3d 3/2 ont un dédoublement spin-orbital de 2,4 eV, qui est composé de Refs. [14, 15]. Avec l'incrément de la composition Zr dans Hf1−x Zrx O2 , Zr3d , et Hf4f les pics se déplacent vers la direction d'énergie inférieure.

(un ) Hf 4f et (b ) Zr 3d spectres de niveau de base pour le Hf1−x Zrx O2 échantillons avec les différentes compositions de Zr
Les propriétés ferroélectriques du Hf1−x Zrx O2 films (x = 0,33, 0,48 et 0,66) ont été caractérisés par la polarisation P par rapport à la tension d'entraînement V mesure des boucles d'hystérésis. P -V boucles ont été enregistrées sur les appareils vierges. La figure 3 montre les courbes de P contre V pour TaN/Hf1−x Zrx O2 (10 nm)/TaN échantillons dans une série de tensions d'entraînement. Avec les augmentations de température post-recuit de 500 à 550°C, le P -V courbes du Hf1−x Zrx O2 ont tendance à être saturés dans un état de sous-boucle. Au fur et à mesure que la composition en Zr augmente, la polarisation résiduelle du film est évidemment améliorée et l'amincissement de la boucle d'hystérésis à polarisation zéro est observé, ce qui peut être mieux décrit phénoménologiquement comme des caractéristiques de type antiferroélectrique superposées [16, 17].
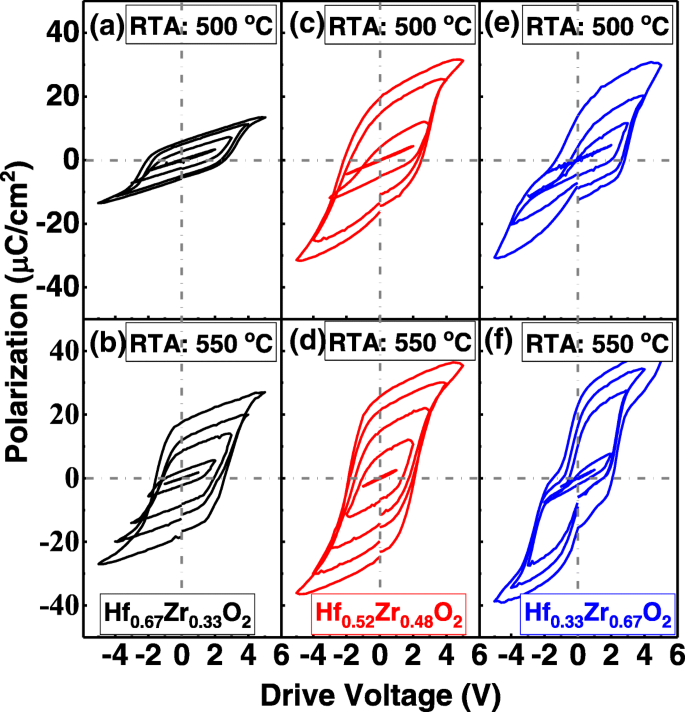
Courbes P-V mesurées du Hf1-x Films ZrxO2 avec différentes compositions de Zr recuits à 500 et 550 o C. (a ) et (b ) sont les Hf0.67 Zr0.33 O2 film recuit à 500 et 550 o C, respectivement. (c ) et (d ) sont les Hf0,52 Zr0.48 O2 film recuit à 500 et 550 o C, respectivement. (e ) et (f ) sont les Hf0.33 Zr0.67 O2 film recuit à 500 et 550 o C, respectivement. Avec le post-recuit, la température passe de 500 à 550 o C, les courbes P-V du Hf1-x Zrx O2 ont tendance à être saturés dans un état de sous-boucle. Une évolution ferroélectrique vers un comportement de type antiferroélectrique est observée avec l'augmentation de la composition en Zr
Résultats et discussion
La figure 4(a) montre les caractéristiques de transfert mesurées des Ge NCFET avec Hf0,52 Zr0.48 O2 ferroélectriques avec différentes températures de recuit et dispositif de contrôle avec Al2 O3 /HfO2 diélectrique d'empilement. Le dispositif de contrôle a été recuit à 500°C. Tous les appareils ont une longueur de grille L G de 2 μm. Les balayages avant et arrière sont indiqués par les symboles ouverts et pleins, respectivement. Les NCFET ont un courant d'entraînement beaucoup plus élevé que le dispositif de commande. On voit que, avec la température de recuit augmentant de 450 à 550 °C, la tension de seuil V TH des appareils CN passent au V positif GS direction. Les NCFET présentent une petite hystérésis, qui devient négligeable avec l'augmentation de la température du RTA. L'effet de piégeage conduit également à l'hystérésis, mais cela produit le I dans le sens inverse des aiguilles d'une montre DS -V GS boucle, à l'opposé des résultats induits par la commutation ferroélectrique [18]. Point SS contre I DS les courbes de la figure 4(b) montrent que le transistor NC présente la chute soudaine de certains points de SS, correspondant au changement brusque de I DS induite par l'effet NC [19]. On observe que les NCFET obtiennent les caractéristiques SS améliorées par rapport au dispositif de commande. Nous avons constaté que les points de chute soudains des dispositifs sont cohérents aux différentes températures de recuit. Le I mesuré DS -V DS courbes des NCFET avec Hf0,52 Zr0.48 O2 ferroélectrique recuit à différentes températures sont représentés sur la figure 4 (c). Je DS -V DS les courbes du transistor NC montrent le phénomène évident de NDR, qui est une caractéristique typique des transistors NC [20,21,22,23]. La figure 4(d) représente les tracés du I DS des Ge NCFET avec le Hf0,52 Zr0.48 O2 couche ferroélectrique recuite à 450, 500 et 550°C, respectivement, à V DS = − 0,05 V et − 0,5 V, et |V GS − V TH | = 1.0 V. Ici, le V TH est défini comme le V GS à Je DS de 10 -7 A/μm. Je DS augmente avec l'augmentation de la température RTA, ce qui est dû à la réduction de la résistance source/drain et à l'amélioration de la mobilité des porteurs à la température de recuit plus élevée.
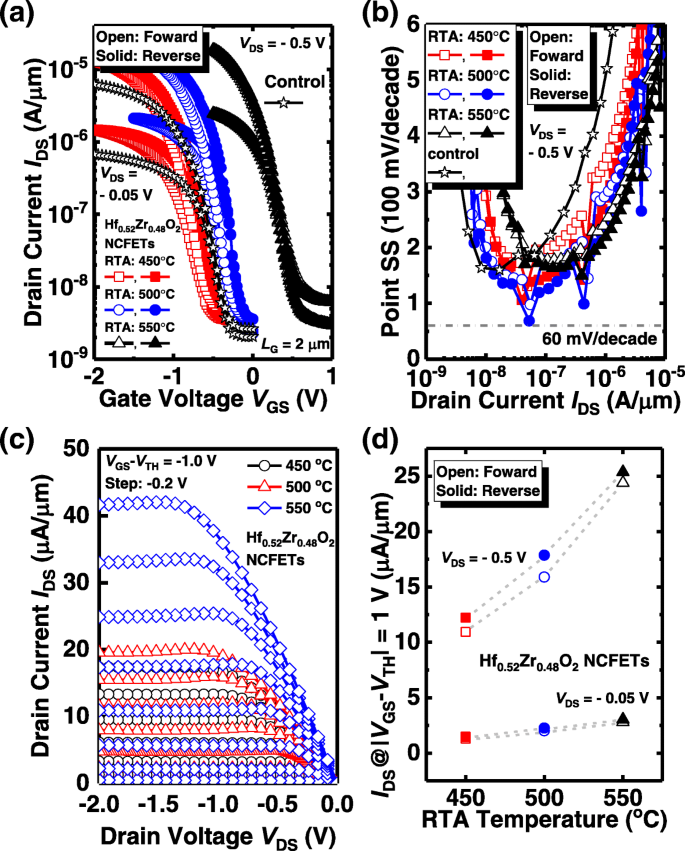
(un ) Mesuré I DS -V GS courbes pour les NCFET avec Hf0,52 Zr0.48 O2 ferroélectrique et dispositif de contrôle. (b ) Point SS contre I DS courbes montrant que les NCFET ont le SS plus raide par rapport au MOSFET de contrôle. (c ) Je DS -V DS courbes pour les NCFET démontrant les phénomènes typiques de NDR. (d ) Comparaison des I DS pour les NCFET recuits à différentes températures à une surcharge de grille de 1 V
En plus du Hf0,52 Zr0.48 O2 transistor ferroélectrique, nous étudions également les caractéristiques électriques des transistors Ge NC avec le Hf0.33 Zr0.67 O2 ferroélectrique. La figure 5(a) présente le I DS -V GS caractéristiques des appareils avec Hf0.33 Zr0.67 O2 avec les différentes températures de recuit à V DS = − 0,05 V et − 0,5 V. Par rapport au Hf0,52 Zr0.48 O2 transistors NC, une hystérésis encore plus petite est obtenue. Similaire au Hf0,52 Zr0.48 O2 Transistors NC, lorsque la température de recuit passe de 450 à 550 °C, V TH de l'appareil passe de − 0.63 V à 0.51 V dans le balayage avant à V DS = − 0,05 V. Point SS en fonction de I DS caractéristiques pour le Hf0.33 Zr0.67 O2 Les NCFET ferroélectriques sont représentés sur la figure 5(b). De plus, les appareils avec une température de recuit de 450 °C et 500 °C obtiennent la baisse soudaine de SS la plus évidente par rapport au transistor recuit de 550 °C. Les points de chute soudains dans différentes températures de recuit se produisent à la même tension de grille. La figure 5(c) montre un I avant et arrière DS du Hf0.33 Zr0.67 O2 NCFET à V DS = − 0,05 V et − 0,5 V, et |V GS –V TH | = 1.0 V. Que ce soit pour le balayage avant ou arrière, le I DS augmente avec la température de recuit, ce qui est cohérent avec la caractéristique de Hf0,52 Zr0.48 O2 appareil.
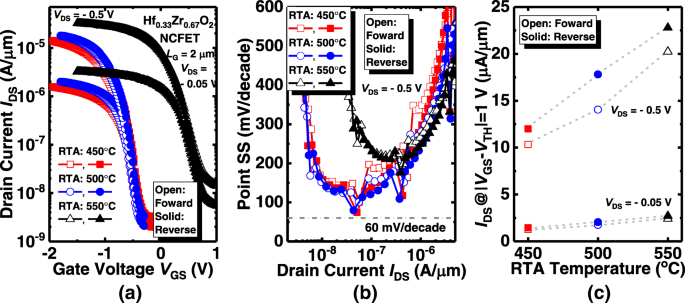
(un ) Caractéristiques de transfert mesurées du Hf0.33 Zr0.67 O2 NC Ge pFET recuits de 450 à 550°C. (b ) Point SS en fonction de I DS pour le Hf0.33 Zr0.67 O2 dispositifs. (c ) Je DS pour les transistors ferroélectriques NC avec différentes températures de recuit à une surcharge de grille de 1 V
Nous étudions également les performances électriques du Ge NCFET avec la plus petite composition de Zr. Les caractéristiques de transfert du Hf0.67 Zr0.33 O2 Les NCFET recuits à différentes températures de recuit sont présentés sur la figure 6(a). Aucun phénomène d'hystérésis n'est observé. Par rapport à Hf0.33 Zr0.67 O2 et Hf0,52 Zr0.48 O2 appareils, le V TH le décalage induit par la variation de la température de recuit est moins prononcé dans Hf0.67 Zr0.33 O2 NCFET. Point SS contre I DS les courbes de la Fig. 6(b) montrent que le Hf0,67 Zr0.33 O2 Le transistor NC présente la chute soudaine de certains points de SS du transistor NC à V DS = − 0,05 V. La figure 6(c) présente le I DS de Hf0.67 Zr0.33 O2 Ge NCFET recuits à 450°C, 500°C et 550°C, à V DS = − 0,05 V et − 0,5 V, et |V GS –V TH | = 1.0 V. De même, I DS augmente à mesure que la température RTA augmente.
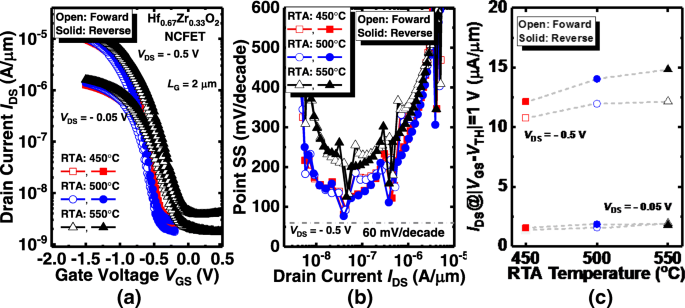
(un ) Mesuré I DS -V GS du Hf0.67 Zr0.33 O2 NC Ge pFET recuits à 450 °C, 500 °C et 550 °C. (b ) Point SS contre IDS caractéristiques des appareils. (c ) Je DS pour les transistors ferroélectriques NC avec différentes températures de recuit à une surcharge de grille de 1 V
La stabilité de l'effet NC induit par la couche ferroélectrique du Hf0,52 Zr0.48 O2 Le NCFET a été vérifié par plusieurs mesures de balayage en courant continu. Le I mesuré DS -V GS les courbes sur 100 cycles de balayage CC sont illustrées à la figure 7(a). On peut voir que les valeurs de V GS correspondant à des SS raides sont cohérents. De plus, le sens des aiguilles d'une montre I-V les boucles sont maintenues à travers les multiples balayages CC. Les points SS raides sont reproductibles et stables grâce à plusieurs balayages CC, ce qui prouve en outre qu'ils sont induits par l'effet NC. La figure 7(b) présente le meilleur point SS et le meilleur courant d'entraînement sur le nombre de cycles de balayage. La figure 7(c) montre les caractéristiques d'hystérésis en fonction du nombre de cycles de balayage CC. I-V stable une fenêtre d'hystérésis de ~ 82 mV est visible.
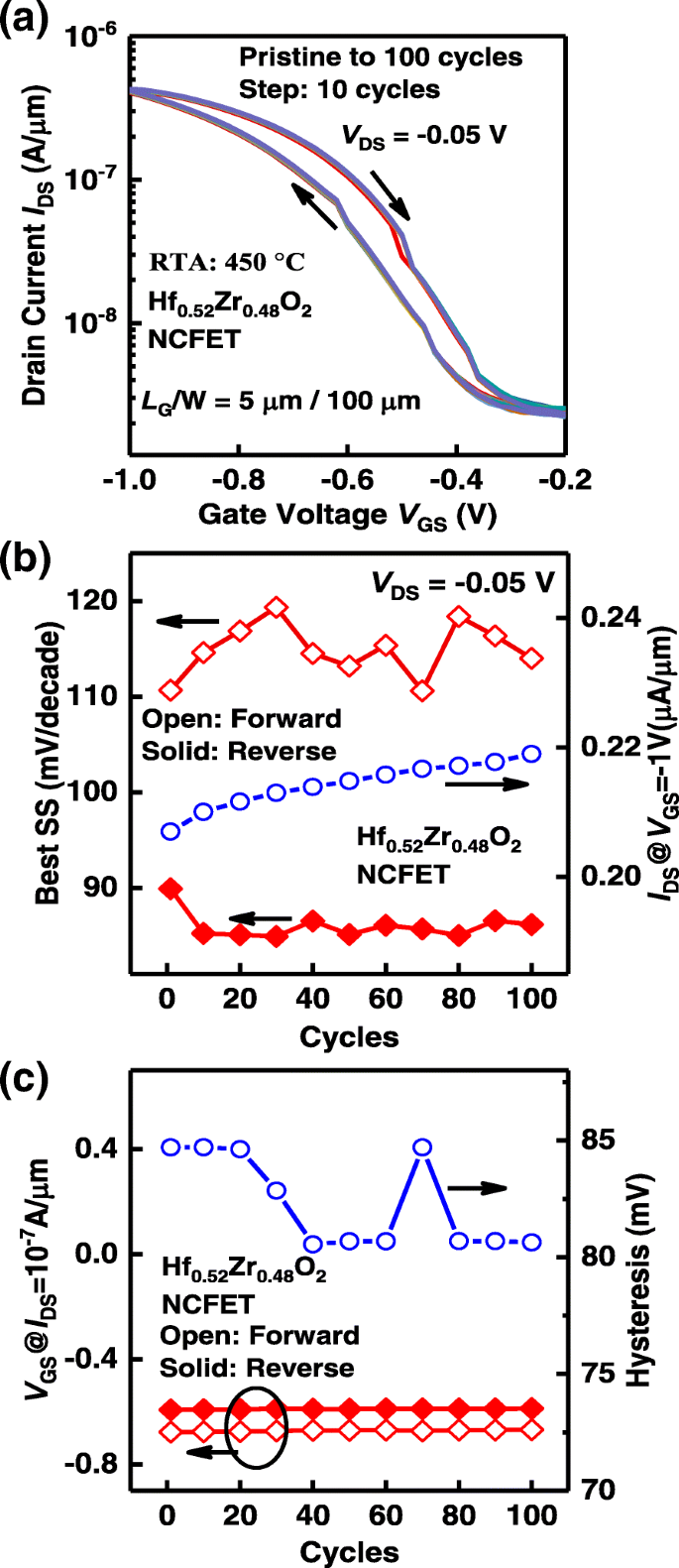
(un ) Mesuré I DS -V GS courbes d'un Hf0,52 Zr0.48 O2 NC Ge pFET sur 100 cycles de balayage CC. (b ) Meilleur point SS et I DS par rapport au nombre de cycles. (c ) Caractéristiques d'hystérésis en fonction du nombre de cycles de balayage DC
Nous résumons l'hystérésis et les caractéristiques de courant d'entraînement des Ge NCFET avec différentes compositions de Zr dans Hf1−x Zrx O2 sur la figure 8. Comme indiqué sur la figure 8(a), les valeurs d'hystérésis sont de 70, 148 et 106 mV pour les appareils avec x = 0,33, 0,48 et 0,67, respectivement, à un V DS de – 0,5 V. Au fur et à mesure que la composition augmente de 0,33 à 0,48, l'hystérésis du dispositif NC augmente de manière significative. Avec l'augmentation supplémentaire de la composition en Zr, l'hystérésis diminue rapidement. Le Je DS des NCFET recuits à 450°C sont représentés sur la figure 8(b), à V DS = − 0. 5 V et V GS − V TH = − 1. 0 V. Ouvert et solide représentent respectivement le balayage avant et arrière. L'appareil CN avec Hf0,52 Zr0.48 O2 atteint le I le plus élevé DS , mais son hystérésis est sérieuse. NCFET avec Hf0.67 Zr0.33 O2 peut obtenir d'excellentes performances avec des courbes sans hystérésis et un I élevé DS . À mesure que la composition de Zr augmente, la capacité ferroélectrique C fe (= 0.3849*P r /(E c *t fe ) [24]) augmente avec l'augmentation de P r , et pendant ce temps, la capacité MOS (C MOS ) augmente également en raison de la permittivité croissante du film HZO. Le Je DS et l'hystérésis sont déterminés par |C fe | et C MOS du transistor. Avec une composition en Zr passant de 0,33 à 0,48, l'augmentation de |C fe | est supposé être plus lent que le C MOS , conduisant à l'élargissement de l'hystérésis. Néanmoins, le plus grand C MOS produit un I plus élevé DS . Avec l'augmentation supplémentaire de la composition de Zr, l'augmentation de |C fe | est plus rapide que C MOS , ce qui pourrait fournir |C fe | ≥ C MOS , réduisant l'hystérésis du NCFET.
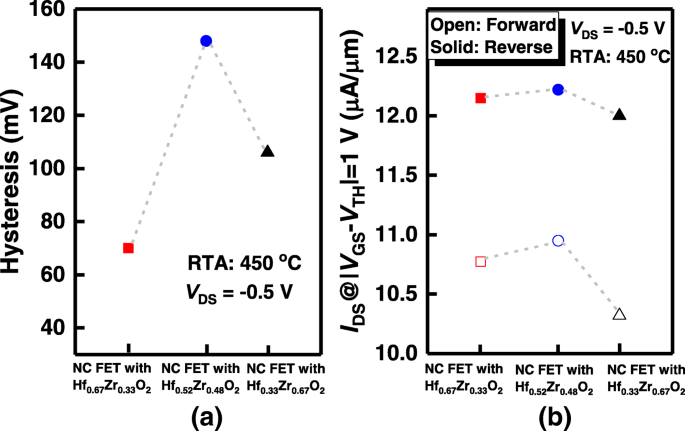
Graphiques statistiques de (a ) hystérésis et (b ) Je DS de Ge NCFET avec Hf1−x Zrx O2 (x = 0,33, 0,48 et 0,67)
Conclusions
Les impacts de la température de recuit et de la composition en Zr dans Hf1−x Zrx O2 sur les performances électriques des NCFET Ge sont étudiées expérimentalement. Les stoechiométries et propriétés ferroélectriques de Hf1−x Zrx O2 ont été confirmés par XPS et P-V mesures, respectivement. Les NCFET démontrent le point abrupt SS et l'amélioration I DS par rapport au dispositif de commande, en raison de l'effet NC. Le V TH et Je DS du Hf1−x Zrx O2 Les NCFET sont fortement affectés par la température de recuit. De multiples mesures de balayage DC montrent que la stabilité de l'effet NC induit par la couche ferroélectrique est obtenue en NCFET. Hf0.67 Zr0.33 O2 Le NCFET peut plus facilement atteindre les caractéristiques sans hystérésis que les appareils avec une composition en Zr plus élevée.
Abréviations
- Al2 O3 :
-
Oxyde d'aluminium
- ALD :
-
Dépôt de couche atomique
- BF2 + :
-
Ion fluorure de bore
- DC :
-
Courant continu
- Voir :
-
Germanium
- GeOx :
-
Oxyde de Germanium
- HF :
-
Acide fluorhydrique
- HfO2 :
-
Dioxyde d'hafnium
- HRTEM :
-
Microscope électronique à transmission haute résolution
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- NC :
-
Capacité négative
- Non :
-
Nickel
- SS :
-
Balançoire sous le seuil
- TaN :
-
Nitrure de tantale
- TDMAHf :
-
Tetrakis (diméthylamido) hafnium
- TDMAZr :
-
Tétrakis (diméthylamido) zirconium
Nanomatériaux
- Champs électriques et capacité
- Facteurs affectant la capacité
- Dispositifs à effet Hall numériques (ON/OFF) :commutateurs et loquets
- Détection de position à effet Hall :Linéarité et pente de réponse pour les configurations de glissement
- Espaceurs d'air pour puces 10 nm
- Un saut nanométrique à des milliards de transistors
- Effet de l'irradiation ultraviolette sur les caractéristiques des diodes 4H-SiC PiN
- Effet du traitement de recuit in situ sur la mobilité et la morphologie des transistors à effet de champ organiques à base de TIPS-Pentacène
- Effet du polyéthylène glycol sur la photocathode NiO



