Double fonction du périphérique V/SiOx/AlOy/p++Si comme sélecteur et mémoire
Résumé
Cette lettre présente des fonctions doubles comprenant le sélecteur et la commutation de mémoire dans un V/SiOx /AlOy /p ++ Dispositif de mémoire résistive Si en contrôlant simplement la limite de courant de conformité (CCL). Une commutation de seuil unidirectionnelle est observée après une formation positive avec un faible CCL de 1 μA. Les déplacements vers le côté électrode V de l'oxygène forment le VOx couche, où la commutation de seuil peut être expliquée par le phénomène de transition métal-isolation. Pour un CCL plus élevé (30 μA) appliqué à l'appareil, une commutation de mémoire bipolaire est obtenue, qui est attribuée à la formation et à la rupture du filament conducteur en SiOy couche. AlOy de 1,5 nm d'épaisseur couche à haute conductivité thermique joue un rôle important dans l'abaissement du courant de coupure pour la commutation de mémoire et de seuil. Grâce à la dépendance à la température, la barrière à haute énergie (0,463 eV) dans le LRS est confirmée, ce qui peut provoquer une non-linéarité dans un état de faible résistance. Plus le CCL est petit, plus la non-linéarité est élevée, ce qui fournit une plus grande taille de tableau dans le tableau de points de croisement. La coexistence de la mémoire et de la commutation de seuil conformément à la CCL offre la flexibilité de contrôler l'appareil pour son utilisation prévue.
Contexte
La mémoire résistive à accès aléatoire (RRAM) est l'un des candidats prometteurs pour la technologie de mémoire non volatile de nouvelle génération en raison de sa vitesse de commutation rapide [1, 2], de sa faible consommation d'énergie [3,4,5,6,7 ,8], capacité à plusieurs niveaux [9,10,11,12,13,14,15], haute évolutivité [16,17,18,19,20] et capacité d'empilement 3D [21,22,23,24,25 ]. Ces propriétés sont particulièrement adaptées à la mémoire de classe de stockage (SCM) qui peut combler l'écart de performances entre la mémoire vive dynamique (DRAM) en tant que mémoire principale et le disque à semi-conducteurs (SSD) en tant que mémoire de stockage. Même si le périphérique RRAM a beaucoup progressé ces dernières années [1,2,3,4,5,6,7,8,9,10,11,12,13,14,15,16,17,18,19 ,20,21,22,23,24,25], il reste cependant un inconvénient majeur :le courant furtif à travers les cellules voisines se produit dans un réseau de points de croisement à haute densité [26]. Le dispositif de mémoire avec le composant sélecteur doit fournir des caractéristiques courant-tension (I-V) non linéaires pour surmonter ce problème [26,27,28,29,30,31,32,33,34,35]. Jusqu'à présent, divers dispositifs avec des concepts non linéaires tels que la commutation résistive complémentaire (CRS) [26], la barrière tunnel [27,28,29,30,31,32,33], la commutation à seuil basée sur Ag [34], le type diode sélecteur [35, 36], commutation de seuil ovonique (OTS) [37, 38] et transition métal-isolant (MIT) [39, 40, 41, 42, 43] ont été rapportés. VO x comme l'un des matériaux typiques du MIT, pourrait être largement utilisé dans des applications potentielles en tant que composant de commutation optique et électrique [40,41,42]. SiO2 est largement utilisé comme couche de passivation dans l'industrie des semi-conducteurs. De plus, le SiOx riche en Si (x < 2) peut être utilisé comme couche de changement de résistance dans la RRAM [44,45,46,47,48,49,50,51,52,53,54,55]. SiOx peut être préféré à de nombreux autres matériaux en termes de compatibilité avec les procédés CMOS et de faible coût. SiOx Il a été rapporté que les dispositifs RRAM à base de RRAM agissent comme médiateurs du rôle des ponts conducteurs en utilisant simplement des électrodes telles que Cu et Ag avec une diffusivité élevée [44,45,46,47]. Dans un autre cas, la commutation de mémoire est induite par l'effet de changement de valence à l'intérieur du SiOx couche, ce qui peut être expliqué par la génération de lacunes d'oxygène ou le modèle d'échange de protons [48,49,50,51,52,53,54,55]. Dans la commutation unipolaire où une opération réglée précède une réinitialisation, il est sensible à l'atmosphère ambiante. Les performances de commutation dans l'air sont significativement dégradées [48,49,50,51,52,53]. D'autre part, la commutation filamentaire sans effets de balayage arrière montre une commutation unipolaire et bipolaire typique dans divers SiOx Périphériques RRAM basés sur [52,53,54].
Ici, nous présentons la coexistence de la commutation de seuil et de la commutation de mémoire dans V/SiOx /AlOy /p ++ Dispositif Si en fonction de la limite de courant de conformité (CCL). Le dispositif avec électrode inférieure en silicium (BE) présente plusieurs avantages par rapport à l'électrode métallique classique. Le dispositif RRAM avec mémoire ou commutation de seuil est directement connecté au côté source ou drain dans un transistor, ce qui est une application potentielle pour la mémoire embarquée et le dispositif à forte pente. Le courant de dépassement pourrait être réduit en raison de la résistance série du Si BE. De plus, la nano-pointe de silicium BE par gravure humide et l'ajustement de la concentration de dopage dans la surface du silicium peuvent améliorer les performances de commutation. L'AlOy La couche, qui est une large bande interdite avec une propriété isolée, aide à abaisser le courant de fonctionnement pendant la commutation de seuil et de mémoire. Le SiOx La couche agit comme une couche de commutation de mémoire à un CCL élevé, tandis qu'elle sert à fournir de l'oxygène à V TE à un CCL faible, ce qui permet une commutation de seuil.
Méthodes
V/SiOx /AlOy /p ++ L'appareil Si a été fabriqué comme suit :tout d'abord, BF2 des ions ont été implantés avec une énergie d'accélération de 40 keV et une dose de 5 × 10 15 cm −2 dans un substrat de Si à Si BE fortement dopé. Les dommages du réseau ont été guéris par le processus de recuit à 1050 °C pendant 10 min. Le Si BE fortement dopé avait une résistance de couche de 30,4 Ω/□. Ensuite, un AlOy de 1,5 nm d'épaisseur couche a été déposée par un système de dépôt de couche atomique (ALD) utilisant H2 O et Al (CH3 )3 et un SiOx de 5,5 nm d'épaisseur couche a subi un dépôt chimique en phase vapeur assisté par plasma (PECVD) en faisant réagir 5 % de SiH4 /N2 (160 sccm), N2 O (1300 sccm) et N2 (240 scccm) à 300 °C. Par la suite, une électrode supérieure (TE) en vanadium (V) de 50 nm d'épaisseur et d'un diamètre de 100 μm a été déposée par pulvérisation cathodique CC d'une cible en V avec du gaz Ar (30 sccm). Enfin, un Al de 50 nm d'épaisseur en tant que couche protectrice a été déposé par pulvérisation cathodique DC pour empêcher une oxydation supplémentaire de V TE. Toutes les propriétés électriques ont été caractérisées via les modes de balayage de tension continue et d'impulsion à l'aide d'un analyseur de paramètres à semi-conducteurs (SPA) Keithley 4200-SCS et d'un module courant-tension (I-V) ultra-rapide 4225-PMU à température ambiante, respectivement. Pour le fonctionnement de l'appareil, le TiN BE était mis à la terre et la polarisation Ni TE était contrôlée.
Résultats et discussion
La figure 1a montre la structure schématique de V/SiOx /AlOy /p ++ Appareil Si. Trois V amorphes, SiOx , et AlOy les couches et la couche de Si monocristallin sont observées par une image en coupe transversale de microscopie électronique à transmission (MET), comme le montre la figure 1b. Les épaisseurs du SiOx et AlOy les couches sont respectivement de 5,5 et 1,5 nm. Pour confirmer le rapport de composition de deux films diélectriques, une analyse XPS a été effectuée (Fichier supplémentaire 1). Le x valeur de SiOx et le y valeur de AlOy sont respectivement de 0,88 et 1,33. Notre SiOx film utilisant PECVD par rapport à SiO2 déposés par oxydation sèche est déposé à une température beaucoup plus basse et présente beaucoup plus de défauts, ce qui les rend adaptés à la commutation résistive à des tensions relativement plus basses. La figure 2a montre une commutation de seuil typique de V/SiOx /AlOy /p ++ Appareil Si. La commutation initiale avec un processus de formation positif nécessite une tension plus élevée que la commutation de seuil ultérieure étant donné que les couches diélectriques ont initialement des défauts plus petits. Un CCL de 1 μA est appliqué à l'appareil pour éviter la formation de filaments conducteurs excessifs dans le SiOx couche. Le courant de fuite est très faible (100 pA à 1 V) par rapport à la commutation de seuil précédemment signalée de VOx . Cet avantage est attribué à l'Al2 O3 avec une permittivité et une conductivité thermique plus élevées par rapport au SiO2 . L'état bloqué a la propriété isolante car les filaments se rompent facilement et il n'y a alors plus de filaments. Un mécanisme possible de commutation de seuil est l'oxydation du V TE à partir de l'oxygène fourni par le SiOx couche pendant le processus de formage positif comme le montre la figure 2b. La propriété électrique de VOx entre V TE et SiOx couche peut passer de l'état isolant à l'état métallique, provoquant un changement soudain de résistance. Un faible CCL de 1 μA n'est pas suffisant pour produire des filaments conducteurs efficaces à l'intérieur du SiOx film. Par conséquent, SiOx avec des propriétés isolantes peut être une autre cause pour réduire le courant de coupure. Pour un processus de formage négatif de V/SiOx /AlOy /p ++ Si appareil, une commutation de seuil n'est pas observée (voir Fichier supplémentaire 1). Lorsque la polarisation négative est appliquée au V TE, le mouvement de l'oxyde se déplace vers le Si BE, de sorte que le V TE ne peut plus participer à la commutation de seuil en tant que VOx . L'encart de la figure 2a montre la tension de seuil (Vth ) et maintenir la tension (Vhold ) pendant les 100 cycles. Le Vème où le courant augmente fortement avec une pente presque infinie comprise entre 1,08 et 1,82 V, et Vhold auquel point le retour du courant à un état de résistance élevée est compris entre 0,12 et 0,54 V. La figure 2c montre les caractéristiques I-V du courant de passage à différentes températures. À 25 °C et 55 °C, ils présentent une commutation de seuil presque similaire, mais la courbe I-V à une température plus élevée de 85 °C perd la propriété de commutation de seuil. Il est bien connu que VOx perd son MIT à haute température. Ainsi, ce résultat est une autre preuve que VOx est la principale cause de la commutation de seuil. La figure 2d montre les caractéristiques transitoires pour la commutation de seuil. L'impulsion d'une amplitude de 1 V surveillait le courant de lecture avant et après l'écriture d'une impulsion d'une largeur de 1 μs. Le courant élevé a été surveillé pendant que l'impulsion de haute amplitude est appliquée à l'appareil, puis le V/SiOx /AlOy /p ++ L'appareil Si a coupé le courant immédiatement après la suppression de l'impulsion d'écriture. Les propriétés du sélecteur analysées ci-dessus peuvent être utilisées lorsqu'elles sont combinées avec le fonctionnement d'éléments de mémoire inférieurs à 1 μA [55, 56].
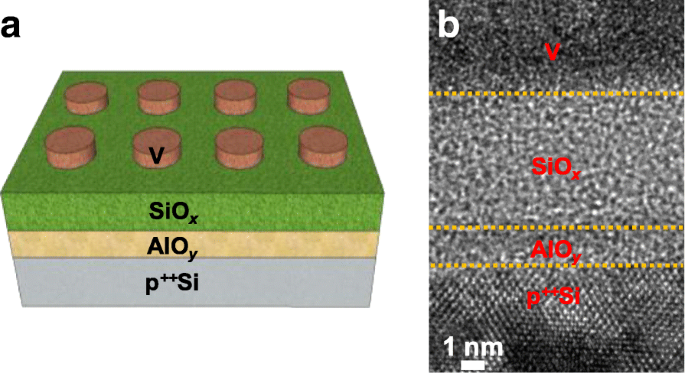
Configuration de l'appareil de V/SiOx /AlOy /p ++ Si. un Dessin schématique et b Image TEM

Commutation de seuil unidirectionnelle de V/SiOx /AlOy /p ++ Si lorsqu'un formage positif avec CCL de 1 μA est appliqué. un Courbes I-V typiques. b Dessin schématique du processus de formage. c Caractéristiques I–V en fonction de la température. d Caractéristiques transitoires
La figure 3a montre la commutation résistive bipolaire de V/SiOx /AlOy /p ++ Dispositif Si après un formage positif avec CCL de 100 μA. Ensuite, le processus de réinitialisation avec une augmentation rapide de la résistance est effectué en balayant la tension négative, et l'appareil est commuté dans un état de résistance élevée (HRS). Le processus défini avec une diminution rapide de la résistance se produit alors à une tension de polarisation positive, provoquant le retour de l'appareil à un état de faible résistance (LRS). Afin de comprendre les propriétés du filament conducteur, nous observons la conductance normalisée et la dépendance à la température. La conduction dans le LRS est une directive importante pour informer indirectement les propriétés du filament conducteur. La figure 3b montre la conductance normalisée (GN ) qui est définie comme la conductance dynamique (Gd ) diviser par la conductance statique (G0 ) pour les courbes I–V de V/SiOx /AlOy /p ++ Dispositif Si dans le LRS avec différentes températures. Quelle que soit la température, le GN la valeur converge vers 1 lorsque la tension est nulle. Cela nous permet d'exclure les mécanismes de conduction bien connus tels que l'émission de Schottky, l'effet tunnel de Fowler-Nordheim et la loi de Child (I~V 2 ) en courant à charge limitée (SCLC). La conduction ohmique métallique peut également être exclue compte tenu de la dépendance à la température, comme le montre la figure 3c. La diminution de la résistance avec l'augmentation de la température suggère que le filament conducteur a une propriété semi-conductrice. Ainsi, on peut exclure la pénétration de V dans le SiOx couche pour le filament conducteur principal de V/SiOx /AlOy /p ++ Appareil Si dans LRS. Par conséquent, le fonctionnement de la mémoire bipolaire du V/SiOx /AlOy /p ++ Le dispositif Si est dominé par la commutation intrinsèque de SiOx . Il est également confirmé que les courants positifs et négatifs ne sont pas très différents, ce qui suggère que plutôt qu'un type d'interface tel que l'émission Schottky, il est dominé par la conduction en masse. Compte tenu de la conductance normalisée mentionnée ci-dessus, il existe deux mécanismes de conduction dominante en volume possibles. La première est la conduction par saut selon la formule :
$$ J={qnav}_o{e}^{-q{\o}_T/ kT}{e}^{qaV/2 dkT} $$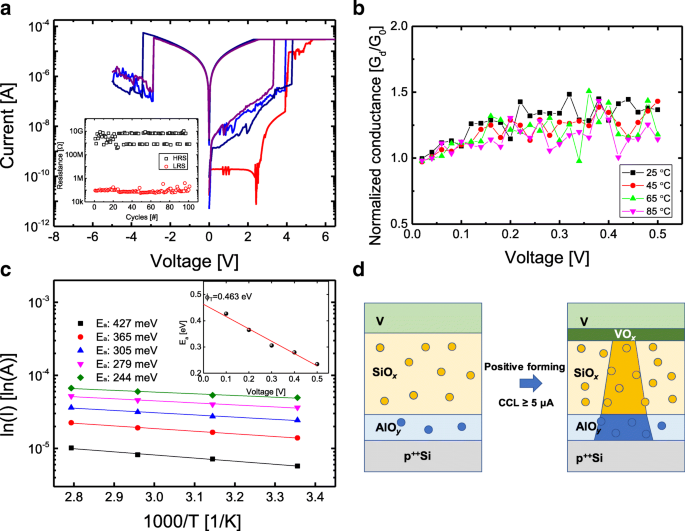
Commutation mémoire de V/SiOx /AlOy /p ++ Si lorsqu'un formage positif avec CCL de 30 μA est appliqué. un Courbes I-V typiques. b Conductance normalisée. c En (I) contre 1000/T. d Schéma du processus de formage
où q , n , un , ø T , v o , et d sont la charge électrique, la concentration de la charge d'espace, la moyenne de la distance de saut, la hauteur de la barrière électronique pour le saut, la fréquence de vibration intrinsèque et l'épaisseur du film diélectrique, respectivement. Le ø T calculé à partir de la pente d'un tracé linéaire de ln (I) par rapport à 1000/T est de 0,463 eV, comme le montre la figure 3c. Une valeur calculée à partir de la relation entre Ea et V est de 5,17 nm, indiquant le filament conducteur formé dans le SiOx n'est pas fort et est proche de l'état HRS. L'autre mécanisme de conduction, l'émission Poole-Frenkel (P-F), a été traité dans le fichier supplémentaire 1. Sur la base des résultats ci-dessus, le modèle de filament conducteur dans l'opération de mémoire de V/SiOx /AlOy /p ++ Le dispositif Si est représenté sur la Fig. 3d. Dans le processus de formage positif, le processus d'oxydation s'est déroulé du côté V TE, mais en raison du CCL élevé, un filament conducteur peut se former à l'intérieur du SiOx et AlOy en raison du mouvement des lacunes d'oxygène. Pendant le processus de réinitialisation, le champ électrique opposé au formage et au durcissement induit de l'oxygène et une recombinaison avec la lacune d'oxygène, entraînant la rupture du filament conducteur. On constate que les opérations de sélection et de mémoire sont observées dans la même cellule. L'opération de mémoire est possible après que l'opération de seuil s'est produite, puis le commutateur est complètement éteint. Cependant, le sens inverse n'est pas possible car la commutation de réinitialisation de l'opération de mémoire n'est pas complètement désactivée.
La figure 4a montre les courbes I-V normalisées dans le LRS de V/SiOx /AlOy /p ++ Dispositif Si en régime basse tension (0~1 V) pour différentes conditions CCL (5 μA, 30 μA et 1 mA). Ici, la courbe I-V normalisée est définie comme le courant à chaque tension divisé par le courant à 1 V. Étant donné que les niveaux du courant LRS en fonction du CCL varient, nous définissons la valeur du courant à 1 V pour comparer facilement le non-linéarité. On peut observer que lorsque le CCL diminue, le courant est supprimé à un régime de tension inférieur. Afin de dériver une relation plus quantitative, la non-linéarité est définie comme le rapport du courant à VREAD à celui à la moitié de VREAD . La figure 4b montre le courant de lecture à 1 V et la non-linéarité en fonction de CCL pour V/SiOx /AlOy /p ++ Appareil Si. La diminution du courant de lecture due à la réduction du CCL suggère que le filament conducteur devient plus fin et que la non-linéarité augmente. Le film d'oxyde de silicium intrinsèque présente une non-linéarité élevée même dans une seule couche. La propriété non linéaire intrinsèque est due à la nature massive de l'oxyde de silicium plutôt qu'à l'interface du silicium. Plus le CCL est petit, moins la dégradation est générée dans le SiOx , de sorte que l'abaissement du niveau d'énergie du piège dans le LRS par rapport à celui du HRS peut être minimisé. Par conséquent, la barrière énergétique la plus élevée peut maximiser la non-linéarité dans l'état LRS lorsqu'une CCL inférieure est appliquée au dispositif. De même, la conduction décrite par l'émission P-F dans le TaOx /TiOy pile assure une non-linéarité élevée [57]. Une autre possibilité est que, parce que la constante diélectrique de l'oxyde est plus petite, davantage de passages sont effectués sur le film d'oxyde en raison de la concentration du champ. Cela peut conduire à l'abaissement du niveau d'énergie du piège de la couche d'oxyde, qui peut servir de barrière tunnel pour Al2 O3 . Pour obtenir la marge de lecture (∆V) en n × n tableau de points de croisement, nous utilisons le circuit équivalent simplifié comme illustré à la Fig. 4c. Dans le pire des cas, les cellules adjacentes sont réglées sur le LRS et la résistance de charge (RL ) à la résistance LRS. Le ∆V a été calculé à partir de la différence entre VOUT à LRS et VOUT chez HRS. La figure 4d montre le V en fonction du nombre de lignes de mots (n ) pour V/SiOx /AlOy /p ++ Appareil Si. Plus le CCL est petit, plus le V est élevé car la non-linéarité augmente. Lorsque la marge de lecture de 10 % est sécurisée, la matrice peut être étendue à environ plus de 10 × 10 pour un CCL de 5 μA et à 5 × 5 pour un CCL de 1 mA. La taille du tableau pour résister au courant de fuite n'est pas suffisante, mais cela aidera à étendre la taille du tableau lorsque l'appareil avec fonction de sélection est connecté dans un V/SiOx /AlOy /p ++ Appareil Si. Par rapport à 0,5 V lu dans tous les CCL, il présente une non-linéarité plus élevée avec une lecture à 1 V. Bien que faible VREAD conduit à une faible puissance statique dans l'opération de lecture, la valeur de la non-linéarité devient plus petite, ce qui est dû au fait que le champ électrique est moindre sur le SiOx /AlOy couche en plus petit VREAD .

Caractéristiques non linéaires de V/SiOx /AlOy /p ++ Si pour la commutation de mémoire. un Courbes I–V avec différents CCL. b Lire le courant et la non-linéarité en tant que fonctions de CCL. c Circuits équivalents du réseau de points croisés. d Marge de lecture en fonction du numéro de ligne de mot pour différents CCL et tension de lecture
Conclusions
Dans ce travail, un V/SiOx /AlOy /p ++ Un dispositif Si ayant à la fois un sélecteur et une fonction de mémoire en contrôlant simplement CCL est étudié. Lorsqu'un CCL de 1 μA ou moins est appliqué, une commutation de seuil unidirectionnelle est observée pour l'application du sélecteur. La formation positive oxyde l'électrode V et le phénomène MIT de VOx peut induire une commutation de seuil. L'AlOy couche est capable d'atteindre une sélectivité élevée de 10 4 en abaissant le courant de coupure. D'autre part, lorsqu'un CCL de 5 μA ou plus est appliqué, une commutation de mémoire est observée car des filaments conducteurs efficaces se forment sur le SiOx couche. Plus le CCL est bas, plus la non-linéarité est grande, ce qui contribue à augmenter la taille du tableau de points de croisement.
Abréviations
- ALD :
-
Dépôt de couche atomique
- BE :
-
Électrode inférieure
- CCL :
-
Limite actuelle de conformité
- CRS :
-
Commutation résistive complémentaire
- DRAM :
-
Mémoire vive dynamique
- HRS :
-
État de haute résistance
- I–V :
-
Courant-tension
- LRS :
-
État de faible résistance
- MIT :
-
Métal-isolant-transition
- OTS :
-
Commutation de seuil ovonique
- PECVD :
-
Dépôt chimique en phase vapeur assisté par plasma
- P-F :
-
Poole-Frenkel
- RRAM :
-
Mémoire vive résistive
- SCLC :
-
Courant limité dans l'espace
- GDS :
-
Mémoire de classe de stockage
- SPA :
-
Analyseur de paramètres de semi-conducteurs
- SSD :
-
Disque SSD
- TE :
-
Électrode supérieure
- TEM :
-
Microscopie électronique à transmission
- V :
-
Vanadium
Nanomatériaux
- Termes et concepts de la mémoire numérique
- Qu'est-ce qu'un système d'exploitation et ses composants
- Gestion de la mémoire C++ :création et suppression
- Mémoire de partition – introduction et services de base
- Les processeurs prennent en charge la convergence de l'IoT et de l'IA
- Contrôle de la double non-linéarité des propriétés de mode et de dispersion dans le guide d'ondes plasmonique graphène-diélectrique
- Fabrication IoT :définition, fonctions et exemples
- Pièces de machine à sous et leurs fonctions
- Types de différentiel et leurs fonctions



