Grand effet photovoltaïque latéral dans l'hétérojonction MoS2/GaAs
Résumé
Bisulfure de molybdène (MoS2 ) des films nanométriques sont déposés sur des substrats de GaAs par pulvérisation cathodique magnétron, et MoS2 Des hétérojonctions /GaAs sont fabriquées. L'effet photovoltaïque latéral (LPE) du MoS2 fabriqué Les hétérojonctions /GaAs sont étudiées. Les résultats montrent qu'un grand LPE peut être obtenu dans le MoS2 /n -Hétérojonction GaAs. Le LPE présente une dépendance linéaire de la position de l'éclairage laser et de la sensibilité considérablement élevée de 416,4 mV mm − 1 . Cette sensibilité est beaucoup plus grande que les valeurs des autres MoS2 signalés -appareils basés. Comparativement, le LPE dans le MoS2 /p L'hétérojonction -GaAs est beaucoup plus faible. Les mécanismes du LPE sont dévoilés en construisant l'alignement des bandes d'énergie du MoS2 /Hétérojonctions GaAs. Les excellentes caractéristiques LPE font de MoS2 films combinés avec des semi-conducteurs GaAs candidats prometteurs pour l'application de détecteurs sensibles à la position haute performance.
Contexte
En raison de ses excellentes propriétés, le bisulfure de molybdène (MoS2 ) est à l'étude comme un type typique de matériaux bidimensionnels pour développer des dispositifs microélectroniques et des dispositifs optoélectroniques de nouvelle génération [1,2,3,4,5]. Contrairement au graphène, MoS2 a une bande interdite évidente et sa bande interdite diminue avec l'augmentation du nombre de couches [6]. La présence de la bande interdite évidente permet la fabrication du MoS2 transistors avec un rapport marche/arrêt supérieur à 10 8 et les photodétecteurs à haute réactivité [7, 8]. Récemment, MoS2 combiné avec d'autres semi-conducteurs a suscité beaucoup d'intérêt, tels que GaAs, Si et GaN [9,10,11,12,13]. Ces hétérostructures conçues fournissent une voie technique réalisable pour MoS2 à base de matériaux pour développer des dispositifs optoélectroniques applicables dans la pratique. Parmi tous ces semi-conducteurs en vrac, GaAs a une bande interdite directe appropriée de ~ 1,42 eV et une mobilité électronique élevée (~ 8000 cm 2 V −1 s −1 ). Lin et al. MoS fabriqué2 Cellules solaires /GaAs avec un rendement de conversion de puissance supérieur à 9,03 % [9]. De plus, Xu et al. signalé un MoS2 Photodétecteur auto-piloté /GaAs avec une détectivité extrêmement élevée de 3,5 × 10 13 Jones [10]. Dans les rapports précédents, les études sur MoS2 Les hétérostructures /GaAs ont été principalement axées sur l'application dans le domaine des cellules solaires et des photodétecteurs. Cependant, le MoS2 /GaAs en tant que détecteur sensible à la position (PSD) basé sur l'effet photovoltaïque latéral (LPE) a été rarement signalé. Différent de l'effet photovoltaïque longitudinal ordinaire, le LPE provient de la diffusion latérale et de la recombinaison des porteurs générés par les photons dans la couche d'inversion à l'interface [14,15,16,17,18]. Dans l'effet LPE, une tension photovoltaïque latérale (LPV) peut être obtenue et elle change linéairement avec la position du spot laser sur la région active de la surface du dispositif. Ces caractéristiques rendent LPE très utile dans le développement de PSD hautes performances et ont été largement étudiées dans les domaines de la robotique, des applications biomédicales, du contrôle de processus, des systèmes d'information de position, etc.
Dans ce travail, MoS2 des films minces d'épaisseurs différentes sont déposés sur la surface de n -/p -Substrats de GaAs par pulvérisation cathodique magnétron. Un grand LPE est observé dans le MoS2 fabriqué /n -Hétérojonction GaAs, et la sensibilité atteint 416,4 mV mm −1 . Nos résultats montrent en outre que le LPE présente une dépendance évidente vis-à-vis des types de porteurs des substrats GaAs et de l'épaisseur du MoS2 cinéma. Grâce à la construction de l'alignement de la bande d'énergie à l'interface, les mécanismes du LPE dans les dispositifs sont proposés.
Méthodes
MoS2 des films minces ont été déposés sur des substrats GaAs orientés (100) en utilisant la technique de pulvérisation cathodique magnétron DC. Le MoS2 les poudres (pureté, ~ 99%) ont été pressées à froid dans un disque sous la pression de 20,0 MPa. Le disque brut de fabrication (Φ60,0 mm × 4,5 mm) a été utilisé comme cible pendant la pulvérisation. Le n- /p Des substrats -GaAs ont été utilisés dans nos expériences, respectivement. Avant le dépôt, les substrats ont été nettoyés par ultrasons en séquence avec de l'alcool, de l'acétone et de l'eau désionisée. Par la suite, MoS2 films minces de différentes épaisseurs (d MoS2 =~ 10, 30, 50, 90 nm) ont été cultivés sur les substrats de GaAs à la température de 400 °C, respectivement. Pendant le dépôt, la pression et la puissance de travail ont été maintenues à 1,0 Pa et 10,0 W, respectivement. À titre de référence, MoS2 des couches minces ont également été déposées sur GaAs intrinsèque (i -GaAs) substrats dans les mêmes conditions. Enfin, des pastilles d'environ 300 µm d'In d'un diamètre de 0,5 mm sous forme d'électrodes ont été pressées sur le MoS2 filmer.
Le MoS2 les films ont été caractérisés par spectroscopie Raman (HORIBA, HR800) avec une longueur d'onde d'excitation de 488 nm. La surface de l'échantillon a été balayée par un microscope à force atomique (AFM). La spectroscopie de photoémission aux rayons X (XPS) a été réalisée par un spectromètre Kratos Axis ULTRA avec une source de rayons X monochromatique Al Kα. Le taux de dépôt a été obtenu par l'épaisseur du microscope électronique à balayage en coupe (MEB) (Fichier supplémentaire 1 :Figure S1) et le temps de dépôt, puis chaque épaisseur de film a été déterminée par le taux de dépôt et chaque temps de dépôt. Les spectres de transmission ont été mesurés par le spectrophotomètre Shimadzu UV-3150. La spectroscopie de photoélectrons ultraviolets (UPS) a été réalisée en utilisant une lampe à décharge gazeuse He-I (21,22 eV) non filtrée. Les LPV ont été mesurées à l'aide d'un voltmètre Keithley 2000 et d'une platine motorisée électrique tridimensionnelle avec un laser d'une longueur d'onde de 650 nm comme source d'éclairage. Le courant-tension (I -V ) les courbes ont été mesurées avec un Keithley 2400 SourceMeter.
Résultats et discussion
La figure 1 montre le spectre Raman du MoS2 film sur le substrat de GaAs. Outre le pic du substrat GaAs à ~ 287,1 cm −1 , deux caractéristiques MoS2 On peut voir des pics Raman, le A1g mode à ∼ 406,7 cm −1 et E 1 2g mode à ∼ 378,9 cm −1 . Les deux encarts de droite montrent l'illustration de la vibration atomique dans MoS2 . Le A1g le mode correspond aux atomes S oscillant en antiphase le long de la direction hors plan, et le E 1 2g mode correspond aux atomes S et Mo oscillant en antiphase parallèlement au plan cristallin. Comme le montre la figure, le pic Raman correspondant au A1g mode est préférentiellement excité pour le film. D'après nos mesures, le rapport d'intensité de A1g /E 1 2g est d'environ 2,1. Ces caractéristiques Raman sont similaires à d'autres résultats rapportés sur MoS2 films minces [19]. L'encart de gauche montre une image topographique AFM du MoS 40 nm2 film développé sur le substrat GaAs. D'après la figure, nous pouvons voir que la surface du film est composée de grains denses en forme de cône. D'après les mesures, la rugosité quadratique moyenne (RMS) du film est d'environ 1,7 nm et la taille moyenne des grains est d'environ 76,3 nm de diamètre. Ces grains à la surface pourraient diminuer la réflexion de la surface vers la lumière externe et améliorer l'absorption lumineuse de l'appareil fabriqué.

Spectre Raman du MoS2 film sur GaAs. Les deux encarts de droite montrent les illustrations schématiques du mode d'oscillation de E 1 2g et A1g , respectivement. Code couleur de l'atome :bleu-vert clair, Mo ; jaune, S. L'encart de gauche montre l'image de la morphologie de surface du MoS tel que cultivé2 films
La figure 2 montre les spectres XPS du MoS2 film. Comme le montre la figure 2a, les pics à 229,3 et 232,5 eV sont liés au Mo 3d5/2 et Mo 3d3/2 orbitales, respectivement. Comme le montre la figure 2b, S 2p3/2 et S 2p1/2 orbitales d'ions sulfure divalents (S 2− ) sont observées à 162,2 et 163,3 eV, respectivement. Les résultats sont en bon accord avec les valeurs rapportées pour le MoS2 cristal [17, 18].

Spectres XPS du MoS2 filmer pour a Lu et b éléments S, respectivement
La figure 3a montre le I longitudinal -V courbe du MoS fabriqué2 /n -Hétérojonctions GaAs. Deux électrodes In d'un diamètre d'environ 0,5 mm ont été pressées sur la surface du MoS2 film et l'arrière du GaAs, respectivement. L'encart montre le circuit schématique pour les mesures longitudinales. La tension directe est définie comme une tension de polarisation positive appliquée sur l'électrode supérieure In. Comme le montre la figure, le MoS2 fabriqué /n - L'hétérojonction GaAs montre un comportement rectificatif évident. Le rapport de rectification (I

un I longitudinal -V courbe du MoS fabriqué2 /n -Hétérojonctions GaAs. L'encart montre le circuit schématique pour les mesures longitudinales. b I transversal -V courbes du MoS fabriqué2 /n -Hétérojonctions GaAs. L'encart supérieur montre le circuit schématique pour les mesures transversales. L'encart inférieur montre le I -V courbes du MoS2 films sur substrat GaAs intrinsèque
La figure 4a montre le circuit schématique pour la mesure du LPE du MoS fabriqué2 /Hétérojonction GaAs. Deux électrodes In d'un diamètre de 0,5 mm sont pressées sur la surface du MoS2 film pour effectuer les mesures du LPE. La distance (2L ) entre les électrodes est de ~ 1,0 mm. Lors de nos mesures, les électrodes A et B ont été connectées respectivement aux sondes positive et négative d'un voltmètre Keithley 2000. La figure 4b montre les courbes LPE du MoS2 /n -GaAs et MoS2 /p -Hétérojonctions GaAs, respectivement. L'épaisseur du MoS2 films est ~ 30,0 nm. Lorsque la surface du MoS2 le film est partiellement illuminé par un spot laser d'un diamètre d'environ 0,1 mm, un grand LPE peut être observé dans le MoS2 /n -Hétérojonction GaAs. Comme le montre la figure, le LPE montre une dépendance approximativement linéaire de la position du spot laser lorsque le spot laser se déplace entre les électrodes A et B sur le MoS2 surface. D'après la figure, nous pouvons voir que le LPV dépend de la position du spot laser. Cela peut être adapté à la théorie de la diffusion [16],
$$ \mathrm{LPV}={K}_0\Big[\exp \left(-\frac{\left|Lx\right|}{d}\right)-\exp \left(-\frac{\left |L+x\droit|}{d}\droit) $$où K 0 , 2L , d , et x représentent respectivement un coefficient de proportionnalité, la distance entre deux électrodes, la longueur de diffusion du porteur et la position du spot laser. Les résultats bien ajustés dans la figure suggèrent clairement que le LPE dans le MoS2 /n L'hétérojonction -GaAs résulte du flux diffus latéral et de la recombinaison des porteurs excités loin de la position du laser. Comme le montre la figure, la valeur LPV est nulle lorsque la tache lumineuse est au centre entre deux électrodes, ce qui peut être attribué à la symétrie de diffusion des porteurs. Lorsque la position de la lumière est proche de l'électrode A, le LPV est positif et vice versa. Cela indique que le LPE dans le MoS2 /n L'hétérojonction -GaAs est causée par les porteurs photoexcités de type trou. La LPV maximale est obtenue lorsque l'éclairement laser est le plus proche des électrodes. D'après nos mesures, la tension photovoltaïque latérale maximale (LPVmax ) est d'environ 208,2 mV dans la région linéaire du MoS2 /n -Hétérojonction GaAs. Comparativement, la LPV du MoS2 /p - L'hétérojonction GaAs est beaucoup plus petite et son LPVmax n'est que de 7,3 mV, comme le montre la figure. D'après la figure, nous pouvons voir que le LPE du MoS2 /p L'hétérojonction -GaAs est déterminée par les porteurs photoexcités de type électron. De plus, les caractéristiques LPE non linéaires du MoS2 /p - L'hétérojonction GaAs est visible sur la figure lorsque le spot laser se déplace entre les électrodes A et B.
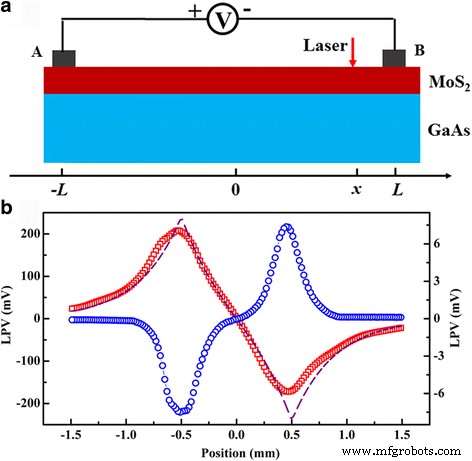
un Schéma de circuit pour la mesure du LPE. b Courbes LPE du MoS2 /n -GaAs et MoS2 /p -Hétérojonctions GaAs, respectivement
La figure 5 montre la sensibilité LPE du MoS2 /n -Hétérojonction GaAs en fonction de la puissance laser et de l'épaisseur (d MoS2 ) du MoS2 film. La sensibilité est définie par S =LPVmax /L . De toute évidence, le S augmente considérablement avec l'augmentation de la puissance laser au début, mais sature ensuite lentement lorsque la puissance augmente encore. Cette saturation pourrait être causée par l'augmentation rapide du taux de recombinaison des trous photoexcités avec l'augmentation de l'intensité laser dans la région illuminée [20]. Comme le montre la figure, un LPE évident et une sensibilité élevée peuvent être obtenus même sous un faible éclairage laser de 100,0 W. D'après la figure, une dépendance significative de la sensibilité sur l'épaisseur du MoS2 des films peuvent être vus. Quand j MoS2 =~ 10,0 nm, S =165,4 mV mm −1 sous l'éclairage laser de 100,0 W. Avec une épaisseur de film croissante, S augmente progressivement. Quand j MoS2 =30,0 nm, S atteint 416,4 mV mm −1 . Cette sensibilité est beaucoup plus grande que le MoS signalé2 /Si périphériques [17, 18]. Après d MoS2> 30,0 nm, S diminue avec l'augmentation du MoS2 épaisseur. Quand j MoS2 =90,0 nm, S = 283,3 mV mm −1 . Ainsi, pour obtenir le plus grand LPE et sensibilité, il existe une épaisseur optimale du MoS2 film dans le MoS fabriqué2 /n -GaAs, environ 30,0 nm.

Dépendance des sensibilités positives et négatives du MoS fabriqué2 /n -Hétérojonction GaAs sur les puissances laser, respectivement
La figure 6a présente les spectres UPS du MoS2 film sur le substrat de Si. La fonction travail (W ) du film peut être calculé à partir de la différence entre la coupure de l'énergie de liaison la plus élevée et l'énergie photonique du rayonnement d'excitation. D'après la figure, W =5,24 eV peut être obtenu. La distance (∆E ) entre la bande de valence (E V ) et le niveau de Fermi (E F ) de MoS2 le film peut être extrait de l'énergie d'apparition, comme indiqué dans l'encart. Le ∆E pour le MoS2 film est d'environ 0,51 eV. Utilisation des données du spectre de transmittance du MoS2 film sur substrat de quartz, (αhν ) 2 est tracé en fonction de l'énergie photonique hν , où h est la constante de Planck et ν est la fréquence des photons. Le α est le coefficient d'absorption, calculé par αd =ln(1/T ) [21], où d et T sont respectivement l'épaisseur et la transmittance du film. La bande interdite (E g ) du film peut être déterminé à partir de l'interception de la ligne sur le hν axe, E g =1,54 eV, comme le montre la figure 6b. Sur la base de ces paramètres de bande d'énergie, le p -type comportement du MoS2 film peut être déterminé, ce qui peut être prouvé par des mesures de Hall. Les résultats de Hall montrent que la concentration du porteur de type trou et la mobilité sont d'environ 3,8 × 10 15 cm −3 et 11,2 cm 2 V −1 s −1 , respectivement.

un Spectres UPS du MoS2 film sur GaAs, montrant le niveau de Fermi des films et la distance entre le niveau de Fermi et le bord supérieur de la bande de conduction. b (αhν ) 2 ~hν courbe du spectre UV du MoS2 film sur substrat de quartz dans les mêmes conditions de dépôt
Afin de clarifier les mécanismes de la LPE dans le MoS2 /GaAs hétérojonctions, les diagrammes de bandes d'énergie à l'interface sont construits sur la base des résultats de la figure 6. Ici, E g =1,42 eV et E F =4,17 eV pour n -GaAs sont pris en compte pour construire la structure de bande [22]. Lorsque le MoS2 film est déposé sur le substrat GaAs, les électrons circulent du GaAs dans le MoS2 film à l'interface en raison du E plus élevé F du GaAs. Le processus d'écoulement s'arrête lorsque les niveaux de Fermi sont égaux et le MoS2 /GaAs p -n la jonction est fabriquée, comme le montre la figure 7a. Par conséquent, un champ intégré (E bi ) se forme à l'interface du MoS2 /Hétérojonction GaAs. E bi =[E F (n -GaAs) − E F (MoS2 )]/e =1,07 V et il pointe du GaAs vers le MoS2 film. Ainsi, le I longitudinal asymétrique -V La courbe est représentée sur la figure 3a. En raison de l'existence d'un fort E bi , de grandes quantités de porteurs de type trou s'accumulent près de l'interface et une couche d'inversion se forme dans le n -Substrat de GaAs près de l'interface, comme le montre la figure 7b. Semblable au gaz de trou bidimensionnel (2DHG) [23], la couche d'inversion pourrait présenter la caractéristique d'une conduction élevée en raison de la forte concentration en feuille des trous (p+ ). D'après la figure 3b, nous pouvons voir que la conduction de la couche d'inversion est beaucoup plus grande que le MoS2 film. Ainsi, la conduction entre deux électrodes du même côté du MoS2 le film est dominé par la couche d'inversion plutôt que par le MoS2 film. Lorsque la jonction est partiellement éclairée par le laser, la lumière est absorbée et les paires électron-trou dans le MoS2 film et GaAs peuvent être induits, respectivement, comme le montre la figure 7c. Cependant, on peut s'attendre à ce que la majeure partie du laser soit absorbée par les substrats GaAs en raison de son épaisseur beaucoup plus grande et de sa bande interdite plus petite. Sous l'éclairage laser, les paires électron-trou ne peuvent être excitées que dans la région éclairée et séparées spatialement par le E bi . En raison de l'orientation du E bi pointage de GaAs vers MoS2 , les trous photoexcités s'écoulent vers l'interface et pénètrent dans la couche d'inversion du GaAs, comme le montre la figure 7c. Les trous photoexcités dans la couche d'inversion diffusent latéralement à distance du spot éclairé vers les deux électrodes. La concentration des trous excités collectés par les deux électrodes est différente pour différentes distances du spot éclairé. Ainsi, un grand LPV est formé entre les électrodes, et le LPE est observé dans l'hétérojonction. Ceci est en accord avec les résultats ajustés de la Fig. 3b, et le LPE dans le MoS2/n Les hétérojonctions -GaAs proviennent principalement de la diffusion des porteurs. Lorsque le MoS2 le film est déposé sur le p -Substrat GaAs, un p -p une hétérojonction est formée, comme le montre la figure 7d. E F (p -GaAs) =5,32 eV est utilisé dans le diagramme de bande [22]. Le E bi du p -p l'hétérojonction peut être calculée, 0,08 V, et sa direction pointe du film vers le substrat. En raison de la E bi , des porteurs de type électronique s'accumulent près de l'interface de l'hétérojonction et la couche d'inversion se forme. Ainsi, le LPE induit par la diffusion des électrons photoexcités est obtenu dans le MoS2 /GaAs p -p hétérojonction, comme le montre la figure 4. Cependant, la concentration du porteur accumulé dans la couche d'inversion pourrait être plus faible en raison de la faible V bi de seulement 0,08 V dans le p -p hétérojonction par rapport au p -MoS2 /n -jonction GaAs. Ceci augmente les difficultés du transport des électrons photoexcités dans la couche d'inversion. Sérieusement, les barrières Schottky peuvent être formées entre le n -type couche d'inversion et le p -MoS2 film, comme le montre la figure 7e. Ces caractéristiques du p -MoS2 /p -La jonction GaAs supprime la collection des électrons photoexcités aux électrodes. En conséquence, le LPE pourrait être réduit en grande partie. Comme le montre la figure 4b, le LPVmax pour le p -p jonction n'est que de 7,3 mV alors qu'elle atteint 208,2 mV dans le p -n jonction.

un Alignement des bandes d'énergie du MoS2 /n -Hétérojonction GaAs, et b l'illustration correspondante du contact électrique à l'interface. c Mécanisme du LPE dans le MoS2 /n -Hétérojonction GaAs. d Alignement des bandes d'énergie du MoS2 /p -Hétérojonction GaAs, et e l'illustration correspondante du contact électrique à l'interface
Il arrive généralement dans les PSD de type hétérojonction signalés que le LPE peut être ajusté en changeant l'épaisseur des couches de protection [20]. Ceci peut être bien compris en considérant la recombinaison des porteurs photoexcités dans le film et l'évolution du champ intégré. Dans le MoS2 /GaAs p -n jonction, la recombinaison des porteurs générés par les photons peut être améliorée en raison du long chemin de transport dans le MoS épais2 film avant qu'ils ne soient collectés par les électrodes. Cela réduit le LPE des hétérojonctions. A l'inverse, un film plus fin peut diminuer fortement la recombinaison, ce qui provoque l'augmentation du LPE. Cependant, lorsque le MoS2 l'épaisseur est inférieure à la valeur critique, le E bi à l'interface diminue avec la diminution du MoS2 épaisseur [24]. Cela peut réduire la séparation des paires électron-trou générées par les photons, et le LPE diminue. Ainsi, il existe une épaisseur optimale du MoS2 film permettant d'obtenir le LPE le plus élevé, environ 30 nm.
Conclusions
En résumé, MoS2 des couches minces ont été déposées à la surface du substrat de GaAs par pulvérisation cathodique magnétron. Un grand LPE a été obtenu dans le MoS2 fabriqué /n L'hétérojonction -GaAs et la dépendance du LPV à la position de l'éclairage laser ont montré une bonne linéarité. En raison de la formation du champ intégré puissant à l'interface, le MoS2 /n -L'hétérojonction GaAs présentait une sensibilité élevée de 416,4 mV mm −1 , alors que la valeur n'était que de 7,3 mV mm −1 pour le MoS2 /p -GaAs. Nos résultats ont en outre montré que le LPE présentait une dépendance évidente vis-à-vis de l'épaisseur du MoS2 films et environ 30,0 nm était l'épaisseur optimale du MoS2 film pour acquérir le LPE le plus élevé dans le MoS fabriqué2 /n -Hétérojonctions GaAs. Les mécanismes à la LPE dans le MoS2 Les dispositifs /GaAs ont été clarifiés sur la base de l'alignement de la bande d'énergie à l'interface.
Abréviations
- ∆E :
-
Distance entre E V et E F
- d MoS2 :
-
Épaisseur du MoS2 film
- E bi :
-
Champ intégré
- E C :
-
Niveau de bande de conduction
- E F :
-
Niveau d'énergie de Fermi
- E g :
-
Bande interdite en énergie
- E V :
-
Niveau bande de Valence
- Je -V :
-
Courant-tension
- LPE :
-
Effet photovoltaïque latéral
- LPV :
-
Photovoltage latéral
- LPVmax :
-
Photovoltage latéral maximum
- MoS2 :
-
Disulfure de molybdène
- PSD :
-
Détecteur sensible à la position
- UPS :
-
Spectroscopie de photoélectrons ultraviolets
- W :
-
Fonction de travail
Nanomatériaux
- Caractéristiques photovoltaïques des dispositifs à hétérojonction GaSe/MoSe2
- MoS2 avec épaisseur contrôlée pour l'évolution électrocatalytique de l'hydrogène
- Cristallisation en fonction de la température de nanoflocons de MoS2 sur des nanofeuillets de graphène pour l'électrocatalyse
- Composite MoS2/noir d'acétylène à quelques couches comme matériau d'anode efficace pour les batteries lithium-ion
- Photoréactivité dépendante du biais des phototransistors MoS2 multicouches
- Performances de détection H2 hautement améliorées des hétérojonctions MoS2/SiO2/Si à quelques couches par la décoration de la surface des nanoparticules de Pd
- Effet de différentes morphologies de CH3NH3PbI3 sur les propriétés photovoltaïques des cellules solaires à pérovskite
- Optimisation des cellules solaires GaAs Nanowire Pin Junction Array en utilisant des hétérojonctions AlGaAs/GaAs
- Propriétés photovoltaïques améliorées dans la cellule solaire à hétérojonction planaire Sb2S3 avec une approche de sélénylation rapide



