Densité élevée de courant de court-circuit induit par piégeage de la lumière dans les cellules solaires à hétérojonction III-Nitride Nanorods/Si (111)
Résumé
Un rendement photovoltaïque de surface efficace de 1,27% en conversion de puissance, à l'exclusion de la zone de contact métallique de la grille et sous 1 soleil, conditions AM 1,5G, a été obtenu pour les matrices de diodes p-GaN/i-InGaN/n-GaN épitaxiées sur (111)-Si. La densité de courant de court-circuit est de 14,96 mA/cm 2 et la tension en circuit ouvert est de 0,28 V. Le piégeage de la lumière amélioré acquis via de multiples réflexions dans les structures de réseau de nanotiges de nitrure III sans contrainte et sans défaut et les réponses à courte longueur d'onde renforcées par les constituants à large bande interdite III-nitrure sont censées contribuer à la améliorations observées dans les performances de l'appareil.
Introduction
Le développement de l'énergie verte est devenu de plus en plus essentiel et les industries des diodes électroluminescentes (LED) ainsi que des cellules solaires se sont développées à un rythme rapide en raison d'une crise énergétique sans cesse croissante. Au cours des dernières décennies, les semi-conducteurs à nitrure III ont été appliqués avec succès aux dispositifs LED [1,2,3], ce qui a entraîné des avantages commerciaux substantiels. Actuellement, de nombreux scientifiques cherchent à exploiter le potentiel de recherche sur les nitrures III pour des applications photovoltaïques [4, 5]. Les matériaux de nitrure des groupes III-V présentent de nombreux avantages pour les systèmes photovoltaïques, tels qu'une bande interdite directe avec un grand coefficient d'absorption [4, 6], une large plage de bande interdite couvrant la majeure partie du spectre solaire via l'ingénierie de bande [4, 6, 7], mobilité élevée des porteurs [7] et résistance supérieure aux radiations [8]. Sur la base de ces superbes propriétés, plusieurs conceptions de structures de dispositifs sont simulées, telles que les cellules tandem InGaN/Si [9,10,11,12,13,14], les cellules solaires à support chaud [15], les cellules solaires à base de Schottky [16, 17,18], des cellules solaires à jonction unique [19,20,21,22,23,24] et multiple [25, 26], ainsi que des effets de polarisation sur les performances des cellules solaires [9, 23, 27]. Les simulations ont prédit que les cellules tandem hétérostructurales InGaN/Si pourraient avoir des rendements aussi élevés que 21 à 36% [10, 11, 13] sur la base de différents modèles de simulation. L'efficacité de conversion de puissance (PCE) de la cellule solaire tandem homostructurale InGaN avec quatre compositions différentes d'In est proposée comme étant de 51% sous 1 rayonnement solaire et de 58% sous des conditions concentrées 250 soleil [26]. Cependant, les problèmes d'impuretés et de recombinaison non radiative deviennent de plus en plus importants dans des conditions de croissance de couches minces d'InGaN à basse température [28,29,30]. Les défauts d'empilement significatifs et les densités de dislocations dus au non-appariement du réseau conduisent à la diminution de la longueur de diffusion des porteurs et à la limitation de la cellule solaire PCE [31,32,33,34]. Par conséquent, de nombreux défis restent à relever pour la réalisation des capacités potentielles des dispositifs photovoltaïques à haut rendement au nitrure III.
Au cours de la dernière décennie, de nombreux sujets de recherche pertinents tels que les méthodes de croissance cristalline à haute teneur en InGaN sur substrat GaN autonome [34], le dopage InGaN de type p [35], les conceptions de puits quantiques [36,37,38,39,40], l'électrode des conceptions [41,42,43,44], des systèmes photovoltaïques à concentrateur [37, 41, 45], des cellules solaires à bande intermédiaire [46] et des structures à réflexion réduite [47,48,49] ont été étudiés. De plus, les cellules solaires non polaires à base de nitrure ont été étudiées sur l'effet de polarisation [50, 51]. Dahal et al. ont démontré un fonctionnement de cellules solaires à puits quantiques multiples supérieur à 30 % InGaN à des longueurs d'onde plus longues (> 420 nm) [38] et illustré une efficacité de 3,03 % sous une intensité d'éclairage accrue jusqu'à 30 soleils [37]. Mori et al. ont étudié les cellules solaires à base de nitrure de concentrateur [45] et ont traité le PCE le plus élevé de 4% fonctionnant à une intensité lumineuse élevée jusqu'à 300 soleils [41]. Même si plusieurs groupes de recherche ont fourni différentes conceptions structurelles ou optiques et amélioré les techniques de croissance, le PCE des cellules solaires au nitrure III n'a pas beaucoup avancé. En revanche, Reichertz et al. ont démontré que les cellules solaires en tandem sont réalisables par croissance épitaxiale de GaN à jonction p-n sur un substrat de Si à jonction p-n [14]. Leurs résultats ont indiqué que le substrat Si contribuait à l'efficacité sur les grandes longueurs d'onde tandis que le nitrure contribuait à l'efficacité sur les courtes longueurs d'onde. Les substrats en silicium offrent non seulement une solution à faible coût, mais également une amélioration du PCE et une bonne conductivité thermique [52].
Habituellement, pour la croissance des cellules solaires, des couches de film continues sont superposées, ce qui entraîne une densité de dislocation élevée. Cependant, lorsque les nitrures III sont cultivés dans des nanostructures, la zone inférieure en contact avec le substrat est petite, ce qui réduit les dislocations de filetage et la contrainte peut également être minime. Tessarek et al. ont rapporté que les dislocations des nanotiges de GaN disparaissaient lorsque le diamètre descendait jusqu'à 200 nm [53]. Par conséquent, comme alternative à la croissance de film sur des substrats de silicium, il serait préférable de faire croître des cellules solaires à nanotiges en nitrure III pour réduire le coût, améliorer la qualité des cristaux et améliorer l'efficacité des cellules. En outre, les nanotiges/nanofils ont une grande capacité pour les applications photovoltaïques car les électrons photo-générés peuvent être collectés plus efficacement avant d'être recombinés avec des trous en raison d'un chemin direct vers les électrodes et les structures de nanotiges peuvent améliorer le piégeage de la lumière pour améliorer l'absorption des photons [54, 55]. Plusieurs groupes ont démontré les photodétecteurs [56, 57], les nanolasers [58, 59], les nano-LED [60, 61] et les applications de séparation photoélectrochimique de l'eau [62] basées sur des nanotiges de nitrure III [55]. Néanmoins, l'inconvénient des cellules solaires à nanotiges est que les paires électron-trou photo-générées se recombinent dans de nombreux centres de piégeage de porteurs en raison de défauts de surface. De plus, les processus de fabrication de dispositifs des cellules solaires à nanotiges sont plus compliqués que ceux des dispositifs à couches minces. Cependant, surmonter les problèmes mentionnés ci-dessus a entraîné une augmentation presque triple du PCE, comme le montrent Wallentin et al. où le réseau de nanotiges InP a un PCE de 13,8% grâce à l'optimisation du diamètre de la nanotige et de la longueur du segment n supérieur [54, 63]. Krogstrup et al. a indiqué qu'une densité élevée de courant de court-circuit (Jsc ) a été obtenu dans les structures de nanofils GaAs à noyau unique en raison de l'absorption de la lumière de plus d'un ordre de grandeur améliorée par la concentration de la lumière [64]. Wierer et al. [65], Cansizoglu et al. [66], et Nguyen et al. [31] ont démontré différents types de cellules solaires à nanotiges de nitrure sur un modèle GaN et un substrat Si. La comparaison des récentes recherches photovoltaïques sur les nanotiges/nanofils est répertoriée dans Informations supplémentaires :Tableau S1. Cependant, les contributions de conversion photoélectrique de différents dispositifs photovoltaïques d'ensemble de nanotiges InGaN à contenu en In sur des substrats de Si (111) à faible coût n'ont pas été discutées systématiquement jusqu'à présent.
Dans cette étude, des ensembles de nanotiges de nitrure de Mg:GaN/InGaN/Si:GaN III avec une concentration d'indium de 8% et 11% ont été cultivés sur des substrats de Si (111) dopé n par épitaxie par faisceau moléculaire assistée par plasma (PA-MBE, Veeco EPI930). Les propriétés structurales et les teneurs en indium ont été estimées par des mesures de diffraction des rayons X à haute résolution (HR-XRD, Bede D1). La structure fine des nanotiges a été analysée par microscopie électronique à transmission à haute résolution (HR-TEM, FEI E.O Tecnai F20 G2). Les propriétés de densité de courant en fonction de la tension (J-V) des cellules solaires au nitrure ont été discutées sous 1 soleil, éclairage AM 1.5G (Newport 94023A). L'efficacité quantique externe (EQE, Enli Technology Co., Ltd., QE-R3018) a été mesurée pour étudier la réponse spectrale. Les alignements et les simulations des diagrammes de bandes ont également été étudiés pour expliquer le transport des électrons et des trous.
Méthode expérimentale
Technique de croissance
La croissance des nanotiges Si:GaN et Mg:GaN/InGaN/Si:GaN est basée sur la technique d'épitaxie par faisceau moléculaire assistée par plasma (PA-MBE). Tous les échantillons ont été cultivés par un système Veeco GEN930 PA-MBE équipé d'une source de plasma d'azote 6N (Veeco, UNI-Bulb). Le substrat Si (111) de type n avec une résistivité de 0,001 à 0,005 Ω cm a été nettoyé avec de l'acétone, de l'isopropanol et de l'eau désionisée dans un bain à ultrasons pendant 5 min à chaque étape pour éliminer la contamination organique résiduelle, puis gravé dans un 48–51% HF:H2 O =1:5 solution pendant 5 min pour éliminer l'oxyde natif. Après le processus de nettoyage/gravure chimique, le substrat de Si a été séché par soufflage avec de l'azote gazeux. Le substrat Si a été introduit dans la chambre tampon puis transféré dans la chambre de croissance par un bras de transfert couplé magnétiquement. Avant la croissance des nanotiges, le substrat a été nettoyé thermiquement à 900 °C pendant 30 min pour éliminer l'oxyde natif résiduel afin d'obtenir une surface de Si reconstruite 7 × 7 propre et ordonnée. Les atomes d'azote activés ont été générés par un canon à plasma et son flux et sa pureté ont été contrôlés via un contrôleur de débit massique haute résolution (HORIBA STEC, SEC-7320 M) et un purificateur d'azote (Entegris, CE35KFI4R). Les sources de Ga, In, Si et Mg de haute pureté (6N ou plus) ont été fournies par des cellules d'effusion à source solide. Le métal du groupe III et N2 la pression équivalente du faisceau de plasma (BEP) a été mesurée avec une jauge de flux de faisceau. En contrôlant les rapports de flux III/V à l'état riche en N, des nanotiges peuvent être obtenues. Tout d'abord, des nanotiges Si:GaN auto-assemblées ont été cultivées à 760 °C pendant 82 min. La désorption de l'InN est critique à des températures élevées car l'indium s'évapore de la surface de l'échantillon. Pour retenir l'indium dans les nanotiges, la technique d'épitaxie à modulation de métal (MME) a été utilisée [67, 68]. Le MME implique l'ouverture et la fermeture périodiques des volets métalliques afin de moduler les flux métalliques, tandis que le N2 l'obturateur est maintenu ouvert. Pour régler la concentration en In, deux temps de cycle différents des atomes In et Ga ont heurté le substrat alternativement pendant 20 s/30 s (échantillon B) et 30 s/30 s (échantillon C) avec 50 périodes à 550 °C. Enfin, la couche de Mg:GaN a été cultivée à 600°C. Les échantillons ont été cultivés sous 9,25 × 10 −6 Torr azote actif BEP avec puissance plasma 450 W, 2,42 × 10 −8 torr En BEP, et 1,93 × 10 −8 torr Ga BEP. De plus, les nanotiges monocouches Si:GaN (échantillon A) ont également été préparées en tant que groupe contrôlé dans les mêmes conditions.
Fabrication d'appareils
Après la croissance des nanotiges, le processus de fabrication du dispositif comprenait les étapes suivantes. (1) La zone de l'appareil de 350 × 350 m 2 mesa a été défini par gravure jusqu'au Si de type n avec du tétrafluorométhane (CF4 ) basée sur la technique de gravure par ions réactifs (Advanced System Technology, Cirie-200) utilisant une résine photosensible (Microchemicals GmbH, AZ1400) comme masque. (2) Un bain à ultrasons avec de l'eau désionisée a été utilisé pour nettoyer les nanotiges lâches de l'appareil, à l'exception de celles de la zone mesa. (3) Immerger l'échantillon dans (NH4 )2 S à 60 °C pendant 1 min pour passiver la surface de nitrure pour la suppression des oxydes natifs et la réduction par recombinaison non radiative [69,70,71,72,73]. (4) Un film mince d'oxyde d'indium et d'étain (ITO) de 100 nm a été déposé sur les nanotiges pour servir de contact transparent ohmique Mg:GaN par pulvérisation (Advanced System Technology, Psur-100HB) accompagné d'une photolithographie (M&R Nano Technology , AG350-6B) et les techniques de décollage. (5) Les contacts métalliques multicouches Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm) sur le film ITO et sur les substrats Si de type n ont été fabriqués par évaporation par faisceau électronique (Advanced System Technology , Peva-600E) en utilisant des techniques de photolithographie et de lift-off. (6) Tous les contacts métalliques de la grille ont été recuits par un système de recuit thermique rapide (Advanced System Technology, FA04) pendant 30 s dans l'azote à 800 °C pour obtenir des contacts ohmiques.
Préparation de l'échantillon TEM
Pour approfondir l'étude de la structure cristalline, des nanotiges individuelles des échantillons B et C ont été extraites par sonication dans de l'éthanol. Après 30 min de sonication, quelques gouttes de la solution d'éthanol ont été déposées sur une grille en cuivre (Ted Pella) et l'éthanol a été évaporé à température ambiante. Avant les mesures, l'échantillon a été cuit à 150 °C pour éliminer les solvants organiques libres.
Résultats et discussion
Propriétés morphologiques et structurelles
Les vues de dessus et les vues en coupe transversale des images de microscopie électronique à balayage (MEB) sont présentées sur la figure 1a–f illustrant la morphologie des nanotiges telles que cultivées. De gauche à droite, la figure 1 a–c représente la variation de la morphologie de surface de Si:GaN (échantillon A) et Mg:GaN/InGaN/Si:GaN avec des atomes In/Ga variés ayant un temps de cycle de 20 s/30 s (échantillon B) et 30 s/30 s (échantillon C) pendant la croissance de 50 cycles d'InGaN, respectivement. Les diamètres des nanotiges Si:GaN et Mg:GaN/InGaN/Si:GaN sont respectivement de 30–100 nm et 80–150 nm, tandis que les densités surfaciques sont ~ 7 × 10 9 cm −2 . Les images en coupe transversale des nanotiges sont présentées sur la figure 1d–f et indiquent que la longueur des nanotiges est d'environ 700 nm pour les échantillons A à C. La structure schématique des échantillons Mg:GaN/InGaN/Si:GaN est illustrée dans la figure 1g.
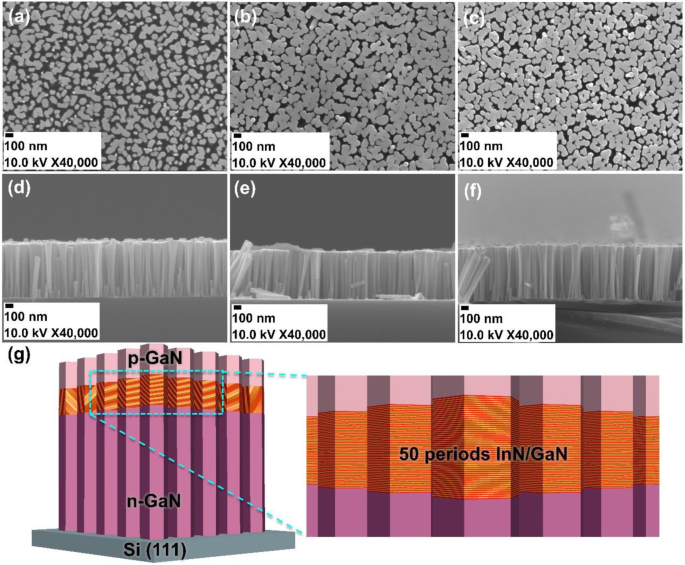
Les vues de dessus SEM de a n-GaN (échantillon A), p-GaN/InGaN/n-GaN avec les atomes In et Ga ayant subi des temps de cycle de b 20 s/30 s (échantillon B) et c 30 s/30 s (échantillon C). Les vues en coupe SEM de d échantillon A, e échantillon B, et f échantillon C. g Un diagramme schématique de la structure des nanotiges p-GaN/InGaN/n-GaN
La figure 2a a enregistré la mesure de diffraction des rayons X thêta-2thêta en se concentrant sur différentes sources d'échantillons de temps de cycle. Le pic le plus fort situé à 28,44° provient du substrat Si. Un pic net et net à 34,56° correspond à la diffraction GaN (0002) et indique une bonne inhibition du mélange de phases à partir de la couche d'InGaN. Un pic sur le côté 2-thêta inférieur du pic GaN (0002) à 34,22° pour l'échantillon B et à 34,13° pour l'échantillon C est InGaN (0002). Le c les constantes de réseau de InN et GaN sont respectivement de 5.760 Å et 5.185 Å [74]. Suivant la loi de Bragg, le c les constantes de réseau de InGaN (0002) sont calculées comme 5,23 Å pour l'échantillon B et 5,25 Å pour l'échantillon C. Importation du c constante de réseau de InGaN (0002) à la loi de Vegard, la concentration en In peut être estimée à 8% pour l'échantillon B et 11% pour l'échantillon C sans tenir compte de la déformation. La figure 2 b montre l'image MET à faible grossissement de l'échantillon C et le diagramme schématique de sa structure. La zone 1 et la zone 2 sont respectivement des régions n-GaN et InGaN. Le diagramme de diffraction électronique à zone sélective (SAED) pris au niveau de la zone 1 démontre que la direction [0001] est parallèle à l'axe long de la nanotige et une direction de croissance commune des nanotiges de nitrure. De plus, aucune dislocation n'est trouvée dans le cristal. Dans les figures 2 c et d, les images TEM à résolution atomique donnent le c constantes de réseau de GaN et InGaN comme 5.19 Å et 5.25 Å respectivement, les mêmes que les résultats calculés par la loi de Bragg via le balayage XRD thêta-2thêta. De plus, le c La constante de réseau d'InGaN pour l'échantillon B est de 5,23 Å via des images TEM à résolution atomique présentées dans les informations supplémentaires :Figure S1. En outre, des images à champ sombre annulaire à grand angle (HAADF) et un balayage linéaire de spectroscopie à rayons X à dispersion d'énergie (EDS), indiquant la distribution de l'indium, sont inclus dans les informations supplémentaires :Figure S2.
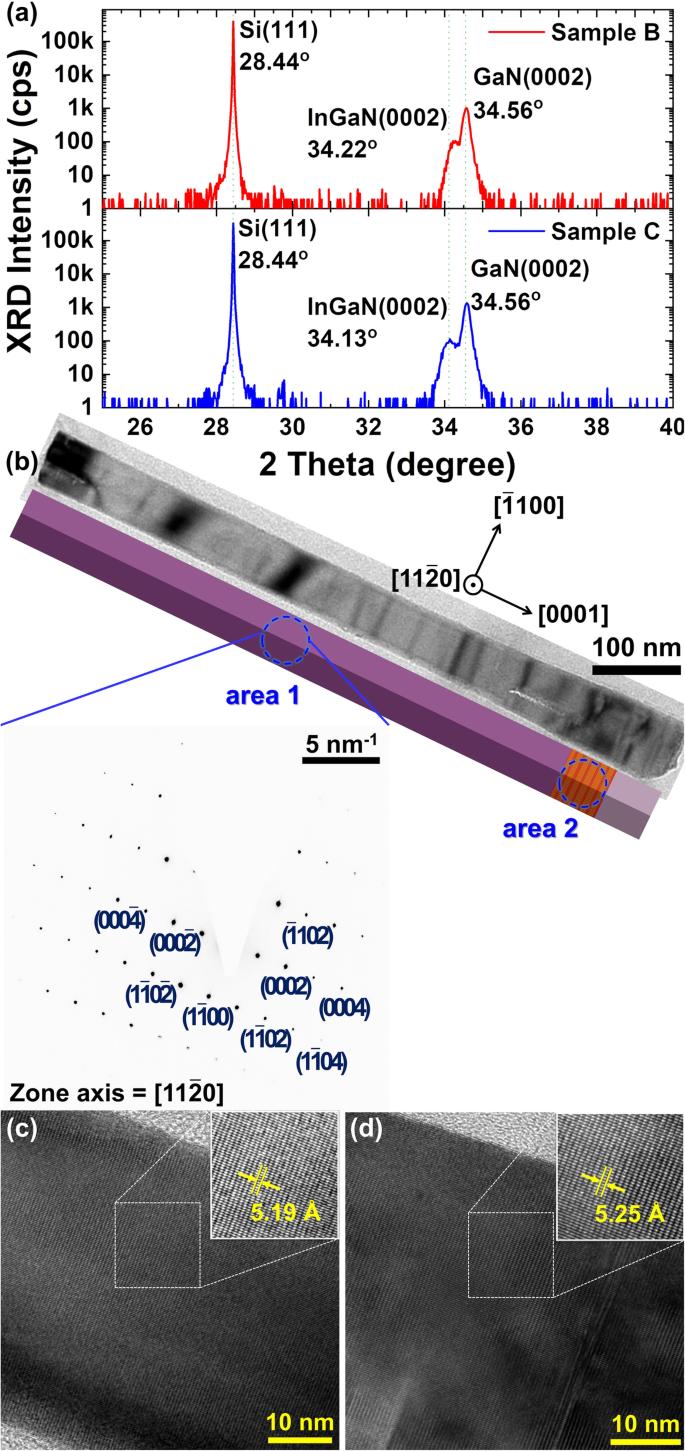
un Spectres HR-XRD pour les scans thêta-2thêta. La teneur en indium du matériau InGaN a été estimée à 8 % pour l'échantillon B (courbe rouge) et à 11 % pour l'échantillon C (courbe bleue) en utilisant la loi de Vegard. b L'image TEM de nanotige de nitrure sans dislocation et le motif SAED de la région n-GaN. Le diagramme schématique de nanotige unique sous l'image obéit à l'échelle relative structurelle. Les images MET à résolution atomique de c n-GaN dans la zone 1 et d InGaN dans la zone 2 montre une luxation libre et leur c constantes de réseau
Analyse des caractéristiques électriques et optiques
Les mesures de densité de courant en fonction de la tension ont été effectuées par un compteur de source Keithley 2400. La figure 3 a affiche le diagramme schématique de la cellule solaire assemblé par nanotige. La surface totale de l'appareil est de 0,12 mm 2 et la surface effective sous l'éclairage à l'exclusion du métal de contact est de 0,0924 mm 2 . Pour collecter les électrons générés par les photons, un film ITO conducteur transparent de 100 nm est déposé sur le dessus du p-GaN pour connecter les nanotiges et le Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm ) électrode de doigt. Des analyses des caractéristiques photoélectriques de l'appareil ont également été menées avec un simulateur solaire sous 1 soleil, condition AM 1,5G, comme indiqué sur la figure 3b–d. La résistance série R s les valeurs déterminées à partir de la figure 3b–d sont 83 Ω, 250 Ω et 2,5 kΩ et la résistance shunt R ch les valeurs sont de 413 kΩ, 550 kΩ et 2 MΩ pour les échantillons A, B et C respectivement. La densité de photocourant à tension nulle, Jsc , de In0,08 Ga0.92 N appareil (échantillon B) et In0.11 Ga0,89 L'appareil N (échantillon C) est de 7,77 mA/cm 2 et 14,96 mA/cm 2 respectivement. L'amélioration du photocourant par rapport à la concentration croissante d'In a été démontrée via Jsc Comparaison. De plus, Krogstrup et al. ont illustré que la propriété de concentration de lumière dans les cellules solaires à nanotiges peut améliorer l'absorption de la lumière et fournir un photocourant élevé [64]. La tension à vide (Voc ) et le facteur de remplissage (FF) de l'échantillon C sont respectivement de 0,28 µV et 30 %. Plusieurs groupes ont également démontré des structures de nanotiges avec un Voc plus faible [72, 75, 76]. Pour élucider les performances photovoltaïques réelles dans une zone réellement éclairée, surface efficace PCE, PCEeff , établit une efficacité basée sur la surface efficace qui exclut la surface de l'électrode de grille, tandis que la surface totale PCE, PCEtot , considère l'ensemble de la zone de l'appareil. Il est à noter que le PCEtot et PCEeff les valeurs sont de 0,98 % et 1,27 %, ce qui indique un PCE de cellule solaire à nanotiges de nitrure plus élevé jamais signalé. La contribution principale vient du haut Jsc , bien que le Voc est inférieur à celui des autres cellules solaires à nanotiges au nitrure III [65, 77]. Il y a deux raisons possibles de faible Voc , y compris le niveau quasi-Fermi limité à la jonction p-n Si dont la bande interdite Si est de 1,12 eV sur la base du diagramme de bande et un chemin de courant confiné peut être créé en raison de l'épinglage du niveau de Fermi en surface [66]. Le tableau 1 résume Jsc , Voc , FF et comparaison PCE de trois échantillons.
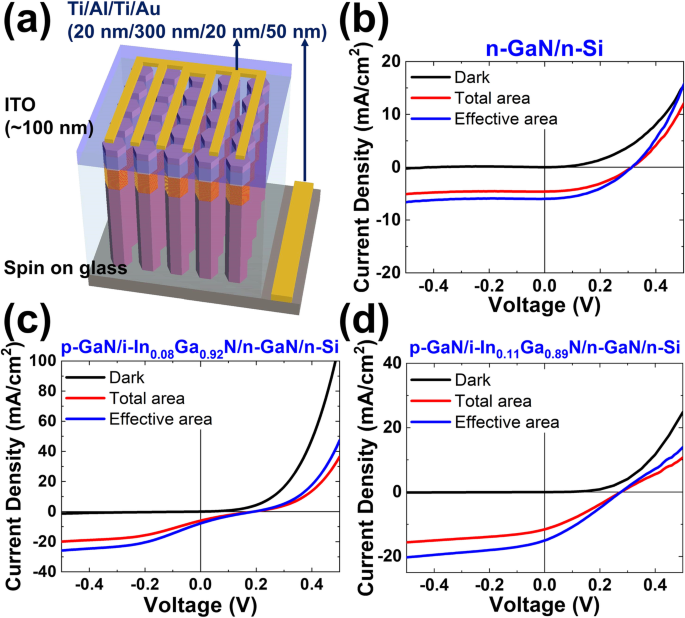
un Le nanotige assemble le diagramme schématique de la cellule solaire. Les courbes densité-tension de courant de b n-GaN/n-Si, c p-GaN/In0,08 Ga0.92 N/n-GaN/n-Si et d p-GaN/In0.11 Ga0,89 Les nanotiges N/n-GaN/n-Si assemblent des cellules solaires mesurées sous 1 soleil, simulateur solaire AM 1.5G
Pour comprendre les propriétés physiques et électriques, les diagrammes de bandes sont calculés en utilisant un programme 1D-DDCC (One Dimensional Poisson, Drift-Diffusion et Schrodinger Solver) [78]. Les affinités électroniques de l'ITO, du Si et du GaN utilisées sont respectivement de 4,40 eV, 4,05 eV et 4,1 eV. La figure 4 a et b montre le diagramme de bande ITO/n-GaN/n-Si sans polarisation de tension et la courbe J-V dans l'obscurité respectivement. Il illustre que la structure ITO/n-GaN/n-Si n'a pas d'effet rectificateur et montre un profil J-V linéaire. La barrière potentielle de l'hétéro-interface peut être ignorée pour les porteurs à transporter car le décalage de bande de conduction entre Si et GaN devrait être une petite valeur de 50 meV. Cette courbe J-V linéaire de type résistance est en contradiction avec les résultats expérimentaux.

un Diagramme de bande ITO/n-GaN/n-Si, b Courbe ITO/n-GaN/n-Si J-V, c Diagramme de bande ITO/n-GaN/p-Si/n-Si, et d Courbes J-V de ITO/n-GaN/p-Si/n-Si simulées par le programme 1D-DDCC
Une explication possible des résultats de la courbe J-V est que la diffusion de Ga induit un p-Si à l'interface GaN/Si et crée une jonction p-n. Reichertz et al. [14] et Neplokh et al. [76] ont vérifié la diffusion d'Al dans le substrat de silicium lors de la croissance de couches de nitrure. Le bore, l'Al et le Ga sont des éléments du groupe IIIB qui peuvent être un dopant pour la formation de la couche p-Si. Cependant, la vitesse de diffusion du Ga est de 8 nm/jour à 700 °C [79]. La figure 4c montre un diagramme de bandes qui comprend une couche de p-Si très mince (1 nm) entre le n-GaN et l'interface n-Si. Un petit champ électrique intégré est créé dans la jonction p-n Si qui peut conduire les électrons vers le substrat n-Si et les trous vers la couche de contact ITO. Les courbes J-V dépendant de l'épaisseur démontrent que la tension d'activation de la diode diminue lorsque l'épaisseur des couches de p-Si devient plus mince sur la figure 4d. Le p-Si ultra-mince sera une limitation pour la séparation de niveau quasi-Fermi et réduira le Voc des performances solaires. La propriété électrique simulée avec la couche p-Si incluse est plus proche de ce résultat de recherche. Par conséquent, le diagramme de bande de la structure Mg:GaN/InGaN/Si:GaN/p-Si/n-Si peut être construit comme un modèle comme dans la Fig. 5. L'éclairage de la lumière AM 1.5G par le haut conduit à l'absorption de photons avec une énergie supérieure à la bande interdite InGaN. Lorsque la lumière irradie sur le Si à travers les tiges et l'espace entre les tiges, les photons avec une énergie supérieure à la bande interdite Si pourraient également être absorbés par le substrat p-n Si et un photocourant est produit. Simultanément, les paires électron-trou générées dans les régions de nitrure par la lumière à courte longueur d'onde sont séparées par un champ électrique intégré à la jonction p-i-n. En fin de compte, les porteurs photo-générés pourraient être collectés via le contact supérieur d'oxyde d'indium et d'étain (ITO) vers Mg:GaN et le contact inférieur Si n. Sur la base de ce modèle de structure et compte tenu de la barrière Schottky introduite par le contact ITO, la simulation de la courbe J-V est illustrée à la Fig. 5b. La courbe J-V simulée indique que la forme en S est causée par un comportement non ohmique du contact p. C'est une raison possible pour expliquer l'existence de la forme en S pour Mg:GaN/u-InGaN/Si:GaN (échantillons B et C) sur les Fig. 3 c et d. Par conséquent, les densités de courant au biais négatif (Jbiais négatif (− 0,5 V) ) où la forme en S est aplatie sont notés dans le tableau S2. Jbiais négatif peut être un point de contrôle pour une optimisation plus poussée et une valeur ciblée.
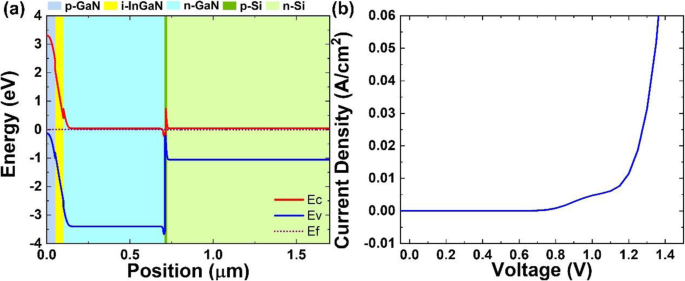
un Le nanotige de nitrure p-i-n sur le diagramme de bande de cellules solaires p-n Si simulé par le programme 1D-DDCC. b Simulation de courbe J-V de nanotige de nitrure p-i-n sur une cellule solaire p-n Si
Les résultats de mesure EQE sans biais de lumière (lumière non modulée supplémentaire) sont présentés sur la figure 6a, qui compare les EQE de Si:GaN/n:Si (échantillon A), Mg:GaN/u-In0,08 Ga0.92 N/Si:GaN (échantillon B) et Mg:GaN/u-In0.11 Ga0,89 N/Si:GaN (échantillon C). L'échantillon C a une concentration en In plus élevée qui pourrait être responsable des valeurs plus élevées à courte longueur d'onde en raison de l'absorption dans la couche d'InGaN. Les EQE maximales dans les échantillons A, B et C sont respectivement de 32 %, 55 % et 63 %. Par rapport aux spectres de réflectance de la plaquette de Si, échantillons A, B et C représentés sur la figure 6b, les oscillations des EQE et des spectres de réflectance sont dues aux interférences de différentes couches. La plaquette de Si nue a la réflectance la plus élevée en raison de sa surface plane. Les échantillons A, B et C ont une réflectance plus faible car les structures de nanotiges ont un effet de piégeage de la lumière. L'échantillon C s'avère avoir l'EQE la plus élevée à grande longueur d'onde et la réflectance la plus faible en raison de l'effet de piégeage de la lumière le plus élevé. Ce résultat peut expliquer le photocourant plus élevé généré dans l'échantillon C. Les spectres de photoluminescence (PL) à température ambiante (RT, 300 K) de l'échantillon B et de l'échantillon C sont illustrés à la figure 6c. Le pic le plus élevé situé à 3,40 eV est l'émission de GaN près du bord de la bande (NBE). Les pics situés à 3.09 eV et 3.03 eV sont dus à In0.08 Ga0.92 N et In0.11 Ga0,89 N Emission NBE. Les résultats sont similaires aux valeurs du calcul de l'équation de courbure de 3,1 eV et 3,0 eV à RT [4]. Il montre également les mêmes fortes oscillations Fabry-Pérot (marquées par des signes astronomiques) que les EQE et les spectres de réflectance, représentant les interfaces lisses entre chaque couche/surface.

un Spectres externes d'efficacité quantique de trois échantillons de nanotiges de nitrure/Si. b Les spectres de réflectance d'une plaquette de Si nue et de trois échantillons de nanotiges/Si de nitrure. c Les spectres de photoluminescence à température ambiante de deux échantillons d'InGaN
Conclusion
Des nanotiges Mg:GaN/InGaN/Si:GaN et Si:GaN de haute qualité cultivées sur n-Si par épitaxie par faisceau moléculaire assistée par plasma sont démontrées avec succès. Les mesures photovoltaïques présentent un PCEeff de 1,27% et un PCEtot de 0,98% sous 1 soleil, éclairage AM 1.5G pour Mg:GaN/u-In0.11 Ga0,89 N/Si:GaN qui a une concentration en In plus élevée et un effet de piégeage de la lumière plus élevé induisant un photocourant élevé. Bien que les nanotiges Si:GaN sur le dispositif n-Si puissent ne pas avoir de champ intégré de jonction p-n important, la conception d'une structure d'hétérojonction appropriée aide à conduire les photoporteurs vers les contacts supérieur et inférieur et améliore les performances de la cellule.
Disponibilité des données et des matériaux
Les auteurs déclarent que les matériaux et les données sont à la disposition des lecteurs, et toutes les conclusions tirées dans ce manuscrit sont basées sur les données qui sont toutes présentées et montrées dans cet article.
Abréviations
- LED :
-
Diode électroluminescente
- PCE :
-
Efficacité de conversion de puissance
- Jsc :
-
Densité de courant de court-circuit
- PA-MBE :
-
Epitaxie par jets moléculaires assistée par plasma
- HR-XRD :
-
Diffraction des rayons X haute résolution
- HR-TEM :
-
Microscopie électronique à transmission haute résolution
- EQE :
-
Efficacité quantique externe
- BEP :
-
Pression équivalente du faisceau
- MME :
-
Epitaxie modulée en métal
- ITO :
-
Oxyde d'indium-étain
- Voc :
-
Tension en circuit ouvert
- RT :
-
Température ambiante
- PL :
-
Photoluminescence
- NBE :
-
Bord de bande proche
Nanomatériaux
- Cellule solaire
- Nano arbres pour cellules solaires à colorant
- Cellules solaires au graphène à haute efficacité
- Nano-hétérojonctions pour cellules solaires
- Caractéristiques photovoltaïques des dispositifs à hétérojonction GaSe/MoSe2
- Absorption de la lumière améliorée par le plasmon dans les cellules solaires à nanofils GaAs à jonction (p-i-n) :étude d'une méthode de simulation FDTD
- Un bref rapport d'avancement sur les cellules solaires à pérovskite à haute efficacité
- PEDOT:Couche de transport de trous transparents PSS hautement conducteur avec traitement au solvant pour cellules solaires hybrides silicium/organique hautes performances
- Tungstène



