Étude à résolution atomique EDX, HAADF et EELS des alliages GaAs1-xBix
Résumé
La distribution des atomes alliés dans les semi-conducteurs s'écarte souvent d'une distribution aléatoire qui peut avoir des effets importants sur les propriétés des matériaux. Dans cette étude, des techniques de microscopie électronique à transmission à balayage sont utilisées pour analyser la distribution de Bi dans plusieurs GaAs à croissance MBE distincte1−x Bix alliages. La quantification statistique des images HAADF à résolution atomique, ainsi que des simulations numériques, sont utilisées pour interpréter le contraste des colonnes contenant du Bi à l'interface GaAs-GaAsBi atomiquement abrupte (001) et le début de l'ordre de type CuPt. À l'aide de la cartographie EELS monochromatique, les décalages vers le rouge de l'énergie du plasmon en vrac sont examinés dans un échantillon présentant des domaines séparés par des phases. Cela suggère une méthode simple pour étudier les expansions locales du volume des cellules unitaires GaAsBi et pour compléter les mesures de déformation du réseau standard basées sur les rayons X. En outre, un échantillon de GaAsBi ordonné CuPt à variante unique cultivé sur un substrat de chute est caractérisé avec des cartographies EDX compositionnelles à l'échelle atomique, et le paramètre d'ordre est estimé. Enfin, un alliage GaAsBi avec une modulation verticale de composition Bi est synthétisé en utilisant une faible vitesse de rotation du substrat. Atomiquement, l'imagerie EDX et HAADF résolue montre que l'ordre habituel de type CuPt est encore modulé le long de l'axe de croissance [001] avec une période de trois constantes de réseau. Ces échantillons distincts de GaAsBi illustrent la variété des distributions de Bi qui peuvent être obtenues dans cet alliage, mettant en lumière les mécanismes d'incorporation des atomes de Bi et les moyens de développer davantage les semi-conducteurs III-V contenant du Bi.
Introduction
Le bismide GaAs1−x Bix L'alliage a fait l'objet de nombreuses recherches et représente la classe émergente de semi-conducteurs du groupe III-V contenant du bismuth [1]. Le bismuth est le plus grand élément stable et non toxique, qui, lors de son incorporation, produit une réduction importante de la bande interdite GaAs. La substitution de Bi dans le sous-réseau du groupe V permet d'atteindre une courbure de bande interdite allant jusqu'à 90 meV/Bi% dans GaAsBi avec une déformation de réseau modérée [1,2,3]. Une grande division de la bande spin-orbite est un autre effet notable de l'incorporation de Bi dans le réseau. Cela peut permettre de supprimer l'absorption de la bande d'intervalence et la recombinaison Auger-Meitner dans GaAs1−x Bix avec des concentrations x> 10 % [4]. Combinées à la sensibilité réduite de la bande interdite, ces propriétés font du bismide un candidat attrayant pour des applications dans les lasers infrarouges à ondes longues, les photodétecteurs et les cellules solaires multijonctions, entre autres [1, 5, 6, 7].
L'incorporation de Bi dans la matrice de GaAs nécessite des conditions de croissance non conventionnelles puisque les atomes de Bi ont tendance à se désorber aux températures de croissance typiques de GaAs [8,9,10]. Des températures de substrat inférieures à 400 °C sont généralement nécessaires, ainsi que des rapports presque stoechiométriques du groupe III/V. Des précautions doivent être prises pour éviter la formation de gouttelettes de surface Ga ou Bi qui peuvent facilement se produire à proximité de ces conditions et sont associées à des non-uniformités de l'épaisseur de la couche croissante et de sa composition [11,12,13,14]. Les basses températures nécessaires pour incorporer de plus grandes concentrations de Bi font de l'épitaxie par faisceau moléculaire (MBE) la méthode de synthèse préférée, bien que des progrès aient été réalisés en utilisant l'épitaxie en phase vapeur métal-organique [15,16,17]. Les alliages GaAsBi présentent toujours une intensité de photoluminescence (PL) étonnamment élevée pour ces basses températures de croissance, ce qui est attribué à l'effet tensioactif Bi et à la densité réduite des défauts ponctuels liés à l'As qui se forment généralement dans le GaAs à basse température [18, 19]. Dans l'image de l'anti-croisement de la bande de valence (VB), les atomes de Bi individuels incorporés produisent un état de résonance inférieur au GaAs étendu VB provoquant la réduction de la bande interdite optique [2, 20, 21]. Les calculs des premiers principes démontrent également que les amas composés d'atomes Bi en interaction proches peuvent produire un rétrécissement de la bande interdite significativement plus important que celui des atomes Bi isolés [22]. Ces différentes configurations Bi produisent de fortes perturbations VB et peuvent introduire des états de défauts électroniques localisés. Des études suggèrent que la tension du réseau produite par les gros atomes de Bi entraînera une liaison plus probable des clusters aux lacunes VGa et VAs [23]. Les conditions de croissance As-rich devraient favoriser la formation de BiGa des défauts d'hétéro-antisites susceptibles de provoquer des pièges à trous profonds dans GaAsBi [23, 24]. Des effets de localisation d'excitons prononcés sont couramment observés dans le PL dépendant de la température des alliages GaAsBi et sont attribués à de tels amas et complexes de défauts liés au Bi [25, 26].
Comme beaucoup d'autres alliages semi-conducteurs ternaires III-V, GaAsBi montre une tendance à l'ordre spontané [27]. Le soi-disant CuPtB -L'ordre de type, dans lequel la concentration d'atomes Bi est modulée sur un plan de type {111} B sur deux, a été observé en utilisant la microscopie électronique à transmission (STEM/TEM) à haute résolution [13, 17, 28]. Il est largement admis que le CuPtB -la modulation de type dans les alliages III-V est entraînée par la dynamique de reconstruction de surface et s'accompagne de la reconstruction (2 × 1) constituée de rangées de dimères de surface [27, 29, 30, 31, 32, 33]. Lorsqu'il est déposé sur des substrats GaAs plats (001), l'ordre se produit sur deux des quatre ensembles distincts de plans {111}. Une seule sous-variante d'ordre de type B peut être en outre sélectionnée en utilisant des substrats vicinaux. En effet, des travaux récents ont montré que cela s'appliquait également au GaAsBi, où un grand CuPtB -des domaines de type ont été obtenus sur un seul ensemble de plans {111}B en utilisant des plaquettes de coupe à faible angle [34]. La commande de type CuPt dans GaInP2 est probablement le plus étudié car des cristaux de haute qualité avec un paramètre d'ordre élevé peuvent être obtenus dans cet alliage. L'ordre à longue distance modifie la symétrie du groupe ponctuel zinc-blende par rapport au tétraèdre Td au trigone C3v [35, 36]. Les effets notables dus à la réduction de la symétrie comprennent le rétrécissement de la bande interdite, la polarisation de la photoluminescence, la biréfringence et la déformation anisotrope [37,38,39]. L'ampleur de ces effets dépend du paramètre d'ordre à longue distance, η , qui montre l'étendue de la distribution élémentaire parmi les plans de réseau ordonnés. Dans un CuPtB -ordonné AB1−x Cx alliage (pour x <=0,5), le réseau alterne en B riche en éléments AB1−(x−η /2) Cx−η /2 et AB riche en C1-(x + η /2) Cx + /2 monocouches suivant une direction <111>B. Le paramètre de commande η =0 dans un alliage aléatoire alors que dans un alliage entièrement ordonné avec une concentration x c'est donc η =2x .
De toute évidence, la distribution de Bi dans de tels alliages ordonnés diffère d'un alliage aléatoire, et cela devrait être pris en compte lors de la déduction des propriétés de l'alliage [17, 40]. La compréhension des effets d'ordonnancement du CuPt dans les alliages GaAsBi dilué n'en est qu'à ses débuts, nécessitant des études plus systématiques. Dans cet article, des méthodes STEM avancées à correction d'aberrations sont utilisées pour analyser les modes de distribution du Bi dans plusieurs alliages GaAsBi à croissance distincte. L'analyse est effectuée à l'aide d'un traitement d'image statistique STEM Z-contraste et de simulations d'image, ainsi que de la spectroscopie de dispersion d'énergie des rayons X (EDX) à résolution atomique. La spectroscopie de perte d'énergie des électrons monochromatiques (EELS) est utilisée pour étudier les changements de volume des cellules unitaires locales dans GaAsBi à l'aide de déplacements d'énergie plasmonique en vrac.
Résultats et discussion
Le premier GaAs1−x Bix L'échantillon présenté ici, S1, est une hétérodiode p-i-n avec des couches de GaAs dopé et un bismide intrinsèque de 420 nm. La concentration de bismuth dans l'échantillon a été déterminée à 4,5% Bi en utilisant la diffraction des rayons X (non montrée ici) et la température ambiante PL, indiquant une bande interdite de 1,10 eV (SI Fig. S1). Les mesures de bord de bande PL sont converties en Bi% en utilisant les références [1, 2, 4]. Une image STEM HAADF en coupe transversale à résolution atomique le long de l'axe de la zone [110] près de l'interface GaAs-GaAsBi est montrée sur la figure 1a. L'axe de croissance [001] et d'autres directions cristallographiques pertinentes sont indiqués sur la figure 1b et s'appliquent également à la figure 1a. Étant donné que les atomes de Bi lourds dispersent les électrons de la sonde à des angles élevés beaucoup plus forts que les atomes de Ga ou d'As, le détecteur HAADF avec un grand angle de collection interne (90 mrad ici) met en évidence favorablement la distribution de Bi dans des échantillons minces. Le cristal vu selon une direction <110> apparaît comme un ensemble d'"haltères" atomiques orientés parallèlement à l'axe de croissance [001]. En raison de leurs numéros atomiques similaires (Z), Ga (31) et As (33) ne peuvent pas être facilement distingués par une simple inspection des images HAADF. Cependant, les colonnes du groupe V contenant du Bi présentent un contraste nettement plus élevé. Comme on peut le voir sur la figure 1a et dans la région agrandie près de l'interface, les colonnes du groupe V sont positionnées dans la moitié supérieure des haltères au-dessus des colonnes Ga. Ceci est attendu lors de l'imagerie de GaAsBi le long de l'axe de la zone [110]. Notez que la polarité des haltères du groupe V/III est inversée lorsque l'échantillon est visualisé le long de la direction orthogonale [\( \overline{1} \)10]. Ces directions orthogonales dans le plan peuvent également être distinguées puisque l'ordre de type CuPt se produit sur des plans de type {111}B et ne peut donc être vu que par imagerie le long de l'axe de la zone [110]. La figure 1b montre une image HAADF à plus faible grossissement plus profondément dans le film avec CuPtB prononcé -type de commande. Les domaines ordonnés alternent aléatoirement entre les deux ensembles de {111}plans B, c'est-à-dire (\( \overline{1} \)11) et (1\( \overline{1} \)1). Ceux-ci sont appelés B+ et B− sous-variantes par convention. La transformée de Fourier de l'image est montrée dans l'encart en haut à gauche. Les quatre principaux spots de Bragg sont de type [111]*, tandis que les quatre spots de super-réseau de type 1/2[111]* indiquent CuPtB ordre avec une magnitude similaire sur les deux ensembles de {111} plans B. Une région GaAsBi à phase séparée est visible sur la figure 1b sous la forme d'une bande plus sombre dans la partie inférieure de l'image. Ce domaine apparaît plus sombre qu'un bamide car il est de type GaAs Bi-déficient. En raison de la métastabilité des alliages GaAsBi, une décomposition spinodale et une séparation de phases ont été rapportées dans de nombreux articles [11,12,13,14, 41, 42]. Pour une représentation plus claire du B+ et B− ordre des sous-variantes, Figs. 1c, d sont présentés en formant des images en utilisant 1/2[111]* paires de réflexion de super-réseau. Un masque est appliqué à chaque paire de super-réseaux dans l'espace réciproque et l'inverse de Fourier est retransformé dans l'espace réel. Les régions plus claires des plans (111) dans ces images indiquent que l'ordre est plus prononcé, ou en d'autres termes, que le paramètre d'ordre varie localement. Il existe également des variations d'épaisseur de surface d'échantillon TEM dues à la préparation de l'échantillon par un faisceau d'ions focalisé. La préparation de l'échantillon peut laisser des couches superficielles amorphes et des agglomérats atomiques de Ga fondus à la surface, ce qui peut provoquer de faibles modulations d'intensité d'image. Cependant, Ga diffuse beaucoup plus faiblement aux angles élevés que les atomes Bi et ne devrait pas influencer significativement l'analyse de la distribution Bi. La flèche sur la figure 1d montre une région avec des limites d'antiphase ordonnées. À travers une telle frontière, le B+ (B− ) change de phase en commutant tous les plans riches en Bi en plans riches en As. L'ordre des limites d'antiphase peut se former par glissement de dislocations ou par alternance aléatoire entre B+ et B− domaines au cours de la croissance [43]. Ce dernier semble être le cas ici.
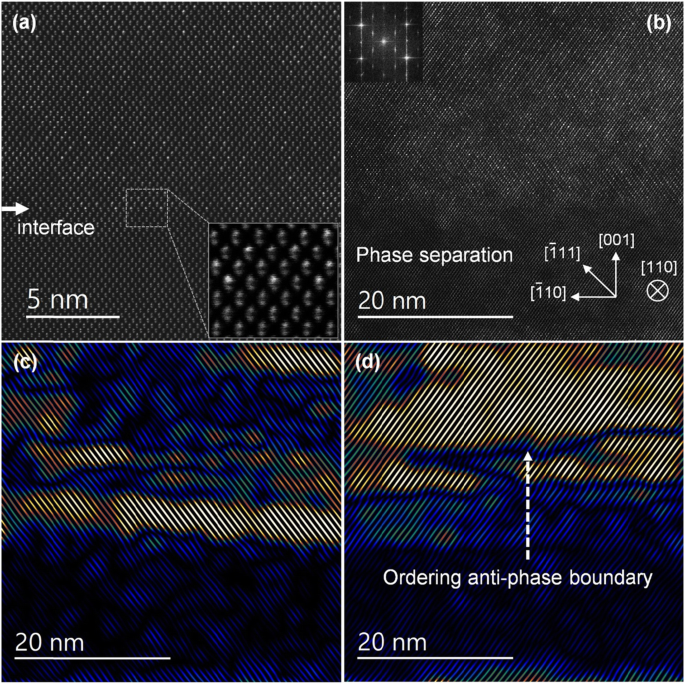
un Image HAADF en coupe transversale de la zone d'interface GaAs-GaAsBi de l'échantillon S1. Un encart agrandi de l'interface est affiché en bas à droite. Les directions cristallographiques sont les mêmes que sur la figure 1b. b Image HAADF de l'échantillon loin de l'interface. Un domaine de type GaAs allongé spontanément séparé en phases est observé au milieu. L'encart montre la transformée de Fourier de l'image. c Une image formée de (b ) en utilisant la paire 1/2[\( \overline{1} \)11]* de réflexions de super-réseau. Des couleurs plus vives indiquent un ordre plus prononcé. d Une image formée de (b ) en utilisant la paire de ½[1\( \overline{1} \)1]*reflets
La quantification de l'image HAADF montrée sur la figure 1a est effectuée ensuite en considérant les distributions spatiales des sections efficaces de diffusion des colonnes atomiques (SCS) (voir Méthodes). L'algorithme StatSTEM est utilisé pour ajuster les colonnes avec des gaussiennes bidimensionnelles, et le SCS d'une colonne donnée est défini comme le volume sous cette gaussienne [44, 45]. Il s'agit d'une quantification basée sur un modèle paramétrique, par opposition à l'intégration directe des intensités des colonnes dans une image expérimentale. L'approche du modèle paramétrique peut être plus fiable si les intensités des colonnes ont tendance à se chevaucher, comme dans <110> GaAsBi. La distribution de SCS dans la figure 1a quantifiée est tracée sous forme d'histogramme sur la figure 2b, qui est provisoirement ajustée avec cinq gaussiennes. Les distributions spatiales de SCS sont ensuite tracées sur la figure 2a sur la structure du modèle composée d'une superposition de gaussiennes utilisant les mêmes carrés de schéma de couleurs placés sur chaque colonne. Les colonnes SCS de Ga et As se chevauchent fortement et produisent le pic principal dans l'histogramme. Cela est dû aux nombres Z similaires de ces atomes ainsi qu'à un élargissement supplémentaire introduit expérimentalement (voir Méthodes). En traçant la composante gaussienne inférieure (couleur bleu foncé) ou supérieure (bleu plus clair) dans ce pic principal montre que ~ 60%, par exemple, les colonnes d'As dans la couche tampon de GaAs sont identifiées correctement, comme cela peut être inspecté à partir de la polarité de l'haltère . À titre de comparaison, la quantification SCS de la couche tampon inférieure de GaAs seule est présentée dans la figure supplémentaire S2. Cela suggère que plus de deux gaussiennes sont actuellement nécessaires pour mieux distinguer les colonnes Ga et As dans le champ de vision et indique que leur SCS moyen diffère jusqu'à 10 %. Cette différence est en accord avec nos simulations présentées ci-dessous ainsi qu'avec les résultats trouvés dans Beyer et al. [17], où les distributions d'intensité de colonne intégrées Ga et As dans [010] GaAsBi ont été résolues. La présence d'atomes Bi fortement diffusants étend le SCS à des valeurs supérieures à ~ 5,5 × 10 5 e - Å 2 (voir SI Fig. S2), qui donne naissance à l'épaule droite de la Fig. 2b. Il est équipé de trois gaussiennes pour distinguer provisoirement les colonnes avec un contenu Bi plus élevé. L'interface GaAs-GaAsBi atomiquement abrupte est visible sur la figure 2a. Un examen plus approfondi montre que la première couche de colonnes du groupe V (001) contenant un nombre important d'atomes de Bi est disposée sur un haltère sur deux le long de l'interface. Cela suggère l'apparition d'un ordre de type CuPt au début de la croissance épitaxiale. Une représentation de la configuration atomique de l'interface est montrée dans l'encart de la figure 2b. Il recrée la disposition des atomes le long de l'interface avec les atomes Bi (orange) sur une colonne sur deux le long du premier plan du groupe V (001). Les premiers ~ 4-5 (001) plans atomiques de la figure 2a ne montrent aucune prédisposition pour CuPt B+ ou B− sous-variantes. Un ordre à variante unique plus prononcé émerge de la ~ 6e (001) couche atomique du groupe V, puis passe à l'autre sous-variante. Pas de défauts antisites BiGa sont indiqués par la distribution SCS à l'interface, qui serait visible sous forme de carrés sur les colonnes du groupe III avec des couleurs associées à Bi. Une probabilité de plusieurs BiGa antisites, cependant, se trouve dans le coin supérieur droit de la figure. Les colonnes du groupe III et du groupe V montrent un SCS de type Bi sur des haltères simples dans cette région, ce qui peut également indiquer la présence de paires de défauts BiGa -BiAs . Pour avoir une meilleure idée du nombre d'atomes Bi impliqués dans la détermination du SCS, notez que dans un échantillon d'une épaisseur nominale de 20 à 25 nm, il y a 50 à 60 atomes dans une colonne <110>. Ainsi, 2 à 3 atomes de Bi sont les plus susceptibles d'être trouvés dans une colonne du groupe V pour un alliage aléatoire avec actuellement 4,5% de Bi. Ce nombre sera plus élevé dans les plans bi-riches ordonnés, atteignant probablement jusqu'à 6-7 dans les colonnes avec le plus grand SCS [40]. Pour compléter l'analyse StatSTEM, la simulation d'image multicoupe HAADF est présentée ensuite sur une structure de supercellule GaAsBi <110> modèle (voir Méthodes pour plus de détails).

un Une distribution de SCS sur la figure 1a. Les carrés de couleur sur chaque colonne atomique sont conformes au schéma de couleurs SCS de la figure 2b. b Un histogramme de SCS sur la figure 1a, équipé de 5 gaussiennes. L'encart montre une représentation de la région d'interface. Les colonnes atomiques Ga sont en bleu foncé, As—en bleu plus clair, et les colonnes contenant Bi sont en orange. c Image HAADF simulée de la structure GaAsBi montrée sur la figure 2d. Le nombre d'atomes Bi dans une colonne est indiqué entre parenthèses en orange à droite de chaque colonne du groupe V. Les valeurs SCS ajustées sont affichées à gauche de chaque colonne et sont normalisées à la plus grande valeur SCS dans la supercellule. d La structure du modèle GaAsBi <110> a pivoté latéralement pour mettre en évidence les positions Bi (orange), les atomes bleu clair-As et bleu foncé-Ga. La flèche indique la direction du faisceau incident
La contribution à l'intensité de l'image HAADF des atomes de Bi à différentes profondeurs d'échantillon peut être non linéaire en raison de ce que l'on appelle vaguement la canalisation [46,47,48,49]. La quantification des dopants à l'échelle atomique doit donc être prise en compte pour distinguer la vraie variation de la composition de la variation des configurations des dopants [50, 51]. Pour illustrer le comportement de canalisation, la variation d'intensité moyenne de la sonde avec la profondeur de l'échantillon lorsqu'elle est positionnée sur la colonne As dans <110> GaAs est simulée numériquement et illustrée dans la figure supplémentaire S3 (voir Méthodes). La structure modèle GaAsBi de 17 nm d'épaisseur utilisée pour les simulations HAADF est montrée sur la figure 2d tournée latéralement pour mettre en évidence les positions des atomes Bi (orange) dans les colonnes As (As—bleu clair, Ga—bleu foncé). La flèche marque la direction du faisceau incident. L'image simulée montrée sur la figure 2c est ajustée à l'aide de l'algorithme StatSTEM pour comparaison avec l'expérience. Les valeurs SCS obtenues ont été normalisées à la valeur SCS de la colonne avec le plus grand SCS (6 atomes de Bi) et arrondies à deux chiffres significatifs. Ces valeurs normalisées sont affichées à gauche de chaque colonne. Le nombre d'atomes Bi dans chaque colonne du groupe V est indiqué entre parenthèses à droite de la colonne. Dans un accord raisonnable avec les résultats précédents, la différence entre les valeurs de As et Ga SCS est d'environ 8 %. La différence de SCS entre les colonnes d'As pur et les colonnes d'As contenant un atome de Bi est comprise entre 2 et 4 % pour des atomes de Bi positionnés différemment. On peut clairement voir que différentes configurations Bi peuvent être mal interprétées pour différentes compositions, par exemple, 4 et 5 atomes ou 5 et 6 atomes, qui donnent presque les mêmes valeurs SCS. Les atomes Bi dans une colonne vers la surface inférieure contribuent de moins en moins au SCS. Plusieurs configurations ayant 2 atomes Bi l'une après l'autre examinées ici semblent produire des contributions importantes aux valeurs SCS. On peut s'attendre à trouver une configuration de 2 atomes de Bi le long d'une colonne [110] en pratique si le CuPtB la commande en alliages GaAsBi produit en effet des unités structurelles avec C3v symétrie de groupe ponctuel, c'est-à-dire un atome de Ga dont les voisins les plus proches sont 1 atomes As et 3 atomes Bi. Notez que des colonnes Ga identiques présentent également une variation de leur SCS jusqu'à ~ 0,02. Cela suggère que leur environnement immédiat, p. De meilleurs algorithmes de mise à l'échelle récemment introduits ouvrent la possibilité d'accélérer les calculs multicoupes de mécanique quantique et ainsi d'explorer plus en détail les effets susmentionnés [53, 54].
Pour conclure l'analyse STEM de l'échantillon S1, la spectroscopie de perte d'énergie électronique (EELS) est utilisée pour cartographier les énergies de plasmon en vrac. Les déplacements d'énergie du plasmon seront liés aux changements de volume des cellules unitaires et donc à la déformation de l'alliage, comme nous le verrons ensuite. GaAs présente un pic de plasmon majeur à ~ 16 eV, et contrairement à, par exemple, CdTe, il ne présente pas de caractéristiques interférentes complexes provenant des transitions interbandes [55]. En première approximation pour interpréter les changements d'énergie du plasmon mesurés, nous utilisons le modèle Drude-Lorenz pour le gaz d'électrons libres, où les électrons libres sont maintenant les électrons de valence dans le semi-conducteur [56]. L'énergie globale du plasmon dans ce modèle est donnée par \( {E}_p=\hslash {\left(N{e}^2/ Vm{\epsilon}_0\right)}^{1/2} \), où N est le nombre d'électrons de valence dans la maille élémentaire, e est la charge électronique, V est le volume de cellule unitaire, m est la masse de l'électron, et ε 0 est la permittivité de l'espace libre. Le modèle simple de Drude-Lorenz prédit généralement l'énergie du plasmon à quelques pour cent près dans les semi-conducteurs et doit être corrigé des effets de structure de bande si une meilleure correspondance est recherchée [56]. Comme indiqué dans InGaAs et les alliages semi-conducteurs au nitrure du groupe III, le changement de volume de cellule unitaire est la principale quantité déterminant les déplacements d'énergie du plasmon [57, 58]. De même, la substitution d'atomes Bi isoélectroniques dans la matrice GaAs agit principalement pour augmenter le volume de la cellule unitaire, V , et ainsi décaler vers le rouge l'énergie du plasmon. Dans ce qui suit, nous utilisons les énergies de crête GaAs et GaAsBi mesurées pour déduire le changement d'état de contrainte local dans la couche GaAsBi via un rapport de leurs volumes de cellules unitaires.
Une région est sélectionnée qui contient des domaines GaAsBi séparés en phase montrés dans l'image HAADF Fig. 3. Les spectres EELS ont été collectés à partir de chaque pixel accompagnant l'image HAADF acquise simultanément (voir Méthodes et SI Fig. S4 pour le spectre brut). Les lignes pointillées dans l'image HAADF indiquent les interfaces entre le GaAsBi intrinsèque et les couches de GaAs de type p (en bas) et de type n (en haut). Les lignes de démarcation de l'interface ont été déterminées à partir d'images STEM à faible grossissement (non illustrées ici). La couche protectrice de Pt est visible en tant que matériau de contraste le plus élevé au-dessus du n-GaAs supérieur. Les couches de GaAs ainsi que les domaines à séparation de phases au sein de GaAsBi apparaissent plus sombres sur l'image HAADF. Le profil de la ligne verticale sur la figure EELS de droite a été acquis en regroupant tous les points de données EELS horizontalement. Il montre le décalage d'énergie de pic de plasmon en vrac relatif, EGaAsBi -EGaAs , par rapport à l'énergie du plasmon GaAs (mesurée à 16,23 eV) dans la couche tampon p-GaAs inférieure. Le pic du plasmon se déplace en moyenne de 0,08 eV vers des énergies plus basses dans la couche de GaAsBi. Les petites variations à l'intérieur de ~ 0,01 eV se situent au niveau des niveaux de bruit de quantification. Les domaines séparés de phase près du GaAs supérieur (couche mince) et inférieur (deux domaines d'intersection) retournent à la valeur d'énergie du plasmon GaAs, suggérant qu'ils contiennent des concentrations de Bi négligeables. Concentrations de dopants dans les couches de GaAs (ordre 10 17 cm −3 ) sont insignifiants par rapport à N /V et ne devrait pas affecter l'énergie du plasmon. Considérons maintenant deux cas limites pour le GaAs1−x Bix volume de cellule unitaire V; un où le réseau est complètement détendu et un autre où il est complètement contraint au substrat GaAs. Dans le cas complètement relaxé, la maille unitaire est cubique avec une constante de réseau a ≈ 5,684 Å à x =4,5% Bi [1]. En utilisant la relation racine carrée ci-dessus entre l'énergie du plasmon et V , le décalage d'énergie par rapport à GaAs devrait être \( \Delta {E}_p^{GaAs Bi}=16.23\left({\left({V}_{GaAs}/{V}_{GaAs Bi}\right) }^{1/2}-1\right)=-0.132\mathrm{eV} \), ce qui est nettement plus grand que celui mesuré. Sur la base des tendances de relaxation des alliages GaAsBi, nous estimons qu'environ 30 % du réseau est détendu dans ce film de 420 nm d'épaisseur, étant donné qu'il a également subi un court recuit thermique lors de la croissance de la couche supérieure de n-GaAs. Par conséquent, la maille unitaire moyenne de GaAsBi sera surestimée dans le scénario complètement relaxé et explique le plus grand \( \Delta {E}_p^{GaAsBi} \) obtenu ci-dessus. Dans l'autre limite, le réseau de bismide est considéré comme complètement déformé avec la constante de réseau dans le plan égale à celle de GaAs (a =5,653 Å). La constante de réseau hors plan requise pour récupérer le décalage d'énergie de - 0,080 eV est alors trouvée a z =5.709 Å. C'est un a sensé z valeur et peut être comparée aux mesures XRD-RSM de GaAsBi contraint en compression au substrat de GaAs [1, 34, 59]. En raison de la relaxation, les constantes de réseau réelles devraient se situer entre ces deux cas limites. Cela démontre une méthode de caractérisation prometteuse qui peut fournir des informations sur la déformation du réseau complémentaire aux techniques basées sur les rayons X dans de tels alliages métastables.

Image en coupe HAADF (à gauche) de l'échantillon p-i-n S1, avec des couches GaAs et GaAsBi marquées. Les régions plus sombres au sein de GaAsBi sont des domaines séparés par des phases. Le profil de la ligne (à droite) montre le décalage d'énergie du pic de plasmon en vrac d'EELS, E GaAsBi -E GaA , par rapport à la couche tampon de GaAs. Le profil est étroitement aligné avec l'image HAADF acquise simultanément sur la gauche. Les pixels de données EELS sont entièrement regroupés dans la direction horizontale et indiquent ainsi des valeurs moyennées dans l'espace. La barre d'échelle est de 100 nm, et elle s'applique également à l'axe vertical du profil EELS
Le deuxième échantillon de GaAsBi, S2, a été cultivé sur une couche tampon de GaAs qui a été déposée sur un substrat de Ge coupé (voir Méthodes). L'hétéro-épitaxie Ge-GaAsBi a été analysée dans nos travaux précédents, qui ont également démontré une variante unique à large domaine CuPtB ordre dans GaAsBi [34]. Des données supplémentaires sont présentées dans ce travail et sont utilisées pour l'exhaustivité de la discussion sur l'ordre atomique Bi. La concentration totale de bismuth dans cet échantillon est d'environ 5,8 % telle que mesurée par PL (SI Fig. S1) [34]. Les chutes combinées à la couche tampon de GaAs employées dans cette épitaxie permettent d'éviter la formation de domaines d'antiphase dans GaAsBi, qui sont encore difficiles à éliminer lors de sa croissance directement sur Ge non polaire [60,61,62]. La figure 4a montre la zone d'interface GaAs-GaAsBi avec une couche de GaAsBi visiblement plus lumineuse dans l'image HAADF. Contrairement au précédent film GaAsBi déposé sur un substrat plan GaAs, ici, un seul CuPtB la sous-variante de commande est sélectionnée en raison de la chute. Cela peut être vu dans l'image HAADF, et son incrustation de transformée de Fourier en haut à droite montrant une paire de points de super-réseau 1/2[\( \overline{1} \)11]*. La figure 4b a été formée en appliquant un masque à la paire de réflexions de super-réseau, analogue à la figure 1c, d. Il montre un ordre beaucoup plus uniforme et plus large dans le film. Des images EDX résolues atomiquement ont été acquises à partir de cet échantillon pour estimer le paramètre d'ordre η sur la base de l'analyse compositionnelle. La cartographie chimique EDX excelle souvent par rapport à la quantification alternative EELS à perte de cœur, qui a tendance à avoir un rapport signal/bruit plus mauvais lors de la quantification des bords à haute énergie et à ionisation retardée [56, 63, 64, 65]. La direction de balayage STEM a été modifiée pour aligner les plans ordonnés (\( \overline{1} \)11) horizontalement. La figure 4c–e montre les cartes élémentaires de rayons X filtrées de Wiener. L'ordre des atomes Bi sur chaque deuxième plan (\( \overline{1} \)11) est clair et suit les positions atomiques As. Pour la quantification compositionnelle EDX, deux ensembles de données avec 512 × 512 pixels chacun ont été acquis à partir de différentes zones de l'échantillon en utilisant des conditions expérimentales identiques. Les sous-régions ont été alignées et les signaux bruts additionnés pour un total de 10 images. Des profils de lignes verticales de données brutes sommées horizontalement de As-K et Bi-M sont montrés sur la figure 4f. Pour quantifier la composition du bismuth dans les plans Bi-riche et Bi-déficient (111), une fenêtre d'intégration de 3 Å de large a été utilisée, centrée sur les plans atomiques. Après soustraction du bruit de fond et calcul de la moyenne sur tous les plans (111), cela montre que le nombre de rayons X Bi est ~ 3 fois plus élevé dans les plans riches en Bi. La concentration totale de 5,8 % de Bi dans l'échantillon, telle qu'obtenue par les mesures PL et XRD-RSM, est ensuite utilisée pour mettre à l'échelle linéairement les comptes de rayons X du Bi à la composition, ce qui montre que le Bi atteint jusqu'à 9 % dans les plans riches en Bi. Le paramètre d'ordre peut donc être estimé (voir Introduction) à η =0,07. Notez qu'un bamide entièrement ordonné avec cette concentration totale de Bi aurait le paramètre d'ordre =0,116. À l'instar de l'analyse HAADF, la quantification EDX de colonnes individuelles souffre d'effets de canalisation car le potentiel d'ionisation des électrons du noyau est très localisé. Comme le montrent d'autres auteurs dans Alx Ga1-x En tant qu'alliage, cela peut entraîner jusqu'à ~ 5% d'écart type des comptages de rayons X en raison de différentes configurations de dopants [50]. Compte tenu de la déviation, les comptages de rayons X s'avèrent toujours à l'échelle linéaire avec un certain nombre de dopants dans des échantillons pas trop épais. L'erreur de configuration dans la présente étude est minimisée en calculant efficacement la moyenne sur ~ 11 colonnes atomiques dans chaque plan (111), pour un total de ~ 130 colonnes. De plus, les queues de sonde électronique et la diffusion multiple peuvent produire une délocalisation du signal dans les images EDX [52]. Les simulations d'images HAADF dans la section précédente montrant la variation des valeurs Ga SCS suggèrent l'ampleur attendue de ces effets dans la quantification EDX. Le bruit de tir semble actuellement être le principal facteur limitant la précision en raison du nombre intrinsèquement faible de rayons X Bi dans de tels alliages dilués.

un Image HAADF de l'échantillon GaAsBi S2 près de l'interface avec la couche tampon GaAs, cultivée sur des chutes (001) Ge. La transformée de Fourier en haut à droite montre une paire de pics indiquant l'ordre sur l'ensemble unique de (\( \overline{1} \)11) plans. b Une image formée à partir de (a ) en utilisant la paire de super-réseaux 1/2[\( \overline{1} \)11]* points de Bragg. c –e Wiener a filtré les images EDX de l'échantillon GaAsBi, avec les émissions de rayons X Bi-M, As-K et Ga-K comme indiqué. Notez que dans les données EDX, les directions cristallographiques sont tournées pour aligner les plans ordonnés (\( \overline{1} \)11) horizontalement. f Profil de comptage de rayons X verticaux sommés horizontalement du signal brut As-K et Bi-M. Deux ensembles de données alignés sont combinés pour obtenir le profil
L'échantillon final de GaAsBi, S3, que nous souhaitons explorer ici a été synthétisé dans des conditions permettant de créer des modulations de composition verticales (VCM) (voir Méthodes) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens et al. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

un HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. b A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Conclusions
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Méthodes
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 cm −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 Torr. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
Disponibilité des données et des matériaux
Les ensembles de données utilisés et/ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- BEP:
-
Beam equivalent pressure ratio
- anguilles :
-
Electron energy-loss spectroscopy
- FFT :
-
Transformée de Fourier rapide
- HAADF :
-
Fond noir annulaire grand angle
- MBE :
-
Epitaxie par faisceau moléculaire
- PL :
-
Photoluminescence
- STEM :
-
Microscopie électronique à transmission à balayage
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX :
-
X-ray energy dispersive spectroscopy
Nanomatériaux
- Application du molybdène métal et de ses alliages
- 4 utilisations de l'hafnium | Les applications de l'hafnium et des alliages d'hafnium
- Propriétés et applications des alliages cuivre-nickel
- Un guide pour le cuivre fiable et ses alliages
- Types et caractéristiques :alliages d'aluminium et de bronze
- Comprendre les alliages métalliques et la limite d'élasticité
- 5 alliages métalliques industriels importants et leurs utilisations
- Traitement thermique de l'aluminium et des alliages d'aluminium
- Traitement thermique du cuivre et des alliages de cuivre



