Comportement de type ferroélectrique provenant de dipôles à vide d'oxygène dans un film amorphe pour mémoire non volatile
Résumé
Les dispositifs ferroélectriques traditionnels souffrent d'un manque d'évolutivité. HfO dopé2 le film mince est prometteur pour résoudre le problème de l'entartrage mais contesté par le courant de fuite élevé et le problème d'uniformité par la nature polycristalline. Un comportement stable de type ferroélectrique est d'abord démontré dans un Al2 amorphe de 3,6 nm d'épaisseur O3 film. L'Al2 amorphe O3 Les dispositifs sont hautement évolutifs, ce qui permet d'activer un transistor à effet de champ non volatil (NVFET) à grilles multiples avec un pas d'ailette à l'échelle nanométrique. Il possède également les avantages d'une température de processus basse, d'une fréquence élevée (~GHz), d'une large fenêtre de mémoire et d'une longue endurance, suggérant un grand potentiel dans les systèmes VLSI. La polarisation commutable (P ) induite par les dipôles de lacune d'oxygène modulés en tension est proposée.
Contexte
La mémoire ferroélectrique à accès aléatoire (FeRAM) basée sur des ferroélectriques pérovskites conventionnels (par exemple, PZT) a été l'une des mémoires non volatiles (NVM) commerciales [1], bien qu'elle ne puisse pas être mise à l'échelle et ne soit pas compatible CMOS. La ferroélectricité a été largement observée dans une variété de matériaux différents, tels que les parois aortiques porcines [2], Sb2 S3 nanofils [3], GaFeO3 film [4], dopé poly-HfO2 films [5], films d'hydroxyapatite nanocristallins [6] et LaAlO3 -SrTiO3 cinéma [7]. Parmi ces matériaux, dopé-HfO2 Les films ont suscité un intérêt particulier pour l'application NVM en raison de leur compatibilité avec les processus CMOS. Mais la structure polycristalline est inévitable pour générer de la ferroélectricité en HfO dopé2 , ce qui a amené à surmonter les obstacles suivants pour l'application du dispositif :1) il est incompatible avec le traitement du dernier de grille en ce qui concerne le budget thermique de 500 °C requis pour former des phases cristallines orthorhombiques [8] ; 2) la consommation d'énergie est induite par un courant de fuite indésirable le long des joints de grains, qui augmente de façon exponentielle avec la réduction de l'épaisseur ferroélectrique. Récemment, une étude théorique a proposé que la ferroélectricité supplémentaire dans le poly-HfO2 épais (>5 nm) peut provenir des corrélations à longue distance dans l'assemblage des dipôles électriques créés par les lacunes d'oxygène [9]. On a observé que le mécanisme de piégeage/dépiégeage de charge de défaut produisait un comportement de type ferroélectrique dans un Al2 amorphe de 5 nm d'épaisseur O3 pour une mémoire multi-états, qui souffre cependant d'une très faible fréquence de piégeage/dépiégeage (par exemple, ~500 Hz) [10].
Dans ce travail, un comportement de type ferroélectrique stable est démontré dans un Al2 amorphe de 3,6 nm d'épaisseur O3 film, où la polarisation commutable (P ) est proposé d'être induit par les dipôles de lacunes d'oxygène modulés en tension. L'Al2 amorphe O3 Le film possède les avantages d'une faible température de processus et d'une fréquence de fonctionnement jusqu'à ~ GHz, qui permettent un transistor à effet de champ non volatil à grilles multiples (NVFET) avec un pas d'ailette à l'échelle nanométrique. Al2 O3 Mémoire NVFET avec des tensions de programme/effacement (P/E) de largeur d'impulsion de 100 ns et plus de 10 6 L'endurance des cycles P/E est démontrée. Les effets des électrodes et de l'épaisseur du film sur le P dans Al2 O3 les condensateurs sont également étudiés. Les dispositifs non volatils amorphes affichent un avenir prometteur dans les mémoires VLSI.
Méthodes
Al amorphe2 O3 les films ont été développés sur des substrats de Si(001), Ge(001) et TaN/Si par dépôt de couche atomique (ALD). TMA et H2 Les vapeurs d'O ont été utilisées comme précurseurs d'Al et d'O, respectivement. Pendant le dépôt, la température du substrat a été maintenue à 300 °C. Différentes électrodes métalliques supérieures, y compris TaN/Ti, TaN et W, ont été déposées sur Al2 O3 surfaces par pulvérisation cathodique réactive. Des condensateurs avec différentes électrodes ont été fabriqués par lithographie et gravure sèche. Un recuit thermique rapide (RTA) à 350 °C pendant 30 s a été réalisé. NVFET avec TaN/Al2 O3 La pile de portes ont été fabriquées sur Ge(001). Après la formation de la grille, les régions source/drain (S/D) ont été implantées par BF2 + avec une dose de 1 × 10 15 cm -2 et une énergie de 20 keV, et des électrodes métalliques en nickel S/D de 20 nm d'épaisseur ont ensuite été formées par un processus de décollement. La figure 1a et b montre les schémas de l'Al2 fabriqué O3 condensateur et le NVFET à canal p. Il y a une couche interfaciale (IL) entre l'électrode et l'Al2 O3 film. Les figures 1c et d montrent les images au microscope électronique à transmission à haute résolution (HRTEM) du TaN/Al2 O3 /Ge s'empile avec différents Al2 amorphes O3 épaisseurs (t AlO ) après un RTA à 350 °C.
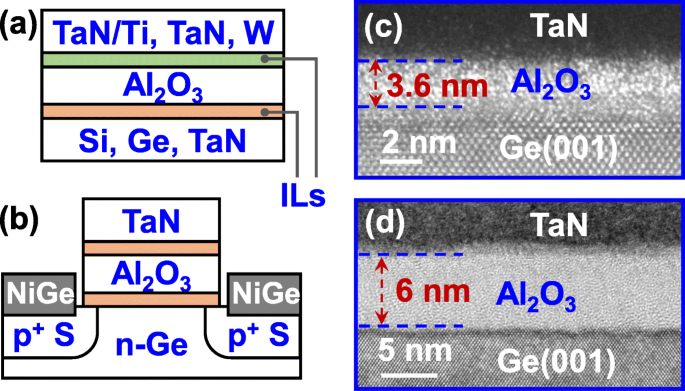
Schémas du a fabriqué Al2 O3 condensateurs avec diverses électrodes et b Al2 O3 NVFET. c et d Images HRTEM du TaN/Al2 fabriqué O3 /Ge stacks avec différents t AlO , montrant l'Al2 amorphe O3 films après RTA à 350 °C
Résultats et discussion
La figure 2 montre le P mesuré contre. tension V caractéristiques pour l'Al2 amorphe O3 condensateurs avec différents t AlO et diverses électrodes supérieures et inférieures. La fréquence de mesure est de 1 kHz. Comme le montre la Fig. 2a–c, avec un 3,6 nm fixe de t AlO , TaN/Al2 O3 Le condensateur /Ge atteint une saturation plus élevée P (P samedi ) par rapport aux appareils avec électrodes supérieures TaN/Ti et W. Le comportement de type ferroélectrique est fortement corrélé avec les interfaces, et il est proposé que la formation de TaAlOx IL entre TaN et Al2 O3 produit plus de lacunes d'oxygène, contribuant à une commutation plus forte P , comparé au TiAlOx et WAlOx IL. P-V les courbes de la Fig. 2d indiquent que TaN/Al2 O3 Le condensateur /TaN a un P beaucoup plus élevé samedi en comparaison avec TaN/Al2 O3 /Ge, qui est attribué au fait que le double TaAlOx Les IL fournissent une concentration d'oxygène manquante plus élevée. Tandis que P samedi est nettement inférieur à celui de l'électrode inférieure en Si (Fig. 2e), par rapport à l'électrode en Ge. Ce résultat indique que Al2 O3 La qualité de l'interface /Si est meilleure, c'est-à-dire moins de lacunes d'oxygène, par rapport à celle du dispositif basé sur le substrat Ge. La figure 2f montre le P-V courbes d'un TaN/Al2 O3 (6 nm)/condensateur Ge, présentant un V plus élevé c et un P presque identique samedi par rapport à celui de l'appareil avec 3,6 nm d'Al2 O3 film de la figure 2b. Il est à noter que la raison du P non fermé -V boucles, c'est parce qu'une fuite existe bel et bien. Il a été rapporté que le grand décalage à un champ électrique de zéro se produisait toujours avec un grand champ, et il disparaissait toujours progressivement avec la plus petite plage de balayage de V [11, 12].
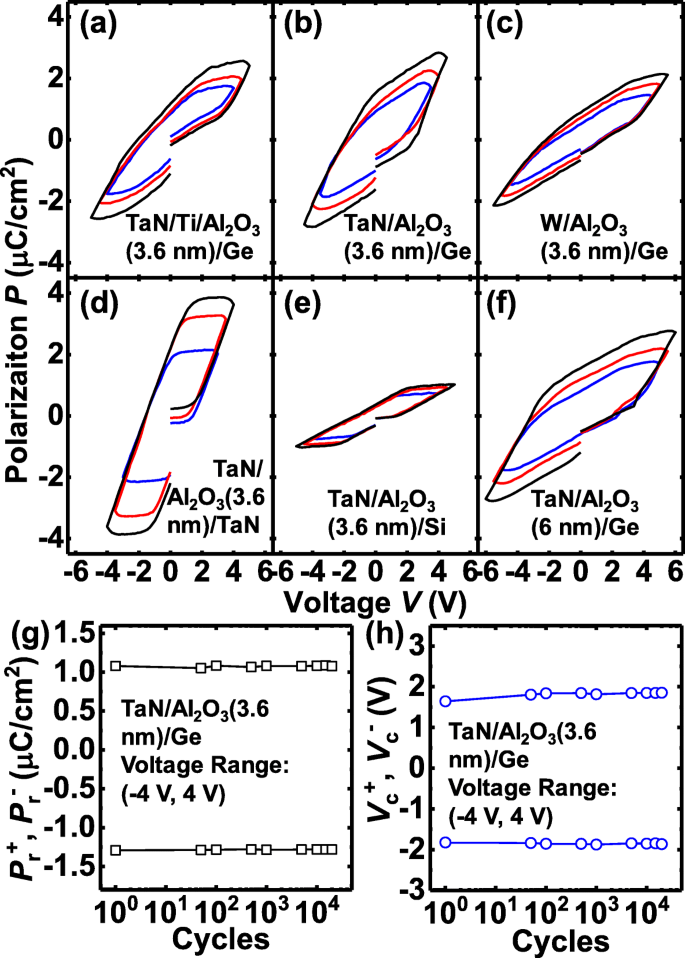
P mesuré contre V caractéristiques de l'Al2 O3 condensateurs avec différentes électrodes. un , b , et c montrant le P -V courbes de TaN/Ti/Al2 O3 /Ge, TaN/Al2 O3 /Ge et W/Al2 O3 /Ge, respectivement, avec un t de 3,6 nm AlO . d et e montrant que le P samedi est amélioré (réduit) en utilisant TaN (Si) comme électrode inférieure au lieu de Ge. f TaN/Al2 O3 (6 nm)/le condensateur Ge a un V plus élevé c et un P similaire samedi par rapport à l'appareil de 3,6 nm d'épaisseur dans b . g et h Mesures d'endurance ne montrant aucune dégradation de P r et V c observé après 10 4 cycles de balayage pour un TaN/Al2 O3 (3,6 nm)/condensateur Ge
Les figures 2g et h montrent l'évolution extraite du reliquat positif et négatif P (P r ) et coercitif V (V c ) valeurs, respectivement, supérieures à 10 4 cycles de balayage pour un TaN/Al2 O3 /Ge condensateur. Aucun effet de réveil, d'empreinte ou de fatigue n'est observé. V c de l'appareil est d'environ 1,8 V, ce qui indique que le E dans l'Al2 O3 le film est de 4 à 6 MV/cm et dans les IL peut dépasser 8 MV/cm, ce qui est suffisamment élevé pour entraîner les lacunes en oxygène [13, 14]. P samedi des appareils varie de 1 à 5 μC/cm 2 , correspondant à une concentration raisonnable en manque d'oxygène dans la plage 3~15×10 12 cm -2 en supposant qu'ils ont la charge de plus deux.
Le mécanisme sous-jacent du comportement de type ferroélectrique associé aux lacunes d'oxygène dans Al2 O3 appareils est discuté. La migration des lacunes d'oxygène induites par la tension a été largement démontrée dans les dispositifs de mémoire vive résistive [15, 16]. La figure 3 montre les schémas du P commutable en TaN/Al2 O3 /Ge, qui provient de la ségrégation des lacunes d'oxygène modulées en tension et des charges négatives pour former les dipôles électriques. Il est raisonnable de déduire que les lacunes mobiles en oxygène proviennent principalement de la formation de TaAlOx IL et sont situés à proximité de l'interface supérieure à l'état initial (Fig. 3a). Les figures 3b et c indiquent comment le P positif et négatif se forment, respectivement, avec la modulation de la lacune d'oxygène et des dipôles de charge négative sous la tension appliquée. Spectres de photoélectrons aux rayons X (XPS) de Al2 O3 /Ge et (Ti, TaN et W)/Al2 O3 Les échantillons de /Ge sont mesurés et représentés sur la figure 4). Pour tout le métal/Al2 O3 /Ge échantillons, il y a un oxyde métallique IL formé entre le métal et Al2 O3 , qui sont proposés comme réservoir d'ions oxygène et de lacunes, ce qui est cohérent avec la réf. [17].
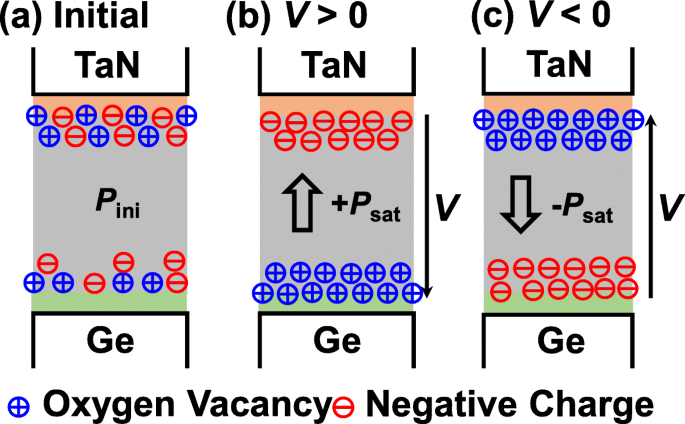
Schémas du mécanisme du comportement de type ferroélectrique dans Al2 O3 condensateurs. P commutable est due à la migration des lacunes d'oxygène et des charges négatives pour former des dipôles

Spectres XPS de niveau de base de a Al2 O3 /Ge, b TaN/Al2 O3 /Ge, c Ti/Al2 O3 /Ge, et d W/Al2 O3 /Ge échantillons
Pour caractériser les performances électriques de l'Al2 O3 NVFET comme NVM, l'opération de programme (effacement) est obtenue en appliquant des impulsions de tension positives (négatives) à la porte, pour augmenter (abaisser) sa tension de seuil (V TH ). La figure 5a montre comment les caractéristiques de transfert de région linéaire de l'Al2 O3 Décalage NVFET par rapport au I initial DS -V GS courbe mesurée avec des tensions de programme (effacement) ±4 V avec une largeur d'impulsion de 100 ns. Ici, V TH est défini comme un V GS à 100 nA⋅W/L, et MW est défini comme la variation maximale de V TH . L'Al2 O3 NVFET obtient un MW de 0,44 V, bien que Al2 amorphe O3 le film a un P plus petit r que le HfO dopé signalé 2 films [5, 8]. Il est à noter que la fréquence de fonctionnement élevée jusqu'à 10 MHz de Al2 O3 Mémoire NVFET, qui indique ce P commutable dans Al2 O3 provient de la migration de la lacune d'oxygène entraînée par la tension pour former des dipôles, et non des défauts de piégeage/dépiégeage de charge. Des impulsions de programme et d'effacement alternées ont été appliquées à l'Al2 O3 appareils pour approfondir l'étude de l'endurance de l'appareil. La figure 5b montre les tracés de V TH contre. Nombre de cycles P/E, suggérant qu'un MW stable peut être maintenu sans dégradation significative sur 10 6 Cycles P/E pour un Al2 de 3,6 nm d'épaisseur O3 NVFET.
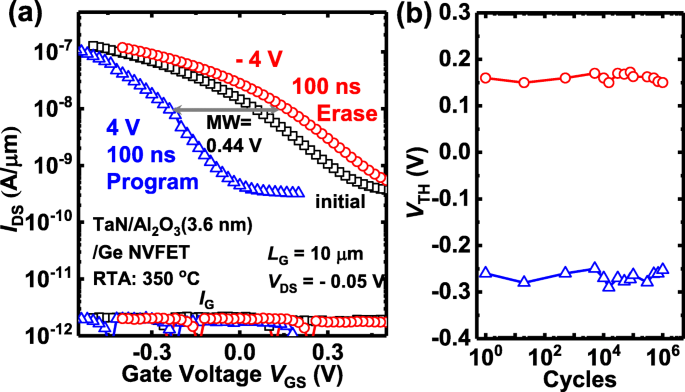
un Mesuré I DS -V GS courbes d'un Al2 de 3,6 nm d'épaisseur O3 NVFET pour l'état initial et les deux états de polarisation. Un MW de 0,44 V est obtenu. b La mesure d'endurance démontre qu'aucune dégradation du MW n'est observée après 10 6 Cycles P/E
Notamment, le comportement de type ferroélectrique observé dans l'Al2 amorphe O3 dispositifs peuvent être étendus aux oxydes amorphes universels, par exemple, l'oxyde d'hafnium (HfO2 ) et oxyde de zirconium (ZrO2 ).
Conclusions
Un comportement stable de type ferroélectrique est d'abord réalisé dans des condensateurs avec un Al2 mince amorphe O3 isolant. P commutable en Al2 amorphe O3 condensateurs est démontré par P-V boucles et test NVFET. Il est proposé que le comportement de type ferroélectrique provienne des lacunes d'oxygène de l'interface et des dipôles d'ions. L'Al2 de 3,6 nm d'épaisseur O3 NVFET atteint un MW de 0,44 V et plus de 10 6 endurance de cycle sous ±4 V à 100 ns condition P/E. Dans l'ensemble, ce travail a ouvert un nouveau monde pour les dispositifs ferroélectriques à oxyde amorphe, qui sont prometteurs pour les NVFET multigrilles (en forme d'ailette, de nanofil ou de nanofeuille) avec un pas d'ailette potentiellement nanométrique dans les systèmes VLSI.
Disponibilité des données et des matériaux
Les ensembles de données soutenant les conclusions de cet article sont inclus dans l'article.
Abréviations
- Al2 O3 :
-
Oxyde d'aluminium
- ALD :
-
Dépôt de couche atomique
- BF2 + :
-
Ion fluorure de bore
- E c :
-
Champ électrique coercitif
- Voir :
-
Germanium
- GeOx :
-
Oxyde de Germanium
- HRTEM :
-
Microscope électronique à transmission haute résolution
- Je DS :
-
Courant de vidange
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- MW :
-
Fenêtre mémoire
- Non :
-
Nickel
- NVFET :
-
Transistor à effet de champ non volatil
- P r :
-
Polarisation résiduelle
- P samedi :
-
Polarisation de saturation
- RTA :
-
Recuit thermique remboursé
- TaAlOx :
-
Oxyde d'aluminium tantale
- t AlO :
-
Épaisseur d'oxyde d'aluminium
- TaN :
-
Nitrure de tantale
- V GS :
-
Tension de grille
- V TH :
-
Tension de seuil
- XPS :
-
Spectres de photoélectrons aux rayons X
Nanomatériaux
- Une mémoire plus intelligente pour les appareils IoT
- La famille de mémoires non volatiles augmente la densité
- Testeur de vitesse d'obturation pour appareils photo argentiques
- Film PC antibuée pour visières, lentilles et lunettes
- Diélectrophorèse assistée par chauffage pour film de nanotubes de carbone à paroi unique alignés de très haute densité
- Nanofils de silicium amorphe cultivés sur film d'oxyde de silicium par recuit
- Film à base d'époxy Solvay pour préimprégnés
- Film de capteur pour l'aérospatiale
- Une nouvelle méthode fabrique de la mémoire informatique à partir d'oxyde de titane



