Conception de modèle de test pour les dommages induits par plasma sur le diélectrique inter-métal dans les processus FinFET Cu BEOL
Résumé
Les interconnexions haute densité, rendues possibles par les technologies avancées CMOS Cu BEOL, conduisent à des couches de métaux étroitement placées. Les lignes métalliques à rapport d'aspect élevé nécessitent des processus de gravure au plasma étendus, ce qui peut poser des problèmes de fiabilité sur les couches diélectriques inter-métalliques (IMD). Cette étude présente des modèles de test nouvellement proposés pour évaluer l'effet de l'effet de charge induit par le plasma sur l'intégrité de l'IMD entre des lignes métalliques proches. De fortes corrélations entre les intensités de charge du plasma et les dommages trouvés dans les couches IMD sont trouvées et analysées de manière exhaustive.
Introduction
Les processus de back-end de ligne (BEOL) à base de Cu ont été largement utilisés alors que les technologies migrent vers un régime inférieur à 100 nm. Les interconnexions compactes sont constituées de vias à rapport d'aspect élevé et de lignes métalliques sont rendues possibles par une série de processus de gravure améliorés par plasma [1,2,3]. Il est bien connu que les traitements au plasma à haute énergie peuvent entraîner une dégradation importante et des dommages latents dans les empilements diélectriques de grille des transistors, qui sont censés être le principal chemin de décharge pendant les événements de charge induits par le processus. Pour éviter les problèmes de fiabilité sur la qualité diélectrique de la grille, les fabricants de circuits intégrés fournissent généralement des règles et des directives de conception qui limitent la taille et la longueur des couches métalliques d'interconnexion [4, 5]. Avec un nombre accru de couches métalliques dans les systèmes de câblage complexes, il est difficile d'éviter le chemin de décharge à travers le film diélectrique inter-métal pendant la charge induite par le processus. Avec l'introduction de matériaux à faible k dans les processus BEOL [6, 7], atténué les problèmes de retard RC, les films d'isolation peuvent être plus sensibles aux contraintes de charge [8, 9]. Les dommages résultant des contraintes induites par la charge plasma sur les structures d'interconnexion compactes responsables de la réalisation des câblages BEOL complexes peuvent grandement affecter le rendement et la fiabilité des circuits intégrés CMOS avancés. Dans cette étude, nous incorporons les enregistreurs PID in situ précédemment rapportés [10,11,12], avec des modèles de test différentiels nouvellement proposés pour surveiller ses éventuels dommages IMD lorsqu'un chemin de décharge supplémentaire devient possible dans le cadre de processus Cu BEOL avancés. Les niveaux de charge plasma signalés par l'enregistreur à différents emplacements sur la plaquette peuvent être corrélés avec les dommages causés par la charge plasma sur les films IMD grâce aux nouveaux modèles de test. Les comportements de défaillance induits par les contraintes sur les structures IMD peuvent ensuite être facilement révélés grâce à ces modèles de test qui peuvent être utilisés dans une structure de test standard pour la surveillance de routine des nouveaux modes de défaillance et des problèmes de fiabilité possibles de l'IMD.
Structure et méthodologie de l'appareil
Les résultats de l'analyse des défaillances sur les circuits intégrés FinFET suggèrent que des dommages latents liés à l'augmentation des états de piège dans les couches diélectriques intermétalliques entre deux structures d'interconnexion isolées étroitement placées peuvent se produire, comme illustré sur la Fig. 1. Comme la largeur de ligne et l'espacement entre les interconnexions via et les interconnexions métalliques réduire de manière agressive à l'avance les processus CMOS BEOL, les charges collectées sur les gros fils métalliques, servent d'antennes, peuvent se décharger à travers l'IMD à travers les métaux et les vias/portes et les fils métalliques, entraînant des contraintes à champ élevé et/ou à courant élevé sur ces films diélectriques. En plaçant l'enregistreur PID in situ [10,11,12] à côté des deux motifs de test différentiels sur chaque puce, les niveaux de charge de plasma de référence sur une plaquette de 12 pouces peuvent d'abord être établis.
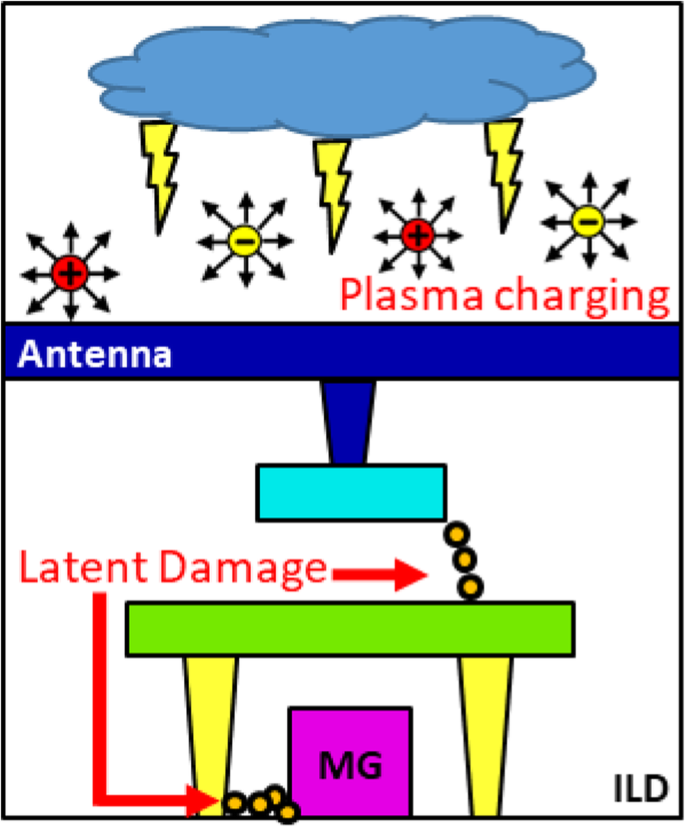
Les dommages induits par le plasma dans les couches diélectriques intermétalliques entre les motifs d'interconnexion étroitement emballés peuvent être liés à une dégradation latente de son intégrité d'isolement
Pour garantir que le courant de charge du plasma traversant la couche diélectrique entre les couches métalliques, le nœud M2 sur le motif de test de la figure 2 est isolé avant la fabrication de la structure de l'antenne. Deux nouvelles conceptions de motifs de test différentiels visant à augmenter la possibilité de causer des dommages latents pendant les contraintes de charge du plasma sont proposées et illustrées sur les figures 2a, b. L'appareil avec un motif de type I ne subira une contrainte de courant élevée que lorsque des électrons seront collectés sur son antenne correspondante. En effet, le courant de décharge est redressé par la jonction n+/p en série sur la voie conductrice. Alors que le dispositif à motif de type II est soumis à des contraintes I dans les deux sens [13]. À savoir, la charge d'ions et la charge d'électrons seront enregistrées sur ce dispositif de surveillance. Par conséquent, les échantillons de cette étude sont réalisés par le processus standard FinFET/Cu BEOL dans un nœud technologique de 16 nm. Les structures d'antenne sur un enregistreur PID ainsi que les dispositifs avec des motifs de type I et II placés sur chaque puce sont tous conçus avec une grande structure métallique 3. Les deux types de dispositifs de surveillance sont conçus avec une configuration différentielle, ce qui peut accentuer et par la suite minimiser le bruit de désalignement pouvant conduire à des lectures de défauts sur les effets PID.
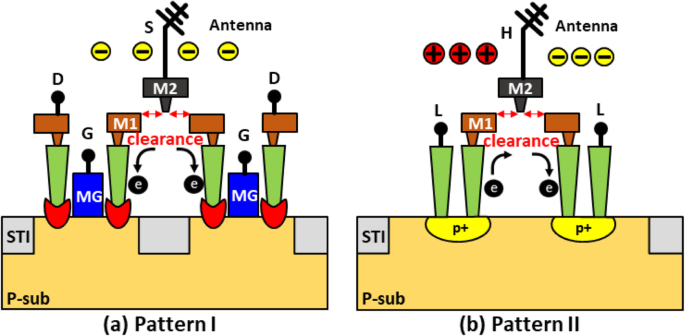
Illustrations de modèles de test différentiels nouvellement proposés conçus pour accentuer l'effet des dommages latents causés par le plasma induit a négatif et b contraintes bidirectionnelles, où le jeu entre la couche métallique doit être réglé à 14 nm
Résultats expérimentaux et discussion
Les données de la figure 3 sont obtenues en appliquant un balayage de tension sur le métal 2 de 0 à 20 V à une vitesse de balayage de 0,7 V/s, tandis que la tension de claquage et le courant de fuite IMD de chaque côté de quelques appareils différents avec motif de test Je peux alors être obtenu et comparé. Lors de la réalisation de la grande antenne M3 de 82 000 m 2 , le processus plasma devrait induire une charge de l'antenne. La charge accumulée devrait se décharger par le chemin avec la résistance la plus faible. Les données révèlent que certains échantillons présentent un claquage diélectrique précoce, tandis que l'IMD sur d'autres appareils reste relativement intact avec une faible fuite.
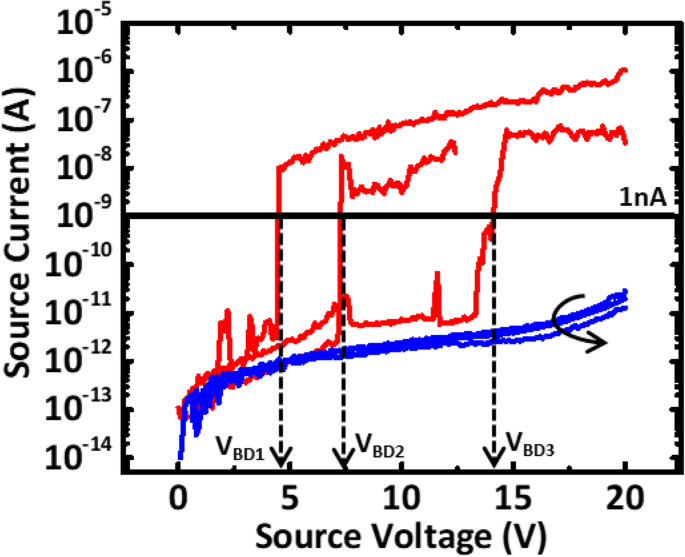
Courant de fuite mesuré sur des appareils avec des mires de test différentielles connectées à une antenne metal-3 de 82 000 μm 2 . V BD est défini comme la tension lorsque le courant atteint 1 nA pour une longueur de via de 32 nm
Dans un événement de charge, il est prévu que le côté le plus faible desservira le chemin de décharge dominant, entraînant un déséquilibre plus important dans le niveau de dommages entre la gauche et la droite. Par conséquent, seuls les appareils avec un grand V BD la différence entre les côtés gauche et droit est plus susceptible de résulter de la charge du plasma. Par conséquent, le plus petit V BD en cas de panne IMD sur une paire est enregistré comme le niveau corrélé au niveau de stress PID. La figure 4a montre trois types typiques de caractéristiques que l'on trouve sur des échantillons sur différentes matrices à travers une tranche. Ces échantillons peuvent être classés en groupes sans ventilation d'un côté ou de l'autre, ventilation d'un côté ou ventilation des deux côtés. La partie des dispositifs présentant les caractéristiques particulières de chaque groupe est représentée dans le diagramme circulaire de la figure 4b. Nous avons constaté que sur les échantillons sans antenne, le changement d'avoir des caractéristiques de claquage unilatéral est beaucoup plus faible. Des comportements symétriques des deux côtés se retrouvent dans la plupart des appareils qui n'ont pas subi de contrainte de charge plasma. Ceux-ci suggèrent en outre que la plupart des caractéristiques asymétriques dans une paire différentielle proviennent des contraintes de charge lorsque la structure de l'antenne est fixée.
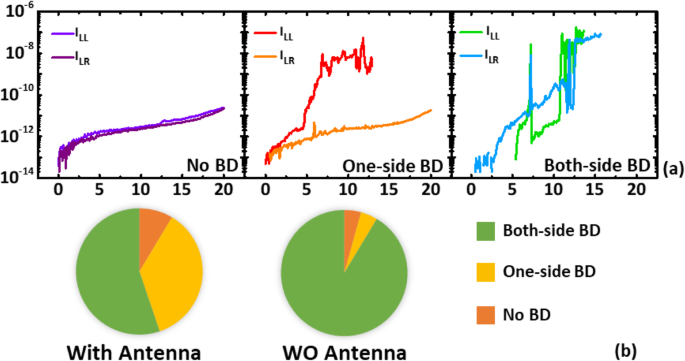
un Différents types de caractéristiques de rupture sur les paires de test à travers une plaquette et b comparer le pourcentage d'échantillons présentant des types distincts de caractéristiques de panne sur des paires d'appareils de plus de 60 matrices
Utilisation du V BD obtenus par la méthode ci-dessus, les cartes de plaquettes du niveau PID et V BD des modèles de dispositifs de type I et II sont comparés sur la Fig. 5. Grande similitude entre les cartes de plaquettes du V BD des deux types de dispositifs de surveillance et les niveaux de charge de référence correspondants sont obtenus à partir de l'enregistreur PID, voir Fig. 5a. On pense que la tension PID enregistre à la fois les événements de charge d'électrons et d'ions pendant les processus métalliques [14]. Cependant, les échantillons à travers une plaquette se révèlent être principalement soumis à plus de charges d'électrons que de charges d'ions [14]. Nous pensons qu'une certaine corrélation régionale peut être observée entre la plaquette de la Fig. 5a, b. Alors que la carte de la plaquette de la figure 5c du modèle II, qui n'a aucune similitude évidente avec celle de la figure 5a, suggère qu'une contrainte bidirectionnelle [15] pourrait entraîner un effet secondaire sur les couches diélectriques, ce qui nécessite une étude plus approfondie. Les tensions de claquage mesurées à partir des nouveaux modèles de test par rapport aux niveaux PID de référence comparés à la figure 6 révèlent en outre que plus le niveau PID d'un dé est élevé, plus son V est bas. BD les nouvelles mires de test. De plus, des corrélations négatives significatives entre V BD et les niveaux de charge plasmatique peuvent être établis. Pour étudier l'effet des contraintes unidirectionnelles et bidirectionnelles sur les dommages IMD, V BD mesuré à partir de modèles conçus avec des modèles de type I et de type II est résumé et comparé à la figure 7. Le V BD La distribution obtenue à partir de dispositifs sur 60 matrices sur des plaquettes indique que les dispositifs soumis à des contraintes de charge bidirectionnelles sont plus susceptibles de présenter une panne IMD à une tension inférieure. Cela pourrait s'expliquer par le niveau de contrainte asymétrique lorsque la polarité change à travers un IMD [16]. De plus, le courant de fuite induit par contrainte (SILC) mesuré avec 10 V à travers la couche diélectrique est un autre indicateur de l'augmentation des états de piège [17] dans le film IMD. Pour minimiser davantage l'effet de variation de matrice à matrice causé par la variation de processus, le rapport de fuite de chaque paire est utilisé comme indice pour évaluer davantage les dommages IMD. La figure 8 a montré qu'il n'y a essentiellement aucune corrélation entre le rapport de courant de fuite sur les deux types de dispositifs sur la même puce. C'est-à-dire que le désalignement entre les couches de métal 1 et de via2 a des effets minimes sur les deux motifs. A noté que le rapport actuel, R , défini comme Je LR /Je LL , est un meilleur indice pour supprimer le bruit de la variation de matrice à matrice sur ces modèles. Sur les appareils totalement impartiaux, la principale contrainte de charge se produit à droite ou à gauche et devrait être complètement aléatoire. Ici, certains effets de biais sont trouvés sur les rapports de courant, où son milieu de distribution n'est pas à 1. Pour s'assurer que seuls les dommages résultant des effets de charge du plasma sont pris en compte, R est le rapport de courant normalisé, comme décrit à la Fig. 9. Dans le graphique de distribution à travers le centre de la plaquette, R N des appareils de type I suit avec le niveau de stress plasma des enregistreurs PID assez proche. D'autre part, R N provenant d'appareils sensibles au stress bidirectionnel ne peut pas être entièrement expliqué par les niveaux PID enregistrés. Cela peut être dû à un R nettement plus élevé N niveau dans les dispositifs du modèle II, à la suite d'événements de charge d'ions supplémentaires à travers la plaquette.

Les schémas et les cartes de plaquettes montrant les distributions de (a ) la tension PID et VBD de (b ) motif de test I et (c ) II, montrant l'effet régional dans la zone encerclée des dommages induits par le plasma sur la couche diélectrique arrière qui peut être attribué aux niveaux de charge du plasma régional
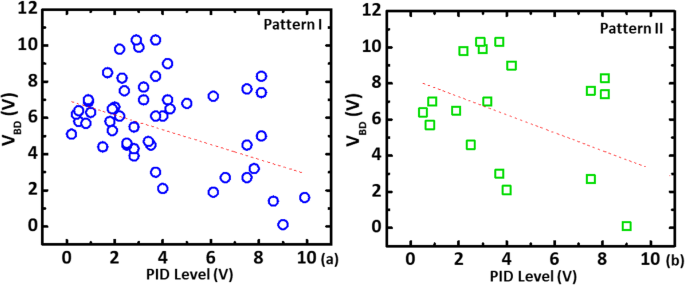
Corrélations entre les niveaux VBD et PID pour a modèle I et b échantillons du modèle II, respectivement [10,11,12]
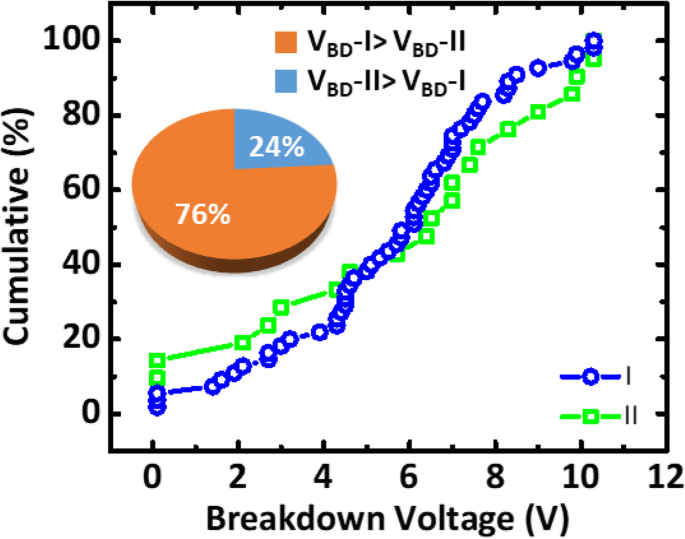
Comparaison de la distribution cumulée de V BD à partir de 60 matrices à travers la plaquette et la partie des échantillons présentant des tensions de claquage plus élevées du modèle I par rapport à celui du modèle II

Rapport de courant de fuite des côtés gauche et droit des modèles I et II montrant qu'il n'y a pas d'effet de désalignement systématique de ces échantillons
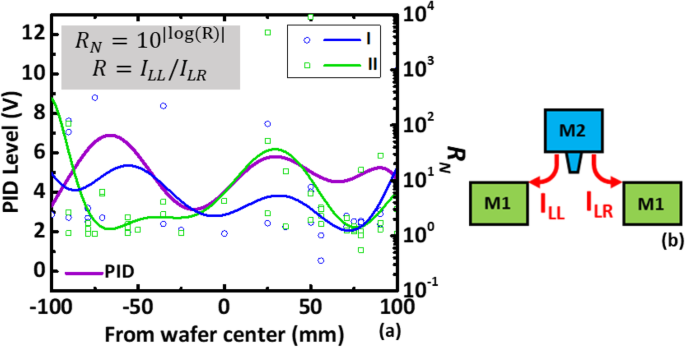
un Rapports de courant normalisés des échantillons des modèles I et II à travers le centre de la plaquette par rapport aux niveaux PID correspondants et b la définition du courant de fuite à gauche (I LL ) et à droite (Je LR )
Conclusions
L'effet de charge induit par le plasma sur l'intégrité des films IMD est étudié par le biais de modèles de test différentiels nouvellement proposés sur des plates-formes avancées FinFET Cu BEOL. Les dommages sous forme de panne précoce et d'augmentation du SILC dans les couches IMD sont directement corrélés aux niveaux de charge du plasma sur les plaquettes de 12 pouces.
Disponibilité des données et des matériaux
Non applicable.
Nanomatériaux
- Une introduction à la fabrication du métal
- 6 considérations de conception importantes pour l'impression 3D métal
- Directives de conception pour la manufacturabilité – Partie 1
- 5 conseils pour la conception de tôlerie
- 6 conseils pour optimiser votre conception pour un projet de fabrication métallique
- Qu'est-ce que l'identification des métaux ? - Tests et astuces pour l'identification
- Comment optimiser les conceptions pour les projets de fabrication de métal
- Considérations relatives à la conception de l'impédance pour les PCB flex-rigides
- Conseils de conception pour le pliage de tôle



