Stratégie d'optimisation de la structure de photodiode d'avalanche séparée par charge d'absorption séparée 4H-SiC et multiplication pour une efficacité de détection élevée des ultraviolets
Résumé
Dans ce travail, des études paramétriques sur l'optimisation structurelle sont systématiquement effectuées pour la photodiode ultraviolette à avalanche (UV APD) à base de 4H-SiC, à charge d'absorption séparée et multiplication (SACM). Selon nos résultats, la tension de claquage peut être fortement affectée par l'épaisseur de la couche de multiplication et la concentration de dopage pour la couche de contrôle de charge. L'épaisseur de la couche de contact ohmique de type n, de la couche d'absorption et de la couche de contrôle de charge peut affecter de manière remarquable la profondeur de pénétration de la lumière, ce qui influence en conséquence le nombre de paires électron-trou photo-générées, et donc l'épaisseur de couche susmentionnée a un fort impact sur la réactivité de la SACM APD. Pour améliorer la réactivité de l'APD, nous avons besoin d'une hauteur de barrière de bande d'énergie réduite à l'interface de la couche d'absorption optique et de la couche de contrôle de charge, de sorte que le transport de porteur favorisé dans la couche de multiplication puisse être favorisé. De plus, nous étudions des mesas biseautés positifs avec des angles plus petits afin de réduire le champ électrique au bord de la mesa. Ainsi, le courant d'obscurité est supprimé en conséquence.
Introduction
En tant que matériau semi-conducteur à large bande interdite, le carbure de silicium (SiC) et le nitrure d'aluminium et de gallium (AlGaN) présentent d'excellentes caractéristiques de matériau telles qu'un champ électrique critique élevé, un meilleur effet anti-rayonnement et une bonne conductivité thermique, ce qui le rend adapté aux ultraviolets (UV) détection [1,2,3]. La bande interdite réglable entre 3,4 et 6,2 eV pour les photodétecteurs à base d'AlGaN permet une longueur d'onde de réponse de coupure contrôlable allant de 365 à 200 nm. Cependant, en raison de la difficulté de cultiver des composés AlGaN riches en Al de haute qualité, le courant d'obscurité pour les photodétecteurs à base d'AlGaN est plus élevé que celui de leurs homologues à base de SiC [4]. Par conséquent, les photodétecteurs à base de SiC ont suscité un vif intérêt dans la recherche. À ce jour, les détecteurs ultraviolets à semi-conducteurs à base de 4H-SiC comprennent une diode à barrière Schottky, une photodiode métal-semiconducteur-métal (MSM), une photodiode p-i-n et une photodiode à avalanche (APD) [5,6,7,8,9]. En raison du gain d'avalanche élevé, du faible courant d'obscurité et du faible bruit, les APD ultraviolets 4H-SiC ont de grandes perspectives d'application dans de nombreux domaines de pointe qui nécessitent une détection de signal ultraviolet faible, tels que l'avertissement d'incendie, la communication quantique et la détection de missiles [ 10,11,12]. Cependant, le matériau SiC a un faible coefficient d'absorption de la lumière, donc une structure de photodiode commune avec une couche de multiplication mince est difficile à atteindre une efficacité quantique élevée. Le problème n'est pas résolu tant que la structure de charge d'absorption séparée et de multiplication (SACM) APD n'est pas proposée. D'une part, la lumière UV peut être efficacement absorbée par la couche d'absorption, et d'autre part, le gain interne élevé peut être obtenu dans la couche de multiplication à champ élevé au moyen du processus d'ionisation par impact. Le processus d'ionisation par impact dans la couche de multiplication peut être terminé par la couche de contrôle de charge [13, 14]. L'avantage pour la structure SACM provient du bruit réduit, car un seul type de porteurs photo-générés avec un taux d'ionisation plus élevé peut être injecté dans la couche de multiplication [15, 16]. Pour obtenir une détectivité élevée pour un signal ultraviolet faible, des APD SACM avec une grande zone de détection active doivent être fabriqués [17]. Cependant, l'augmentation de la taille du dispositif s'accompagne d'un courant de fuite de surface et d'un courant de fuite en vrac considérablement améliorés. Ainsi, cela impose non seulement une exigence stricte sur la qualité de la plaquette épitaxiale SiC, mais reflète également un grand défi pour le processus de fabrication du dispositif et la conception du dispositif. Au cours des dernières décennies, Cree Company a considérablement promu la technologie de croissance épitaxiale pour les films SiC, ce qui a ainsi conduit à l'amélioration continue de la qualité cristalline. Plus récemment, Zhou et al. ont proposé une technique de refusion de résine photosensible à température variable pour créer des parois latérales très lisses pour la mesa biseautée 4H-SiC APD [18], ce qui permet un gain de multiplication élevé de plus de 10 6 et un faible courant d'obscurité de ~ 0,2 nA/cm 2 . Néanmoins, les recherches précédentes se sont davantage concentrées sur l'amélioration de la qualité des matériaux et l'optimisation de la technologie de fabrication des APD SACM [19,20,21], tandis que l'impact de la conception structurelle sur le transport de porteurs photogénérés et la détectivité du photocourant a rarement été discuté jusqu'à présent. . Par conséquent, dans cette lettre, nous étudions systématiquement les performances optoélectroniques pour les APD ultraviolets SACM à base de 4H-SiC à grande surface avec différentes conceptions structurelles. Pendant ce temps, des images physiques perspicaces et des discussions sont également fournies. Nous pensons que les résultats de ce travail sont utiles aux chercheurs pour optimiser les APD 4H-SiC à moindre coût.
Comme on le sait, la multiplication des porteurs à grande échelle est générée lors de l'ionisation par impact, qui est néanmoins fortement influencée par l'épaisseur de la couche de multiplication et la concentration de dopage pour la couche de contrôle de charge. Le très fort champ électrique est produit dans la couche de multiplication pour permettre l'ionisation par impact. Le champ électrique peut être interrompu par la couche de contrôle de charge en raison de la plus grande concentration de dopage qu'elle contient. De plus, nous constatons également qu'en modulant la bande d'énergie entre la couche d'absorption et la couche de contrôle de charge, nous sommes en mesure d'ajuster la réactivité spectrale. L'adoption raisonnable d'une mesa biseautée positive peut permettre une réduction significative du champ électrique de surface de la paroi latérale, ce qui est utile pour supprimer le courant d'obscurité et le claquage des bords. Une analyse détaillée et des discussions seront menées par la suite.
Méthodes de recherche et modèles physiques
La figure 1a montre la vue en coupe schématique d'un APD 4H-SiC SACM standard utilisé dans ce travail, qui possède n + -couche de type 4H-SiC comme substrat. Ensuite, l'empilement architectural comprend un p + de 3 µm d'épaisseur -type couche (N un = 1 × 10 19 cm −3 ) servant de couche de contact ohmique de type p, un n − de 0,5 µm d'épaisseur -type couche de multiplication (N d = 1 × 10 15 cm −3 ) pour la multiplication des porteurs, une couche de contrôle de charge de type n de 0,2 µm d'épaisseur (N d = 5 × 10 18 cm −3 ) pour terminer le processus d'ionisation par impact, et un n − de 0,5 µm d'épaisseur -couche d'absorption de type (N d = 1 × 10 15 cm −3 ) pour absorber les photons entrants. Au-dessus de la structure de l'appareil, il y a un n + de 0,3 μm d'épaisseur -couche de contact de type ohmique (N d = 1 × 10 19 cm −3 ). Un angle de biseau positif (θ = 8°) est créé pour la structure mesa afin de supprimer le claquage des bords [22, 23]. Le diamètre des APD 4H-SiC SACM est de 800 μm. Les contacts de cathode et d'anode sont considérés comme des contacts ohmiques idéaux dans nos calculs. Selon les figures 1c et d, nos résultats montrent que les résultats calculés pour la structure APD 4H-SiC SACM standard susmentionnée présentent un courant d'obscurité de 2,5 nA/cm 2 , la tension de claquage de 161,6 V et la sensibilité maximale de 0,11 A/W à la longueur d'onde de 280 nm. Les caractéristiques courant-tension calculées et la sensibilité pour l'APD standard 4H-SiC SACM sont cohérentes avec les données expérimentales. Cela prouve pleinement que l'ionisation par impact, le coefficient d'absorption du matériau 4H-SiC, l'équation de Poisson, l'équation de continuité du courant et les équations de dérive-diffusion utilisées dans ce travail sont raisonnables. Ici, nous prenons la structure de la figure 1a comme référence de recherche tandis que les variables étudiées incluent l'angle mesa biseauté, l'épaisseur et la concentration de dopage pour chaque couche.
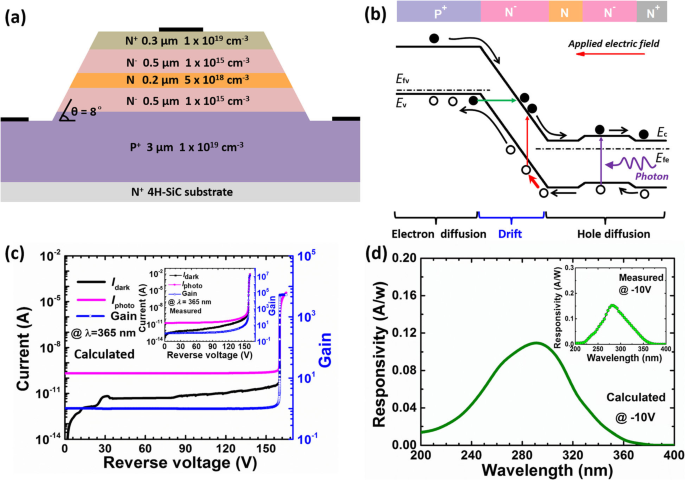
un Structure transversale schématique (non dessinée à l'échelle), b diagramme schématique des bandes d'énergie sous polarisation inverse pour l'APD SACM 4H-SiC standard, c les caractéristiques courant-tension calculées et le gain de multiplication, et d caractéristiques de réponse spectrale calculées à la tension inverse de 10 V pour l'APD 4H-SiC SACM standard. Figure incrustée dans c montre les caractéristiques courant-tension mesurées et le gain de multiplication. Figure incrustée en d montre les caractéristiques de réponse spectrale mesurées pour la norme APD 4H-SiC SACM biaisée à − 10 V
Pour mieux comprendre l'impact de différentes variables structurelles sur les propriétés photoélectriques des APD 4H-SiC SACM, la figure 1b montre le diagramme schématique des bandes d'énergie sous polarisation inverse. Les paires électron-trou photogénérées dans la couche d'absorption se diffuseront dans la couche de multiplication par l'intermédiaire de la couche de contrôle de charge. Une fois que les paires électron-trou photogénérées ont atteint la région de multiplication, elles seront séparées par le champ électrique appauvri. Les trous subiront alors un processus de multiplication dans la couche de multiplication, ce qui donne lieu à un gain de courant interne. Pendant ce temps, les électrons photo-générés retournent à la cathode et sont convertis en courant sans subir d'ionisation par impact. Les facteurs importants qui influencent le photocourant comprennent les profils de champ électrique dans la couche de multiplication, l'alignement des bandes d'énergie dans la couche de contrôle de charge, la couche d'absorption et la couche de contact ohmique de type n, dans laquelle toute barrière énergétique peut entraver le transport des porteurs. Il convient également de noter que les profils de champ électrique dans la couche de multiplication peuvent être déterminés par les concentrations de dopage à la fois pour la couche de multiplication et la couche de contrôle de charge. Pendant ce temps, l'angle mesa biseauté est également sensiblement associé à la distribution du champ électrique. Nous ferons également attention à l'épaisseur de chaque couche pour assurer le processus de diffusion des porteurs à haute efficacité. Par conséquent, il est important d'étudier systématiquement ces paramètres structurels clés pour optimiser les performances de l'appareil.
Les investigations numériques sont menées par APSYS, qui peut résoudre les équations de continuité actuelles, les équations de Poisson et les équations de dérive-diffusion de manière cohérente avec des conditions aux limites appropriées. Les processus d'ionisation par impact et de tunnel Zener ont été inclus dans les équations de dérive-diffusion. La diffusion porteuse à porteuse pour le processus de transport de porteuse a également été incluse dans le modèle de mobilité à faible champ. La durée de vie de la recombinaison Shockley-Read-Hall (SRH) est supposée égale à 1 µs [24]. Plus précisément, le champ (E ) dépendance des coefficients d'ionisation par impact pour les électrons (α n ) et des trous (β p ) pour les couches à base de 4H-SiC peut être exprimé par les formules de Chynoweth (1) et (2) comme suit, respectivement [25] :
$$ {\alpha}_n=1.98\times {10}^6\exp \left[-{\left(\frac{9.46\times {10}^6}{E}\right)}^{1.42}\ right]{\mathrm{cm}}^{-1} $$ (1) $$ {\beta}_p=4.38\times {10}^6\exp \left[-{\left(\frac{1.14\ fois {10}^7}{E}\right)}^{1.06}\right]{\mathrm{cm}}^{-1} $$ (2)Le coefficient d'absorption (∂) en termes de différentes longueurs d'onde (λ) pour le matériau 4H-SiC est calculé par l'équation suivante. (3) [26] :
$$ \partial =-790.3+18.2\uplambda -0.17{\uplambda}^2+8.57\times {10}^{-4}{\uplambda}^3-2.39\times {10}^{-6}{ \uplambda}^4+3,53\times {10}^{-9}{\uplambda}^5-2,16\times {10}^{-12}{\uplambda}^6 $$ (3)Les autres paramètres matériaux utilisés dans les modèles numériques se trouvent ailleurs [27]. Les calculs sont basés sur la méthode des éléments finis, qui oblige les utilisateurs à ajuster correctement les distributions de maillage pour effectuer des calculs précis.
Résultats et discussions
Impact des paramètres structurels de la couche de contact ohmique de type n sur les performances photoélectriques
Afin de sonder l'effet de l'épaisseur et de la concentration de dopage pour la couche de contact ohmique de type n sur les performances photoélectriques, nous concevons un dispositif de référence, les dispositifs L1 à L4 et les dispositifs A1 à A4, respectivement. Notez que le dispositif de référence est la structure de base de l'APD SACM telle qu'elle est illustrée sur la figure 1a. Les autres APD proposés sont identiques au dispositif de référence, à l'exception de la couche de contact ohmique SiC de type n, dont les informations structurelles détaillées sont présentées dans le tableau 1.
Nous montrons tout d'abord la tension de claquage en termes d'épaisseur pour la couche de contact ohmique SiC de type n sur la figure 2a, c'est-à-dire les dispositifs L1 à L4. L'encart de la figure 2a montre sélectivement le courant d'obscurité, le courant photoélectrique sous l'éclairage de 365 nm et le gain pour le dispositif L1. Pour l'appareil L1, la tension de claquage est de ~ 161,6 V et la densité de courant d'obscurité reste au niveau de ~ 2,5 nA/cm 2 lorsque la polarisation est inférieure à 161,6 V. Notez que la tension de claquage est obtenue au courant de 10 −5 A. Le courant d'obscurité augmente lorsque le processus d'ionisation par impact se produit. Le niveau de photocourant devient élevé dans la région linéaire lorsque l'éclairage à 365 nm éclaire l'appareil, ce qui montre que le gain de multiplication peut être supérieur à 10 3 pour le dispositif L1 à la tension inverse de 161,6 V. La tension de claquage par avalanche pour les cinq APD étudiées est résumée sur la figure 2a. À partir de la figure 2a, nous pouvons obtenir que l'épaisseur de la couche de contact ohmique de type n a un effet négligeable sur la tension de claquage. Pour révéler le mécanisme sous-jacent des observations, nous calculons et montrons la distribution verticale du champ électrique pour le dispositif de référence et les dispositifs L1 à L4 sur la Fig. 2b, qui illustre que la couche de contrôle de charge confine la limite de la région d'appauvrissement et du champ électrique dans la couche de multiplication. Par conséquent, nous pouvons supposer que la couche de contact ohmique de type n n'affectera pas les profils de champ électrique dans la couche de multiplication et cela est prouvé sur la figure 2b. Les observations de la figure 2b interprètent bien la tension de claquage identique de la figure 2a pour le dispositif de référence et les dispositifs L1 à L4. Ensuite, nous montrons le courant photo-généré pour les cinq appareils de la figure 2c. Pour une meilleure résolution, nous collectons le courant photo-généré à la polarisation de 100 V qui est montré dans l'encart pour la figure 2c. Nous pouvons voir que le courant photo-généré diminue avec l'augmentation de l'épaisseur pour la couche de contact ohmique de type n. Une couche de contact ohmique de type n trop épaisse entraînera une recombinaison non radiative des porteurs photo-générés et réduira en conséquence le courant de diffusion. Avec le courant photo-généré, nous pouvons obtenir la sensibilité spectrale du dispositif de référence et des dispositifs L1 à L4 à la tension inverse de 100 V sur la figure 2d. La longueur d'onde de réponse de crête pour les cinq dispositifs étudiés est centrée à 280 nm. La réactivité diminue avec l'augmentation de l'épaisseur de la couche de contact de type n, ce qui correspond à l'encart de la figure 2c. Par conséquent, nous résumons ici que l'épaisseur de la couche de contact ohmique 4H-SiC de type n doit être correctement mince pour éviter l'augmentation de la recombinaison non radiative et le courant de diffusion réduit.

un Tension de claquage, b distribution verticale du champ électrique des APD SACM polarisés à − 160 V, c caractéristiques photocourant-tension sous un éclairage de 280 nm, et d caractéristiques de réponse spectrale des APD SACM polarisées à - 100 V pour le dispositif de référence et les dispositifs L1 à L4 avec différentes épaisseurs de couche de contact ohmique de type n, respectivement. Figure incrustée dans a montre les caractéristiques courant-tension calculées et le gain de multiplication pour le dispositif L1. Figure incrustée dans c montre le photocourant pour l'appareil de référence et les appareils L1 à L4 polarisés à − 100 V
Ensuite, nous étudions la tension de claquage en fonction de la concentration de dopage dans la couche de contact ohmique de type n en analysant le dispositif de référence et les dispositifs A1 à A4 de la figure 3a. L'encart de la Fig. 3a présente le courant d'obscurité, le courant photo-généré et le gain en termes de polarisation appliquée pour le dispositif A1. La tension de claquage est définie lorsque le courant atteint 10 −5 A. Selon la figure 3a, la tension de claquage ne dépend guère de la concentration de dopage dans la couche de contact ohmique 4H-SiC de type n. Comme cela a été démontré précédemment, la couche de contrôle de charge peut effectivement confiner la région d'appauvrissement et le champ électrique dans la couche de multiplication. Par conséquent, la variation de la concentration de dopage dans la couche de contact ohmique de type n n'affecte pas la distribution du champ électrique à l'intérieur du dispositif [voir Fig. 3b]. Nous calculons et montrons ensuite le courant photo-généré en termes de polarisation appliquée pour le dispositif de référence et les dispositifs A1 à A4 sur la figure 3c. On peut voir sur la figure 3c que la concentration de dopage de la couche de contact ohmique de type n a un effet négligeable sur le photocourant polarisé. La sensibilité spectrale à différentes longueurs d'onde pour les cinq dispositifs étudiés est illustrée à la figure 3d. Les données sont calculées à la tension inverse de 100 V. La longueur d'onde avec une réactivité maximale de ~ 0,11 A/W est de 280 nm. Conformément à la figure 3c, la réactivité dépend moins de la concentration de dopage dans la couche de contact ohmique de type n. Par conséquent, nous concluons que la réactivité est plus influencée par l'épaisseur que la concentration de dopage pour la couche de contact ohmique de type n pour les APD 4H-SiC SACM. Nous suggérons également d'augmenter la longueur de diffusion du porteur dans le but d'améliorer la réactivité.

un Tension de claquage, b distribution verticale du champ électrique des APD SACM polarisés à − 160 V, c caractéristiques photocourant-tension sous un éclairage de 280 nm, et d caractéristiques de réponse spectrale des APD SACM polarisées à - 100 V pour le dispositif de référence et les dispositifs A1 à A4 avec une concentration de dopage différente de la couche de contact ohmique de type n, respectivement. Figure incrustée dans a montre les caractéristiques courant-tension calculées et le gain de multiplication pour le dispositif A1. Figure incrustée dans c montre le photocourant pour l'appareil de référence et les appareils A1 à A4 polarisés à − 100 V
Impact des paramètres structurels de la couche d'absorption sur les performances photoélectriques
Dans cette section, l'impact de l'épaisseur et de la concentration de dopage de la couche d'absorption sur les performances photoélectriques des APD SACM à base de 4H-SiC est étudié. Les informations structurelles détaillées de la couche d'absorption pour les SACM APD sont résumées et présentées dans le tableau 2. Les dispositifs M1 à M4 et les dispositifs B1 à B4 sont structurellement identiques au dispositif de référence, à l'exception de la couche d'absorption. Les dispositifs M1 à M4 ont des épaisseurs différentes tandis que les dispositifs B1 à B4 possèdent différentes concentrations de dopage pour la couche d'absorption.
En utilisant le dispositif de référence et les dispositifs M1 à M4, la figure 4a montre la tension de claquage en termes de différentes épaisseurs pour la couche d'absorption. À des fins de démonstration, nous calculons et présentons le courant d'obscurité, le courant photo-généré et le gain en fonction de la polarisation appliquée pour le dispositif M1 dans l'encart de la figure 4a. La tension de claquage est collectée lorsque le courant est de 10 −5 A. Nous pouvons voir que la tension de claquage dépend à peine de l'épaisseur de la couche d'absorption. Il est connu que la tension de claquage est fortement soumise à l'intensité du champ électrique dans la couche de multiplication légèrement dopée, et par conséquent, la figure 4b montre la distribution verticale du champ électrique pour les cinq dispositifs étudiés à la polarisation inverse de - 160 V. les distributions de champ pour l'appareil de référence et les appareils M1 à M4 sont exactement les mêmes, ce qui confirme la conclusion de la Fig. 4a. Nous démontrons ensuite le courant photo-généré et la réactivité dans les Figs. 4c et d, respectivement. Le courant photo-généré [voir l'encadré pour la figure 4c] et la sensibilité montrent la tendance à la diminution avec l'augmentation de l'épaisseur de la couche d'absorption. Pour mieux traiter le mécanisme sous-jacent, nous calculons et montrons également la distribution des porteurs au sein de la couche de multiplication de la figure 4e lorsque la polarisation inverse est de 100 V pour les cinq dispositifs étudiés. Nous pouvons voir que les niveaux de concentration d'électrons et de trous diminuent avec l'augmentation de l'épaisseur de la couche d'absorption, ce qui est attribué à la recombinaison non radiative améliorée lorsque la couche d'absorption devient épaisse. La recombinaison non radiative consomme des porteurs, supprimant ainsi le courant de diffusion et la réactivité. Ici, afin d'éviter la consommation de porteurs par recombinaison non radiative, nous suggérons que la couche d'absorption ne peut pas être trop épaisse pour obtenir des APD 4H-SiC SACM à haute détectivité.

un Tension de claquage, b distribution verticale du champ électrique des APD SACM polarisés à − 160 V, c caractéristiques photocourant-tension sous un éclairage de 280 nm, d caractéristiques de réponse spectrale, et e profils de concentration en porteurs dans la couche de multiplication des APD SACM polarisés à - 100 V pour le dispositif de référence et les dispositifs M1 à M4 avec différentes épaisseurs de couche d'absorption, respectivement. Figure incrustée dans a montre les caractéristiques courant-tension calculées et le gain de multiplication pour le dispositif M1. Figure incrustée dans c montre le photocourant pour l'appareil de référence et les appareils M1 à M4 polarisés à − 100 V
Outre l'épaisseur de la couche d'absorption, la concentration de dopage pour la couche d'absorption a également un impact significatif sur les performances du dispositif. Nous calculons et montrons ensuite la tension de claquage pour l'appareil de référence et les appareils B1 à B4 sur la Fig. 5a. La tension de claquage est définie lorsque le courant est de 10 −5 A comme indiqué dans l'encart de la Fig 5a. On peut voir sur la figure 5a que la concentration de dopage pour la couche d'absorption n'a pas d'effet significatif sur la tension de claquage. Cela peut être prouvé en outre par les distributions verticales de champ électrique unidimensionnel sur la figure 5b, de sorte que la concentration de dopage pour la couche d'absorption ne modifie pas de manière significative les profils de champ électrique dans la couche de multiplication. Nous présentons également le courant photo-généré à la longueur d'onde de 280 nm pour les dispositifs étudiés sur la Fig. 5c, qui indique l'amélioration du courant photo-généré lorsque la concentration de dopage dans la couche d'absorption augmente. En accord avec la figure 5c, la réactivité dépendante de la longueur d'onde sur la figure 5d est également favorisée lorsque la concentration de dopage pour la couche d'absorption augmente, par exemple, dispositif B4.

un Tension de claquage, b distribution verticale du champ électrique des APD SACM polarisés à − 160 V, c caractéristiques photocourant-tension sous un éclairage de 280 nm, et d caractéristiques de réponse spectrale des APD SACM polarisées à - 100 V pour le dispositif de référence et les dispositifs B1 à B4 avec une concentration de dopage différente de la couche d'absorption, respectivement. Figure incrustée dans a montre les caractéristiques courant-tension calculées et le gain de multiplication pour le dispositif B1. Figure incrustée dans c montre le photocourant pour l'appareil de référence et les appareils B1 à B4 polarisés à − 100 V
Afin de montrer l'origine en profondeur de la réactivité améliorée pour le dispositif B4, nous montrons les profils de bande d'énergie pour la couche de contrôle de charge, la couche d'absorption et la couche de contact ohmique de type n pour les dispositifs B1 et B4 sur les Figs. 6a et b, respectivement. Ici, il convient de mentionner que les concentrations de dopage pour la couche de contrôle de charge et la couche de contact ohmique de type n sont de 5 × 10 18 cm −3 et 1 × 10 19 cm −3 , respectivement. Par conséquent, la concentration de dopage plus faible pour la couche d'absorption peut générer un champ électrique intégré et créer les barrières énergétiques aux interfaces couche de contrôle de charge/couche d'absorption/couche de contact ohmique de type n [28]. Les barrières énergétiques peuvent retarder la diffusion des porteurs photo-générés dans la couche de multiplication. Une méthode très pratique qui peut réduire les barrières consiste à augmenter la concentration de dopage dans la couche d'absorption. En conséquence, les valeurs de barrière de bande de valence effective ψ v pour la couche de contrôle de charge sont 513 meV et 480 meV pour les dispositifs B1 et B4, respectivement. On constate que l'augmentation de la concentration de dopage pour la couche d'absorption favorise le transport des trous photo-générés [voir Fig. 6c]. L'ionisation d'impact deviendra forte une fois que de nouveaux trous photogénérés pourront être injectés dans la région de multiplication, ce qui entraînera une augmentation du courant photogénéré et de la réactivité.
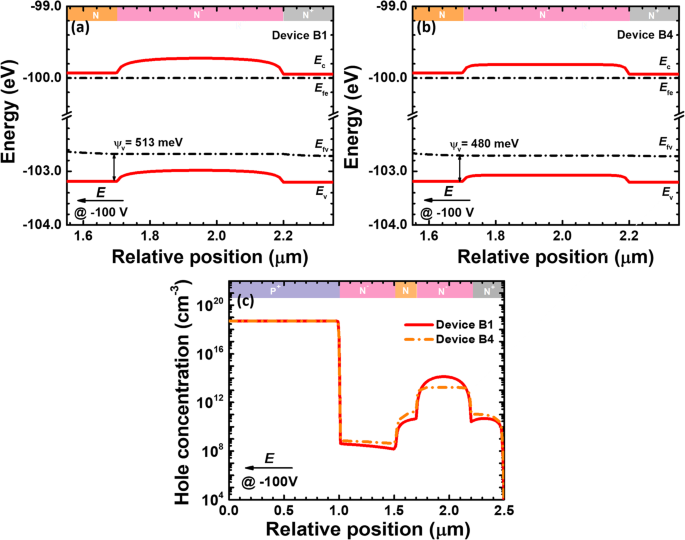
Diagrammes de bandes d'énergie de la couche de contrôle de charge, de la couche d'absorption et de la couche de contact ohmique de type n pour a appareil B1 et b appareil B4, c profils de concentration de trous sous un éclairage de 280 nm pour les appareils B1 et B4. Les données sont calculées à la tension inverse de 100 V
Impact des paramètres structurels de la couche de contrôle de charge sur les performances photoélectriques
Pour sonder l'impact de l'épaisseur et de la concentration de dopage de la couche de contrôle de charge sur les performances photoélectriques, nous avons défini différentes informations architecturales pour la couche de contrôle de charge, comme indiqué dans le tableau 3. Les dispositifs N1 à N4 et les dispositifs C1 à C4 sont différents du dispositif de référence uniquement. dans la couche de contrôle de charge. Différentes concentrations de dopage et épaisseurs de couche sont adoptées pour les dispositifs N1 à N4 et C1 à C4.
Comme cela a été mentionné précédemment, le champ électrique qui permet l'ionisation par impact et le claquage par avalanche est principalement confiné dans la couche de multiplication. La tension de claquage en fonction de l'épaisseur de la couche de contrôle de charge sur la figure 7a induit que l'épaisseur de la couche de contrôle de charge a un très faible effet sur le processus de multiplication des porteurs. Ceci est encore prouvé en montrant la figure 7b. La figure 7c montre le courant photo-généré en termes de polarisation appliquée pour le dispositif de référence et les dispositifs N1 à N4. Le courant photo-généré devient faible une fois que l'épaisseur de la couche de contrôle de charge a augmenté, ce qui traduit également la moindre réactivité avec l'augmentation de l'épaisseur de la couche de contrôle de charge. Nous attribuons également à la recombinaison non radiative améliorée qui consomme des porteurs et supprime le courant de diffusion.

un Tension de claquage, b distribution verticale du champ électrique des APD SACM polarisés à − 160 V, c caractéristiques photocourant-tension sous un éclairage de 280 nm, et d caractéristiques de réponse spectrale des APD SACM polarisées à - 100 V pour le dispositif de référence et les dispositifs N1 à N4 avec différentes épaisseurs de couche de contrôle de charge, respectivement. Figure incrustée dans a montre les caractéristiques courant-tension calculées et le gain de multiplication pour le dispositif N1. Figure incrustée dans c montre le photocourant pour l'appareil de référence et les appareils N1 à N4 polarisés à − 100 V
Le rôle de la couche de contrôle de charge est de confiner le champ électrique fort et le processus de multiplication des porteurs au sein de la couche de multiplication. Cependant, la largeur de la région d'appauvrissement peut être encore étendue tant que la concentration de dopage dans la couche de contrôle de charge diminue. Les profils de champ électrique peuvent alors affecter sensiblement la tension de claquage, le courant photo-généré, le gain et la réactivité. Par conséquent, nous concevons les dispositifs C1 à C4 dans le tableau 3. Selon la figure 8a, à mesure que la concentration de dopage diminue, la tension de claquage reste initialement la même, puis la tension de claquage augmente lorsque la concentration de dopage pour la couche de contrôle de charge est inférieure à 2 × 10 18 cm −3 . L'encart de la Fig. 8a indique que la tension de claquage est de ~ 315 V pour le dispositif C1 tandis que le courant d'obscurité s'élève également à 3,5 × 10 −11 A par rapport à celui de l'appareil N1. Pour révéler l'origine des observations de la figure 8a, nous calculons la distribution verticale du champ électrique sur la figure 8b, ce qui démontre que le champ électrique est principalement concentré dans la couche de multiplication pour les dispositifs de référence et les dispositifs C3 et C4. Cependant, le champ électrique et la région d'appauvrissement pénètrent dans la couche de contrôle de charge lorsque la concentration de dopage pour la couche de contrôle de charge est inférieure à 2 × 10 18 cm −3 . L'extension de la zone d'appauvrissement pour les dispositifs C1 et C2 contribue à réduire l'intensité du champ électrique et ainsi la tension de claquage est augmentée en conséquence pour les dispositifs C1 et C2. La largeur accrue de la région d'appauvrissement produira plus de courant de génération de charge d'espace, ce qui se traduit donc par un courant d'obscurité accru, c'est-à-dire 3,5 × 10 − 11 A et 5 × 10 − 11 A pour les appareils C1 et C2, respectivement. Nous montrons ensuite le courant photo-généré à la longueur d'onde de 280 nm sur la figure 8c. The 100V-biased spectral responsivity curves at different wavelengths for the five investigated devices are illustrated in Fig. 8d. Excellent agreement is obtained between Figs. 8c and d, such that the increased photo-generated current gives rise to the enhanced responsivity, i.e., devices C1 and C2. Other devices show similar photo-current level and the responsivity.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices C1 to C4 with different doping concentration of charge control layer, respectively. Inset figure in a shows the calculated current-voltage characteristics and the multiplication gain for device C1. Inset figure in c shows photocurrent-voltage characteristics for reference device and devices C1 to C4
As has been interpreted previously, the energy band barrier height at the interface of multiplication layer/charge control layer can soundly affect the carrier diffusion. Due to the expansion of the depletion region for devices C1 and C2, the electric field in the depletion region will annihilate the energy barrier at the interface of multiplication layer/charge control layer [e.g., the inset for device C1 in Fig. 9a]. Meanwhile, we observe the valence band barrier at the interface of multiplication layer/charge control layer for device C4 according to the inset for Fig. 9b. The energy barrier will correspondingly retard the hole diffusion into the multiplication layer from the charge control layer. We also selectively compute and show the hole concentration profiles for device C1 and C4 in Fig. 9c. Because the interface of multiplication layer/charge control layer for device C1 no longer hinders the injection of photo-generated holes into the multiplication layer, more holes are limited in the charge control layer and the absorption layer for device C4. As a result, the hole concentration in the multiplication layer for device C1 is higher than that for device C4. Thus, the enhanced photo-generated current and the responsivity for device C1 are obtained when compared with device C4.
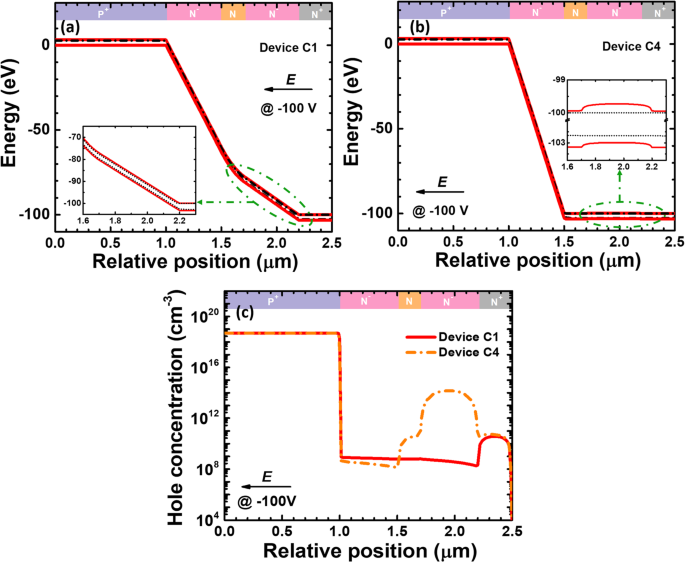
Energy band diagrams for a device C1 and b device C4, c hole concentration profiles for device C1 and C4. Data are calculated at the reverse voltage of 100 V. Insets for a et b show the local energy band diagrams for multiplication layer/charge control layer for devices C1 and C4, respectively
Impact of the Structural Parameters for the Multiplication Layer on the Photoelectric Performance
The impact ionization and the carrier multiplication process take place in the multiplication layer, making the design for the multiplication layer essentially vital for 4H-SiC SACM APDs. Therefore, we look into the impact of the thickness and doping concentration for the multiplication layer on the photoelectric performance for SACM APDs. The detailed structural information of the multiplication layer for different SACM APDs are summarized and presented in Table 4. The only difference for the devices in Table 4 lies on the multiplication layer.
As Fig. 10a presents, the breakdown voltage is enhanced from 110 to 210 V when the multiplication layer thickness is increased from 0.3 to 0.7 μm. For the purpose of demonstration, the inset of Fig. 10a demonstrates the current in terms of the voltage for reference device and devices P1 to P4. This indicates that a thick multiplication layer helps to reduce the electric field intensity [see Fig. 10b] and increase the breakdown voltage. We then show the photo-generated current for the five devices in Fig. 10c. The photo-generated current increases slightly with increasing the thickness of the multiplication layer for devices P2 to P4, except that device P1 has the highest photocurrent. The spectral responsivity characteristics for the five investigated devices at the reverse voltage of 100 V are provided in Fig. 10d. The peak responsivity for reference device and devices P2 to P4 improves slightly as the thickness of the multiplication layer increases, and this is because the number of carriers generated by impact ionization increases when the depletion region width increases. Note that device P1 with the thinnest multiplication layer owns the highest peak responsivity at the wavelength of 280 nm. This is because the − 100 V applied voltage is close to Geiger mode for device P1, and the avalanche gain is more likely to occur than that for other devices.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices P1 to P4 with different thicknesses of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices P1 to P4. Inset figure in c shows photocurrent-voltage characteristics under 280 nm illumination for reference device and devices P1 to P4
Then, we show the breakdown voltage in terms of the multiplication layer doping concentration for reference device and devices D1 to D4 in Fig. 11a. It seems that when the doping concentration for the multiplication layer is lower than 10 16 cm −3 , the breakdown voltage is less affected. We believe the breakdown voltage can be significantly decreased if the doping concentration in the multiplication layer exceeds 10 18 cm −3 . The dark current as a function of the applied bias for the five APDs are shown in the inset of Fig. 11a. The dark current increases with increasing doping concentration of the multiplication layer due to the enhanced space charge generation in the depletion region. Therefore, for the purpose of significantly decreasing the dark current and promoting the carrier multiplication process, we rarely have the multiplication layer heavily doped. Then, we calculate the vertical one-dimensional electric field profiles for the five studied devices, which are demonstrated in Fig. 11b. We can see that the electric field profiles of the five devices are mainly confined in the multiplication layer. In addition, Figs. 11c and d demonstrate the photo-generated current and the wavelength-dependent responsivity for the five devices. We can see that the photo-generated current for reference device and devices D1 and D2 are almost the same under the 280 nm illumination, while that the photon-generated current for the devices D3 and D4 is slightly increased. Therefore, the responsivity at the wavelength of 280 nm in Fig. 11d for devices D3 and D4 is slightly higher than the others.

un Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent-voltage characteristics under 280 nm illumination, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices D1 to D4 with different doping concentration of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices D1 to D4. Inset figure in c shows photocurrent for reference device and devices D1 to D4 biased at − 100 V
Impact of the Beveled Mesa Angle on the Photoelectric Performance
In order to eliminate premature breakdown and suppress leakage current that are caused by the junction termination, positive beveled mesas with a small inclination angle are usually adopted when fabricating 4H-SiC APDs [13,14,15,16, 18]. However, the angles of the positive beveled mesa adopted in previous reports are various. Thus, to get systematic insight into the influence of different mesa inclination angles on the electric field profiles for 4H-SiC SACM APDs, we design the devices that are shown in Table 5.
We firstly calculate and show the dark current-voltage characteristics for the six investigated devices with the various bevel angles in Fig. 12a. We can see that the dark current increases as the positive beveled angle becomes large [see Fig. 12a]. The breakdown voltages for the investigated devices are ~ 161.6 V except that device E5 is slightly less than 161.6 V. The premature breakdown is observed as the beveled mesa angle increase in the dark condition. Meanwhile, we calculate and show photo-generated current in terms of the applied bias for reference device and devices E1 to E5 in Fig. 12b. We also see that the photo-generated current also increases as the positive bevel increases according to the inset for Fig. 12b. The premature breakdown is also observed as the beveled mesa angle increase in Fig. 12b. Therefore, the responsivity of solar-blind waveband at − 100 V slightly enhances as the positive bevel angle increases according to Fig. 12c.
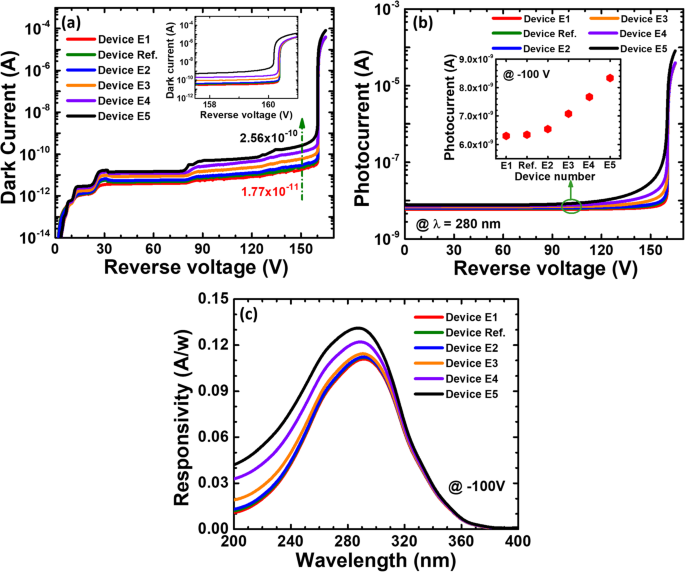
un Numerically calculated dark current-voltage characteristics, b photocurrent-voltage characteristics under 280 nm illumination, and c spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices E1 to E5, respectively
To reveal the origin for the observations in Figs. 12a and b, we calculate the lateral electric field distribution in the multiplication layer at the reverse bias of − 100 V in Fig. 13a, which demonstrates that, when the beveled mesas are utilized, the electric field decreases from the mesa center to the mesa edge. Moreover, the edge electric field intensity drops as the angle further decreases for the investigated devices. As has been mentioned, the junction termination will cause a large number of surface imperfections, which may cause the premature breakdown and the strongly leakage current, and the adopting of the beveled mesa shifts the premature breakdown from the mesa surface to the bulk [29]. Moreover, to get a full picture for the electric field profiles, the two-dimensional electric field distributions at the reverse bias of − 100 V for reference device and devices E1 to E5 are presented in Figs. 13b-g. We can see that the area of the high electric field in the entire multiplication layer gets narrowed, and this simultaneously causes the carriers that regenerated by impact ionization to decrease. As can be seen from Table 6, as the beveled mesa angle decreases, the surface electric field at the relative position of 700 μm decreases from 2.03 × 10 6 V/cm to 2.90 × 10 5 V/cm. As a result, the surface leakage and bulk leakage can be further suppressed as the beveled mesa angle get further decreased as shown in Fig. 12a. Although a small beveled mesa angle is preferred, this sacrifices the active detection area for APDs, and therefore, the responsivity is the lowest for device E1 according to Fig. 12c. Thus, one shall properly optimize beveled mesa angles depending on the crystalline quality for the 4H-SiC epitaxial layers and the surface conditions after junction termination. The suggested beveled angle in this works is in the range of 10–20°.
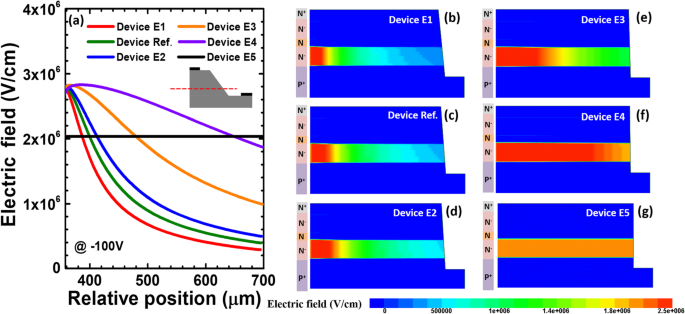
un Lateral electric field distribution of the multiplication layer at − 100 V, and numerically calculated two-dimensional electric field distribution at − 100 V for b device E1, c reference device, d device E2, e device E3, f device E4 and g device E5
Conclusions
To summarize, we have numerically investigated and demonstrated the impact of the thickness and doping concentration of each layer on photoelectric performance for 4H-SiC SACM APDs. The obtained conclusions are as follows:(1) for n-type ohmic contact layer with a properly high doping concentration (N d ≈ 1 × 10 19 cm −3 ) to enable ohmic contact, the thickness and doping concentration hardly affect the breakdown voltage. Nevertheless, the responsivity decreases as the thickness of the n-type ohmic contact layer increases. The thickness shall be controlled to about 0.2 μm; (2) the doping concentration for the absorption layer is vitally important, which can modulate the photo-generated carrier transport and affect the responsivity. The doping concentration is generally controlled at the intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (3) the doping concentration for the charge control layer regulates the electric field distribution and affects the depletion region width for 4H-SiC SACM APDs. The depletion region width increases as the doping concentration of the charge control layer decreases. According to our results, when the doping concentration is about 1 × 10 18 cm −3 , the depletion region can be completely terminated by the charge control layer; (4) the breakdown voltage can be strongly affected by the thickness of multiplication layer which is the main support region of the electric field. The dark current is sensitive to the doping concentration of multiplication layer, and a low doping concentration for the multiplication layer is required, since the doping concentration therein influences the space charge generation current. Thus, the suggested doping concentration in this works is intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (5) we also point out the advantage of beveled mesa for 4H-SiC SACM APDs, and the optimized beveled mesa angles shall be a compromise among the active detection area, the surface conditions for the mesa, and the crystalline quality for 4H-SiC epitaxial films. This work indicates that the optimum beveled mesa angle is in the range of 10–20°. We strongly believe that this work provides the physical insight for the device physics and hence the findings in this work are very important for 4H-SiC-based SACM APDs.
Disponibilité des données et des matériaux
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Abréviations
- AlGaN:
-
Aluminum gallium nitride
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- MSM:
-
Metal-semiconductor-metal
- SACM:
-
Separated absorption charge and multiplication
- SiC:
-
Silicon carbide
- SRH:
-
Shockley-Read-Hall
- UV APD:
-
Avalanche ultraviolet photodiode
Nanomatériaux
- Réparer une stratégie de maintenance défaillante :optimisation PM et AMDEC
- Démonstration d'un biocapteur flexible à base de graphène pour la détection sensible et rapide des cellules cancéreuses de l'ovaire
- Technologies avancées de dépôt de couche atomique pour les micro-LED et les VCSEL
- Ingénierie des procédés de revêtement par immersion et optimisation des performances pour les appareils électrochromes à trois états
- Métasurfaces diélectriques d'ordre élevé pour séparateurs de faisceaux de polarisation à haute efficacité et générateurs de vortex optiques
- Amélioration de la modulation et de l'absorption de fréquence du microbolomètre THz avec structure en micropont par antennes de type spirale
- Diodes émettant de la lumière ultraviolette à base d'AlGaN presque efficace et sans chute avec une couche de blocage d'électrons de type p à super-réseau spécialement conçue pour une efficacit…
- Matériaux et conception de PCB pour haute tension
- VMC Machinery pour la production et l'efficacité



