Amélioration de la propagation du courant en modulant localement le type de dopage dans la couche n-AlGaN pour les diodes électroluminescentes ultraviolettes profondes à base d'AlGaN
Résumé
Dans ce rapport, nous modulons localement le type de dopage dans le n -Couche d'AlGaN en proposant une couche d'étalement de courant structurée n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN) pour des diodes électroluminescentes ultraviolettes profondes (DUV LED) à base d'AlGaN. Après avoir inséré une fine couche de p-AlGaN dans la couche de fournisseur d'électrons n-AlGaN, une barrière de bande de conduction peut être générée dans le n -Couche fournisseur d'électrons de type, qui permet la modulation de la distribution latérale du courant dans la couche fournisseur de trous de type p pour LED DUV. De plus, selon nos études, la concentration de dopage en Mg, l'épaisseur, la composition en AlN pour la couche d'insertion p-AlGaN et le nombre de jonctions NPN-AlGaN ont une grande influence sur l'effet d'étalement du courant. Une couche d'étalement de courant NPN-AlGaN correctement conçue peut améliorer la puissance de sortie optique, l'efficacité quantique externe (EQE) et l'efficacité de la prise murale (WPE) pour les LED DUV.
Introduction
En raison de diverses applications telles que la désinfection, la purification de l'eau, le traitement médical et l'enregistrement optique à haute densité [1,2,3,4,5,6,7,8], des efforts intensifs ont été investis pour développer l'AlGaN- à haute efficacité. à base de diodes électroluminescentes ultraviolettes profondes (DUV LED). Au stade actuel, des progrès remarquables ont été réalisés pour améliorer la qualité cristalline des films d'AlGaN riches en Al, par exemple, la croissance de films d'AlN sur des substrats de saphir à nano-motifs par épitaxie quasi-Van der Waals assistée au graphène peut considérablement libérer la contrainte et réduire la densité de dislocation [9], qui indique l'efficacité quantique interne (IQE) de 80 % [10]. Il convient de noter qu'un tel IQE est mesuré en utilisant la méthode de photoluminescence à basse température, qui n'implique aucune injection de porteur. Cependant, les LED DUV fonctionnent par polarisation électrique, qui est associée au flux de courant et au transport de porteurs [11,12,13]. Un autre aspect très important concernant le flux de courant est l'effet d'encombrement du courant, qui se produit facilement lorsque l'appareil est polarisé à un niveau de courant très élevé [14]. Les LED DUV ont une efficacité de dopage Mg très inférieure dans la couche p-AlGaN avec une composante AlN élevée [15, 16], conduisant à une faible conductivité électrique. De plus, les LED DUV adoptent les structures flip-chip qui présentent le schéma d'injection latérale du courant. Par conséquent, par rapport aux LED UV, bleues et vertes à base d'InGaN/GaN, les LED DUV à base d'AlGaN sont plus contestées par l'effet d'encombrement actuel [17]. L'apparition de l'effet d'encombrement du courant soit au niveau de l'électrode de contact p soit au bord de la mesa entraîne une intensité d'électroluminescence inégale dans les puits quantiques multiples (MQW) et l'augmentation de la température de jonction [18]. De ce fait, il est en effet crucial de favoriser l'étalement latéral du courant pour les LED DUV. À cette fin, l'électrode de type p à bandes multiples étroites proposée permet une répartition du courant uniformément répartie, augmentant ainsi l'efficacité de la prise murale (WPE) de 60% [19]. De plus, la couche d'étalement de courant ITO/ZGO (ZnGaO) peut mieux répartir le courant et améliorer l'efficacité quantique externe (EQE), mais la résistivité interfaciale accrue aux interfaces ZGO/p-GaN rend le WPE moins amélioré pour les LED DUV [20] .
Par conséquent, au stade actuel, l'attention de la recherche est portée sur le côté p pour faciliter la propagation du courant pour les LED DUV. Dans ce travail, différent des autres approches, nous proposons et prouvons que l'amélioration de la distribution de courant dans la couche de fournisseur de trous de type p pour les LED DUV peut être obtenue en concevant la couche de fournisseur d'électrons n-AlGaN. La barrière énergétique est générée dans la bande de conduction en modulant le type de dopage dans la couche de fournisseur d'électrons, c'est-à-dire que la structure n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN) est proposée et étudiée paramétriquement. Nos résultats montrent que la distribution latérale des trous peut être homogénéisée en utilisant la jonction NPN-AlGaN, ce qui améliore donc la puissance de sortie optique, l'efficacité quantique externe et l'efficacité de la prise murale pour les LED DUV. Un autre avantage de notre conception est que, du point de vue de la croissance épitaxiale, le fait d'avoir la couche d'étalement de courant dans la couche de fournisseur d'électrons de type n permet aux épi-cultivateurs plus de liberté dans l'optimisation des conditions de croissance.
Méthodes de recherche et modèles physiques
Les structures LED NPN-AlGaN DUV sont schématisées sur la figure 1a. Dans chaque LED DUV étudiée, nous avons un n-Al0,60 de 4µm d'épaisseur Ga0.40 N/p-Alx Ga1−x N/n-Al0.60 Ga0.40 couche N, et la concentration de dopage Si du n-Al0,60 Ga0.40 La région N est 5 × 10 18 cm −3 . Ensuite, cinq paires de Al0.45 Ga0,55 S/O0,56 Ga0.44 N couches actives à puits quantiques multiples (MQW) sont conçues, pour lesquelles les épaisseurs des puits quantiques et des barrières quantiques sont respectivement de 3 nm et 12 nm. Les MQW sont coiffés d'un p-Al0,60 dopé au Mg de 18 nm d'épaisseur Ga0.40 Couche N servant de p-EBL, après quoi un p-Al dopé au Mg de 50 nm d'épaisseur0.40 Ga0,60 Une couche N et une couche p-GaN dopée au Mg de 50 nm d'épaisseur suivent. La concentration de trous pour le p-EBL et les couches de fournisseur de trous est définie sur 3 × 10 17 cm −3 . Nous concevons la géométrie de l'appareil avec une mesa rectangulaire de 350 × 350 m 2 . La figure 1b montre les profils de bande de conduction schématiques lorsque deux jonctions NPN-AlGaN (c'est-à-dire la structure NPNPN-AlGaN) sont utilisées dans la structure LED DUV, et nous pouvons voir les barrières énergétiques existant dans le p-Al appauvri x Ga1−x N régions. Les barrières énergétiques peuvent ajuster la distribution horizontale du courant dans la couche de fournisseur de trous de type p. Remarque, pour garantir le flux de courant à travers la jonction n-AlGaN/p-AlGaN polarisée en inverse, il est très important que la couche d'insertion p-AGaN soit complètement épuisée afin que la jonction NPN-AlGaN soit en mode de claquage à portée de main. [21]. Une analyse détaillée et des discussions seront présentées par la suite. Notre LED DUV de référence est identique aux LED DUV NPN-AlGaN sauf que le n-Al0.60 dopé Si de 4 µm d'épaisseur Ga0.40 La couche N est utilisée comme couche de fournisseur d'électrons.
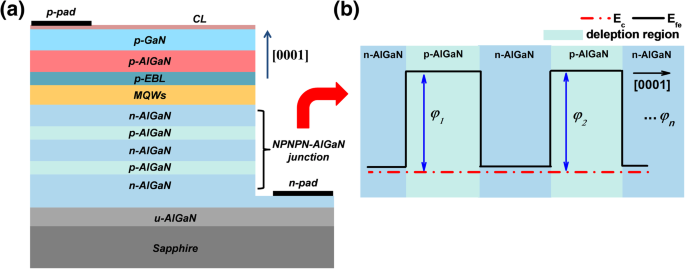
un Structures schématiques de la LED NPN-AlGaN. b Profil de bande de conduction schématique pour la structure NPNPN-AlGaN ayant deux jonctions NPN-AlGaN ; nous définissons les hauteurs de barrière pour chaque jonction NPN-AlGaN comme φ 1 , φ 2 , et φ n , et n est le nombre de jonction NPN-AlGaN
Pour mieux comprendre le mécanisme physique de l'effet d'étalement de courant amélioré permis par la jonction NPN-AlGaN, un circuit équivalent pour la LED DUV avec un schéma d'injection de courant latéral est illustré à la Fig. 2a. Nous pouvons voir que le courant circule de la couche fournisseur de trous de type p vers la région n-AlGaN le long des directions verticale et latérale. Si la résistance électrique de la couche de fournisseur d'électrons n-AlGaN est inférieure à celle de la couche d'étalement de courant (CL), le courant a tendance à s'entasser dans la région sous le contact ohmique de type p, c'est-à-dire I 1> Je 2> Je 3> …> Je n [14]. L'incorporation de jonctions NPN-AlGaN dans la structure LED DUV peut supprimer l'effet d'encombrement du courant destructeur. Ensuite, nous simplifions davantage les chemins de circulation du courant pour la LED NPN-AlGaN DUV sur la figure 2b, de sorte que le courant total peut être divisé en une partie verticale (I 1 ) et une partie horizontale (I 2 ) du point A au point B . Par conséquent, la tension totale entre les deux points est partagée par la couche d'étalement de courant, la couche p-GaN, la couche p-AlGaN, les MQW, les jonctions NPN-AlGaN et la couche n-AlGaN. Basé sur les chemins actuels de I 1 et Je 2 , Éqs. 1 et 2 sont obtenus, respectivement, et en résolvant les deux formules précédentes, Eq. 3 est alors dérivé :
$$ {I}_1{R}_{\mathrm{CL}-\mathrm{V}}+{I}_1{R}_X+{I}_1\bullet N\bullet {R}_{npn}+{ I}_1\left({R}_{n-\mathrm{V}}+{R}_{nL}\right)={U}_{\mathrm{AB}}, $$ (1) $$ {I}_2\gauche({R}_{\mathrm{CL}-\mathrm{L}}+{R}_{\mathrm{CL}-\mathrm{V}}\right)+{I}_2 {R}_X+{I}_2\bullet N\bullet {R}_{npn}+{I}_2{R}_{n-\mathrm{V}}={U}_{\mathrm{AB}} , $$ (2) $$ \frac{I_1}{I_2}=1+\frac{R_{\mathrm{CL}-\mathrm{L}}-{R}_{n-\mathrm{L}} }{R_{\mathrm{CL}-\mathrm{V}}+{R}_X+{R}_n+N\bullet {R}_{npn}} $$ (3)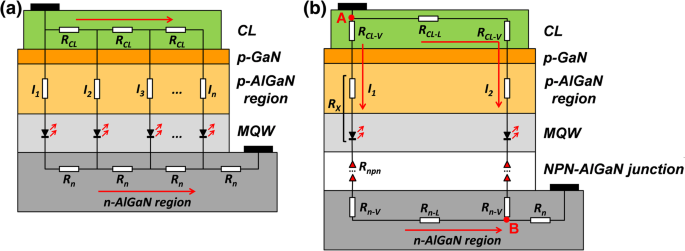
un LED DUV avec circuit équivalent schéma d'injection de courant latéral (I 1> Je 2> Je 3> ……> Je n ). b LED DUV à structure NPN-AlGaN simplifiée circuit équivalent et chemins de courant I 1 et Je 2 sont exposés
où R CL−V et R CL−L sont respectivement les résistances verticale et horizontale de la couche d'étalement de courant ; R n −V et R n −L désignent respectivement les résistances verticales et horizontales de la couche n-AlGaN ; R n est la somme de R n −V et R n −L (c'est-à-dire, R n =R n −V + R n −L ) pour le chemin actuel I 1; la somme de la résistance pour la région d'injection de trous de type p et la région MQW est représentée par R x ; R npn est la résistance interfaciale induite par la hauteur de barrière dans chaque jonction NPN-AlGaN; N signifie le nombre total pour la jonction NPN-AlGaN et la chute de tension totale entre les points A et B est décrit par U AB . Il convient de mentionner que la couche d'étalement de courant de 200 nm d'épaisseur est beaucoup plus fine que la couche de fournisseur d'électrons n-AlGaN de 4 µm d'épaisseur pour tous les dispositifs étudiés. Par conséquent, un CL dont la résistance électrique est beaucoup plus grande que celle de la couche n-AlGaN est obtenu, c'est-à-dire, R CL−L − R n −L ≫ 0. Il est évident que le rapport de I 1 /Je 2 peut être réduit en faisant N × R npn augmentation de la valeur. Par conséquent, l'effet d'étalement du courant dans la couche de fournisseur de trous de type p peut être amélioré en utilisant la jonction NPN-AlGaN dans la couche de fournisseur d'électrons de type n pour les structures LED DUV. D'une part, le N × R npn la valeur peut être améliorée en augmentant N . De l'autre, la valeur de R npn est affectée par la composante AlN, l'épaisseur et la concentration de dopage Mg pour la couche d'insertion p-AlGaN. Par conséquent, une analyse détaillée sera menée dans les discussions ultérieures.
Le simulateur Crosslight APSYS est utilisé pour étudier la physique du dispositif, et les modèles que nous utilisons sont fiables selon nos publications précédentes sur les LED bleues, UVA et DUV à base de nitrure [22,23,24]. Dans nos modèles physiques, le rapport de décalage de bande d'énergie pour l'hétérojonction AlGaN/AlGaN est fixé à 50:50 [25]. Le coefficient de recombinaison Auger, la durée de vie de la recombinaison Shockley-Read-Hall (SRH) et l'efficacité d'extraction de la lumière sont définis sur 1,0 × 10 −30 cm 6 /s [26], 10 ns [27] et ~ 8% [28] pour les LED DUV, respectivement. Les charges d'interface induites par la polarisation à l'interface à mésadaptation de réseau sont prises en compte en supposant un niveau de polarisation de 40 % [29].
Résultats et discussions
Influence de la structure NPN-AlGaN sur l'effet de propagation du courant pour les LED DUV
La LED A (c'est-à-dire la LED DUV de référence sans jonction NPN-AlGaN) et la LED B (c'est-à-dire la LED DUV avec jonction NPN-AlGaN) ont d'abord été étudiées pour sonder l'influence de la structure NPN-AlGaN dans l'homogénéisation du courant pour le Couche de fournisseur de trous de type p. Chaque jonction NPN-AlGaN a un p-Al0,60 de 20 nm d'épaisseur Ga0.40 Couche d'insertion N, pour laquelle la concentration de dopage Mg est de 1 × 10 18 cm −3 . La figure 3a montre le profil de bande d'énergie lorsque la densité de courant est de 170 A/cm 2 pour la LED B. Deux barrières énergétiques dans la bande de conduction sont formées dans les jonctions NPN-AlGaN, et la formation de la barrière énergétique est bien attribuée à l'effet d'épuisement du p-Al0,60 inséré Ga0.40 couche N. Les barrières générées dans la LED B induisent la résistance interfaciale de R npn dans la région de jonction NPN-AlGaN, ce qui aide à diminuer I 1 /Je 2 comme mentionné dans l'éq. 3, de sorte que plus de trous s'écouleront le long du chemin actuel I 2 . Nous calculons et montrons ensuite la concentration de trous horizontaux dans le dernier puits quantique (LQW) pour les LED A et B lorsque la densité de courant est de 170 A/cm 2 , comme le montre la figure 3b. Nous pouvons clairement voir que la LED B obtient un meilleur étalement du courant latéral par rapport à la LED A. Par conséquent, nous prouvons que le NPN-AlGaN dans la couche fournisseur d'électrons de type n facilite l'effet d'étalement du courant dans la couche fournisseur de trous de type p pour LED DUV.

un Profil de bande d'énergie pour la LED B, dans lequel nous définissons la bande de conduction, les niveaux quasi-Fermi pour les électrons et les trous, et la bande de valence comme E c , E fe , E fh , et E v , respectivement. b Concentration de trous horizontaux dans le LQW pour les LED A et B lorsque la densité de courant est de 170 A/cm 2
En plus de montrer la concentration de trous latéraux, nous démontrons également les niveaux de concentration de trous dans les MQW pour les LED A et B sur la figure 4a. Nous pouvons voir qu'en raison de l'effet d'étalement du courant amélioré, la concentration de trous dans les MQW est améliorée pour la LED B par rapport à celle de la LED A. Le niveau de concentration en trous amélioré dans les MQW favorise davantage la recombinaison radiative pour la LED B (voir Fig. 4b).
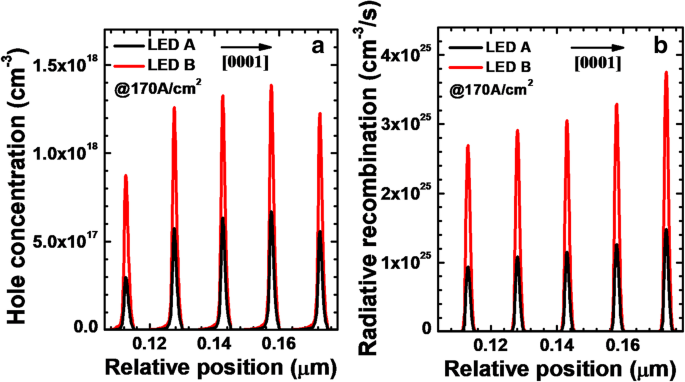
un Niveaux de concentration des trous et b profils de recombinaison radiative dans les MQW pour les LED A et B, respectivement. Nous collectons les données à l'emplacement de 120 μm du bord droit de la mesa lorsque la densité de courant est de 170 A/cm 2
L'impact de la jonction NPN-AlGaN est également justifié par les performances optiques et électriques calculées pour les LED A et B comme le montre la figure 5. La figure 5a présente l'EQE et la densité de puissance optique en fonction du courant injecté pour les deux LED. A et B. Nous pouvons voir que la LED B a à la fois une EQE et une densité de puissance optique plus élevées que la LED A, grâce à l'effet de propagation de courant amélioré et à l'efficacité d'injection de trous permis par la jonction NPN-AlGaN. Par exemple, l'amélioration de la densité de puissance optique pour la LED B est d'environ 1,67 % lorsque la densité de courant est de 170 A/cm 2 selon la figure 5a. Les études de la figure 5b montrent que la tension directe de la LED B avec jonction NPN-AlGaN a une légère augmentation par rapport à celle de la LED A. Nous attribuons ce phénomène aux barrières énergétiques dans les régions d'appauvrissement causées par le NPN-AlGaN. jonctions. Heureusement, la tension directe plus élevée de la LED B n'a pas d'effet néfaste sur l'efficacité de la prise murale (WPE), et la WPE de la LED B dépasse celle de la LED A lorsque la densité de courant d'injection est supérieure à ~ 56 A/cm 2 comme le montre la figure 5c. Nous pensons que l'EQE et le WPE améliorés peuvent être réalisés une fois que la jonction NPN-AlGaN peut être optimisée, ce qui sera entièrement étudié comme suit.
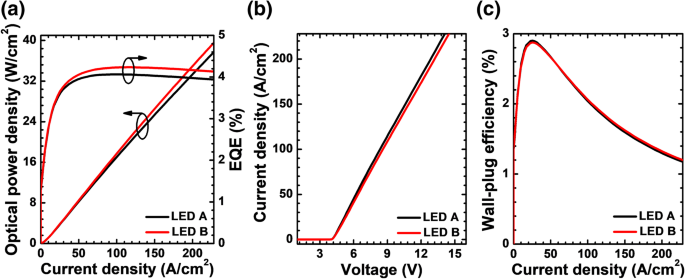
un EQE et densité de puissance optique en termes de courant d'injection, b caractéristique courant-tension, et c WPE en fonction du courant d'injection pour les LED A et B
Effet de la composition d'AlN pour la couche p-AlGaN sur l'effet de propagation du courant
Dans cette section, l'impact de la composition d'AlN pour la jonction NPN-AlGaN sur les propriétés optiques et électriques des LED DUV est étudié. Afin d'illustrer clairement ce mécanisme, nous utilisons cinq LED DUV, c'est-à-dire les LED Ci (i =1, 2, 3, 4 et 5) avec différents NPN-Alx Ga1−x N jonctions, pour lesquelles les compositions AlN pour p-Alx Ga1−x N couches d'insertion sont respectivement 0,60, 0,63, 0,66, 0,69 et 0,72. La concentration et l'épaisseur de dopage pour le p-Alx Ga1−x N couches sont 1,8 × 10 18 cm −3 et 20 nm, respectivement. Deux jonctions NPN-AlGaN, c'est-à-dire la jonction NPNPN-AlGaN sont utilisées pour tous les dispositifs étudiés. Nous calculons ensuite la hauteur de barrière de bande de conduction pour chaque NPN-Alx Ga1−x Jonction N pour LED Ci (i =1, 2, 3, 4 et 5) comme indiqué dans le tableau 1. Il est distinct de voir que la valeur de la hauteur de la barrière de conduction augmente avec la composition d'AlN pour le p-Alx Ga1−x N couche d'insertion augmente. La hauteur de barrière de conduction élevée peut faire la valeur de R npn augmentation et une diminution du ratio de I 1 /Je 2 est déclenché simultanément comme mentionné dans l'Eq. 3. Pour prouver ce point, les distributions de trous latéraux dans le dernier puits quantique pour tous les appareils étudiés lorsque la densité de courant est de 170 A/cm 2 sont calculés et présentés sur la figure 6a. Pour la LED C1, la distribution des trous peut être modulée après le NPN-Al0.60 Ga0.40 La structure N est adoptée, et il est évident que l'effet d'étalement du courant s'améliore encore une fois que la composante AlN de la couche d'insertion p-AlGaN augmente jusqu'à 0,63 pour nos structures.
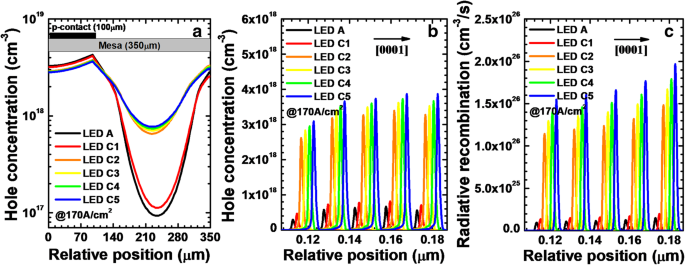
un Concentration de trous horizontaux dans le LQW, b niveaux de concentration des trous, et c profils de recombinaison radiative dans les MQW pour les LED A et Di (i =1, 2, 3, 4 et 5) lorsque la densité de courant est de 170 A/cm 2 . Nous décalons volontairement les courbes pour b et c par 2 nm pour une identification plus facile
Nous démontrons les niveaux de concentration de trous simulés et les profils de recombinaison radiative dans les MQW pour les LED A et Ci (i =1, 2, 3, 4 et 5) sur les Fig. 6b et c lorsque la densité de courant est de 170 A/cm 2 , respectivement. Les niveaux de concentration des trous et les profils de recombinaison radiative sont collectés à 120 μm du bord droit de la mesa. Nous décalons spatialement les niveaux de concentration de trous et les profils de recombinaison radiative sur les figures 6b et c pour les LED DUV étudiées de 2 nm pour une identification plus facile, respectivement. La concentration de trous la plus faible dans les MQW est clairement observée pour la LED A et, par conséquent, la recombinaison radiative la plus faible est également illustrée sur la figure 6c. La concentration de trous et la recombinaison radiative dans les MQW augmentent en raison de l'adoption de la jonction NPN-AlGaN, et elles peuvent être encore plus augmentées avec l'augmentation de la composition en AlN dans la couche d'insertion p-AlGaN.
La densité de puissance optique et l'EQE en fonction de la densité de courant d'injection sont en outre calculées et présentées pour les LED étudiées sur la figure 7a. Comme le montre la figure, l'EQE et la densité de puissance optique augmentent une fois la jonction NPN-AlGaN adoptée. De plus, l'EQE et la densité de puissance optique peuvent être encore améliorées à mesure que la composition en AlN pour la couche d'insertion p-AlGaN augmente. Nous contribuons à cela à la distribution des trous latéraux plus homogène dans les MQW comme le montre la figure 6a. Les caractéristiques courant-tension des LED A et Ci (i =1, 2, 3, 4 et 5) sont présentés sur la figure 7b. La tension directe pour la LED C1 montre une petite augmentation par rapport à la LED A, et la LED C5 montre la plus grande tension directe. La figure en médaillon montre la tension directe pour toutes les LED étudiées lorsque la densité de courant est de 170 A/cm 2 . Il est à noter que la tension directe diminue pour les LED C2, C3 et C4 par rapport à la LED A. Bien que la jonction NPN-AlGaN augmente la résistance verticale pour les LED DUV, la concentration de porteurs plus uniforme le long de la direction horizontale améliore la conductivité horizontale, conduisant ainsi à une tension directe réduite. Cela indique que l'effet d'étalement de courant amélioré peut aider à réduire la tension de fonctionnement directe pour les LED DUV tant que la couche d'étalement de courant est correctement conçue [30]. Cependant, notre conception module le chemin du courant en induisant des barrières, et par conséquent, une hauteur de barrière trop élevée peut sacrifier la conductance électrique [21], par exemple, la LED C5.
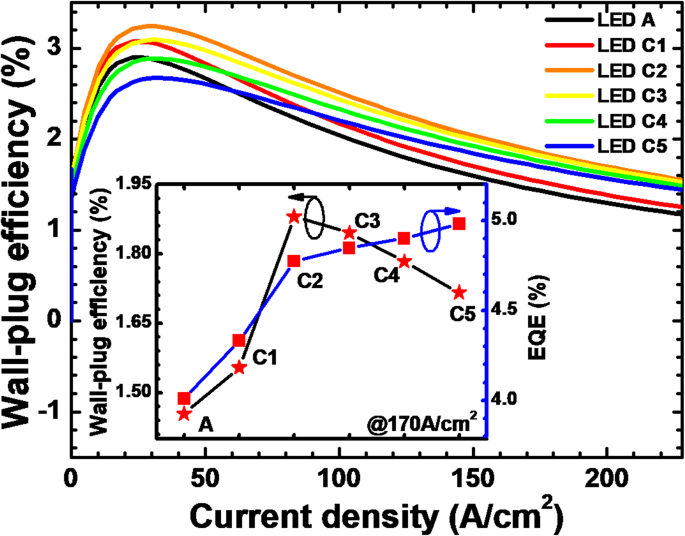
un EQE et densité de puissance optique en termes de courant d'injection et b caractéristiques courant-tension pour les LED A et Ci (i =1, 2, 3, 4 et 5). En médaillon :les tensions directes des LED A et Ci (i =1, 2, 3, 4 et 5) lorsque la densité de courant est de 170 A/cm 2
Le WPE en fonction de la densité de courant d'injection pour tous les dispositifs étudiés est présenté sur la figure 8. Par rapport à la LED A, le WPE de la LED C1 augmente une fois la jonction NPN-AlGaN adoptée. WPE pour LED Ci (i =2, 3, 4 et 5) peut être encore améliorée lorsque la composition en AlN de la couche p-AlGaN augmente pour la jonction NPN-AlGaN. Cependant, la LED C2 affiche le WPE le plus élevé en raison de la tension de fonctionnement directe la plus faible malgré la densité de puissance optique relativement faible parmi les LED Ci (i =2, 3, 4 et 5). De plus, nous montrons le WPE et l'EQE à la densité de courant d'injection de 170 A/cm 2 pour tous les appareils étudiés dans la figure en médaillon. Il est bien connu que l'effet d'encombrement du courant est sérieux à une densité de courant d'injection élevée. La jonction NPN-AlGaN pour LED C5 joue le mieux pour homogénéiser le courant. Cependant, le WPE n'est pas satisfaisant une fois que la tension de fonctionnement directe augmente de manière significative. Par conséquent, il convient d'optimiser pleinement la valeur du composant AlN de la couche d'insertion p-AlGaN pour la jonction NPN-AlGaN avant de pouvoir obtenir l'amélioration à la fois pour EQE et WPE.
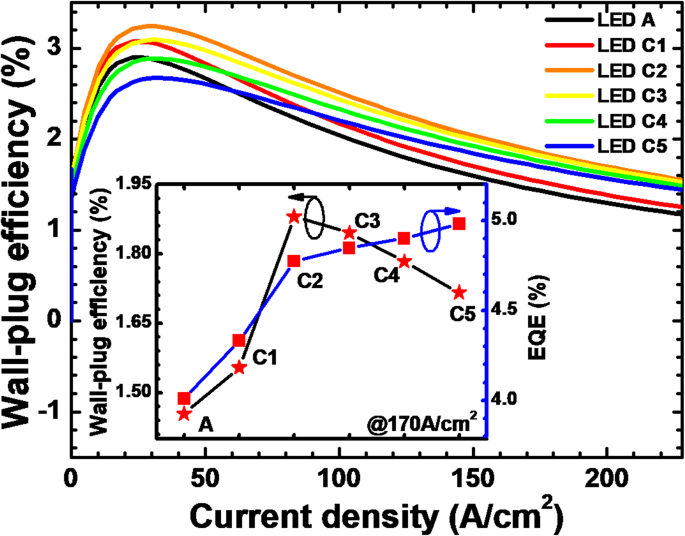
Relation entre WPE et le courant d'injection pour les LED A et Ci (i =1, 2, 3, 4 et 5). En médaillon :l'EQE et le WPE pour les LED étudiées structurées avec une couche de p-AlGaN avec divers composants d'AlN lorsque la densité de courant est de 170 A/cm 2
Effet de la concentration de dopage Mg pour la couche p-AlGaN sur l'effet de propagation du courant
La largeur de la région d'appauvrissement pour la jonction NPN-AlGaN peut être gérée en faisant varier la concentration de dopage en Mg pour la couche d'insertion p-AlGaN, et la hauteur de la barrière de bande de conduction changera également en conséquence. Ainsi, la valeur de R npn peut être augmenté une fois que la région d'épuisement pour la jonction NPN-AlGaN devient large, et la valeur de I 1 /Je 2 sera réduit, c'est-à-dire que l'effet de propagation du courant pour les LED DUV peut être amélioré. Pour mieux élucider ce point, cinq LED DUV avec différentes concentrations de dopage en Mg pour la couche d'insertion p-AlGaN dans la jonction NPN-AlGaN ont été conçues et étudiées. Nous avons fixé les concentrations de dopage Mg pour la couche de p-AlGaN à 3 × 10 17 , 7,5 × 10 17 , 1,7 × 10 18 , 2 × 10 18 , et 3 × 10 18 cm −3 pour LED Di (i =1, 2, 3, 4 et 5), respectivement. L'épaisseur et la composition en AlN de la couche d'insertion p-AlGaN sont respectivement de 20 µnm et 0,61. Nous adoptons deux jonctions NPN-AlGaN. Comme le montre le tableau 2, la hauteur de barrière de bande de conduction augmente à mesure que la concentration de dopage en Mg augmente pour la couche de p-AlGaN. Ensuite, nous calculons et montrons la concentration de trous latéraux dans le dernier puits quantique lorsque la densité de courant est de 170 A/cm 2 sur la figure 9a, et il est évident que, par rapport à la distribution latérale des trous pour la LED A, la distribution latérale des trous devient plus uniforme lorsque la jonction NPN-AlGaN est introduite pour les LED DUV. De plus, une distribution des trous encore plus homogénéisée peut être obtenue une fois que la concentration de dopage en Mg pour la couche p-AlGaN dans la jonction NPN-AlGaN augmente.
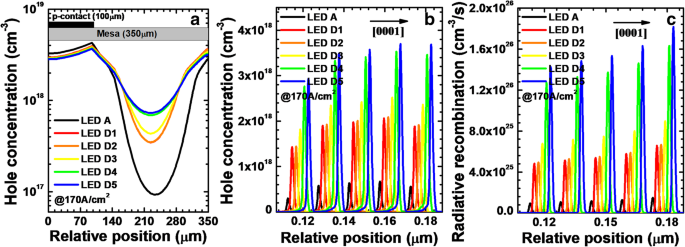
un Concentration de trous horizontaux dans le LQW, b niveaux de concentration des trous, et c profils de recombinaison radiative dans les MQW pour les LED A et Di (i =1, 2, 3, 4 et 5) lorsque la densité de courant est de 170 A/cm 2 . Nous décalons volontairement les courbes pour b et c par 2 nm pour une identification plus facile
Ensuite, les niveaux de concentration de trous calculés et les profils de recombinaison radiative dans les MQW sont démontrés pour toutes les LED étudiées sur les figures 9b et c lorsque la densité de courant est de 170 A/cm 2 , respectivement, et l'emplacement où les données sont collectées est à 120 μm du bord droit de la mesa. Comme prévu, les LED Di (i =1, 2, 3, 4 et 5) ont les niveaux de concentration de trous et les profils de recombinaison radiative les plus élevés dans les MQW par rapport à la LED A, tandis que la concentration de trous et la recombinaison radiative augmentent avec l'augmentation des concentrations de dopage en Mg dans la couche p-AlGaN pour les LED avec jonctions NPN-AlGaN. Nous contribuons à la concentration croissante de trous dans les MQW pour les LED Di (i =1, 2, 3, 4 et 5) à l'effet de propagation du courant amélioré.
En raison de l'effet d'encombrement réduit du courant et de la concentration croissante de trous dans les MQW, les LED Di (i =1, 2, 3, 4 et 5) montrent en conséquence l'EQE favorisée et la densité de puissance optique (voir Fig. 10a). Les caractéristiques courant-tension des LED A et Di (i =1, 2, 3, 4 et 5) sont illustrés à la Fig. 10b. Apparemment, les tensions de fonctionnement directes pour les LED Di (i =1, 2, 3, 4 et 5) augmentent avec l'augmentation de la concentration de dopage en Mg pour la couche d'insertion p-AlGaN. Parmi eux, la LED D5 montre la tension d'allumage la plus élevée, et cela est attribué à la diode parasite qui est causée par le niveau très élevé de concentration de dopage en Mg dans la couche p-AlGaN. Selon la figure en médaillon de la figure 10b, on voit également que la LED D5 montre la plus grande tension de fonctionnement directe parmi toutes les LED étudiées lorsque la densité de courant d'injection est de 170 A/cm 2 .
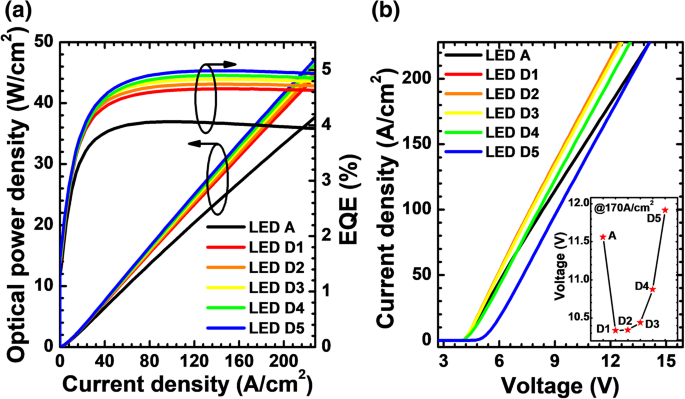
un EQE et densité de puissance optique en termes de courant d'injection et b caractéristiques courant-tension pour les LED A et Di (i =1, 2, 3, 4 et 5). En médaillon :les tensions directes des LED A et Di (i =1, 2, 3, 4 et 5) lorsque la densité de courant est de 170 A/cm 2
Pour une analyse plus complète, nous calculons le WPE en fonction de la densité de courant d'injection pour toutes les LED étudiées comme le montre la Fig. 11. Les WPE pour les LED Di (i =1, 2, 3 et 4) sont supérieurs à ceux de la LED A. Le WPE de la LED D5 ne dépasse celui de la LED A que lorsque la densité de courant d'injection est supérieure à 43 A/cm 2 . Le WPE inférieur pour LED D5 à une densité de courant inférieure à 43 A/cm 2 est due à la consommation de tension directe supplémentaire à la jonction NPN-AlGaN comme mentionné précédemment. D'après la figure en médaillon, on peut voir que l'EQE montre une tendance ascendante avec l'augmentation de la concentration de dopage en Mg pour la couche de p-AlGaN. Cependant, le WPE diminue avec l'augmentation supplémentaire de la concentration de dopage en Mg pour la couche de p-AlGaN. Par conséquent, nous concluons que l'effet d'étalement du courant et la tension directe sont très sensibles au niveau de dopage Mg de la couche d'insertion p-AlGaN.
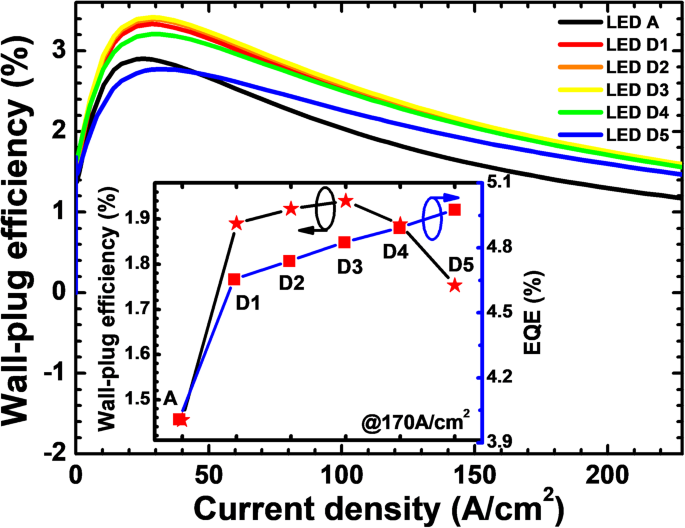
Relation entre WPE et le courant d'injection pour les LED A et Di (i =1, 2, 3, 4 et 5). En médaillon :l'EQE et le WPE pour les LED étudiées structurées avec une couche de p-AlGaN avec différentes concentrations de dopage lorsque la densité de courant est de 170 A/cm 2
Effet de l'épaisseur de la couche p-AlGaN sur l'effet d'étalement du courant
Dans cette section, l'impact de l'épaisseur de la couche d'insertion p-AlGaN dans la jonction NPN-AlGaN sur les performances de la LED est étudié. Tout d'abord, deux jonctions NPN-AlGaN (ie, jonction NPNPN-AlGaN) sont appliquées pour toutes les LED DUV étudiées, dont la composition en AlN et la concentration de dopage pour la couche p-AlGaN dans la jonction NPN-AlGaN sont de 0,61 et 1,5 × 10 18 cm −3 , respectivement. Nous avons ensuite défini différentes épaisseurs de 18, 20, 24, 28 et 32 nm pour la couche p-AlGaN dans les LED Ti (i =1, 2, 3, 4 et 5), respectivement. Les hauteurs de barrière de bande de conduction calculées pour chaque jonction NPN-AlGaN sont présentées dans le tableau 3. On peut voir que la hauteur de barrière de bande de conduction augmente lorsque la couche p-AlGaN dans la jonction NPN-AlGaN devient épaisse, ce qui permet la réduction de Je 1 /Je 2 et en conséquence l'étalement du courant amélioré.
Nous calculons et montrons la concentration de trous horizontaux dans le LQW pour les LED A et Ti (i =1, 2, 3, 4 et 5) lorsque la densité de courant est de 170 A/cm 2 dans la figure 12a. Clairement, la distribution des trous devient plus homogène lorsque la jonction NPN-AlGaN est introduite dans la structure LED DUV, et elle devient plus uniforme si l'épaisseur de la couche p-AlGaN dans la jonction NPN-AlGaN augmente. L'effet d'encombrement réduit du courant est attribué à la hauteur de barrière de bande de conduction plus élevée dans la région d'appauvrissement causée par la couche de p-AlGaN épaissie dans la jonction NPN-AlGaN. Figure 12b and c exhibit the hole concentration levels and radiative recombination profiles, respectively, for LEDs A and Ti (i =1, 2, 3, 4, and 5) at the injection current density of 170 A/cm 2 . The hole concentration levels and radiative recombination profiles are collected at the location of 120 μm away from the right-hand edge of the mesa. We can see that, when compared to that of LED A in the MQWs, LEDs Ti (i =1, 2, 3, 4, and 5) show the higher hole concentration levels and thus higher radiative recombination profiles. Once the thickness of the p-AlGaN layer is increased, further enhanced hole concentration and radiative recombination in the MQWs can be obtained.
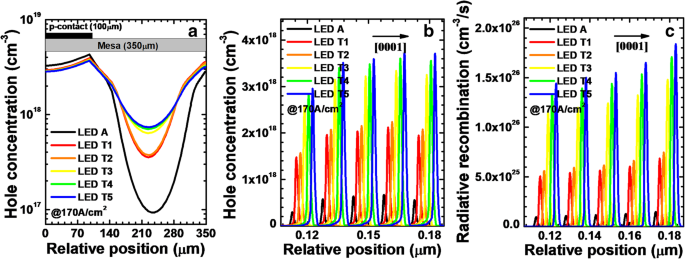
un Horizontal hole concentration in the LQW, b hole concentration levels, and c radiative recombination profiles in the MQWs for LEDs A and Ti (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b et c by 2 nm for easier identification
The observed optical power density and EQE for all studied LEDs in Fig. 13a agree well with the results shown in Fig. 12c, such that the increasing thickness for the p-AlGaN layer in the NPN-AlGaN junction can improve the optical power density and EQE. Moreover, we calculate and show the current-voltage characteristics for LEDs A and Ti (i =1, 2, 3, 4, and 5) in Fig. 13b. It shows that the forward operating voltages for LEDs Ti (i =1, 2, 3, and 4) exhibit a significant reduction when compared to that for LED A at the injection current density larger than 102 A/cm 2 , which is due to the significantly improved current spreading effect after adopting the NPN-Al0.61 Ga0.39 N junction as mentioned previously. However, a too thick p-AlGaN layer can cause an increase in the turn-on voltage owing to the parasitic N-AlGaN/P-AlGaN diode, e.g., LED T5 has the highest forward operating voltage among all the investigated LEDs when the current density is 170 A/cm 2 , which is also shown in the inset figure of Fig. 13b.
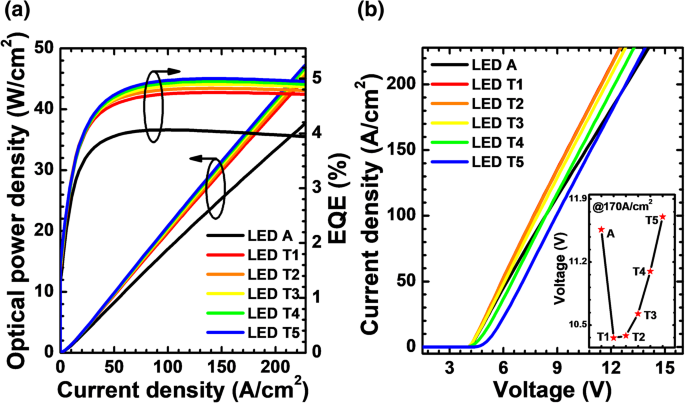
un EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ti (i =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ti (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
To this end, it is particularly important to further discuss the impact of higher forward operating voltage on DUV LED performance. Therefore, we calculate the WPE for all investigate devices and show the results in Fig. 14. We can see that the WPE for all LEDs with NPN-AlGaN junction exhibits distinct enhancement when compared to that for LED A. The presented WPEs in the inset figure also indicate that the NPN-AlGaN-structured DUV LED can save more electrical power than LED A. It is worth mentioning that the thickness for the p-AlGaN layer cannot be improved blindly, such that only when the thickness is properly set, then fully maximized WPE can be obtained.
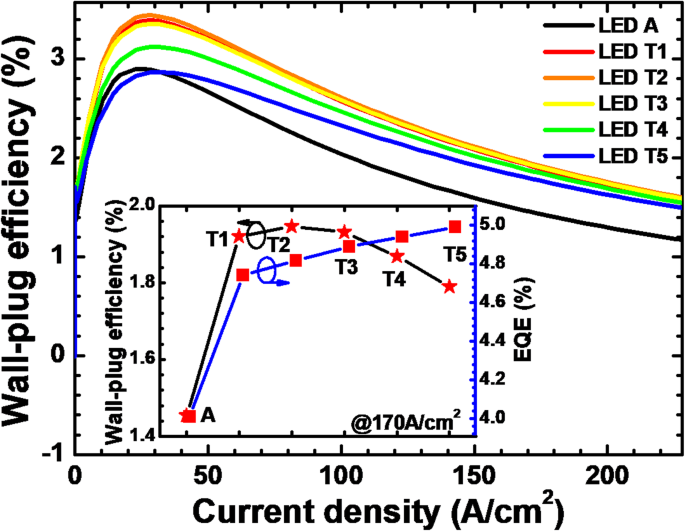
Relationship between WPE and the injection current for LEDs A and Ti (i =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with a p-AlGaN layer with various thicknesses when the current density is 170 A/cm 2
Effect of the NPN-AlGaN Junction Number on the Current Spreading Effect
Finally, we investigate the influence of the NPN-AlGaN junction number on the current spreading effect. The p-Al0.61 Ga0.39 N layer is adopted in the NPN-AlGaN junction for the proposed DUV LEDs in this section, for which the Mg doping concentration and thickness are 1.5 × 10 18 cm −3 and 20 nm, respectively. LEDs Ni (i =1, 2, 3, 4, and 5) have 1, 2, 3, 4, and 5 NPN-AlGaN junctions, respectively. As presented in Table 4, the conduction barrier heights of all NPN-AlGaN junctions are almost the same for LEDs Ni (i =1, 2, 3, 4, and 5). However, the total conduction barrier height for NPN-Al0.61 Ga0.39 N junctions in each investigated DUV LED surely increases when more NPN-Al0.61 Ga0.39 N junctions are utilized. Thus, the value of N × R npn can be enhanced, which helps to better spread the current horizontally, i.e., the increased value of I 2 dans l'éq. 3 is favored. The enhanced current spreading effect can be observed in Fig. 15a. The hole concentration in the LQW can become more uniform if the NPN-AlGaN junction number becomes more.
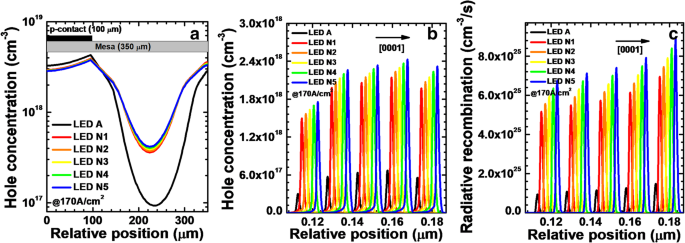
un Horizontal hole concentration in the LQW, b hole concentration, and c radiative recombination profiles in the MQWs for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b et c by 2 nm for easier identification
Then, the hole concentration levels and radiative recombination profiles in the MQWs for LEDs Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 are exhibited in Fig. 15b and c, respectively. We collect the hole concentration levels and radiative recombination profiles at the location of 120 μm away from the right-hand mesa edge. The hole concentration and radiative recombination are improved by using the NPN-Al0.61 Ga0.39 N junction, and further improvement can be obtained when more NPN-AlGaN junctions are included. Ascribed to the enhanced hole concentration in the MQWs, the optical power density and EQE for the DUV LEDs with NPN-AlGaN junction also shows a significant improvement. The current-voltage characteristics for all studied devices are shown in Fig. 16b, which illustrates that the forward operating voltages for LEDs Ni (i =1, 2, 3, 4, and 5) are lower than that for LED A, and this indicates that the current spreading effect can help to reduce the forward voltage once the Mg doping concentration, thickness, and AlN composition for the p-AlGaN layer are appropriately applied to the NPN-AlGaN junction. The turn-on voltage for all LEDs with NPN-AlGaN junction is almost the same as that for LED A, which illustrates the negligible impact of the reversely biased N-AlGaN/P-AlGaN parasitic junction if the Mg doping concentration in the p-AlGaN layer is properly set, i.e., the p-AlGaN layer has to be completely depleted before the device is biased.
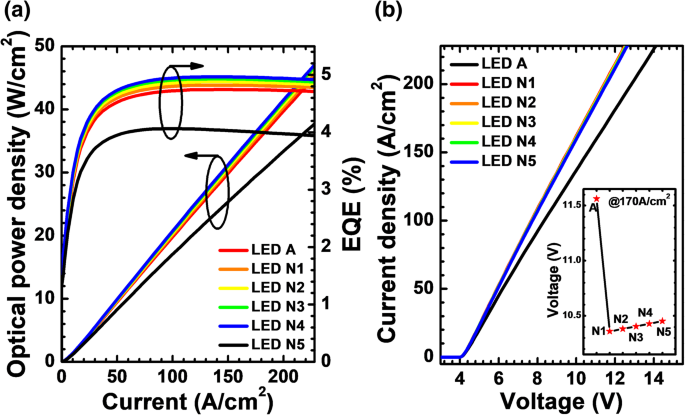
un EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ni (i =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
Last but not the least, the WPEs have also been demonstrated for LEDs Ni (i =1, 2, 3, 4, and 5) in Fig. 17. The WPEs of all DUV LEDs with NPN-Al0.61 Ga0.39 N junction have been promoted owing to the reduced forward operating voltage. In the inset figure, we show the EQE and WPE for LEDs A and Ni (i =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . Although the EQE and WPE for LEDs Ni (i =1, 2, 3, 4, and 5) increase with the increasing of the NPN-AlGaN junction number, clearly, we can see that the magnitude of the increase is gradually decreasing, which indicates that the NPN-AlGaN junction number also shall be set to a proper number, and we firmly believe that the device will consume more electrical power if too many NPN-AlGaN junctions are adopted in DUV LEDs.
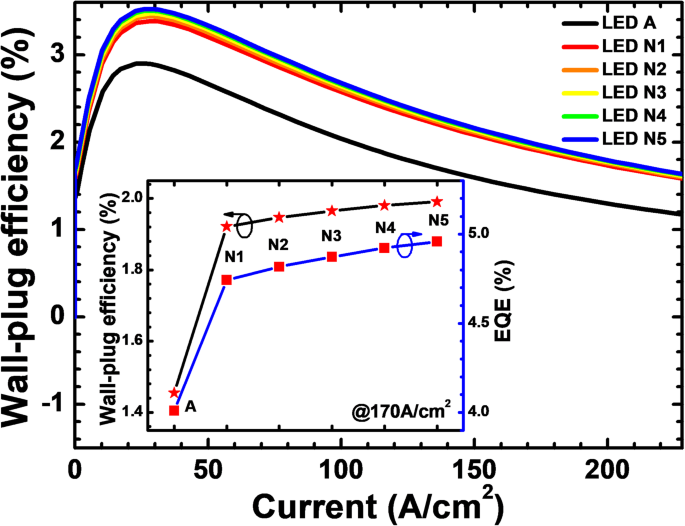
Relationship between WPE and the injection current for LEDs A and Ni (i =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with various NPN-AlGaN number when the current density is 170 A/cm 2
Conclusions
To conclude, we have suggested embedding the NPN-AlGaN junction in the n-type electron supplier layer for DUV LEDs. After comprehensive and systematic discussions, we find that the NPN-AlGaN junction can reduce the current crowding effect in the p-type hole supplier layer and improve the hole injection for DUV LEDs. The NPN-AlGaN junction can tune the conductivity for the n-type electron supplier layer so that the current path in the p-type hole supplier layer can be manipulated. For further explorations, we have investigated the impact of different parameters for NPN-AlGaN junctions on the current spreading effect, the EQE, and the WPE. We find that the current can be further homogenized if the AlN composition, the Mg doping concentration, the thickness of the p-AlGaN insertion layer, and the NPN-AlGaN junction number are increased properly. Although the EQE can be promoted by using the proposed NPN-AlGaN junctions, the WPE is not always monotonically improving, which arises from the additional voltage drop at the barriers within the NPN-AlGaN junctions. Hence, more attention shall be made when designing NPN-AlGaN current spreading layers for DUV LEDs. However, we firmly believe that our results have provided an alternative design strategy to reduce the current crowding effect for DUV LEDs. Meanwhile, we also have introduced additional device physics and hence are very useful for the community.
Disponibilité des données et des matériaux
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Abréviations
- APSYS :
-
Modèles physiques avancés de dispositifs à semi-conducteurs
- CL :
-
Current spreading layer
- LED DUV :
-
Diodes émettrices de lumière ultraviolette profonde
- EQE :
-
Efficacité quantique externe
- ITO :
-
Oxyde d'indium-étain
- LQW:
-
Last quantum well
- MQW :
-
Puits quantiques multiples
- NPN-AlGaN:
-
n-AlGaN/p-AlGaN/n-AlGaN
- IQE :
-
Efficacité quantique interne
- SSR :
-
Shockley-Read-Hall
- WPE :
-
Efficacité de la prise murale
- ZGO:
-
Zinc gallate
Nanomatériaux
- Les 4 principaux types d'entraînement à fente pour les fixations
- Présentation des arguments en faveur des puces neuromorphiques pour l'IA informatique
- La conception de la couche d'émission pour les multiplicateurs d'électrons
- Synthèse verte de points quantiques InP/ZnS Core/Shell pour une application dans des diodes électroluminescentes sans métaux lourds
- Le précurseur de titane optimal pour la fabrication de la couche compacte de TiO2 pour les cellules solaires à pérovskite
- Diodes émettant de la lumière ultraviolette à base d'AlGaN presque efficace et sans chute avec une couche de blocage d'électrons de type p à super-réseau spécialement conçue pour une efficacit…
- Diodes électroluminescentes à pérovskite haute luminance avec solvant alcoolique à haute polarité traitant le PEDOT:PSS comme couche de transport de trous
- Sur la couche de diffusion de courant p-AlGaN/n-AlGaN/p-AlGaN pour les diodes électroluminescentes ultraviolettes profondes à base d'AlGaN
- Influence de la largeur du puits quantique sur les propriétés d'électroluminescence des diodes électroluminescentes ultraviolettes profondes AlGaN à différentes températures



