Ge pMOSFET avec passivation GeOx formés par post-oxydation à l'ozone et au plasma
Résumé
Une étude comparative sur les performances électriques des pMOSFET Ge avec un GeOx Une couche de passivation formée par post-oxydation à l'ozone (OPO) et post-oxydation au plasma (PPO) est réalisée. PPO et OPO ont été réalisés sur un Al2 O3 Substrat /n-Ge (001) suivi d'un HfO2 à 5 nm diélectrique de grille déposé in situ dans une chambre ALD. La qualité de la couche d'interface diélectrique/Ge a été caractérisée par spectroscopie photoélectronique aux rayons X et microscopie électronique à transmission. Le traitement PPO conduit à une tension de seuil positive (V TH ) et un I inférieur ON /Je OFF ratio, ce qui implique une mauvaise qualité d'interface. Les pMOSFET Ge avec OPO présentent un I plus élevé ON /Je OFF rapport (jusqu'à quatre ordres de grandeur), une oscillation inférieure au seuil améliorée et des caractéristiques de mobilité des porteurs améliorées par rapport aux dispositifs PPO. Un Al2 plus épais O3 couche de bloc dans le processus OPO conduit à une plus grande mobilité dans les transistors Ge. En comparant deux méthodes d'oxydation différentes, les résultats montrent que l'OPO est un moyen efficace d'augmenter la qualité de la couche d'interface, ce qui contribue à l'amélioration de la mobilité effective des pMOSFET Ge.
Contexte
Les dispositifs CMOS (complémentaires métal-oxyde-semi-conducteur complémentaires) conventionnels approchant de leur limite physique, il est difficile d'améliorer les performances des dispositifs semi-conducteurs à grande vitesse avec du silicium (Si) comme matériau de canal. Le remplacement du substrat ou du matériau du canal par un autre matériau à haute mobilité est une option impérative. Le germanium (Ge) a été considéré comme un matériau de canal alternatif prometteur en raison de la mobilité des porteurs supérieure à celle du Si. Le MOSFET a généralement besoin d'une interface oxyde/semi-conducteur de haute qualité pour atteindre une mobilité efficace élevée. Cependant, pendant une assez longue histoire, les MOSFET Ge ont souffert de la densité élevée d'états d'interface (D il ) causée par la mauvaise stabilité thermique de GeO2 et les liens pendants [1]. Ainsi, de nombreuses recherches ont été menées sur la passivation d'interface Ge.
Plusieurs approches pour obtenir une couche d'interface Ge/diélectrique de haute qualité ont été rapportées, telles que la passivation de Si en déposant uniformément plusieurs monocouches de Si sur un substrat de Ge avant l'épitaxie diélectrique ou l'auto-passivation en formant GeO2 exprès [2, 3]. Afin de former un GeO2 de haute qualité couche, il existe de nombreux processus d'oxydation pour réduire D il et améliorer la stabilité thermique, y compris l'oxydation à haute pression [4], l'oxydation à l'ozone [5], H2 O plasma [6], et post-oxydation plasma à résonance cyclotron électronique (ECR) [7].
Ces dernières années, de nombreux travaux ont été rapportés selon lesquels un MOSFET Ge haute performance peut être réalisé par post-oxydation via Al2 O3 /Ge interface. En 2014, un inverseur Ge CMOS a été réalisé sur un substrat Ge-sur-isolant (GeOI) avec GeOx développé par recuit thermique rapide dans de l'oxygène pur ambiant après 1 nm Al2 O3 a été déposé sur Ge [8]. En réf. [7], Ge pMOSFET et nMOSFET avec GeOx la passivation ont été fabriquées avec un plasma d'oxygène après l'oxydation et la dépendance à la température de GeOx l'épaisseur et les performances électriques ont également été discutées. L'oxydation thermique du Ge par l'ozone peut être réalisée à une température plus basse, car l'ozone est plus réactif que l'oxygène [5]. L'impact de la température sur GeOx l'épaisseur augmentée par l'ozone sur la surface de Ge a été démontrée. Ge pMOSFET avec GeOx une passivation fabriquée par post-oxydation à l'ozone a également été signalée [9].
Dans ce travail, Ge pMOSFETs avec GeOx la passivation est fabriquée à l'aide d'une post-oxydation à l'ozone (OPO) et d'une post-oxydation au plasma d'oxygène (PPO) de l'Al2 O3 Interface /n-Ge. Une étude comparative sur les performances électriques des pMOSFET Ge avec OPO et PPO est réalisée. Tous les processus, à l'exception de la passivation, sont contrôlés avec précision pour être identiques. La post-oxydation a été réalisée après l'Al2 O3 dépôt de couche de bloc différent de [9] dans lequel la post-oxydation était après HfO2 déposition. Le mécanisme de dégénérescence de la mobilité de Coulomb et la diffusion de la rugosité est étudiée. L'impact de l'épaisseur de l'Al2 O3 La couche de bloc sur les performances de l'appareil est également discutée. Dans l'ensemble, nous démontrons que l'OPO est une technique de passivation prometteuse pour la future fabrication de MOSFET Ge.
Méthodes
Les pMOSFET Ge ont été fabriqués sur 4 pouces. Plaquettes n-Ge (001) avec une résistivité de 0,14 à 0,183 Ω cm. Trois processus de passivation différents ont été effectués, et les étapes clés du processus sont illustrées à la figure 1a. Les plaquettes ont été nettoyées avec du HF dilué (1:50) et de l'eau déminéralisée pendant plusieurs cycles pour éliminer l'oxyde natif, puis transférées immédiatement dans une chambre de dépôt de couche atomique améliorée par plasma PEALD (Picosun R200 Advanced). Ensuite, un mince Al2 O3 film (~ 1 nm) a été déposé à 300 °C avec du triméthylaluminium (TMA) et de l'eau déionisée (H2 O) comme précurseurs de Al et O, respectivement. Parce que l'Al2 O3 /GeO2 couche est trop mince pour avoir un rapport d'atomes d'oxygène précis, nous avons marqué ces deux couches comme AlOx /GeOx . La PPO a été réalisée avec la source plasma distante Litmas pendant 60 µs. Un générateur d'ozone (générateurs d'ozone de la série AC aux États-Unis) avec un débit d'oxygène d'entrée de 750 scccm a été utilisé pour le traitement OPO dans 50 % d'O3 /O2 ambiant. Sans casser le vide, 60 cycles HfO2 a ensuite été déposé sur le dessus d'AlOx /GeOx après traitement PPO ou OPO à 300 °C en utilisant du tétrakis diméthylamino hafnium (TDMAHf) et H2 O comme précurseurs de Hf et O, respectivement. Un TaN de 100 nm a ensuite été déposé par pulvérisation cathodique réactive comme métal de grille. Après la structuration de la grille et la gravure, BF 2+ auto-aligné implantation dans des régions source/drain(S/D) avec une énergie de 20 keV et une dose de 1 × 10 15 cm − 2 a été effectuée. Un métal Ni S/D de 20 nm a été déposé et modelé par un processus de décollement. Enfin, un recuit thermique rapide à 450°C pendant 30 s pour l'activation du dopant et le contact ohmique S/D a été suivi. Les images schématiques et microscopiques des pMOSFET Ge fabriqués sont présentées sur les figures 1b et c, respectivement.
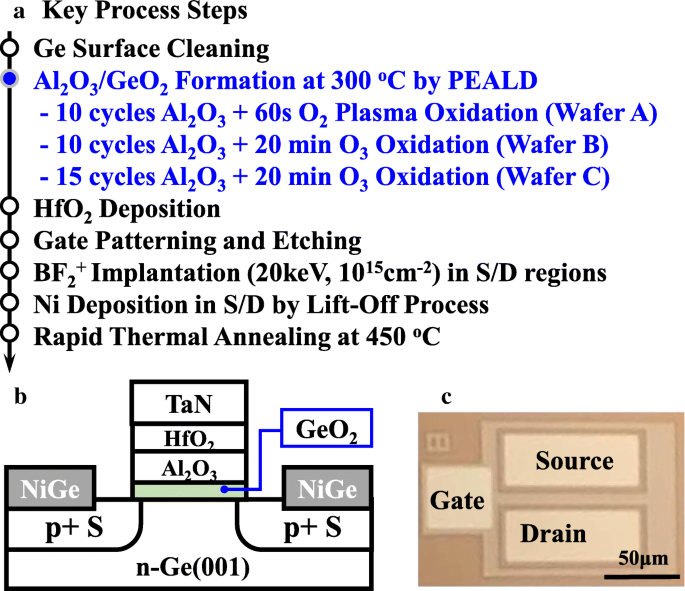
un Flux de processus clé pour la fabrication de pMOSFET Ge avec GeO2 passivation de surface avec trois méthodes de passivation différentes. b Schéma et c images au microscope du transistor Ge fabriqué
La section transversale de TaN/HfO2 /AlOx /GeOx L'empilement de grille /Ge a été représenté à l'aide d'un microscope électronique à transmission (MET) pour comparer l'impact du plasma d'oxygène ou de l'ozone sur GeOx formation. Les figures 2a et b montrent les images MET en coupe transversale de TaN/HfO2 /AlOx /GeOx /Ge gate stack avec PPO et OPO, respectivement. L'épaisseur du HfO2 amorphe couche dans les deux appareils est de 6 nm. La plaquette A avec un traitement PPO des années 60 a un AlOx distinct /GeOx couche entre le HfO2 et substrats Ge. Cette AlOx /GeOx couche dans la plaquette B formée par 20 min OPO a une marge désordonnée. L'épaisseur du GeOx couche est conforme aux données de [10].
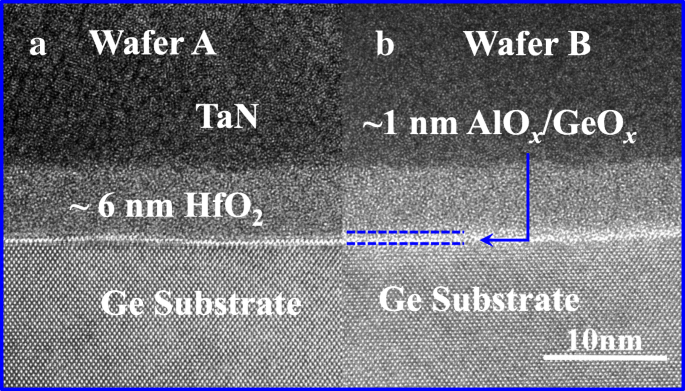
Images MET en coupe transversale de l'empilement de grilles à k/métal élevé avec un AlOx /GeOx couche interfaciale (IL) fabriquée par a OPO et b PPO sur un canal n-Ge (001)
Résultats et discussion
Les caractéristiques de sortie et de transfert couplées à la tension de capacité (CV) grille-source haute fréquence ont été mesurées par Keithley 4200-SCS. La figure 3 montre la comparaison des caractéristiques de transfert et de sortie des pMOSFET Ge avec trois conditions de formation différentes de l'AlOx /GeOx couche de passivation. Tous les dispositifs sur différentes tranches ont une longueur de grille (L G ) de 3 μm. Les appareils sur la plaquette A présentent un courant de drain saturé plus élevé (I DS ) par rapport aux deux autres tranches. Mais les plaquettes B et C avec OPO montrent un courant à l'état OFF beaucoup plus faible (I OFF ) par rapport à la plaquette A avec PPO. On voit également que les plaquettes B et C avec OPO fonctionnaient en mode enrichissement et la plaquette A fonctionnait en mode épuisement. On en déduit qu'après traitement PPO, la surface n-Ge reste encore de type p en raison du D élevé il valeur qui a été discutée dans [11]. Plaquette C avec un Al2 plus épais O3 la couche de blocs affiche un V positif TH décalage par rapport à la plaquette B et un D plus élevé il que la plaquette B. Il est observé à partir des caractéristiques de sortie illustrées sur la Fig. 3b que, sous une faible tension de grille (V GS ), la plaquette A a un I inférieur DS sur les tranches B et C en raison de l'oscillation sous-seuil (SS) moins raide. Lorsque le V GS augmente, Je DS de la plaquette A est de plus en plus élevée par rapport aux deux autres appareils. Par conséquent, à partir des images de la Fig. 3 et MET de la Fig. 2, la diffusion de l'AlOx /GeOx la couche peut supprimer le I OFF , entraînant ainsi une amélioration des effets de passivation.
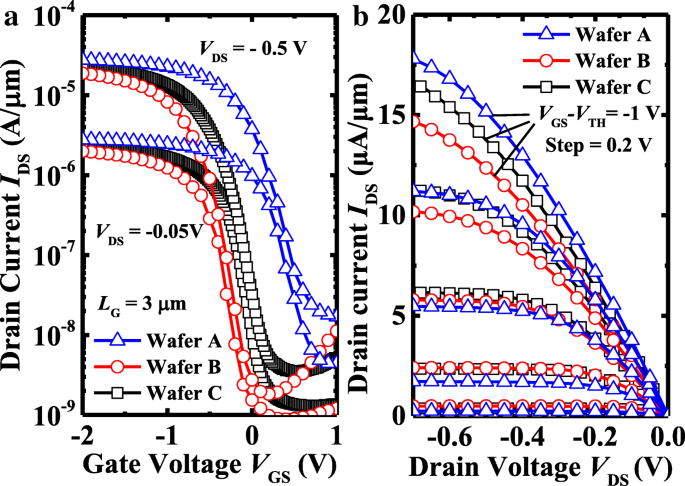
un Je DS –V GS et b Je DS –V DS caractéristiques des pMOSFET Ge avec un Al2 O3 /GeO2 couche de passivation fabriquée par PPO (wafer A) et OPO (wafers B et C)
La figure 4 résume les résultats statistiques du I ON /Je OFF rapport et oscillation sous le seuil des appareils sur différentes tranches. Les pMOSFET Ge avec OPO présentent un I plus élevé ON /Je OFF rapport (~ 4 ordres de grandeur) et SS remarquablement amélioré par rapport au dispositif PPO, indiquant une meilleure qualité de l'interface diélectrique/canal. Par rapport à la plaquette B, la plaquette C présente un courant à l'état passant plus élevé (I ON ) mais un I inférieur ON /Je OFF rapport.
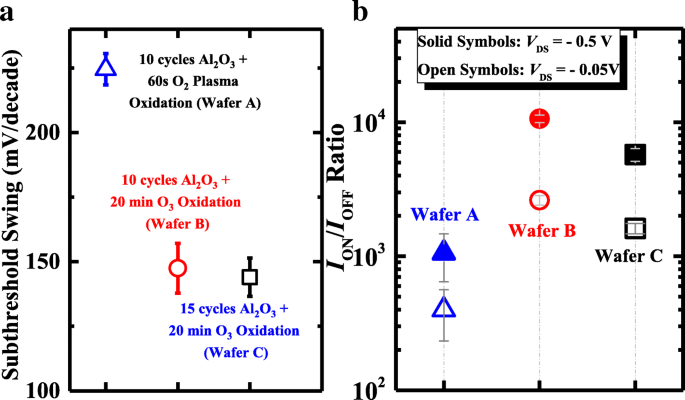
Graphiques statistiques de a SS et b Je ON /I OFF rapport pour les pMOSFET Ge avec différentes conditions de passivation
Pour représenter davantage la qualité de la couche interfaciale des différentes méthodes de post-oxydation, les plaquettes A, B et C (échantillons factices sans HfO2 et métaux de grille) ont été testés par spectroscopie photoélectronique à rayons X (XPS). La mesure XPS a été réalisée sur trois échantillons factices post-oxydation après traitement PPO ou OPO sans HfO2 dépôt et pulvérisation TaN. La stoechiométrie de GeOx dans Al2 O3 Des échantillons de /GeO/Ge ont été étudiés avec une source de rayons X monochromatique doux Al Kα (1486,6 eV). Ge 3d les pics et l'analyse de différenciation des pics sont illustrés à la Fig. 5. Le Ge 3d 5/2 le pic des trois échantillons est unifié à 29,7 eV, et les déplacements chimiques du Ge 3d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ , et Ge 4+ à Ge 3d 5/2 sont fixés à 0,6, 0,8, 1,8, 2,75 et 3,4 eV, respectivement [12]. Sur la Fig. 5b, la plaquette A montre qu'après une PPO de 60 s, la principale valence de Ge dans GeOx sont Ge 1+ et Ge 3+ . Une distribution d'état de cantonnière Ge similaire est observée dans la plaquette C, et un Ge 3+ composante est légèrement augmentée. Dans la Fig. 5b, la plaquette B montre qu'un dispositif OPO avec un diluant (10 cycles) Al2 O3 oxydera davantage Ge 1+ dans Ge 2+ , Ge 3+ , et Ge 4+ , tandis que Ge 1+ est considérablement réduit.
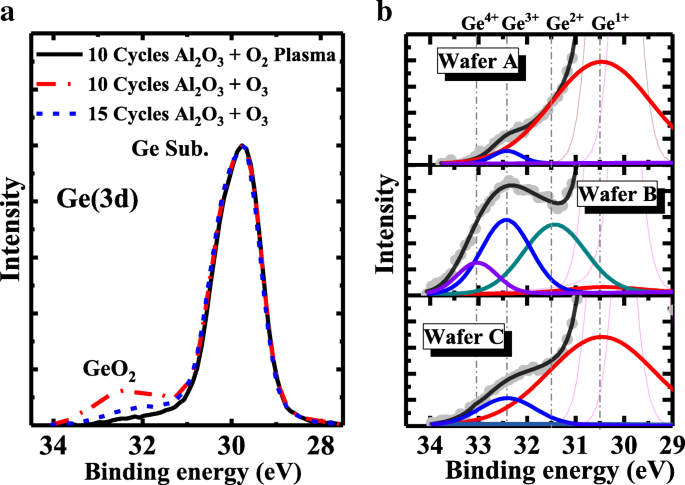
un Ge 3d Spectres XPS de Al2 O3 /GeOx /Ge formé par des conditions différentes. b Raccords de pointe du Ge 3d Spectres XPS du GeO2 couche pour les trois échantillons
Les caractéristiques CV porte-source sont illustrées à la Fig. 6. À partir de la courbe CV à 1 MHz, le D il l'écart proche est estimé par Terman méthode [13], et une valeur d'épaisseur d'oxyde équivalente (EOT) est également évaluée comme indiqué dans le tableau 1. L'OPO de vingt minutes (plaquettes B et C) entraîne une EOT plus élevée que la PPO (plaquette A). La plaquette C présente un EOT plus élevé que celui de la plaquette B, en raison de l'Al2 plus épais O3 comme couche de blocage. Il a été rapporté que l'épaisseur de GeOx sur une surface Ge nue en O3 ambiant atteint la saturation en quelques minutes et l'épaisseur de saturation est dominée par la température au lieu du temps d'oxydation [10]. Donc dans cet article, l'épaisseur de GeOx par l'ozone, la post-oxydation est saturée après quelques minutes et le temps d'oxydation restant est uniquement pour le recuit.
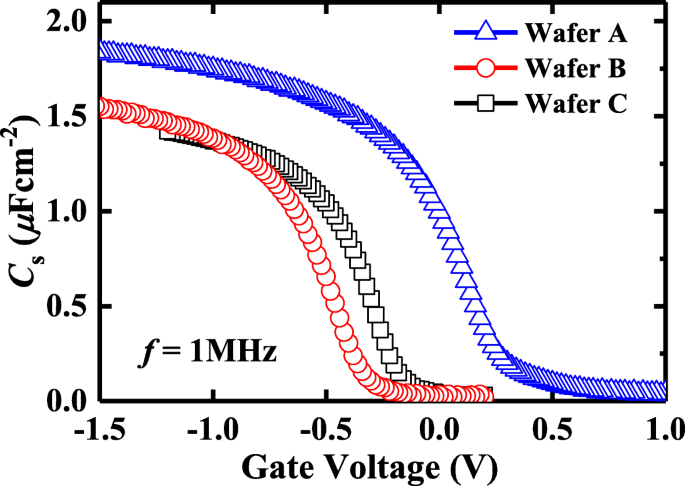
Capacité porte-source par rapport à V GS caractéristiques des Ge pMOSFET passivés par PPO (wafers A) et OPO (wafers B et C)
La figure 7 résume la résistance totale (R T ) contre L G de chaque appareil dans ce travail. Ici, R T est défini comme V DS /Je DS à V DS = 0,05 V et V GS − V TH = 1 V. La résistance série source/drain (S/D) (R SD ) et la résistance du canal (R CH ) peut être extrait de l'interception et de la pente de l'ajustement linéaire de R T –L G lignes comme le montre la figure 7. Le R extrait SD et R CH les résultats sont résumés dans le tableau 1. La figure 7 montre que les pMOSFET Ge avec PPO présentent un R inférieur SD et R CH ce qui est cohérent avec les résultats de capacité illustrés à la figure 6.
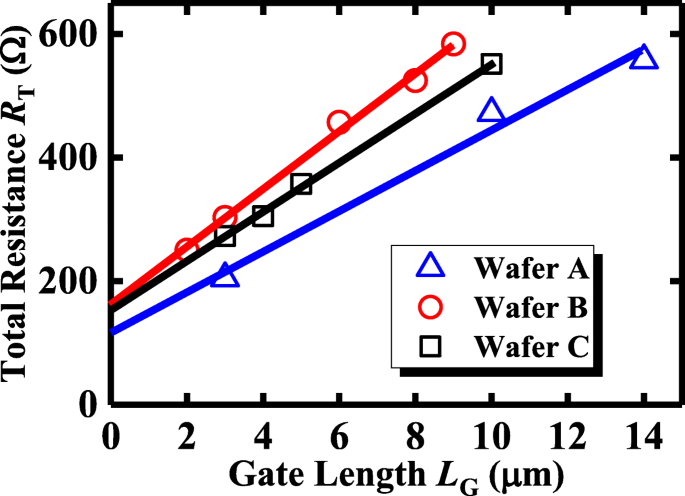
Résistance totale (R T ) en fonction de la longueur de la porte (L G ) de Ge pMOSFET
Mobilité efficace du trou μ eff a été extrait sur la base d'une approche basée sur la pente de résistance totale. Dans la Fig. 8, nous comparons le μ eff de nos pMOSFET Ge avec traitement PPO et OPO avec ceux d'autres pMOSFET Ge rapportés [9, 14]. Q inv est la densité de charge d'inversion dans le canal du dispositif. Les pMOSFET Ge avec OPO présentent un pic plus élevé μ eff par rapport aux appareils avec PPO. Plaquette C avec un Al2 plus épais O3 la couche de blocs a une mobilité de trou de pointe plus élevée de 283 cm 2 /V s par rapport à la plaquette B avec l'Al2 plus fin O3 . La plaquette A avec PPO présente un trou à champ élevé inférieur μ eff avec les appareils avec OPO, ce qui est attribué à la plus faible diffusion de rugosité. Mais, à faible champ, les transistors sur la plaquette A avec PPO atteignent un μ inférieur eff que les dispositifs OPO en raison de la diffusion coulombienne plus élevée [15]. Seuls quelques travaux sur les pMOSFET Ge fabriqués par passivation à l'ozone ont été rapportés. Ici, une comparaison des performances des dispositifs clés entre nos dispositifs et les pMOSFET Ge rapportés traités avec OPO [9, 14] est effectuée, et les résultats sont présentés dans le tableau 2. Il est conclu que la plaquette C dans ce travail atteint le haut -champ μ eff amélioration et plus élevé I ON /Je OFF par rapport à l'appareil rapporté traité avec OPO. De plus, à un Q inv de 5 × 10 12 cm − 2 , la plaquette C démontre un μ 2,37 fois plus élevé eff en comparaison avec la mobilité universelle Si. Le Je ON de la plaquette C est légèrement inférieure à celle de la Réf. [9] qui est dû à la plus grande EOT.
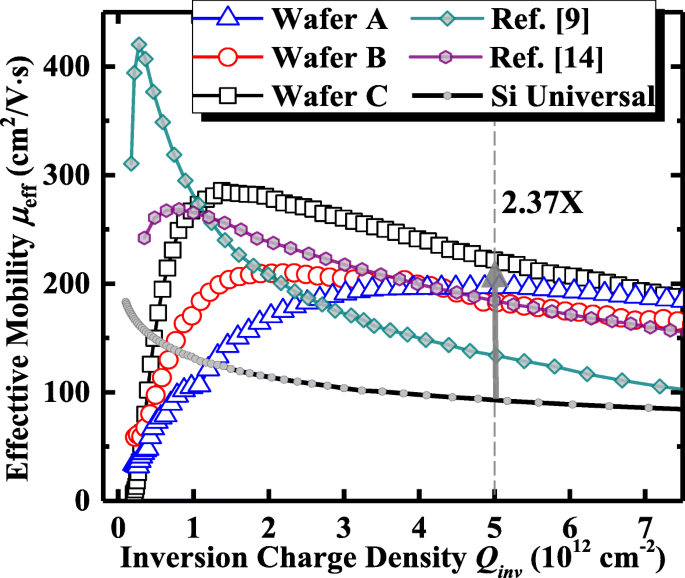
μ eff contre Q inv de Ge pMOSFET avec différentes conditions de passivation. Transistors Ge avec 15 cycles Al2 O3 + 20 min O3 l'oxydation (plaque C) présente un pic μ eff de 283 cm 2 /Vs. L'impact de la résistance S/D sur μ eff l'extraction a été supprimée par la méthode d'extraction de la mobilité effective des canaux basée sur la pente de résistance totale [16]
Conclusions
Les pMOSFET Ge sont réalisés avec GeOx passivation, qui est formée par le traitement OPO ou PPO de Al2 O3 /n-Ge dans PEALD. Les appareils OPO présentent les meilleures caractéristiques de transfert et de sortie, le plus élevé I ON /Je OFF rapport, l'oscillation inférieure au seuil améliorée et le pic plus élevé μ eff par rapport aux appareils PPO. Pour le procédé OPO à 15 cycles, un Al2 plus épais O3 couche conduit à une valeur EOT plus élevée et à un μ amélioré eff dans les appareils par rapport au cas à 10 cycles. Tous les résultats de ce travail indiquent que l'OPO est un moyen de passivation efficace pour obtenir une interface Ge/diélectrique de haute qualité et peut donc être une technique de passivation candidate prometteuse pour la future fabrication de MOSFET Ge.
Abréviations
- Al2 O3 :
-
Oxyde d'aluminium
- ALD :
-
Dépôt de couche atomique
- BF2 + :
-
Ion fluorure de bore
- EOT :
-
Épaisseur d'oxyde équivalente
- Voir :
-
Germanium
- GeOx :
-
Oxyde de Germanium
- HF :
-
Acide fluorhydrique
- HfO2 :
-
Dioxyde d'hafnium
- TEM :
-
Microscope électronique à transmission
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- OPO :
-
Post-oxydation à l'ozone
- OPP :
-
Post-oxydation plasma
- Q inv :
-
Densité de charge d'inversion
- SS :
-
Balançoire sous le seuil
- XPS :
-
Spectroscopie photoélectronique aux rayons X
- μ eff :
-
Mobilité efficace des trous
Nanomatériaux
- Créer des robots avec Raspberry Pi et Python
- Diriger avec persévérance et persévérance
- Capteur Portenta et thermocouple (avec MAX6675)
- Classe et objet C++ avec exemple
- Nanomatériau et nanocomposite intelligents dotés d'activités agrochimiques avancées
- Réglage de la chimie de surface du polyétheréthercétone par revêtement d'or et traitement au plasma
- Résistance de contact réduite entre le métal et le n-Ge par insertion de ZnO avec traitement au plasma d'argon
- Qu'est-ce que la découpe plasma et comment fonctionne la découpe plasma ?
- Node-RED et démarrage avec Docker



