Enquête sur la bande d'énergie aux hétérojonctions de ZnO/β-Ga2O3 (\( \overline{2}01 \)) déposées sur la couche atomique
Résumé
L'alignement des bandes d'énergie de ZnO/β-Ga2 O3 (\( \overline{2}01 \)) l'hétérojonction a été caractérisée par spectroscopie photoélectronique aux rayons X (XPS). Les films de ZnO ont été développés en utilisant un dépôt de couche atomique à différentes températures. Un alignement de bande de type I a été identifié pour tous les ZnO/β-Ga2 O3 hétérojonctions. Le décalage de la bande de conduction (valence) variait de 1,26 (0,20) eV à 1,47 (0,01) eV avec la température de croissance augmentant de 150 à 250 °C. L'augmentation du décalage de la bande de conduction avec la température est principalement due aux interstitiels de Zn dans le film de ZnO. En attendant, le défaut complexe de type accepteur Vzn + OH pourrait expliquer le décalage réduit de la bande de valence. Ces résultats faciliteront la conception et l'analyse physique de ZnO/β-Ga2 O3 appareils électroniques pertinents.
Introduction
Oxyde de gallium (Ga2 O3 ) a été largement étudié en tant que matériau semi-conducteur prometteur à bande interdite ultralarge pour les dispositifs électroniques de puissance de nouvelle génération en raison de ses propriétés uniques [1]. Parmi divers polymorphes (α, β, γ, δ et ε), monoclinique β-Ga2 O3 a la plus grande stabilité thermique [2]. De plus, -Ga2 O3 a une bande interdite à température ambiante de 4,5 à 4,9 eV et une excellente stabilité chimique [3]. Surtout, -Ga2 O3 a une mobilité élevée des électrons en vrac de ∼100 cm 2 /V·s, champ de claquage beaucoup plus élevé de 8 MV/cm que celui du SiC (3,18 MV/cm) ou du GaN (3 MV/cm) [4], et la concentration en porteurs peut être facilement modulée en dopant Sn et Si [ 5, 6]. Par conséquent, -Ga2 O3 Des dispositifs basés sur des photodétecteurs solaires aveugles [7] et des transistors à effet de champ métal-oxyde-semiconducteur (MOSFET) [8] ont été signalés. Cependant, des limitations existent toujours dans β-Ga2 O3 -appareils à base, tels que le mauvais contact ohmique entre le métal et le β-Ga2 O3 [9]. Au cours des dernières années, insertion d'une couche intermédiaire métal-oxyde-semiconducteur à haute concentration électronique, c'est-à-dire une couche semi-conductrice intermédiaire (ISL) entre le métal et Ga2 O3 , s'est avéré être une résolution efficace car la modulation de la barrière énergétique à l'interface [10,11,12].
L'oxyde de zinc (ZnO) a beaucoup attiré l'attention car il a une grande énergie de liaison aux excitons de 60 meV, une concentration élevée en électrons de> 10 19 cm −3 , et une forte énergie de cohésion de 1,89 eV. [13, 14] De plus, le décalage de réseau entre ZnO et Ga2 O3 est à moins de 5 % [15]. Diverses techniques de dépôt ont été développées pour préparer un film de ZnO, notamment la méthode hydrothermale [16, 17] et le dépôt chimique en phase vapeur (CVD). [18] Cependant, la méthode hydrothermale nécessite un processus compliqué et le taux de croissance est assez lent, et le CVD nécessite généralement une température de croissance élevée et silencieuse au-dessus de 900 ° C. Ces inconvénients rendent difficile son application dans des dispositifs. Récemment, le dépôt de couche atomique (ALD) est devenu une technique prometteuse, qui présente une excellente couverture des étapes, une contrôlabilité de l'épaisseur à l'échelle atomique, une bonne uniformité et une température de dépôt relativement basse. Par conséquent, le ZnO déposé sur une couche atomique sur des semi-conducteurs à large bande interdite peut réduire le désordre de l'interface et produire un échantillon plus contrôlable pour examiner l'alignement des bandes d'énergie, qui joue un rôle important dans le processus de transport des porteurs [19]. Jusqu'à présent, alignement des bandes entre Ga2 O3 et le ZnO déposé sur une couche atomique n'a pas été étudié expérimentalement, bien qu'il existe quelques rapports sur l'alignement théorique des bandes de ZnO et Ga2 O3 . [20] Par conséquent, comprendre l'alignement des bandes d'énergie du ZnO/β-Ga2 déposé sur la couche atomique O3 l'hétérojonction est hautement souhaitable pour la conception et l'analyse physique des dispositifs pertinents à l'avenir. Dans ce travail, l'alignement des bandes d'énergie du ZnO déposé sur la couche atomique sur β-Ga2 O3 a été caractérisé par spectroscopie photoélectronique aux rayons X (XPS). De plus, l'influence de la température de croissance du ZnO sur l'alignement des bandes a également été abordée.
Méthodes
-Ga2 O3 (\( \overline{2}01 \)) substrats avec une concentration de dopage Sn de ~ 3 × 10 18 /cm 3 ont été coupés en petits morceaux de la taille de 6 × 6 mm 2 . Les échantillons coupés en dés ont été alternativement nettoyés dans de l'acétone, de l'isopropanol par nettoyage aux ultrasons toutes les 10 min, puis rincés à l'eau déminéralisée pour éliminer les solvants organiques résiduels. Après cela, Ga2 O3 les substrats ont été transférés dans un réacteur ALD (Wuxi MNT Micro Nanotech co., LTD, Chine). Le taux de croissance des films de ZnO était d'environ 1,6 /cycle. Les films de 40 et 5 nm de ZnO ont été cultivés sur du β-Ga2 nettoyé. O3 en utilisant Zn (C2 H5 )2 (DEZ) et H2 O à chaque température de 150, 200 et 250 °C, respectivement. L'épaisseur des films de ZnO préparés a été mesurée par Ellipsomètre (Sopra GES-5E). Le ZnO(40 nm)/β-Ga2 O3 a été utilisé comme étalon de masse, et le ZnO(5 nm)/β-Ga2 O3 a été utilisé pour déterminer l'alignement de la bande, en attendant la masse nue β-Ga2 O3 a été utilisé comme échantillon témoin. Des mesures XPS (AXIS Ultra DLD, Shimadzu) avec un pas de 0,05 eV ont été effectuées pour mesurer le maximum de bande de valence (VBM), les spectres Ga 2p et Zn 2p. Pour éviter les interférences de l'oxydation de surface et de la contamination, tous les échantillons ont été gravés par des ions Ar pendant 3 min avec une tension de 2 kV avant la mesure XPS. A noter que tous les spectres XPS ont été calibrés par le pic C 1s à 284,8 eV pour compenser l'effet de charge. Pour identifier la bande interdite, les spectres de transmittance optique de Ga2 O3 et le ZnO ont été mesurés par spectroscopie ultraviolet-visible (UV-VIS) (Lambda 750, PerkinElmer, USA).
Résultats et discussion
La figure 1 montre la variation de (αhv ) 1/n en fonction de l'énergie des photons pour le -Ga2 en vrac O3 et le film de ZnO tel que cultivé déposé à 200 °C. La bande interdite optique (E g ) du film ZnO et β-Ga2 O3 peut être déterminé par la relation de Tauc [21] :(αhv ) 1/n = A (hv − E g ), où est le coefficient d'absorption, A est une constante, hv est l'énergie du photon incident, E g est la bande interdite d'énergie optique, n est 1/2 pour la bande interdite directe et 2 pour la bande interdite indirecte. Ici, à la fois ZnO et β-Ga2 O3 ont une bande interdite directe typique qui fait la valeur de n est 1/2. Par la suite, E g peut être extrait en extrapolant la portion de ligne droite au biais d'énergie à α =0. Par conséquent, le E extrait g de ZnO et -Ga2 O3 sont respectivement de 3,20 eV et 4,65 eV, en bon accord avec les valeurs rapportées. [22, 23]

L'intrigue de (αhv ) 2 contre hv pour a Film de ZnO cultivé sur verre de quartz b -Ga2 O3 substrat. L'encart montre les spectres de transmission optique de ZnO et β-Ga2 O3 , respectivement
Le décalage de bande de valence (VBO) peut être déterminé par la méthode de Kraut en utilisant la formule suivante [24]
$$ \Delta {E}_V=\left({E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3}\right)-\ gauche({E}_{Zn\ 2p}^{Zn O}-{E}_{VBM}^{Zn O}\right)-\gauche({E}_{Ga\ 2p}^{Ga_2{O }_3}-{E}_{Zn\ 2p}^{Zn O}\right), $$ (1)où \( {E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3} \) \( \Big({E}_{Zn\ 2p}^{Zn O}-{E}_{VBM}^{Zn O} \)) représente la différence d'énergie entre le niveau de cœur Ga 2p (Zn 2p) (CL) et le VBM du volume β-Ga 2 O3 (ZnO), et \( {E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{Zn\ 2p}^{Zn O} \) désigne la différence d'énergie entre Ga 2p et Niveaux de base Zn 2p. La figure 2 montre tous les spectres CL, y compris Zn 2p de ZnO (40 nm)/β-Ga2 O3 et ZnO (5 nm)/β-Ga2 O3 , Ga 2p de Ga2 en vrac O3 et ZnO (5 nm)/β-Ga2 O3 , ainsi que les spectres de bande de valence du Ga2 en vrac O3 et ZnO (40 nm)/β-Ga2 O3 . La figure 2a présente les spectres CL de Zn 2p sur le ZnO (40 nm)/β-Ga2 O3 , qui est calme et symétrique indiquant l'état de liaison uniforme, et le pic se situe à 1021,09 eV correspond à la liaison Zn-O [25]. Le VBM peut être déterminé en utilisant une méthode d'extrapolation linéaire [26]. Le VBM de ZnO est situé à 2,11 eV. Sur la figure 2b, le pic situé à 1117,78 eV correspond à la liaison Ga-O [27] et au VBM de Ga2 O3 est déduit à 2,74 eV selon la méthode mentionnée ci-dessus. Les CL de Zn 2p et Ga 2p dans le ZnO (5 nm)/β-Ga2 O3 sont représentés sur la figure 2c. Selon l'éq. (1), le VBO à l'interface ZnO/Ga2 O3 est déterminé à 0,06 eV.
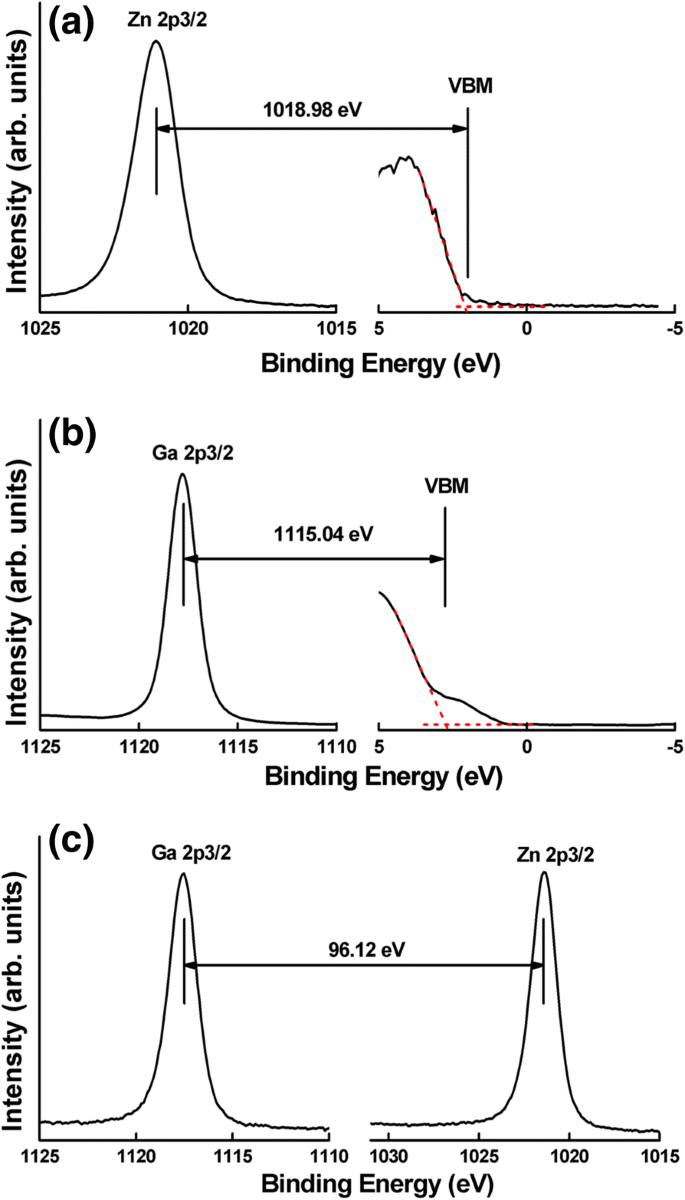
Spectres XPS haute résolution pour le niveau de base et le maximum de bande de valence (VBM) de a Spectre de niveau de base Zn 2p et VBM à partir de 40 nm ZnO/β-Ga2 O3 , b Spectre de niveau de noyau Ga 2p et VBM à partir de β-Ga2 nu O3 , et c les spectres de niveau cœur de Ga 2p et Zn 2p obtenus à partir de spectres XPS haute résolution de 5 nm ZnO/β-Ga2 O3
Sur la base du E calculé g et ∆E V , le décalage de bande de conduction (CBO) au niveau du ZnO/Ga2 O3 l'interface peut être facilement déduite de l'équation suivante :
$$ \Delta {E}_C={E}_g^{Ga_2{O}_3}-{E}_g^{ZnO}-\Delta {E}_V, $$ (2)où\( {E}_g^{Ga_2{O}_3} \) et \( {E}_g^{ZnO} \) sont la bande interdite d'énergie pour β-Ga2 O3 et ZnO, respectivement. Le diagramme détaillé des bandes d'énergie pour ZnO/β-Ga2 O3 est représenté sur la figure 3. L'interface a un alignement de bande de type I, où les bords des bandes de conduction et de valence de ZnO sont situés dans la bande interdite de β-Ga2 O3 .

Diagramme schématique d'alignement des bandes du ZnO (200 °C)/β-Ga2 O3 hétérojonction
Examiner plus en détail l'effet de la température de croissance sur l'alignement des bandes entre ZnO et β-Ga2 O3 , les films de ZnO sont également cultivés à 150 et 250 °C. Notez que les films de ZnO préparés par ALD à des températures de 150 à 250 ° C ont une nature polycristalline. La figure 4 montre les spectres XPS O 1s haute résolution des films de ZnO cultivés à différentes températures. Chaque spectre O 1s peut être bien séparé en trois composantes en utilisant la fonction gaussienne-lorentzienne. Les pics centrés à 530,0 (O1), 531,6 (O2) et 532,4 (O3) eV correspondent respectivement aux bandes Zn-O, aux lacunes en oxygène et au groupe -OH [28, 29]. Le pourcentage relatif des différents composants est également calculé en fonction de l'aire du pic, digéré sur la figure 4. Il montre que la teneur relative des lacunes en oxygène augmente de 10,7 à 15,0 % en raison de la décomposition des précurseurs et de l'augmentation des interstitiels de Zn. Cependant, la contrepartie -OH diminue de 5,1 à 1,9% en raison de réactions plus complètes entre les précurseurs DEZ et les groupes -OH de surface dans cette plage de température [30].

Spectres XPS O 1 à haute résolution des films de ZnO cultivés à a 150 °C, b 200 °C, et c 250 °C, respectivement
La figure 5 montre les décalages de bande de ZnO/β-Ga2 O3 hétérojonctions en fonction de la température de croissance. Le CBO augmente de 1,26 à 1,47 eV avec une température de croissance variant de 150 à 250 °C. Les défauts du donneur natif comprennent l'anti-position de Zn, les lacunes d'oxygène et les interstitiels de Zn. Cependant, l'énergie de formation des atomes d'antiposition est si élevée que sa concentration est extrêmement faible. Les interstitiels de Zn ont plus d'influence sur le minimum de bande de conduction (CBM) que celui de la lacune d'oxygène car le CBM est principalement dominé par l'orbite 4s de l'atome de Zn. [31] En conséquence, l'augmentation du CBO de 0,21 eV pourrait être principalement due aux interstitiels de Zn. D'autre part, le VBO diminue de 0,20 à 0,01 eV avec la température de croissance augmentant de 150 à 250 °C. Les défauts accepteurs natifs comprennent l'anti-position O, les lacunes de Zn et les interstitiels d'oxygène [32], dont les énergies de formation sont élevées et leur nombre peut être même négligeable. De plus, les niveaux d'accepteurs les plus natifs se situent profondément dans la bande interdite de ZnO, ils ont donc peu d'effet sur le VBM [33]. Cependant, Vzn + OH est favorable à présenter duo à la faible énergie de formation, [34] Vzn + OH peut apparaître avec un électron appartenant aux liaisons OH. Le réseau hydrogène H + ion agit comme un centre de compensation, et il peut se lier avec le VZn autour du noyau de défauts de dislocation et d'empilement, assurant le défaut complexe de type accepteur pour la conductivité de type p [35]. Plus de groupes -OH résiduels dans le film de ZnO sont obtenus à une température de croissance plus basse, c'est-à-dire 150 °C [36]. Le niveau de l'accepteur à proximité du VBM diminue avec la température, ce qui entraîne effectivement un décalage vers le bas de E V de ZnO, donc le ∆E V devient plus faible. Par conséquent, le ZnO déposé à plus basse température pourrait être plus efficace pour réduire la hauteur de barrière à l'interface entre le métal et Ga2 O3 .

Les décalages de bande de conduction et de valence du ZnO/β-Ga2 déposé sur la couche atomique O3 hétérojonctions fabriquées à différentes températures
Conclusions
En résumé, l'alignement des bandes d'énergie au ZnO/β-Ga2 déposé sur la couche atomique O3 (\( \overline{2}01 \)) a été caractérisé par XPS. Un alignement de bande de type I formé au niveau du ZnO/β-Ga2 O3 interface. Le décalage de la bande de conduction a augmenté de 1,26 à 1,47 eV tandis que le décalage de la bande de valence a diminué de 0,20 à 0,01 eV avec la température augmentant de 150 à 250 °C. Ces observations suggèrent que le ZnO déposé à plus basse température est favorable pour être un ISL prometteur pour réduire la hauteur de barrière électronique au ZnO/β-Ga2 O3 interface.
Abréviations
- ALD :
-
Dépôt de couche atomique
- CBM :
-
Bande de conduction minimum
- CBO :
-
Décalage de la bande de conduction.
- CVD :
-
Dépôt chimique en phase vapeur
- DEZ :
-
Zn (C2 H5 )2
- Ga2 O3 :
-
Oxyde de gallium
- GaN :
-
Nitrure de gallium
- ISL :
-
Couche semi-conductrice intermédiaire
- MOSFET :
-
Transistors à effet de champ métal-oxyde-semiconducteur
- OH :
-
hydroxyle
- SiC :
-
Carbure de silicium
- UV-VIS :
-
Spectroscopie ultraviolet-visible
- VBM :
-
Bande de valence maximum
- VBO :
-
Décalage de la bande de valence
- XPS :
-
Spectroscopie aux rayons X
- ZnO :
-
Oxyde de zinc
Nanomatériaux



