Recombinaison à contrainte contrôlée dans plusieurs puits quantiques InGaN/GaN sur substrats de silicium
Résumé
Cet article rapporte les propriétés de photoluminescence (PL) des diodes électroluminescentes à puits quantiques multiples InGaN/GaN (MQW) développées sur des substrats de silicium qui ont été conçues avec différentes architectures de contrôle des contraintes de traction comme le dopage périodique Si δ à la couche GaN de type n ou insérer une couche d'InGaN/AlGaN pour étudier le mécanisme de recombinaison à contrainte contrôlée dans le système. Les résultats de PL se sont avérés que les échantillons libérés de contraintes de traction avaient de meilleures performances de PL car leurs efficacités quantiques externes ont augmenté à 17%, 7 fois plus grandes que celles de l'échantillon régulier. L'analyse détaillée a confirmé qu'ils avaient des taux de recombinaison non radiative plus faibles ((2,5~2,8)×10 −2 s −1 comparé à (3,6~4,7)× 10 −2 s −1 ), ce qui était associé à la meilleure qualité cristalline et à l'absence de dislocations ou de fissures. De plus, leurs taux de recombinaison radiative se sont révélés plus stables et beaucoup plus élevés ((5,7~5,8) ×10 −3 s −1 par rapport à [9~7] ×10 −4 s −1 ) à température ambiante. Cela a été attribué à la suppression des états localisés peu profonds sur les interfaces MQW, laissant les centres de localisation radiatifs profonds à l'intérieur des couches d'InGaN dominant la recombinaison radiative.
Contexte
Les structures à puits quantiques multiples (MQW) InGaN/GaN cultivées sur des substrats de silicium au lieu de saphir conventionnel ont attiré une attention croissante pour leurs applications potentielles dans l'éclairage à semi-conducteurs à faible coût, l'affichage sur panneau et la photonique sur silicium [1,2,3,4, 5]. L'obstacle critique dans la fabrication d'un film de GaN de haute qualité sur Si est le décalage de dilatation thermique (56 %) entre GaN et Si, qui a introduit une contrainte de traction et des fissures importantes dans les films de GaN développés [6,7,8,9]. De plus, une couche de GaN de type n dopé Si sous les couches MQW est nécessaire pour les diodes électroluminescentes (LED) ou les diodes laser (LD). Dans ces cas, une contrainte de traction supplémentaire due au dopage au Si sera apportée. Ces dernières années, des efforts ont été faits pour surmonter ces difficultés via l'utilisation de couches intermédiaires avec une contrainte de compression appropriée pour contrebalancer la contrainte de traction 15,16], le dopage delta pour la relaxation des contraintes [17, 18], ou le dépôt de couche tampon adapté au réseau [19, 20]. Selon des travaux antérieurs [17], l'architecture de dopage Si périodique de la couche de GaN de type n pourrait obtenir une couche de GaN plus lisse avec une qualité cristalline plus élevée et une densité de fissures plus faible que sur du GaN uniformément dopé. Cela a été attribué à la réduction de la contrainte de traction. Plusieurs travaux ont été effectués pour examiner la morphologie de surface, la densité de dislocation et les propriétés électriques des couches GaN cristallines de GaN/Si à dopage δ sur des substrats de saphir [21, 22] ou de silicium [23]. Malheureusement, peu d'entre eux ont directement étudié les propriétés de luminescence des structures InGaN/GaN MQW au-dessus d'une couche de Si GaN à dopage δ et ont clarifié la relation entre l'amélioration de l'efficacité de la luminescence et la libération de contrainte causée par les améliorations de la structure du film, qui sont essentielles pour le dispositif. fabrication. Il convient également de mentionner qu'il est difficile de mesurer directement la déformation ou d'observer les distorsions du réseau sans décomposer les échantillons de LED. Des méthodes indirectes sont toujours appliquées pour évaluer la déformation interne. Par exemple, une pression mécanique a été appliquée pour moduler la contrainte interne, ce qui a conduit aux changements de champ piézoélectrique à l'intérieur des MQW ainsi qu'aux performances optoélectroniques des dispositifs LED [24,25,26,27]. Dans tous ces cas, les mesures de spectres de luminescence se sont avérées indispensables pour examiner les performances du dispositif liées à la contrainte.
Par conséquent, dans ce travail, des structures de LED InGaN/GaN MQW ont été déposées sur des substrats de silicium cristallin. Soit du Si GaN uniformément dopé, soit du Si périodique GaN dopé fonctionnant comme une couche de GaN de type n a été développé à des fins de comparaison. En outre, deux autres échantillons de contrôle basés sur des couches de GaN de type n uniformément dopées en Si, insérés par une couche mince d'AlGaN ou d'InGaN respectivement, ont également été préparés pour soutenir l'analyse de l'influence de la contrainte de compression ou de la contrainte de traction sur les performances du dispositif, comme AlGaN a une constante de réseau plus petite que GaN, ce qui libérera partiellement la contrainte de traction sur la surface, ainsi que la couche insérée d'InGaN aggravera la contrainte de traction au contraire. L'efficacité relative de la photoluminescence (PL) et les durées de vie (taux) de recombinaison pour chaque échantillon ont été extraites des spectres PL en régime permanent (SS) à température variable et des spectres PL résolus en temps (TR), puis analysées systématiquement. Les résultats se sont avérés que les échantillons libérés de contraintes de traction avaient de meilleures performances PL car la recombinaison non radiative liée aux défauts de structure était la suppression et la recombinaison radiative sont plus liées aux états de recombinaison profonds à l'intérieur des couches de puits d'InGaN, ce qui a conduit à une recombinaison radiative plus stable avec la température .
Méthodes
Comme le montre le schéma de la Fig. 1, la croissance épitaxiale des MQW InGaN/GaN a été réalisée par dépôt chimique en phase vapeur métal-organique qui a été rapporté dans des travaux antérieurs [17] :couche d'AlN de 100 nm, couche d'AlGaN à gradation linéaire de 660 nm et 200 Une couche de GaN nominalement non dopée nm a été développée sur le substrat Si (111) comme tampon à 1060, 1060 et 1020 °C, respectivement. Pour les échantillons S1, S3 et S4, une couche de GaN de 1 μm de Si uniformément dopé a été déposée sur le tampon avec une concentration en atomes de Si estimée autour de 10 18 cm −3 . Pour les échantillons S3 et S4, une couche insérée d'InGaN de 20 nm avec In% ~ 10at% ou une couche insérée de 20 nm d'AlGaN avec Al% ~ 20% a été déposée après la couche de GaN uniformément dopée en Si de type n. Pour l'échantillon S2, 20 périodes de plans Si dopé δ chacune suivies de 50 nm de GaN nominalement non dopé avec une épaisseur totale de 1 μm au lieu d'une couche de GaN uniformément dopé au Si ont été développées sur le tampon. Après celles-ci, sur chaque échantillon de S1-S4, 6 périodes de QW InGaN/GaN ont été cultivées à 800 °C, dans lesquelles la composition en indium est d'environ 22,0 % at. L'épaisseur moyenne du puits/barrière a été estimée à 2,4 nm/10 nm. Après cela, des couches de GaN de type p dopées au Mg à 220 nm ont été cultivées à 1020 °C. Pour les tests de spectres PL, un système Zolix-750 PL avec un laser pulsé de 10 mW, 377 nm a été utilisé comme source de lumière d'excitation, et un ANDOR Newton CCD avec une résolution de 0,09 nm a été utilisé comme photodétecteur. Dans les mesures TRPL, les désintégrations de la PL ont été enregistrées par un système de comptage de photons uniques en corrélation temporelle entre 10 et 300 K.
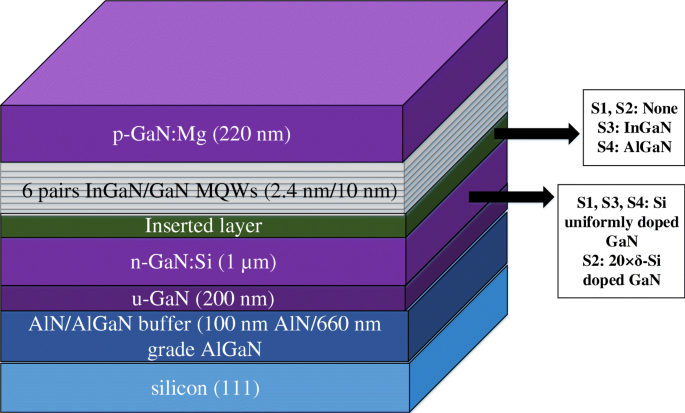
Structures des échantillons de LED MQW cultivés sur des substrats de Si. S1, S3 et S4 contiennent une couche de GaN de type n de 1 μm de Si uniformément dopée. S3 contient une couche insérée d'InGaN de 20 nm. S4 contient une couche insérée d'AlGaN de 20 nm. S2 contient 20 périodes de plans dopés Si-δ chacun suivis de 50 nm de GaN nominalement non dopé avec une épaisseur totale de 1 μm au lieu d'une couche de GaN de type n uniformément dopée en Si
Résultats et discussion
La vue d'ensemble des propriétés SSPL pour chaque échantillon MQW testé à 10 K est illustrée à la Fig. 2. Comme on le voit dans l'encart, le MQW d'origine sur Si-structuré S1 présente des pics d'émission autour de 500-650 nm avec une oscillation de Fabry-Perot. Les spectres PL pour les quatre échantillons ont le même caractère. Ce phénomène est couramment observé dans les LED à base de GaN cultivées sur des substrats Si [28,29,30], car l'interface tampon/Si a une grande réflectance, de sorte qu'une fraction descendante remarquable de l'intensité PL des MQW est réfléchie et interfère avec le flux directement ascendant fraction. Ces pics d'oscillation peuvent être simplement décrits comme des signaux PL gaussiens multipliés par l'élément d'oscillation (1 + Acos (4πnd /λ )) (représentée par la courbe rouge dans l'insert de la Fig. 1), dans laquelle A représente la force d'oscillation, n est l'indice de réfraction moyen du film MQW, d est l'épaisseur totale du film MQW, et λ est la longueur d'onde PL. Selon le modèle ci-dessus, le pic PL gaussien d'origine peut être ajusté et extrait des pics d'oscillation complexes (illustrés par la courbe bleue dans l'insert de la figure 1). Le résultat SSPL s'est avéré que S1 a un pic PL vert pointu à 531 nm, selon l'énergie de bande interdite du cristal InGaN avec In% ~ 22at%. À titre de comparaison, S2 avec une couche de GaN de type n dopé Si δ a un pic PL remarquablement décalé vers le rouge à 579 nm, S3 avec une couche insérée d'InGaN a un pic PL légèrement décalé vers le bleu à 517 nm, et S4 avec une couche insérée AlGaN a un PL légèrement décalé vers le rouge pic à 545 nm. Considérant que la couche insérée en AlGaN joue le rôle de relâchement de la contrainte de traction juste familière avec la fonction de dopage δ du Si, alors que la couche insérée en InGaN aggrave la contrainte de traction, ces résultats indiquent que la contrainte de traction sur le substrat conduira au décalage vers le bleu de la position MQW PL ou l'élargissement de la bande interdite moyenne du puits InGaN. L'effet de relâchement de contrainte de la couche de GaN dopé Si δ est beaucoup plus fort que celui de l'introduction de la couche insérée.
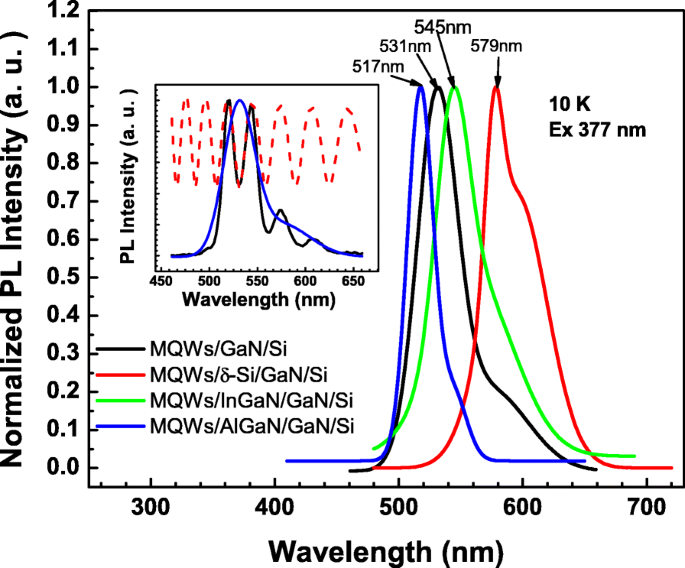
Vue d'ensemble de SSPL pour S1-S4 excité par un laser 377 nm à 10 K. Les signaux PL d'origine contiennent une oscillation de Fabry-Perot qui est représentée par la courbe noire dans l'insert (S1 à titre d'exemple). L'élément d'oscillation (courbe en tirets rouges) et le pic PL gaussien (courbe bleue) sont divisés en ajustant les signaux d'origine. Toutes les données PL pour S1-S4 sont traitées par la même méthode, puis, le PL gaussien divisé est montré dans la figure
Pour comprendre la nature de la recombinaison dans les MQW, il est essentiel de tester leurs propriétés de désintégration PL car les durées de vie PL liées aux taux de recombinaison radiative/non radiative peuvent être directement extraites des courbes de désintégration. Ici, les décroissances PL ont été mesurées en fixant la longueur d'onde détectée à des valeurs maximales de S1-S4, et les mesures ont été effectuées à différentes températures allant de 10 à 300 K. La figure 3 montre trois courbes de décroissance PL typiques pour S1 testé à 10, 100 , et 300 K. On constate que les désintégrations de PL pour tous les S1-S4 ont tendance à varier avec la température. Ce phénomène reflète les dépendances à la température des taux de recombinaison radiative et des taux de recombinaison non radiative dans les échantillons. La fonction de décroissance exponentielle suivante a été utilisée pour ajuster chaque courbe de décroissance :
$$ I(t)={I}_0{e}^{-t/\tau } $$ (1)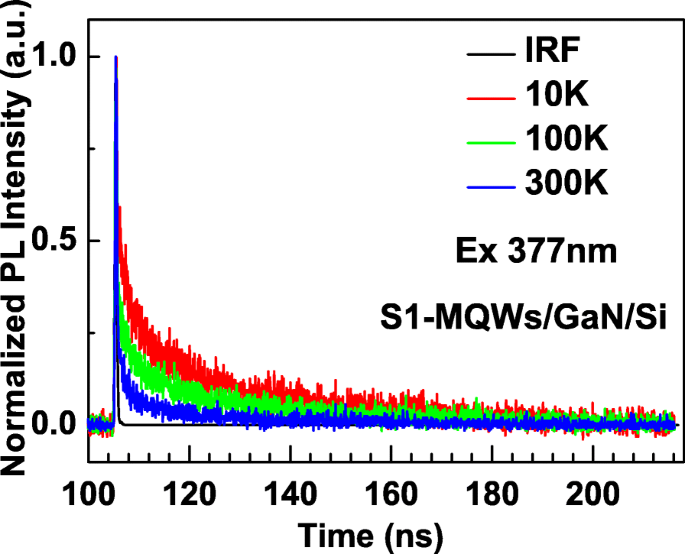
Courbes de décroissance PL pour S1 excité par un laser pulsé à 377 nm à 10 K, 100 K et 300 K
où je 0 représente l'intensité PL à t = 0 et τ représente la durée de vie du PL. Il convient de noter que toutes les courbes de décroissance ne peuvent pas être parfaitement ajustées par la fonction de décroissance exponentielle ci-dessus. Cela a été largement discuté par plusieurs groupes [31,32,33,34]. Une hypothèse raisonnable était qu'il existe plusieurs centres de recombinaison dans le système. Parfois, une fonction de décroissance multi-exponentielle a été utilisée pour ajuster les courbes. Ici, pour éviter d'introduire trop d'hypothèses difficiles à vérifier enfin, ou de faire en sorte que l'analyse ne reflète de manière incorrecte que les parties mineures de l'ensemble des propriétés du PL, nous avons utilisé le modèle le plus simple pour extraire une durée de vie moyenne du PL pour chaque échantillon, ce qui peut refléter les propriétés dynamiques globales du PL. Les durées de vie obtenues pour S1-S4 ont été rassemblées sur la figure 4a. Pour connecter les résultats dynamiques PL à la probabilité de recombinaison, le taux de recombinaison k a été défini comme k = 1/τ . Taches de k en fonction de la température pour S1–S4 sont également illustrés à la Fig. 4b. Les résultats montrent clairement deux types différents d'évolution de k avec la température que les taux de recombinaison pour les échantillons libérés de la contrainte de traction S2 et S4 sont inférieurs à celui de l'échantillon d'origine S1 ou de l'échantillon aggravé par la contrainte de traction S3 sur toute la plage de températures et augmentent plus sévèrement avec l'augmentation de la température. Notez que k = k r + k nr , dans laquelle k r représente le taux de recombinaison radiative et k nr représente le taux de recombinaison non radiative. Il est prévu que k nr augmente lorsque la température augmente et domine k à température ambiante, car il s'agit toujours de processus d'échange d'énergie avec la chaleur [35]. Ainsi, le k les résultats à haute température de la Fig. 4b montrent que les processus de libération de contrainte tels que le dopage Si δ et l'insertion d'AlGaN ont une influence positive sur la suppression de la recombinaison non radiative dans les MQW tout en réduisant les défauts de dislocation ou les fissures qui ont une influence majeure sur k nr . Mais k r devient non négligeable à basse température. Par conséquent, des informations supplémentaires et une analyse plus approfondie sont nécessaires pour expliquer le comportement de k côté basse température.

un Durées de vie PL en fonction de la température pour S1–S4. La longueur d'onde détectée est conservée à chaque position de pic conformément aux résultats SSPL de la figure 2. b Taux de recombinaison correspondants pour S1-S4, qui sont obtenus par k = 1/τ
Par conséquent, pour diviser k r et k nr de chaque k valeur, les spectres SSPL sur diverses conditions de température pour chaque échantillon ont été mesurés. Ensuite, l'intensité de chaque pic PL correspondant à leurs longueurs d'onde détectées sur les tests TRPL précédents a été enregistrée comme I (T ). Après cela, l'efficacité relative du PL a été définie comme η = Je (T )/Je 0 , dans laquelle Je 0 représente l'intensité PL à 0 K. Les efficacités PL obtenues pour S1-S4 ont été rassemblées sur la figure 5a. On peut constater que les rendements PL pour S2 et S4 sont tous deux d'environ 17 %, ce qui est 7 fois supérieur à celui de S1. Il est connu que seule la recombinaison radiative contribue à l'intensité PL; par conséquent, cette efficacité PL relative reflète le rapport entre le taux de recombinaison radiative et le taux de recombinaison total :
$$ \eta ={k}_r/\left({k}_r+{k}_{nr}\right)={k}_r/k $$ (2)
un Efficacité relative de PL par rapport à la température pour S1-S4. La longueur d'onde détectée est conservée à chaque position de pic conformément aux résultats SSPL de la figure 2. b Taux de recombinaison total, taux de recombinaison radiative et taux de recombinaison non radiative en fonction de la température pour S1
Ainsi, il est capable de résoudre k r = kη et k nr = k (1 − η ) à partir des résultats TRPL combinés avec η . Le calcul respectif pour k r et k nr de S2 a été montré dans la Fig. 5b à titre d'exemple. Les résultats se sont avérés que même pour S2 avec une modification de dopage Si δ, le taux de recombinaison non radiative est supérieur au taux de recombinaison radiative jusqu'à atteindre une température très basse de 50 K. Cela explique la raison pour laquelle k continue d'augmenter lorsque la température augmente car elle est dominante dans k nr . Cela indique également la forte demande d'amélioration supplémentaire de la qualité cristalline pour les structures MQW sur Si. Le taux de recombinaison radiative k r a été trouvé en déclin monotone avec la température croissante, ce qui n'est pas en accord avec les propriétés typiques de PL provenant de la recombinaison de paires électron-trou libres que k r est exempt de température. Cependant, il est raisonnable que le processus PL soit dominant dans la localisation des excitons. Les excitons ont tendance à se délocaliser dans une plage de températures plus élevée ; en conséquence, l'augmentation de la température conduira à la baisse du taux de localisation [32]. k nr et k r en fonction de la température pour S1-S4 ont été résumés dans les Fig. 6a, b, respectivement. Comme indiqué, les résultats de k nr à 300 K pour S2 et S4 sont 2,5 × 10 −2 s −1 et 2,8 × 10 −2 s −1 , respectivement, qui sont inférieurs à ceux de S1 (3,6 ×10 −2 s −1 ) et S4 (4,7 ×10 −2 s −1 ). Ceux-ci vérifient en outre que les processus de libération de contrainte suppriment la formation de dislocations et de fissures dans les MQW, diminuant par conséquent les densités des centres de recombinaison non radiatifs. Cet effet de suppression devient plus sensible lorsque la température baisse. Le k obtenu r les résultats sont plus compliqués. Comme indiqué, k r pour S1 et S3 baisse beaucoup plus sévèrement que pour S2 et S4 suite à l'augmentation de la température. En conséquence, obtenu k r à 300 K pour S2 (5,7 × 10 −3 s −1 ) et S4 (5,8 ×10 −3 s −1 ) sont beaucoup plus élevés que pour S1 (9×10 −4 s −1 ) et S3 (7 ×10 −4 s −1 ). Il est raisonnable d'attribuer ce phénomène aux processus de libération de contrainte :selon la discussion ci-dessus, les processus radiatifs dans ces échantillons MQW sont principalement liés à la recombinaison d'excitons dans des états localisés. Ici, k r est principalement déterminé par le taux de localisation des excitons k loc . Le déclin dramatique de k loc avec une température croissante indique que la profondeur moyenne des états localisés est relativement faible dans le système, ce qui rend l'exciton facile à délocaliser à haute température. En d'autres termes, les profondeurs moyennes des états localisés dans les échantillons avec relâchement de déformation comme S1 et S3 sont plus petites que celles sans relâchement de déformation. Sur la base des travaux précédents [36], les centres de recombinaison radiative localisés dans les MQW InGaN/GaN sont souvent offerts par des défauts structuraux dans les couches de puits d'InGaN, comme des variations d'épaisseur de puits et des amas riches en indium, dans lesquels les variations d'épaisseur de puits offrent des états peu profonds ainsi que les amas riches en indium offrent des états avec des profondeurs beaucoup plus profondes [33]. Ici, le résultat de k r indique qu'une forte contrainte de traction sur les interfaces MQW dirigée par le substrat Si et le GaN dopé Si peut améliorer la formation de défauts structuraux radiatifs peu profonds, de sorte que la profondeur des états localisés pour S1 et S3 est plus petite et que les variations d'épaisseur sont dominantes dans les processus de localisation des excitons . Pour S2 et S4, les variations d'épaisseur de puits sont supprimées, de sorte que les processus de localisation des excitons sont dominants dans les états profonds à l'intérieur des puits InGaN, présentant des profondeurs moyennes d'états localisés beaucoup plus grandes et des k plus stables. r contre la température. Par conséquent, les échantillons S1 et S3 présentent un k plus élevé r que S2 et S4 du côté des basses températures où l'effet de délocalisation des excitons est faible, mais beaucoup plus petit k r à température ambiante.

un Taux de recombinaison non radiative en fonction de la température pour S1-S4. b Taux de recombinaison radiative en fonction de la température pour S1–S4
Conclusions
En résumé, des spectres SSPL et TRPL à température variable ont été étudiés pour différents MQW InGaN/GaN sur des structures Si avec ou sans traitements de relâchement des contraintes de traction. Il a été constaté que l'échantillon avec une couche de GaN à dopage Si δ ou une couche insérée d'AlGaN avait un taux de recombinaison plus faible et une efficacité PL plus élevée (jusqu'à 17%) que l'échantillon ordinaire (2,5%) ou l'échantillon avec une couche insérée d'InGaN (1,6%). Une analyse plus approfondie a clarifié que les taux de recombinaison plus faibles étaient principalement dus à des taux de recombinaison non radiative dominants plus faibles (2,5 × 10 −2 s −1 pour l'échantillon de dopage , 3,6 × 10 −2 s −1 pour l'échantillon inséré en AlGaN par rapport à 3,6 × 10 −2 s −1 pour un échantillon régulier et 4,7 × 10 −2 s −1 pour l'échantillon inséré en InGaN), qui étaient attribuables à la suppression de la formation de dislocations ou de fissures. Outre des taux de recombinaison non radiative plus faibles, les meilleures performances PL étaient également dues aux taux de recombinaison radiative qui étaient plus stables et plus élevés à température ambiante (5,7 ×10 −3 s −1 pour l'échantillon de dopage , 5,8 ×10 −3 s −1 pour l'échantillon inséré en AlGaN par rapport à 9 × 10 −4 s −1 pour un échantillon régulier et 7 × 10 −4 s −1 pour l'échantillon inséré InGaN). Ils étaient également attribuables à la suppression des variations d'épaisseur de puits sur les interfaces MQW, laissant les centres de localisation radiative profonds à l'intérieur des couches d'InGaN dominer le processus de recombinaison radiative. Les résultats ci-dessus ont montré une image claire des processus de recombinaison des dispositifs LED InGaN/GaN MQW sur des substrats de silicium, ce qui pourrait guider la fabrication des dispositifs à l'avenir.
Abréviations
- IQE :
-
Efficacité quantique interne
- LD :
-
Diode laser
- LED :
-
Diode électroluminescente
- MQW :
-
Puits quantique multiple
- PL :
-
Photoluminescence
- SSPL :
-
Photoluminescence en régime permanent
- TRPL :
-
Photoluminescence résolue en temps
Nanomatériaux
- Le transport quantique devient balistique
- Construire des qubits à un seul atome au microscope
- Nanosilicium pour produire de l'hydrogène
- Nano revêtement pour plusieurs couleurs
- Nano graphème, mémoire transparente flexible à base de silicium
- Le réarrangement atomique de plusieurs puits quantiques à base de GaN dans du gaz mixte H2/NH3 pour améliorer les propriétés structurelles et optiques
- Émission multicolore de la structure nanopyramide quasi-cristalline photonique à base de GaN ultraviolet avec plusieurs puits quantiques semipolaires InxGa1−xN/GaN
- Usure tribochimique du silicium sans oxyde en fonction de la vitesse de glissement
- Points quantiques de bismuth dans des puits quantiques recuits GaAsBi/AlAs



