Analyse de la distribution Bi dans le GaAsBi épitaxié par HAADF-STEM corrigé par aberration
Résumé
La teneur en Bi dans GaAs/GaAs1 − x Bi x Les hétérostructures /GaAs cultivées par épitaxie par faisceau moléculaire à une température de substrat proche de 340 °C sont étudiées par des techniques de champ sombre annulaire à grand angle et corrigées des aberrations. L'analyse à faible grossissement d'images de microscopie électronique à transmission à champ sombre annulaire à angle élevé, corroborée par l'analyse EDX, a révélé des couches planes sans défaut et une distribution Bi non homogène aux interfaces et au sein de la couche GaAsBi. À fort grossissement, l'analyse qHAADF a confirmé la distribution inhomogène et la ségrégation du Bi à l'interface GaAsBi/GaAs à faible flux de Bi et une forme d'haltère déformée dans les zones à plus forte teneur en Bi. À un flux de Bi plus élevé, la taille de la collecte de Bi augmente, conduisant à des particules riches en Bi à peu près équiaxiales facettées le long du mélange de zinc {111} et uniformément dispersées autour de la matrice et des interfaces. L'analyse FFT vérifie la coexistence de deux phases dans certains amas :un Bi rhomboédrique pur (rh-Bi) entouré d'un blende de zinc GaAs1 − x Bi x matrice. Les clusters peuvent affecter la relaxation du réseau local et conduire à un système GaAsBi/GaAs partiellement détendu, en bon accord avec l'analyse XRD.
Contexte
De nos jours, les semi-conducteurs à base de GaAsBi suscitent l'intérêt en tant que dispositifs stables en température et dans l'infrarouge moyen [1]. L'ajout d'une petite quantité de Bi dans le réseau de GaAs conduit à une réduction importante de la bande interdite, étant l'un des effets optoélectroniques les plus intéressants [2, 3]. Cependant, l'incorporation même d'une petite quantité de Bi dans GaAs est difficile en raison de la faible énergie de liaison Ga-Bi, du grand écart de miscibilité et de la grande différence dans la constante de réseau entre GaBi et GaAs. Par conséquent, GaAsBi doit être cultivé dans le cadre d'un processus dynamique hors équilibre pour une incorporation efficace du Bi. Bien que même s'il est synthétisé avec succès, la distribution de Bi est parfois non uniforme, augmentant la densité de centres de recombinaison non radiatifs et affectant donc leur efficacité dans le fonctionnement du laser. La grande taille et la faible électronégativité du Bi ont tendance à produire une séparation de phase [4], des gouttelettes de surface [5, 6], un ordre atomique [7,8,9], des gouttelettes liquides à l'échelle nanométrique [10] ou des amas de Bi pendant la croissance épitaxiale. La présence d'amas de Bi a déjà été détectée par Ciatto et al. grâce à une combinaison de techniques de spectroscopie d'absorption des rayons X (XAS), de microscopie à force atomique et de diffraction des rayons X (XRD) [11]. Ensuite, plusieurs auteurs ont signalé la présence d'agrégats de Bi dans des échantillons de GaAsBi recuits en utilisant différentes techniques de microscopie électronique à transmission [4, 12, 13]. De plus, Kunzer et al. [14] ont confirmé par résonance de spin électronique (ESR) qu'environ 10% du Bi incorporé avait occupé les sites Ga dans les couches GaAsBi. Par conséquent, la compréhension et le contrôle de l'incorporation de Bi et de la formation de défauts sont essentiels pour l'application réussie de GaAsBi aux dispositifs. Il est à noter que le développement de nouveaux matériaux à base de Bi est lié à l'avancement des outils de caractérisation. En ce sens, les techniques de microscopie électronique à transmission à champ sombre annulaire à angle élevé (HAADF-STEM) dans les microscopes à correction d'aberration jouent un rôle important dans l'obtention d'informations à un niveau inférieur à l'angström [15, 16]. Dans cette technique, l'intensité dans les images est à peu près proportionnelle au numéro atomique moyen (Z ) dans la colonne atomique projetée, de sorte qu'il peut être appliqué avec succès dans les hétérostructures diluées Ga(AsBi) en raison de la grande différence de numéro atomique de Bi par rapport à As et Ga. De plus, des caractéristiques lumineuses dans les images HAADF, contrairement à la la microscopie électronique à transmission à haute résolution (HRTEM), peut être associée à des colonnes atomiques dans un cristal aligné en raison de l'absence d'inversions de contraste et de délocalisation. De plus, les images HAADF corrigées des aberrations des échantillons de GaAsBi montrent une faible dépendance à l'épaisseur de l'échantillon et une dépendance presque linéaire à la composition As/Bi [12]. De plus, en appliquant l'algorithme d'analyse d'image quantitative HAADF (qHAADF), développé par Molina et al. [17], il est possible de corréler efficacement l'intensité du HAADF et la composition de la colonne atomique dans les matériaux semi-conducteurs ternaires III-V [12, 16, 18] et par conséquent dans les composés GaAsBi. De plus, les images HAADF-STEM haute résolution offrent des informations sur la qualité cristalline [19,20,21,22].
Dans ce travail, nous étudions par imagerie HAADF-STEM corrigée des aberrations et rayons X complémentaires à dispersion d'énergie (EDX) la distribution Bi dans GaAs/GaAs1 − x Bi x Hétérostructures /GaAs cultivées par épitaxie par jets moléculaires (MBE) à une température de substrat proche de 340 °C. Nous avons également étudié l'effet du rassemblement de Bi aux nano et micro-échelles. Pour ce faire, nous avons utilisé l'approche qHAADF, l'analyse par transformée rapide de Fourier (FFT) d'images haute résolution et les techniques XRD.
Méthodes
Nous étudions une série de deux échantillons constitués de GaAs/GaAs1 − x Bi x Hétérostructures /GaAs cultivées par MBE source solide sur 2″ n + GaAs :plaquettes de Si (001) avec un flux de Bi différent donné par les températures de cellule de Bi S1 (460 °C) et S2 (505 °C). Le système utilisé était une machine VG V80 MBE avec une pression de fond moyenne au repos de ~ 5 × 10 − 10 mbar. Les structures se composent nominalement d'un tampon GaAs de 130 nm, d'une couche de GaAsBi de 130 nm, d'une couche d'espacement de GaAs de 5 nm, puis d'un capuchon de GaAs de 130 nm. Avant la croissance, le substrat a été dégazé à 400 °C pendant 20 min, puis l'oxyde de surface a été éliminé à 600 °C. Le tampon GaAs et le capuchon ont été cultivés à ~ 580 °C sous un As2 tandis que la couche de GaAsBi et la couche d'espacement de GaAs ont été développées à ~ 340 °C sous un As4 presque stoechiométrique flux. La couche de GaAsBi a donc été recuite in situ à ~ 580 °C pendant ~ 20 min pendant la croissance de la calotte de GaAs. Dans ces conditions de croissance, aucune gouttelette métallique en surface n'a été observée. Les températures du substrat ont été estimées à l'aide de la thermométrie optique, les résultats étant calibrés par rapport aux transitions de reconstruction de surface à des températures connues. Avant la croissance de GaAsBi, la surface de l'échantillon a été exposée à un flux de Bi pendant 20 s ; le but de cette étape était d'établir une couche superficielle de Bi et d'améliorer l'incorporation de Bi au début de la croissance de GaAsBi.
Les spécimens pour HAADF-STEM ont été préparés en coupe transversale par broyage mécanique et Ar + le broyage ionique à l'aide d'un système de polissage ionique de précision (PIPS), avec des inclinaisons de faisceau de − 3° et + 4° et une énergie de faisceau comprise entre 2,8 et 3,0 kV. À l'étape de broyage finale, l'énergie ionique a été réduite à 1,5 kV pour améliorer la qualité de la surface. Les échantillons avant d'être étudiés ont été nettoyés au plasma pour réduire l'effet du dépôt du faisceau d'électrons sur la surface de l'échantillon [23]. Des images HAADF-STEM, un spectre de perte d'énergie électronique sans perte (EELS) et des balayages de lignes de spectre de rayons X à dispersion d'énergie ont été réalisés à 200 kV, à l'aide d'un Titan 3 Thémis à 60-300 kV. Le Titan 3 Themis est équipé d'un canon à émission de champ froid (FEG), d'un correcteur de sonde Cs et d'un monochromateur d'électrons, permettant une résolution atomique en imagerie HAADF. Ce microscope comprend également un détecteur Super-X quad EDX pour l'analyse élémentaire, fournissant simultanément des informations sur la position et la composition des atomes. Les images d'électrons secondaires (SE) pour l'étude de la topographie de l'échantillon MET ont été réalisées à l'aide d'un microscope FEI NOVA NANOSEM 450 à 2 kV.
La raie Bi-M à 2,42 keV a été utilisée pour la détermination quantitative de la composition en Bi via le logiciel Bruker Espirit. L'épaisseur de l'échantillon a été déterminée à partir de l'analyse du signal EELS à perte nulle résolue spatialement, en utilisant le logiciel Digital Micrograph (GATAN™) [23]. La distribution Bi colonne par colonne a été étudiée en utilisant le logiciel qHAADF disponible pour fonctionner sur le Digital Micrograph. Ce logiciel permet de mesurer et de cartographier l'intensité intégrée de zones sélectionnées autour des colonnes atomiques en détectant des pics d'intensité dans l'image HAADF-STEM [17]. Les spectres XRD ω-2θ (0 0 4) ont été mesurés avec un diffractomètre à rayons X Bruker D8 Discover utilisant Cu-Kα1 radiation. Les scans ont été simulés à l'aide du logiciel Bede Rads Mercury.
Résultats et discussion
La figure 1 montre des images HAADF-STEM à faible grossissement prises sur l'axe de la zone [110] des échantillons S1 (a) et S2 (b), ainsi que les profils d'intensité corrigés par gradient d'épaisseur pris le long de la direction [001] à partir des régions marquées dans les images HAADF-STEM (rectangles verts). Aucune dislocation de filetage ou défaut d'empilement n'a été détecté dans les régions étudiées des deux échantillons. En HAADF, l'intensité obtenue est proportionnelle au numéro atomique moyen. Ainsi, pour une épaisseur d'échantillon constante, le contraste le plus brillant de l'image est lié à une teneur en Bi plus élevée (Z Bi = 83, Z Ga = 31 et Z Comme = 33). Ceci rend possible l'étude de la distribution du Bi dans les hétérostructures GaAsBi/GaAs. Comme on peut l'observer sur la figure 1a, aucune variation de contraste nette n'est détectée dans la couche de GaAsBi de l'échantillon S1 - avec une teneur en Bi plus faible - ne montrant aucune preuve évidente de regroupement, même pas dans d'autres zones avec une épaisseur d'échantillon plus élevée. Cependant, des clusters de Bi et d'As ont été rapportés dans la littérature, même pour des échantillons de GaAsBi avec une teneur en Bi aussi faible que 1,44 %, bien que cultivés à des températures plus basses [11]. En ce qui concerne l'échantillon S2, avec une teneur en Bi plus élevée, la figure 1b représente certaines zones avec un contraste plus brillant dans la couche avec une taille et une distribution relativement homogènes. Ces régions, régulièrement réparties le long de la couche et des interfaces de GaAsBi, peuvent être directement interprétées comme des amas contenant du Bi en raison de leur intensité HAADF plus élevée. Pour une meilleure visualisation, l'image filtrée passe-bas correspondante est représentée en encart dans la même image, où la couleur jaune correspond aux zones à contenu Bi plus élevé et le noir aux zones plus basses (échelle de température). La formation d'agrégats de Bi dans GaAsBi sans provoquer de défauts structurels a déjà été rapportée par d'autres auteurs [7, 24, 25]. L'intégration de Bi (1,6 fois le volume atomique d'As) dans la matrice de GaAs peut provoquer une augmentation de l'énergie de substitution à cause de la déformation, réduisant la solubilité des atomes d'As et permettant le rassemblement de ceux de Bi. Une étude de l'échantillon à l'aide d'un microscope électronique à balayage par canon à émission de champ (FEG-SEM) a été réalisée pour s'assurer que les clusters Bi sont intégrés dans la couche. À cette fin, des images topographiques d'électrons secondaires acquises à basse tension (non présentées ici) ont été comparées à celles de STEM prises dans la même zone.

un Images transversales HAADF-STEM de l'échantillon S1 montrant les interfaces GaAs/GaAsBi/GaAs. b Image en coupe HAADF-STEM de l'échantillon S2, dans la couche GaAsBi, des points lumineux répartis le long de la couche GaAsBi liés aux zones riches en Bi sont observés. Le détail utilisant l'échelle de couleur de température d'une zone après application d'un filtre passe-bas est inclus en encart dans la même image pour une meilleure visualisation. c Profils d'intensité corrigés par gradient d'épaisseur pris le long de la direction [001] des régions marquées par des rectangles verts dans les images HAADF-STEM, ligne bleue pour l'échantillon S1 et ligne noire pour l'échantillon S2, montrant un comportement légèrement différent aux interfaces
Afin d'obtenir de plus amples informations sur la distribution Bi dans les échantillons, les profils d'intensité le long de la direction de croissance avec un gradient d'épaisseur corrigé sont présentés sur la figure 1c. Les profils, tirés des images HAADF-STEM de la Fig. 1a, b, indiquent un comportement similaire dans les deux échantillons :interfaces à peu près abruptes, couches de GaAsBi de longueur similaire (~ 140 nm). En ce qui concerne l'interface GaAsBi/GaAs, l'intensité HAADF chute de sa valeur maximale à ~ 0 sur environ 10 nm (voir le rectangle gris en pointillés dans le profil), suggérant une certaine incorporation de Bi dans toute la couche de couverture de GaAs, même sans flux de Bi. Les profils présentent également des informations sur le temps d'équilibrage. Comme on peut le constater à partir des profils, dans l'échantillon à plus faible teneur en Bi (S1), l'interface GaAs/GaAsBi est plus abrupte que celle dans l'échantillon à plus forte teneur en Bi (S2). Ceci peut s'expliquer par les coefficients d'incorporation Bi différents des deux échantillons. S1, bien que cultivé à la même température que S2, a une teneur en Bi beaucoup plus faible. S1 est donc probablement cultivé dans des conditions cinétiquement limitées avec une incorporation de Bi proche de l'unité [26], ce qui signifie que la couche de surface de Bi s'équilibrera sur un laps de temps inférieur à la durée de vie de surface d'un atome de Bi à cette température. S2, en revanche, a probablement un coefficient d'incorporation de Bi plus faible [27]. Dans ce cas, la couche superficielle de Bi prendrait plus que la durée de vie de surface d'un atome de Bi pour s'équilibrer, ce qui entraînerait une stabilisation plus lente de l'incorporation de Bi.
Pour confirmer la corrélation faite entre les profils d'intensité HAADF-STEM et la distribution Bi dans l'hétérostructure, des cartes de composition STEM-EDX Bi des échantillons ont été simultanément prises. Ils sont illustrés à la Fig. 2 pour un échantillon à faible (a) et à fort (b) flux de Bi. Les profils de composition Bi correspondants le long de la direction de croissance, déterminés en intégrant les spectres EDX ponctuels d'une zone d'environ 130 nm, sont représentés sur la figure 2c sous forme de lignes bleues et noires respectivement. Ces profils de composition présentent la même tendance détectée dans les interfaces GaAs/GaAsBi/GaAs par analyse HAADF à faible grossissement. La fraction atomique moyenne de Bi dans les couches de GaAsBi a été quantifiée à partir des spectres EDX correspondants étant respectivement de 1,2 ± 0,4% et 5,3 ± 0,4% dans les échantillons S1 et S2, montrant une distribution non homogène de Bi dans la couche de GaAsBi dans les deux échantillons. .

Cartes élémentaires STEM/EDX représentant la distribution Bi dans les échantillons S1 (a ) et S2 (b ). Les détails des cartes élémentaires Bi, Ga et As correspondant à l'amas marqué d'un rectangle blanc sur la figure 1b révèlent une baisse des signaux As et Ga là où il y a une région Bi élevée. c Bi profils de contenu selon la direction [001] extraits après intégration d'une zone d'environ 130 nm à partir de la carte EDX des échantillons S1 (ligne bleue) et S2 (ligne noire). Des caractéristiques similaires ont été observées dans les profils d'intensité à faible grossissement illustrés à la figure 1c
La présence d'amas Bi serait due à un effet d'encombrement stérique. Dans ce cas, la tension superficielle peut augmenter en raison de la plus grande taille atomique des atomes de Bi, donc pour réduire la contrainte dans la structure, les atomes de Bi pourraient bloquer l'incorporation de Ga et par conséquent provoquer des lacunes de Ga dans le réseau. Des cartes de composition Ga et As de l'amas entouré d'un carré blanc sur la figure 2b sont incluses pour montrer comment les deux signaux tombent là où il y a un signal Bi élevé. Cela suggère que, dans ce cluster particulier, Bi pourrait occuper à la fois les sous-réseaux du groupe III et du groupe V. Cela prouve également que les grappes ne sont pas superficielles formées lors de la préparation des échantillons MET.
Pour mener à bien une étude approfondie de la distribution Bi au niveau atomique, des images HAADF-STEM à fort grossissement et corrigées des aberrations ont été prises dans la projection [110]. Dans cet alliage semi-conducteur III-V, les deux pics d'intensité maximale d'un haltère correspondent aux colonnes atomiques des groupes III et V. Pour corréler correctement l'intensité dans les colonnes atomiques avec leur composition, le niveau de fond a été supprimé des images expérimentales HAADF-STEM. Ensuite, une localisation automatique des pics d'intensité a été réalisée, et les zones d'intégration autour des colonnes atomiques du groupe V sont soigneusement sélectionnées. Les intensités intégrées sont mesurées et cartographiées pour chaque haltère à l'aide de l'approche qHAADF. La procédure pour quantifier la teneur en Bi était similaire à celle publiée dans la Réf. [28]. Dans ce travail, les quotients d'intensité intégrés de chaque haltère (R ) a été calculé comme un rapport entre l'intensité intégrée dans les colonnes du groupe V (I As − Bi ) dans toute l'image et l'intensité moyenne intégrée dans les colonnes du groupe V de la couche GaAs (I Comme ), en tant que R = (Je (As − Bi) )/Je Comme .
La figure 3a montre une image HAADF-STEM à fort grossissement de l'interface GaAs/GaAsBi prise à partir de l'échantillon à faible teneur en Bi (S1). La carte d'intensité intégrée normalisée colorée de l'image HAADF est illustrée à la figure 3b. Les points de couleur allant de 1 (bleu foncé) à 1,27 (rouge) représentent le contenu Bi dans les colonnes du groupe V. Comme on peut l'observer, de petites fluctuations de R les valeurs de la valeur moyenne se trouvent dans les deux couches. Afin de comparer la dispersion des résultats obtenus, nous avons calculé le coefficient de corrélation Cv (défini comme le rapport entre l'écart type et la moyenne R valeur) dans le GaAs (substrat), la couche GaAsBi et la couche de couverture GaAs. Le Cv les valeurs étaient respectivement de 1,3, 2,6 et 2,6 %, car les fluctuations observées dans l'interface GaAsBi/GaAs sont plus élevées que celles trouvées dans le substrat GaAs pris comme référence; on peut considérer que ces variations de R les valeurs sont liées aux changements dans la composition de la colonne Bi. La cause du Cv non nul dans le substrat peut être dû à des fluctuations d'épaisseur locales, au bruit du détecteur (mesuré dans une région sans matériau à 0,6 %) ou à des hydrocarbures déposés sur l'échantillon de surface lors de la caractérisation microscopique.

un Image en coupe [110] HAADF-STEM de l'interface GaAsBi/GaAs de l'échantillon S1. Le détail d'une région non déformée dans la couche de GaAs et des haltères anion-cation déformés dans une zone riche en Bi à un grossissement plus élevé sont inclus en encart dans la même image. b Carte colorée représentant R valeurs autour des colonnes du groupe V de l'image HAADF de la figure 3a. La couleur verte correspond à la composition moyenne de Bi dans la couche de GaAsBi mesurée par EDX. Malgré la distribution homogène de Bi dans l'image HAADF-STEM, la carte d'intensité montre des zones avec une forte probabilité de nanoclustering (points rouges) et des colonnes avec une teneur relativement faible en Bi (points bleus) dans la couche GaAsBi. c Profil le long de la direction de croissance de l'ensemble du R carte d'intensité, montrant une interface GaAsBi/GaAs floue à environ 10 nm
Cette analyse qHAADF confirme une interface GaAsBi/GaAs supérieure non abrupte sur environ 10 nm perçue à faible grossissement, principalement en raison de la ségrégation de surface Bi pendant la croissance, comme cela peut être observé à partir du profil pris le long de la direction de croissance dans toute l'intensité R carte, illustrée à la Fig. 3c. De plus, des colonnes dispersées riches en Bi dans la couche GaAsBi (points rouges), ainsi que des zones à faible teneur en Bi (points bleus) dans la couche GaAsBi, sont également détectées avec ce logiciel, confirmant les fluctuations de la teneur en Bi dans la couche GaAsBi . La présence de colonnes riches en Bi semble produire une distorsion distincte dans la forme de l'haltère, comme cela peut être apprécié dans l'encart à un grossissement plus élevé de la figure 3a. La substitution d'atomes d'As par des atomes de Bi plus gros au cours de la croissance épitaxiale aurait élargi localement le réseau de la matrice, provoquant une distorsion de la forme de l'haltère alors que la structure est maintenue.
Les techniques HAADF-STEM permettent également une analyse structurelle et compositionnelle des grappes détectées à faible grossissement dans l'échantillon S2. Ces amas, distribués de manière presque homogène, occupent environ 20 à 30 % de la surface de la couche de GaAsBi. Pour connaître la composition Bi, la forme et la taille des amas trouvés, des images HAADF-STEM corrigées des aberrations ont été prises dans la projection [110] et des cartes élémentaires EDX et des ratios de cartes d'intensité autour des colonnes du groupe V ont été réalisées. Pour identifier différentes phases cristallines, une étude de transformée de Fourier rapide (FFT) a été réalisée dans les images haute résolution dans différentes zones à l'intérieur et à proximité des amas.
La figure 4a montre une image haute résolution [110] HAADF-STEM de l'interface GaAsBi/GaAs avec un amas clair de Bi d'environ 12 nm de diamètre. Les rectangles rouges dans l'image représentent les zones où l'étude FFT a été réalisée. Il est bien connu que le filtrage passe-bas non seulement réduit la quantité de bruit dans les données, mais supprime également les caractéristiques périodiques observées dans l'image brute, en accentuant les bords du cluster Bi. L'image HAADF-STEM filtrée, suivant la procédure décrite par Werner et al. [29], est illustré à la Fig. 4b. Comme on peut l'apprécier, les facettes {111} et (001) dans la zone la plus lumineuse sont clairement observables. Cependant, la distribution d'intensité suggère la présence de deux volumes de composition différents dans la particule :un riche en Bi de forme trapézoïdale entouré d'une zone moins riche en Bi. Une forme de cluster similaire a été observée pour Wood et al. dans un GaAs1 − x à cinq périodes Bi x /GaAs1 − y Bi y structure [10].
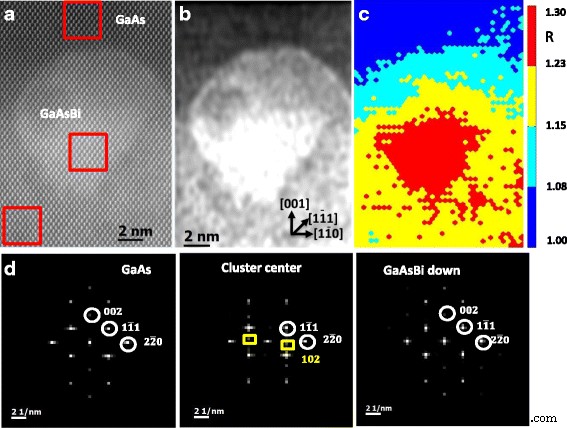
un Image transversale [110] HAADF-STEM de l'interface GaAsBi/GaAs de l'échantillon S2, capturant un amas de Bi d'environ 12 nm, à côté de l'interface GaAsBi/GaAs. b L'image faiblement filtrée de l'image HAADF-STEM montre deux zones de contraste différent dans la couche GaAsBi, une zone riche en Bi est facettée le long des plans {111} et (001), entourée d'une zone plus faible en Bi. c Carte colorée représentant le R valeurs autour des colonnes du groupe V représentant une distribution Bi graduée autour du cluster. d La transformation de Fourier correspondante à partir des zones sélectionnées marquées de rectangles rouges sur la figure 1a. Des spots supplémentaires correspondant aux plans {102} liés à la phase rh-Bi sont détectés dans la région d'amas au contraste le plus élevé
L'analyse qHAADF à travers l'intensité R la carte illustrée à la figure 4c représente une forme de particule à peu près équiaxiale et un gradient de concentration de Bi culminant au centre de l'amas.
Wu et al. [4] ont rapporté la présence de différentes structures cristallographiques dans les couches de GaAsBi en étudiant les micrographies HRTEM et en modélisant la formation et la transformation de phase du zinc blende riche en Bi rhomboédrique (rh-Bi) nucléé dans des plans de zinc blende {111}. En ce sens, il convient de mentionner que les points lumineux dans la FFT provenant d'images HAADF-STEM haute résolution peuvent être interprétés comme des points de diffraction provenant de plans cristallographiques. Ensuite, des taches supplémentaires dans le modèle conventionnel pour la structure de mélange de zinc de GaAs doivent être interprétées comme des phases supplémentaires. Pour étudier la présence de différentes structures cristallines dans l'amas, la figure 4d montre les FFT correspondant à trois zones différentes marquées par des carrés rouges sur la figure 1a. De droite à gauche montre une région homogène dans la couche de couverture de GaAs, la zone la plus lumineuse dans la couche de GaAsBi et une autre région avec un contraste plus faible dans la même couche de GaAsBi. Les cercles blancs indiquent la position du pic de diffraction avec les indices de Miller 002, \( 1\overline{1}1 \) et\( 2\overline{2}0 \). Comme on peut l'observer, ce n'est qu'au centre de l'amas qu'apparaissent des taches claires, marquées d'un carré jaune, liées à des plans {102} à peu près parallèles aux plans de zinc blende {220}, suggérant qu'une nouvelle phase rh-Bi s'est nucléée dans la couche de mélange de zinc GaAsBi. Les FFT décrivent également un élargissement des pics de diffraction liés aux plans {111}. Ce pic asymétrique observé peut être dû aux micro-déformations causées par le cisaillement des plans {111} entre les phases de rh-Bi et de mélange de zinc dans l'amas.
Pour une étude approfondie de la composition des amas, il convient de mentionner que lorsque les électrons traversent un spécimen transparent aux électrons avec des amas intégrés, ils transportent des informations non seulement sur l'amas, mais également sur la matrice. Ainsi, pour estimer la composition réelle des clusters, nous suivons la même procédure décrite dans la réf. [25]. Les résultats ont également souligné que les amas proches de l'interface GaAsBi/GaAs ont tendance à être de plus petite taille (12 nm) avec une teneur en Bi plus élevée (≈ 30 %), probablement en raison de la présence de Bi à la surface lorsque la couche de couverture commence à être cultivé. Cependant, la plupart des amas situés à l'intérieur des couches de GaAsBi ont une taille plus importante (16 nm), mais leur teneur en Bi est inférieure (≈ 22 %). De plus, dans la couche GaAsBi, des amas avec une teneur en Bi supérieure (35 %) et une taille plus élevée (23 nm) ont été détectés. De plus, comme cela a été mentionné précédemment, le noyau de certains clusters est constitué de rh-Bi pur.
Afin d'étudier l'état de déformation du film épitaxié, des courbes de rayons X à haute résolution ω-2θ ont été enregistrées. La figure 5 montre les (004) scans XRD des couches GaAsBi/GaAs en bleu et des ajustements simulés en orange pour les échantillons S1 (a) et S2 (b). Dans les deux échantillons, le pic d'intensité le plus pointu et le plus élevé situé à 0° seconde d'arc correspond au substrat de GaAs, tandis que le large pic d'intensité plus faible situé à des secondes d'arc négatives correspond à la couche GaAsBi contrainte. L'angle entre les pics se rapporte à la quantité de décalage de réseau entre les deux couches. L'épaulement à droite du pic de GaAs dans le spectre de S2 indique une couche de GaAs sous contrainte de traction; ceci implique une relaxation de déformation dans la couche S2 GaAsBi. Le spectre XRD de l'échantillon S1 a été bien ajusté en utilisant la fraction Bi et les épaisseurs données par les mesures EDX et HAADF. Il n'y a aucune indication de relaxation de contrainte dans le spectre XRD de l'échantillon S1. Le spectre XRD de l'échantillon S2 était plus problématique à ajuster. La figure 5b montre les données modélisées par une couche uniforme de GaAsBi de 5,8 %, telle que déterminée par l'analyse HAADF-STEM, en ignorant les amas riches en Bi, et une relaxation de la couche GaAsBi de 6 %, telle que déterminée en ajustant la courbe XRD ; cela serait raisonnable si les clusters n'étaient pas cohérents avec le reste de la matrice GaAsBi. Ce modèle ne représente pas avec précision la couche; alors que la séparation substrat-GaAsBi est suffisante pour expliquer les données, aucun pic de tension de GaAs à ~ 250° secondes d'arc n'est visible. Le pic de traction GaAs suggère qu'une relaxation s'est produite dans la couche. La relaxation d'une couche compressive réduira la constante de réseau hors plan, ce qui implique que la teneur moyenne modélisée en Bi de 5,8 % est une sous-estimation de la moyenne réelle ; ceci est cohérent avec l'observation d'amas riches en Bi dans la couche. Aucun pic correspondant à ~ 22-35% GaAsBi n'a été observé par cartographie spatiale réciproque (non montrée), ce qui suggère que les clusters peuvent ne pas être cohérents avec la matrice GaAsBi. Aucune autre modélisation du spectre S2 XRD n'a été tentée.

Données de diffraction des rayons X (lignes bleues) et ajustements simulés (lignes orange) de l'échantillon S1 (a ) et échantillon S2 (b ). Lignes pointillées verticales mettant en évidence le pic GaAs à 0° secondes d'arc et le pic du film GaAsBi situé à des secondes d'arc négatives. L'épaulement sur le pic de GaAs de droite sur la figure 5b indique une couche de couverture de GaAs sous contrainte de traction
Conclusions
Les analyses ac-HAADF-STEM offrent des informations utiles sur la structure et la composition des hétérostructures GaAs/GaAsBi/GaAs, les résultats étant en bon accord avec les investigations EDX, FFT et XRD. L'analyse d'images HAADF-STEM à faible grossissement a permis de détecter une distribution Bi inhomogène et des interfaces GaAsBi/GaAs non abruptes. À fort grossissement, l'analyse qHAADF a révélé une ségrégation claire du Bi à l'interface GaAsBi/GaAs à faible flux Bi (S1) et une forme d'haltère déformée dans les zones avec une fraction Bi plus élevée, en raison des positions As-substitution des atomes Bi dans le sous-réseau du groupe V . À un flux de Bi plus élevé (S2), la taille du rassemblement de Bi augmente, conduisant à des amas à peu près équiaxiaux uniformément dispersés autour de l'ensemble de la matrice et des interfaces. L'étude a révélé la coexistence de deux phases cristallines différentes dans les plans de cisaillement {111} des clusters étudiés rh-Bi et zinc blende, affectant la relaxation locale du réseau et conduisant à un système GaAsBi/GaAs partiellement relaxé, en bon accord avec l'analyse XRD.
Abréviations
- Ac-HAADF-STEM :
-
Microscopie électronique à transmission annulaire à champ sombre et à angle élevé avec correction d'aberrations
- EDX :
-
Rayons X à dispersion d'énergie
- anguilles :
-
Spectre de perte d'énergie électronique
- ESR :
-
Résonance de spin électronique conventionnelle
- FEG :
-
Pistolet à émission champ froid
- FFT :
-
Transformation rapide de Fourier
- HRTEM :
-
Microscopie électronique à transmission haute résolution
- IMEYMAT :
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE :
-
Epitaxie par faisceau moléculaire
- qHAADF :
-
Algorithme d'analyse d'image quantitative HAADF
- SEM :
-
Microscope électronique à balayage
- XAS :
-
Spectroscopie d'absorption des rayons X
- XRD :
-
Diffraction des rayons X
Nanomatériaux
- Analyse de forme d'onde
- Options d'analyse
- Analyse des défaillances de composants
- Analyse des défaillances de composants (suite)
- Qu'est-ce que l'analyse de réseau ?
- En savoir plus sur l'analyse du spectre
- DISTRIBUTION WEARHOUSE
- Qu'est-ce que la distribution électrique ?
- Qu'est-ce que la planification de la distribution ?



