Modification de la structure du GaN entre le réseau Nanowall, la nanocolonne et le film compact développé sur Si (111) par MBE
Résumé
Le changement de structure du réseau de nanoparois GaN, de la nanocolonne et du film compact a été obtenu avec succès sur Si (111) par épitaxie par faisceau moléculaire assistée par plasma (MBE). Comme prévu, la croissance des nanocolonnes de GaN a été observée dans des conditions riches en N sur du Si nu, et la croissance s'est déplacée vers un film compact lorsque le flux de Ga a été amélioré. Fait intéressant, si un pré-dépôt d'aluminium (Al) pendant 40 s a été effectué avant la croissance du GaN, le GaN se développe sous la forme d'un réseau de nanoparois. Les résultats montrent que l'Al pré-déposé sort sous forme de gouttelettes avec un diamètre et une hauteur typiques de ~ 80 et ~ 6,7 nm, respectivement. Un modèle de croissance pour le réseau de nanowalls est proposé et le mécanisme de croissance est discuté. GaN se développe dans la zone sans gouttelettes d'Al tandis que la croissance au-dessus des gouttelettes d'Al est entravée, ce qui entraîne la formation d'un réseau continu de nanoparois de GaN qui supprime les obstacles à la fabrication de nano-dispositifs.
Contexte
En tant que semi-conducteurs directs à large bande interdite, le GaN et les composés apparentés ont obtenu un grand succès dans les diodes électroluminescentes [1,2,3], les diodes laser [4] et les transistors à haute mobilité électronique [5, 6]. L'hétéroépitaxie d'un film de GaN sur saphir, carbure de silicium ou silicium monocristallin induit cependant une forte densité de dislocation. On pense que leurs nanostructures ont des performances supérieures en raison d'un rapport surface/volume sans dislocation, sans contrainte et grand [7, 8]. Les recherches sur les nanocolonnes et les nanofils de GaN ont été intensivement menées [9,10,11,12]. La nucléation nanocolonne de GaN se produit spontanément par le mécanisme de croissance de Volmer-Weber [13], alors que la condition riche en azote (riche en N) empêche les sites de nucléation de fusionner. Une grande attention a été portée à la fabrication d'un dispositif électrique sur les nanofils de GaN ou sur les nanocolonnes. Les nanofils de GaN ont été dispersés mécaniquement sur SiO2 Substrat /Si et contacts ohmiques formés sur les deux faces d'un nanofil individuel de manière aléatoire [14]. Dans un autre cas [15], un côté du nanofil était fixé à une platine connectée à l'électrode négative tandis qu'un autre côté était aligné à l'électrode positive au moyen d'un microscope électronique à balayage (MEB), formant un dispositif électrique pour la recherche scientifique.
Alternativement, une nanostructure spéciale, à savoir le réseau de nanoparois GaN qui est électriquement conducteur dans le plan, est prometteuse car aucun processus complexe n'est nécessaire pour la fabrication du nano-dispositif. En 2007, la croissance du réseau de nanoparois GaN a été obtenue par le groupe de Kishino en utilisant une couche de Ti modelée par lithographie par faisceau d'électrons comme masque [16]. Il y a plusieurs années, la croissance du réseau de nanoparois GaN sans aucune lithographie a été obtenue avec succès sur des substrats de saphir et de silicium [17,18,19]. L'intensité d'émission à la limite de la bande du réseau de nanoparois de GaN est similaire à celle des nanocolonnes de GaN et la luminescence jaune n'est pas évidente, ce qui indique une haute qualité du réseau de nanoparois de GaN. Différent de la nanostructure séparée telle que les nanocolonnes, le réseau de nanoparois est électriquement conducteur dans le plan [18, 20, 21] qu'il pourrait être fabriqué en nano-dispositif aussi facilement que le film [22]. Par conséquent, l'obstacle de la fabrication de dispositifs sur les nanocolonnes séparées pourrait être levé par la conduction électrique dans le plan du réseau de nanoparois. Il est crucial d'étudier le mécanisme de croissance du réseau de nanowalls. La formation spontanée induite par la dislocation d'un réseau de nanoparois est considérée comme le mécanisme de croissance du réseau de nanoparois de GaN sur c nu -saphir plan [23]. Étant donné que la formation de réseaux de nanoparois induite par la dislocation est peu contrôlée, la croissance du réseau de nanoparois sur un substrat de Si (111) avec une couche tampon d'Al [18] a été réalisée. Le mécanisme de croissance de la nanoparoi sur Si (111) est significativement différent de celui sur substrat de saphir nu; cependant, aucune recherche n'est effectuée bien que le mécanisme de croissance sur Si (111) soit la clé de la croissance du réseau de nanoparois.
Dans ce travail, la croissance de GaN dans diverses structures, notamment le réseau de nanoparois, les nanocolonnes et le film compact, est systématiquement étudiée. Diverses structures GaN mentionnées ci-dessus ont été cultivées sur Si (111) en utilisant l'épitaxie par faisceau moléculaire assistée par plasma (MBE). Les résultats montrent que le changement de structure de la croissance de GaN peut être obtenu en ajustant le rapport Ga/N et en ajoutant les gouttelettes d'Al pré-déposées. La morphologie et la photoluminescence du réseau de nanoparois GaN ont été mesurées par microscopie électronique à balayage à émission de champ (FESEM) et analyseur de spectre de photoluminescence avec un laser He-Cd (325 nm, 200 mW) comme source d'excitation. Un microscope à force atomique (AFM) a été utilisé pour la caractérisation de la couche d'Al pré-déposée. Le mécanisme de croissance du réseau de nanoparois GaN sur Si (111) avec des gouttelettes d'Al métallique est proposé.
Expérimental
Les structures GaN ont été développées sur les substrats Si (111) par un système Riber 32 MBE équipé d'un N2 Source de plasma RF (Veeco, RFS-N/TH). La pression de la chambre de croissance a été pompée à 3.0 × 10 − 10 Torr avant la croissance. Le N2 gaz, Ga et Al avec une pureté de 99,9999% ont été utilisés dans cette expérience. Le substrat Si (111) (sans dopage, un côté poli pour la croissance, 380 ±20 μm, fourni par Sigma-Aldrich) avec une résistivité> 5000 Ω cm a été nettoyé par un procédé RCA standard, suivi d'un trempage dans HF:H2 O = 1:50 pendant quelques secondes pour éliminer la couche d'oxyde de silicium sur la surface du substrat Si ainsi que pour former une surface à terminaison hydrogène.
Pour la croissance des nanocolonnes GaN, les obturateurs des N2 le plasma et la source de Ga ont été ouverts simultanément et le Si nu (111) a été chauffé à 973 K. La puissance et la pression du N2 la source de plasma utilisée dans tous les échantillons de ce travail a été fixée à 400 W et 4,2 × 10 − 5 Torr, respectivement. Avant la croissance du réseau de nanoparois de GaN, les gouttelettes d'Al d'un diamètre d'environ 80 nm ont été déposées sur le Si nu (111) chauffé à 973 K. La source d'Al a été maintenue à 1323 K. Le pré-dépôt des gouttelettes d'Al a entraîné une nucléation et une croissance différentes de GaN, conduisant à la croissance du réseau de nanoparois. Le flux de Ga pour la croissance du réseau de nanoparois était le même avec les nanocolonnes (φ Ga = 1.2 × 10 − 7 Torr à 1169 K). Pour la croissance du film de GaN, le flux de Ga a été augmenté à 5,3 × 10 − 7 Torr tandis que le flux N était maintenu constant.
Résultats et discussion
Quand les volets du N2 plasma et Ga ont été ouverts simultanément, GaN (S1 ) s'est développé sous forme de nanocolonnes sur le Si nu (111) comme le montre la figure 1a. Le flux de Ga était de 1,2 × 10 − 7 Torr et le substrat Si (111) ont été maintenus à 973 K comme indiqué dans le tableau 1. On observe que le diamètre des nanocolonnes de GaN varie de 52 à 125 nm avec une longueur d'environ ~ 460 nm. La densité des nanocolonnes comptées à partir de l'image SEM est de ~ 10 7 mm − 2 . De toute évidence, la plupart des nanocolonnes observées sur la figure 1b ne sont pas perpendiculaires au substrat, mais s'inclinent avec un angle de ~ 30°. La surface supérieure des nanocolonnes est lisse, en accord avec le rapport de Bertness [9]. On pense que les nanocolonnes nucléent spontanément puis se propagent car le coefficient de collage sur le (0 0 01) c -plan est plus haut que celui sur le {110 0} m -avion. La longueur de diffusion L de l'atome de Ga absorbé (Gaab ) est essentiel pour la croissance des nanocolonnes. Comme décrit dans l'éq. (1), la longueur de diffusion L dépend de la distance de saut moyenne a , le Gaab énergie de désorption Q des , et l'énergie d'activation pour un saut de diffusion de surface Q d [13][i>.
$$ L=\sqrt{2}a\ \exp \left(\frac{Q_{\mathrm{d}\mathrm{es}}-{Q}_{\mathrm{d}}}{2 kT}\ à droite) $$ (1)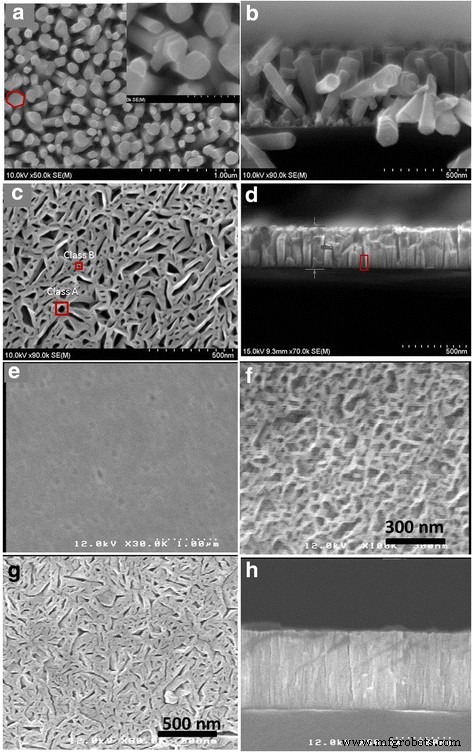
Images FESEM d'échantillons cultivés dans différentes conditions. un , b Correspondant aux nanocolonnes GaN (échantillon S1 ). c , d Correspondant au réseau de nanowall GaN (échantillon S2 ), e Correspondant au film compact (échantillon S3 ), f Correspondant au réseau de nanowall GaN (échantillon S4 ) au début du stade de croissance. g , h Correspondant au réseau de nanoparois GaN cultivé à une température plus basse de 900 K (échantillon S5 )
Étant donné que les parois latérales des nanocolonnes atomiquement plates fournissent peu de sites d'adsorption, on suppose que le Gaab longueur de diffusion L sur le m -le plan des flancs est beaucoup plus haut que celui sur le c -plan, entraînant la croissance verticale de GaN en nanocolonnes. Si cette hypothèse était vraie, la forte anisotropie du taux de croissance serait modifiée lorsque le rapport Ga/N est amélioré. En effet, le GaN (S3 ) la structure a changé de la nanocolonne au film compact (Fig. 1e) lorsque le flux de Ga a été augmenté à 5,3 × 10 − 7 Torr. Par conséquent, la croissance de GaN sous forme de nanocolonne ou de film compact peut être contrôlée en ajustant le rapport Ш/V.
Bien que les nanocolonnes GaN présentent des performances supérieures à celles du film, la fabrication d'un dispositif électrique est très difficile car la nanocolonne séparée doit être alignée avant la fabrication du contact électrique. Une nanostructure électriquement conductrice dans le plan est donc privilégiée. Pour la croissance de l'échantillon S2 , un pré-dépôt d'Al métallique a été effectué dans la chambre de croissance MBE pendant 40 s. Ensuite, le N2 le plasma et la source de Ga ont été ouverts simultanément. Le flux de Ga pour le S2 la croissance est résumée dans le tableau 1, la même que celle de S1 . La figure 1c montre l'image FESEM vue de dessus de l'échantillon S2. Il est assez intéressant de noter que le GaN croît sous la forme du réseau de nanoparois sur l'Al/Si (111). Les nanoparois d'un diamètre de 50 à 100 nm se chevauchent et s'entrelacent les unes avec les autres, formant un réseau continu dans le plan, à savoir le réseau de nanoparois. Deux classes de trous sont observables, nommées classe A et classe B. Les diamètres des trous de classe A et de classe B sont généralement de 50~100 et 10~ 49 nm, respectivement. La caractéristique continue dans le plan rend le réseau de nanoparois dans le panneau électriquement conducteur [18], éliminant dans une certaine mesure les obstacles à la fabrication de nano-dispositifs. La surface supérieure des nanoparois est relativement plate, différente de la matrice GaN à facettes rapportée dans la réf. [13]. Il est visible que les trous montrés dans l'image vue de dessus s'étendent jusqu'à proximité du substrat, comme indiqué par le rectangle de la Fig. 1d.
On peut se demander comment sont générés les trous mentionnés ci-dessus. Nous avons développé un échantillon S5 à une température de croissance inférieure de 900 K. Les autres paramètres de croissance sont les mêmes avec l'échantillon S2 , comme le montre le tableau 1. À partir de la figure 1g, nous observons que l'échantillon S5 a également grandi sous la forme du réseau de nanowalls avec des trous plus petits. La figure 1h est l'image en coupe de S5 , montrant une couche plus compacte que S2. Afin de voir le début de la croissance du réseau de nanowalls GaN, nous avons développé un autre échantillon S4 en peu de temps avec pré-dépôt d'Al. Tous les paramètres de croissance de S4 sont les mêmes que ceux de l'échantillon S2 à l'exception du temps de croissance (20 vs 120 min). L'épaisseur de S4 est d'environ 50 nm et son image en vue de dessus est illustrée à la Fig. 1f. On observe que des trous se sont formés à ce stade et que le GaN as-gown est un réseau continu dans le plan, plutôt que les nanofils ou les îlots de GaN. A partir de l'étude des échantillons S1 , S2 , S4 , et S5 , il est clair que le pré-dépôt de la couche d'Al modifie le comportement de croissance du GaN au début, de la nanocolonne au réseau continu de nanoparois dans le plan.
Notez que toutes les conditions de croissance de S2 sauf que les pré-dépôts d'Al sont les mêmes que ceux de S1 . Ensuite, on peut se demander quelle est la structure de l'Al pré-déposé et comment elle affecte la croissance ultérieure du GaN. Pour trouver ces réponses, le pré-dépôt d'Al pendant 40 s sur le Si nu (111) est étudié par la FESEM et l'AFM. La figure 2a montre l'image vue de dessus de l'Al pré-déposé. On constate que l'Al sur le substrat Si existe sous forme de gouttelettes (points blancs) autres qu'un film. Les gouttelettes d'Al métallique avec une densité de ~ 4 × 10 7 mm − 2 distribuer relativement uniformément sans accumulation significative. Récemment, les gouttelettes d'Al ont été cultivées avec succès à l'aide de MBE par Li et al. pour améliorer la qualité du GaN tel que cultivé et réduire le stress [24]. Pour approfondir l'étude de la morphologie des gouttelettes d'Al, l'AFM a été utilisé pour mesurer leurs images tridimensionnelles et les paramètres associés, comme indiqué sur la Fig. 2b, c. Les gouttelettes sont sphériques comme le montre la figure 2b, en accord avec le résultat SEM. La hauteur et le diamètre de la gouttelette d'Al mesurés sont respectivement de 6,7 et 80 nm. Poppitz et al. [25] ont étudié la croissance du réseau de nanoparois GaN sur du 6H-SiC nu (0001) par un MBE assisté par faisceau de fer. Leurs résultats montrent que les conditions de croissance extrêmement riches en N combinées à la température élevée du substrat et à l'irradiation énergétique des ions N pendant la croissance sont les principales raisons de la formation du réseau de nanoparois sur le 6H-SiC nu (0001). En tant que pionnier, Kesaria et al. [17] ont étudié le réseau de nanoparois GaN sur substrat de saphir nu en utilisant du PA-MBE. Dans leurs recherches, il est considéré que les nanoparois de GaN nucléent au bord et les dislocations de vis et se développent sous une atmosphère riche en N.
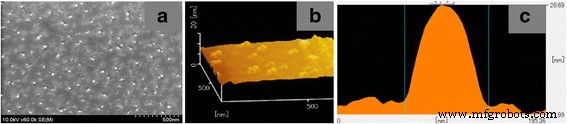
FESEM (a ) et AFM (b ) images du substrat Al pré-déposé sur Si. c Une mesure de paramètre d'une goutte d'Al par AFM
Dans notre cas, le mécanisme de croissance du réseau de nanoparois GaN devrait être différent puisque les nanoparois croissent avec l'exigence du pré-dépôt d'Al métallique. Bien entendu, à notre connaissance, tous les réseaux de nanoparois de GaN, y compris dans notre expérience, sont cultivés dans une atmosphère riche en N. N riche est nécessaire pour réduire la coalescence des nanoparois. Intéressons-nous maintenant au rôle des gouttelettes d'Al dans la formation du réseau de nanoparois. Semblable aux gouttelettes d'Au agissant comme catalyseur [26], si les gouttelettes d'Al agissaient comme catalyseur, le GaN devrait croître jusqu'aux nanocolonnes plutôt qu'au réseau de nanoparois. Le rôle des gouttelettes d'Al n'est donc pas un catalyseur dans notre étude. La température de fusion du métal Al est de 933 K tandis que la température du substrat est maintenue à 973 K pendant la croissance. Au début de la croissance du GaN, les gouttelettes d'Al sont donc des gouttelettes liquides. Selon un rapport précédent, dans le cas de GaN sur Si (111) avec des gouttelettes de Ga [13], les gouttelettes de Ga agissent comme des réservoirs qui fournissent des atomes de Ga à leur proche voisinage. Les gouttelettes de Ga elles-mêmes, cependant, entravent la croissance de GaN sur elles, car les sites de gouttelettes de Ga d'origine sont des cercles creux. Dans notre cas, le diamètre des gouttelettes d'Al est de ~ 80 nm, similaire à la taille des trous de classe A de la Fig. 1a. Par conséquent, les gouttelettes d'Al peuvent entraver la croissance de GaN sur elles, conduisant à la formation des trous de classe A observés dans le réseau de nanoparois de GaN. En raison du même rapport Ш/V des échantillons S1 et S2 , la longueur de diffusion Ga L sur Si pour le réseau de nanowall, la croissance devrait être la même que pour les nanocolonnes. La taille typique du substrat de Si nu (la zone sans gouttelettes d'Al) est d'environ 80 nm, dans les limites de la valeur du diamètre de la nanocolonne sur la figure 1a. En d'autres termes, la longueur de diffusion Ga L couvre la taille du substrat de Si nu, ce qui entraîne la croissance continue de GaN dans la zone sans les gouttelettes d'Al, c'est-à-dire le réseau de nanoparois de GaN.
Sur la base de l'analyse ci-dessus, un modèle de croissance du réseau de nanoparois de GaN est proposé et illustré sur la figure 3. GaN nuclée sur le substrat de Si nu, comme illustré sur la figure 3a. Depuis le Gaab longueur de diffusion L recouvre le substrat de Si nu, GaN se développe dans tout le substrat de Si nu tandis que la croissance de GaN au-dessus des gouttelettes d'Al est entravée (Fig. 3b). De plus, dans des conditions riches en N, le GaN a tendance à croître verticalement, comme le montre la figure 3c. Étant donné que le substrat de Si nu est un réseau continu dans le plan, la croissance de GaN au-dessus est également un réseau continu appelé réseau de nanoparois, comme illustré sur la figure 3d. Cette hypothèse est confirmée par l'image vue de dessus de l'échantillon S4 dans la figure 1f. En raison de la condition riche en N pour l'échantillon S2 croissance, la croissance latérale est limitée que les trous sont capables de réserver dans la croissance ultérieure. Notez que les gouttelettes d'Al et la condition riche en N sont essentielles pour la croissance du réseau de nanoparois de GaN.
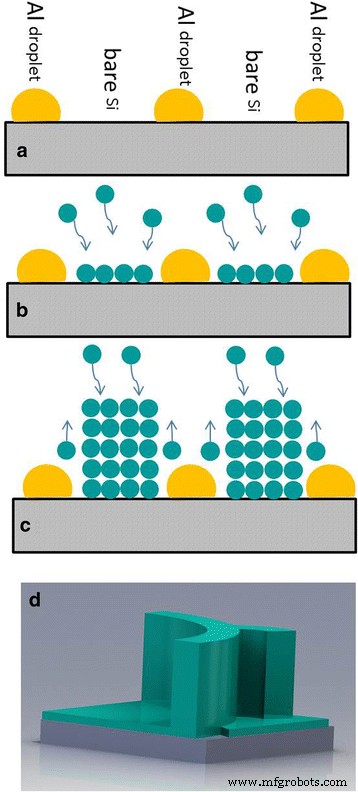
Modèles de croissance du réseau de nanowalls GaN. un Les gouttelettes d'Al pré-déposées sur le substrat de Si. b Nucléation du réseau de nanoparois GaN sur le Si nu. c Illustration en coupe du réseau de nanoparois de GaN développé verticalement à l'état riche en N. d Illustration d'inclinaison du réseau de nanowalls GaN
La diffraction des rayons X a été utilisée pour la caractérisation de la structure cristalline du réseau de nanoparois de GaN, comme le montre la figure 4. Deux pics de diffraction du GaN(002) et du GaN(004) sont observés avec le pic Si (111) du Substrat Si. Le résultat révèle que le réseau de nanoparois de GaN est hexagonal et s'oriente fortement le long de C axe. En plus du motif XRD, la courbe d'oscillation à balayage du GaN (002) a également été mesurée comme indiqué dans l'encadré de la figure 4. La largeur totale à mi-hauteur est de 52,2 arcmin, similaire au rapport précédent cultivé sur le saphir substrat [27]. Les propriétés électriques ont également été mesurées à l'aide du système de mesure Van der Pauw Hall (HL5500PC, Nanometrics) à 293 K. La conductivité électrique, la mobilité Hall et la concentration électronique du réseau de nanoparois GaN sont de 10,2 S/cm, 31 cm 2 /Vs, et 2,1×10 18 cm − 3 , respectivement. Quant au film de GaN, la conductivité électrique augmente jusqu'à 666,7 S/cm en raison de la concentration en électrons plus élevée de 2,2×10 20 cm − 3 . La concentration élevée de porteurs dans le film est probablement attribuée à la concentration élevée de défauts intrinsèques générés par le rapport Ga/N non optimisé. Quant à la mobilité de salle du film, la valeur est de 18,7 cm 2 /Vs.

Diagramme de diffraction des rayons X du réseau de nanoparois GaN (S2 ). L'encart est la courbe d'oscillation -scan de l'échantillon S2
La figure 5 montre les spectres de photoluminescence du réseau de nanoparois GaN avec un laser He-Cd comme source d'excitation. Selon le rapport de Kesaria et al. [17], une comparaison directe de la cathodoluminescence entre un film de GaN, un réseau de nanoparois et une nanocolonne cultivée sur un substrat de saphir nu a été réalisée. Leurs résultats montrent que l'émission en bord de bande du réseau de nanoparois est légèrement supérieure à celle de la nanocolonne, et bien supérieure à celle du film. Une large émission de défauts centrée de 520 à 620 est observable pour le réseau de nanowall alors qu'aucune émission de défaut n'a pu être observée pour la nanocolonne. Sur la figure 5, une forte émission de bord de bande centrée à 363,7 nm est observée avec la pleine largeur à mi-hauteur de 14,1 nm. En accord avec le rapport de Kesaria et al. [17], dans la gamme de 520 à 620 nm, une large émission vert-jaune attribuée aux défauts ponctuels [28] est détectable mais très faible, indiquant une haute qualité de la nanoparoi de GaN réseau. Par conséquent, la luminescence du réseau de nanoparois de GaN développé sur le substrat de saphir nu et sur le substrat de Si avec les gouttelettes d'Al est presque la même bien que le mécanisme de croissance soit différent.

Spectres de photoluminescence (PL) du réseau de nanoparois GaN mesurés à température ambiante
Conclusions
Dans ce travail, le changement de structure de la croissance de GaN parmi la nanocolonne, le réseau de nanoparois et le film compact a été réalisé avec succès sur un substrat Si (111) en utilisant MBE. Les nanocolonnes de GaN ont été développées sur le substrat de Si nu dans des conditions riches en N tandis que le film compact a été développé avec un flux de Ga amélioré. En ajoutant une couche d'Al pré-déposée, la croissance de GaN passe des nanocolonnes au réseau de nanoparois continu dans le plan. La couche d'Al pré-déposée existe sous la forme de gouttelettes d'une hauteur et d'un diamètre typiques de 6,7 et 80 nm, respectivement. Le mécanisme de croissance du réseau de nanowalls est abordé. GaN croît en continu sur le substrat de Si nu tandis que la croissance de GaN sur les gouttelettes d'Al est entravée, ce qui entraîne la formation du réseau de nanoparois. Les gouttelettes d'Al et les conditions riches en N sont essentielles à la croissance du réseau de nanoparois.
Nanomatériaux
- Opérateurs de bits et de décalage de bits C#
- C Structure et fonction
- Équipe Chimie et Industrie 4.0
- 5G et GaN :le passage du LDMOS au GaN
- 5G et GaN :futures innovations
- IoT et blockchain – Un changement de paradigme
- Différence entre structure et union
- Dévoilement de la structure atomique et électronique des nanofibres de carbone empilées
- Structure et propriétés électroniques de la nanoargile de kaolinite dopée par un métal de transition



