Percer la largeur de canaux multi-mesa limitée des HEMTs GaN normalement désactivés grâce à la modulation de la longueur de trou de passage
Résumé
Nous présentons de nouveaux transistors à haute mobilité électronique (HEMT) normalement hors GaN qui surmontent les limitations typiques de la largeur du canal multi-mesa (MMC) grâce à la modulation de la longueur du trou traversant pour réguler l'effet d'écran de neutralité de charge. Nous avons préparé des HEMT GaN en mode d'amélioration (mode E) ayant des largeurs allant jusqu'à 300 nm, sur la base d'un effet d'épinglage de surface amélioré. Les HEMT GaN en mode E ayant des structures et des largeurs MMC ainsi que des longueurs de trous traversants de 100 nm/2 μm et 300 nm/6 μm, respectivement, présentaient des tensions de seuil positives (V ème ) de 0,79 et 0,46 V, respectivement. Les résistances à l'état passant des structures MMC et via-hole-longueur étaient inférieures à celles des HEMT GaN à nanoruban à trois grilles typiques. De plus, les appareils ont non seulement atteint le mode E, mais ont également amélioré les performances énergétiques des HEMT GaN et atténué efficacement l'effet thermique de l'appareil. Nous avons contrôlé l'effet d'épinglage de la surface de la paroi latérale de la longueur du trou traversant pour obtenir les HEMT GaN en mode E. Nos résultats suggèrent que les HEMT de longueur de via-hole normalement hors GaN ont un grand potentiel pour une utilisation dans l'électronique de puissance de nouvelle génération.
Contexte
Les nitrures à large bande interdite III-V sont des matériaux semi-conducteurs prometteurs pour le fonctionnement en fréquence et en tension en raison de leurs excellentes propriétés matérielles, notamment de larges bandes interdites, des champs électriques critiques élevés, des vitesses électroniques à saturation élevée et des conductivités élevées [1, 2]. En conséquence, ils sont largement utilisés dans diverses applications, notamment les diodes électroluminescentes (DEL) et les transistors [3]. De plus, les hétérostructures nitrure d'aluminium gallium/nitrure de gallium (AlGaN/GaN) forment des gaz d'électrons bidimensionnels (2DEG) adaptés au développement de dispositifs à hautes performances, profitant de la polarisation spontanée et piézoélectrique des composés III-nitrure [4,5 ,6]. La quantité de 2DEG est influencée par la proportion de dopage induit par la polarisation, qui affecte directement les caractéristiques du dispositif [7,8,9]. Bien qu'ils aient de nombreuses propriétés intéressantes, les transistors à haute mobilité électronique (HEMT) AlGaN/GaN n'ont pas trouvé d'utilité universelle car leurs caractéristiques électroniques peuvent nécessiter des configurations de circuits complexes pour les applications de circuits numériques, de puissance, RF et micro-ondes. En conséquence, un fonctionnement normalement éteint serait essentiel pour tout futur dispositif à semi-conducteur III-V [10, 11]. Bien que certaines techniques de fabrication spéciales aient été testées (p. ex., utilisation de grilles en retrait [12,13,14], insertion de couches de recouvrement de type p sous la grille [15, 16], structures de jonction tunnel [17], implantation d'ions fluorure dans la barrière sous la grille [18], et l'inclusion de fines couches barrières en AlGaN avec une grille métallique spéciale et un traitement de recuit thermique rapide (RTA) [19]), ils peuvent aggraver les performances de l'appareil et causer des problèmes de stabilité en raison des dommages matériels induits par le traitement et augmentation des effets des champs thermiques et électriques.
Alternativement, une équipe de l'Université d'Hokkaido a découvert que les HEMT AlGaN/GaN fabriqués avec des nanocanaux à ailettes présentaient un décalage de la tension de seuil (V ème ) dans le sens positif [20, 21]. Un groupe de l'Université de Soochow a signalé que la valeur de V ème ont subi un décalage positif systématique lorsque la largeur du nanocanal était inférieure à 90 nm [22]. Des chercheurs de l'Université nationale de Kyungpook ont considéré la relaxation partielle de la contrainte des côtés des canaux pour expliquer le comportement [23]. Une équipe du Massachusetts Institute of Technology a simulé la tension de seuil après passivation de surface des HEMT à base de GaN et a déterminé que des valeurs positives se produisaient lorsque la largeur du canal était inférieure à 100 nm [24], le résultat d'effets de paroi latérale et d'une contrainte de traction accrue qui a diminué la concentration d'électrons dans le canal. Les structures en forme d'ailettes non seulement décalent la tension de seuil, mais améliorent également la contrôlabilité de la grille, grâce à la structure 3-D, qui induit des performances à l'état passant tout en améliorant les caractéristiques à l'état bloqué. Le courant de drain maximal normalisé (I D /mm) dans un HEMT AlGaN/GaN ayant une structure en forme d'ailette est supérieur à celui d'une structure plane correspondante [25]. Bien que ces méthodes aient été utilisées pour fabriquer des HEMT en mode E, il reste très difficile de développer des transistors de puissance hautes performances normalement hors GaN. Tout d'abord, la combinaison d'une faible résistance à l'état passant (R sur ) et une faible puissance totale de l'appareil doit être atteinte lorsque la largeur du canal est limitée à moins de 100 nm. Bien que la valeur de R sur du canal peut être diminué en réduisant la longueur de la grille normalement fermée, le contrôle du courant de fuite de drain à l'état bloqué pose un autre défi car la largeur de la grille influence la transconductance et la fuite de grille par la diffusion de champ de Coulomb de polarisation et les chemins de fuite de grille [26, 27 ]. Les films déposés peuvent être utilisés comme diélectriques de grille pour améliorer ces problèmes [28].
Dans cette lettre, nous décrivons une percée dans la limitation de la largeur des canaux à trois portes et proposons une méthode pour moduler la longueur des trous de traversée des canaux. Notre appareil a atteint le mode E avec une largeur de structure MMC de 300 nm et une longueur de trou d'interconnexion de 6 μm et a présenté une tension de seuil de 0,46 V. Cette approche a non seulement diminué la résistance à l'activation de l'appareil (R sur ) mais pourrait également atténuer l'effet Joule. En combinant une tri-porte 3-D avec différentes largeurs de canaux et longueurs de trous traversants, nous avons obtenu des HEMT normalement hors GaN ayant des valeurs positives de V ème de 0,79 et 0,46 V lorsque les largeurs de canal/longueurs de trous de passage étaient respectivement de 100 nm/2 μm et 300 nm/6 μm.
Méthodes
La plaquette épi AlGaN/GaN a été cultivée sur un substrat de saphir (0001) à l'aide d'un système de dépôt chimique en phase vapeur métal-organique Nippon Sanso SR-2000 (MOCVD). La croissance de la structure épitaxiale a commencé avec une couche de nucléation GaN déposée à 600 °C. Une couche tampon GaN dopée non intentionnellement de 2 μm d'épaisseur, une couche barrière d'AlGaN dopée non intentionnellement de 21,8 nm d'épaisseur nominale de 23 % d'aluminium et une couche de couverture de GaN de 2 nm d'épaisseur ont ensuite été déposées à 1180 °C. Le traitement du dispositif a commencé à l'aide d'un système de gravure ionique réactive (RIE) à plasma à couplage inductif (ICP) avec un BCl3 /Cl2 mélange gazeux pour isoler une mesa de 130 nm de profondeur et graver une structure de tranchée périodique. Par la suite, deux processus ont été appliqués pour restaurer les facettes cristallines de la région de l'évidement et des parois latérales de la mesa et diminuer les niveaux de défauts de surface et de dommages par bombardement ionique. Le premier impliquait l'utilisation de KOH fondu pour une gravure chimique humide cristallographique pour éliminer les dommages de surface induits par la gravure sèche et produire simultanément des parois latérales verticales lisses ; la seconde consistait à appliquer une solution de piranha (un mélange de H2 SO4 et H2 O2 ) pour le nettoyage des surfaces et l'élimination des résidus organiques. La photolithographie conventionnelle avec une lampe au mercure a été appliquée pour définir le drain, la source, la grille et les plots de contact pour les mesures en courant continu. Des contacts ohmiques à l'hétérojonction AlGaN/GaN, composés de titane/aluminium/nickel/or (Ti/Al/Ni/Au, 30/120/20/80 nm), ont été déposés sur les régions drain/source par évaporation par faisceau d'électrons et recuit à 850 °C pendant 30 s sous vide. Pour compléter le canal du transistor, une électrode de grille a été fabriquée par évaporation par faisceau d'électrons de Ni/Au (20/80 nm). La figure 1 fournit des représentations schématiques de la section transversale de la structure HEMT, une vue de dessus de l'appareil et un schéma structurel 3D de l'appareil. La longueur du portail (L g ), largeur de la structure MMC (W MMC ), structure MMC via-hole-length (L MMC ), et la hauteur de la structure MMC (H MMC ) étaient respectivement de 2 μm, 100-500 nm, 1-6 μm et 130 nm. Les ailettes étaient connectées en parallèle. Pour améliorer l'effet d'épinglage de surface, la structure de longueur de trou traversant GaN HEMT n'a pas été soumise à une passivation. La figure 2a présente une image en vue de dessus au microscope électronique à balayage (MEB) de la surface métallique dans la région de la source et du drain. L'image de microscopie optique (OM) de la figure 2b révèle des portes et des canaux complets ; observer combien de canaux existaient dans l'appareil a été utile lors du calcul du courant réel. La surface est apparue accidentée sur l'image car, après recuit, les atomes ont migré dans le réseau cristallin et le nombre de dislocations a diminué, diminuant efficacement la résistance. L'image SEM de la figure 2c a confirmé les dimensions du canal.
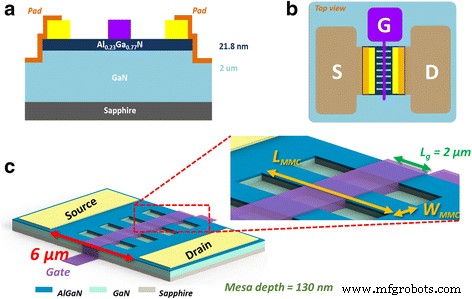
Représentations schématiques de a la section transversale de la structure HEMT, vue depuis une direction parallèle au canal du transistor ; b la vue de dessus de la structure HEMT ; et c la structure 3-D de l'HEMT
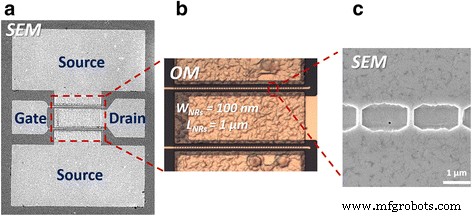
un Image SEM vue de dessus de l'appareil ; b image OM vue de dessus de l'appareil, révélant une largeur et une longueur de canal de 100 nm et 1 μm, respectivement ; et c image SEM vue de dessus de la chaîne
Résultats et discussion
À ce jour, la plupart des développements technologiques dans les transistors GaN haute tension ont été basés sur des HEMT AlGaN/GaN, qui sont intrinsèquement des dispositifs en mode d'épuisement (mode D) en raison du gaz d'électrons 2-D induit par la polarisation à l'interface AlGaN-GaN [29]. Néanmoins, des transistors GaN normalement désactivés seront nécessaires si l'industrie de l'électronique de puissance doit adopter largement les technologies GaN.
Le nombre de liaisons pendantes sur une surface (Al)GaN est d'environ 10 15 cm −2 ; ces liaisons pendantes induisent une flexion de bande appauvrie en surface en raison d'un effet d'épinglage de surface. La figure 3a montre les zones appauvries en surface du canal latéral à partir des portes de paroi latérale dans la structure à trois portes. Des chercheurs de l'Université nationale de Kyungpook ont signalé un phénomène similaire [21]. La figure 3b présente le I DS –V G caractéristiques de transfert des dispositifs ayant une valeur fixe de L MMC de 2 μm et des valeurs de W MMC de 100, 300 et 500 nm. Lorsque la tension drain-source était de 8 V, les valeurs de V ème de ces appareils étaient respectivement de +0,79, -1,32 et -2,18 V. Ainsi, un décalage positif de la tension de seuil s'est produit lorsque les canaux sont devenus plus étroits. Ce phénomène peut être dû à l'épuisement du canal latéral et à l'épinglage de surface de la longueur de trou de traversée de 2 μm de la paroi latérale dans la structure de longueur de trou de traversée MMC par les effets de l'épuisement du canal latéral et de la courbure de la surface de la longueur de trou de traversée .

un Représentation schématique des HEMT AlGaN/GaN ayant des canaux larges et étroits. b Je DS –V G caractéristiques de transfert mesurées pour un dispositif ayant une valeur de L MMC de 2 μm et différentes valeurs de W MMC
La figure 4 affiche l'IDS –VG caractéristiques de transfert des dispositifs ayant une valeur fixe de W MMC de 300 nm et les valeurs de L MMC de 1, 2 et 6 μm. Lorsque la tension drain-source était de 8 V, les valeurs de V ème étaient de -2,12, -1,07 et +0,46 V, respectivement. L'appareil a atteint un fonctionnement normal lorsque la longueur et la largeur du MMC étaient respectivement de 6 μm et 300 nm. La modulation de la longueur du trou traversant et de la largeur du canal peut fournir un dispositif affichant un fonctionnement normalement éteint. Le tableau 1 répertorie les tensions de seuil mesurées pour diverses longueurs de trous traversants et largeurs de canaux multi-mesa. Lorsque la largeur du canal a été fixée à 500 nm et que la longueur du trou de passage a été augmentée de 0,8 à 6 μm, la valeur de V ème augmenté de -2,62 à -1,62 V, le courant de drain de saturation a diminué de 747 à 98 mA/mm et la transconductance a diminué de 270 à 40 mS/mm. Lorsque la largeur du canal a été fixée à 300 nm et que la longueur du trou de passage a été augmentée de 0,8 à 6 μm, la valeur de V ème augmenté de -2,15 à +0,46 V, le courant de drain de saturation a diminué de 685 à 6,8 mA/mm et la transconductance a diminué de 290 à 7,4 mS/mm. Lorsque la largeur du canal a été fixée à 100 nm et que la longueur du trou de passage a été augmentée de 0,8 à 2 μm, la valeur de V ème augmenté de -0,41 à +0,79 V, le courant de drain de saturation a diminué de 547 à 53 mA/mm et la transconductance a diminué de 400 à 67 mS/mm. La capacité de traitement du courant HEMT est fortement affectée par les concentrations de porteurs [20, 21]. En conséquence, les courants de drain de saturation et les transconductances des dispositifs ont été fortement affectés par les états de surface totale des parois latérales et l'effet d'appauvrissement de la surface du canal à trois grilles lors de la variation des largeurs et des longueurs de trous d'interconnexion des HEMT GaN. Par rapport aux appareils signalés précédemment [23], notre appareil a atteint un nouveau jalon pour la faible résistance, normalement hors GaN HEMT.

Je DS –V G caractéristiques de transfert des dispositifs ayant une valeur fixe de W MMC de 300 nm et diverses valeurs de L MMC
Conclusions
Nous avons préparé des HEMT GaN en mode E ayant une structure multi-mesa-channel (MMC) ; ils présentaient une tension de seuil positive de 0,46 V lorsque la largeur du canal et la longueur du trou traversant étaient respectivement de 300 nm et 6 μm. Nous en déduisons que les effets de l'épuisement du canal latéral et de la courbure de la surface de la longueur du trou traversant. Lorsqu'ils contenaient une tri-porte ayant une structure de longueur de trou traversant MMC, les nouveaux HEMT GaN normalement désactivés présentaient une très faible résistance à l'état passant, même en augmentant la largeur de la structure MMC à 300 nm (anciennement limitée à moins de 100 nm). De plus, la modulation de la structure MMC de longueur de trou traversant fournissait normalement des HEMT GaN améliorant d'excellentes performances de puissance, en raison de l'augmentation de la largeur du dispositif de structure MMC.
Nanomatériaux
- Poignées à souder ou à tirer :quelle est la différence ?
- Briser l'anatomie d'une vis
- Modulation de largeur d'impulsion
- Open Source et IoT :l'innovation par la collaboration
- Briser le cycle de la dette technologique de la chaîne d'approvisionnement
- Transformer le processus d'approvisionnement grâce à la robotique
- ProtoPumpkins au fil des ans
- Sécheurs d'air réfrigérés - Décomposer les bases
- Décomposer les bases de la fabrication de conduits



