Examen des progrès récents sur les diodes PN verticales basées sur GaN
Résumé
En tant que matériau semi-conducteur représentatif à large bande interdite, le nitrure de gallium (GaN) a attiré une attention croissante en raison de ses propriétés matérielles supérieures (par exemple, une mobilité élevée des électrons, une vitesse de saturation élevée des électrons et un champ électrique critique). Les dispositifs GaN verticaux ont été étudiés, sont considérés comme l'un des candidats les plus prometteurs pour les applications d'électronique de puissance et sont caractérisés par la capacité de haute tension, de courant élevé et de tension de claquage élevée. Parmi ces dispositifs, la diode à jonction PN (PND) verticale à base de GaN a été considérablement étudiée et montre de grands progrès en termes de performances sur la base d'une qualité d'épitaxie élevée et d'une conception de structure de dispositif. Cependant, la qualité d'épitaxie de son dispositif nécessite une amélioration supplémentaire. En termes de performances électriques de l'appareil, l'effet d'encombrement du champ électrique au bord de l'appareil est un problème urgent, qui entraîne une panne prématurée et limite les supériorités de libération du matériau GaN, mais est actuellement atténué par la terminaison de bord. Cette revue met l'accent sur les progrès des techniques de croissance épitaxiale des matériaux et des terminaux de bord, suivies de l'exploration des développements actuels du GaN et des avantages potentiels par rapport au silicium-carbone (SiC) pour les matériaux et les dispositifs, les différences entre les diodes à barrière GaN Schottky (SBD) et les PND comme concerne les mécanismes et les caractéristiques, et les avantages des dispositifs verticaux par rapport à leurs homologues latéraux. Ensuite, l'examen fournit une perspective et révèle la tendance de conception du PND GaN vertical utilisé pour un système d'alimentation, y compris avec un PND GaN vertical inachevé.
Introduction
La consommation mondiale d'énergie augmente beaucoup plus rapidement qu'au cours des dernières décennies en raison de la croissance rapide de l'industrie et de l'économie. Par conséquent, des technologies avancées d'économie d'énergie sont nécessaires pour atténuer les problèmes d'augmentation de la consommation d'énergie.
Les dispositifs à base de silicium sont actuellement le type dominant parmi les dispositifs de puissance [1]. Parmi ces dispositifs de puissance, les structures de transistors bipolaires à grille isolée (IGBT) jouent un rôle important et affichent une tendance croissante vers le remplacement du transistor bipolaire à jonction de puissance (BJT) et du transistor à effet de champ à semi-conducteur à oxyde métallique (MOSFET) depuis l'invention du IGBT en 1982 [2]. Actuellement, les IGBT sont des éléments essentiels des champs électroniques de puissance pour la conversion et la transmission [3]. Cependant, les dispositifs d'alimentation à base de silicium ont atteint leurs limites matérielles fondamentales à ce jour et sont largement utilisés dans les applications d'énergie électrique.
Compte tenu de ses propriétés exceptionnelles, le GaN fait partie des matériaux semi-conducteurs à large bande interdite (notamment SiC, GaN, Ga2 O3 et diamant) capables de fabriquer des dispositifs de puissance avec une faible capacité et résistance pour une tension de claquage spécifiée par rapport aux dispositifs à base de Si. Ainsi, des dispositifs à base de GaN avec une faible consommation d'énergie, des densités de puissance élevées et une efficacité de conversion élevée pour les systèmes électroniques de puissance sont attendus.
Comme le montre le tableau 1, le GaN a un facteur de mérite de Baliga (BFOM) beaucoup plus élevé que le SiC (qui a été commercialisé), une caractéristique qui est attribuée à sa vitesse de saturation des électrons plus élevée et à son champ électrique critique plus élevé. Cependant, le SiC a une meilleure conductivité thermique. De plus, GaN possède une plus grande mobilité des porteurs µ et une conductivité thermique plus élevée, et atteint à la fois p - et n -dopage de type par rapport au Ga2 O3 . Pendant ce temps, pour le semi-conducteur à large bande interdite ultime, le diamant, des progrès considérables doivent être accomplis pour atteindre le stade pratique. À ce jour, les dispositifs à base de GaN, par exemple les dispositifs à trois bornes (transistors à effet de champ à hétérostructure (HFET) et MOSFET) et les dispositifs à deux bornes (SBD et PND) sont devenus des sujets de recherche clés, et de grands progrès ont été réalisés dans leur applications dans la rectification et la conversion de puissance.
GaN contre SiC
De par ses propriétés matérielles inhérentes, le GaN présente des avantages légèrement supérieurs au SiC, notamment une bande interdite d'énergie plus large, un champ électrique critique plus élevé, une vitesse de saturation des électrons plus élevée et un BFOM 3 à 4 fois meilleur pour les dispositifs d'alimentation [6]. Ainsi, compte tenu de ses caractéristiques exceptionnelles, les appareils à base de GaN devraient surpasser leurs homologues à base de SiC. Dans l'application pratique, les dispositifs verticaux à base de GaN sont essentiels pour une densité de puissance élevée et une fréquence de fonctionnement élevée (Fig. 1) en raison de leurs excellentes propriétés matérielles.
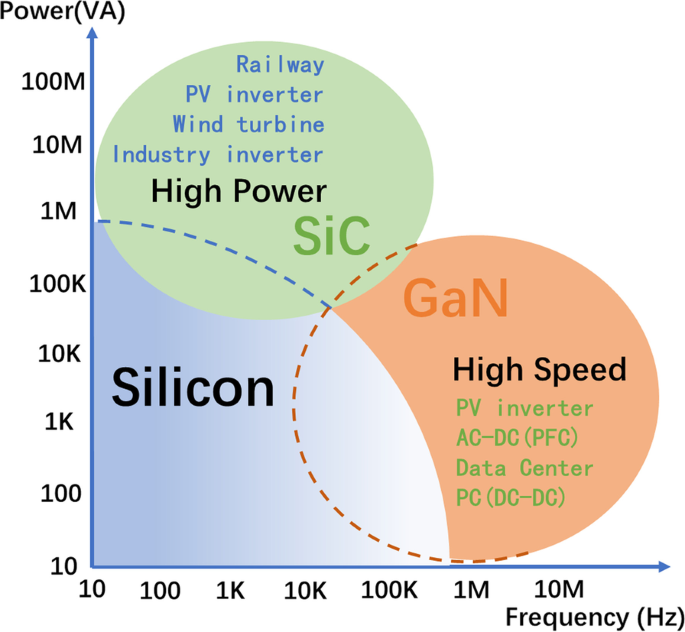
Applications potentielles des transistors de commutation de puissance GaN et SiC [7]
En tant que semi-conducteurs à large gap les plus matures, les dispositifs SiC ont réalisé des progrès remarquables au cours de la dernière décennie et affichent des performances prometteuses en termes de haute tension, de faible résistance à l'état passant et de vitesse de commutation rapide [8]. Compte tenu de la base de recherche approfondie depuis 1980 et du substrat SiC plus grand disponible avec un faible défaut (< 10 4 cm −2 ), les SBD SiC et les transistors à effet de champ à jonction (JFET) ont été les premiers dispositifs à base de SiC commercialisés depuis 2001. D'autres dispositifs de puissance à base de SiC, notamment les MOSFET et les BJT, ont été développés avec succès dans le domaine des applications haute tension et puissance et ont démontré performances [9].
Par rapport au SiC, les dispositifs GaN se sont développés très lentement. Leur qualité matérielle insatisfaisante empêche la réalisation de certaines de leurs propriétés théoriquement supérieures. Compte tenu de l'absence de substrat GaN, la plupart des études sur les dispositifs GaN sont principalement basées sur la structure latérale (par exemple, l'hétérostructure AlGaN/GaN) à ce stade. Avec sa mobilité électronique plus élevée de 2000 cm 2 /V s (gaz d'électrons bidimensionnel (2DEG) dans AlGaN/GaN), 1 000 cm 2 /V s (GaN en vrac) et vitesse de saturation plus élevée de 2,5 × 10 7 cm/s par rapport à leurs homologues SiC, les dispositifs AlGaN/GaN sont préférés pour les applications haute fréquence et ont une faible puissance par rapport aux dispositifs SiC [10]. Dans les champs à haute fréquence, les SBD AlGaN/GaN atteignent d'excellentes performances de transport électrique et sont plus adaptés aux applications micro-ondes et ondes millimétriques au niveau du watt [11, 12]. Le SBD AlGaN/GaN est un dispositif représentatif des SBD GaN. La grande mobilité du 2DEG signifie que les SBD AlGaN/GaN présentent d'énormes avantages en termes de performances dans les applications haute fréquence par rapport aux SBD verticaux et maintiennent également une faible tension d'activation. Récemment, les SBD AlGaN/GaN ont servi de base à un circuit redresseur de 5,8 GHz avec une puissance d'entrée de 6,4 W et une tension d'activation de 0,38 V avec une tension de claquage (BV ) de 3000 V [13, 14]. La fréquence de coupure maximale est proche de 1 THz à 0 V avec une distance anode-cathode de 70 nm [15].
Pour les dispositifs d'alimentation à base de GaN, le substrat GaN (GaN en vrac) est idéal pour la croissance par épitaxie, qui pourrait utiliser la technologie d'homoépitaxie pour éliminer le décalage. La faible densité de dislocations du GaN en vrac est essentielle pour le substrat épitaxié car la densité élevée de dislocations peut affecter les caractéristiques de performance telles que BV , courant de fuite inverse, volume de production et fiabilité [16]. Les développements de dispositifs verticaux à base de GaN ont été stimulés par les progrès du substrat GaN ces dernières années. Cependant, étant donné la technologie relativement immature de la triode verticale, la diode GaN verticale est devenue un sujet de recherche brûlant à ce stade initial. Par rapport aux SBD AlGaN/GaN, les SBD GaN verticaux présentent des avantages similaires dans les champs de fréquence tels qu'une vitesse de commutation élevée avec un faible temps de récupération inverse et une faible perte de conduction ; néanmoins, ce dernier a une grande densité de courant et moins de chemin de fuite que le premier [17, 18].
Certains problèmes se sont posés pour le substrat GaN. Premièrement, les substrats GaN sont actuellement disponibles avec des densités de dislocation de 10 4 –10 6 cm −2 , mais ces densités de dislocations sont encore bien supérieures à celles des substrats Si et SiC [19]. Deuxièmement, en ce qui concerne la taille de la plaquette de 4 à 6 pouces et son coût raisonnable (10 euro/cm 2 ) de SiC, la taille de 2 à 3 pouces et le coût relativement élevé (100 euro/cm 2 ) du substrat GaN inhibent la commercialisation et la productivité du GaN à grande échelle [20]. En plus d'augmenter le nombre de fournisseurs, l'hétéroépitaxie sur des substrats étrangers (Si, saphir ou SiC) est un moyen alternatif de réduire le coût du substrat GaN, mais le défi de l'inadéquation et des défauts relativement élevés doit être résolu.
En plus des problèmes mentionnés ci-dessus dans les matériaux en vrac, le défi pour la diode GaN est d'atteindre une haute qualité du p -type matériel. En ce qui concerne les techniques relativement avancées pour former p -type SiC par implantation ionique Al, immature p -la technologie d'implantation ionique et la faible activation de l'accepteur pour p -type GaN sont des obstacles vitaux, qui limitent le développement de la structure et la fabrication de dispositifs à base de GaN. Ainsi, différents types de structures de terminaison de bord sont proposés pour améliorer les performances de la diode GaN et constituent un élément clé de cette revue.
Périphériques verticaux basés sur GaN sur le substrat FS
Jusqu'à il y a 10 ans, la plupart des diodes GaN, y compris les SBD et les PND, étaient fabriquées sur des substrats étrangers formant des structures de dispositifs latérales ou quasi-verticales en raison de l'indisponibilité d'un substrat GaN en vrac. Les diodes latérales ou quasi-verticales présentent des caractéristiques électriques exceptionnelles, mais elles souffrent toujours d'inconvénients inhérents à la structure du dispositif [21]. Premièrement, l'inadéquation et les défauts sont inévitables. Ensuite, pour les dispositifs GaN sur substrats étrangers, un tampon est essentiel entre la couche de dérive de GaN et le substrat étranger. Ainsi, la relaxation des contraintes de la couche tampon provoquerait un bombage de la plaquette, ce qui abaisserait l'épaisseur des couches d'épitaxie de GaN [22]. De plus, la grande résistance thermique aux limites (GaN avec substrat) a une influence sérieuse sur les performances du dispositif pour les dispositifs GaN fonctionnant à haute densité de puissance [23].
Selon le développement des techniques d'épitaxie, le substrat GaN autonome (FS-GaN) à faible densité de dislocation adopté pour les dispositifs GaN verticaux a fait de grands progrès. La qualité du matériau du GaN homéopitaxial sur le substrat FS-GaN a une amélioration évidente et montre le potentiel pour les applications de puissance. Les dispositifs GaN verticaux pourraient atténuer les inconvénients des homologues GaN latéraux. Premièrement, des couches épitaxiales de GaN plus épaisses peuvent être développées sans aucun tampon, et une BV plus élevée (qui dépassent celle des dispositifs GaN latéraux) peuvent être obtenus et déterminés par l'épaisseur de la couche de dérive. Pendant ce temps, un champ électrique maximum est situé à la partie interne des appareils et est loin de la surface de l'appareil (éliminant l'effet de piégeage d'électrons qui se produit généralement dans les appareils latéraux). Compte tenu de la haute qualité du substrat FS-GaN, les dispositifs GaN verticaux sont étudiés depuis 2011 [24]. Depuis lors, les PND GaN verticaux avec un BV élevé et une faible résistance à l'état passant ont été fabriqués et atteignent des performances remarquables.
PND versus SBD
Pour les applications pratiques, les diodes sont des composants essentiels pour la conversion et l'inversion de puissance [25]. Avec les propriétés matérielles distinctes du GaN, les diodes à base de GaN (SBD et PND) présentent des performances remarquables, qui devraient satisfaire les exigences des applications de puissance. Comme le montre la figure 2, les PND ont la plus grande portée parmi les appareils GaN avec des structures variées et des tensions de tenue de 600 à 5 000 V, une caractéristique qui indique des scénarios d'application plus larges.
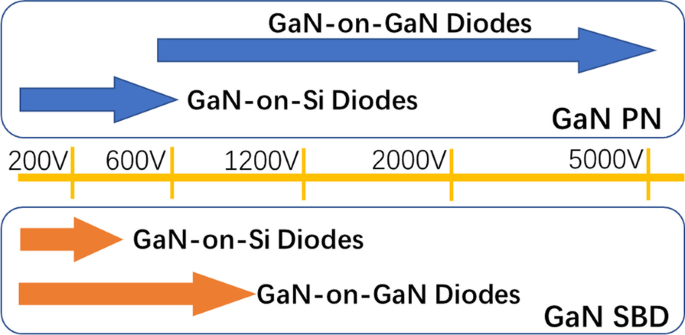
Aperçu des types d'appareils, des rapports et des classes de tension des principaux appareils d'alimentation GaN verticaux signalés ces dernières années [26]
Par rapport aux PND, qui n'ont pas de problème de stockage des porteurs minoritaires et une hauteur de barrière SBD inférieure, les SBD GaN présentent une faible tension d'activation vers l'avant (V sur ) et une récupération inverse rapide, et ces caractéristiques indiquent que les avantages du SBD sont révélés par une faible perte de conduction/de commutation, un fonctionnement à haute fréquence, mais un BV inférieur valeur que celle de PND; de plus, notez qu'une tension de mise sous tension élevée peut entraîner une perte de conduction élevée et dégrader l'efficacité des circuits et des systèmes [27, 28].
Aux champs de forte puissance, les SBD quasi-verticaux ou verticaux présentent d'excellents avantages par rapport aux SBD AlGaN/GaN [29]. De plus, une faible tension d'activation (< 0,5 V) est obtenue en ajustant la hauteur de la barrière avec un métal à faible fonction de travail. Cependant, une faible hauteur de barrière peut facilement conduire à un courant de fuite inverse élevé et abaisser le BV . Par conséquent, des structures de terminaison de bord variées sont proposées pour améliorer les performances. Grâce à l'aide de diverses technologies de terminaison de bord [27, 28, 30, 31], la densité de courant élevée à KA/cm 2 noter avec BV s supérieur à 1 kV est confirmé. Pendant ce temps, les SBD verticaux présentent également une grande capacité pour les hautes fréquences, telles que 177-183 GHz et une fréquence de coupure maximale de 902 GHz à 0 V, une caractéristique qui est attendue pour les sources d'alimentation dans les systèmes de communication sans fil térahertz [12, 32].
En ce qui concerne n -type GaN, le p -type GaN cultivé par dépôt chimique en phase vapeur métalorganique (MOCVD) et épitaxie par faisceau moléculaire (MBE) a été introduit en utilisant Mg comme accepteur [33]. Par rapport aux SBD GaN, les PND GaN présentent de nombreux avantages, tels qu'une faible résistance à l'état passant (R sur Un ) et une stabilité adéquate de l'appareil et une capacité d'inhibition des courants de surtension. Malgré la tension d'activation élevée (> 3 V) et la vitesse de commutation relativement faible, un courant de fuite ultra-faible en raison de la hauteur de barrière plus élevée et du BV élevé Est obtenu. Notez qu'un BV élevé de 0,6 à 5 kV est la performance la plus remarquable pour les PND à base de GaN. Ainsi, les PND à base de GaN ont un grand potentiel en tant que blocs de construction importants des systèmes d'alimentation de prochaine génération pour les applications à haute puissance, qui nécessitent un rendement élevé et une faible perte d'énergie [34]. Semblables aux SBD GaN verticaux, les terminaisons de bord des PND GaN sont également fabriquées pour atténuer l'encombrement du champ électrique autour de l'anode, une caractéristique qui sera décrite en détail plus loin dans cet article.
Dans les dispositifs de puissance, la jonction PN peut également être traitée comme une nouvelle structure de jonction. Pour utiliser un BV élevé avec un faible courant de fuite inverse des PND, des performances de commutation élevées et une faible tension d'activation des SBD en même temps, de nouvelles structures de dispositifs, y compris la barrière de jonction Schottky (JBS) et le PN Schottky (MPS) fusionné, génèrent une combinaison de SBD et de PND en la formation de p -régions de grille de type dans la région de contact Schottky. Les dispositifs JBS ou MPS possèdent les caractéristiques de conduction directe des SBD et de blocage inverse des PND et devraient avoir de meilleures performances de commutation et une tension inverse plus élevée que les PND et SBD conventionnels, respectivement [35].
Outre leur application à haute puissance, les PND GaN sont également adoptés pour les dispositifs optoélectroniques tels que les diodes électroluminescentes (DEL), les photodétecteurs et pour la détection de flamme en raison des faibles courants d'obscurité de quelques pA dans les photodiodes à jonction PN à base de GaN [36 , 37].
Objectif de cet examen
Sur la base des propriétés matérielles supérieures du GaN, les dispositifs à base de GaN ont été largement étudiés et utilisés dans les applications d'électronique de puissance comme l'un des matériaux semi-conducteurs les plus chauds. Parmi les dispositifs à base de GaN, le PND vertical à base de GaN a été considérablement exploré et présente un excellent BFOM. Les techniques de borne de bord sont également essentielles pour atténuer l'entassement du champ électrique autour de la pastille d'anode.
Dans cette revue, les avancées dans les techniques de croissance d'épitaxie des matériaux et de terminaux de bord en tant qu'accent principal sont suivies en illustrant les développements actuels du GaN, les différences entre les SBD et les PND GaN en termes de mécanismes et de caractéristiques, et les avantages des dispositifs verticaux par rapport aux dispositifs latéraux. . Cette revue fournit une perspective et révèle la tendance de conception des PND GaN verticaux utilisés pour un système d'alimentation, y compris les PND GaN verticaux inchoates. Le développement de la croissance épitaxiale correspondant à une couche différente dans les PND GaN verticaux est introduit dans la Sect. 2. Les technologies de terminaux de périphérie sont explorées dans la Sect. 3. Dans la sect. 4, les PND GaN verticaux sur substrat Si sont démontrés comme méthode alternative. Enfin, la conclusion et les perspectives du développement futur des PND GaN verticaux sont fournies.
Croissance de l'épitaxie des matériaux
Substrat GaN des PND verticaux
En tant que processus épitaxial courant, les couches épitaxiales de dispositifs verticaux sont actuellement principalement développées par MOCVD sur des substrats conducteurs de GaN fabriqués par épitaxie en phase vapeur d'hydrure (HVPE). Dans cette structure, la qualité du substrat affecte directement la structure épitaxiale suivante. De nombreux mécanismes de défaillance dans le dispositif proviennent de la qualité de l'épitaxie du substrat [38]. Un substrat GaN conducteur de haute qualité doit être obtenu pour améliorer encore le I direct et inverse –V performances, en particulier le courant de fuite inverse et BV capacité.
Le substrat cultivé par HVPE a été considéré comme la méthode la plus pratique pour la production de masse en raison de son coût et de sa reproductibilité relativement bas. Cependant, au début, la technologie de croissance immature signifiait que le substrat GaN cultivé par HVPE avait une concentration de fond élevée en porteurs (> 10 19 cm −3 ) et une qualité de cristal insatisfaisante. Par conséquent, le HVPE n'a pas été adopté pour développer la structure de l'appareil [39]. Grâce au développement rapide de la technologie de croissance par épitaxie, des matériaux GaN en vrac de haute qualité par HVPE deviennent progressivement possibles [40, 41]. Mis à part le substrat, la couche partiellement épitaxiale du dispositif peut désormais être développée par HVPE et peut entraîner une uniformité de courant plus élevée et l'élimination de la macro-étape sur la surface de GaN en combinant le HVPE et le processus d'épitaxie MOCVD avec une technologie sans carbone par rapport aux dispositifs cultivés uniquement par MOCVD [42].
Actuellement, un substrat GaN commercial avec une densité de dislocation minimale inférieure à 10 4 cm −2 est disponible. Les PND verticaux GaN sur substrat GaN à faible densité de défauts ont été traités. Cependant, la courbure des plaquettes reste un problème. En tant que solution prometteuse, la méthode ammonothermique permet d'obtenir un substrat GaN avec une meilleure qualité d'épitaxie. Avec les autoclaves haute pression et l'ammoniac supercritique, la dislocation du filetage peut être considérablement réduite à 10 4 –10 5 cm −2 [43]. En utilisant la méthode ammonothermique, une faible résistance de 0,001 Ω cm 2 dans le substrat GaN avec des n fortement dopés -type (1 × 10 19 –1 × 10 20 cm −3 ) a été signalé ainsi que le BV de 3 kV [44]. Cependant, l'inconvénient de la méthode ammonothermique est le faible taux de croissance d'environ 80-90 μm/jour, une caractéristique qui est défavorable à la production pratique. L'amélioration du taux de croissance et le maintien d'une haute qualité des matériaux sont également des axes rentables pour les recherches ultérieures.
En plus du substrat GaN commercial, certains substrats ont également été étudiés pour des performances distinctives, y compris le plan non Ga (c -plan) substrats. Généralement, un Ga-polaire (c'est-à-dire, c -plan) est utilisé pour un dispositif vertical GaN. Ensuite, les couches épitaxiales suivantes montrent un effet de polarisation drastique. Cependant, dans la direction opposée des homologues Ga-polaires, les couches homoépitaxiales le long du N -la direction polaire démontre des propriétés uniques du dispositif en raison de la température de décomposition plus élevée et de la propriété dépendante de la polarité [45, 46]. Avec le N -substrat FS-GaN monocristallin polaire, un champ électrique de 2,2 MV/cm sans aucune terminaison de bord a été atteint, ainsi qu'un BV de 2,4 kV avec N2 O traitement plasma de surface et plaque de champ (FP) [46, 47]. En tant qu'autre substrat GaN spécial, le m -plan attire également une large attention étant donné sa propriété non polaire pour laquelle le Ga:N était de 1:1 dans le m -plan par rapport à Ga uniquement dans le c -polaire et seulement N dans le N -substrats polaires. Avec ce substrat GaN non polaire, les caractéristiques des PND ont été signalées avec un champ électrique critique de 2,0 MV/cm et un rapport marche/arrêt élevé sans FP ni terminaison de bord [48].
Techniques d'épitaxie N-GaN
Avant l'existence de substrats GaN conducteurs de haute qualité, les PND GaN étaient principalement fabriqués sur des substrats étrangers, notamment du Si, du SiC et du saphir. Par conséquent, la structure des dispositifs a toujours été limitée à des dispositifs latéraux. Une méthode basée sur la structure latérale a été proposée pour améliorer la qualité épitaxiale. Compte tenu de la faible dislocation de filetage (TD) sur la région de la fenêtre au niveau des dispositifs latéraux, la couche épitaxiale de GaN développée latéralement à travers le masque peut atteindre une densité de TD beaucoup plus faible. Ainsi, une surcroissance épitaxiale latérale a été réalisée pour faire croître la couche épitaxiale de GaN sur un substrat de saphir pour les PND latéraux. Le courant de fuite inverse a été supprimé de trois ordres de grandeur [49].
Avec le développement de la technologie épitaxiale, des substrats de GaN monocristallins de haute qualité avec de faibles densités de dislocation de 3 × 10 –6 cm −2 sont devenus disponibles et des PND GaN ont été fabriqués sur des substrats de GaN. Combinés à des couches épitaxiales supérieures par MOCVD, les dispositifs présentent un faible courant de fuite et un BV élevé. de 600 V à 4 kV correspondant à une épaisseur de dérive de 6 à 40 μm [16, 50]. En ce qui concerne le dispositif sur le substrat de saphir, courant de fuite inverse et BV considérablement amélioré [51].
Avec le substrat GaN natif, aucune couche tampon spéciale ne se produit généralement dans la structure épitaxiale du PND comme celle sur un substrat étranger. L'effet de la couche tampon dans le PND sur le substrat GaN a été étudié comme référence. L'existence d'une couche tampon signifie que la couche de dérive a une densité de défauts plus faible. Pendant ce temps, un BV plus élevé peut être obtenu avec une couche de dérive plus fine mais une couche tampon plus épaisse. Le courant de fuite inverse de l'appareil a également été amélioré. Ces paramètres de l'appareil présentent une forte relation avec l'épaisseur de la couche tampon, ce qui a un léger effet sur les caractéristiques directes de l'appareil [52].
Les couches épitaxiales supérieures sont déposées par MOCVD, épitaxie métal-organique en phase vapeur (MOVPE) et MBE, comme discuté dans cette partie. La structure épitaxiale des PND comprend un n hautement dopé + -Couche de GaN et une couche de dérive de n − -GaN entre le substrat et p -GaN (Fig. 3). Le n hautement dopé + -La couche GaN agit comme une couche de transition sur le substrat conducteur GaN dans certains rapports.
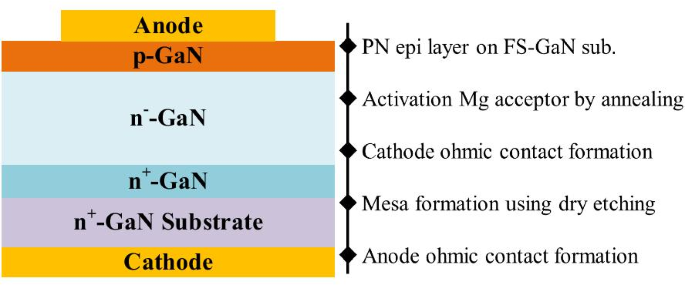
Structure schématique et processus de fabrication du PND vertical GaN
En général, la BV détermine les scénarios d'application des appareils. Par exemple, le BV le plus élevé pour un dispositif SiC par rapport à celui avec GaN permet au dispositif SiC d'être utilisé dans des applications haute puissance et haute tension comme les véhicules électriques et les trains à grande vitesse (Fig. 1). De même, les diodes PN sont généralement appliquées à des tensions plus élevées par rapport à la diode Schottky et aux HEMT. Dans les PND, le BV est principalement réalisée par la couche de dérive (n légèrement dopé − -GaN) avec l'élargissement de la région d'appauvrissement (comme représenté dans l'équation 1 avec la tension appliquée V pour lequel V est positif/négatif pour la polarisation directe/inverse lorsque le dispositif est sous polarisation inverse. De plus, la décomposition se produit avec une augmentation supplémentaire du biais inverse.
$${W_{\text{D}}} =\sqrt {\frac{{2{\varepsilon_{\text{s}}}\left( {{V_{{\text{bi}}}} - V } \right)}}{q}\frac{{{N_{\text{A}}} + {N_{\text{D}}}}}{{{N_{\text{A}}}{N_ {\text{D}}}}}}$$ (1)où S , q , V bi , N D , et N A sont respectivement l'aire de la jonction, la charge électronique, le potentiel intégré, la concentration du donneur et la concentration de l'accepteur [53].
Selon la largeur d'épuisement, les appareils peuvent être divisés en [W non perforés D> W Dm (W Dm :largeur maximale de la couche d'appauvrissement)] et perforation (W D < W Dm ). Compte tenu des problèmes de structure et de bord de l'épitaxie, la plupart des dispositifs verticaux GaN relèvent du type de perforation, c'est-à-dire que leurs régions d'épuisement s'étendent au-delà de l'ensemble du n − -Couche GaN et atteindre le n + -Substrat GaN avant claquage.
De plus, comme décrit dans l'Eq. (2), la BV peut être amélioré en augmentant l'épaisseur et en diminuant le n -type concentration de dopage de la couche de dérive.
$${\text{BV}} ={E_{\text{C}}}t - \frac{{q{N_{\text{D}}}{t^2}}}{{2{\varepsilon_0 }{\varepsilon_{\text{r}}}}}$$ (2)où E C , q , t , N D , et ε r sont le champ électrique critique, la charge électronique, n − -Épaisseur de la couche de GaN, concentration nette de porteurs du n − -Couche de GaN et permittivité des semi-conducteurs, respectivement [54]. Heureusement, l'expérience indique qu'une couche de dérive avec une épaisseur plus épaisse et un dopage plus faible ne contribue qu'à une légère augmentation de la résistance à l'état passant en conduction directe.
Par rapport à l'amélioration de la BV en augmentant l'épaisseur de la couche de dérive, en diminuant le n -type concentration de dopage dans le n − -La couche de GaN est actuellement difficile, en raison des fortes concentrations de fond notamment celles de Si, O etc. Pour une nouvelle diminution de la concentration de dopage dans le n − -Couche de GaN, la concentration de dopage involontaire est étudiée. De nombreux groupes de recherche ont introduit un i-GaN nominal d'environ 10 15 –10 16 cm − 3 en contactant p -GaN pour former le p –i –n structure pour améliorer le BV des diodes [55].
Certes, la condition préalable de ces mesures est une qualité épitaxiale élevée de la couche de dérive en raison du fait que les TD peuvent augmenter la fuite à l'état bloqué et dégrader le BV propriétés [56].
Pour améliorer encore la qualité épitaxiale de la couche de dérive dans les PND verticaux GaN, la croissance par MBE a été étudiée sur le substrat GaN. Un courant de fuite inférieur à 3 nA/cm 2 et un champ électrique de 3,1 MV/cm ont été obtenus par la très faible densité de dislocation. Les performances de claquage presque idéales indiquent que le MBE est une méthode efficace pour la croissance de couches épitaxiales dans les PND verticaux GaN [56]. Cependant, similaire à la croissance ammonothermique, le taux d'épitaxie est un autre inconvénient.
Epitaxie P-GaN
Le P-GaN, une composante importante des PND verticaux GaN, a été signalé en 1989 depuis l'apparition du GaN par HVPE en 1969 [57, 58]. Il a d'abord été utilisé pour obtenir des LED bleues. Ensuite, le p -GaN a été progressivement utilisé dans le domaine des appareils électriques tels que les appareils normalement éteints et les PND. Dans les PND GaN verticaux, le p -GaN constitue la lumière (environ 10 19 cm −3 ) et lourd (≥ 10 20 cm −3 ) concentration de dopage, qui correspondent à former une couche de jonction PN avec la couche de dérive et à faciliter les contacts ohmiques comme l'électrode d'anode.
Généralement, la croissance épitaxiale d'un p -GaN est fabriqué par MOCVD à une température d'environ 1000 °C et adopte le Mg 2+ comme accepteur. Ensuite, le p cultivé -La couche de GaN doit être activée à des températures élevées de 700 à 800 °C dans N2 ambiante ou 400 °C en O2 ambiant, facilitant ainsi une concentration de trous relativement élevée [59,60,61]. Cependant, l'énergie d'ionisation élevée de 150 à 200 meV de la liaison Mg-H signifie un p -Taux d'activation du GaN de seulement 1 à 3 %. Un faible taux d'activation est également lié à la température. Les dopants Mg peuvent être re-passivés à des températures élevées de ≥ 600 °C dans NH3 ou de l'hydrogène ambiant [62]. Pour améliorer la concentration des trous, il n'est pas possible d'augmenter uniquement la concentration de dopage car une concentration de dopage plus élevée dans le p -GaN pourrait conduire à une détérioration de la qualité cristalline de la couche et réduire la densité de trous par effet d'auto-compensation [63]. À l'heure actuelle, un pic de densité de trous peut généralement être atteint à une concentration d'accepteurs d'environ 3 × 10 19 cm −3 [64]. Bien qu'il y ait des problèmes pour p -GaN, les rapports d'enquête liés ne sont pas beaucoup. Elle peut être attribuée à deux raisons. L'un est les limitations des propriétés intrinsèques du matériel et de l'équipement épitaxié. Une autre est que le présent p -GaN peut également obtenir des performances comparatives de l'appareil.
Cependant, l'optimisation de la condition de croissance et le nouveau processus épitaxial sont toujours à l'étude. Par exemple, en 2017, le p repoussé non activé -GaN par MBE a été proposé et a un avantage sur MOCVD. Avec l'environnement à faible croissance d'hydrogène, un BV de 1,1 kV et un facteur d'idéalité de 2,5 ont été atteints par les PND verticaux fabriqués en GaN [65]. Un autre p intéressant -La méthode de fabrication de GaN est l'implantation d'ions Mg avec un processus de recuit ultra-haute pression (UHPA). Les résultats révèlent qu'un taux d'activation élevé de 70 % et une mobilité des trous de 24,1 cm 2 V −1 s −1 ont été obtenus avec un recuit post-implantation à une température de 1573-1753 K dans N2 pression de 1 GPa. Ce résultat est comparable à celui de la croissance par épitaxie par MOCVD [66].
En conclusion, pour le substrat, le substrat commercial GaN à faible défaut est maintenant disponible. Pendant ce temps, la technologie épitaxiale est toujours en développement, une situation qui affecte fortement les performances de l'appareil. En comparaison avec MOCVD, le MBE peut atteindre une excellente qualité épitaxiale, ce qui se traduit par d'excellentes performances de l'appareil sans aucune terminaison de bord. Cependant, son taux de croissance lent et son coût élevé rendent le MBE impropre à une productivité à grande échelle. La croissance par épitaxie par MOCVD reste la principale méthode de production en pratique. Ainsi, l'amélioration de la qualité des couches épitaxiées cultivées par MOCVD est une question urgente, qui prendrait un temps considérable. Par conséquent, une conception ou des mesures avancées de la structure de l'appareil sont proposées pour d'excellentes performances à ce stade.
Techniques de terminaison de bord
For a vertical GaN PNDs, BV is an important parameter. Almost all investigations on vertical GaN PNDs are centered on improving the withstanding voltage at reverse (i.e., BV ). However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
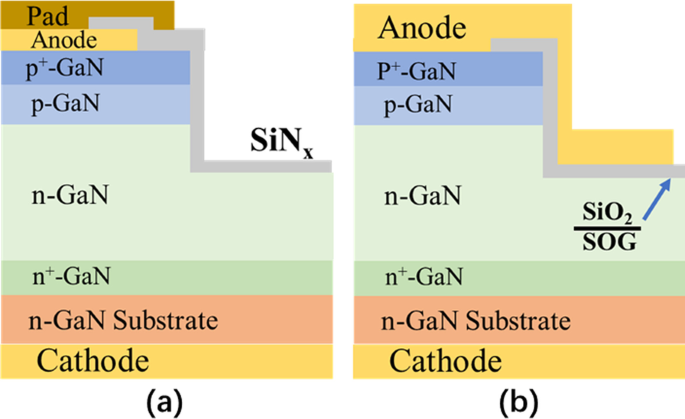
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 O3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 O3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
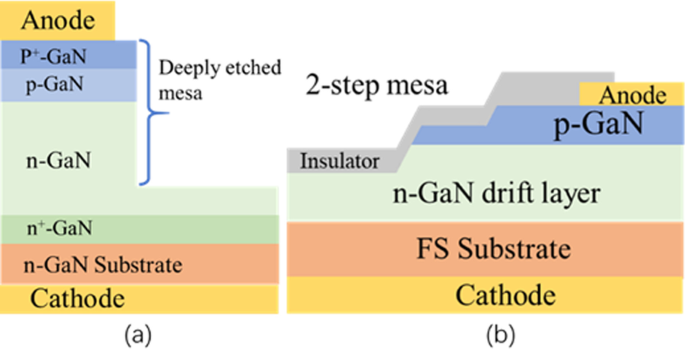
un PNDs with deeply etched mesa structure; b PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I –V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n − -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
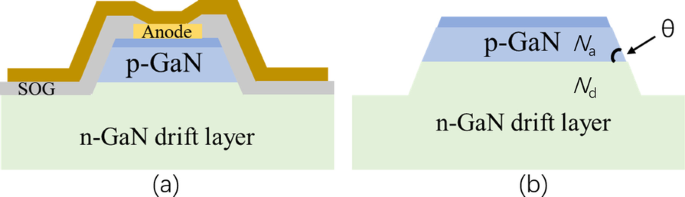
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D et θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
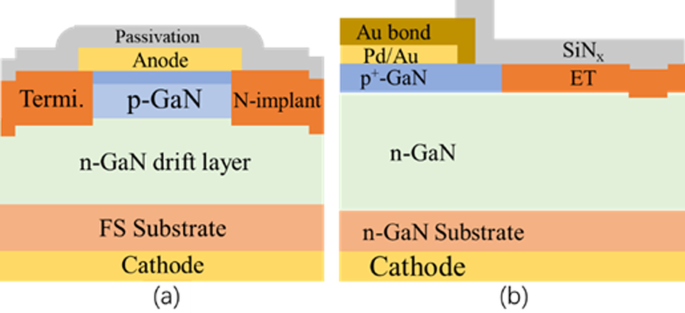
un Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I –V characteristics and a lower reverse leakage current [86].
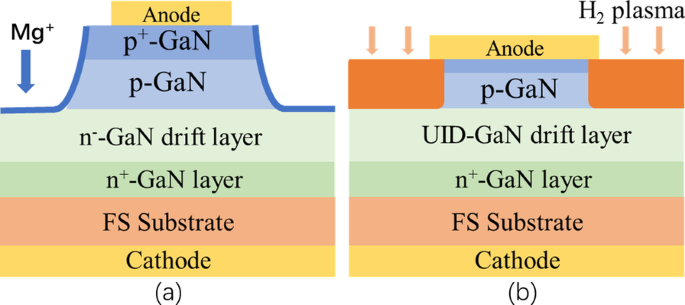
un Schematic view of PND structure by Mg ion treatment; b PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R sur of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I –V characteristics with R sur of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
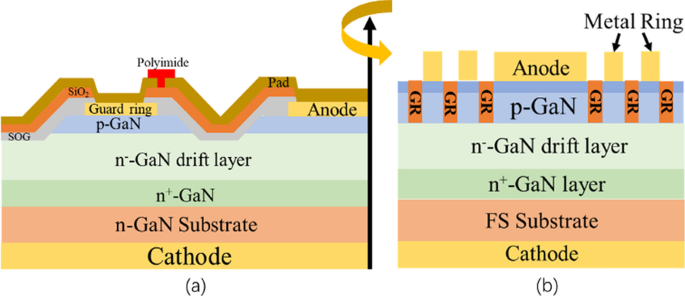
un Vertical GaN PNDs structure with floating GR termination; b PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 cm −2 and high electron mobility of 720 cm 2 /Vs a été obtenu. With the FP structure, the device has a BV of 820 V with R sur of 0.33 mΩ cm 2 .
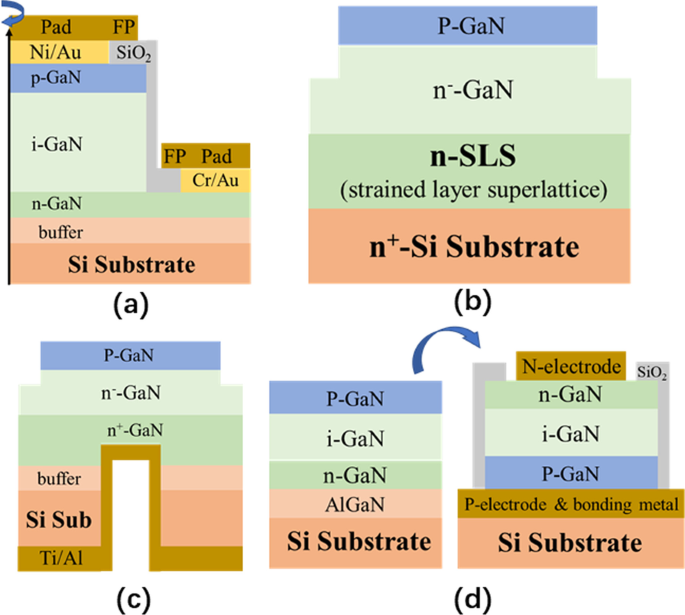
un Quasi-vertical PINDs with FP; b fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; d PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R sur of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. Les valeurs de R sur versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
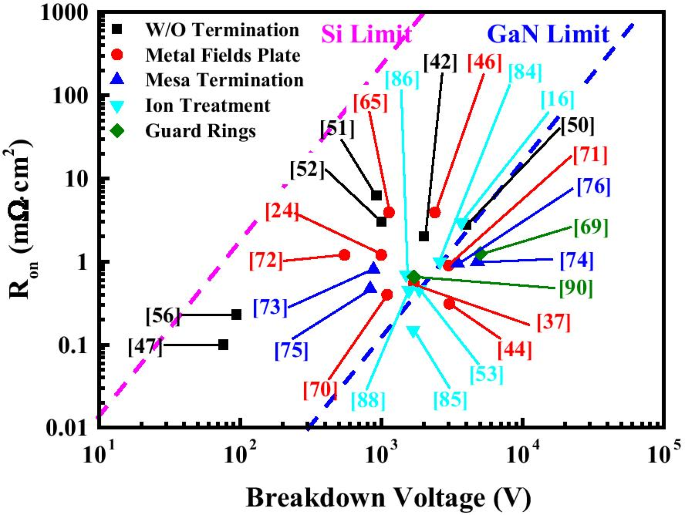
Benchmarking of the R sur versus BV of quasi- or full-vertical GaN PNDs
Disponibilité des données et des matériaux
Les ensembles de données utilisés ou analysés au cours de la présente étude sont disponibles auprès de l'auteur correspondant sur demande raisonnable.
Abréviations
- GaN :
-
gallium nitride
- SiC :
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD :
-
Diode barrière Schottky
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM :
-
La figure de mérite de Baliga
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV :
-
breakdown voltage
- FS :
-
free-standing
- MOCVD :
-
metalorganic chemical vapor deposition
- MBE :
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- LED :
-
light-emitting diode
- HVPE :
-
hydride vapor phase epitaxy
- FP :
-
field plate
- TD:
-
threading dislocation
- MOVPE :
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP :
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH :
-
tetramethylammonium hydroxide
Nanomatériaux
- Les appareils de nouvelle génération offrent une capacité PoE améliorée pour les appareils IoT
- Les appareils augmentent la puissance PoE sur les commutateurs et les câbles existants
- Nanogénérateur
- Sécurité de l'IoT :ce que nous pouvons apprendre des menaces récentes
- Les ingénieurs développent des radios Wi-Fi ultra-basse consommation
- Comment l'énergie sans fil transforme la fabrication
- Alimentez sans fil plusieurs appareils portables à l'aide d'une source unique
- Utiliser la technologie solaire pour alimenter des appareils intelligents à l'intérieur
- Le système récupère l'énergie des ondes radio pour alimenter les appareils portables



