Fiabilité améliorée des écrans TFT a-IGZO avec une taille de fonction réduite et une structure de couche d'arrêt de gravure propre
Résumé
Les effets de Cu + diffus dans des transistors à couche mince (TFT) amorphes d'oxyde d'indium-gallium-zinc (a-IGZO) sur la microstructure et les performances au cours d'un processus d'arrêt de gravure propre (CL-ES) et d'un processus de gravure par canal arrière (BCE) sont étudiés et comparés . La couche CL-ES formée avec un composant propre, comme vérifié par TOF-SIMS, peut protéger la couche a-IGZO du décapant S/D et empêcher Cu + diffusion, ce qui permet de réduire le nombre de défauts de type accepteur et d'améliorer la fiabilité des TFT. Les TFT fabriqués à structure CL-ES ont une stabilité de sortie supérieure (I final ds /initial I ds = 82,2 %) par rapport à celui des TFT structurés BCE (53,5 %) car ils ont une meilleure valeur SS initiale (0,09 V/dec vs 0,46 V/dec), et une meilleure valeur SS finale (0,16 V/dec vs 0,24 V/dec) après l'évaluation de la contrainte de courant élevé (HCS). En particulier, la variation des tensions de seuil a une grande différence (3,5 V pour les TFT CL-ES et 7,2 V pour les TFT BCE), ce qui signifie que les TFT structurés CL-ES ont une fiabilité plus élevée que les TFT structurés BCE. TFT. Par conséquent, le processus CL-ES devrait promouvoir l'application généralisée de la technologie a-IGZO dans l'industrie des semi-conducteurs.
Contexte
Récemment, les produits d'affichage ont mis l'accent non seulement sur les grandes surfaces et les hautes résolutions, mais aussi sur des conceptions extérieures esthétiques [1,2,3]. Les lunettes étroites ont été adoptées comme l'une des caractéristiques vitales de cet accent de conception [4]. Pour réaliser cela, il est essentiel d'intégrer les circuits principaux qui pilotent l'affichage dans le panneau. Gate Drive IC on array (GOA) est une méthode relativement simple et couramment utilisée, où le signal de porte entre dans le panneau une ligne après l'autre et le V sur se déplace séquentiellement à chaque fois. GOA présente de multiples avantages, tels qu'un coût réduit (élimination des coûts G-IC, suppression du processus de liaison G-IC, utilisation accrue du substrat de verre, etc.) et un effet esthétique (cadres étroits ou dispositifs sans bordure) [5]. Contrairement aux TFT à pixels individuels, cependant, les TFT GOA nécessitent des conditions de fiabilité plus strictes pour obtenir un courant de sortie plus élevé et des performances plus longues. Avec les demandes récemment croissantes du marché pour des produits haute résolution, l'amélioration de la fiabilité des performances de GOA est devenue urgente et nécessaire [6].
L'oxyde d'indium-gallium-zinc amorphe (a-IGZO) est largement utilisé dans l'industrie de l'affichage en raison de sa mobilité électronique à saturation élevée (5~10 cm 2 /V s) et faible courant de coupure (< 1 pA) [7, 8]. La technologie de gravure par canal arrière (BCE) est couramment utilisée pour la production de TFT dans l'industrie [9, 10]. Les TFT a-IGZO structurés par BCE ont des caractéristiques satisfaisantes pour les TFT de pixels individuels et la réduction de la taille des TFT GOA. Cependant, certaines caractéristiques clés des TFT, en particulier la stabilité du courant de sortie, ne peuvent pas satisfaire l'environnement de contrainte de courant élevé (HCS) requis pour les TFT GOA [11,12,13], principalement en raison de deux caractéristiques du processus BCE [14]. La première est que la surface d'un film a-IGZO (canal arrière du a-IGZO TFT) est exposée à des agents de gravure S/D, qui consistent traditionnellement en HNO3 , H3 Bon de commande4 , et CH3 COOH, qui ont une vitesse de gravure rapide qui n'est pas contrôlable pour les films a-IGZO [15]. Un léger H2 O2 -Un décapant à base de gravure stable et des dommages minimes aux films a-IGZO peuvent être utilisés pour la gravure de l'électrode S/D (Cu métal), mais des dommages à la surface du film a-IGZO sont toujours inévitables [16]. Deuxièmement, le contact direct du métal S/D (Mo/Cu/Mo) avec le film a-IGZO peut contaminer le canal arrière du TFT [17]. Heureusement, un processus CL-ES (Clean Etch Stopper), qui est moins compliqué et coûteux et minimise la contamination, peut être utilisé pour fabriquer des TFT basés sur un IGZO avec une uniformité et une stabilité améliorées pour les écrans de grande surface [18]. Bien que le TFT structuré CL-ES montre une performance améliorée, les questions de la réaction de l'agent de gravure avec le film a-IGZO et de la façon dont Cu + la diffusion dans les films a-IGZO affecte la microstructure et les performances des dispositifs restent floues.
Dans cette étude, des TFT a-IGZO GOA avec une taille réduite et une structure de canal arrière propre ont été fabriqués via un processus CL-ES par gravure par lots de multicouche a-IGZO/Mo/Cu/Mo. De plus, l'influence du graveur et du Cu + La diffusion sur la microstructure et les performances des dispositifs TFT a-IGZO GOA structurés CL-ES sont étudiées et comparées à celles des dispositifs TFT a-IGZO GOA structurés BCE. Plus important encore, la couche d'arrêt de gravure du dispositif CL-ES sert de couche de protection de gravure S/D ainsi que le Cu + couche barrière de diffusion, qui aide à réduire la quantité de défauts et à améliorer la fiabilité de la fiabilité de la contrainte de courant élevée, les valeurs SS, la contrainte de courant élevée et les variations de tension de seuil, etc. Par conséquent, ce travail fournit des preuves directes et une démonstration perspicace que l'amélioration Les performances des TFT structurés CL-ES sont fortement corrélées avec sa structure CL-ES et ses composants propres et confirment que le processus CL-ES pourrait être une voie efficace pour la production de masse d'écrans avec des performances satisfaisantes.
Méthodes expérimentales
Fabrication de TFT a-IGZO GOA
Les dispositifs TFT a-IGZO structurés en CL-ES ont été fabriqués via un processus CL-ES modifié en cinq étapes (Fig. 1), comme indiqué dans nos travaux précédents [15]. Tout d'abord, l'électrode de grille a été formée avec du métal Mo/Cu et l'isolant de grille a été déposé avec une double couche SiNx/SiOx (3000 Â/1000 Â) en utilisant PECVD à 340°C. Deuxièmement, un film a-IGZO de 300 Å a été déposé par pulvérisation cathodique réactive magnétron DC à température ambiante avec une pression partielle d'oxygène de 15 %. Une couche d'arrêt de gravure (SiOx, ESL) de 1000 Å a été déposée en utilisant PECVD à 240 °C et gravée réactivement par CF4 plasma pour la structuration, en utilisant le masque de photolithographie actif du procédé BCE comme masque de gravure. Pour cette étape, le film a-IGZO sous les motifs de la couche ES a été protégé de l'exposition au CF4 plasma, tandis que le reste du film a-IGZO, non protégé par les motifs de la couche ES, n'a pas non plus été gravé mais a été converti en un film conducteur. Troisièmement, les électrodes source-drain (S/D) (triples couches Mo/Cu/Mo) ont été déposées par pulvérisation et gravées à l'aide d'un H2 O2 agent de gravure contenant 0,2 % en poids d'un additif fluoré, le masque de photolithographie S/D et le motif de couche ES servant de masque de gravure. Quatrièmement, une couche de passivation de 3000 Â a été déposée. Les processus ultérieurs étaient similaires à ceux d'une fabrication typique de fond de panier TFT LCD.

Processus de fabrication du TFT a-IGZO GOA
À titre de comparaison, les dispositifs TFT a-IGZO à structure BCE ont été fabriqués à l'aide du processus BCE conventionnel et du même masque BCE.
Caractérisation
Les morphologies, les microstructures et les compositions des échantillons ont été caractérisées par SEM (Camscan Mx2600FE), la spectroscopie photoélectronique à rayons X (XPS, PHI Quantera II) et la spectrométrie de masse à ions secondaires à temps de vol (IONTOF, TOF-SIMS 5) . Les mesures électriques ont été effectuées à l'aide d'un analyseur de caractéristiques à semi-conducteur (Keysight 4082A) dans un environnement sombre et à 60°C. Pour plus de simplicité, la fiabilité HCS a été évaluée sur plus de 1000 s avec V gs à 25 V et V ds à 25 V. Au cours de l'évaluation, l'état du GOA TFT a été surveillé en mesurant le I ds courant à intervalles de 1 s, et la tendance du I ds courant a été analysé. Le Je d -V g les caractéristiques de transfert ont également été surveillées à des intervalles de 100 s.
Résultats et discussion
Le dispositif GOA TFT, contenant des canaux TFT et des composants de grille, de drain et de source, tels que fabriqués par le processus CL-ES, est illustré à la Fig. 2. Pour mesurer avec précision chaque caractéristique TFT, tous les TFT ont été déconnectés à l'aide d'un laser, ainsi devenant indépendants, de sorte que la porte, la source et le drain ne pourraient pas partager un nœud avec un autre TFT. Comme indiqué par la ligne rouge sur la Fig. 2, ce TFT a une conception structurelle multicanaux et GOA séparée, avec une largeur et une longueur de canal de 120 m et 10 μm, respectivement, pour la commodité des mesures électriques. Ce TFT est également conçu pour avoir un niveau moyen de flux de courant vers les canaux TFT individuels en plaçant un morceau de métal flottant (situé au milieu des canaux), qui intègre chaque canal. Avant l'évaluation de la fiabilité du HCS, la fiabilité du fonctionnement séparé est d'abord confirmée en évaluant l'interférence électrique du TFT d'intérêt provenant des autres TFT périphériques. Dans ce cas, le I désactivé Le courant de bruit des TFT GOA séparés est mesuré à 3 pA (insérer la courbe sur la Fig. 2), confirmant qu'il n'y a pas d'interférence électrique provenant des autres dispositifs constituant GOA à proximité.
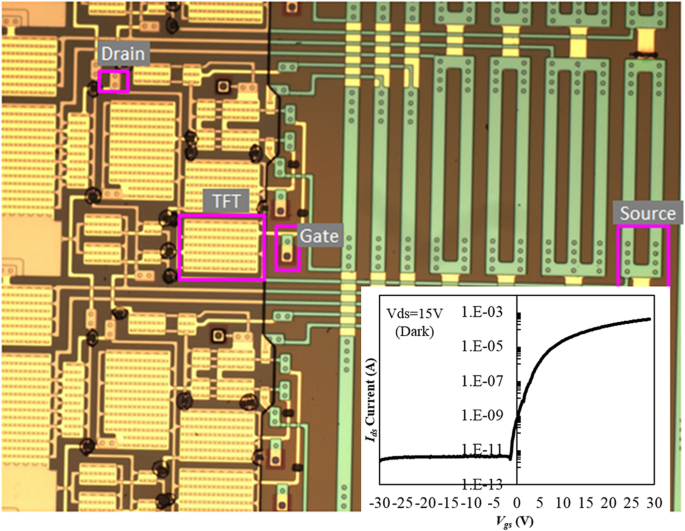
Photographies des TFT GOA séparés électriquement des circuits GOA (insérer :I désactivé courant de bruit entre le TFT d'intérêt et les autres TFT périphériques)
Plusieurs tailles de caractéristiques des TFT structurés CL-ES et TFT structurés BCE sont mesurées et comparées. Pour les TFT structurés CL-ES (Fig. 3a), la largeur et la longueur sont de 4 m et 6 μm, respectivement, similaires à celles des TFT a-IGZO structurés BCE de la Fig. 3b. Généralement, le procédé BCE est souhaitable pour la fabrication de TFT à oxyde en raison de sa petite taille de caractéristique. Par conséquent, les TFT structurés CL-ES obtenus présentent une taille de caractéristique réduite et un degré d'intégration aussi élevé que les TFT structurés BCE. De plus, la taille de la section transversale des TFT structurés CL-ES est similaire à celle des TFT structurés BCE (Fig. 3c, d), tandis que les TFT structurés CL-ES montrent une couche ES distincte qui n'est pas observée. dans les TFT BCE. Le processus CL-ES forme principalement des motifs ES, tandis que le processus de gravure par lots sur a-IGZO/Mo/Cu/Mo multicouche peut être réalisé avec des masques similaires pour les motifs actifs et les électrodes source-drain que ceux du processus BCE. Par conséquent, à l'exception des motifs ES, le nombre de masques photolithographiques utilisés dans le procédé CL-ES est le même que pour le procédé BCE. Ce processus CL-ES peut éviter le nombre accru de masques du processus ESL conventionnel et a une taille de caractéristique réduite, ce qui le rend économiquement viable pour la production de masse. De plus, sans utiliser l'exposition en demi-teinte, une procédure de simplification de processus classiquement utilisée dans l'industrie LCD TFT, la complication du processus et le coût de fabrication sont tous deux réduits.
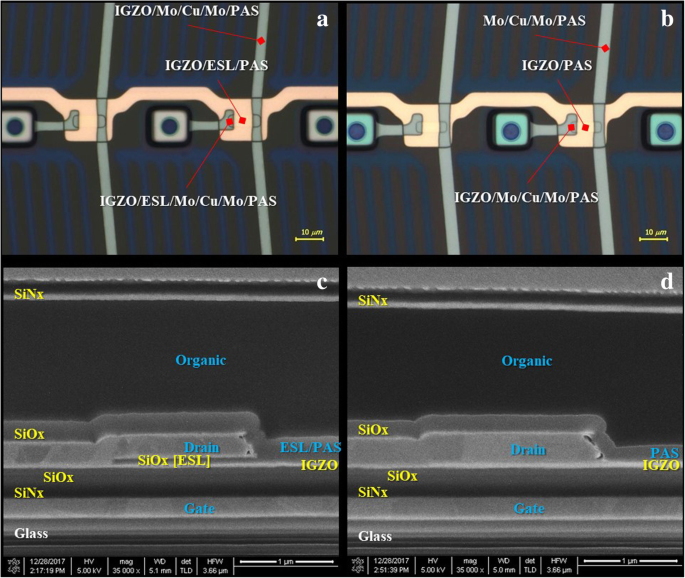
Images SEM des TFT a-IGZO :a Vue de dessus TFT structurée CL-ES, b Vue de dessus TFT structurée BCE, c Vue en coupe TFT structurée CL-ES, et d Vue en coupe TFT structurée BCE
Pour observer davantage les défauts de surface des TFT à structure BCE au cours du processus de fabrication de BCE, la composition de surface des films a-IGZO avant recuit (échantillon 1), après recuit (échantillon 2) et après exposition au H2 O2 Cu etchant (échantillon 3) est étudié via XPS. Dans les spectres entièrement balayés des films a-IGZO (Fig. 4a–c), des pics pour les éléments In, Ga, Zn, O et C existent au cours du processus de fabrication BCE. Comme le montre la Fig. 4d, bien que le TFT structuré BCE ne montre aucun changement significatif dans la composition des films a-IGZO avant recuit (échantillon 1) et après recuit à 330 °C pendant 1 h (échantillon 2), des changements significatifs sont observé après exposition à des produits chimiques humides (échantillon 3). En particulier, le zinc, qui a une énergie de liaison relativement faible avec l'oxygène, est de 4,82 % dans l'échantillon 1 et de 5,42 % dans l'échantillon 2, mais il a diminué à 3,16 % dans l'échantillon 3. L'indium a une variation minimale dans les compositions parmi les différents processus et la variation relative en pourcentage de Zn par rapport à In est énorme, à savoir 44,1 %, 46,0 % et 27,6 % pour les échantillons 1, 2 et 3, respectivement. Ceci est similaire pour le gallium, qui a également une forte affinité de liaison avec l'oxygène. En d'autres termes, pendant le processus de gravure humide, des défauts indésirables, y compris une perte substantielle de Zn et Ga, se sont produits sur la surface arrière exposée de l'oxyde semi-conducteur. Les raisons de ce phénomène peuvent être liées à leurs différentes énergies de liaison à l'oxygène et aux différentes structures moléculaires du film a-IGZO [19].

Analyse XPS de la composition de surface des couches minces a-IGZO a avant recuit, b après recuit, et c après exposition au H2 O2 Cu graveur pendant le processus BCE. d Pourcentages atomiques correspondants pour le processus ci-dessus
Il est bien connu que la résistance chimique des films a-IGZO aux agents de gravure acides est très faible [20]. En particulier, la perte brutale de Zn, dont on pense qu'elle détermine la structure moléculaire de l'a-IGZO, provoque un affaiblissement de la structure de surface des films d'a-IGZO. De plus, la réduction de Ga, qui supprime la génération de porteurs via sa forte énergie de liaison avec l'oxygène, peut augmenter la probabilité de développer des lacunes d'oxygène [Vo] [21]. Par conséquent, les TFT GOA structurés en BCE ne peuvent pas éviter les dommages de gravure sur le canal arrière du TFT, même dans un H2 relativement doux O2 -graveur à base de Cu.
Pour confirmer la protection de la couche ES, la composition de la région du canal TFT a-IGZO est étudiée en utilisant TOF-SIMS pour les échantillons préparés par les procédés BCE et CL-ES (clean etch stopper) (Fig. 5). Depuis Cu + dans le film a-IGZO peut produire des défauts de type accepteur et piéger des électrons, le canal TFT a-IGZO doit être propre pour améliorer la stabilité électrique. Comme observé, le Cu + Le pic détecté dans l'échantillon BCE est 20 fois supérieur à celui de l'échantillon CL-ES. De plus, la région de détection de Cu + chevauche la zone de détection de Zn + et Ga + dans une large mesure (Fig. 5a). Ces résultats ont indiqué que les films a-IGZO dans les TFT à structure BCE sont contaminés par Cu + en raison du contact direct du film a-IGZO dans la région du canal arrière TFT avec le métal Cu. Pour les TFT structurés CL-ES (Fig. 5b), Cu + n'est détecté que dans la région ES, indiquant que le contact direct de la région du canal TFT a-IGZO avec le métal Cu est évité. Étonnamment, une quantité considérable de Zn + apparaît dans l'ESL. Le Zn + diffusé est causée par les conditions de plasma de prétraitement et les conditions de pression plus élevées pendant le dépôt ESL. Par conséquent, la couche ES dans les TFT structurés CL-ES est essentielle pour améliorer la stabilité électrique en évitant les dommages de surface et la contamination des films a-IGZO.

Analyse TOF-SIMS des régions de canaux des TFT a-IGZO fabriqués via a le BCE et b les processus CL-ES
L'évaluation de la contrainte de courant élevé (HCS) pour les TFT a-IGZO GOA structurés CL-ES et BCE est illustrée à la figure 6a. Pour les mêmes tailles d'entités, le I initial ds Le courant du TFT structuré CL-ES est de 429 A, ce qui est supérieur à celui du TFT structuré BCE (343 μA). Après l'évaluation HCS pour 1000 s, le I ds Le courant du TFT structuré CL-ES est de 352 µA, soit environ 82,2 % de sa valeur initiale. En revanche, le I ds Le courant résiduel du TFT structuré BCE a diminué à 183 µA et ne conserve que 53,5% de sa valeur initiale. De plus, tel qu'évalué par extrapolation (Fig. 6b), le I ds Le courant résiduel du TFT structuré CL-ES devrait être de 302,6 A, maintenant 70,5 % de sa valeur initiale après 10 000 s. Pour le TFT structuré par BCE, le I ds le courant résiduel diminue fortement à 111,7 µA, ne conservant que 33,7% de sa valeur initiale. Par conséquent, avec les mêmes caractéristiques de sortie, le degré d'intégration du TFT GOA fabriqué via le processus CL-ES peut être augmenté jusqu'à 271% par rapport à celui du processus BCE.
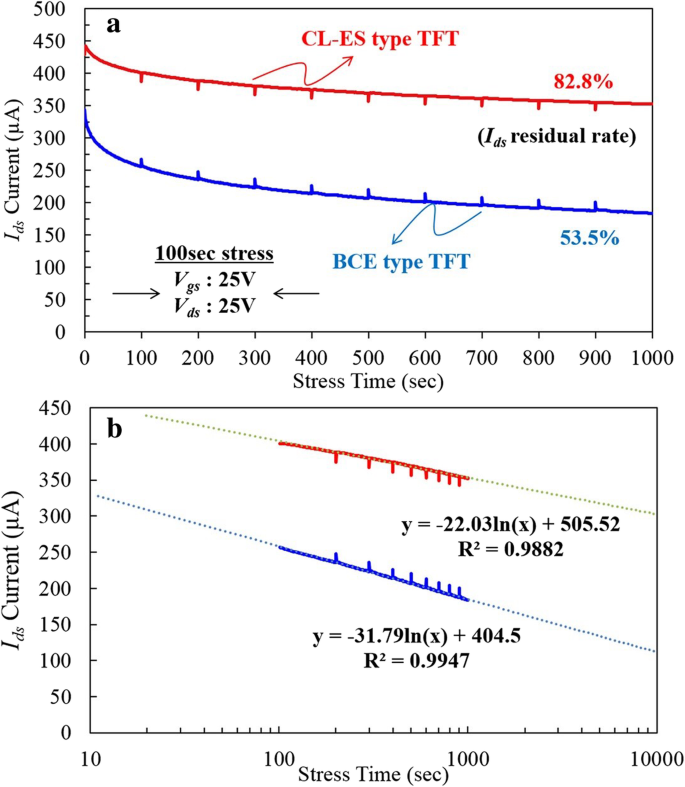
un Données expérimentales pour 1000 s et b extrapolation pour l'évaluation HCS à long terme des TFT GOA structurés CL-ES et BCE
De plus, le I -V Les caractéristiques de transfert des TFT GOA structurés CL-ES et BCE au cours de l'évaluation de la fiabilité HCS sont également mesurées (Fig. 7 et Tableau 1). Pour le TFT structuré CL-ES (Fig. 7a), la tension de seuil est de 0,0 V lors de l'évaluation HCS initiale (25 °C) et de 3,5 V après l'évaluation HCS à 60 °C pendant 1000 s. De plus, la tension de seuil se décale continuellement dans le sens positif avec un changement total (ΔV ème ) de 3,5 V. La valeur d'oscillation sous le seuil (SS) est légèrement augmentée de 0,09 à 0,16 V/déc. Pour le TFT à structure BCE, la tension de seuil est beaucoup plus élevée, à savoir 4,0 V à 25 °C, et augmente à 11,2 V après évaluation HCS à 60 °C pendant 1000 s. Une raison possible de ces tensions de seuil élevées est la diffusion de Cu + dans le film a-IGZO pendant le processus de gravure humide du processus BCE. Cu + peut agir comme sites de défauts de type accepteur dans les films a-IGZO, et une haute densité de Cu + peut piéger un grand nombre d'électrons. Les électrons piégés génèrent un potentiel coulombique blindé qui entraîne le phénomène transitoire de décalage de tension de seuil. Généralement, la masse de l'isolant de grille et les sites de défauts nouvellement formés à l'intérieur de la masse des films a-IGZO peuvent augmenter la valeur SS des TFT [11]. Ces résultats expliquent clairement la diminution du I ds courant résiduel dans les TFT structurés BCE. Cependant, la valeur SS du TFT structuré BCE montre une tendance à diminuer de 0,46 à 0,24 µV/déc. Cette valeur de SS décroissante résulte de l'accumulation d'électrons à proximité de l'interface a-IGZO, après quoi l'isolant de grille peut rapidement remplir les niveaux élevés des sites pièges de type accepteur qui existaient initialement. De plus, les sites pièges se remplissent plus rapidement qu'ils ne sont générés par le HCS, et par conséquent, le nombre d'électrons piégés diminue progressivement avec le temps. Ceci est en accord avec le comportement de décalage positif de la tension de seuil.

Je -V caractéristiques de transfert mesurées lors de l'évaluation HCS de a le CL-ES et b les TFT GOA structurés par BCE. Comportement de c la tension de seuil et d l'oscillation sous le seuil à des intervalles de 1000 s et V ds = 15 V. Les mesures initiales du I d -V d caractéristiques de sortie pour e le CL-ES- et f les TFT GOA structurés par BCE avec V gs = 0, 5, 10, 15 et 20 V
Quant à l'uniformité des caractéristiques pour CL-ES, car ESL fournit une protection active du canal arrière contre Cu + contamination et endommagement par gravure, son résultat est stable par rapport à celui de BCE. De plus, il convient de noter que les caractéristiques de la courbe de sortie ne montrent aucune différence pour BCE et peuvent promettre une production et une stabilité CL-ES (tableau 2, Fig. 7e, f).
Les figures 7 c et d montrent les résultats de l'oscillation sous le seuil et le comportement de la tension de seuil ainsi que la progression de l'évaluation du HCS. En règle générale, la valeur de swing sous le seuil du TFT GOA augmente progressivement, comme on le voit pour le TFT structuré CL-ES (Fig. 7d). Cependant, le TFT structuré par BCE montre un comportement anormal, la valeur de swing sous le seuil augmentant initialement et diminuant par la suite au cours de l'évaluation HCS. La valeur SS du TFT structuré BCE augmente de 0,46 à 0,55 V/déc lorsque la température du substrat augmente de 25 à 60 °C. Dans le même temps, la tension de seuil passe négativement de 4,0 à 2,9 V (Fig. 7c). Ce phénomène anormal résulte de l'endommagement de la surface du film a-IGZO par le H2 O2 mordancer avec du fluorure ajouté. Comme mentionné précédemment, les dommages de surface des films a-IGZO impliquent un manque d'atomes de Zn, de Ga et d'oxygène, ce qui forme de nombreux sites de défauts, y compris des lacunes d'oxygène. On pense que ces sites de défauts sont actifs en tant qu'états de type donneur peu profond, qui sont proches de la bande de conduction minimale, et sont capables d'excitation thermique et d'agir comme des sources d'électrons pour la bande de conduction, conduisant à une dégradation de l'a- Caractéristiques IGZO TFT. Sur la base des résultats ci-dessus, le TFT structuré CL-ES avec de petits états de type accepter et des carences en oxygène qui agissent comme des états de type donneur peu profond est une bien meilleure structure que le TFT structuré BCE.
Conclusion
En conclusion, nous démontrons que le GOA TFT structuré CL-ES, avec une taille réduite des fonctionnalités de l'appareil et une couche d'arrêt de gravure propre, peut améliorer considérablement les performances et la stabilité de l'appareil. Avec le procédé de fabrication de TFT structuré CL-ES proposé, les dommages et la contamination du canal arrière du TFT sont minimisés. De plus, pour le même degré d'intégration que celui du TFT GOA structuré en BCE, le procédé TFT structuré en CL-ES peut répondre aux objectifs de conception esthétique et de rentabilité de fabrication. Le TFT GOA structuré CL-ES montre d'excellentes performances électriques par rapport à celles du TFT GOA structuré BCE, y compris un courant ionique résiduel beaucoup plus élevé (~ 187%), une valeur SS initiale beaucoup plus faible (0,09 V/dec) et un variation beaucoup plus faible de la tension de seuil (3,5 V). Cela implique la possibilité de conceptions GOA avec une intégration et une fiabilité beaucoup plus élevées. Les performances et la stabilité améliorées suggèrent que le TFT structuré CL-ES, avec un processus simplifié et une couche d'arrêt de gravure propre, surmonte avec succès les défauts de type donneur causés par les carences en oxygène et les défauts de type accepteur causés par Cu + diffusion au cours du processus BCE. Par conséquent, une composition de surface propre pour la région de canal a-IGZO dans les TFT structurés CL-ES est importante pour la production de fonds de panier TFT a-IGZO avec des écrans haute fiabilité, haute résolution et à lunette étroite.
Abréviations
- TFT :
-
Transistor à couche mince
- GOA :
-
Circuit intégré de lecteur de porte sur la baie
- a-IGZO :
-
Oxyde d'indium-gallium-zinc amorphe
- LCD :
-
Affichage à cristaux liquides
- PEVCD :
-
Dépôt chimique en phase vapeur assisté par plasma
- ESL :
-
Couche d'arrêt de gravure
- BCE :
-
Gravure du canal arrière
- HCS :
-
Tension de courant élevée
- SiOx :
-
Oxyde de silicium
- SiNx :
-
Nitrure de silicium
- SS :
-
Swing sous le seuil
Nanomatériaux
- Concevoir avec Bluetooth Mesh :nœuds et types de fonctionnalités
- Les MCU offrent des performances, une connectivité et une sécurité améliorées
- Conduire la fiabilité et améliorer les résultats de la maintenance avec l'apprentissage automatique
- Différence entre structure et classe :expliquée avec un exemple C++
- Amélioration de la modulation et de l'absorption de fréquence du microbolomètre THz avec structure en micropont par antennes de type spirale
- Morphologie, structure et propriétés optiques des films semi-conducteurs avec des nano-îlots GeSiSn et des couches tendues
- Amélioration des performances du périphérique TFT a-IGZO à l'aide d'un processus d'interface propre via des nano-couches Etch-Stopper
- Résistance de contact réduite entre le métal et le n-Ge par insertion de ZnO avec traitement au plasma d'argon
- IBM :garantir de manière proactive la fiabilité et la sécurité avec EAM



