IBM chez SPIE :sept avancées pour les puces au-delà de 7 nm
Lorsque nous avons annoncé les premières puces de test fonctionnelles à 7 nœuds (7 nm) de l'industrie en 2015, avec nos partenaires GLOBALFOUNDRIES et Samsung, nous savions que le processus pour que les puces atteignent la « maturité de fabrication » - peut-être dès l'année prochaine, serait rapide. Alors que cet effort s'accélère dans l'industrie des semi-conducteurs, IBM continue de repousser les limites en se concentrant sur les défis des prochains nœuds au-delà de 7 nm.
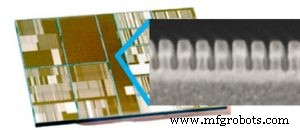 Notre équipe IBM présente sept articles à la conférence 2017 de l'International Society for Optics and Photonics (SPIE) Advanced Lithography axé sur l'exploration et l'activation de la technologie au-delà du nœud 7 nm. Et cela commence par la lithographie ultraviolette extrême (EUV).
Notre équipe IBM présente sept articles à la conférence 2017 de l'International Society for Optics and Photonics (SPIE) Advanced Lithography axé sur l'exploration et l'activation de la technologie au-delà du nœud 7 nm. Et cela commence par la lithographie ultraviolette extrême (EUV).
Avec des puces de 7 nm, nous créons maintenant des conceptions relatives à la taille d'un transistor, ou même au câblage entre les transistors, qui sont vraiment au niveau atomique. Pour obtenir ce type de mise à l'échelle sans schémas de modélisation trop complexes, l'EUV est la clé. En une seule exposition, l'EUV peut créer un motif à haute résolution qui est inaccessible par les processus antérieurs de structuration des semi-conducteurs. Cependant, l'activation de la modélisation EUV nécessite un équipement, un processus et un savoir-faire spécialisés, tous trouvés dans les laboratoires de recherche d'IBM à Albany, NY et Yorktown Heights, NY. Ces sept avancées présentées au SPIE concernant les masques EUV (modèles utilisés pour imprimer des conceptions de circuits sur une plaquette de silicium) et les matériaux de structuration (résistants à la lumière ou matériaux résistants à la gravure), peuvent tous être considérés comme essentiels pour permettre la technologie 7 nm. et au-delà :
Dans Optimisation de l'intention de conception au nœud au-delà de 7 nm :l'intersection des techniques d'atténuation stochastique DTCO et EUVL , Michael Crouse montre que même si le titre de son exposé est gros, de petits changements dans les conceptions de câblage peuvent considérablement améliorer les conditions d'impression. Dans la figure 1, il montre que si l'optimisation des formes de masque est effectuée correctement, des lignes continues sans rupture peuvent être imprimées aux plus petites dimensions requises pour le nœud de 7 nm et au-delà.
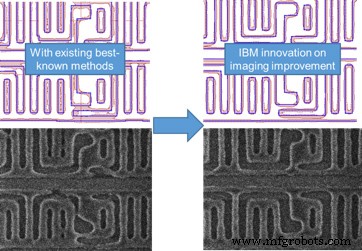
Figure 1 :Amélioration de l'optimisation du contraste sur le câblage métallique bidimensionnel démontrée avec la lithographie EUV. Avec le type d'amélioration illustré à droite, les caractéristiques 20-30{ccf696850f4de51e8cea028aa388d2d2d2eef894571ad33a4aa3b26b43009887} plus petites que celles du nœud 7 nm peuvent être imprimées de manière plus robuste et la variabilité physique/électrique peut être considérablement réduite.
Dans Enquête sur les empilements de masques alternatifs en lithographie EUV, Martin Burkhardt simule les performances de nouveaux matériaux non utilisés actuellement pour les masques EUV. En considérant l'ensemble du tableau périodique, il est en mesure d'illustrer que les masques EUV qui offrent un contraste encore meilleur sont à notre portée. En fait, la fabrication de masques avec certains de ces matériaux permettrait d'obtenir des motifs plus fidèles sur une plaquette de silicium sans aucun autre changement dans la technologie EUV, et permettrait ainsi à l'industrie de s'adapter facilement au-delà de 7 nm.
Dans Analyse complète de la rugosité des bords et de la largeur des lignes pour la lithographie EUV , Ravi Bonam illustre comment les petites imperfections et ondulations d'une ligne de câblage peuvent être caractérisées clairement et, ce faisant, montre quelles conditions produisent les caractéristiques les plus droites, essentielles pour améliorer la fabricabilité du processus de structuration EUV, ainsi que les performances et le rendement de la puce.
Dans Principes fondamentaux des interactions résistance EUV-masque inorganique , Dario Goldfarb cherche à améliorer la pile de films de matériau de structuration (le point de transfert du motif à la plaquette) en améliorant les interactions physiques et chimiques aux interfaces entre ces films, qui souvent n'aiment pas se coller les uns aux autres. Il exploite cette compréhension pour créer des interactions chimiques spécifiques pour maintenir ces matériaux ensemble (illustré à la figure 2), ce qui est essentiel pour garantir que ces minuscules formes à motifs EUV puissent rester en place suffisamment longtemps pour transférer leurs motifs dans le substrat ci-dessous.

Figure 2 :Une résistance EUV qui était auparavant impossible à modeler sur un masque dur en silicium inorganique peut désormais être clairement modelée après une personnalisation de surface adaptée à la combinaison résistance/masque dur.
Dans un thème similaire à l'exposé de Dario Goldfarb, Indira Seshadri fait une démonstration dans Ultrathin EUV patterning stack utilisant une brosse en polymère comme couche de promotion de l'adhérence , qu'en utilisant un matériau semblable à un polymère qui établit un pont entre de minuscules caractéristiques à motifs EUV et le substrat sous-jacent, ces motifs à très haute résolution peuvent être gravés dans le substrat en dessous et conserver la forme de conception souhaitée, clé pour garantir des puces souples à ces longueurs échelles.
Avec autant de nouvelles solutions à couches minces en jeu, la capacité de discerner et d'améliorer les processus dignes de fabrication dès le début des phases de recherche est essentielle. Dans une conférence intitulée Diriger vers le bas la densité de défauts dans les piles de films composites de structuration EUV , Luciana Meli présente des études de cas systématiques, en utilisant un hybride de techniques d'inspection des défauts disponibles, pour montrer les améliorations de processus et de matériaux nécessaires pour fournir la faible défectivité requise pour 7 nm et au-delà de la fabricabilité EUV.
Rassemblant bon nombre de ces concepts d'amélioration de l'imagerie et des matériaux, Anuja De Silva présentera une conférence intitulée Développement de motifs à exposition unique pour la lithographie EUV , présentant une structuration réussie des circuits de câblage aux dimensions de 30 nm et moins requises au-delà du nœud de 7 nm. La capacité d'y parvenir représente un grand pas en avant par rapport aux capacités initialement disponibles pour le nœud 7 nm (voir Figure 3), et peut en fait améliorer le nœud 7 nm lui-même, bien qu'elle soulignera les défis qui restent à relever pour permettre des puces pleinement fonctionnelles et exploitables à dimensions requises pour la technologie au-delà de 7 nm.
Une puce de 7 nm a 20 milliards de transistors dans l'espace à peu près de la taille d'un ongle. Ils feront leur chemin dans les systèmes et les appareils, étendant les capacités - et la loi de Moore - pour effectuer des tâches de plus en plus exigeantes dans l'analyse de données, l'informatique cognitive et tout ce que la prochaine génération d'applications mobiles contient. Les travaux présentés à SPIE cette année rapprochent l'industrie des solutions de modélisation qui non seulement rendent le processus 7 nm plus robuste avec l'EUV à exposition unique, mais permettent également une mise à l'échelle supplémentaire pour obtenir encore plus d'avantages en termes de puissance/performance pour les années à venir.

Figure 3 :L'innovation sur plusieurs aspects du processus de modélisation permet à IBM de fournir une capacité de processus de modélisation holistique pour fournir les tailles de fonctionnalités nécessaires au-delà du nœud 7 nm.
Autres présentations IBM au SPIE 2017
Optimisation de l'intention de conception au nœud au-delà de 7 nm :l'intersection des techniques d'atténuation stochastique DTCO et EUVL , Michael Crouse, Nicole Saulnier, Derren Dunn
Enquête sur les empilements de masques alternatifs en lithographie EUV , Martin Burkhardt
Décomposition du TCC à l'aide de noyaux non cohérents pour un calcul plus rapide des images lithographiques, Alan Rosenbluth
Développement de masques durs contenant du Ti par dépôt PEALD, Anuja De Silva
Options de modélisation DSA pour les applications logiques et mémoire, Charlie Liu
Étude électrique du processus de rétrécissement DSA et de l'effet de rectification de CD à moins de 60 nm à l'aide d'un véhicule de test EUV, Cheng Chi
Atteindre la véritable superposition dans les nœuds avancés, Chiew-Seng Koay
Stratégies sans couche de finition pour le contrôle de l'orientation des copolymères entièrement organiques à haut χbloc, Dan Sanders
Identification et analyse de sensibilité de fiabilité d'un système de règles de base corrélé (arc de conception), Eric Eastman
Développement et étalonnage rapides et avancés de modèles DSA 3D pour la co-optimisation de la technologie de conception, Kafai Lai
Impacts inattendus des gaz RIE sur les films lithographiques, Martin Glodde
Prédiction des tests électriques utilisant la métrologie hybride et l'apprentissage automatique, Marie Breton
Réduction du LER dans Si et SiN grâce à l'optimisation RIE pour les applications de guides d'ondes photoniques, Nathan Marchack
Stratégies de modélisation d'auto-assemblage dirigé pour les applications de mémoire à changement de phase, R. Bruce
Caractérisation des matériaux pour l'intégration de processus de dispositifs multicanaux à porte tout autour (GAA), Raja Muthinti
Analyse complète de la rugosité des bords et de la largeur des lignes pour la lithographie EUV, Ravi Bonam
Nanomatériaux
- Cible en alliage de tungstène et de titane pour puces
- Allez au-delà des exigences minimales du réseau Skype pour de meilleurs résultats
- Présentation des arguments en faveur des puces neuromorphiques pour l'IA informatique
- Les scientifiques d'IBM inventent un thermomètre pour l'échelle nanométrique
- IBM 5 en 5 :les laboratoires médicaux « sur une puce » serviront de détectives de la santé pour traquer les maladies à l'échelle nanométrique
- Les chercheurs IBM remportent le prix de l'innovation pour la recherche sur les semi-conducteurs
- IBM présente une architecture blockchain hybride pour l'Internet des objets
- Au-delà de l'AIOps :observabilité pour des opérations informatiques efficaces
- Les sept exigences pour un usinage optimisé



